HDI 制作流程
- 格式:ppt
- 大小:4.79 MB
- 文档页数:50

制作HDI盲埋孔板的基本流程一.概述:HDI板,是指High Density Interconnect,即高密度互连板,是PCB行业在20世纪末发展起来的一门较新的技术。
传统的PCB板的钻孔由于受到钻刀影响,当钻孔孔径达到0.15mm时,成本已经非常高,且很难再次改进。
而HDI板的钻孔不再依赖于传统的机械钻孔,而是利用激光钻孔技术。
(所以有时又被称为镭射板。
)HDI板的钻孔孔径一般为3-5mil(0.076-0.127mm),线路宽度一般为3-4mil(0.076-0.10mm),焊盘的尺寸可以大幅度的减小所以单位面积内可以得到更多的线路分布,高密度互连由此而来。
HDI技术的出现,适应并推进了PCB行业的发展。
使得在HDI板内可以排列上更加密集的BGA、QFP等。
目前HDI技术已经得到广泛地运用,其中1阶的HDI已经广泛运用于拥有0.5PITCH的BGA的PCB制作中。
HDI技术的发展推动着芯片技术的发展,芯片技术的发展也反过来推动HDI技术的提高与进步。
目前0.5PITCH的BGA芯片已经逐渐被设计工程师们所大量采用,BGA的焊角也由中心挖空的形式或中心接地的形式逐渐变为中心有信号输入输出需要走线的形式。
所以现在1阶的HDI已经无法完全满足设计人员的需要,因此2阶的HDI开始成为研发工程师和PCB制板厂共同关注的目标。
1阶的HDI技术是指激光盲孔仅仅连通表层及与其相邻的次层的成孔技术,2阶的HDI技术是在1阶的HDI技术上的提高,它包含激光盲孔直接由表层钻到第三层,和表层钻到第二层再由第二层钻到第三层两种形式,其难度远远大于1阶的HDI技术。
二.材料:1、材料的分类a.铜箔:导电图形构成的基本材料b.芯板(CORE):线路板的骨架,双面覆铜的板子,即可用于内层制作的双面板。

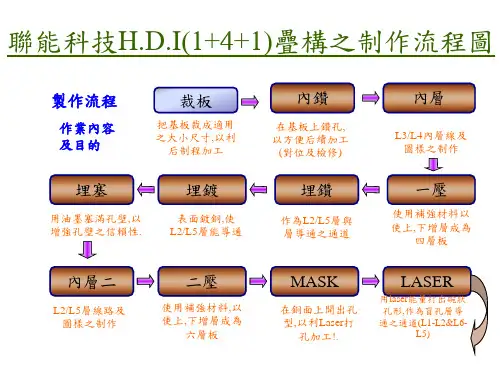


HDI基本知识制作流程随着电子行业日新月异的变化,电子产品向着轻、薄、短、小型化发展,相应的印制板也面临高精度、细线化、高密度的挑战。
全球市场印制板的趋势是在高密度互连产品中引入盲、埋孔,从而更有效的节省空间,使线宽、线间距更细更窄。
一.HDI定义HDI:high Density interconnection的简称,高密度互连,非机械钻孔,微盲孔孔环在6mil以下,内外层层间布线线宽/线隙在4mil以下,焊盘直径不大于0.35mm的增层法多层板制作方式称之为HDI板。
盲孔:Blind via的简称,实现内层与外层之间的连接导通埋孔:Buried via的简称,实现内层与内层之间的连接导通盲埋孔大都是直径为0.05mm~0.15mm的小孔,埋孔在內層薄板上按正常雙面板製作,而盲孔成孔方式有激光成孔,等离子蚀孔和光致成孔,通常采用激光成孔,而激光成孔又分为CO2和YAG紫外激光机(UV)。
二.HDI板板料1.HDI板板料有RCC, FR4,LD PP1)RCC:Resin coated copper的简称,涂树脂铜箔。
RCC是由表面经粗化、耐热、防氧化等处理的铜箔和树脂组成的,其结构如下图所示:(我司要求樹脂厚度需>4mil时才使用RCC)RCC的树脂层,具备与FR一4粘结片(Prepreg)相同的工艺性。
此外还要满足积层法多层板的有关性能要求,如:(1)高绝缘可靠性和微导通孔可靠性;(2)高玻璃化转变温度(Tg);膨脹係數CTE較大(3)低介电常数和低吸水率;(4)对铜箔有较高的粘和强度;但其peel strenth較差(5)固化后绝缘层厚度均匀同时,因为RCC是一种无玻璃纤维的新型产品,有利于激光、等离子体的蚀孔处理,有利于多层板的轻量化和薄型化。
另外,涂树脂铜箔具有9um,12um,18um等薄铜箔,容易加工。
2)FR4板料:我司要求樹脂厚度<=4mil时需使用FR4。
使用PP时一般采用1080, 尽量不要使用到2116的PP3)LD PP:一種可激光鑽孔的粘結片2. 铜箔要求:当客户无要求时,基板上铜箔在传统PCB内层优先采用1 OZ,HDI板优先使用HOZ,内外电镀层铜箔优先使用1/3 OZ。



一。
概述:板,是指High Density Inrconnect,即高密度互连板,是行业在20世纪末发展起来的一门较新的技术。
传统的的由于受到钻刀影响,当钻孔孔径达到0.15mm时,成本已经非常高,且很难再次改进。
而HDI板的钻孔不再依赖于传统的钻孔,而是利用技术。
(所以有时又被称为镭射板。
)HDI板的钻孔孔径一般为3-5l(0.076-0.127mm),线路宽度一般为3-4mil(0.076-0.10mm),焊盘的尺寸可以大幅度的减小所以单位面积内可以得到更多的线路分布,高密度互连由此而来。
HDI技术的出现,适应并推进了PCB行业的发展。
使得在HDI板内可以排列上更加密集的BGA、QFP等。
目前HDI技术已经得到广泛地运用,其中1阶的HDI已经广泛运用于拥有0.5TCH的BGA的PCB制作中。
HDI技术的发展推动着芯片技术的发展,芯片技术的发展也反过来推动HDI 技术的提高与进步。
目前0.5PITCH的BGA芯片已经逐渐被设计工程师们所大量采用,BGA的焊角也由中心挖空的形式或中心接地的形式逐渐变为中心有信号输入输出需要走线的形式。
所以现在1阶的HDI已经无法完全满足设计人员的需要,因此2阶的HDI 开始成为研发工程师和PCB制板厂共同关注的目标。
1阶的HDI技术是指盲孔仅仅连通表层及与其相邻的次层的成孔技术,2阶的HDI技术是在1阶的HDI技术上的提高,它包含激光盲孔直接由表层钻到第三层,和表层钻到第二层再由第二层钻到第三层两种形式,其难度远远大于1阶的HDI技术。
二。
材料:1、材料的分类a.铜箔:导电图形构成的基本材料b.芯板(CORE):线路板的骨架,双面覆铜的板子,即可用于内层制作的双面板。
c.半固化片(Prepreg):多层板制作不可缺少的材料,芯板与芯板之间的粘合剂,同时起到绝缘的作用。
d.阻焊油墨:对板子起到防焊、绝缘、防腐蚀等作用。
e.字符油墨:标示作用。
f.表面处理材料:包括铅锡合金、镍金合金、银、OSP等等。



HDI(HighDensityInterconnector)制作流程培训教程1.前言本教程旨在为初学者提供HDI(HighDensityInterconnector)制作的详细流程,帮助读者掌握HDI制作的基本知识和技能。
通过本教程的学习,读者将能够了解HDI的制作原理、流程和关键环节,为从事相关工作奠定基础。
2.HDI简介HDI(HighDensityInterconnector)是一种高密度互连技术,主要用于印刷电路板(PCB)的制作。
HDI技术可以提高PCB的布线密度,减小PCB尺寸,降低信号传输延迟,提高信号完整性,从而满足高性能电子产品对PCB的要求。
HDI技术在方式、笔记本电脑、服务器等电子产品中得到了广泛应用。
3.HDI制作流程3.1材料准备1.基材:通常采用FR-4环氧玻璃布基材,具有良好的绝缘性能和机械强度。
2.铜箔:用于制作PCB的导电层,分为压延铜箔和电解铜箔两种。
3.焊接掩模:用于保护铜箔在焊接过程中不受氧化,提高焊接质量。
4.抗剥油:用于防止铜箔在后续工序中被剥离。
5.线路油墨:用于绘制线路图案。
6.抗焊油墨:用于保护线路在焊接过程中不受氧化。
7.焊接材料:如焊锡膏、助焊剂等。
3.2基材处理1.剪裁:根据设计要求,将基材剪裁成所需尺寸。
2.清洗:去除基材表面的污渍、油渍等,以保证后续工序的顺利进行。
3.打磨:对基材表面进行打磨,提高基材与铜箔的结合力。
3.3铜箔贴附1.涂覆抗剥油:在基材表面涂覆一层抗剥油,防止铜箔在后续工序中被剥离。
2.贴附铜箔:将铜箔贴附在基材上,采用热压或真空吸附等方式。
3.4线路制作1.涂覆线路油墨:在铜箔表面涂覆一层线路油墨,用于绘制线路图案。
2.曝光:将涂覆有线路油墨的铜箔暴露在紫外光下,使线路图案固化。
3.显影:将未固化的线路油墨清洗掉,露出铜箔上的线路图案。
4.蚀刻:将铜箔上未涂覆线路油墨的部分腐蚀掉,形成线路。
5.清洗:去除线路表面的蚀刻液残留,以保证后续工序的顺利进行。
基本知识及制作流程随着电子行业日新月异的变化,电子产品向着轻、薄、短、小型化发展,相应的印制板也面临高精度、细线化、高密度的挑战。
全球市场印制板的趋势是在高密度互连产品中引入盲、埋孔,从而更有效的节省空间,使线宽、线间距更细更窄。
一.HDI定义HDI:high Density interconnection的简称,高密度互连,非机械钻孔,微盲孔孔环在6mil以下,内外层层间布线线宽/线隙在4mil以下,焊盘直径不大于0.35mm的增层法多层板制作方式称之为HDI板。
盲孔:Blind via的简称,实现内层与外层之间的连接导通埋孔:Buried via的简称,实现内层与内层之间的连接导通盲进孔大都是直径为0.05mm~0.15mm的小孔,埋盲孔成孔方式有激光成孔,等离子蚀孔和光致成孔,通常采用激光成孔,而激光成孔又分为CO2和YAG紫外激光机(UV)。
二.HDI板板料1.HDI板板料有RCC,LDPE,FR41)RCC:Resin coated copper的简称,涂树脂铜箔。
RCC是由表面经粗化、耐热、防氧化等处理的铜箔和树脂组成的,其结构如下图所示:(厚度>4mil时使用)RCC的树脂层,具备与FR一4粘结片(Prepreg)相同的工艺性。
此外还要满足积层法多层板的有关性能要求,如:(1)高绝缘可靠性和微导通孔可靠性;(2)高玻璃化转变温度(Tg);(3)低介电常数和低吸水率;(4)对铜箔有较高的粘和强度;(5)固化后绝缘层厚度均匀同时,因为RCC是一种无玻璃纤维的新型产品,有利于激光、等离子体的蚀孔处理,有利于多层板的轻量化和薄型化。
另外,涂树脂铜箔具有12pm,18pm等薄铜箔,容易加工。
2)LDPE:3)FR4板料:厚度<=4mil时使用。
使用PP时一般采用1080, 尽量不要使用到2116的PP2. 铜箔要求:当客户无要求时,基板上铜箔在传统PCB内层优先采用1 OZ,HDI板优先使用HOZ,内外电镀层铜箔优先使用1/3 OZ。