SMT表面组装技术SMT对照表
- 格式:doc
- 大小:399.00 KB
- 文档页数:13


SMT知识一、 名词解释SMT:“Surface Mounted Technology” 的缩写,表面贴装技术。
SMD:“Surface Mounted Devices” 的缩写,表面组装器件。
SMC:“Surface Mounted Components”的缩写,表面组装元件。
PCB:”Printed Circuit Board”的缩写,印刷电路板。
Resistor:电阻(在PCB上用字母“R”表示,如“R1,R2,R3”等)Capacitor:电容(在PCB上用字母“C”表示,如“C1,C2,C3”等)Inductor:电感(在PCB上用字母“L”表示,如“L1,L2,L3”等)Chip bead: 磁珠(在PCB上用字母“L”表示,如“L1,L2,L3”等,我们一般也用“Inductor”来表示)IC:集成电路二、 SMT的意义1.电子产品追求小型化,以前使用的穿孔插件元件已无法缩小;2.电子产品功能更完整,所采用的集成电路(IC)已无穿孔元件,特别是大规模、高集成IC,不得不采用表面贴片元件;3.产品批量化,生产自动化,厂方要以低成本高产量出产优质产品以迎合顾客需求及加强市场竞争力;4.电子元件的发展,集成电路(IC)的开发,半导体材料的多元应用;5.电子科技革命势在必行,追逐国际潮流。
三、 现我厂SMT工艺流程印刷锡膏——手工贴片——波峰焊——目视——插件焊接——清洗——ICT测试四、 允收标准1.插件目标:焊点表层总体呈现光滑和与焊接零件有良好润湿。
部件的轮廓容易分辨。
焊接部件的焊点有顺畅连接边缘。
表层形状呈凹面状。
可接受:1)有些成份的焊锡合金、引脚或印刷板贴装和特殊焊接过程可能导致干枯粗糙、灰暗、或颗粒状外观的焊锡。
这些焊接是可接受的。
2)可接受的焊点必须是当焊锡与待焊表面,形成一个小于或等于90度的连接角时能明确表现出浸润和粘附,当焊锡的量过多导致蔓延出焊盘或阻焊层的轮廓时除外。

SMT组装工艺标准本标准完全等同于IPC-A-610B 第10章表面组装Ⅱ级水准主要内容1.红胶粘接标准2.各类组件安放及焊接标准2.1片状元件2.2管状元件2.3IC类组件2.3.1“L”形引脚2.3.2“J”形引脚2.3.3“I”形引脚3.片状元件侧立﹑竖起的要求4.各类组件焊接损伤标准4.1片状电阻损伤4.2片状电容损伤4.3管状元件损伤W=端面寬度T=端面長度P=焊盤寬度H=元件高度1红胶粘接标准优选﹕焊盘和端面上看不到红胶痕迹, 红胶点位于焊盘中间接收﹕红胶沾染焊盘和端面之间﹐沾染程度小于焊点最小距离C的1/4不合格: 红胶沾染到焊盘和端面之间﹐沾染程度接近焊点最小距离C的1/22 组件安放及焊接标准2.1片式组件(Ⅰ)移位A优选﹕端面没有越出焊盘接收﹕在焊点最小距离C符合接收条件的条件下,允许A越出.不合格: A越出使焊点最小距离C不符合接收条件的要求.移位BT长度方向越出(B>0)焊点C优选﹕C=W (W<P)或C=P(P<W)接收﹕C=50%W(W<P)或C=50%P(P<W)不合格: C<50%W(W<P)或C<50%P(P<W) 焊点D优选﹕D=T(端面长度)接收﹕如果其它焊点形态参数符合可接收条件对D无特定要求焊点E F各级别对E无特殊要求在焊点润湿良好情况下对F无特殊要求焊点G接收﹕焊点润湿良好不合格: G< 0.2mm立方体多面(1.3.5)引出端(Ⅱ)W=端面寬度T=端面長度P=焊盤寬度H=元件高度焊点ASMT组装工艺标准移位BT长度方向出(B>0)焊点C优选﹕C=W (W<P)或C=P(P<W)接收﹕C=50%W(W<P)或C=50%P(P<W)不合格: C<50%W(W<P)或C<50%P(P<W)焊点不润湿或半润湿.焊点D优选﹕D= T接收﹕焊点润湿良好,对D无特殊要求,焊点润湿良好有少许助剂残留,焊料不必铺展到焊盘边缘.焊点E优选﹕E= G+H 且焊料润湿良好接收﹕E可能横向超出焊盘和纵向高出端面,但不允许伸到组件基体不合格: 焊点延伸到组件基体焊点F优选﹕焊点润湿良好接收﹕F=G+0.5mmH(H<2mm)或F=G+25%H(H>2mm)不合格: F<G+25% H焊点JSDL-07-12-04-00SMT组装工艺标准2.2 管状元件W=端面寬度T=端面長度P=焊盤寬度H=元件高度移位A优选﹕引出端没有越出焊盘(A≦0)接收﹕A≦25%W(W<P)或A≦25%P(P<W)不合格: A>25%W移位B端头面越出(B>0)焊点C优选﹕C≧W (W<P)或C≧P(P<W)接收﹕C=50%W(W<P)或C=50%P(P<W)不合格: C<50%W或C<50%P焊点DSDL-07-12-05-00SMT组装工艺标准焊点E优选﹕E= G+H 且焊料润湿良好接收﹕E可能横向超出焊盘和纵向高出顶面,但不允许漫到组件基体不合格: 焊点漫延到组件基体焊点F优选﹕焊料润湿良好接收﹕焊点润湿良好﹐对F无特殊要求不合格: 焊点不润湿焊点G接收﹕焊点润湿良好对G无特殊要求不合格: 焊点不润湿焊点J优选﹕端面完全重合焊盘接收: J>0不合格: 圆柱端面和焊盘不重合2.3 IC类组件2.3.1 “L”形引脚W=端面寬度T=端面長度P=焊盤寬度H=元件高度SDL-07-12-06-00SMT组装工艺标准移位A优选:没有越出合格:A=50%W(W>1mm)或A=0.5W(W<1mm)不合格﹕A>50%W(W>1mm)A>0.5W(W<1mm)移位B各级别对B的要求都不允许违反关于电气间隙或对引脚跟部焊点参数的最低要求焊点C优选:C≧W可接收:C=50%W不合格:C<50%W焊点D优选:D=L接收:D=W+引脚跟部的焊点高度不合格:D<W焊点E接收:对外形较高的组件,焊料可以延伸但不得触及封装体或封口﹔对外形较低的组件焊料可延伸到封装体不合格:高外形组件----焊料触及封装或封口低外形组件----焊料过多以致不符合导体间隙的要求﹐或者不能确定是否润湿;焊点不润湿或半润湿SDL-07-12-07-00SMT组装工艺标准焊点F接收: F=G+50%不合格: F<G+50%2.3.2 “J”形引脚W=端面寬度T=端面長度焊点不得触及封装移位A优选:没有越出可接收:A≦50%W不合格:A>50%W移位B不作具体要求焊点C优选:C≧W可接收:C=50%W不合格:C<50%WSDL-07-12-08-00SMT组装工艺标准焊点D 接收:D>150%W不合格:D<150%W焊点润湿情况不明显焊点E接收:焊点不得碰到封装体不合格:焊点碰到封装﹐焊点开裂﹐焊点不足焊点F 接收:F=50%T+G不合格:F<G+50%T焊点跟部润湿情况不明显焊点G 接收:焊点焊点充足﹐润湿良好不合格:焊点再流焊不充分2.3.3 “I”形引脚W=端面寬度T=端面長度SDL-07-12-09-00SMT组装工艺标准移位A优选:没有越出不合格:A>0移位B不允许越出焊点C优选:C≧W可接收:C=75%W不合格:C<75%W移位D对D不作具体规定焊点E可接收:焊点润湿情况良好﹐焊点可以进入引脚弯部﹐但不能碰到封装不合格: 焊点不润湿﹐焊点碰到封装焊点F可接收:F=0.5mm不合格:F<0.5mmSDL-07-12-10-00SMT组装工艺标准焊点G焊点充足﹐润湿情况良好3.片状元件侧立﹐竖立的要求侧立可接收:C侧立组件小(长)L≦3.05mm(宽)W≦1.52mm比周围组件矮﹐组件板上侧立的片状元件不大于5个不合格:侧立组件不符合以上情况﹐焊盘或组件端面不完全润湿﹐组件竖立(碑石现象)4.组件焊接损伤4.1片状元件损伤电阻裂纹﹑缺口优选:无缺损可接收:顶面涂层在离边缘小于0.25mm的A区域内有缺口在B区域﹐不允许缺损不合格:任何侧面缺口﹐任何侧面裂纹电阻端子﹑缺损优选:电极金属镀层完整可接收: 电极金属镀层脱落不超过50%不合格:变形程度越出规定的公差﹐电极顶面金属镀层脱落比例超过50%4.2 片状电容的浸析4.2.1片状电容的浸析优选:无浸析现象可接收: 任何边的浸析不超过边长(W或T)的1/4不合格: 端头面浸析﹐露出陶瓷面浸析不超过边长W或T的1/4SDL-07-12-11-00SMT组装工艺标准4.2.2片状电容的缺口和裂缝优选:没有缺口和裂缝可接收: 缺口或切口尺寸小于25%T=厚度的1/425%W=宽度的1/425%L=长度的1/4不合格: 缺口或切口已露出电极﹐有裂缝4.3 管状元件可接收:没有任何损伤不合格:任何裂缝缺口和损伤。

50条SMT工艺技术一、什么是表面组装技术?英文称之为“Surface Mount Technology ”简称SMT,它是将表面贴装元件贴,焊到印制是电路板焊盘上涂布焊锡膏,再将表面贴装元器件准确地放到涂有焊锡膏的焊盘上,通过加热印制电路板直至焊锡膏熔化,冷却后便实现了元器件与印制电路之间的连接.二、表面组装技术的优点:1)组装密度高,采用SMT相对来说,可使电子产品体积缩小60%,重量减轻75%2)可靠性膏,一般不良焊点率小于百万分之十,比通孔元件波峰焊接技术低一个数量级.3)高频特性好4)降低成本5)便于自动化生产.三、表面组装技术的缺点:1)元器件上的标称数值看不清,维修工作困难2)维修调换器件困难,并需专用工具3)元器件与印刷板之间热膨胀系数(CTE)一致性差。
随着专用携手拆装设备及新型的低膨胀系数印制板的出现,它们已不再成为阻碍SMT深入发展的障碍.四、表面组装工艺流程:SMT工艺有两类最基本的工艺流程,一类为锡膏回流焊工艺,另一类是贴片—波峰焊工艺.在实际生产中,应根据所用元器件和生产装备的类型以及产品的需求选择不同的工艺流程,现将基本的工艺流程图示如下:1)锡膏—回流焊工艺,该工艺流程的特点是简单,快捷,有利于产品体积的减小.2)贴片-波峰焊工艺,该工艺流程的特点是利用双面板空间,电子产品的体积可以进一步减小,且仍使用通孔元件,价格低廉,但设备要求增多,波峰焊过程中缺陷较多,难以实现高密度组装。
3)混合安装,该工艺流程特点是充分利用PCB板双面空间,是实现安装面积最小化的方法之一,并仍保留通孔元件价低的特点.4)双面均采用锡膏—回流焊工艺,该工艺流程的特点能充分利用PCB 空间,并实现安装面积最小化,工艺控制复杂,要求严格,常用于密集型或超小型电产品,移动电话是典型产品之一。
我们知道,在新型材料方面,焊膏和胶水都是触变性质流体,它们引起的缺陷占SMT总缺陷的60%,训练掌握这些材料知识才能保证SMT质量.SMT还涉及多种装联工艺,如印刷工艺,点胶工艺,贴放工艺,固化工艺,只要其中任一环节工艺参数漂移,就会导致不良品产生,SMT工艺人员必须具有丰富的工艺知识,随时监视工艺状况,预测发展动向。

(表面组装技术)SMT实用工艺基础目錄第一章SMT概述41.1SMT概述41.2 SMT相关技术5一、元器件5二、窄间距技术(FPT)是SMT发展的必然趋势5三、无铅焊接技术5四、SMT主要设备发展情况61.3常用基本术语7第二章SMT工艺概述72.1 SMT工艺分类7一、按焊接方式,可分为再流焊和波峰焊两种类型7二、按组装方式,可分为全表面组装、单面混装、双面混装三种方式(见表2-1)82.2施加焊膏工艺8一、工艺目的8二、施加焊膏的要求9三、施加焊膏的方法92.3施加贴片胶工艺9一、工艺目的9二、表面组装工艺对贴片胶的要求及选择方法9三、施加贴片胶的方法和各种方法的适用范围112.4贴装元器件11一、定义11二、贴装元器件的工艺要求112.5再流焊11一、定义11二、再流焊原理12第三章波峰焊接工艺143.1波峰焊原理143.2波峰焊工艺对元器件和印制板的基本要求153.3波峰焊工艺材料163.4波峰焊工艺流程173.5波峰焊的主要工艺参数及对工艺参数的调整173.6波峰焊接质量要求19第四章表面组装元器件(SMC/SMD)概述194.1表面组装元器件基本要求194.2表面组装元件(SMC)的外形封装、尺寸主要参数及包装方式(见表4-1)214.3表面组装器件(SMD)的外表封装、引脚参数及包装方式(见表4-2)224.4表面组装元器件的焊端结构224.5表面组装电阻、电容型号和规格的表示方法;234.6表面组装元器件(SMC/SMD)的包装类型244.7表面组装元器件使人用注意事项25第五章表面组装工艺材料介绍――焊膏255.1焊膏的分类、组成255.2焊膏的选择依据及管理使用275.3焊膏的发展动态285.4无铅焊料简介28第六章SMT生产线及其主要设备306.1 SMT生产线306.2 SMT生产线主要设备31第七章SMT印制电路板设计技术337.1 PCB设计包含的内容:337.2如何对SMT电子产品进行PCB设计33第八章SMT印制电路板的设计要求368.1几种常用元器件的焊盘设计368.2焊盘与印制导线连接,导通孔.测试点.阻焊和丝网的设置418.3元器件布局设置438.4基准标志46第九章SMT工艺(可生产性)设计----贴装机对PCB设计的要求489.1可实现机器自动贴装的元器件尺寸和种类489.2 PCB外形和尺寸499.3 PCB允许翘曲尺寸499.4 PCB定位方式49第十章SMT不锈钢激光模板制作、外协程序及制作要求5010.1向模板加工厂发送技术文件5010.2模板制作外协程序及制作要求51第十一章SMT贴装机离线编程5511.1 PCB程序数据编辑5611.2自动编程优化编辑5711.3在贴装机上对优化好的产品程序进行编辑5711.4校对并备份贴片程序58第十二章后附(手工焊)修板及返修工艺介绍5812.1后附(手工焊)、修板及返修工艺目的5812.2后附(手工焊)、修板及返修工艺要求5812.3后附(手工焊)、修板及返修技术要求5912.4后附(手工焊)、修板及返修方法59第十三章BGA返修工艺6113.1 BGA返修系统的原理6113.2 BGA的返修步骤6113.3 BGA植球工艺介绍63第十四章表面组装检验(测)工艺6414.1表面组装检验(测)工艺介绍6414.2组装前检验(来料检验)6514.3工序检验6714.4表面组装板检验7114.5 AOl检测与X光检测简介74第十五章SMT回流焊接质量分析7715.1 PCB焊盘设计7715.2焊膏质量及焊膏的正确使用7915.4贴装元器件 .8015.5回流焊温度曲线8015.6回流焊设备的质量81第十六章波峰焊接质量分析8116.1设备要求8216.2材料要求8216.3印制电路板8416.4元器件8416.5工艺8416.6设备维护85第十七章中小型SMT生产线设备选型8617.1中小型SMT生产线设备选型依据8717.2中小型SMT生产线设备选型步骤8817.3 SMT生产线设备选型注意事项93附录SMT 在焊接中不良故障96一.再流焊的工艺特点97二.影响再流焊质量的原因分析99三、SMT再流焊接中常见的焊接缺陷分析与预防对策103SMT實用工藝基礎第一章SMT概述SMT(表面組裝技術)是新一代電子組裝技術。


SMT表面组装技术SMT工艺技术SMT工艺技术(一)SMT——表面贴装技术(SurfaceMountTechnology)SMC——表面安装元件(SurfaceMountponet)SMD——表面安装器件(SurfaceMountDevice)SMB——表面安装印刷电路板(SurfaceMountPrintedCircuitBoard)THT——通孔插装技术MSI——中规模集成电路LSI——大规模集成电路SMT的优点:1.元器件安装密度高,电子产品体积小,重量轻。
2.可靠性高,抗振能力强。
3.高频特性好。
4.易于实现自动化,提高生产效率。
5.可以降低成本。
SMT的八大技术问题:管理工程,测试,材料,设备,工艺方法,图形设计,基板,元器件。
一.锡膏要具备的条件焊膏是由合金焊料粉、糊状焊剂和一些添加剂混合成而成的具有一定粘性和良好触变性特性的膏状体。
它是一种均相的、稳定的混合物。
在常温下焊膏可将电子元器件初粘在既定位置,当焊膏被加热到一定温度时,随着溶剂和部分添加剂的挥发、合金粉的熔化,焊膏再流使被焊元器件与焊盘互联在一起经冷却形成永久连接的焊点。
对焊膏要求能采用多种方式涂布,特别要具有良好的印刷性能和再流焊特性,并且在贮存时要具有稳定性。
1.焊膏应用前需具备以下特性:1)。
具有较长的贮存寿命,在2~5度下保存3~6个月,贮存时不会发生化学变化,也不会出现焊料粉和焊剂分离的现象,并保持其粘度和粘接性不变。
2)。
吸湿性小、低毒、无臭、无腐蚀性。
2.涂布时以及再流焊预热过程中具有的特性。
1)。
要具有良好的印刷性和滴涂性,脱膜性良好,能连续顺利的进行涂布,不会堵塞丝网或漏板的孔眼及注射用的管嘴,也不会溢出不必要锡膏。
2)。
有较长的工作寿命运,在印刷或滴涂后通常要求在常温下能放置12-24小时,其性能保持不变。
3)。
在再流焊预热过程中,焊膏应保持原来的形状和大小,不产生塌落。
塌落是指一定体积的焊膏印刷或滴涂于PCB后,由于重力和表面张力的作用及温度升高或停放时间过长而引起的高度降低,底面积超出规定边界的现象,塌落的程度称为塌落度。

![SMT表面装贴技术-3[1]](https://uimg.taocdn.com/59fd1be64b35eefdc8d333ea.webp)

SMT 技术组成SMT表面组装技术SMT技术组成报告名字:指导老师:班级:时间:目录第一章SMT生产设备11.1 涂敷设备11.1.1 印刷设备11.1.2 点涂设备11.2贴片设备21.2.1贴片机的基本结构21.3焊接设备41.3.1 回流炉41.3.2 波峰焊接机41.4检测设备41.4.1 检测用治具51.5 返修设备51.5.1 手工返修设备——电烙铁51.6 清洗设备51.6.1 水清洗机51.6.2 气相清洗机51.6.3 超声清洗机6第二章SMT生产工艺62.1 涂敷工艺62.1.1 焊膏涂敷62.1.2 贴片胶涂敷62.2 贴装工艺72.2.2 保证贴装质量的三要素72.2.3 贴片机编程72.3 焊接工艺72.3.1 回流焊工艺82.3.2 波峰焊工艺8第三章SMT管理83.1 5S管理83.1.1 5S的作用83.2 SMT质量管理93.2.1 ISO900093.2.2 统计过程控制(SPC)103.2.3 6σ103.2.4 质量管理的常用工具103.3 SMT生产过程中的静电防护103.3.1静电的产生113.3.2 静电的危害113.3.3 SMT生产中的静电防护11第一章SMT生产设备1.1涂敷设备涂敷主要目的是将胶水活焊膏准确地涂敷与PCB上,使贴片工序贴装的元器件能够粘在PCB焊盘上。
主要涂敷设备有印刷设备和点涂设备。
1.1.1印刷设备用于焊膏印刷的印刷机品种很多,以自动化程度来分,可分为手动印刷机、半自动印刷机、全自动印刷机。
1.印刷机的基本结构无论哪种印刷机,其基本结构都是由机架、印刷工作台、模板固定机构、印刷头系统以及其他保证印刷精度而配备的其他选件CCD、定位系统、擦板系统、2D及3D测量系统等。
1.1.2点涂设备点涂可简单地定义为通过压力作用使液体发生移位。
点胶机是用途广泛的点涂设备,可注滴包括瞬间胶(快干胶)、红胶、黄胶、环氧树脂、硅胶、厌氧胶(螺丝胶)、防焊剂、锡浆、润滑油、焊膏等。
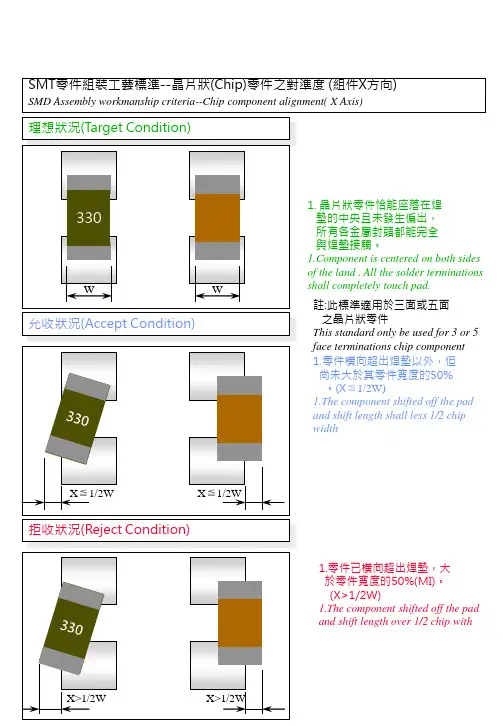
ABA B双面混装结构SMICSMC/SOTTHC 与SMC/SMD 同侧THC 与SMC/SMD 非同侧A B单面混装结构第一章SMT 表面组装技术表面组装技术的概念➢ 表面组装技术指采用自动化组装设备将片式化微型无引线或短引线表面组装元器件(SMC/SMD ,统称片状元器件)直接贴装、焊接到印制电路板(PCB )表面或其他基板表面规定位置的一种电子装联技术。
SMT (Surface Mounting Technology ),表面组装技术 SMA (Surface Mount Assembly),表面组装组件 表面组装技术的特点SMT 技术与传统T HT (Through Hole Technology )技术的区别 组装方法—根本区别在于“贴”和“插” 元器件类型 印制电路板 焊接方法自动化程度、面积 SMT 生产系统组成基本组成:印刷机+贴片机+焊接设备 表面组装方式与组装工艺流程影响表面组装方式的因素及组装方式分类表面组装方式按印制板焊接面数和元器件安装方式SMT 组装方式可分为单面混合组装、双面混合组装和全表面组装三种。
单面混合组装方式表面组装方式 SMT 设备条件 具体产品要求单面表面组装双面表面组装全表面组装结构表面组装工艺流程不同组装方式对应不同的组装工艺流程,同一组装方式也可以有不同的工艺流程:主要取决于所用元器件类型、SMA组装质量要求、组装设备、生产线实际条件等。
课后作业1、简述SMT区别于传统THT技术的特点。
2、判断电路板组装类型并给出相应的组装工艺流程。
作业答案:判断电路板组装方式并设计组装工艺流程第一步:判断组装方式:双面混合组装符合要求的组装流程有多个:举例如下组装工艺流程1:来料检测—PCB A面涂覆焊膏—贴装元器件—焊膏烘干—再流焊接—插装THC 引线折弯—翻板—B面涂覆粘结剂—贴装元器件—粘结剂固化—翻板—波峰焊接—清洗—最终检测组装工艺流程2:来料检测—PCB A面涂覆焊膏—贴装SMIC/SMC—焊膏烘干—A面再流焊接—翻板—B面涂覆粘结剂—贴装元器件—粘结剂固化—翻板—插装THC—B面波峰焊接—清洗—最终检测只翻一次板的工艺组装工艺流程3:来料检测—PCB B面涂覆粘结剂—贴装元器件—粘结剂固化—翻板—PCB A面涂覆焊膏—贴装元器件—焊膏烘干—A面再流焊接—插装THC—B面波峰焊接—清洗—最终检测工艺设计基本原则:1、依据具体电路板形式进行设计2、依据具体设备条件进行设计3、再流焊与波峰焊同时兼有时,一般先进行再流焊4、波峰焊与再流焊不能同时或无间歇连续进行5、为防止大的SMIC脱落,可增加涂覆粘结剂,但粘结剂仅起到增强元器件固定牢固度的作用第二章、表面组装元器件表面组装元器件种类表面组装元器件主要包括:【表面组装元件】【表面组装器件】【表面组装连接件】从种类来分:可分片式电阻器、片式电容、片式电感、片式机电元件。
SMT常用术语中英文对照副标题:SMT常用术语中英文对照作者:SMT中文网日期:2006-8-31 来源:网络搜集SMT常用术语中英文对照简称英文全称中文解释SMTSurface Mounted Technology表面贴装技术SMDSurface Mount Device表面安装设备(元件)DIPDual In-line Package双列直插封装QFPQuad Flat Package四边引出扁平封装PQFPPlastic Quad Flat Package塑料四边引出扁平封装SQFPShorten Quad Flat Package 缩小型细引脚间距QFPBGABall Grid Array Package球栅阵列封装PGAPin Grid Array Package针栅阵列封装CPGACeramic Pin Grid Array陶瓷针栅阵列矩阵PLCCPlastic Leaded Chip Carrier 塑料有引线芯片载体CLCCCeramic Leaded Chip Carrier 塑料无引线芯片载体SOPSmall Outline Package小尺寸封装TSOPThin Small Outline Package薄小外形封装SOTSmall Outline Transistor小外形晶体管SOJSmall Outline J-lead PackageJ形引线小外形封装SOICSmall Outline Integrated Circuit Package 小外形集成电路封装MCMMultil Chip Carrier多芯片组件MELF圆柱型无脚元件DDiode二极管RResistor电阻SOCSystem On Chip系统级芯片CSPChip Size Package 芯片尺寸封装COBChip On Board板上芯片SMT基本名词解释AAccuracy(精度):测量结果与目标值之间的差额。
SMT表面组装技术SMT工艺一.概述.1.S MT:表面装贴工艺.指将无引脚的片式元件(SMD)装贴于线路板上的组装技术SMT技术在电子产品制造业中,已被越来越多的工厂采用.是电子制造业的发展趋势.SMT:Surfacemountingtechnology表面装贴工艺SMD:Surfacemountingdevice表面装贴元件2.特点A.由于采用SMT机器,自动化程度高,减少了人力。
B.元件尺寸小,且无引脚,可使电子产品轻,薄,小型化。
C.装配密度高,速度快。
二.OKMCOSMT生产工艺流程,如下::使用机器将锡浆印刷在线路板上。
(DEK-265 印刷锡浆机):使用机器将规则元件贴在线路板上。
(NITTO 多元件高速贴片机):使用机器将不规则元件贴在线路板上。
(TENRYU中速贴片机)热风回流,将锡浆熔解,形成焊点.(HELLER回流炉),如短路,少锡,元件移位等。
(使用检查模板检查)三.工艺简介。
1. 锡浆印刷。
采用的机器:DEK-265锡浆印刷机(英国DEK 公司)。
1.1基本原理。
以一定的压力及速度,用金属或橡胶刮刀将装在钢网上的锡浆通过钢网漏印在线路板上。
锡浆成份为:锡63%,铅37%,松香含量:9-10%,熔点为183O C. 步骤为:图示:刮刀锡浆钢网(厚0.15MM)顶针 线路板(PCB)1.2DEK265印刷锡浆机印刷锡浆的品质直接影响点焊回流炉的品质,所以需要检查锡浆的印刷品质.一般地,主要检查以下的项目:少锡 短路 无锡浆 偏位印刷轮廓不良:拉尖,锡浆下垂。
如果钢网无损坏,印刷参数设置合适,通常印刷后,无以上不良。
主要的控制方法为过程技术员监控锡浆的厚度,如太厚,易产生QFPIC短路或锡珠。
如太薄,易产生假焊或少锡。
1.3要达到好的印刷品质,必须具备以下几点:(OKMCO选用原则)A.好的印刷钢网: 钢网厚度,钢网的开口尺寸等参数合适,孔壁垂直,无损坏。
如果钢网太厚,或开口尺寸太大,印刷在线路板上的锡浆份量就会太多,容易引起锡珠问题.同时,在元件较密集或IC脚距较小的地方,容易引起短路。