恒定表面浓度的扩散
- 格式:ppt
- 大小:154.00 KB
- 文档页数:4




恒定表面源扩散
恒定表面源扩散是一种重要的环境质量评估方法,用于估算某一特定
环境中由恒定表面源产生的污染物扩散的程度。
该方法具有简单、高效、可靠等优点,在环境评估和控制中得到了广泛的应用。
恒定表面源扩散主要基于康威方程和高斯模型,通过对表面源排放量、风向、风速、大气稳定度等参数进行定量分析,确定污染物扩散面积
和浓度分布,进而估算污染物对环境和人体健康的影响程度。
此外,
该方法还可以用于评估污染物治理措施的效果,并为环保政策的制定
提供科学依据。
恒定表面源扩散方法的应用需要进行大量数据采集、处理和模型建立,同时还需对模型进行严密的验证和精度分析。
在模型建立过程中,需
要考虑实际环境条件对模型的影响,如地形、建筑物、植被等,以及
不同污染物的特性、化学反应和物理过程等。
此外,在使用该方法时,还需注意选择适当的指标和阈值来评估环境质量,并在实践中根据实
际情况不断调整和优化模型。
然而,恒定表面源扩散方法也存在一些局限性和不足,如不考虑污染
物源的变化和间歇性排放对模型的影响,模型结果可能存在误差;模
型的适用范围和可靠性受限于输入参数的准确性和完整性;模型结果
仅供参考,对如何有效地控制和治理污染仍需要进一步的研究。
总之,恒定表面源扩散方法是一种实用、可靠的环境质量评估方法,在环境保护和治理中具有重要的应用价值。
然而,在使用该方法时,需注意模型建立和输入参数的准确性和完整性,以及模型结果的合理性和可靠性,从而为保护环境和人类健康做出更大的贡献。

扩散工艺前言:扩散部按车间划分主要由扩散区域及注入区域组成,其中扩散区域又分扩散老区和扩散新区。
扩散区域按工艺分,主要有热氧化、扩散、LPCVD、合金、清洗、沾污测试等六大工艺。
本文主要介绍热氧化、扩散及合金工艺。
目录第一章:扩散区域设备简介……………………………………第二章:氧化工艺第三章:扩散工艺第四章:合金工艺第一章:扩散部扩散区域工艺设备简介炉管设备外观:扩散区域的工艺、设备主要可以分为:类别主要包括按工艺分类热氧化一氧、二痒、场氧、Post氧化扩散推阱、退火/磷掺杂LPCVD TEOS、SI3N4、POL Y清洗进炉前清洗、漂洗合金合金按设备分类卧式炉A、B、C、D、F、H、I六台立式炉VTR-1、VTR-2、VTR-3 清洗机FSI-1、FSI-2炉管:负责高温作业,可分为以下几个部分:组成部分功能控制柜→对设备的运行进行统一控制;装舟台:→园片放置的区域,由控制柜控制运行炉体:→对园片进行高温作业的区域,由控制柜控制升降温源柜:→供应源、气的区域,由控制柜控制气体阀门的开关。
FSI:负责炉前清洗。
第二章:热氧化工艺热氧化法是在高温下(900℃-1200℃)使硅片表面形成二氧化硅膜的方法。
热氧化的目的是在硅片上制作出一定质量要求的二氧化硅膜,对硅片或器件起保护、钝化、绝缘、缓冲介质等作用。
硅片氧化前的清洗、热氧化的环境及过程是制备高质量二氧化硅膜的重要环节。
2. 1氧化层的作用2.1.1用于杂质选择扩散的掩蔽膜常用杂质(硼,磷,砷等)在氧化层中的扩散系数远小于在硅中的扩散系数,因此氧化层具有阻挡杂质向半导体中扩散的能力。
利用这一性质,在硅上的二氧化硅层上刻出选择扩散窗口,则在窗口区就可以向硅中扩散杂质,其它区域被二氧化硅屏蔽,没有杂质进入,实现对硅的选择性扩散。
1960年二氧化硅就已被用作晶体管选择扩散的掩蔽膜,从而导致了硅平面工艺的诞生,开创了半导体制造技术的新阶段。
同时二氧化硅也可在注入工艺中,作为选择注入的掩蔽膜。


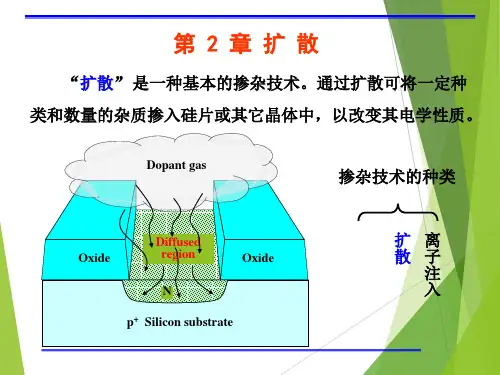


材料科学基础(武汉理工大学,张联盟版)课后习题及答案第七章第七章答案7-1略7-2浓度差会引起扩散,扩散是否总是从高浓度处向低浓度处进行?为什么?解:扩散是由于梯度差所引起的,而浓度差只是梯度差的一种。
当另外一种梯度差,比如应力差的影响大于浓度差,扩散则会从低浓度向高浓度进行。
7-3欲使Ca在CaO中的扩散直至CaO的熔点(2600℃)时都是非本质扩散,要求三价离子有什么样的浓度?试对你在计算中所做的各种特性值的估计作充分说明。
已知CaO肖特基缺陷形成能为6eV。
解:掺杂M引起V’’Ca的缺陷反应如下:当CaO在熔点时,肖特基缺陷的浓度为:3+2+所以欲使Ca在CaO中的扩散直至CaO的熔点(2600℃)时都是非本质扩散,M的浓度为,即2+3+7-4试根据图7-32查取:(1)CaO在1145℃和1650℃的扩散系数值;(2)Al2O3在1393℃2+3+和1716℃的扩散系数值;并计算CaO和Al2O3中Ca和Al的扩散活化能和D0值。
解:由图可知CaO在1145℃和1650℃的扩散系数值分别为,Al2O3在1393℃和1716℃的扩散系数值分别为根据可得到CaO在1145℃和1650℃的扩散系数的比值为:,将值代入后可得,Al2O3的计算类推。
7-5已知氢和镍在面心立方铁中的扩散数据为2cm/s和2cm/s,试计算1000℃的扩散系数,并对其差别进行解释。
解:将T=1000℃代入上述方程中可得。
,同理可知原因:与镍原子相比氢原子小得多,更容易在面心立方的铁中通过空隙扩散。
7-6在制造硅半导体器体中,常使硼扩散到硅单晶中,若在1600K温度下,保持硼在硅单晶-3表面的浓度恒定(恒定源半无限扩散),要求距表面10cm深度处硼的浓度是表面浓度的一半,问需要多长时间(已知D1600℃=8×10-12cm/s;当2时,)?解:此模型可以看作是半无限棒的一维扩散问题,可用高斯误差函数求解。
其中-122=0,,所以有0.5=s。

扩散工艺扩散技术目的在于控制半导体中特定区域内杂质的类型、浓度、深度和PN结。
在集成电路发展初期是半导体器件生产的主要技术之一。
但随着离子注入的出现,扩散工艺在制备浅结、低浓度掺杂和控制精度等方面的巨大劣势日益突出,在制造技术中的使用已大大降低。
3.1 扩散机构3.1.1 替位式扩散机构这种杂质原子或离子大小与Si原子大小差别不大,它沿着硅晶体内晶格空位跳跃前进扩散,杂质原子扩散时占据晶格格点的正常位置,不改变原来硅材料的晶体结构。
硼、磷、砷等是此种方式。
3.1.2 填隙式扩散机构这种杂质原子大小与Si原子大小差别较大,杂质原子进入硅晶体后,不占据晶格格点的正常位置,而是从一个硅原子间隙到另一个硅原子间隙逐次跳跃前进。
镍、铁等重金属元素等是此种方式。
3.2 扩散方程∂N / ∂t = D*2N / ∂x2N=N(x,t)杂质的浓度分布函数,单位是cm-3D:扩散系数,单位是cm2/s加入边界条件和初始条件,对上述方程进行求解,结果如下面两小节所诉。
3.2.1 恒定表面浓度扩散整个扩散过程中,硅片表面浓度NS 保持不变N(x,t)=NSerfc(x/(2*(Dt)1/2))式中erfc称作余误差函数,因此恒定表面浓度扩散分布符合余误差分布。
3.2.2.限定源扩散杂质源限定在硅片表面薄的一层,杂质总量Q是常数。
N(x,t)=(Q/( Dt)1/2)*exp(-X2/4Dt)exp(-X2/4Dt)是高斯函数,因此限定源扩散时的杂质分布是高斯函数分布。
由以上的求解公式,可以看出扩散系数D以及表面浓度对恒定表面扩散的影响相当大3.2.3 扩散系数扩散系数是描述杂质在硅中扩散快慢的一个参数,用字母D表示。
D大,扩散速率快。
D与扩散温度T、杂质浓度N、衬底浓度N、扩散气氛、衬底晶向、缺陷等因素有关。
Bexp(-E/kT)D=DT:绝对温度;K:波尔兹曼常数;E:扩散激活能D:频率因子3.2.4 杂质在硅中的固溶度杂质扩散进入硅中后,与硅形成固溶体。
两步法掺硼杂质(硼扩散)实验一、实验目的和要求:扩散工艺实验是通过平面工艺制造出有晶体管特性的硅平面NPN 晶体管等器件中的氧化、扩散、光刻这三个平面工艺中最基本工艺之一。
硼扩散工艺实验的目的是通过具体的硼扩散工艺操作熟悉硼扩散工艺步骤、了解扩散设备的使用以及进一步掌握和巩固两步法硼扩散工艺的原理和相关知识。
同时了解相关测试和分析手段,以及对工艺环境和成品率进行分析和评价。
二、实验原理:1、杂质浓度分布情况:硼扩散通常分为硼的预沉积(预扩散)和硼的再分布(再扩散)两步进行。
这就是硅平面工艺中所说的两步扩散工艺。
(1) 预沉积:采取恒定表面浓度的扩散方式,在硅片表面沉积上一层杂质原子。
由于扩散温度较低,且扩散时间较短,因此在预沉积过程中,杂质原子在硅片表面的扩散深度较浅。
其杂质分布遵循余误差函数分布。
根据这种扩散的特点可以写出它的初始条件和边界条件为:初始条件: (,0)0N x = (x 扩散结深)边界条件: (0,)N s N t = 和 (,t)0N ∞= (t 扩散时间;为Si 片表面的杂质浓度为恒定值)根据扩散方程 22N N D t x∂∂=∂∂ 和上述条件可解出预淀积杂质分布(,)N x t 表达式:220(,)(1)exp()s N x t N d πλλ=-- (λ为结深的微元) (1)简写为(,)s N x t N erfc = (D 为扩散系数) (2) 式中:erfc 为余误差函数;表面杂质浓度s N 和D 扩散系数主要取决于不同杂质元素和扩散温(0exp()a E D D kT -=,0D 和a E 为实验值)。
注:N s 是半导体内表面处的杂质浓度,它并不等于半导体周围气氛中的杂质浓度。
当气氛中得分压强较低时,在半导体内表面处的杂质溶解度将与其周围气氛中杂质的压强成正比。
当杂质分压强较高时,则与周围气氛中杂质的分压强无关,数值上等于扩散温度下杂质在半导体中的固溶度。
(2) 再分布:是把由预沉积过程在硅片表面淀积了一定杂质的硅片,放入较高温度的扩散炉内加热,使杂质向硅片内部扩散,扩散过程中没有外来杂质的补充,是一种限定源扩散。
扩散法制作PN 结与结深测量一、实验目的通过固态氮化硼源扩散实验,了解扩散原理,掌握扩散工艺步骤与操作方法,学会用电解显微法测量PN 结的厚度。
二.实验原理在超大规模集成电路工艺中,硅中杂质原子的扩散很重要。
扩散是半导体器件制造过程中常用的步骤,是一种原子或分子在高温下由高浓度区向低浓度区移动过程,目的是为了控制杂质浓度,均匀性和重复性,以及成批地大量生产器件片子,以降低生产成本。
在双极型器件技术中,采用扩散形成基区发射区和电阻,而在MOS 器件技术中则用其形成源区和漏区,以及对多晶硅掺杂。
浓度覆盖范围很宽的掺杂原子可以采用如下的方式引入到硅片中,高温气相化学源扩散,掺杂氧化物源扩散,离子注入层的扩散和退火。
1.扩散方程扩散是物质分子或原子热运动引起的一种自然现象。
扩散现象在日常生活中随处可见。
如果你做一个蓝墨水滴入清水的扩散实验,你就会发现:浓度差别的存在是产生扩散运动的必要条件,环境温度的高低则是决定扩散运动快慢的重要因素,环境温度越高,分子的运动越激烈,扩散过程进行得就越快。
人们总结出各种扩散现象所共同遵循的客观规律,即杂质粒子(可以是原子、分子或离子)的扩散流密度与扩散杂质的浓度梯度成正比。
其数学表达式为:N D J ∇-= (3.1) 对于平面器件工艺中的扩散问题,由于扩散所形成的P -N 结平行于硅片表面,而且扩散深度很浅。
因此可以近似地认为扩散只沿垂直于硅片表面的方向(x 方向)进行,这时(3.1)式可简化为:xN D t x J ∂∂-=)(、 (3.2) 上两式中:J ——扩散流密度,其单位为粒子/厘米2·秒;N ——杂质浓度,其单位为个/厘米3;N ∇ ——代表三维空间的浓度梯度;xN ∂∂ ——代表x 方向上的浓度梯度,它表示在扩散方向(x 方向)上的浓度的变化率;D ——称为扩散系数,其单位为厘米2/秒,负号表示扩散粒子流的方向与浓度梯度的方向相反,即扩散粒子流的方向是由浓度高的地方指向浓度低的地方。