(完整word版)Varian离子注入设备规格
- 格式:doc
- 大小:30.19 KB
- 文档页数:7



viista810离子注入机说明书
1、打开真空计《先开左边开关,再打开右边开关,左边表盘为低真空,右边表盘为高真空,可以换挡最后抽到本底真空-*10Ypa以下,本底气压越高越好)今打开机械泵今电磁阀1(抽到2Pa以下,需要几分钟时间)今电磁阀2。
2、在控制柜后面的所有开关都打开今分子泵电源开今关电磁阀1。
3、合头部电源(绿为开,红为关)打开供气小流量N2量程010sccm (2.5sccm起弧》大流量0---100sccm(He60sccm起弧)打开电弧电压(70V左右)今灯丝电源电流(10A左右)今引出电压引出电流(根据实验需要可任意加)抑制电压1000V左右,抑制电流越小越好,最好是0今打开加速电源(10100KV,可根据实验需要参数设定来调节)
100kV10mA为最大参数。
灯丝电源和电弧电源可以调节加谏电流,加速申源控制加速电压,可以按需要进行调节到自己想要的。
4、如果出故障小红灯闪按下控制柜上面的大红色按钮和上面的黄色按钮停止工作,等一会再试试,如果还不行就全都关了,找老师检修。
5、关机步骤
1)控制柜关
先关抑制电源10多秒之后将引出电源(左旋降到0)关掉电弧
电源(左旋降到0)关掉今灯丝电源(最好不要超过15A)(左旋降。
到0)关掉流量(左旋降到0)关掉予合头部分电源关掉(按红色按钮。
2)关掉真空计(先右下角开关,再关左下角开关)。
3)关闭分子泵红色Stop关电磁阀2关机械泵今关总电源控制柜后面所有开关都关掉。

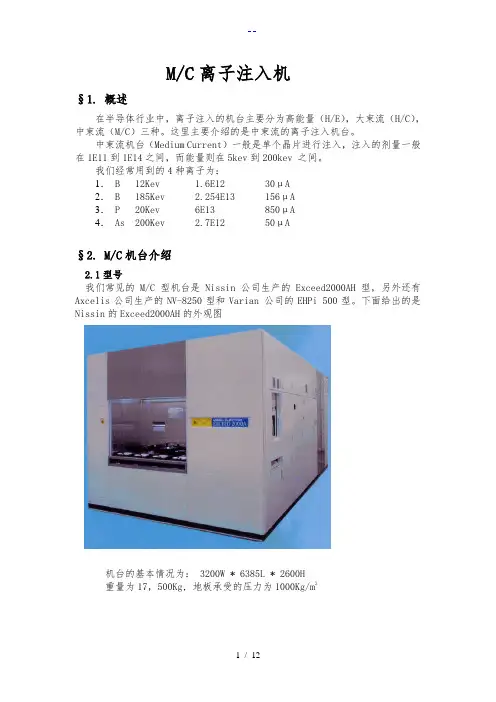
M/C离子注入机§1. 概述在半导体行业中,离子注入的机台主要分为高能量(H/E),大束流(H/C),中束流(M/C)三种。
这里主要介绍的是中束流的离子注入机台。
中束流机台(Medium Current)一般是单个晶片进行注入,注入的剂量一般在1E11到1E14之间,而能量则在5kev到200kev 之间。
我们经常用到的4种离子为:1.B 12Kev 1.6E12 30μA2.B 185Kev 2.254E13 156μA3.P 20Kev 6E13 850μA4.As 200Kev 2.7E12 50μA§2. M/C机台介绍2.1型号我们常见的M/C型机台是Nissin公司生产的Exceed2000AH型,另外还有Axcelis公司生产的NV-8250型和Varian 公司的EHPi 500型。
下面给出的是Nissin的Exceed2000AH的外观图机台的基本情况为: 3200W * 6385L * 2600H重量为17,500Kg, 地板承受的压力为1000Kg/m2其中,控制面板如图所示。
2.2工作原理离子植入的基本原理就是把气体或固体源的原子离子化,然后对离子进行选择,把所需的离子进行加速,达到所需的能量,注入到硅片中的过程。
下面就是整个机台的俯视图,主要分为End Station, Beam Line, Ion Source 三个大的部分。
2.3主要部件2.3.1 离子源(Ion Source)。
因为我们要注入的杂质是有一定的能量的,所以必须对杂质进行加减速,而只有带电微粒才能在电场的作用下加减速,因此要使杂质离子化。
离子源就是用电子撞击气体分子,得到我们所需要的离子的部件。
离子源包括Arc chamber 和Extraction electrode 系统。
1.Arc chamber.Arc chamber 是利用灯丝加热,放出电子,然后电子撞击通入的气体分子,得到离子。

离⼦注⼊技术(Implant)离⼦注⼊技术摘要离⼦注⼊技术是当今半导体⾏业对半导体进⾏掺杂的最主要⽅法。
本⽂从对该技术的基本原理、基本仪器结构以及⼀些具体⼯艺等⾓度做了较为详细的介绍,同时介绍了该技术的⼀些新的应⽤领域。
关键字离⼦注⼊技术半导体掺杂1 绪论离⼦注⼊技术提出于上世纪五⼗年代,刚提出时是应⽤在原⼦物理和核物理究领域。
后来,随着⼯艺的成熟,在1970年左右,这种技术被引进半导体制造⾏业。
离⼦注⼊技术有很多传统⼯艺所不具备的优点,⽐如:是加⼯温度低,易做浅结,⼤⾯积注⼊杂质仍能保证均匀,掺杂种类⼴泛,并且易于⾃动化。
离⼦注⼊技术的应⽤,⼤⼤地推动了半导体器件和集成电路⼯业的发展,从⽽使集成电路的⽣产进⼊了⼤规模及超⼤规模时代(ULSI )。
由此看来,这种技术的重要性不⾔⽽喻。
因此,了解这种技术进⾏在半导体制造⾏业以及其他新兴领域的应⽤是⼗分必要的。
2 基本原理和基本结构2.1 基本原理离⼦注⼊是对半导体进⾏掺杂的⼀种⽅法。
它是将杂质电离成离⼦并聚焦成离⼦束,在电场中加速⽽获得极⾼的动能后,注⼊到硅中⽽实现掺杂。
离⼦具体的注⼊过程是:⼊射离⼦与半导体(靶)的原⼦核和电⼦不断发⽣碰撞,其⽅向改变,能量减少,经过⼀段曲折路径的运动后,因动能耗尽⽽停⽌在某处。
在这⼀过程中,涉及到“离⼦射程”、“”等⼏个问题,下⾯来具体分析。
2.1.1 离⼦射程xpy pz图2.1.1(a )离⼦射程模型图图2.1.1(a )是离⼦射⼊硅中路线的模型图。
其中,把离⼦从⼊射点到静⽌点所通过的总路程称为射程;射程的平均值,记为R ,简称平均射程;射程在⼊射⽅向上的投影长度,记为p x ,简称投影射程;投影射程的平均值,记为p R ,简称平均投影射程。
⼊射离⼦能量损失是由于离⼦受到核阻挡与电⼦阻挡。
定义在位移x 处这两种能量损失率分别为n S 和e S :n n xdE S d =(1)ee dE S k dx== (2)则在dx 内总的能量损失为:()n e n e dE dE dE S S dx =+=+(3)P0000P 0n ed d d d d R E E E ER x E x S S ===+?(4)n S 的计算⽐较复杂,⽽且⽆法得到解析形式的结果。

离子注入机剂量计算公式离子注入机剂量计算公式。
离子注入技术是一种常用的微电子加工技术,通过将离子注入到半导体材料中,可以改变其导电性能和其他物理特性,从而实现微电子器件的制备。
在离子注入过程中,剂量的计算是非常重要的,它直接影响到加工后材料的性能和器件的性能。
剂量的计算是根据离子注入机的参数和加工条件来确定的,一般来说,剂量的计算公式如下:D = N A。
其中,D表示剂量,单位为离子数/cm²;N表示注入的离子浓度,单位为离子数/cm³;A表示注入的面积,单位为cm²。
在实际的离子注入过程中,通常需要根据具体的加工要求和材料特性来确定离子浓度和注入面积。
下面将详细介绍离子注入机剂量计算公式的具体应用。
首先,需要确定离子浓度N。
离子浓度是指单位体积内的离子数,通常可以通过离子源的参数和加工条件来确定。
例如,如果离子源的输出为I个离子/s,加工时间为t秒,注入的体积为V cm³,那么离子浓度可以用下面的公式来计算:N = I t / V。
其中,N表示离子浓度,单位为离子数/cm³;I表示离子源的输出,单位为离子数/s;t表示加工时间,单位为秒;V表示注入的体积,单位为cm³。
其次,需要确定注入的面积A。
注入的面积是指离子注入到材料表面的面积,通常可以通过控制离子束的大小和形状来确定。
例如,如果离子束的直径为 d cm,注入的面积为圆形,那么注入的面积可以用下面的公式来计算:A = π (d/2)²。
其中,A表示注入的面积,单位为cm²;d表示离子束的直径,单位为cm。
最后,根据上面的公式,可以计算得到剂量D。
例如,如果离子浓度N为1×10¹⁶个/cm³,注入的面积A为10 cm²,那么剂量D可以用下面的公式来计算:D = 1×10¹⁶ 10 = 1×10¹⁷个/cm²。
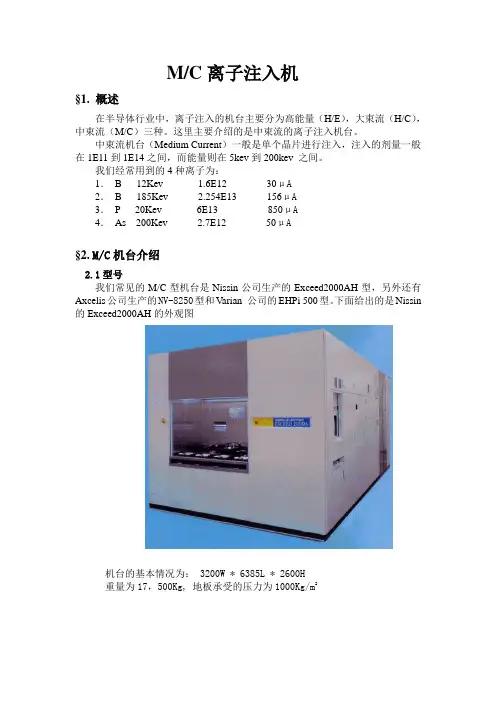
M/C离子注入机§1. 概述在半导体行业中,离子注入的机台主要分为高能量(H/E),大束流(H/C),中束流(M/C)三种。
这里主要介绍的是中束流的离子注入机台。
中束流机台(Medium Current)一般是单个晶片进行注入,注入的剂量一般在1E11到1E14之间,而能量则在5kev到200kev 之间。
我们经常用到的4种离子为:1.B 12Kev 1.6E12 30μA2.B 185Kev 2.254E13 156μA3.P 20Kev 6E13 850μA4.As 200Kev 2.7E12 50μA§2. M/C机台介绍2.1型号我们常见的M/C型机台是Nissin公司生产的Exceed2000AH型,另外还有Axcelis公司生产的NV-8250型和Varian 公司的EHPi 500型。
下面给出的是Nissin 的Exceed2000AH的外观图机台的基本情况为: 3200W * 6385L * 2600H重量为17,500Kg, 地板承受的压力为1000Kg/m2其中,控制面板如图所示。
2.2工作原理离子植入的基本原理就是把气体或固体源的原子离子化,然后对离子进行选择,把所需的离子进行加速,达到所需的能量,注入到硅片中的过程。
下面就是整个机台的俯视图,主要分为End Station, Beam Line, Ion Source三个大的部分。
2.3主要部件2.3.1 离子源(Ion Source)。
因为我们要注入的杂质是有一定的能量的,所以必须对杂质进行加减速,而只有带电微粒才能在电场的作用下加减速,因此要使杂质离子化。
离子源就是用电子撞击气体分子,得到我们所需要的离子的部件。
离子源包括Arc chamber 和Extraction electrode 系统。
1.Arc chamber.Arc chamber 是利用灯丝加热,放出电子,然后电子撞击通入的气体分子,得到离子。


第26卷第3期2020年9月分析测试技术与仪器ANALYSISANDTESTINGTECHNOLOGYANDINSTRUMENTSVolume26Number3㊀㊀㊀㊀Sep.2020大型仪器功能开发(151~159)收稿日期:2020-06-08ꎻ㊀修订日期:2020-07-23.基金项目:国家重点研发计划(项目号:2019YFB1503602ꎬ2018YFB1107502)ꎬ国家自然科学基金(项目号:51720105004)ꎬ中国科学院科研仪器设备研制项目(项目号:GJJSTD20200006)及中国科学院仪器设备功能开发技术创新项目作者简介:张明亮(1979-)ꎬ男ꎬ博士ꎬ副研究员ꎬ硕士生导师ꎬ主要研究领域:微电子机械系统压力传感器㊁微纳米加工工艺开发㊁热电材料及器件ꎬE-mail:zhangml@semi.ac.cn通信作者:王晓东ꎬ博士ꎬ研究员ꎬ博士生导师ꎬ«分析测试技术与仪器»编委ꎬ主要研究方向:太阳能电池陷光结构㊁纳米热电结构与器件㊁量子点场效应晶体管㊁半导体微纳米加工技术ꎬE-mail:xdwang@semi.ac.cn.瓦里安300XP离子注入机改造及功能开发张明亮1ꎬ2ꎬ韩国威1ꎬ刘㊀庆1ꎬ李㊀艳1ꎬ杨富华1ꎬ2ꎬ3ꎬ4ꎬ王晓东1ꎬ2ꎬ3ꎬ4(1.中国科学院半导体研究所半导体集成技术工程研究中心ꎬ北京㊀100083ꎻ2.中国科学院大学微电子学院及材料与光电研究中心ꎬ北京㊀100049ꎻ3.北京量子信息科学研究院ꎬ北京㊀100193ꎻ4.北京市半导体微纳集成工程技术研究中心ꎬ北京㊀100083)摘要:在完全掌握瓦里安300XP离子注入机各部件的工作原理后ꎬ将原离子源供电系统中500W电流源和450W起弧电源升级为1500W电流源和1500W起弧电源ꎬ并集成到当前系统中.将现有不稳定的气体流量㊁离子源电源㊁分析器㊁源磁场和吸极高压塑料光纤隔离控制线路ꎬ升级成多通道光纤通讯光端机隔离控制系统.将一个10cm进样终端改造成15cm的样品卡盘ꎬ并开发了一套独立控制剂量监测系统.改造后ꎬ硼最大束流超过150μAꎬ且可调节.15cm圆片的片内及片间电阻不均匀性小于3.5%.利用大束流硼离子注入制备浓硼掺杂单晶硅结构层ꎬ应用到微电子机械系统压力传感器㊁热电器件以及纳米谐振子器件中.关键词:离子注入ꎻ浓硼掺杂ꎻ自停止腐蚀ꎻ微电子机械系统压力传感器ꎻ热电器件ꎻ纳米谐振子中图分类号:O472+.1文献标志码:B文章编号:1006 ̄3757(2020)03 ̄0151 ̄09DOI:10.16495/j.1006-3757.2020.03.001ReformationandFunctionDevelopmentofVarian300XPIonImplanterZHANGMing-liang1ꎬ2ꎬHANGuo-wei1ꎬLIUQing1ꎬLIYan1ꎬYANGFu-hua1ꎬ2ꎬ3ꎬ4ꎬWANGXiao-dong1ꎬ2ꎬ3ꎬ4(1.EngineeringResearchCenterforSemiconductorIntegratedTechnologyꎬInstituteofSemiconductorsꎬChineseAcademyofSciencesꎬBeijing100083ꎬChinaꎻ2.TheSchoolofMicroelectronics&CenterofMaterialsScienceandOptoelectronicsEngineeringꎬChineseAcademyofSciencesꎬBeijing100049ꎬChinaꎻ3.BeijingAcademyofQuantumInformationScienceꎬBeijing100193ꎬChinaꎻ4.BeijingEngineeringResearchCenterofSemiconductorMicro-NanoIntegratedTechnologyꎬBeijing100083ꎬChina)Abstract:AfterhavingafullunderstandingoftheworkingprinciplesofeverypartsoftheVarian300XPionimplanterꎬthe500Wcurrentsourceand450Warcingpowersupplywereupgradedtothe1500Wcurrentsourceand1500Warcingpowersupplyꎬandintegratedintotheoriginalionsourcepowersupplysystem.Theexistingunstablegasflowꎬionsource分析测试技术与仪器第26卷powersupplyꎬanalyzerꎬsourcemagneticfieldandhighvoltageplasticopticalfiberisolationcontrolcircuitwereupgradedtothemulti-channelopticalfiberisolationcommunicationsystem.A10cmsampleinjectionterminalwastransformedintoa15cmsamplechuckꎬandanindependentdosemonitoringsystemwasdeveloped.Afterreconstructionꎬthemaximumbeamcurrentofboronwasmorethan150μAandadjustable.Theinhomogeneityofresistancebetweenandinthe15cmwaferswaslessthan3.5%.Borondopedmonocrystalsiliconstructurelayerwaspreparedbythestrongbeamcurrentboronionimplantationandappliedtothemicro-electro-mechanicalsystemspressuresensorꎬthermoelectricdeviceandnano-resonatordevice.Keywords:ionimplantationꎻborondopingwithhighconcentrationꎻself-stopetchingꎻmicro-electro-mechanicalsystemspressuresenorꎻthermoelectricdeviceꎻnano-resonator㊀㊀半导体器件被广泛应用于运算㊁存储㊁显示㊁通讯和供电等领域ꎬ是构建现代信息社会的重要基石.本质上ꎬ半导体器件丰富的功能均是通过可控可调的半导体电阻实现.掺杂是调控半导体材料电阻的主要工艺ꎬ把杂质原子可控地引入半导体材料晶体结构中ꎬ改变材料的能带结构ꎬ如多数载流子类型㊁浓度㊁迁移率等ꎬ实现半导体器件的预期功能.离子注入和扩散是最常用的两种掺杂工艺.由于离子注入能够准确地重复控制每一次掺入杂质的浓度㊁深度以及杂质分布ꎬ成为一种标准半导体掺杂工艺ꎬ已经在微电子㊁光电子㊁传感器㊁新材料等领域广泛使用[1].离子注入设备体积庞大ꎬ系统复杂ꎬ价格昂贵ꎬ是半导体制造中的核心装备之一.中国科学院半导体研究所拥有瓦里安公司制造的Varian300XP型中束流离子注入机ꎬ配有三氟化硼(BF3)和膦烷(PH3)气体源ꎬ可在20~130keV束流加速度下工作ꎬ通过对各种半导体材料进行掺杂ꎬ用于制作光电探测器㊁光伏器件㊁微电子机械系统(MEMS)压力传感器及执行器㊁场效应管㊁二极管和热电器件等.该设备对所内外开放共享使用ꎬ为众多科研项目的顺利完成及预研产品的开发起到了关键支撑作用.1㊀工作原理Varian300XP离子注入设备的支持系统包括水㊁电㊁气㊁真空及排风系统.水包括普通工艺冷却水及高纯水两个独立循环系统.主供电为美国标准208V60Hzꎬ经内部电源变换ꎬ有直流高压㊁交流高压和隔离供电等形式.使用气体包含压缩空气㊁高纯氮气和离子源气体.真空由三台机械干泵㊁两台氦冷泵和一台分子泵建立.排风主要集中在离子源㊁样品操作台及机械泵排气部分.在高真空建立好之后ꎬ启动高纯水循环系统ꎬ开启隔离变压器ꎬ给离子源内部供电.我所Varian300XP离子注入机采用Freeman离子源ꎬ在棒形钨灯丝上通过约180A电流ꎬ在弧室壁与灯丝间加50V电压ꎬ质量流量计(MFC)控制的源气体分子与高能电子碰撞ꎬ在弧室内产生等离子体.使用30kV左右吸出高压将正离子吸出弧室ꎬ引入分析器ꎬ具有不同荷质比的离子在分析磁场中以不同的轨迹飞行ꎬ互相分离.调节分析器的磁场强度ꎬ能选择需要的杂质离子束通过分析器出口狭缝ꎬ在加速管中使用静电场加速到设定能量.通过四级杆聚焦镜调整束流形状后ꎬ用平面扫描器将杂质离子均匀分散成正方形ꎬ通过主法拉第杯及设定法拉第杯ꎬ观察示波器上的波形ꎬ对离子束的扫描范围及分布情况进行调节ꎬ利用处于光阑上的4个角法拉第杯监测束流大小.设定好注入剂量后ꎬ启动注入ꎬ束线挡板自动放下ꎬ杂质元素均匀注入到工艺室内的衬底上ꎬ同时ꎬ注入光阑4个角上的角法拉第杯开始记录注入离子剂量ꎬ当累计注入剂量达到设定值ꎬ剂量控制系统自动将束线挡板竖起ꎬ阻断离子束ꎬ完成设定注入工艺.通常Varian300XP离子注入机配有三氟化硼㊁膦烷㊁砷烷和氩气气体源ꎬ可以提供硼㊁氟㊁磷㊁二氟化硼和砷的注入ꎬ离子束能量在20~200keV范围内可调.对于中等剂量注入(<1ˑ1016cm-2)ꎬ为保证注入的均匀性ꎬ一般通过调节注入的束流ꎬ使每一片完成时间大于60s.对于使用光刻胶做掩蔽层定义注入区域的衬底ꎬ一般使用小于100μA的束流ꎬ保证整个注入过程中光刻胶不变形或开裂.例如ꎬ以100μA的束流ꎬ对10cm衬底片注入1ˑ1015cm-2的硼离子ꎬ约需9min即可完成ꎬ对光片进行注入ꎬ可使用更大的束流.Varian公司的离子注入机部门被AppliedMaterials公司收购后ꎬVarian300XP的升级版为VIISta9003D型离子注入机.我所的Varian300XP离子注入机在一家半导体工厂已被使用多年ꎬ且部分改装过ꎬ仅有一个进样终端正常工作.经过安装调试后ꎬ基本可以使用ꎬ但251第3期张明亮ꎬ等:瓦里安300XP离子注入机改造及功能开发是硼离子束流最大仅30μAꎬ单个进样终端ꎬ卡盘为10cm.离子源内部的电气控制经常失灵ꎬ注入过程中ꎬ扫描系统也频繁出错ꎬ导致10cm圆片片内方块电阻不均匀性超过10%ꎬ因此有必要对其进行功能改造升级.2㊀改造及功能开发结果2.1㊀离子源供电电源引出束流小ꎬ注入效率低是这台设备存在的主要问题ꎬ我们先后从引出距离㊁引出电压㊁狭缝开口尺寸㊁源磁场㊁灯丝形状和灯丝纯度等各方面进行优化ꎬ未能有效增加引出束流大小.与此同时ꎬ供电电源中频繁出现元器件烧坏问题ꎬ灯丝电源与起弧电源经常不匹配ꎬ无法稳定起弧.离子源供电电源互联关系的原理框图如图1(a)所示.由图1(a)可见ꎬ灯丝电流源提供稳定可调的电流ꎬ使钨灯丝产生热电子发射.同时ꎬ起弧电源在灯丝与弧室之间加稳定可调的电压ꎬ获得稳定的源气体等离子体.原离子源供电系统中灯丝电源最大输出500Wꎬ起弧电源最大输出450Wꎬ如图1(b)所示.这两套电源由于年代久远ꎬ电子元件老化严重ꎬ影响了离子束流及相关性能ꎬ因此定制了300A的电流源ꎬ电压5Vꎬ电流㊁电压双控制ꎬ最大输出1500W.同时还定制了1500W起弧电源ꎬ电压150Vꎬ电流10Aꎬ采用电压㊁电流双控制模式ꎬ并集成到当前的系统中ꎬ实物如图1(c)所示.用ϕ2ˑ80高纯钨棒做灯丝ꎬ离子源真空在20μTorr左右ꎬ灯丝电源在150A左右ꎬ起弧电源75Vꎬ得到稳定的弧流约2Aꎬ阳极引出硼离子束流约10mA.而改造前ꎬ最大的阳极引出硼离子束流约2mAꎬ且不稳定ꎬ经常灭弧.两台电源的电流㊁电压均能控制并调节ꎬ功能符合预期ꎬ运转正常.图1㊀离子源供电电源(a)内部电源互联原理框图ꎬ(b)旧系统中电源ꎬ(c)改造后电源实物照片Fig.1㊀Supplypowersofionsourcesection(a)principleschemeofinnerpowersconnectionꎬ(b)powersinoldsystemꎬ(c)photosofnewpowersafterreforming2.2㊀光电隔离控制系统离子源内部与外部操作台之间有吸出和加速高压ꎬ操作台上的控制必须通过隔离高压系统来实现.在原控制系统中ꎬ电位器产生的模拟量ꎬ通过电压频率转换ꎬ成为控制发光二极管的方波信号ꎬ如图2(a)所示.通过塑料光纤ꎬ光信号送入离子源内ꎬ在通过频率电压逆转换ꎬ将控制端的模拟电压还原回来ꎬ如图2(b)所示.由于芯片功能衰退或互联问题ꎬ光电隔离控制经常不稳定ꎬ尤其是对分析磁场的控制和对源气体流量的MFC的控制.用工业级的多通道光端机更换旧的光纤通讯系统ꎬ三组光端机的发射部分如图2(c)所示ꎬ两组光端机的接受部分如图2(d)所示ꎬ用于控制灯丝电源㊁起弧电源㊁4路气体流量MFC.另一个光端机接收器如图2(e)所示ꎬ用于控制分析器㊁源磁场及析出高压.改造后ꎬ原控制面板上的电位器全部停用ꎬ新的电位器统一接在一个5V直流电源上ꎬ可调节输出0~5V模拟信号.在未加高压情况下ꎬ外部电位器设定的电压值与内部光端机接收器输出的电压值保持一致ꎬ最大偏差小于0.1Vꎬ完全满足使用需求.在120kV(析出高压30kVꎬ直线加速高压90kV)高压下ꎬ测试每一路光电隔离控制线路ꎬ均可以稳定调节ꎬ不受高压影响ꎬ也不影响高压的调节与设定ꎬ实现了预期的功能.351分析测试技术与仪器第26卷图2㊀光电隔离控制系统改造(a)改造前发送端ꎬ(b)改造前离子源内接收端ꎬ(c)改造后的光端机发射端ꎬ(d)和(e)改造后的光端机接受端Fig.2㊀Reformingofphotoelectricisolationcontrolsystem(a)oldtransmittingendsꎬ(b)oldreceivingendsinionsourceꎬ(c)transmittingendsofnewopticaltransceiversꎬ(d)and(e)receivingendsofnewopticaltransceivers2.3㊀进样终端升级原设备中一个进样终端不可用ꎬ将这一路的法拉第检测系统含光阑及后端的进样卡盘全部去除ꎬ用从其他旧设备上拆下的15cm部件替换安装.系统通电后ꎬ手动逐步检查操作ꎬ发现进出样片功能正常.一个10cm进样终端升级为15cmꎬ将10cm单晶硅圆片贴在15cm单晶硅圆片上ꎬ并固定在进样室内ꎬ如图3所示.2.4㊀剂量监控系统改造深入分析扫描控制板上各模块的功能ꎬ在原电路板上加装电位器㊁正负极性转换开关及电容滤波器ꎬ如图4(a)所示.测试发现ꎬ束流能够向两个进样终端偏转ꎬ15cm的光阑㊁4个角法拉第杯能够正常接收到束流ꎬ说明扫描开的离子束满足15cm晶圆片注入的面积.新开发的剂量监控系统如图4(b)所示ꎬ包括电流转电压模块㊁电压转频率模块㊁以单片机为核心的计数比较模块及电磁气动阀束流开关.图3㊀进样卡盘升级Fig.3㊀Upgradeofsamplechuck451第3期张明亮ꎬ等:瓦里安300XP离子注入机改造及功能开发利用CA741放大器将电流信号转换成电压信号ꎬ再用AD654将电压转换成方波频率ꎬ送入单片机进行累积计数.在单片机另一输入端设定需要注入剂量的数值ꎬ单片机不断比较累计计数与设定剂量数值ꎬ当两者完全相等时ꎬ输出一个5V的高电位ꎬ控制继电器接通24V电磁阀控制信号ꎬ压缩空气推动气缸ꎬ切换束线挡板ꎬ从开通到关闭位置状态.按下复位键ꎬ当累计计数与设定剂量数值不等时ꎬ单片机输出0V低电位ꎬ束线挡板保持在开通位置状态.用数字源表的恒电流源模式产生的电流模拟离子束束流检测到剂量监控系统功能与预期一致ꎬ运转完全正常.通过调节放大器的放大系数和AD654的时间常数ꎬ离子束束流25μA产生40kHz方波ꎬ在10~400kHz范围ꎬ电流与频率线性相关系数大于0.99ꎬ满足对设备实际产生离子束束流的数字化计量.经计算ꎬ2ˑ107个方波计数相当于1ˑ1015cm-2的剂量ꎬ在实际硅片上注入后ꎬ通过电阻反推注入离子数量ꎬ与设定剂量值基本一致ꎬ同时ꎬ还与工艺仿真结果吻合较好.图4(a)扫描控制模块ꎬ(b)剂量监控及束流开关控制模块Fig.4㊀(a)Scanningcontrolmoduleꎬ(b)dosecontrollerandionbeamswitchmodule2.5㊀加速高压系统改造原设备的直线加速高压部分采用二极管和大电容的倍压器架构ꎬ由于二极管和电容器的性能退化ꎬ经常发生击穿㊁打火等现象ꎬ导致系统无法正常使用.将旧的电源及倍压器拆除ꎬ换上定制的单极性输出高压电源ꎬ输出高压直接加载到加速管上ꎬ工作完全正常ꎬ加载的高压在0~100kV可调节ꎬ原系统中的高压测量模块正常工作ꎬ能够准确读出实际加载的高压ꎬ该数值等于新高压电源加载的高压值与吸出高压之和ꎬ完全符合预期.2.6㊀硼离子束流及注入均匀性改造后的离子注入整体设备运行正常ꎬ在150A灯丝电流㊁75V起弧电压㊁三氟化硼气体保持离子源真空为20μTorr㊁28keV析出电压和束流能量加速到60keV等条件下ꎬ主法拉第杯上测量到的束流达到160μAꎬ如图5所示.㊀㊀通常采用离子注入后形成电阻的不均匀性反映图5㊀主法拉第杯实时监测束流照片Fig.5㊀PhotoofbeamcurrentdetectingonthemaininlineFaradaycup551分析测试技术与仪器第26卷离子注入的均匀性.在设备全部正常运转情况下ꎬ使用硼离子注入n型单晶硅片ꎬ退火激活后ꎬ测量注入面方块电阻ꎬ统计计算结果如表1所列.在两个剂量水平上ꎬ各用5片15cm圆片测量片内和片间均匀性ꎬ测试结果表明ꎬ片内及片间的电阻不均匀性都优于3.5%.使用离子注入工艺仿真软件ICECREAM和SRAM进行仿真ꎬ仿真结果与此台设备实际工艺结果较一致.表1㊀硼离子注入形成电阻的不均匀性Table1㊀Inhomogeneityofresistivitybyimplantation注入元素能量/keV剂量/cm-2氮气保护下退火激活平均方阻/(Ω/•)片内均匀性/%片间均匀性/%B301ˑ10151000ħ30min3302.63.1B301ˑ10161000ħ30min273.53.23㊀应用实例研究发现ꎬ浓硼掺杂的单晶硅层ꎬ在碱性湿法腐蚀中ꎬ腐蚀速度大大减小[2].随着腐蚀温度降低ꎬ在较低的硼掺杂浓度下ꎬ就会出现腐蚀自停止效应.EPW S 是一种有机碱性溶液ꎬ包含乙二胺㊁邻苯二酚㊁水和吡嗪ꎬ能够在50ħ以上使用ꎬ对氧气不敏感ꎬ不形成残留物ꎬ各向异性腐蚀ꎬ(100)面与(111)面腐蚀速率比约100ʒ1ꎬ能有效避免碱金属离子对半导体器件性能的影响.氢氧化钾溶液是最常用的一种单晶硅湿法腐蚀溶液ꎬ(100)面与(111)面腐蚀速率比约400ʒ1ꎬ可以选择性各向异性腐蚀.在有机碱性溶液中ꎬ相对较低的硼掺杂浓度即可实现腐蚀自停止层制作ꎬ在较低的腐蚀温度下ꎬ较低的硼掺杂浓度就可以制备出腐蚀自停止层单晶硅[3].在完成设备升级改造后ꎬ一般1~2h就能顺利完成浓硼离子注入工艺.利用大束流硼离子注入制备浓硼掺杂单晶硅结构层ꎬ1ˑ1016cm-2以上的离子剂量已经能够应用到MEMS压力传感器㊁热电器件以及纳米谐振子器件中.3.1㊀MEMS压力传感器P型重掺杂的硅压阻温度系数小ꎬGoodrich公司报道了一款基于重掺杂硼的硅压阻MEMS压力传感器ꎬ经过温度补偿ꎬ测量精度达到0.05%ꎬ是目前报道的性能最好的压阻式MEMS压力传感器[4].由于在医疗㊁气象㊁航空航天等领域的广泛应用需求ꎬ微型化MEMS压力传感器的研究受到越来越多的关注[5].在n型单晶硅表面注入硼ꎬ形成浓硼掺杂层ꎬ利用该浓硼层制作硅纳米线压阻ꎬ互联成惠斯通电桥ꎬ构建出MEMS压力传感器芯片.经过浓硼掺杂过的单晶硅在四甲基氢氧化铵(TMAH)溶液中腐蚀后剩余的硅薄膜如图6(a)所示.该膜厚可以通过离子注入及后续退火工艺调节.表面整层的浓硼掺杂硅通过沟槽刻蚀隔离技术ꎬ在应力集中的感压膜上形成压阻条.图6(b)是悬空硅压阻局部放大的扫描电镜(SEM)照片ꎬ宽度120nmꎬ厚度1.1μm.图6(c)是感压膜边沿切向压阻条的SEM照片.图6(d)为MEMS压力传感器芯片横截面的SEM照片ꎬ感压膜厚度40μm.实验室测试发现ꎬ满量程1MPa输出约50mVꎬ满量程精度优于1%.温度特性测试在恒温箱中进行ꎬ分别测量-25㊁25㊁120ħ3个点的数据ꎬ灵敏度温度系数最大仅3%ꎬ电阻温度系数最大为2.5%.3.2㊀热电器件热电器件基于塞贝克效应能够将热能转换成电能ꎬ基于珀尔帖效应能使用电能产生局部制冷.体硅材料的热电优值ZT仅仅0.01左右ꎬ浓硼掺杂的硅纳米线表现出优异的热电性能[6]ꎬ最大热电优值ZT接近1[7].由于硅材料应用广泛ꎬ并且微纳加工工艺成熟ꎬ易于集成ꎬ已经吸引了广泛的研究兴趣[8].利用离子注入在n型单晶硅表面形成浓硼掺杂层ꎬ在TMAH溶液中自停止腐蚀ꎬ制作出硅纳米线热电器件[9].硅纳米线热电器件结钩如图7(a)所示ꎬ利用金属铂构建两个热岛ꎬ同时用作温度传感器.图7(b)是硅纳米线热电器件的中间悬空的硅纳米线的SEM照片.硅纳米线的长7.66μmꎬ宽408nmꎬ高685nmꎬ电导率约为1.3ˑ10-3Ω∙cmꎬ对应的掺杂浓度为8.92ˑ1019cm-3.该硅纳米线的热导率为17.25W/(m K)ꎬ与块体单晶硅的热导率相比[120W/(m K)]ꎬ降低了约7倍.测量得到ꎬ该硅纳米线室温下塞贝克系数是44.45μV/K.651第3期张明亮ꎬ等:瓦里安300XP离子注入机改造及功能开发图6㊀基于浓硼掺杂硅压阻MEMS压力传感器(a)浓硼掺杂层SEM照片ꎬ(b)悬空硅压阻的局部放大SEM照片ꎬ(c)边沿切向压阻条的SEM照片ꎬ(d)压力传感器横截面SEMFig.6㊀SiliconpiezoresistiveMEMSpressuresensorbasedonhighconcentrationborondoping(a)SEMofhighconcentrationborondopingsiliconlayerꎬ(b)partiallyenlargedSEMofsuspendedsiliconpiezoresistiveꎬ(c)SEMofedgetangentialpiezoresistiveꎬ(d)crosssectionSEMofpressuresensorchip图7㊀硅纳米线热电器件(a)结构示意图ꎬ(b)放大的器件中悬空硅纳米线SEM照片Fig.7㊀Thermoelectricaldevicebasedonsiliconnanowire(a)schemeofdevicestructureꎬ(b)SEMofsuspendedsiliconnanowireinthermoelectricdevicewithmagnified3.3㊀硅纳米带谐振子高灵敏传感器在公共安全㊁环境监测㊁食品卫生和临床诊断等领域有着迫切应用需求ꎬ谐振频率变化的纳米线谐振子是高灵敏传感器的核心元件.微751分析测试技术与仪器第26卷纳机电生化传感器利用机械组元与待测物相互作用ꎬ通过测量机械组元的质量㊁应力和表面声波等参数的变化ꎬ获得检测物的信息.基于谐振原理的生化传感器ꎬ表现出高灵敏度ꎬ能检测出单个细菌㊁单个病毒和单条DNA等.并且ꎬ经过表面修饰后ꎬ检测选择性得到提高ꎬ例如ꎬ利用自组装分子固定抗体ꎬ可检测肝癌标志物甲胎蛋白.修饰表面敏感层ꎬ可检测环境中爆炸物㊁有毒气体的分子等.用纳米材料构筑谐振型生化传感器ꎬ将进一步促进生化传感器向小型化㊁高灵敏㊁低成本和智能化方向发展.悬臂梁和双端固支梁是最常用的微纳谐振子ꎬ它们本征共振频率f0为:f0=12πkm∗=CtL2Eρ(1)式中ꎬk㊁m∗是梁的弹性系数和有效质量ꎬt㊁L是梁的厚度及长度ꎬE㊁ρ是梁材料的杨氏模量和密度ꎬC是常数ꎬ悬臂梁的C为0.1615ꎬ双端固支梁的C为1.027.若不考虑表面吸附对谐振子刚度系数的影响ꎬ谐振子频移(Δf)与吸附质量(Δm)成线性关系:Δf=-f02m∗Δm(2)由式(2)可见ꎬ提高检测灵敏度(f0/2m∗)的途径有:(1)提高本征共振频率(f0).(2)减小振动部分有效质量(m∗).由式(1)可见ꎬ对于相同材料和尺寸ꎬ双端固支梁的共振频率是悬臂梁的6倍多.振动部分有效质量随梁尺寸的立方减小ꎬ纳米尺寸谐振子将大大提高对质量检测的灵敏度.例如ꎬ一微米尺度梁(长ˑ宽ˑ厚为200ˑ20ˑ0.2μm3)与一纳米尺度梁(长ˑ宽ˑ厚为1000ˑ200ˑ200nm3)ꎬ微米梁的质量是纳米梁的2ˑ104倍ꎬ纳米梁的本征共振频率是微米梁的4ˑ104倍.根据式(2)ꎬ纳米梁对质量检测的灵敏度是微米梁的8ˑ108倍.利用离子注入形成浓硼掺杂层ꎬ通过电子束光刻和干湿法刻蚀ꎬ制作出硅纳米带谐振器.单栅极硅纳米带谐振子的SEM照片如图8(a)所示.由图8(b)可知ꎬ硅纳米带长5.2μmꎬ宽75nmꎬ厚800nm.图8㊀硅纳米线谐振子(a)单栅极硅纳米带谐振子ꎬ(b)单栅极局部放大SEM照片ꎬ(c)和(d)不同长度双栅极硅纳米带谐振子Fig.8㊀Nanoresonatorbasedonsiliconnanowire(a)nanoresonatorwithsinglesiliconnanobeltgateꎬ(b)partiallyenlargedSEMof(a)ꎬ(c)and(d)differentlengthnanoresonatorswithdoublesiliconnanobeltgates851第3期张明亮ꎬ等:瓦里安300XP离子注入机改造及功能开发该谐振子通过栅极加交流激励信号ꎬ驱动硅纳米带振动ꎬ通过测量源漏两端的电阻变化率ꎬ得到谐振频率.另外ꎬ还可以通过源漏通电流㊁加热驱动硅纳米带振动㊁测量纳米带与栅极间的电容变化率读出谐振频率.类似的工艺ꎬ还可以制作出不同长度硅纳米带㊁双栅控制的谐振子ꎬ如图8(c)和(d)所示.利用这套工艺ꎬ可以制备出一系列不同尺寸的硅纳米带谐振子ꎬ可控调节的尺寸范围为:长1~10μmꎬ宽50~1000nmꎬ厚200~2000nmꎬ为高灵敏度传感器的构建奠定了基础.4 结论针对中科院半导体所瓦里安300XP离子注入机的功能缺陷ꎬ将原离子源供电系统中灯丝电流源和起弧电压源的最大输出功率升级ꎬ并集成到当前的系统中.将原系统中塑料光纤隔离控制线路更换成工业级多通道光纤通讯光端机ꎬ对气体流量㊁离子源电源㊁分析器㊁源磁场㊁吸极高压进行稳定控制和调节.将原系统中采用倍压原理的高压加速系统升级成一体化单极性的高压输出电源.将一个10cm进样终端改造成15cm的样品卡盘ꎬ并开发一套独立控制剂量监测系统.改造后ꎬ硼最大束流超过150μAꎬ15cm晶圆片内片间电阻不均匀性优于3.5%.利用大束流硼离子注入制备浓硼掺杂单晶硅结构层ꎬ成功应用到MEMS压力传感器㊁热电器件以及纳米谐振子器件中.致谢:感谢国家重点研发计划(项目号:2019YFB1503602ꎬ2018YFB1107502)㊁国家自然科学基金(项目号:51720105004)㊁中国科学院科研仪器设备研制项目(项目号:GJJSTD20200006)及中国科学院仪器设备功能开发技术创新项目对本研究工作的支持.参考文献:[1]㊀QuirkMꎬSerdaJ著ꎬ韩郑生译.半导体制造技术[M].北京:电子工业出版社ꎬ2010. [2]㊀SteinslandEꎬNeseMꎬHanneborgAꎬBernsteinRWꎬSandmoHꎬKittilslandG.Boronetch-stopinTMAHsolution[J].SensorsandActuatorsA-Physicalꎬ1996ꎬ54:728-732.[3]㊀李国正.Si的化学自停止腐蚀方法研究[J].微电子学ꎬ1995ꎬ4:45-47.[LIGuo-zheng.Techniquesforchemicalself-etch-stopethchingofsilicon[J].Microelectronicsꎬ1995ꎬ4:45-47.][4]㊀GuoSꎬEriksenHꎬChildressKꎬFinkAꎬHoffmanM.Hightemperaturehighaccuracypiezoresistivepressuresensorbasedonsmart-cutSOI[J].MEMS2008ꎬTucsonꎬAZꎬUSAꎬJanuary13-17ꎬ2008:892-895. [5]㊀SongPSꎬMaZꎬMaJꎬYangLLꎬWeiJTꎬZhaoYMꎬZhangMLꎬYangFHꎬWangXD.RecentprogressofminiatureMEMSpressuresensors[J].Micromachinesꎬ2020ꎬ11:56.[6]㊀HochbaumAIꎬChenRꎬDelgadoRꎬLiangWꎬGarnettECꎬNajarianMꎬMajumdarAꎬYangPD.Enhancedthermoelectricperformanceofroughsiliconnanowires[J].Natureꎬ2008ꎬ451:163-168. [7]㊀BoukaiAIꎬBunimovichYꎬTahir-KheliJꎬYuJꎬGoddardIIIWAꎬHeathJR.Siliconnanowiresasefficientthermoelectricmaterials[J].Natureꎬ2008ꎬ451:168-171.[8]㊀QiYYꎬWangZꎬZhangMLꎬWangXDꎬYangFH.Thermoelectricdevicesbasedonone-dimensionalnanostructures[J].JournalofMaterialsChemistryAꎬ2013ꎬ1:6110.[9]㊀MaZꎬLiuYꎬDengLXꎬZhangMLꎬZhangSYꎬMaJꎬSongPSꎬLiuQꎬJiAꎬYangFHꎬWangXD.Heavilyboron-dopedsiliconlayerforthefabricationofnanoscalethermoelectricdevices[J].Nanomaterialsꎬ2018ꎬ8:77.951。

Varian 离子注入机 EHP220设备规格1.概要本E220中束流离子注入机使用离子源,通过磁分析器、平行束透镜、加速系统等系统来完成注入。
B+束流达0.9mA,P+束流达1.6mA,As+束流达1.2mA。
2. 系统组成E220中束流离子注入机主要由以下几个主要系统组成:2-1)、束线系统;2-2)、靶室系统;2-3)、电源系统;2-4)、辅助系统;2-5)、控制系统;3. 性能指标3-1)、离子能量:10-200keV (+)3-2)、束流最小束流:10μA,且能稳定最大束流:3-3)、工作效率机械传送效率≥160片/小时(10scans)。
3-4)、注入均匀性及重复性注入剂量均匀性:1σ≤0.5%注入剂量重复性:1σ≤0.5%3-5)、质量分析能力M/△M≥85(≥100KV)3-6)、颗粒污染测试颗粒污染控制<0.1/cm2@0.2μm。
3-7)、圆片注入倾斜角度圆片注入倾斜角度:0~60°3-8)、靶注片方式靶注片方式:单圆片注入圆片直径:200mm3-9)、系统真空度静态离子源真空度: 3.00E-6 Torr静态束线真空度: 4.00E-6 Torr静态靶室真空度: 5.00E-6 Torr3-10)、辐射剂量辐射剂量:≤2usv/h4. 场务安装4-1)、安装条件电源:45KVA , 208V,3相,5线,50/60Hz冷却水:入口 2.8Kg/cm2(mix) -10.5 Kg/cm2(max), 0.63L/S 21℃(max)干氮:1.4Kg/cm2(mix) -10.5 Kg/cm2(max)0.47L/S(normal) - 4.7L/S(max)压缩空气:7Kg/cm2(mix) -10.5 Kg/cm2(max)2.35L/S(mix)通风:70.5L/S 、压力-500Pa(气箱排气)2.58L/S(终端排气)2.58L/S(靶室排气)散热:10 kwh(空气)32.5 kwh(水)尺寸:498cm×310cm×244cm重量: 11000Kg4-2)、废气排放设备废气排放图详见附件图14-3)、重心分布设备重心分布图详见附件图25. 附属品5-1)、工具维护保养设备所需工具:1套/台5-2)、离子源离子源:1套/台6. 性能指标验收整机指标测试测试:日期:验收:日期:6-1)、离子能量与能量精度测量离子能量是引出电压与加速电压之和,测量时以测量仪器上显示的能量读数为准。
Varian 离子注入机 EHP220设备规格
1.概要
本E220中束流离子注入机使用离子源,通过磁分析器、平行束透镜、加速系统等系统来完成注入。
B+束流达0.9mA,P+束流达1.6mA,As+束流达1.2mA。
2. 系统组成
E220中束流离子注入机主要由以下几个主要系统组成:
2-1)、束线系统;
2-2)、靶室系统;
2-3)、电源系统;
2-4)、辅助系统;
2-5)、控制系统;
3. 性能指标
3-1)、离子能量:10-200keV (+)
3-2)、束流
最小束流:10μA,且能稳定
最大束流:
3-3)、工作效率
机械传送效率≥160片/小时(10scans)。
3-4)、注入均匀性及重复性
注入剂量均匀性:1σ≤0.5%
注入剂量重复性:1σ≤0.5%
3-5)、质量分析能力
M/△M≥85(≥100KV)
3-6)、颗粒污染测试
颗粒污染控制<0.1/cm2@0.2μm。
3-7)、圆片注入倾斜角度
圆片注入倾斜角度:0~60°
3-8)、靶注片方式
靶注片方式:单圆片注入
圆片直径:200mm
3-9)、系统真空度
静态离子源真空度: 3.00E-6 Torr
静态束线真空度: 4.00E-6 Torr
静态靶室真空度: 5.00E-6 Torr
3-10)、辐射剂量
辐射剂量:≤2usv/h
4. 场务安装
4-1)、安装条件
电源:45KVA , 208V,3相,5线,50/60Hz
冷却水:入口 2.8Kg/cm2(mix) -10.5 Kg/cm2(max), 0.63L/S 21℃(max)干氮:1.4Kg/cm2(mix) -10.5 Kg/cm2(max)
0.47L/S(normal) - 4.7L/S(max)
压缩空气:7Kg/cm2(mix) -10.5 Kg/cm2(max)
2.35L/S(mix)
通风:70.5L/S 、压力-500Pa(气箱排气)
2.58L/S(终端排气)
2.58L/S(靶室排气)
散热:10 kwh(空气)
32.5 kwh(水)
尺寸:498cm×310cm×244cm
重量: 11000Kg
4-2)、废气排放
设备废气排放图详见附件图1
4-3)、重心分布
设备重心分布图详见附件图2
5. 附属品
5-1)、工具
维护保养设备所需工具:1套/台
5-2)、离子源离子源:1套/台
6. 性能指标验收
整机指标测试
测试:日期:
验收:日期:
6-1)、离子能量与能量精度测量
离子能量是引出电压与加速电压之和,测量时以测量仪器上显示的能量读数为准。
测量方法:
通过引出单电荷,离子能量为: 10keV~200keV(单电荷)
采用高压计检测设备实际离子能量,实际离子能量与设备显示离子能量进行对比,得出其误差,计算后获得能量精度。
1)最高能量检测:
能量为200KeV,引出的P+束流大小应在60 μA下进行试验,稳定工作0.2小时,束流变化≤10%,试验过程中出现的打火故障以不中断引束流为准。
实际测量:
验收结果:离子最高能量满足指标≥KeV要求。
测试:日期:
验收:日期:
2)最低能量检测:
能量为10keV,引出的P+束流大小应在200μA下进行试验,稳定0.2小时,束流变化≤10%。
实际测量:
验收结果:离子最低能量满足指标≤ KeV要求。
测试:日期:
验收:日期:
3)能量精度检测:
a. 引出元素为P+时检测数据如下:(单位KeV)
计算方法:能量精度=(高压计测量值﹣设备显示值)/高压计测量值×100%
稳定运行时间:0.5小时
测量结果:在引出元素为P+时,能量最大可达到 KeV,能量精度为,优于±0.5%的指标要求。
测试:日期:
验收:日期:
6-2)、注入元素测量
测量条件:要求有BF3、PH3、AsH3、Ar四路气体源的配置,能够注入B+11、P+31、As+75这三种元素。
测量方法:通过自动引束,分别引出三种元素离子,确定某种粒子的质量数。
测量结果:
束流为 mA,质量数:
P+
31
B+
束流为 mA,质量数:
11
As+
束流为 mA,质量数:
75
测试:日期:
验收:日期:
6-3)、注入剂量均匀性测量
1) 测量条件:
a. 硅片:8”(200mm)圆片、P(100)晶向;
硅片电阻率:P-型1~100Ω/cm;
b.注入元素为P+ 31,能量为160KeV,剂量5E14ions/cm2,注入角度为0°,扭转角度为0°。
2) 测量方法:
利用快速退火炉(RTP)退火后用四探针测试仪测方块电阻,按照相对标准方差的统计规律,计算出均匀性参数,仪器相对偏差≤±0.2%,每片测量81个点。
3) 计算方法:
参考GB/T15862-1995标准的计算方法,最后计算出均匀性参数。
指标要求注入剂量均匀性为1δ≤0.50%。
实际测量注入剂量均匀性为1δ≤%。
测试:日期:
验收:日期:
6-4)、注入剂量重复性测量
1) 测量条件:
a、硅片:10片8”(200mm)圆片;P(100)晶向;
硅片电阻率:P-型1~100Ω/cm;
b.注入元素为P+ 31,能量为160KeV,剂量5E14ions/cm2,注入角度为0°,扭转角度为0°。
2) 测量方法:
将10片8”晶片分不同时间不同匹次注入完成,利用快速退火炉(RTP)退火后用四探针测试仪测方块电阻,按照相对标准方差的统计规律,计算出重复性参数,仪器相对偏差≤±0.2%,每片测量81个点。
3)计算方法:
参考GB/T15862-1995标准的计算方法,最后计算出重复性参数。
指标要求剂量重复性为1δ≤0.50%。
检测数据如下:
实际测量注入剂量重复性为1δ≤%。
测试:日期:
验收:日期:
6-5)、生产效率测量
指标:160片/h
1)条件:
a. 样品晶片数为50片,分装2盒。
b. 以控制实际单片注入时间不大于10秒为准。
2)测试方法:
设备正常运行,注入参数不变,机械手从片库取片送到注入靶台上,靶片转某一角度后,Y方向机械扫描上下各一次后回位,机械手卸片到片库,片库上升一位到下一晶片,这一过程为一次送片;计算一小时内的送片数量(通过左右两边同时进行)1小时装卸片数为生产效率数据。
测量结果:实际注入片数量为片,生产效率为片/小时。
测试:日期:
验收:日期:
6-6)、辐射剂量测量
测试方法:用X射线测量仪,在能量为200keV,P+ 31束流为1600μA的情况下在机器的相应部位(图3),距离机器外壳10cm左右测量。
要求辐射剂量≤2usv/h。
测试仪器:美国产射线探测仪Fluke Biomedical 451P
测试数据:
测试结果:实际测量机器辐射剂量最大处为 usv/h,折算为毫仑/小时,符合机器指标要求。
6-7)、其它测试
1)离子源寿命测试
离子源寿命≥80小时(离子束线系统指标)
离子源灯丝工作寿命统计(具体见调机记录)
测试结论:离子源寿命小时,≥100小时
测试:日期:验
收:日期:
2)束流测试
束流由靶室系统内的聚焦法拉第杯接收,测量值以移动法拉第水平移动一次所接收的束流积分值为准。
(a)最大束流测试
分别引出B+11、P+31、As+175三种离子,在不同能量(见数据表)下,以注入扫描6次为要求进行束流调整,束流引出到达靶后能够稳定工作1小时并且束流变化≤10%。
测量数据表:
测试:日期:
验收:日期:
(b)最小束流考核:
分别引出B+11、P+31、As+175三种离子,在不同能量(见数据表)下,以注入扫描6次为要求进行束流调整,束流引出到达靶后能够稳定工作1小时并且束流变化≤10%。
测量数据表:
测试:日期:
验收:日期:
7. 安全性
设备出厂经过严格的安全、保护测试。
7-1)、人生安全
1)设备X射线的辐射总剂量≤2usv/h;
2)设备的气体离子源使用有充分的安全措施。
7-2)、智能连锁装置
1)本设备所有高电压部分都有充分的连锁装置,并设计有保护盖,且有明显图示警示。
7-3)、环境安全
1)本设备设计时遵循SEMI环境安全要求,使用和报废后都不会对环境安全产生重大影响。
8.保修本设备保修期为六个月,我方负责无偿快速的维修故障,但消耗品不在保修部件之内(消耗品清单会在设备交货时提供)。
9.培训
10.文件资料(收到订金后5个工作日发给甲方)
1)维护手册 1套/台
2)操作手册 1套/台
3)部件清单
4)消耗品清单。