外延生长工艺原理
- 格式:ppt
- 大小:5.57 MB
- 文档页数:16





SIC外延生长法的工艺流程SIC外延生长法的工艺流程序号:1SIC外延生长法是一种重要的半导体材料生长技术,被广泛应用于功率电子、射频器件和光电子器件等领域。
它通过在SIC衬底上连续沉积SiC晶体层,实现了对SiC材料的高质量控制和大面积生长。
在本文中,我们将深入探讨SIC外延生长法的工艺流程,以帮助读者更好地理解和学习该技术。
序号:2SIC外延生长法的基本原理是在惰性气体气氛中,通过化学气相沉积(CVD)的方法,将硅和碳源气体分解成SiC气体,然后在SIC衬底上沉积成SIC晶体层。
在整个工艺过程中,需要控制好气氛、温度和气体流量等参数,以保证SIC晶体层的质量和厚度的一致性。
序号:3具体而言,SIC外延生长法的工艺流程可以分为以下几个关键步骤:a. 衬底准备:选择合适的SIC衬底,并进行表面处理,以去除杂质和缺陷。
通常使用化学气相沉积(CVD)或物理气相沉积(PVD)等方法来制备合适的SIC衬底。
b. 热解预处理:将SIC衬底放置在高温炉中,通过热解预处理,去除表面的氧化物和其它杂质。
这一步骤也有助于提高SIC晶体层的生长质量。
c. 生长条件控制:在热解预处理后,将SIC衬底放置在CVD反应室中。
控制好反应温度、压力和气体流量等参数,以实现SiC晶体层的均匀和连续生长。
通常,选择适当的碳源和硅源气体,如甲烷(CH4)和四氯化硅(SiCl4),作为SIC生长的原料气体。
d. 控制生长时间:根据所需的SIC晶体层厚度和生长速率,控制生长时间。
通过调整反应室中的反应气体流量和温度,可以有效控制SIC晶体层的生长速率。
e. 冷却和退火:在SIC晶体层生长完成后,将SIC衬底从反应室中取出,并进行冷却和退火处理。
这一步骤有助于提高晶体层的结晶质量、降低残余应力,并改善界面的质量。
序号:4总结回顾:SIC外延生长法是一种关键的半导体材料生长技术,其工艺流程包括衬底准备、热解预处理、生长条件控制、控制生长时间以及冷却和退火等关键步骤。


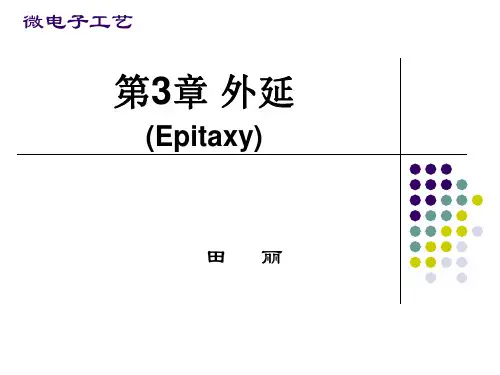


今天来探讨LED外延片的成长工艺,早期在小积体电路时代,每一个6吋的外延片上制作数以千计的芯片,现在次微米线宽的大型VLSI,每一个8吋的外延片上也只能完成一两百个大型芯片。
外延片的制造虽动輒投资数百亿,但却是所有电子工业的基础。
硅晶柱的长成,首先需要将纯度相当高的硅矿放入熔炉中,并加入预先设定好的金属物质,使产生出来的硅晶柱拥有要求的电性特质,接着需要将所有物质融化后再长成单晶的硅晶柱,以下将对所有晶柱长成制程做介绍:长晶主要程式:1、融化(MeltDown)此过程是将置放于石英坩锅内的块状复晶硅加热制高于摄氏1420度的融化温度之上,此阶段中最重要的参数为坩锅的位置与热量的供应,若使用较大的功率来融化复晶硅,石英坩锅的寿命会降低,反之功率太低则融化的过程费时太久,影响整体的产能。
2、颈部成长(Neck Growth)当硅融浆的温度稳定之后,将方向的晶种渐渐注入液中,接着将晶种往上拉升,并使直径缩小到一定(约6mm),维持此直径并拉长10-20cm,以消除晶种内的排差(dislocation),此种零排差(dislocation-free)的控制主要为将排差局限在颈部的成长。
3、晶冠成长(Crown Growth)长完颈部后,慢慢地降低拉速与温度,使颈部的直径逐渐增加到所需的大小。
4、晶体成长(Body Growth)利用拉速与温度变化的调整来迟维持固定的晶棒直径,所以坩锅必须不断的上升来维持固定的液面高度,于是由坩锅传到晶棒及液面的辐射热会逐渐增加,此辐射热源将致使固业介面的温度梯度逐渐变小,所以在晶棒成长阶段的拉速必须逐渐地降低,以避免晶棒扭曲的现象产生。
5、尾部成长(Tail Growth)当晶体成长到固定(需要)的长度后,晶棒的直径必须逐渐地缩小,直到与液面分开,此乃避免因热应力造成排差与滑移面现象。
切割:晶棒长成以后就可以把它切割成一片一片的,也就是外延片。
芯片,圆片,是半导体元件"芯片"或"芯片"的基材,从拉伸长出的高纯度硅元素晶柱(Crystal Ingot)上,所切下之圆形薄片称为外延片(外延片)。

LED芯片制造流程外延生长的基本原理是:在一块加热至适当温度的衬底基片(主要有蓝宝石和、SiC、Si)上,气态物质InGaAlP有控制的输送到衬底表面,生长出特定单晶薄膜。
目前LED外延片生长技术主要采用有机金属化学气相沉积方法。
/4MOCVD介绍:金属有机物化学气相淀积(Metal-Organic Chemical Vapor Deposition,简称MOCVD),1968年由美国洛克威尔公司提出来的一项制备化合物半导体单品薄膜的新技术。
该设备集精密机械、半导体材料、真空电子、流体力学、光学、化学、计算机多学科为一体,是一种自动化程度高、价格昂贵、技术集成度高的尖端光电子专用设备,主要用于GaN(氮化镓)系半导体材料的外延生长和蓝色、绿色或紫外发光二极管芯片的制造,也是光电子行业最有发展前途的专用设备之一。
LED芯片的制造工艺流程:外延片→清洗→镀透明电极层→透明电极图形光刻→腐蚀→去胶→平台图形光刻→干法刻蚀→去胶→退火→SiO2沉积→窗口图形光刻→SiO2腐蚀→去胶→N极图形光刻→预清洗→镀膜→剥离→退火→P极图形光刻→镀膜→剥离→研磨→切割→芯片→成品测试其实外延片的生产制作过程是非常复杂的,在展完外延片后,下一步就开始对LED外延片做电极(P极,N极),接着就开始用激光机切割LED外延片(以前切割LED外延片主要用钻石刀),制造成芯片后,在晶圆上的不同位置抽取九个点做参数测试,如图所示:1、主要对电压、波长、亮度进行测试,能符合正常出货标准参数的晶圆片再继续做下一步的操作,如果这九点测试不符合相关要求的晶圆片,就放在一边另外处理。
2、晶圆切割成芯片后,100%的目检(VI/VC),操作者要使用放大30倍数的显微镜下进行目测。
3、接着使用全自动分类机根据不同的电压,波长,亮度的预测参数对芯片进行全自动化挑选、测试和分类。
`4、最后对LED芯片进行检查(VC)和贴标签。
芯片区域要在蓝膜的中心,蓝膜上最多有5000粒芯片,但必须保证每张蓝膜上芯片的数量不得少于1000粒,芯片类型、批号、数量和光电测量统计数据记录在标签上,附在蜡光纸的背面。
液相外延法生长晶体液相外延法(Liquid Phase Epitaxy,简称LPE)是一种用于生长晶体的常用方法。
它是通过在溶液中使底物与溶液中的成分反应,使晶体逐渐沉积在底物上的过程。
液相外延法具有生长速度快、晶体质量高等优点,因此在半导体器件制造、光电子器件以及光纤等领域得到广泛应用。
液相外延法的基本原理是利用熔点较低的材料,在高温下将其溶解于溶剂中,形成溶液。
溶液中含有需要生长的晶体材料的离子或分子。
然后,将底物(通常是晶体片或玻璃片)放入溶液中,通过控制温度和浓度等参数,使溶液中的晶体材料逐渐沉积在底物表面,形成所需的晶体结构。
液相外延法的生长过程可以分为几个主要步骤。
首先是预处理步骤,即对底物进行清洗和表面处理,以保证底物表面的纯净度和光洁度。
然后,将底物放入外延炉中,控制炉内温度和压力,使溶液中的晶体材料在底物表面生长。
在生长过程中,可以通过改变温度、浓度和生长时间等参数,来控制晶体的生长速度和质量。
最后,将生长完毕的晶体进行冷却和固化处理,以获得完整而稳定的晶体结构。
液相外延法在半导体器件制造中有着广泛的应用。
例如,用于生长硅、镓、砷化镓、磷化镓等材料的外延片,可以用于制造各种类型的光电子器件,如LED、激光器等。
此外,液相外延法还可以用于生长光纤材料,用于制造通信领域所需的光纤器件。
液相外延法的优点之一是生长速度快。
由于溶液中的晶体材料可以快速沉积在底物表面,因此可以在较短的时间内得到较大尺寸的晶体。
此外,液相外延法还具有较高的生长温度范围,可以适应不同材料的生长需求。
然而,液相外延法也存在一些限制和挑战。
首先,由于生长过程中需要控制多个参数,如温度、浓度、生长时间等,因此操作相对复杂,需要经验丰富的操作人员。
其次,溶液中的杂质和缺陷会对晶体的生长和质量产生影响,因此需要对溶液进行精确的控制和纯化。
此外,液相外延法的生长速度受到物质扩散的限制,因此无法实现超高速的生长。
总结起来,液相外延法是一种常用的晶体生长方法,具有生长速度快、晶体质量高等优点。
外延生长的基本原理与应用领域外延生长的基本原理是,在一块加热至适当温度的衬底基片(主要有蓝宝石和SiC,Si)上,气态物质In,Ga,Al,P有控制的输送到衬底表面,生长出特定单晶薄膜。
目前LED外延片生长技术主要采用有机金属化学气相沉积方法。
MOCVD金属有机物化学气相淀积(Metal-OrganicChemicalVaporDeposition,简称 MOCVD), 1968年由美国洛克威尔公司提出来的一项制备化合物半导体单品薄膜的新技术。
该设备集精密机械、半导体材料、真空电子、流体力学、光学、化学、计算机多学科为一体,是一种自动化程度高、价格昂贵、技术集成度高的尖端光电子专用设备,主要用于GaN(氮化镓)系半导体材料的外延生长和蓝色、绿色或紫外发光二极管芯片的制造,也是光电子行业最有发展前途的专用设备之一。
日亚化工(株)日亚化工是GaN系的开拓者,在LED和激光领域居世界首位。
在蓝色、白色LED市场遥遥领先于其他同类企业。
它以蓝色LED的开发而闻名于全球,与此同时,它又是以荧光粉为主要产品的规模最大的精细化工厂商。
它的荧光粉生产在日本国内市场占据70%的比例,在全球则占据36%的市场份额。
荧光粉除了灯具专用的以外,还有CRT 专用、PDP专用、X光专用等类型,这成为日亚化工扩大LED事业的坚实基础。
除此以外,日亚化工还生产磁性材料、电池材料以及薄膜材料等精细化工制品,广泛地涉足于光的各个领域。
在该公司LED的生产当中,70%是白色LED,主要有单色芯片型和RGB三色型两大类型。
此外,该公司是世界上唯一一家可以同时量产蓝色LED和紫外线LED两种产品的厂商。
以此为基础,日亚化工不断开发出新产品,特别是在SMD(表面封装)型的高能LED方面,新品层出不穷。
2004年10月,日亚化工开发出了发光效率为50lm/W的高能白色LED。
该产品成功地将之前量产产品约20lm/W的发光效率提高了2.5倍。