硅外延生长
- 格式:pptx
- 大小:2.29 MB
- 文档页数:75





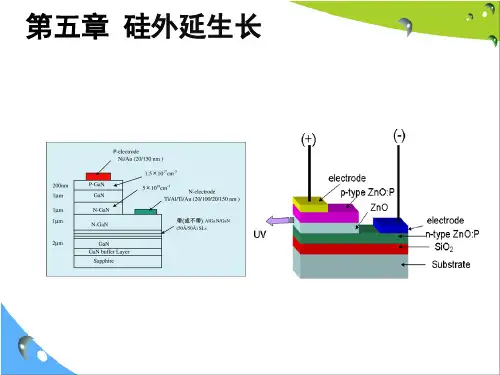

第五章硅外延生长1、解释名词:①*自掺杂:外延生长时由衬底、基座和系统等带来的杂质进入到外延层中的非人为控制的掺杂称为自掺杂。
②外扩散:在外延生长中,由于是在高温条件下进行的,衬底中的杂质会扩散进入外延层致使外延层和衬底之间界面处的杂质浓度梯度变平的现象。
③外延夹层:外延层和衬底界面附近出现的高阻层或反形层。
④双掺杂技术:在外延生长或扩散时,同时引入两种杂质。
因为原子半径不同而产生的应变正好相反。
当两种杂质原子掺入比例适当时,可以使应力互相得到补偿,减少或避免发生晶格畸变,从而消除失配位错的产生。
这种方法叫作双掺杂技术。
⑤SOS技术:在蓝宝石或者尖晶石衬底上外延生长硅。
⑥SOI技术:把器件制作在绝缘衬底上生长的硅单晶层上。
(当器件尺寸缩小到亚微米范围以内时,常规结构就不适应了,导致了SOI结构的发展)⑦SIMOX:氧注入隔离,通过氧离子注入到硅片,再经高温退火过程消除注入缺陷而成。
⑧SDB&BE:直接键合与背面腐蚀技术。
将两片硅片通过表面的S i O2层键合在一起,再把背面用腐蚀等方法减薄来获得SOI结构。
⑨ELTRAN:外延层转移,在多孔硅表面上可生长平整的外延层,并能以合理的速率将多孔硅区域彻底刻蚀掉,该技术保留了外延层所具有的原子平整性,在晶体形成过程中也不产生颗粒堆积或凹坑,因此具有比其它SOI技术更为优越的性能。
⑩Smart-Cut:利用H+注入Si片中形成气泡层,将注氢片与另一片支撑片键合,经适当的热处理,使注氢片从气泡层完整剥离形成SOI结构。
2、*(简述)详述影响硅外延生长速率的因素。
答:①S i CL4浓度:生长速率随浓度的增加增大并达到一个最大值,以后由于腐蚀作用增大,生长速率反而降低。
②*温度:当温度较低时,生长速率随温度升高而呈指数变化,在较高温度区,生长速率随温度变化比较平缓,并且晶体完整性比较好。
③气流速度:在反应物浓度和生长温度一定时,生长速率与总氢气流速平方根成比例关系,但到极限时不在增加。


关于低压硅外延生长的热力学研究低压硅外延生长技术是一种重要的半导体晶体生长技术,其在微电子领域有着广泛的应用。
本文将重点介绍低压硅外延生长热力学方面的研究进展。
低压硅外延生长是指在低压下,将硅原子从气相中输送到衬底表面,通过反应形成硅晶体的过程。
其主要反应式如下:SiH4(g) → Si(s) + 2H2(g)该反应是一个热力学上可逆的反应,其反应过程需要能量的供给。
在低压下进行生长,有利于提高反应产物的纯度,减少杂质的存在,从而提高硅晶体的质量。
热力学研究是低压硅外延生长中的重要内容之一。
其主要研究对象包括反应机理、反应动力学和生长条件等方面。
在热力学研究中,常用的工具是热力学计算软件,比如HSC Chemistry和THERMOCALC等软件。
反应机理是低压硅外延生长研究中的重要内容,其研究目的是确定反应机理和反应物质的生成过程。
常用的方法是实验分析和计算模拟。
实验分析主要是通过表征生长过程中反应物质的生成和消耗来确定反应机理。
计算模拟则是在已知反应物质和反应条件的前提下,通过计算得到反应物质的生成和消耗过程,从而确定反应机理。
反应机理的研究可以为低压硅外延生长提供理论依据,从而指导实际生产操作。
反应动力学是低压硅外延生长研究中的另一个重要内容。
其研究目的是确定反应速率和反应速率常数。
反应速率是指反应物质转化的速度,其受反应温度、反应物质浓度和反应压力等因素的影响。
反应速率常数则是反应速率和反应物质浓度之间的关系。
反应动力学的研究可以为低压硅外延生长提供生长条件的选择依据,从而优化生长过程,提高生长速率和生长质量。
生长条件是低压硅外延生长研究中的另一个重要方面。
其研究目的是确定生长过程中所需的反应温度、反应压力、反应气体流量、生长时间等参数,并根据这些参数制定生长工艺。
生长条件的选择对于获得高质量硅晶体、提高生长效率和降低成本等方面都具有重要意义。
生长条件的研究需要考虑反应物质的化学性质、物理性质以及生长物质的纯度等因素。


第五章硅的外延薄膜的生长外延生长工艺是一种在单晶衬底的表面上淀积一个单晶薄层(0.5∼20微米)的方法。
如果薄膜与衬底是同一种材料该工艺被称为同质外延,但常常就被简单地称为外延。
在硅衬底上淀积硅是同质外延最重要的在技术上的应用,并且是本章的基本主题。
在另一方面,如果在化学成分不同的衬底上进行淀积,则称为异质外延。
这种工艺已在被称为SOS的在蓝宝石(Al2O3)上淀积硅的工艺中得到应用。
外延起源于两个希腊字,意思是整理安排。
外延生长可以从气相(VPE)、液相(LPE)或固相(SPE)中获得。
在硅工艺中,气相外延得到了最广泛的接受,因为它对杂质浓度有良好的控制以及能获得晶体的完整性。
液相淀积在制造Ⅲ−Ⅴ族化合物外延层时得到广泛使用。
正如在第九章“非晶层损伤的退火”中讲到的,固相外延可用于离子注入的非晶层的再结晶。
发展硅外延的主要动机是为了改善双极型晶体管及后来的双极型集成电路的性能。
通过在重掺杂的硅衬底上生长一层轻掺杂的外延层,双极型器件得到优化:在维持低集电区电阻的同时,获得高的集电极-衬底击穿电压。
低的集电区电阻提供了在中等电流时的高的器件工作速度。
最近外延工艺已被用于制造先进的CMOS大规模集成电路。
这些电路中,器件被做在重掺杂的衬底上的一层很薄的(3∼7微米)轻掺杂的外延层中。
这种结构减少了在功率增加或在遭到辐射脉冲时CMOS电路可能经受的闩锁效应。
在外延层中制造器件(双极型和MOS)的其他优点还有:器件掺杂浓度的精确控制,并且这层中可以不含氧和碳。
但外延工艺并不是没有缺点,包括:a)增加了工艺复杂性和硅片成本;b)在外延层中产生缺陷;c)自掺杂以及d)图形改变和冲坏。
在这一章中,我们介绍了:a)外延淀积基础;b)外延层的掺杂;c)外延膜中的缺陷;d)对大规模集成电路的外延淀积的工艺考虑;e)外延淀积设备;f)外延膜的表征;g)硅外延的选择性淀积;和h)硅的分子束外延。
外延淀积基础这部分讨论了用于硅的气相外延的化学气相淀积(CVD)工艺的基础理论。
第五章硅和硅基薄膜的外延生长5.1 概述外延生长(通常亦简称外延)是半导体材料和器件制造的重要工艺之一,它的应用和发展对于提高半导体材料的质量和器件的性能,对于新材料、新器件的开发,对于半导体科学的发展都具有重要意义。
所谓外延生长就是在一定条件下,在经过仔细制备的单晶衬底上,沿着原来的结晶方向生长出一层导电类型、电阻率、厚度和晶格结构、完整性等都符合要求的新单晶层的工艺过程。
所生长的单晶层称为外延层。
外延生长同从熔体中直接生长一样都是制备半导体材料单晶的方法,但相比之下外延生长有它一些特殊的优点:(1)利用外延生长可以在一块低电阻率的衬底上生长出一层很薄的高电阻率的外延层,然后把器件制作在外延层上,解决了高频大功率晶体管要求高的击穿电压和低的饱和压降之间的矛盾。
(2)可进行选择性外延生长,为集成电路和某些特殊结构器件的研制提供了便利条件。
(3)外延技术可以控制外延层中的杂质分布。
(4)采用适当的外延技术可以生长异质、薄层、超薄层组分可变的外延层,为制造多层异质结构器件提供了条件。
(5)可在低于衬底熔点的温度下制备半导体薄膜。
外延生长分类的方法很多,从不同的角度有不同的分类方法,主要有以下四种分类方法:(1)根据外延层在器件制作过程中的作用可分为正外延和反外延。
如果器件直接制作在外延层上,则这种外延技术称为正外延;如果器件制作在衬底上,而外延层只起支撑和隔离作用,则这种外延技术称为反外延。
(2)根据衬底和外延层材料是否相同又可分为同质外延和异质外延。
如果衬底和外延层属于同一种材料则称为同质外延,否则称为异质外延。
(3)根据在生长过程中向衬底输送原子的方法不同可分为气相处延、液相外延和固相外延。
(4)根据生长机理的不同可分为直接外延生长和间接外延生长。
不经过中间化学反应,原子从源直接转移到衬底上形成外延层的外延生长称为直接外延生长;生长外延层所需要的原子或分子是由含有该组分的化合物,通过还原、热分解、歧化等化学反应而得,则这种外延生长称为间接外延生长。