半导体物理基础 第六章 MOS
- 格式:ppt
- 大小:1.00 MB
- 文档页数:21

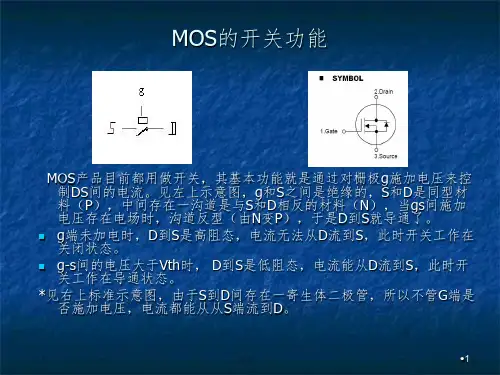

mos原理
MOS原理:现代电子技术的基础
MOS(Metal-Oxide-Semiconductor)是一种半导体器件,是现代电子技术的基础之一。
MOS原理是指利用金属-氧化物-半导体结构来实现电子器件的工作原理。
MOS器件具有低功耗、高速度、高可靠性等优点,被广泛应用于集成电路、微处理器、存储器等领域。
MOS原理的基本结构是由金属、氧化物和半导体三部分组成。
金属是电极,氧化物是绝缘层,半导体是导电层。
当金属电极施加电压时,电子会在半导体中形成电子云,这个电子云会在氧化物中形成电场,从而控制半导体中的电子流动。
这种控制电子流动的方式被称为场效应,因此MOS器件也被称为场效应晶体管。
MOS器件的优点之一是低功耗。
由于MOS器件的绝缘层是氧化物,所以电流只能通过金属电极和半导体之间的电场控制,而不能通过氧化物。
这种结构使得MOS器件的电流非常小,因此功耗也很低。
MOS器件的另一个优点是高速度。
由于MOS器件的电流非常小,所以响应速度也非常快。
此外,MOS器件的结构非常简单,制造工艺也比较成熟,因此可以实现高密度集成,从而提高器件的速度。
MOS器件的可靠性也非常高。
由于MOS器件的绝缘层是氧化物,所以不容易受到外界的干扰。
此外,MOS器件的结构非常简单,没有机械部件,因此也不容易出现故障。
MOS原理是现代电子技术的基础之一,MOS器件具有低功耗、高速度、高可靠性等优点,被广泛应用于集成电路、微处理器、存储器等领域。
随着科技的不断发展,MOS器件的性能也在不断提高,未来MOS器件将会更加智能化、高效化、可靠化。


第六章MOS电容•硅表面的悬挂键•表面束缚电子态•界面态•理想MOS电容•理想MOS电容中表面电荷和表面势的关系•表面电荷主要来源的转化•小信号理想MOS电容的C-V特性•实际MOS电容中有许多其他电荷•小信号实际MOS电容的C-V特性•从实际MOS电容的C-V特性可以得到的信息半导体器件的基本结构-金属/氧化层/半导体结构的电容~电压关系硅片表面的悬挂键•硅单晶体内部一个原子是以共价键形式和周围四个原子结合起来的。
•在表面,硅原子的排列中断,表面的原子就有一部分未成键的电子。
•这种未成键的电子的面密度约1015/cm2。
•这些未成键的电子和体内成键的电子所处的状态不同,是局域束缚电子。
氧化层和硅的界面没有界面态;=?sc1/2exp 1s s q q kT kT ψψ⎫⎤⎪⎛⎞−−⎬⎜⎟⎥⎝⎠⎦⎪⎭小信号理想MOS的C-V特性取决于:测试信号和偏置电压的选择:•低频、稳态;•高频、稳态;•高频、瞬态。
实际MOS电容中有许多其他电荷畸变平移AC B从MOS电容测试可以获得的信息一般可以测试:•可动离子浓度(加偏压、温度测试C-V曲线漂移);•界面态密度(低频稳态和高频稳态C-V曲线);•产生寿命(高频深耗尽到高频稳态的过渡过程);•氧化层厚度(氧化层电容);•衬底的导电类型和掺杂浓度(耗尽区稳态高频C-V);其他影响因素;•二氧化硅中的陷阱、外表面吸附离子、含磷二氧化硅极化、界面杂质、辐射效应…重点内容•表面电荷和表面势的关系。
•小信号MOS电容的三种特性曲线是在什么情况下得到的。
•从MOS电容测试可以得到哪些信息。
•电荷在二氧化硅和金属的界面附近对测试结果没有影响而在半导体表面一侧则影响最大(为什么?)。




mos晶体管的工作原理
MOS晶体管(Metal-Oxide-Semiconductor Field-Effect Transistor)是一种基于半导体材料的电子器件,主要由金属
栅极、氧化物绝缘层和半导体底座构成。
MOS晶体管的工作原理可以分为三个主要阶段:截止区、线
性区和饱和区。
1. 截止区:当栅极电压低于半导体底座的临界电压(即阈值电压)时,MOS晶体管处于截止状态。
在这种状态下,栅极无
法形成足够的电场,无法形成有效的电子导流通道,这样导致源极和漏极之间没有电流流动。
2. 线性区:当栅极电压高于阈值电压,但没有达到最大电压时,MOS晶体管处于线性区。
在这种状态下,栅极的电场会引起
半导体底座中的自由电子进行电导。
漏极和源极之间的电流正比于栅极与漏极之间的电压差,并且可以通过调节栅极电压来控制电流的大小。
3. 饱和区:当栅极电压达到最大电压时,MOS晶体管处于饱
和区。
在这种状态下,栅极电场已经饱和,无法更进一步增加。
这导致电子在MOS管底座中形成一个电导通道,源极和漏极
之间的电流开始饱和,基本不再随栅极电压的变化而改变。
通过调节栅极电压,可以实现对MOS晶体管的导通与截止控制。
这种电压控制特性使得MOS晶体管成为现代电子器件中
最常用的器件之一,广泛应用于逻辑电路、放大器、存储器等各种应用中。

mos半导体物理
MOS半导体物理是指金属-氧化物-半导体(Metal-Oxide-Semiconductor)结构的物理性质和行为。
MOS结构是一种重要的半导体器件结构,在集成电路中广泛应用,例如MOS场效应晶体管(Metal-Oxide-Semiconductor Field-Effect Transistor, MOSFET)。
MOSFET是目前最主要的半导体器件之一,其特点是功耗低、速度快、集成度高等。
在MOS半导体物理中,主要研究以下几个方面:
1. 电子能级和能带结构:研究材料中的电子能级分布和能带结构,以理解电子在MOS结构中的行为。
2. 介电常数和界面态:研究氧化物材料的介电常数和界面态的形成机制,包括表面反应和界面态的能级位置等。
3. 电场效应:研究外加电场对MOS结构中载流子的影响,例如电子和空穴在电场作用下的运动和输运特性。
4. 表面态和氧化物质量:研究表面态的形成和性质,以及氧化物质量的控制和改善,以提高MOS结构的性能。
5. 载流子输运:研究载流子在MOS结构中的输运过程,包括电子和空穴的迁移率、散射机制等。
通过对MOS半导体物理的研究,可以深入理解MOS结构的
性质和行为,并为MOSFET等器件的设计和优化提供理论基础。

mos的原理
MOS(Metal-Oxide-Semiconductor)是一种常见的半导体器件。
它是由一层金属氧化物半导体材料(通常是二氧化硅)作为绝缘层和两个金属电极构成的。
MOS的原理是基于PN结和金
属电场效应晶体管的原理。
在MOS的基础结构中,金属部分是源极和漏极,金属氧化物
半导体材料是栅极,而半导体衬底则充当了体极。
当在MOS
器件上加上适当的电压时,PN结的箭头指向漏极到源极的方向。
在MOS工作时,通过在栅极上施加不同的电压,可以控制栅
极-源极电场的强弱,从而控制电流的流动。
当栅极电压为零
或低时,MOS器件处于关断状态,阻止电流通过;而当栅极
电压为正时,形成正电场,会吸引电子使其在输运层形成导电通道,导致电流通过,MOS器件处于开通状态。
此外,MOS器件还可以通过控制栅极电压的大小,调整导电
通道的导电效率,实现不同电流的流动。
这种根据输入电压来控制输出电流的特性,使MOS器件具有非常重要的应用,如
在集成电路中可以实现逻辑门电路,开关电路等。
总结来说,MOS器件的原理是基于PN结和金属电场效应晶
体管的原理。
通过控制栅极电压来改变电场强度,从而控制电流的流动情况,实现不同信号和电路的处理和转换。
mos器件工作原理
MOS器件(MOS:Metal-Oxide-Semiconductor)是一种常见
的电子器件,它的工作原理可以简单地描述为通过控制栅极电压来操控源极和漏极之间的电流。
在MOS器件中,栅极与介质层之间存在一个绝缘层,可以用
来隔离栅极和源漏极。
当给栅极施加电压时,电场会引起绝缘层下的内部电荷分布,从而形成一个电场效应。
这个电场效应会影响介质层下的电荷运动,从而控制源极和漏极之间的电流。
当栅极施加正电压时,电场效应会引起绝缘层下的正电荷集中,形成一个正电荷层,这个电荷层会吸引反应电子到栅极附近。
这些反应电子会在栅极和源极之间形成一个导电通道,允许电流流动。
因此,当栅极施加正电压时,MOS器件处于导通状态。
反之,当栅极施加负电压时,电场效应会引起绝缘层下的负电荷集中,形成一个负电荷层,这个电荷层会排斥源极或漏极中的电荷,阻止电流的流动。
因此,在负电压的作用下,MOS
器件处于截止状态。
通过控制栅极电压,可以在MOS器件中实现开关功能,从而
用于数字电路和模拟电路中的信号处理和放大等应用。
此外,由于其结构简单、功耗低等优势,MOS器件广泛应用于集成
电路中。
MOS的表面能带弯曲•说明:qψS ( 表面势能) = ( 半导体内的E i ) – ( 表面处的E i );V GS 可使表面势ψs 变化( 基本是线性变化关系) ;Q n(y) 是沟道中的少数载流子面电荷密度.•半导体的Fermi势ψB和表面状态:在半导体表面处的载流子浓度决定于表面能带的弯曲程度:n P0 = n i exp[(E F-E i)/kT] >> n i ;p P0 = n i exp[(E i-E F)/kT] << n i .在半导体内的Fermi势能(qψB = E i-E F ) 可用半导体内的参量来表示:∵半导体内的平衡多子浓度p P0 = n i exp[(E i-E F)/kT] = n i exp(qψB/kT) ≈ N A ,∴ψB =( E i-E F )/q = (kT/q) ln(N A / n i ).可见: 在ψs = ψB时, 表面处的多子浓度将小于体内的多子浓度, 而少子浓度将多于体内的少子浓度,即表面呈现为弱反型的表面;在ψs = 2ψB时, 表面处的多子浓度将远小于体内的多子浓度,而少子浓度将远多于体内的少子浓度,为强反型表面.理想MOSFET的阈值电压:•说明:①MOSFET是“理想”的含义:在MOS系统中不含有任何电荷状态(除栅电压在半导体表面产生的空间电荷以外, 不考虑表面态电荷和M-S功函数差).→在栅电压V GS = 0 时, 半导体表面的能带不发生弯曲(平带状态) .②在讨论V T时忽略了反型层中的电荷:因为刚达到强反型时, 正好沟道中的电子浓度= p-衬底内的空穴浓度; 而且反型层仅限于表面极薄的一层,其中的电荷Q n, 比耗尽层中的电荷Q B少得多(在刚强反型时, 耗尽层宽度最大). 所以可忽略反型层中的电荷Q n .MOS的非饱和特性•说明:沟道的长度(y方向)为L ;沟道的宽度(z方向)为Z ;沟道的厚度(x方向)为X(y) ;沟道的截面积为A ;沟道的电子浓度为n .•理想MOSFET的输出伏安特性计算~沟道电流I D是沟道中的面电荷密度Q n(y)漂移运动的结果:I D= Z X q n μn E(y) = Q n(y) Z μn E(y) ,代入Q n(y)与电压的关系, 并把E(y)用电压来表示为dV(y)/dy, 即有I D= Z μn C i [V GS - V T - V(y)] dV(y)/dy ,积分之∫I D dy = Z μn C i ∫*V GS - V T - V(y)] dV(y) ,[ 积分限: y= 0~L , V= 0~V DS ]则得到I D= ( Z μn C i / L ) {(V GS - 2ψB - V D/2) V DS-(2γ/ 3)×* (V DS+ 2ψB)3/2 - (2ψB)3/2 ] },I D≈( m Z μn C i / L ) { (V GS - V T ) V DS - V DS2 }= m β, (V GS - V T ) V DS - V DS2 } (Sah方程) ,其中γ≡( 2εε0 q N A )1/2 /C i称为衬偏系数; 对较小的N A , m = 1/2 .β = Z μn C i / L .①当V DS 较小时, 有线性特性:I D= ( Z μn C i / L ) {V GS - 2ψB - *2εε0 q N A(2ψB)]1/2 / C i } V DS= β (V GS - V T ) V DS∝V DS ,当V GS= 2ψB - *2εε0 q N A (2ψB)]1/2 / C i ≡V T 时, I D = 0, 即沟道夹断, 这时的栅电压就是阈值电压(夹断电压) .线性区的跨导为g m= ( Z μn C i / L ) V DS .系数( Z μn C i / L ) 称为器件的增益因子(或导电因子).②饱和区:由dI D / dV DS= 0 = β*(V GS - V T ) – V DS ] ,得到饱和电压V DSat = V GS - V T.把V DSat代入到I D表示式中, 求得饱和电流为I DSat= (β/2) (V GS - V T ) 2 ∝V GS2 .可见, 饱和电流与V DS无关, 而与V GS有抛物线关系; 而且饱和电压V DSat随着V GS 的增大而升高.•长沟道MOSFET的电流饱和机理:随着V DS的增加, 夹断点逐渐从漏端移向源端(夹断区扩大); 所增加的电压(V DS - V D sat ) 就降落在夹断区上(使电场↑), 而未夹断的沟道上的电压基本上维持在V D sat ; 当电子从源端漂移到夹断点时, 就被夹断区中的强电场拉到漏极, 则漏极电流基本上由未夹断的沟道区(有效沟道长度)决定, 而有效沟道上的电压基本不变, 故电流饱和(实际上, 由于有效沟道长度随V DS而变, 类似BJT中的Early效应, 所以电流并不完全饱和, g D≠0).饱和电流与V GS有抛物线关系; 饱和电压与V GS之间有线性关系.实际mos的VT•对于实际的MOSFET,需要考虑金属与半导体功函数之差、Si-SiO2系统中电荷的影响。