无铅制程
- 格式:doc
- 大小:40.00 KB
- 文档页数:14

无铅制程教程三篇一、无铅制程的概述无铅制程是一种替代传统有铅制程的电子焊接方法,旨在减少对环境和人体的有害影响。
它是近年来电子行业的一个重要技术发展方向。
本篇文章将从制程原理、材料选择和焊接工艺等方面介绍无铅制程的基本概念和应用。
1. 制程原理无铅制程的核心概念是使用无铅焊料替代传统的铅锡合金焊料。
无铅焊料由多种金属元素组成,如银、铜、锡和锌等。
相比之下,传统的铅锡合金焊料含有大量的铅,对环境和人体健康造成潜在的危害。
2. 材料选择在采用无铅制程时,必须选择适合的材料来替代铅锡焊料。
常用的无铅焊料有银基焊料、铜基焊料和锡基焊料等。
根据具体焊接需求和技术要求,选用合适的材料以确保焊接质量和可靠性。
3. 焊接工艺无铅制程的焊接工艺与传统的有铅制程有一定的区别。
在无铅制程中,焊接温度和焊接时间等参数需要进行优化和控制。
此外,焊接设备的选择和调整也是确保无铅焊接质量的重要因素。
二、无铅焊接工艺的优势无铅制程相对于有铅制程具有多种优势,本篇文章将从环境友好、提高可靠性和法规要求等方面介绍无铅焊接工艺的优势。
1. 环境友好无铅焊料避免了铅对环境的污染,有助于保护生态环境和人类健康。
在电子行业中广泛应用无铅制程,对于减少环境污染具有积极的影响。
2. 提高可靠性相较于传统的铅锡焊料,无铅焊料通常具有更高的熔点和较差的润湿性。
这使得焊点在高温环境下更加稳定,提高了焊接连接的可靠性和耐久性。
3. 法规要求许多国家和地区的法规要求电子产品必须采用无铅制程。
逐渐普及和应用无铅焊接工艺可以确保企业符合相关法规,并顺利进入国际市场。
三、无铅焊接的实施方法无铅焊接具有一定的技术难度,但随着技术的不断发展和成熟,相关实施方法也日趋完善。
本篇文章将从设备调整、工艺控制和质量检验等方面介绍无铅焊接的实施方法。
1. 设备调整由于无铅焊接与有铅焊接存在一定的差异,设备的调整至关重要。
焊接设备的温度控制和焊接参数的设定需要进行调整,以适应无铅焊接的要求。
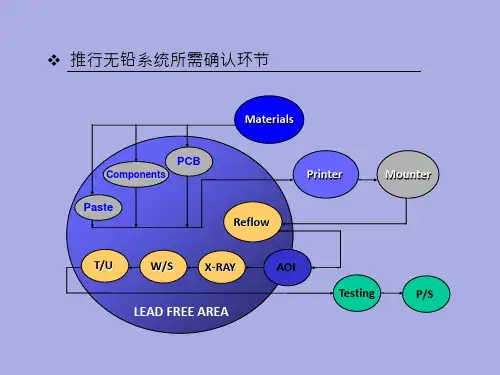

一、锡膏丝印工艺要求1、解冻、搅拌首先从冷藏库中取出锡膏解冻至少4小时,然后进行搅拌,搅拌时间为机械2分钟,人手3分钟,搅拌是为了使存放于库中的锡膏产生物理分离或因使用回收造成金属含量偏高使之还原,目前无铅锡膏Sn/Ag3.0/Cu0.5代替合金,比重为7.3,Sn63/Pb37合金比重为8.5因此无铅锡膏搅拌分离时间可以比含铅锡膏短。
2、模板不锈钢激光开口,厚度80-150目(0.1-0.25mm)、铜及电铸Ni模析均可使用。
3、刮刀硬质橡胶(聚胺甲酸酯刮刀)及不锈钢金属刮刀。
4、刮刀速度\角度每秒2cm-12cm。
(视PCB元器件大小和密度确定);角度:35-65℃。
5、刮刀压力(图一)1.0-2Kg/cm2 。
6、回流方式适用于压缩空气、红外线以及气相回流等各种回流设备。
7、工艺要求锡膏丝印工艺包括4个主要工序,分别为对位、充填、整平和释放。
要把整个工作做好,在基板上有一定的要求。
基板需够平,焊盘间尺寸准确和稳定,焊盘的设计应该配合丝印钢网,并有良好的基准点设计来协助自动定位对中,此外基板上的标签油印不能影响丝印部分,基板的设计必需方便丝印机的自动上下板,外型和厚度不能影响丝印时所需要的平整度等。
8、回流焊接工艺回流焊接工艺是目前最常用的焊接技术,回流焊接工艺的关键在于调较设置温度曲线。
温度曲线必需配合所采用的不同厂家的锡膏产品要求。
二、回流焊温度曲线本文推荐的无铅回流焊优化工艺曲线说明(如图二):推荐的工艺曲线上的四个重要点:1、预热区升温速度尽量慢一些(选择数值2-3℃/s),以便控制由锡膏的塌边而造成的焊点桥接、焊球等。
2、活性区要求必须在(45-90sec、120-160℃)范围内,以便控制PCB基板的温差及焊剂性能变化等因数而发生回流焊时的不良。
3、焊接的最高温度在230℃以上保持20-30sec,以保证焊接的湿润性。
4、冷却速度选择在-4℃/s。
回流温度曲线如下:(图二)图二中红色曲线推荐对焊点亮度要求的客户回流曲线湿度变化说明:1、焊锡膏的焊剂在湿度升至100℃时开始熔化(开始进入活性时期),焊锡膏在活化区的主要作用是将被焊物表面的氧化层去掉,如果活性区的时间过长,焊剂会蒸发挥过快,也会造成焊点表面不光滑,有颗粒状。


無鉛制程鉛的特性.危害以及消耗量鉛是一種成本較低,溫度及電氣性能都有著適當性質的元素,由於鉛錫(Pb-Sn)合金同時具有低成本與適當性質, Pb-Sn焊錫合金一直被用於接著材料,也是在現代電子工業中,使用最廣的焊接劑材料 .鉛一種對人體極有害的元素,神經系統和生育系統紊亂、神經和身體發育遲緩。
鉛中毒特別對年幼兒童的神經發育有極大危害。
雖然已有法律來控制鉛的使用例如,鉛在鉛錘、汽油和油畫中的使用有嚴格的規範,在美國從1978 年起,鉛在消費油畫中的使用已被禁止,其他相關的法規在美國、歐洲和日本正在孕育之中。
盡管鉛一直都有控制,但在使用始終是非常廣, 表一顯示了鉛在各種産品中的使用量,蓄電池占鉛用量的80%,電子焊錫大約占所有鉛用量的0.5%即使鉛在電子焊錫中的使用被禁止,也不能解決全部的鉛中毒問題。
可是,電子焊錫中的0.5%的鉛數量上還是可觀的。
表一、鉛在産品中的消耗量産品消耗量(%)蓄電池80.81其他氧化物(油畫、玻璃和陶瓷産品、4.78顔料和化學品)彈藥 4.69鉛箔紙 1.79電纜覆蓋物 1.4鑄造金屬 1.13銅錠、銅坯0.72管道、彎頭和其他擠壓成型産品0.72焊錫(非電子焊錫)0.7電子焊錫0.49其他 2.77從上表可以,雖然鉛對人體極有害,但由于錫/鉛焊錫這種合金要提供與錫/鉛共晶焊錫相似的物理、機械、溫度和電氣性能,電子工業正在尋找無鉛焊錫,能夠取代普遍接受和廣泛使用的錫/鉛焊錫。
各種代替鉛的元素代替鉛的元素,首先必須考慮成品方面,替代鉛的材料及其相對價格鉛的替代元素相對價格鉛(參考值)1銻(Sb) 2.2鉍(Bi)7.1銅(Cu) 2.5銦(In)194銀(Ag)212錫 (Sn) 6.4鋅(Zn) 1.3除了成本之外,還必須瞭解考慮作爲鉛替代的元素的供需情況如表可以看出含鉍合金從可利用資源的出發點上是無希望的,現在可利用得鉍供應可能被全部用完,如果將此合金廣泛用於正在蓬勃發展的電子工業 ,那這種可利用資源將會全部用完,在要使用此種可利用資源的其他工業上就根本就無法供用.美國礦產局有關不同元素的世界用量及産量的資料元素世界用量(噸)世界産量(噸)剩餘産量(噸)Ag13,50015,0001,500Bi4,0008,0004,000Cu8,000,00010,200,0002,200,000In80 to 100200100Sb78,200122,30044,100Sn160,000241,00081,000Zn6,900,0007,600,000700,000注:現在世界焊錫消耗量 = 60,000 噸,或 6,600,000 升我們要估量各種元素的價格,各元素的產量,從價格表中可以看出比鉛貴的元素有很多,例如,銦(In)是用來取代鉛的主要元素之一,但它是一種次貴重金屬,幾乎和銀一樣貴。



无铅工艺技术
无铅工艺技术,又称为无铅制程技术,是一种利用无铅焊料进行连接的电子制造工艺。
无铅工艺技术的应用已经成为电子制造业的趋势,因为它具有环保、可靠性高和成本低等优点。
首先,无铅工艺技术相对于传统的有铅工艺技术更环保。
有铅焊料中的铅含量较高,使用有铅焊料进行生产会导致污染环境。
而无铅焊料中不含铅或者只含微量铅,因此使用无铅焊料可以减少对环境的污染,并符合全球环保要求。
其次,无铅工艺技术可以提供更高的可靠性。
铅在高温环境下容易发生氧化,导致焊点与焊盘之间的连接失效。
而无铅焊料不易发生氧化,因此可以在高温环境下保持良好的连接效果,提高产品的可靠性。
再次,无铅工艺技术相对于有铅工艺技术来说成本更低。
虽然无铅焊料的成本相对较高,但是无铅工艺技术可以实现自动化生产,提高生产效率,减少人工成本。
另外,由于无铅焊料的可靠性高,可以减少产品的修理和退货率,降低了售后服务的成本。
在无铅工艺技术的应用过程中,需要注意以下几个问题。
首先,无铅焊料的熔点较高,在焊接过程中需要控制好温度,以免损坏其他关键部件。
其次,无铅焊料的流动性较差,焊接过程中需要做好焊接头的设计,以确保焊料能够充分润湿焊盘和焊脚。
最后,无铅工艺技术需要与其他工艺技术相结合,如表面贴装技术和可靠性测试技术等,以确保产品的质量。
总的来说,无铅工艺技术是电子制造业的发展趋势,其环保、可靠性高和成本低等优点使其越来越受到关注和采用。
在应用无铅工艺技术的过程中,需要注意相关问题,以确保产品质量。
未来,随着技术的不断发展,无铅工艺技术将更加完善和成熟,为电子制造业带来更多的便利和机遇。

无铅制程导入面临问题及解决方案1 引言实施无铅化电子组装,许多企业并不主动,而是在各种压力下才转为无铅化生产。
外来压力主要包括法令规定、环保要求、市场利益、用户需求、有害物质回收处理和无铅技术方面等。
无铅化电子组装实施5步法,即:〔1〕选择正确的物料和设备,〔2〕定义制程工艺;〔3〕建立可靠的制造工艺:收集分析数据,排除制程中缺陷;〔4〕执行无铅化生产:生产开始后仔细跟踪制程并作必要的调整;〔5〕控制并改良制程:持续不断的跟进、监控和分析数据,并良好控制整个制程。
2 物料选择2.1 PCB无铅化制造中涉及许多与PCB有关的问题,包括设计、材料和工艺等,特别需要关注和控制的问题有:可焊性及热过程中可焊性的退化问题;较低CTE基材选用问题;合适的焊盘涂层材料选择问题;焊接过程中大尺寸PCB下垂变形问题;高温下基板z轴的热膨胀系数导致通孔可靠性问题;基材高温分解引起的可靠性问题;基材吸水后在高温再流过程中可能导致的内部分层、玻璃纤维和树脂界面接合的退化问题;另外还有兼容性和长期可靠性问题。
基材对于简单产品,焊接温度为235-240摄氏度,对于大热容量的复杂产品,可能需要260摄氏度高温才能满足要求,传统PCB基材大量使用溴化环氧树脂等含卤素聚合物的阻燃材料〔含PBB和PBDE〕,在无铅工艺高的焊接温度下可能出现不可接受的变色、起皮和变形,而且容易释放出高毒性物质〔如二恶英等致癌物〕,另外焊接温度升高,由于材料的CET不匹配,尤其是Z方向,易造成多层结构的PCB金属化孔镀层断裂,一般玻璃转化温度Tg前后,都要求有较低的CTE,如图1中B为合适的材料选择。
常用FR4的Tg在135摄氏度左右,Tg下树脂、玻璃纤维的CTE与Cu〔16×16-6/k〕相似,而在Tg-260摄氏度间Z轴CTE较大,〔80-90×10-6/k〕,基于外观要求、设计难度和绿色制造等理由,无铅化用PCB应转向使用Tg较高的FR4、FR5或CEMn基材有助于降低不匹配产生的应力,但后两者成本较高,表1和图2为不同钎料焊接温度对PCB基材的性能要求。

无铅制程导入生产线注意事项一、无铅解说:随着欧洲WEEE法规要求在2006年前分阶段废止电子焊接中铅的使用,j****及其它相关国家在努力更早的达到相同的目标,无铅应用在全世界正在呈现迅速增长的势头。
毋庸置疑,无铅焊接带来了一系列的挑战,提出作为一般装配的无铅合金还很新,有关其工艺极限的数据也还很少。
两种主要的合金都是锡一银一铜和锡一铅合金的变本。
这些合金具有较高的熔融温度.对金属表面的熔湿也较慢(在实际焊接中,焊锡很难溶解,时间慢,在没有完全熔接时锡点就已凝固,此为目前制程中最大问题),焊点表面也不如锡─铅焊点光滑,光亮。
能够很好地适用于合铅工艺的助焊剂化学成份未必是适合无铅焊接的最佳选择。
二、无铅合金的手工焊接:1:手工焊接可以使用哪些无铅合金和助焊剂。
目前常用的无铅焊线有锡一银一铜(熔点217-221℃),锡银(熔点221℃)以及锡铜(熔点227℃)。
三种合金全都具有免清洗,可水洗或松香配系,并能控制成极为纤细的线径。
这些合金已用于无铅产品的手工装配,并与无铅合金相容。
2:无铅焊料合金需要使用温度较高的烙铁头吗?使用无铅焊接进行手工焊接并不一定需要较高的焊接温度,烙铁头温度700~800华式度之间即可进行正常焊接。
焊接人员会注意到熔温速度比传统的Sn63焊料慢,此外还可能需要略长的接触时间才能达到良好的焊接效果,焊点终饰外观将会不同,终饰外面略为暗淡,是上述无铅焊料的典型特点。
使用具有较高锡含量无铅焊料容易造成烙铁头腐蚀,因而可能需较为频繁的更换烙铁头。
3:无铅焊点再加工可以使用哪些助焊剂?无铅焊接与Sn63焊接并无不同。
助焊剂有免清洗,可水洗及松香类型,可适应各种焊接和再加工工艺。
可水洗型助焊剂,由于其较高的活化剂浓度而能实现更为有效的焊接,免清洗型焊剂传统上由较弱的有机酸制成,其焊接过程较慢,如果曝露于过度加热环境中则较易失活。
无铅制程的导入已成为现在各电子相关行业必须认真面对的一个总体赵势,无铅制程表象上述讲就是不含铅,还属于环保产品,它相对有铅来讲,无论是制程还是材料要求都需高一些,有些操作技巧需要在作业中克服和改善。

无铅制程知识讲座尊敬的各位听众,大家好!今天我将为大家带来一场关于无铅制程的知识讲座。
无铅制程是现代电子制造过程中的一项重要技术,它不仅可以提高产品的品质,还能有效降低对环境的污染。
让我们一起来了解一下吧。
首先,让我们明确一下什么是无铅制程。
无铅制程是一种使用无铅焊料及处理方法的电子制造技术。
相对于传统的铅焊接技术,无铅制程具有更高的可靠性、更低的环境污染风险和更长的使用寿命。
在无铅制程中,我们使用的是一种称为无铅焊料的材料,它可以替代传统的含铅焊料,从而降低对环境和人体健康的潜在危害。
无铅制程的实施主要分为两个方面:一是无铅焊料的使用,二是无铅加工工艺的应用。
无铅焊料主要由锡、银、铜等元素组成,不含有害的铅成分。
在无铅制程中,焊接工艺的温度和时间需要进行严格的控制和调整,以确保焊接质量的稳定和可靠。
无铅制程带来的好处不仅仅是环境友好,还有一系列的技术优势。
首先,无铅制程可以提高产品的可靠性和稳定性。
铅焊接会加速器件的老化和腐蚀,而无铅焊接可以减少这种现象,延长产品的寿命。
其次,无铅制程还可以提高焊接质量和一致性。
无铅焊料的粘附性较强,能更好地与焊接表面结合,从而减少焊接缺陷和虚焊的风险。
此外,无铅制程还可以降低生产过程中的能源消耗和生产成本,提高企业的竞争力。
然而,我们也要认识到无铅制程带来的一些挑战与问题。
首先,无铅焊料相对成本较高,这增加了生产成本。
其次,无铅终端的使用寿命相对较短,需要维修和更新的频率更高。
最后,无铅制程在实施过程中还需要员工接受培训和技术支持,以确保焊接工艺的准确性和稳定性。
总之,无铅制程是一种环保、可靠的电子制造技术,对于提高产品品质和保护环境具有重要意义。
虽然无铅制程也面临一些挑战和问题,但通过技术改进和不断创新,我们相信无铅制程将会成为未来电子制造业发展的主流趋势。
谢谢大家!(此为人工智能文章生成,仅供参考。
)无铅制程作为一种环保、可靠的电子制造技术,具有广泛的应用前景和深远的影响。
无铅制程试验条件■锡铅焊点可靠性测试方法:01 对电子组装品进行热负荷试验(温度冲击或温度循环试验);02 按照疲劳寿命试验条件进行对电子器件结合部进行机械应力测试;在无铅制程焊点可靠性测试中,比较重要的是针对焊点与连接元器件热膨胀系数不同进行的温度相关疲劳测试。
包括等温机械疲劳测试,热疲劳测试及耐腐蚀测试等。
其中根据测试结果等温机械疲劳测试可以确认相同温度下不同无铅材料的抗机械应力能力不同,同时还表明不同无铅材料显示出不同的失效机理,失效形态各有不一。
热疲劳测试是用于考察由于热应力所引起的低循环疲劳对焊点连接可靠性的影响。
▲TOP------------------------------------------------------------------------------------------------------------■目前常用的可靠度试验设备(接合可靠度评估)为:01 高温烤箱 02 热冲击试验[三箱气体式]&[两箱移动式液体]03 恒温恒湿机 04 低阻量测系统05 离子迁移量测系统 06 复合式试验机(温湿度+振动)07 蒸汽老化试验 08 金相切片试验09 振动测试 10 IC零件脚的拉力试验11 弯曲测试 12 电阻电容的推力试验13 落下测试▲TOP------------------------------------------------------------------------------------------------------------■无铅制程接合可靠度(信赖性)评估的试验规范:01 EIAJ(JEITA)ET-740702 EIAJ(JEITA)ET-740103 IPC-SM-78504 IPC-970105 IPC-TM650------------------------------------------------------------------------------------------------------------■无铅制程接合可靠度的试验条件:■无铅制程接合可靠度的试验条件:在高温放置对于强度之影响均倾强度渐渐降低之方向。
电子产品组装中无铅制程的实施方案主要内容:1 电子产品转入无铅制程的时代迫切性2 无铅化电子组装的概念3 无铅焊料的定义4 无铅焊料及其供应元器件的选择5 无铅制程的特点与难点6 各种焊接工艺无铅制程的指导性原则7 无铅制程的导入方案8 亿铖达的专业精神如何帮助您顺利导入无铅制程一、电子产品转入无铅制程的时代迫切性1991年美国参议院提出Reid法案,要求将电子工业用焊料中铅含量控制在0.1%以下,虽然该法案当时遭到了美国工业界的强烈反对而中途夭折,但却引发了世界范围内对无铅化电子组装技术的研发热潮。
同时许多国家和地区的政府也开始关注电子产品生产过程中的环保问题,无铅化电子组装也慢慢演变成一个行业政策的问题。
2003年是无铅化电子组装发展进程中的一个里程碑。
该年2月13日,欧盟正式公布了WEEE和RoHS指令,明确规定自2006年7月1日起,所有进入欧洲市场的电力电子产品必须不含有6种有毒有害物质,其中铅排在第一位。
作为第一个强制要求无铅化的政府官方文件,这两个指令的正式出台对世界范围内的电子工业产生了巨大影响。
仅以中国为例,中国现在每年向欧盟出口电子产品可创汇约2000亿美元,如果不能突破无铅化电子组装这一绿色技术壁垒,其损失是显而易见的。
因此,中国信息产业部在欧盟指令出台后不久,即2003年3月,已经开始拟定《电子信息产品污染防治管理办法》,其核心内容是自2006年7月1日起,投放于中国市场的国家重点监管目录内的电力电子产品也必须不含有6种有毒有害物质,同样铅也是排在第一位。
据我们了解,这一《管理办法》最晚于2005年正式出台。
另一方面,绝大多数国际知名的电子公司都已经把自己的产品完全实现无铅化的日程表锁定在2005年。
当然,他们也必然会要求其OEM厂家及相关供应商要保持同步。
由上述阐述可见,电子产品转入无铅制程的迫切性是这个时代的要求,只有下大力气尽快尽可能好地完成这一转变,才有可能在未来的市场竞争中立于不败之地。
有关SMT无铅制程的工艺一﹑SMT有铅制程所采用的焊锡膏,其成分主要是锡(63%)﹑铅(37%),标准熔化温度为183℃,实际生产温度控制在210~260℃,如果PCB表面温度高于260℃,将使SMT贴装元件受高温损坏的可能性大大增加。
二﹑SMT无铅制程所采用的焊锡膏,其成分主要是锡与其它很多金属的合金,目前国外几大著名供应商所提供的无铅锡膏,熔化温度为220℃左右。
三﹑有铅制程向无铅制程转化中的问题:1﹑SMT有铅制程标准温度曲线,如图1:0 (S)图12﹑SMT 无铅制程温度曲线:(如果沿用有铅制程将会遇到下列问题)图2从图2可以看到,如果只通过升高温度,是不能完成SMT 无铅制程。
否则,SMT 元件在焊接时,损坏率会非常高。
四﹑解决方法:1﹑熔锡之前的助焊剂预热温度及时间基本不变。
2﹑使用2个以上的回流焊机加热区作为焊接区。
3﹑焊接区中的第一个加热区用来急速升温,使PCB 的表面温度达到无铅锡的熔化温度以上10~20℃,焊接区中的第二个加热区用来保持前一区的熔锡温度,同时增加熔锡时间。
从温度曲线来看,在焊接区产生了一个温度平台。
(注:在熔锡温度超过锡膏熔化温度不多时,锡膏熔化需要更多的时间。
比如:用5℃的水熔化同样大小的冰块,将比用10℃的水需要更多的时间。
)(S):220℃4﹑无铅制程温度曲线,如图3:图3五﹑相关设备:在可以承受高温的SMT 元件被生产出来之前,现在的欧﹑美﹑日的企业一般都要求按上述工艺生产,特别是日系企业的需求尤为强烈,因为日本国内在2002年将强制执行电子产品生产的无铅制程。
因此,无铅制程不久也将成为国内的主要生产工艺。
JT 公司是国内最先进行SMT 无铅制程研究的设备制造厂家,在2000年的深圳NEPCON 中,首家唯一推出适用于SMT 无铅制程的热风回流焊机及波峰焊机。
JT 公司的S 系列热风回流焊机,是专门针对SMT 无铅制程而研发,其性能详见JT 公司资料。
无铅制程PCBA可靠度规范随着科学技术的不断进步和电子工艺的快速发展,电子制造业已经成为了全球最为重要的行业之一。
然而,电子制造业在一些环节上的环保问题以及废品量过大等问题仍然严重存在。
为了减少对环境的污染和提高产品质量,近些年来,无铅制程PCBA技术逐渐成为了制造业的一个新的热点。
无铅制程PCBA技术是基于的无铅化工艺的一种。
相比传统的有铅PCBA制程技术,无铅制程PCBA技术在制造过程中更加绿色环保,同时具备更高的可靠度和更稳定的性能。
随着无铅制程PCBA技术的成熟和普及,制造业对于其可靠度的要求也越来越高,那么对于无铅制程PCBA可靠度规范来说需要注意哪些细节呢?一、规范化生产令制度生产令单是集成制造系统的一个基本组成部分,采用规范化的生产令的方式,可以有效遵循无铅制程PCBA生产技术和工艺标准,保证生产的可靠度和质量。
二、加强售后服务无铅制程PCBA的可靠度和寿命需要通过长期的零部件的和零星故障的监控与追踪,以实现全面确定这些方面的表现。
如果我们采用无铅PCB和含铅组件相结合的混合制造工艺,还需要加强售后服务,以便通过维修或更换问题零部件来解决问题。
三、强化检测部门在生产过程中,必须通过各种手段加强检测部门的技能和水平,以保证所有生产的无铅制程PCBA的可靠性和稳定性。
检测部门应针对制品进行容易性、可靠性的检查,设置质量检测流程,确保每个批次的产品符合标准。
四、严格遵循设计和制造标准为了强化无铅制程PCBA的可靠性规范,厂家在设计,制造,测试和维护各方面都需要严格遵守相关标准,以便保证生产的产品能够满足规范要求。
同时,对于设计方案建议要综合考虑制造成本和产品的维护质量方面,避免不必要的矛盾冲突。
五、加强员工培训无铅制程PCBA生产需要高精度,严格的质量控制和操作技巧。
因此,员工培训是非常重要的——只有经过针对性培训后工人们才能正确掌握不同生产线的不同标准和技术细节,从而更好地生产出符合规范的产品。
考虑到环境和健康的因素,欧盟已通过立法将在2008年停止使用含铅钎料,美国和日本也正积极考虑通过立法来减少和禁止铅等有害元素的使用。
铅的毒害目前全球电子行业用钎料每年消耗的铅约为20000t,大约占世界铅年总产量的5%。
铅和铅的化合物已被环境保护机构(EPA)列入前17种对人体和环境危害最大的化学物质之一。
无铅钎料目前常用的含铅合金焊料粉末有锡一铅(Sn-Pb)、锡一铅一银(Sn-Pb-Ag)、锡一铅一铋(Sn-Pb-Bi)等,常用的合金成分为63%Sn/37%Pb以及62%Sn/36%Pb/2%Ag。
不同合金比例有不同的熔化温度。
对于标准的Sn63和Sn62焊料合金来说,回流温度曲线的峰值温度在203到230度之间。
然而,大部分的无铅焊膏的熔点比Sn63合金高出30至45度,因此,无铅钎料的基本要求目前国际上公认的无铅钎料定义是:以Sn为基体,添加了Ag、Cu、Sb、In其它合金元素,而Pb的质量分数在0.2%以下的主要用于电子组装的软钎料合金。
无铅钎料不是新技术,但今天的无铅钎料研究是要寻求年使用量为5~6万吨的Sn-Pb钎料的替代产品。
因此,替代合金应该满足以下要求:(1)其全球储量足够满足市场需求。
某些元素,如铟和铋,储量较小,因此只能作为无铅钎料中的微量添加成分;(2)无毒性。
某些在考虑范围内的替代元素,如镉、碲是有毒的。
而某些元素,如锑,如果改变毒性标准的话,也可以认为是有毒的;(3)能被加工成需要的所有形式,包括用于手工焊和修补的焊丝;用于钎料膏的焊料粉;用于波峰焊的焊料棒等。
不是所有的合金能够被加工成所有形式,如铋的含量增加将导致合金变脆而不能拉拔成丝状;(4)相变温度(固/液相线温度)与Sn-Pb钎料相近;(5)合适的物理性能,特别是电导率、热导率、热膨胀系数;(6)与现有元件基板/引线及PCB材料在金属学性能上兼容;(7)足够的力学性能:剪切强度、蠕变抗力、等温疲劳抗力、热机疲劳抗力、金属学组织的稳定性;(8)良好的润湿性;(9)可接受的成本价格。
新型无铅钎料的成本应低于22.2/kg,因此其中In的质量分数应小于1.5%,Bi含量应小于2.0%。
早期的研发计划集中于确定新型合金成分、多元相图研究和润湿性、强度等基本性能考察。
后期的研发计划主要集中于五种合金系列:SnCu、SnAg、SnAgCu、SnAgCuSb和SnAgBi。
并深入探讨其疲劳性能、生产行为和工艺优化。
表2.3 NCMS美国国家制造科学中心提出的无铅钎料性能评价标准IPC也于2000年6月发布了研究报告“A guide line for assembly of lead-free electronics”。
目前国际上关于无铅钎料的主要结论如下:现在已经有很多种无铅钎料面世没有一种能够为SnPb钎料的直接替代提供全面的解决方案。
(1)对于某些特殊的工艺过程,某些特定的无铅钎料可以实现直接替代;(2)目前而言,最吸引人的无铅钎料是Sn-Ag-Cu系列。
其他有潜力的组合包括Sn-0.7Cu、Sn-3.5Ag和Sn-Ag-Bi;(3)目前还没有合适的高铅高熔点钎料的无铅替代品;(4)目前看来,钎剂的化学系统不需要进行大的变动;(5)无铅钎料形成焊点的可靠性优于SnPb合金。
几种无铅钎料的对比(1)SnCu:价格最便宜;熔点最高;力学性能最差。
(2)SnAg:力学性能良好,可焊性良好,热疲劳可靠性良好,共晶成分时熔点为221℃。
SnAg和SnAgCu组合之间的差异很小,其选择主要取决于价格、供货等其他因素。
(3)SnAgCu(Sb):直到最近几年才知道Sn-Ag-Cu之间存在三元共晶,且其熔点低于Sn-Ag共晶,当然该三元共晶的准确成分还存在争议。
与Sn-Ag和Sn-Cu相比,该组合的可靠性和可焊性更好。
而且加入0.5%Sb后还可以进一步提高其高温可靠性。
(4)SnAgBi(Cu)(Ge):熔点较低,200~210℃;可靠性良好;在所有无铅钎料中可焊性最好,已得到Matsushita确认;加入Cu或Ge可进一步提高强度;缺点是含Bi 带来润湿角上升缺陷的问题。
(5)SnZnBi:熔点最接近于Sn-Pb共晶;但含Zn带来很多问题,如钎料膏保存期限、大量活性钎剂残渣、氧化问题、潜在腐蚀性问题。
目前不推荐使用。
2.2选择合金由上,本次回流工艺设计焊料合金采用Sn/Ag/Cu合金(Sn/Ag3.0/Cu0.5),因为该合金被认为是国际工业中的首选并且得到了工业和研究公会成员的推荐。
因为虽然一些公会还提议并且研究了另一种合金Sn/0.7Cu(质量百分比),一些企业在生产中也有采用这种合金。
但是相对Sn/Cu合金的可靠性和可湿性,另外考虑到在回流焊和波峰焊中采用同种合金,Sn/Ag/Cu合金便成为工艺发展试验最好的选择。
Sn/Ag3.0/Cu0.5合金性能:溶解温度:固相线217℃/液相线220℃;成本:0.10美元/cm3与Sn/Cu焊料价格比:2.7机械强度:48kg/mm2延伸率:75%湿润性:良由Sn/Ag/Cu合金性能可知:焊料合金熔融温度比原Sn/Pb合金高出36℃,形成商品化后的价格也比原来提高。
工艺焊接温度采用日本对此合金焊料的推荐工艺曲线,见图2.1。
图2.1日本推荐的无铅回流焊典型工艺曲线说明:推荐的工艺曲线上有三个重要点:(1)预热区升温速度要尽量慢一些(选择数值2~3℃/s),以便控制由焊膏的塌边而造成焊点的桥接、焊锡球等。
(2)预热要求必须在(45~90sec、120~160℃)范围内,以控制由PCB基板的温差及焊剂性能变化等因素而发生回流焊时的不良。
(3)焊接的最高温度在230℃以上,保持20~30sec,以保证焊接的湿润性。
冷却速度选择-4℃/s6回流焊中出现的缺陷及其解决方案焊接缺陷可以分为主要缺陷、次要缺陷和表面缺陷。
凡使SMA功能失效的缺陷称为主要缺陷;次要缺陷是指焊点之间润湿尚好,不会引起SMA功能丧失,但有影响产品寿命的可能的缺陷;表面缺陷是指不影响产品的功能和寿命。
它受许多参数的影响,如焊膏、基板、元器件可焊性、印刷、贴装精度以及焊接工艺等。
我们在进行SMT工艺研究和生产中,深知合理的表面组装工艺技术在控制和提高SMT生产质量中起着至关重要的作用。
6.1回流焊中的锡珠(1)回流焊中锡珠形成的机理回流焊中出现的锡珠(或称焊料球),常常藏于矩形片式元件两焊端之间的侧面或细间距引脚之间,如图6.1、6.2。
在元件贴装过程中,焊膏被置于片式元件的引脚与焊盘之间,随着印制板穿过回流焊炉,焊膏熔化变成液体,如果与焊盘和器件引脚等润湿不良,液态焊料会因收缩而使焊缝填充不充分,所有焊料颗粒不能聚合成一个焊点。
部分液态焊料会从焊缝流出,形成锡珠。
因此,焊料与焊盘和器件引脚的润湿性差是导致锡珠形成的根本原因。
图6.1片式元件一例有粒度稍大的锡球图6.2比引脚四周有分散的锡球锡膏在印刷工艺中,由于模板与焊盘对中偏移,若偏移过大则会导致锅膏漫流到焊盘外,加热后容易出现锡珠。
贴片过程中Z轴的压力是引起锡珠的一项重要原因,往往不被人们历注意,部分贴片机由于Z铀头是依据元件的厚度来定位.故会引起元件贴到PCB上一瞬间将锡蕾挤压到焊盘外的现象,这部分组喜明显会引起锡珠。
这种情况下产生的锡珠尺寸稍大,通常只要重新调节Z铀高度,就能防止锡珠的产生,如图6.3所示。
图6.3锡球的产生(2)原因分析与控制方法造成焊料润湿性差的原因很多,以下主要分析与相关工艺有关的原因及解决措施:图6.4控制升温速率及保温时间(平台区)是防止锡球的好方法(1)回流温度曲线设置不当。
焊膏的回流与温度和时间有关,如果未到达足够的温度或时间,焊膏就不会回流。
预热区温度上升速度过快,时间过短,使焊膏内部的水分和溶剂未完全挥发出来,到达回流焊温区时,引起水分、溶剂沸腾,溅出锡珠。
实践证明,将预热区温度的上升速度控制在1~4℃/s是较理想的。
(2)如果总在同一位置上出现锡珠,就有必要检查金属模板设计结构。
模板开口尺寸腐蚀精度达不到要求,焊盘尺寸偏大,以及表面材质较软(如铜模板),会造成印刷焊膏的外形轮廓不清晰,互相桥接,这种情况多出现在对细间距器件的焊盘印刷时,回流焊后必然造成引脚间大量锡珠的产生。
因此,应针对焊盘图形的不同形状和中心距,选择适宜的模板材料及模板制作工艺来保证焊膏印刷质量。
(3)如果从贴片至回流焊的时间过长,则因焊膏中焊料粒子的氧化,焊剂变质、活性降低,会导致焊膏不回流,产生锡珠。
选用工作寿命长一些的焊膏(我们认为至少4h),则会减轻这种影响。
(4)另外,焊膏错印的印制板清洗不充分,会使焊膏残留于印制板表面及通孔中。
回流焊之前,贴放元器件时,使印刷焊膏变形。
这些也是造成锡珠的原因。
因此应加强操作者和工艺人员在生产过程中的责任心,严格遵照工艺要求和操作规程进行生产,加强工艺过程的质量控制。
6.2立片问题(曼哈顿现象)形片式元件的一端焊接在焊盘上,而另一端则翘立,这种现象就称为曼哈顿现象,见图6.5。
引起这种现象的主要原因是元件两端受热不均匀,焊膏熔化有先后所致。
在以下情况会造成元件两端受热不均匀:图6.5立片现象图6.6元件偏离焊盘故两侧受力不平衡产生立片现象(1)元件排列方向设计不正确。
我们设想在回流焊炉中有一条横跨炉子宽度的回流焊限线,一旦焊膏通过它就会立即熔化,如图6.7所示。
片式矩形元件的一个端头先通过回流焊限线,焊膏先熔化,完全浸润元件端头的金属表面,具有液态表面张力;而另一端未达到183℃液相温度,焊膏未熔化,只有焊剂的粘接力,该力远小于回流焊焊膏的表面张力,因而,使未熔化端的元件端头向上直立。
因此,应保持元件两端同时进入回流焊限线,使两端焊盘上的焊膏同时熔化,形成均衡的液态表面张力,保持元件位置不变。
图6.7焊盘一侧锡青末熔化.两焊盘张力不平衡就会出现立碑(2)在进行汽相焊接时印制电路组件预热不充分。
汽相焊是利用惰性液体蒸汽冷凝在元件引脚和PCB焊盘上时,释放出热量而熔化焊膏。
汽相焊分平衡区和饱和蒸汽区,在饱和蒸汽区焊接温度高达217℃,在生产过程中我们发现,如果被焊组件预热不充分,经受100℃以上的温差变化,汽相焊的汽化力很容易将小于1206封装尺寸的片式元件浮起,从而产生立片现象。
我们通过将被焊组件在高低温箱内145~150℃的温度下预热1~2min,然后在汽相焊的平衡区内再预热1min左右,最后缓慢进入饱和蒸汽区焊接,消除了立片现象。
(3)焊盘设计质量的影响。
若片式元件的一对焊盘尺寸不同或不对称,也会引起印刷的焊膏量不一致,小焊盘对温度响应快,其上的焊膏易熔化,大焊盘则相反,所以,当小焊盘上的焊膏熔化后,在焊膏表面张力作用下,将元件拉直竖起。
焊盘的宽度或间隙过大,也都可能出现立片现象。