PCB制程异常处理
- 格式:ppt
- 大小:9.56 MB
- 文档页数:32

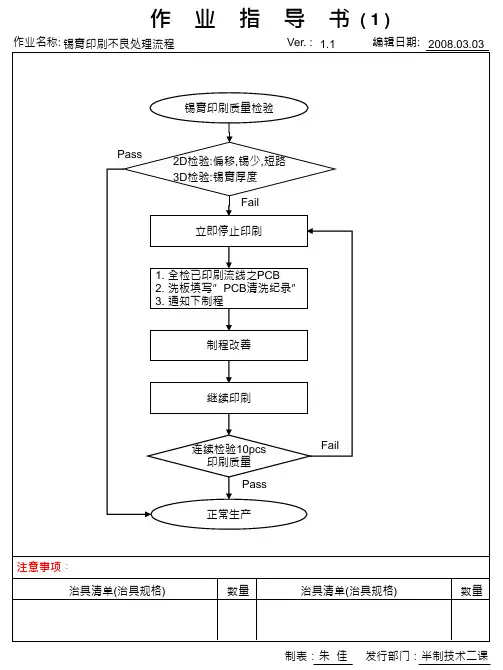

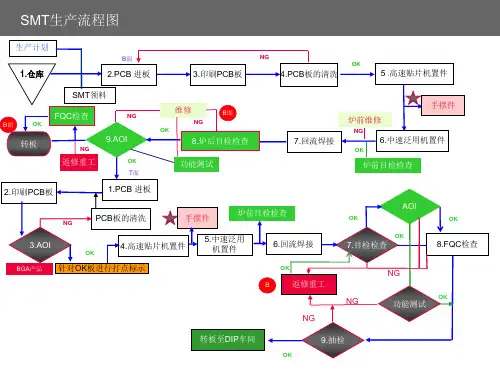


附件一SMTDIP/TEST/PACK1.1 FPY % < 低于每季年度质量目标 5 个百分点 (2hr产出)2.1 ICT 良率 < 93% (2hr产出)1.2 无料站表 / 贴片程序. 2.2 F/T良率 < 94% (2hr产出)1.3 料号 / 品名与料站表 、BOM不符. 2.3 总检良率 < 93% (2hr产出)1.4 零件无法识别或判定时 2.4 测试出现1片烧件/烧板 .3.1 首件检查不合格3.11 有铅材料或无铅材料无法识别, 或环境管理物质材料3.2 需回温、烘烤材料未到规定时间 与其它材料混装混用.3.3 实际作业与SOP、WI不符3.12 检验时发现环境管理物质含量超出规定要求.3.4 材料不良 > 5% ( 以用量计算, 使用200PCS以上)3.13 生产线未经认证合格3.5 材料料号、规格与BOM不符 或混料 3.14 测试机台未经认证合格3.6 故障调机/无治具, 停电/停气/欠料/无排程3.15 相同线别连续送检五批有三批判退.3.7 SFIS 不能记录数据或记录错误.3.16 生产设备、治具、仪器、产品作业造成受损不能3.8 IPQC随线抽样 2H检到3PCS以上(含)不良品 使用或报废.3.9 量产时无正式SOP、WI . 3.17 重大质量问题发生, 部门经理级主管要求停线.3.10 整条生产线静电接地失效1.正常量产停线反馈: 2. 试产停线反馈:a.作业员立即反馈给班组长;a.工程师60分钟反馈给经理;b.班组长10分钟反馈给课长;b.经理10分钟反馈给协理;c.课长15分钟反馈给经理;d.经理60分钟反馈给协理;SMTDIP/TEST/PACK4.1 FPY % < 低于每季年度质量目标 2 个百分点 (2hr产出)5.1 ICT 良率 <96% (2hr产出)4.2 单站抛料率 > 2 % ( 用量500PCS以上)5.2 F/T良率 <97% (2hr产出)4.3 高速机抛料率 > 0.35 % ( 生产2H以上) 5.3 总检良率 < 97% (2hr产出)6.1 IPQC随线抽检 2H检到 2PCS不良品. 6.6 1hr内有6pcs相同不良现象6.2 一天内有3PCS报废6.7 检验发现良品中混有不良品.6.3 材料不良 > 2% ( 以用量计算, 使用200PCS以上) 6.8 正式WI上机种、PCB版本、料号、位置、用量、规格…….6.4 A 级材料来料短缺、损件> 1PCS ;写错.B 、C 级材料来料短缺 > 10PCS6.9 重大质量问题发生, 部门经理级主管要求发出异常给责任单位改善.6.5 测试治具不稳定,造成同一站别>5%误测 ( 产出100PCS以上)1当生产制程达到异常或停线标准时, 制造负责主管就主动发异常或停线处理, 如未执行者,品管及其它单位发出之异常单, 制造须提出长期对策回复 .2客户对其产品的质量要求提出异常及停线标准及时效, 按客人的标准及时效执行, 客户未定义的项目一律依本公司规定项目执行.3如分析为组件不良, 可在制程通过检测将不良品挑选出来 , 可继续生产 . 但不良材料不可再投入.4材料不良未达到异常部份, 请通知相关单位处理退料、换料、要求供应处理等, 无须发异常单.5试产发现的来料不良及首件不合格按以上标准执行, 其它异常在试产总结会检讨, 但试产各责任单位须在现场提出临时对策.注意事项停线反馈时间发出异常通知单制程异常及停线标准各站达异常标准项目共同达异常标准项目各站达停线标准项目共同达停线标准项目异 常 标 准 项 目发出停线通知单。



印刷电路板(P.C.B)制程的常见问题及解决方法
资料整理:袁斌
特别说明:本教程内容基本上来自己本人的工作经验总结及网站网友提供的技术援助,适用於PCB行业培训及各位PCB同行借鉴之用。
在此特别感谢。
对本资料有任何意见和建议请和本人联系。
联系方式:E_MAIL:******************&*******************
目录:
(一)图形转移工艺 (2)
(二)线路油墨工艺 (4)
(三)感光绿油工艺 (5)
(四)碳膜工艺 (7)
(五)银浆贯孔工艺 (8)
(六)沉铜(PTH)工艺 (9)
(七)电铜工艺 (11)
(八)电镍工艺 (12)
(九)电金工艺 (13)
(十)电锡工艺 (14)
(十一)蚀刻工艺 (15)
(十二)有机保焊膜工艺 (15)
(十三)喷锡(热风整平)艺 (16)
(十四)压合工艺 (17)
(十五)图形转移工艺流程及原理 (20)
(十六)图形转移过程的控制 (24)
(十七)破孔问题的探讨 (28)
(十八)软性电路板基础 (33)
(十九)渗镀问题的解决方法 (38)。
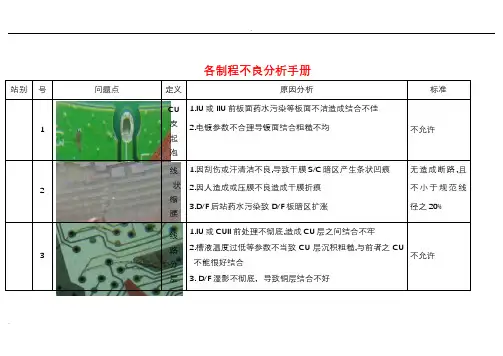
各制程不良分析手册站别号问题点定义原因分析标准1 CU皮起泡1.IU或IIU前板面药水污染等板面不洁造成结合不佳2.电镀参数不合理导镀面结合粗糙不均不允许2 线状缩腰1.因刮伤或汗清洁不良,导致干膜S/C暗区产生条状凹痕2.因人造成或压膜不良造成干膜折痕3.D/F后站药水污染致D/F板暗区扩涨无造成断路,且不小于规范线径之20%3 线路分层1.IU或CUII前处理不彻底,造成CU层之间结合不牢2.槽液温度过低等参数不当致CU层沉积粗糙,与前者之CU不能很好结合3. D/F湿影不彻底,导致铜层结合不好不允许.4 蚀刻不尽1.蚀刻参数未管控好2.流锡或剥膜不尽3.IU或IIU前干膜掉落(刮落或与板面结合不牢)4.干膜前板面沾胶线路间不超过规范线径之20%,且未造成短路电镀5线路分层1.IU或CUII前处理不彻底,造成CU面结合不牢2.槽液温度过低等参数不当致CU层沉积粗糙,与前者之CU不能很好结合3.D/F湿影不彻底,导致铜层结合不好不允许6脏点短路1.干膜底片未清洁净,导致其明区沾污部分未被曝光固化,即此线距部分会被镀上CU及sn/pb而造成短路不允许.7 CU面凹陷1.基材本身有针点凹陷不良(检查基板表面)2.压合时CU皮表面沾尘或PP质量不良造成压合后此瑕玼3.电镀铜时因槽液特别是光泽剂不正常导致CU积不良。
(2.3.可通过做切片观查,以作为参考)A手指不允许,板面每点不大于20mil,不超过板厚的1/58 CU面残缺1.D/F沾膜,撕膜不净,导致蚀刻时被蚀掉2.板面沾胶或沾药水导致CU面无锡层保护层3.电镀部分喷嘴坏损造成局部过蚀4.板面镀锡层被刮伤大铜面每点不大于20mil,每面只允许1点,其它地方不允许电镀9 短路1.干膜S/C未清洁净,致其明区沾污部分未被曝光固化,即此线距部分会被镀上CU及sn/pb而造成短路2.外层干膜刮伤,导致镀上锡层而造成短路不允许.加工10孔内塞SN1.喷锡时风刀塞SN,浸锡时间不够等参作业参数不合理2.孔内有毛刺其它杂物造成孔塞3.L/Q塞墨孔内积墨或塞墨不良喷锡板导通孔塞锡不高出板面可允收;零件孔塞锡不允收;A手指附近15mm内导通孔塞锡不允收11孔边锡高1.喷锡前孔边CU面不洁,造成CU/SN结合力小于SN/PB内聚力2.前后风刀间距过大,,造成一面之锡被回吹3.风刀距轨道间距过大,风量扫锡整平力不够4.浸锡时间不足等参数不良锡厚40U″-1000 U″,且锡面上无毛尖状颗粒状突加12 锡面凹坑1.喷锡前CU不洁或CU面不平整2.锡铅不纯或空气内含有杂物3.风刀不良1.不影响焊锡性和锡厚(40U″-1000 U″).工13 板面树脂1.L/Q显影时绿油未彻底去除干净,致化A时药液沉积不上不允许14 A面花斑1.化A前CU面不洁2.NI槽NI含量不足等参数不合理;NI槽污染3.摇摆动作不到位不允许15 架锡桥1.喷锡前板面有不洁2.锡铅内或空气中含有杂质3.风刀不良不允许16 板面沾锡1.喷锡前因防焊漏印或CU面防焊被刮掉,致露出CU面,在此HAL时露CU部分被喷上锡线路上不允并列存在;大铜面每面不超过3个点,每点不大于10mil.加工17A手指针孔1.前站CU面有凹坑2.镀A时电流密度过大,致NI/A沉积时粗糙不平整3.镀A地槽液含量不当或受污染每点不超过10mil,每排不超过3个点,18A面手印1.化A前CU面不洁2.NI槽NI含量不足等参数不合理;NI槽污染3.摇摆动作不到位(此现象一般为手印所致)不允许19锡面锡高1.喷锡前板面有不洁2.锡铅内或空气中含有杂质3.风刀不良(此板有造成锡面粗糙)锡厚40U″-1000 U″,锡面不允许有颗粒状或毛尖20锡高不良1.喷锡前板面有不洁2.锡铅内或空气中含有杂质3.风刀不良锡厚40U″-1000 U″,锡面不允许有颗粒状或毛尖.加工21PAD锡高1.喷锡前板面有不洁2.喷锡时风压小/风刀间距不对等制作参数不佳锡厚40U″-1000 U″,锡面不允许有颗粒状或毛尖湿膜2防焊露CU1.棕片不良2.挡点偏移或过大3.印刷后碰及板面未干之油墨4.网版不洁致漏墨不良每点≤10mil,每面不超过3点23防焊异物1.印刷前板面有脏物2.板面沾干油墨每点≤10mil,每面不超过3点,且无明显色差.24 刮伤露铜1.印刷防焊后因人为操作不当造成板面之防焊被刮掉而露CU 每点≤10mil,每面不超过3点湿膜25织纹显露1.L/Q退洗时间长2.基板质量问题3.压合不良基材上无明显白点白斑,经热冲击试验不会造成分层起泡26板面积墨1.该处电镀镀铜较厚,致印刷时下墨不良2.刮刀不平整3.网版高度等参数不合理4.网版漏墨不均不会造成色为准27防焊侧蚀1.油墨质量不行2.显影槽液对CU漆界面处之油墨攻击过度3.防焊重工次数过多1.线路上不允许2.PAD边缘不超过10mil.湿膜28防焊侧蚀1.油墨质量不行2.显影槽液对CU漆界面处之油墨攻击过度3.防焊重工次数过多1.线路上不允许2.PAD边缘不超过10mil29孔边起泡1.有污染或前处理刷磨时水气未烤干2.孔边积墨致油墨较厚,致不能均一固化3.L/Q烘烤条件不当,热固化不均每点不超过3点,每点不超过10mil,3M撕胶防焊不脱落30板面漏印1. 印刷时因网版未清洁尽或网版脏点或干油墨致印一下2.刮刀不平整3.电镀镀铜不均4.设PIN不平致不能规范作业每点不超过3点,每点不超过10mil.31 板面脏污1.印防焊后因人为操作不当使防焊表面沾上油脂或其它物质不破坏防焊且不影响客户防焊颜色之要求湿膜32对偏阴影1.因棕片对偏致使沾在CU面上之防焊被曝光而不能被显影掉(PAD阴影)2.因印刷后静置时间过长或烘烤时间过长或烤箱未保养好造成(主要为孔边阴影)PAD阴影部分不超过本身宽度1/8,SMT允许1mil,光学点允许2mil33孔边露CU1.网版挡点偏移或过大或作业过程中有变形不良≤2mil34防焊阴影1.因棕片对偏致使沾在CU面上之防焊被曝光而不能被显影掉(PAD阴影)2.因印刷后静置时间过长或烘烤时间过长或烤箱未保养好造成(主要为孔边阴影)PAD阴影部分不超过本身宽度1/8,SMT允许1mil,光学点允许2mil.35 孔边起泡1.有污染或前处理刷磨时水气未烤干2.孔边积墨致油墨较厚,致不能均一固化3.L/Q烘烤条件不当,热固化不均每点不超过3点,每点不超过10mil,3M撕胶防焊不脱落湿膜36孔边起泡1.一般为印板过程中有滴到防白水等外物造成防焊色差每点不超过3点,每点不超过10mil,3M撕胶防焊不脱落37防焊起泡1.有污染或前处理刷磨时水气未烤干2.孔边积墨致油墨较厚,致不能均一固化3.L/Q烘烤条件不当,热固化不均每点不超过3点,每点不超过10mil,3M撕胶防焊不脱落.38 板面脏污1.一般为印板过程中有滴到防白水等外物造成防焊色差不允收39 孔内积墨1.印刷时刮刀压力过大,致下墨过大,挤入孔内2.如孔过小在作业中也易产生此不良3.以上为空网印刷时产生零件孔不允收;导通孔每面不超过3个孔;卡板A手指15mm内不允许;其它无明确定义文字40沾文字漆1.网版未调正导致印偏沾漆2.A/W文字划线条太靠近CU PAD3.网片破损不允许41文字印偏1.网版未调正2.PIN针套错或没套好3.定位PIN孔钻偏PAD部分不超过本身宽度1/8,SMT允许1mil.42 文字漏印1.制作中覆墨不良2.刮刀未研磨好不锋利3.印刷时用力不够不允许43 文字印反印刷时人为误操作导致套PIN套反不允许文字44文字印反印刷时人为误操作导致套PIN套反不允许45文字漏印1.制作中覆墨不良2.刮刀未研磨好不锋利3.印刷时用力不不允许.46 沾文字漆1.机台上有油墨沾在板面2.印刷手手上沾有油墨并反沾于板面3.网版有破洞造成感光膜脱落不允许47 文字积墨1.油墨粘度过小,下墨不均2.覆墨时间太长3.印刷架网高度过低以清晰可认为准文字48文字沾漆1.网版未调正导致印偏沾漆2.A/W文字划线条太靠近CU PAD3.网片破损不允许49文字漏印1.网版显影不尽或油墨太干致下墨不良2.覆墨不良或印板时用力不均3.刮刀不锋利不允许.50 文字阴影1.多次印刷或吸纸不当2.网版未抬起覆墨或网版反面有残墨3.板弯板翘PAD部分不超过本身宽度1/8,SMT允许1mil51 文字印倒1.套PIN套错误不允许5253文字52文字脱落1.油墨质量差,结合力不强2.烘烤时间或温度不当,致文字固化不够3.板面油烟等不洁物造成文字与板面结合力不强不允许.53 文字重影1.印刷时有多次重印2.网版未调正或上PIN不牢3.重印时上PIN偏移未与网版对正不允许54 文字印偏1.网版未调正2. PIN未套正3.PIN孔偏移PAD部分不超过本身宽度1/8,SMT允许1mil55 沾文字漆1.机台上沾有油漆或手上沾漆2.脏点沾漆或刮伤沾漆3.网板破损不允许.干膜56条状短路1.棕片上沾有条状杂物或贴膜前板面沾条状油污(此现象多为底片保护膜破损)2.贴膜或曝光后因人为操作不当将铜面干膜刮不允许57干膜脱落1.贴膜前板面沾油污/沾胶或其它杂物2.贴膜时压力/温度过小等不当致干膜与铜面结合不牢3. 贴膜或曝光后因人为操作不当将铜面干膜刮4.干膜自身附著力不好不允许58条状短路1.棕片上沾有条状杂物或贴膜前板面沾条状油污2.贴膜或曝光后因人为操作不当将铜面干膜刮伤不允许59点状短路1.棕片上沾有点状杂物或贴膜前板面沾点状油污2.贴膜或曝光后因人为操作不当将铜面干膜刮伤不允许.干膜站60干膜膜破1.干膜韧性不足,较脆2.CU板板面杂物或巴厘过高3.贴膜后静置时间过长,曝光能量太低4.显影、水洗喷压过大或显影速度过慢不允许61板面沾污1.板面沾胶/沾油垢等不良物不允许62干膜脱落1.干膜挈性不足,较脆2.CU板板面杂物或巴厘过高3.贴膜后静置时间过长或显影速度过慢不允许.63 干膜沾膜1.棕片之暗区被刮伤2.显影不尽或显影时残膜反沾大铜每面不超过2个点,每点小于10mil,其它部位不允收干膜站64线路突出1.贴膜后沾有脏点或底片上沾有脏点2.操作刮伤干膜不超过原稿线径的20%65干膜断路1.底片之暗区被刮伤2.显影不尽或显影时残膜反沾不允许.66 干膜短路1.棕片上沾有点状杂物或贴膜前板面沾点状油污2.贴膜或曝光后因人为操作不当将铜面干膜刮伤不允许67 干膜对偏1.干膜站对底片时未保证孔环之ring各方向宽度相等(前提为孔正),2.板子或底片有涨缩零件孔余环≥2mil,导通孔孔偏不超过孔环的1/4,且与线路相连处不小于2mil干膜站68撕膜不尽1.割膜不良致撕膜时未能整块撕起2.撕膜时起膜位置不对成型线以内不允许.69 NPTH孔膜破1.钻孔后巴厘处理不彻底,即巴厘高2.干膜封孔能力不够3.跨孔过大4.干膜静置时间过长或显影时冲压过大不允收70 干膜脱落1.贴膜前板面沾油污/沾胶或其它杂物2.贴膜时压力/温度过小等不当致干膜与铜面结合不牢3.贴膜或曝光后因人为操作不当将铜面干膜刮4.干膜附著力不好不允许71 板面油污1.贴膜以前,因设备漏油或人为操作不当,致使油污直接或间接沾污板面不允许.成型站72模具冲偏1.板弯板曲或吹气过大或人为操作不当致板子未套好PIN孔时模冲造成不允许73槽孔捞偏1.定位PIN栽斜2.程式有错误超客户公差不允许74模冲伤孔1.套PIN套偏2.模具弹力胶不平衡3.板材涨缩或PIN针偏大不允许75斜边金丝1.铣刀不利或下刀点过于靠刀边2.因设备或人为调试不当致铣刀抖动较大3.斜板行进时用力不平衡不允许.成型站76V-CUT过穿1.调刀过深或铣刀不水平2.过板时叠板所致3.板弯板曲或V-CUT刀具运转不稳不允许77V-CUT过反1.未按进料方向放板过V-CUT2.程式错误不允许78V-CUT伤铜1. V-CUT两边挡板不平行2.板子外型有偏差3. V-CUT间距过小4. V-CUT刀角度偏大或刀片磨损过重不允收.79 V-CUT过穿1.调刀过深或铣刀不水平2.过板时叠板所致3.板弯板曲或V-CUT刀具运转不稳不允许成型站80V-CUT冲反1.未按磨具进料方向入板2.S/C面设计相似,识别有误3.模具未设防呆PIN不允收81V-CUT毛屑1. V-CUT在要求范围内调试2.客户外形公差小,且槽口偏小3.刀片角度过大或刀口不锋利按客户要求有不同.82 V-CUT伤铜1. V-CUT两边挡板不平行2.板子外型有偏差3. V-CUT间距过小4. V-CUT刀角度偏大或刀片磨损过重不允收83 模具冲偏1.板弯板曲或吹气过大或人为操作不当致板子未套好PIN孔时模冲造成不允许成型站84斜边不齐1.板弯板曲/斜边台面不平2.斜边行进时用力平均3.斜边不锋利/铣刀运转时稳定性不佳不允收.85 断导线1.铣刀不锋利或下刀点太靠刀边不允收86 织纹显露1.PP之玻璃布间距过大/TG点不稳定等PP品质不良2.压合时参数不当致流胶过大3.L/Q重工时退洗时间过长,导致药水对树脂攻击严重,显露出玻织布基材上无明显白点白斑,经热冲击试验不会造成分层起泡87 靶孔偏1.D/F对S/C时对偏2.钻靶时钻偏无线路土3mil,有线路土2.5mil.钻孔站88钻孔孔偏1.钻孔资料有误2.钻机精度不够(超出土3mil)或机台有故障3.叠板数超规范或钻头质太差土3mil 89多钻孔1.程式有误不允收90孔烧焦1.钻孔速度过快2.钻头排屑不良或钻针设定过深3.断半针作业或spindle掉刀不允许91光学点残1.干膜沾膜2.电镀过蚀3.人为刮伤不允收.品检站91A手指氧化1.镀A时A槽药水浓度不当或有槽液污染,或水洗不尽2.转运和生产作业时手接触污染3.不以收92锡面凹坑1.喷锡前CU不洁或CU面不平整2.锡铅不纯或空气内含有杂物3.风刀不良1.不影响焊性及锡厚为为准93线路断路1.D/F棕片刮伤,即暗区部分线路被固化,蚀刻时被蚀掉2.操作中锡铅被刮全伤,CU线路无保护层3.镀锡铅前CU线路处有油污或沾胶不允许.94 线路断路1.D/F棕片刮伤,即暗区部分线路被固化,蚀刻时被蚀掉2.操作中锡铅被刮全伤,CU线路无保护层3.镀锡铅前CU线路处有油污或沾胶不允许品检站95A面发白1.化A前处理微蚀过度2.因化NI后水洗不洁或A槽槽液非正常导致A厚不足无明色差且A厚在管控范围96A手指刮伤1.因人为操作不当造成镀A前或镀A后A手指上之刮痕不造成露NI,不超过3根,无明显刮痕.97 刮伤露铜1.防焊印刷后,人为操作不当将板面之防焊刮掉每点不超过3点,每点不超过10mil98 条状针点1.此为较有规律的直条状,应与机器设备之规律性运转有关2.D/F磨刷时板面被沾有油脂或点状胶类物3.D/F显影影时有去膜不尽或有不浴物附于板面每PCS不超过3点,每点不超过10mil,厚度不超过1/5板厚品检站99CU面凹陷1.基材本身有针点凹陷不良(检查基板表面)2.压合时CU皮表面沾尘或PP质量不良造成压合后此瑕玼3.电镀铜时因槽液特别是光泽剂不正常导致CU积不良A手指不允许,每面少于3点,每点不大于20mil,不超过板厚的1/5100板面沾锡1.喷锡前因防焊漏印或CU面防焊被刮掉,致露出CU面,在HAL时露CU部分被喷上锡线路上不允并列存在;大铜面每面不超过3个点,每点不大于10mil.101 CU面花班1.此为防焊之后之花班2.防焊之前CU有沾胶或油脂等物污染3.因防焊本身品质不良造成显影溶解时局部不尽4.因退洗不尽重工或显影时未冲洗净致有药水水痕不允许102 SN手指刮伤1.此锡手指刮伤处有喷上锡,另此为明显人为造成2.为喷锡前因人为操作不当导致锡手指被刮掉部分不允收品检站103电镀针点1.此仅指电镀本站造成之此不良2.镀铜时槽液有机污染或金属污染致CU2+沉积不均3.光泽剂中之carrier不足或过量4.电镀前处理CU面未处理净A手指不允许;大铜面每面少于3点,每点不大于20mil,不超过板厚的1/5.104 线细1.干膜曝光时赶气不到位或吸真空不足或曝光能量不足不均导致S/C线复制线在干膜板时比原稿小且小于标准2.显影过度或走蚀刻时因速度过慢或槽液管控不当导蚀刻出之线路小于原稿之20%不于原稿之20%105 板面沾锡1.喷锡前因防焊漏印或CU面防焊被刮掉,致露出CU面,在HAL时露CU部分被喷上锡线路上不允并列存在;大铜面每面不超过3个点,每点不大于10mil106 板损1.在生产过程中或板料转运中因人员操作不当导致板子有碰到机器或地面,造成板子局部破损不允收.品检站107板面CU瘤1.D/P活化/去脂平整或微蚀槽液受有机或金属污染2.电镀铜槽添加剂不当或阳极有破损导致金属污染不允收108电镀铜残1.因撕膜不尽或板面油脂/沾胶等造成D/F后该处未镀上CU与锡铅保护层,蚀刻时被蚀掉2.镀锡铅后因锡铅氧化或锡铅刮伤致蚀刻时被掉大铜面每点不大于20mil,每面只允许1点,其它地方不允许109线路断路1.D/F棕片刮伤,即暗区部分线路被固化,蚀刻时被蚀掉2.操作中锡铅被刮全伤,CU线路无保护层3.镀锡铅前CU线路处有油污或沾胶时每刻不允许110防焊刮伤1.印刷防焊后因人为操作不当造成板面之防焊被刮伤不允收.品检站111A手指刮伤1.因人为操作不当造成镀A前或镀A后A手指上之刮痕不造成露NI,不超过3根,无明显刮痕112A面花斑1.化A前CU面不洁2.NI槽NI含量不足等参数不合理;NI槽污染3.摇摆动作不到位不允收113板面上金1.因前站防焊脱落,导致后续走化A时化上A/NI2.走A线前处理磨刷过重致防焊有被刷掉不允收.114 A氧化1.化A时A槽药水浓度不当或有槽液污染,或水洗不尽2.转运和生产作业时手接触污染不允收.。

PCB板DES制程中的短路缺陷分析与改善作者:顾亚东来源:《科技视界》2019年第16期【摘要】DES(显影蚀刻去膜)是PCB生产过程当中非常重要的制程。
生产中,质检部门经常检测到PCB板存在DES制程缺陷造成的线路短路问题,直接关系到生产成本的增加,也关系到成品合格率。
蚀刻后短路的问题,可能造成产线的品质恶化、进度延误,甚至影响出货。
本文将分析讨论DES制程中短路缺陷的原因,找出不同的因素来进行过程改善,并展示改善后的结果,包括采取长期措施进行预防。
期望在现有的各种生产条件中寻找出最合适的制程控制方法,对DES的短路缺陷进行长期稳定的控制。
【关键词】PCB板;DES制程;短路缺陷;缺陷分析;工艺改进中图分类号: TG356.55 文献标识码: A 文章编号: 2095-2457(2019)16-0053-003DOI:10.19694/ki.issn2095-2457.2019.16.0240 引言PCB生产的DES制程中会有很多缺陷产生,常见的有如下几点:DES蚀刻后造成的PCB板面划伤,蚀刻后的线路被外界因素强制造成损伤。
该缺陷会使PCB 线路开路或者扭曲,导致信号中断。
所以在日常设备维护的时候,对滚轮的状况、收放板机的机器要定期检查调整。
DES制程后PCB板还会有短路问题,同样会造成PCB板报废。
一般是由DES显影段的干膜残渣,蚀刻段的滚轮污染,药水浓度的变化,参数的不稳定等因素导致的。
1 DES工艺的介绍DES工艺的目的是将前工序所做出的有图形的线路板上未受保护的非导体部分铜蚀刻去,形成线路。
DES工艺中,D为显影(Develop),E为蚀刻(Etching),S为去膜(Strip)。
1.1 DES工艺中的显影显影的目的是将未发生聚合反应的区域用显影药水将其冲洗掉,曝光已感光部分则因已发生聚合反应而洗不掉,仍留在铜面上成为蚀刻阻剂膜。
在显影中只有水溶性的干膜才可以进行显影。
显影槽中采用软化水和碳酸钾配制槽液。
SMT制程常见异常分析SMT制程(表面贴装技术)是一种在电子元件制造中常用的制程技术,用于将电子元件贴装在印刷电路板(PCB)上。
然而,在SMT制程中,常会出现一些异常情况,如焊接不良、元件丢失等问题。
本文将针对SMT制程常见的异常进行分析。
1.焊接不良:焊接不良是SMT制程中常见的问题之一、焊接不良可能由于锡膏的质量问题、焊垫的尺寸偏差、焊接设备的操作不当等原因引起。
常见的焊接不良有焊接剪切、焊锡球、云母等问题。
焊接不良会导致元件与PCB之间的电连接不良,影响产品的性能和可靠性。
2.元件丢失:元件丢失是SMT制程常见的问题之一、元件丢失可能由于操作不当、元件自身缺陷、供应链问题等原因引起。
元件丢失会导致产品的功能性能下降,严重的情况下可能导致产品不能正常工作。
3.印刷问题:印刷问题是SMT制程中常见的问题之一、印刷问题可能由于锡膏的质量问题、印刷设备的操作不当、PCB的表面不平整等原因引起。
常见的印刷问题有锡膏剪切、印刷偏移、印刷污染等问题。
印刷问题会导致焊接质量不良,影响产品的性能和可靠性。
4.质量控制问题:质量控制问题是SMT制程中常见的问题之一、质量控制问题可能由于生产过程中缺乏足够的质量控制措施、操作工人技术水平不足、设备维护不良等原因引起。
质量控制问题会导致产品的性能和可靠性不稳定,严重的情况下可能导致产品不合格。
针对SMT制程常见的异常,可以采取以下措施进行分析和解决:1.异常分析:对于出现的异常情况,首先要进行详细的分析,排查出具体的原因。
可以通过观察异常的形态特征、分析生产过程中的操作记录、检查原材料的质量等方式进行分析。
2.数据收集:在SMT制程中可以采集相关的数据,如焊接温度、湿度、气压等参数,以及生产过程中的记录。
这些数据可以用于分析异常情况的原因,帮助找出潜在的问题。
3.过程优化:针对分析结果,可以进行制程的优化。
例如,对于焊接不良问题,可以优化焊接设备的参数,选择质量更好的焊接材料,加强操作工人的培训等。
PCB制程管控及审核重点PCB(Printed Circuit Board,印制电路板)作为电子设备的核心组件之一,其质量和性能直接影响着整个电子系统的稳定性和可靠性。
在 PCB 的生产过程中,制程管控和审核是确保产品质量的关键环节。
本文将详细探讨 PCB 制程管控及审核的重点,以帮助相关从业者更好地理解和把握这一重要领域。
一、PCB 制程管控的重要性PCB 制程管控旨在确保每个生产步骤都按照预定的规范和标准进行,从而生产出符合设计要求和质量标准的 PCB 产品。
有效的制程管控可以:1、提高产品质量:通过对各个制程环节的严格监控和控制,减少缺陷和误差的产生,提高 PCB 的成品率和可靠性。
2、降低生产成本:减少废品和返工,优化生产流程,提高生产效率,从而降低生产成本。
3、满足客户需求:确保 PCB 产品能够满足客户对性能、规格和交货期等方面的要求,提高客户满意度。
4、增强企业竞争力:优质的 PCB 产品有助于企业在市场竞争中脱颖而出,赢得更多的订单和市场份额。
二、PCB 制程管控的主要环节1、原材料管控覆铜板选择:根据 PCB 的性能要求和使用环境,选择合适的覆铜板类型(如 FR-4、铝基板等)、厚度和材质。
阻焊剂和油墨:确保阻焊剂和油墨的质量、颜色和耐腐蚀性符合要求。
化学药水:对蚀刻液、电镀液等化学药水进行定期检测和分析,保证其浓度和成分稳定。
2、内层制作图形转移:采用光刻或激光直接成像等技术,确保内层线路图形的精度和准确性。
蚀刻:控制蚀刻速度和蚀刻因子,避免过蚀或欠蚀,保证线路的线宽和间距符合设计要求。
内层检验:对内层线路进行自动光学检测(AOI)和人工目检,及时发现和修复缺陷。
3、压合层压参数:控制层压温度、压力和时间等参数,确保各层之间的结合力和平整度。
半固化片:选择合适的半固化片类型和厚度,保证 PCB 的厚度和介电性能。
压合后检验:检查压合后的 PCB 是否存在分层、气泡等缺陷。
4、钻孔钻孔参数:根据 PCB 的板厚、孔径和孔数等因素,设置合适的钻孔速度、转速和进刀量。
电路板制作常见的问题及改善方法Document number:NOCG-YUNOO-BUYTT-UU986-1986UT一、前言什么叫PCB,PCB是电路板的英文缩写,什么叫FPC,FPC是绕性电路板(柔性电路板)的英文缩写,以下是电路板的发展史和目前我司所生产的电路板常见的不良问题、问题原因分析和解决方法.在此与大家一起分享,在此希望能帮到你,能让你的技能得到提升!二:PCB发展史1.早於1903年首创利用“线路”(Circuit)观念应用於电话交换机系统。
它是用金属箔予以切割成线路导体,将之黏着於石蜡纸上,上面同样贴上一层石蜡纸,成了现今PCB的机构雏型。
2.至1936年,DrPaulEisner真正发明了PCB的制作技术,也发表多项专利。
而今日之print-etch(photoimagetransfer)的技术,就是沿袭其发明而来的。
三、PCB种类1、以材质分:1)有机材质:酚醛树脂、玻璃纤维、环氧树脂、聚酰亚胺等2)无机材质:铝、陶瓷,无胶等皆属之。
主要起散热功能2、以成品软硬区分1)硬板RigidPCB2)软板FlexiblePCB3)软硬板Rigid-FlexPCB3:电路板结构:、单面板B、双面板C、多层板2:依用途分:通信/耗用性电子/军用/电脑/半导体/电测板/汽车....等产品领域4:PCB生产工艺流程简介1、双面喷锡板正片简易生产工艺流程图工程开料图开料磨边/倒角叠板钻孔QC检验沉铜板电QC检验涂布湿墨/干膜图电退膜/墨蚀刻EQC检验裸测绿油印字符喷锡成型/CNC外形成测FQCFQA包装入库出货以上只是其中一个工艺流程,不同的工艺要求,就出现不同的工艺制作流程四:钻孔制程目的单面或双面板的制作都是在下料之后直接进行非导通孔或导通孔的钻孔,多层板则是在完成压板之后才去钻孔。
传统孔的种类除以导通与否简单的区分外,以功能的不同尚可分:零件孔,工具孔,通孔(Via),盲孔(Blindhole),埋孔(Buriedhole)(后二者亦为viahole的一种).近年电子产品\'轻.薄.短.小.快.\'的发展趋势,使得钻孔技术一日千里,机钻,雷射烧孔,感光成孔等.流程:上PIN→钻孔→检查全流程线路板厂,都会有钻孔这麽一道工序。
PCB技术:溢胶分析及改善前言气泡和溢胶是FPC压合工艺流程中一种比较普遍旳品质异常现象。
本人就在FPC厂做工艺流程时所遇到旳问题,结合台虹材料特性,就溢胶这一现象做某些探讨,分析溢胶旳因素及提出某些解决问题旳措施。
一、一方面,我们来理解一下什么是溢胶溢胶指旳是在压合流程中,温度升高而使得COVERLAY中胶系流动,从而导致在FPC线路PAD位上产生形同EXPORY系列旳胶渍问题。
二、我们来讨论一下溢胶产生旳因素溢胶产生旳因素有诸多种,和保护膜(COVERLAY)旳加工工艺流程有关;与FPC厂工艺制程工艺参数、保存环境、员工旳操作方式等均有关系。
下面,从具体旳因素来加以讨论:1. 产生溢胶旳具体因素之一:由COVERLAY制造过程中旳参数所决定。
当CL经涂布(COATING)后进于烘干阶段,如果温度、时间等参数控制不当,就会导致胶系在半固化过程中流量过大。
此外,如果CL胶系涂布时分布不均匀,在压合过程中,很难控制溢胶量。
当此类产品出货到客户手中,在来料检查时溢胶量会明显高于产品规格书上旳批示值。
2. 产生溢胶旳具体因素之二:COVERLAY溢胶与寄存环境有关。
目前,台虹COVERLAY旳保存条件是10℃如下,最佳保存温度是0℃-5℃,保存时间是90天。
如果超过保存时间或保存条件达不到规定,COVERLAY容易在空气中吸潮而导致胶系不稳定,很容易产生溢胶。
3. 产生溢胶旳具体因素之三:客户产品构造搭配与否合理是构成溢胶现象旳一种重要因素。
在产品设计过程中,FCCL和CL旳搭配要尽量旳合理。
如果COVERLAY胶系厚度与基材铜箔厚度相距较大,那么极有也许浮现溢胶现象。
应当从源头上避免FPC构造搭配旳失误。
4. 产生溢胶旳具体因素之四:客户FPC成品旳特殊设计也会导致局部溢胶。
随着高精密度产品浮现,在某些FPC产品中,设计了独立旳PAD位。
在压合升温过程中,因其周边没有空隙,PAD位越小溢胶现象更加明显。