离子注入工艺
- 格式:pptx
- 大小:555.67 KB
- 文档页数:2

离子注入工艺流程
《离子注入工艺流程》
离子注入工艺是一种将离子束束注入半导体器件中,改变器件性能的技术。
离子注入工艺可以增强器件的导电性、改变其电子结构、调节材料的性能等。
下面我们将介绍一下离子注入工艺的基本流程。
首先,器件准备。
在进行离子注入之前,需要准备好待处理的半导体器件。
这包括对器件进行清洁和表面处理,以确保离子能够完全渗透到材料内部。
接着是离子注入。
在离子注入设备中,通过高能离子束束注入到半导体器件中。
这一步需要严格控制离子束的能量、注入时间和深度,以确保离子能够准确地渗透到材料内部并达到预期的效果。
然后进行退火处理。
在离子注入完成后,通常需要对器件进行退火处理。
这是为了让离子束注入的材料重新排列,使其在晶格中形成更稳定的结构,并恢复器件的性能。
最后是器件测试。
经过以上步骤后,需要对器件进行测试,以确保离子注入工艺达到预期的效果。
这包括对器件的导电性能、电子结构等进行检测。
总的来说,离子注入工艺流程包括器件准备、离子注入、退火处理和器件测试。
通过严格控制这些步骤,离子注入工艺可以
有效地改善半导体器件的性能,为半导体工业的发展提供重要支持。
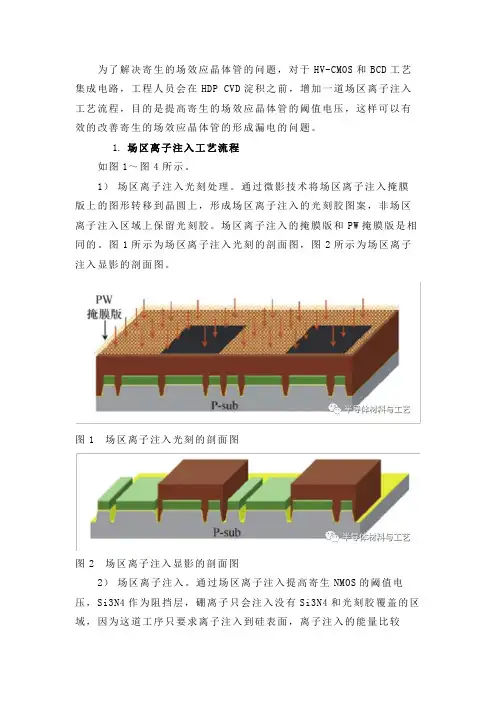
为了解决寄生的场效应晶体管的问题,对于HV-CMOS和BCD工艺集成电路,工程人员会在HDP CVD淀积之前,增加一道场区离子注入工艺流程,目的是提高寄生的场效应晶体管的阈值电压,这样可以有效的改善寄生的场效应晶体管的形成漏电的问题。
1.场区离子注入工艺流程如图1~图4所示。
1)场区离子注入光刻处理。
通过微影技术将场区离子注入掩膜版上的图形转移到晶圆上,形成场区离子注入的光刻胶图案,非场区离子注入区域上保留光刻胶。
场区离子注入的掩膜版和PW掩膜版是相同的。
图1所示为场区离子注入光刻的剖面图,图2所示为场区离子注入显影的剖面图。
图1 场区离子注入光刻的剖面图图2 场区离子注入显影的剖面图2)场区离子注入。
通过场区离子注入提高寄生NMOS的阈值电压,Si3N4作为阻挡层,硼离子只会注入没有Si3N4和光刻胶覆盖的区域,因为这道工序只要求离子注入到硅表面,离子注入的能量比较低,所以硼离子无法穿透Si3N4。
也可以把这道工序移到淀积HDP CVD 之后,不过离子注入的能量要非常高才能穿透很厚的STI氧化层。
图3所示为场区硼离子注入的剖面图。
3)去除光刻胶。
利用干法刻蚀和湿法刻蚀去除光刻胶。
图4所示为去除光刻胶后的剖面图。
4)淀积厚的SiO2层。
利用HDP CVD淀积一层很厚的SiO2层,厚度约4500~5500Å。
因为HDP CVD是用高密度的离子电浆轰击溅射刻蚀,防止CVD填充时洞口过早封闭,产生空洞现象,所以HDP CVD的阶覆盖率非常好,它可以有效地填充STI的空隙。
图4所示为淀积SiO2的剖面图。
图3 场区硼离子注入的剖面图图4 去除光刻胶的剖面图HDP CVD淀积SiO2后,后续的工艺步骤与正常的工艺流程是一样的。
利用STI隔离技术制造的集成电路也有几个需要注意的问题,第一个与沟槽上方的拐角有关,沟槽上方的拐角不能太尖,否则会造成沟槽侧壁反型,从而造成器件的亚阈值漏电流过大,因为在一个MOS管中,多晶硅栅会延伸到STI场氧化层上,以保证多晶硅栅可以完全控制源漏之间的沟道。




半导体制造技术–离子注入工艺1. 简介离子注入是一种常用的半导体制造技术,它通过将高能离子注入到半导体材料中,改变材料的物理和电学特性。
离子注入工艺在集成电路制造、光电技术和材料研究等领域具有重要应用。
2. 工艺过程离子注入工艺通常包括以下几个步骤:2.1 基片准备首先,需要对半导体基片进行准备。
这包括将基片清洗干净,并去除表面的杂质和氧化层。
基片的表面质量对离子注入的效果有很大影响,因此基片准备是非常关键的一步。
2.2 掩膜制备接下来,需要对基片进行掩膜制备。
掩膜是一层覆盖在基片表面的保护层,用于选择性地控制离子注入的位置和深度。
常用的掩膜材料包括光刻胶、金属掩膜和二氧化硅等。
掩膜的制备需要结合光刻技术和蚀刻工艺。
2.3 离子注入离子注入是离子注入工艺的核心步骤。
在离子注入过程中,会使用离子加速器将高能离子注入到基片中。
离子加速器通过电场加速离子,并通过磁场进行离子束的聚焦。
离子注入的能量和剂量可以通过调整加速电压和注入时间等参数来控制。
2.4 后处理注入完成后,需要进行后处理步骤。
后处理通常包括退火、清洗和测量等。
退火可以恢复晶格的完整性和排除晶格缺陷,以提高器件的性能和可靠性。
清洗过程用于去除残留的掩膜和杂质。
测量步骤则用于检验注入效果和性能。
3. 应用领域离子注入工艺在半导体制造和研发中具有广泛的应用。
以下是离子注入工艺在不同领域的主要应用:3.1 VLSI集成电路制造离子注入在VLSI(超大规模集成电路)的制造过程中起着至关重要的作用。
通过注入不同类型的离子,可以改变材料的导电性能,实现不同功能的晶体管和电路元器件。
3.2 光电技术离子注入工艺在光电技术中也有广泛应用。
例如,对硅材料进行离子注入可以产生不同的光电特性,用于制造太阳能电池、光电探测器和光纤等器件。
3.3 材料研究离子注入工艺在材料研究中也扮演着重要角色。
通过注入离子,可以改变材料的物理性质,例如硬度、磁性和光学特性。
这对于研究新材料的性能和应用具有重要意义。



半导体离子注入工艺09电科A柯鹏程 0915221019离子注入法掺杂和扩散法掺杂对比来说,它的加工温度低、容易制作浅结、均匀的大面积注入杂质、易于自动化等优点。
当前,离子注入法已成为超大规模集成电路制造中不可缺少的掺杂工艺。
离子注入是一种将带点的且具有能量的粒子注入衬底硅的过程。
注入能量介于1eV到1MeV之间,注入深度平均可达10nm~10um。
相对扩散工艺,粒子注入的主要好处在于能更准确地控制杂质参杂、可重复性和较低的工艺温度。
1.离子注入原理:离子是原子或分子经过离子化后形成的,即等离子体,它带有一定量的电荷。
可通过电场对离子进行加速,利用磁场使其运动方向改变,这样就可以控制离子以一定的能量进入wafer内部达到掺杂的目的。
离子注入到wafer中后,会与硅原子碰撞而损失能量,能量耗尽离子就会停在wafer中某位置。
离子通过与硅原子的碰撞将能量传递给硅原子,使得硅原子成为新的入射粒子,新入射离子又会与其它硅原子碰撞,形成连锁反应。
杂质在wafer中移动会产生一条晶格受损路径,损伤情况取决于杂质离子的轻重,这使硅原子离开格点位置,形成点缺陷,甚至导致衬底由晶体结构变为非晶体结构。
2.离子射程离子射程就是注入时,离子进入wafer内部后,从表面到停止所经过的路程。
入射离子能量越高,射程就会越长。
投影射程是离子注入wafer内部的深度,它取决于离子的质量、能量,wafer的质量以及离子入射方向与晶向之间的关系。
有的离子射程远,有的射程近,而有的离子还会发生横向移动,综合所有的离子运动,就产生了投影偏差。
3.离子注入剂量注入剂量是单位面积wafer表面注入的离子数,可通过下面的公式计算得出 Q=It/enA ,式中,Q是剂量;I是束流,单位是安培;t是注入时间,单位是秒;e是电子电荷,1.6×10-19C;n是电荷数量;A是注入面积,单位是。
4.离子注入工艺(1)沟道效应入射离子与wafer之间有不同的相互作用方式,若离子能量够高,则多数被注入到wafer内部;反之,则大部分离子被反射而远离wafer。

半导体制造技术离子注入工艺引言离子注入是半导体制造过程中最重要的工艺之一。
通过将离子束注入半导体材料中,可以改变材料的电学性质,从而实现半导体器件的功能。
本文将介绍离子注入工艺的基本原理、设备和应用。
基本原理离子注入是指利用离子束将离子注入到半导体材料中的过程。
离子束由带电粒子组成,通过加速器将离子加速到高能量,然后用磁场聚焦,最后将离子束束缚在一个小区域内,以控制离子注入的位置和剂量。
离子注入可以改变半导体材料的晶格结构、掺杂杂质、形成浅局域态等。
设备离子注入设备包括加速器、磁束控制装置和探针台。
加速器用于将离子加速到高能量,常见的加速器有静电加速器和电场加速器。
磁束控制装置用于聚焦离子束,以控制离子注入的位置和剂量。
探针台是将待处理的半导体材料固定在上面,保证离子束和材料之间的相对位置不变。
工艺步骤离子注入工艺通常包含以下步骤:1.准备材料:将待处理的半导体材料进行清洗和处理,以去除表面的污染物和氧化层。
2.装载材料:将准备好的材料装载到探针台上,并确保其位置准确。
3.设定参数:根据需要控制离子注入的剂量和能量,设定加速器和磁束控制装置的参数。
4.进行离子注入:打开加速器和磁束控制装置,使离子束注入到半导体材料中。
5.处理后续步骤:在离子注入完成后,需要进行后续的退火、清洁等处理,以恢复材料的结构和性能。
应用离子注入工艺在半导体制造中有广泛的应用,主要用于以下方面:1.控制器件电学性能:通过控制离子注入的剂量和能量,可以调节半导体材料的电学性能,如掺杂杂质、形成浅局域态等,从而实现不同类型的器件。
2.修复晶格缺陷:通过离子注入可以填补晶格的缺陷,提高材料的结构完整性和稳定性。
3.改进材料外延:离子注入可以用于改善材料的外延生长,提高材料的质量和晶体结构。
4.实现器件叠层结构:利用离子注入可以在半导体材料中形成多种不同材料的层状结构,以实现多层器件的集成。
结论离子注入工艺是半导体制造中不可或缺的技术,通过控制离子束的注入位置、剂量和能量,可以改变材料的电学性质,实现不同类型的功能器件。

离子注入工艺,靶材料
离子注入工艺是一种将离子束加速并注入到固体材料中的技术,用于改变材料的物理、化学和电学性质。
在离子注入工艺中,靶材料是被注入离子的固体材料。
靶材料可以是各种类型的半导体、金属、陶瓷或其他材料。
选择靶材料的类型取决于具体的应用和所需的改性效果。
对于半导体行业,常用的靶材料包括硅、锗、砷化镓等。
离子注入可以用于改变半导体的导电性、掺杂浓度、阈值电压等性质,以实现器件性能的调控。
在金属材料领域,离子注入可以用于改善材料的硬度、耐磨性、耐腐蚀性等性质。
靶材料可以是钢、铝、钛等金属。
在陶瓷材料方面,离子注入可以用于改变陶瓷的光学、电学和机械性能。
靶材料可以是氧化铝、氮化硅等陶瓷材料。
除了上述材料,还有许多其他类型的靶材料可以用于离子注入工艺,具体选择取决于应用需求和目标性质的改变。
需要注意的是,离子注入工艺是一种高精度的技术,需要在专业的实验环境中进行,以确保注入离子的准确性和均匀性。
半导体工艺--离子注入离子注入法掺杂相比扩散法掺杂来说,它的加工温度低、容易制作浅结、均匀的大面积注入杂质、易于自动化等优点。
目前,离子注入法已成为超大规模集成电路制造中不可缺少的掺杂工艺。
1.离子注入原理离子是原子或分子经过离子化后形成的,即等离子体,它带有一定量的电荷。
可通过电场对离子进行加速,利用磁场使其运动方向改变,这样就可以控制离子以一定的能量进入wafer内部达到掺杂的目的。
离子注入到wafer中后,会与硅原子碰撞而损失能量,能量耗尽离子就会停在wafer中某位置。
离子通过与硅原子的碰撞将能量传递给硅原子,使得硅原子成为新的入射粒子,新入射离子又会与其它硅原子碰撞,形成连锁反应。
杂质在wafer中移动会产生一条晶格受损路径,损伤情况取决于杂质离子的轻重,这使硅原子离开格点位置,形成点缺陷,甚至导致衬底由晶体结构变为非晶体结构。
2.离子射程离子射程就是注入时,离子进入wafer内部后,从表面到停止所经过的路程。
入射离子能量越高,射程就会越长。
投影射程是离子注入wafer内部的深度,它取决于离子的质量、能量,wafer的质量以及离子入射方向与晶向之间的关系。
有的离子射程远,有的射程近,而有的离子还会发生横向移动,综合所有的离子运动,就产生了投影偏差。
3.离子注入剂量注入剂量是单位面积wafer表面注入的离子数,可通过下面的公式计算得出,式中,Q是剂量;I是束流,单位是安培;t是注入时间,单位是秒;e是电子电荷,1.6×10-19C;n是电荷数量;A是注入面积,单位是。
4.离子注入设备离子注入机体积庞大,结构非常复杂。
根据它所能提供的离子束流大小和能量可分为高电流和中电流离子注入机以及高能量、中能量和低能量离子注入机。
离子注入机的主要部件有:离子源、质量分析器、加速器、聚焦器、扫描系统以及工艺室等。
(1)离子源离子源的任务是提供所需的杂质离子。
在合适的气压下,使含有杂质的气体受到电子碰撞而电离,最常用的杂质源有和等,(2)离子束吸取电极吸取电极将离子源产生的离子收集起来形成离子束。
半导体工艺之沉积和离子注入工艺(半导体)(芯片)由许多比指甲盖还小、比纸还薄的微观层(layer)组成。
半导体堆叠得又高又实,形成类似于高层建筑的复杂结构。
为了形成这种结构,需要多次重复以下步骤:光刻--在单晶硅(single- crystal silicon,半导体的原材料)晶圆的顶部涂覆薄膜(thin film)并绘制电路,刻蚀--选择性地去除不必要的材料,然后清洗表面杂质。
在刻蚀和清洗过程之后,薄膜起到分割、连接和(保护电路)的作用。
接下来,我们将介绍制造薄膜的沉积工艺和赋予半导体电性能的离子注入工艺。
沉积工艺:给晶圆“涂”上薄膜术语“薄膜”是指1微米(μm)或更薄的薄膜,这种厚度无法通过简单的(机械)加工达到。
沉积是指将所需分子或原子水平的薄膜涂覆到晶圆上的一系列工艺。
由于薄膜非常薄,因此需要精确的技术将薄膜均匀地涂覆到晶圆上。
沉积后的半导体结构沉积大致可分为两种类型。
这两种类型是物理气相沉积(PVD, physical vapor deposition)和化学气相沉积(CVD, chemical vapor deposition)。
物理气相沉积主要用于沉积(金属膜),不伴有化学反应。
而化学气相沉积涉及将外部能量施加到由气体化学反应形成的颗粒蒸气中,蒸汽被喷射到表面进行沉积。
这种技术可用于将薄膜沉积到导体、绝缘体和半导体上。
化学气相沉积是当前半导体工艺中使用最广泛的沉积方法。
化学气相沉积可进一步分为热化学气相沉积(thermal CVD)、等离子体化学气相沉积(plasma CVD)和光诱导化学气相沉积(photo-induced CVD),具体取决于所使用的外部能源。
其中,等离子体化学气相沉积应用最广泛,因为它能够在低温下形成薄膜,调节薄膜厚度的均匀性,并处理大容量。
通过沉积过程形成的薄膜有两层:金属(导电)层,用于连接电路之间的电信号,以及绝缘层,用于电隔离内部连接层或防止污染物进入。
半导体工艺--离子注入离子注入法掺杂相比扩散法掺杂来说,它的加工温度低、容易制作浅结、均匀的大面积注入杂质、易于自动化等优点。
目前,离子注入法已成为超大规模集成电路制造中不可缺少的掺杂工艺。
1.离子注入原理离子是原子或分子经过离子化后形成的,即等离子体,它带有一定量的电荷。
可通过电场对离子进行加速,利用磁场使其运动方向改变,这样就可以控制离子以一定的能量进入wafer内部达到掺杂的目的。
离子注入到wafer中后,会与硅原子碰撞而损失能量,能量耗尽离子就会停在wafer中某位置。
离子通过与硅原子的碰撞将能量传递给硅原子,使得硅原子成为新的入射粒子,新入射离子又会与其它硅原子碰撞,形成连锁反应。
杂质在wafer中移动会产生一条晶格受损路径,损伤情况取决于杂质离子的轻重,这使硅原子离开格点位置,形成点缺陷,甚至导致衬底由晶体结构变为非晶体结构。
2.离子射程离子射程就是注入时,离子进入wafer内部后,从表面到停止所经过的路程。
入射离子能量越高,射程就会越长。
投影射程是离子注入wafer内部的深度,它取决于离子的质量、能量,wafer的质量以及离子入射方向与晶向之间的关系。
有的离子射程远,有的射程近,而有的离子还会发生横向移动,综合所有的离子运动,就产生了投影偏差。
3.离子注入剂量注入剂量是单位面积wafer表面注入的离子数,可通过下面的公式计算得出 ,式中,Q 是剂量;I 是束流, 单位是安培;t 是注入时间,单位是秒;e 是电子电荷,1.6×10-19C ;n 是电荷数量;A 是注入面积,单位是 。
4.离子注入设备离子注入机体积庞大,结构非常复杂。
根据它所能提供的离子束流大小和能量可分为高电流和中电流离子注入机以 及高能量、中能量和低能量离子注入机。
离子注入机的主要部件有:离子源、质量分析器、加速器、聚焦器、扫描系统以及工艺室等。
(1)离子源离子源的任务是提供所需的杂质离子。
在合适的气压下,使含有杂质的气体受到电子碰撞而电离,最常用的杂质源有 和 等,(2)离子束吸取电极吸取电极将离子源产生的离子收集起来形成离子束。