封装
- 格式:doc
- 大小:54.50 KB
- 文档页数:8

1、SOP/SOIC封装即小外形封装,表面贴封装型之一。
封装技术
由飞利浦开发,以后逐渐派生SQJ(J型引脚小外形封装)、TOSP (薄小外形封装)、VSOP(甚小外形封装)、SSOP(缩小外形封装)、TSSOP(薄的缩小外形封装)及SOT(小外形晶体管)、SOIC(小外形集成电路)等
2、DIP封装即双列直插式封装。
属于插装式封装,引脚从封装
两侧引出,在塑料与陶瓷两种。
应用范围包括标准逻辑IC,存储器LSI及微机电路等。
3、PLCC封装即塑封J引线封装,外形成正方形,四周都有脚,
外形尺寸比DIP小很多,适合SMT表面安装技术在PCB上安装布线,具有外形尺寸小,可靠性高的优点。
4、TQFP封装即薄塑封四角扁平封装。
它能有效利用空间,从而
降低印制电路板对空间大小要求。
一般用于网络器件
5、PQFP封装即塑封四角扁平封装,用其封装的芯片一般引脚间
距很小,且引脚很细,一般大规模或超大规模集成电路采用这种封装形式。
6、TSOP封装即薄型小尺寸封装,它的一个典型特征就是在封装
芯片的周围做出引脚。
适合高频应用场合。
7、BGA封装即球栅阵列封装,它的IO端子是以圆形或柱状焊点
按阵列形式分布在封装下面。

修改者:林子木电子元件封装大全及封装常识一、什么叫封装封装,就是指把硅片上的电路管脚,用导线接引到外部接头处,以便与其它器件连接.封装形式是指安装半导体集成电路芯片用的外壳。
它不仅起着安装、固定、密封、保护芯片及增强电热性能等方面的作用,而且还通过芯片上的接点用导线连接到封装外壳的引脚上,这些引脚又通过印刷电路板上的导线与其他器件相连接,从而实现内部芯片与外部电路的连接。
因为芯片必须与外界隔离,以防止空气中的杂质对芯片电路的腐蚀而造成电气性能下降。
另一方面,封装后的芯片也更便于安装和运输。
由于封装技术的好坏还直接影响到芯片自身性能的发挥和与之连接的PCB(印制电路板)的设计和制造,因此它是至关重要的。
衡量一个芯片封装技术先进与否的重要指标是芯片面积与封装面积之比,这个比值越接近1 越好。
封装时主要考虑的因素:1、芯片面积与封装面积之比为提高封装效率,尽量接近1:1;2、引脚要尽量短以减少延迟,引脚间的距离尽量远,以保证互不干扰,提高性能;3、基于散热的要求,封装越薄越好。
封装主要分为DIP 双列直插和SMD 贴片封装两种。
从结构方面,封装经历了最早期的晶体管TO(如TO-89、TO92)封装发展到了双列直插封装,随后由PHILIP公司开发出了SOP 小外型封装,以后逐渐派生出SOJ(J 型引脚小外形封装)、TSOP(薄小外形封装)、VSOP(甚小外形封装)、SSOP(缩小型SOP)、TSSOP(薄的缩小型SOP)及SOT(小外形晶体管)、SOIC(小外形集成电路)等。
从材料介质方面,包括金属、陶瓷、塑料、塑料,目前很多高强度工作条件需求的电路如军工和宇航级别仍有大量的金属封装。
封装大致经过了如下发展进程:结构方面:TO->DIP->PLCC->QFP->BGA ->CSP;材料方面:金属、陶瓷->陶瓷、塑料->塑料;引脚形状:长引线直插->短引线或无引线贴装->球状凸点;装配方式:通孔插装->表面组装->直接安装二、具体的封装形式1、SOP/SOIC 封装SOP 是英文Small Outline Package 的缩写,即小外形封装。

常见封装类型
芯片的封装类型已经经历了插针式、表贴式、阵列式、等好几代的变迁。
芯片面积与封装面积之比越来越接近1,适用频率变高,耐温性变强,引脚数增多,间距变小,重量减少,可靠性提高等。
1.直插式封装
(1)DIP双列直插封装
双列直插式封装。
插装型封装之一,引脚从封装两侧引出,封装材料有塑料和陶瓷两种。
DIP是最普及的插装型封装。
图1 DIP双列直插式封装
(2)SIP双列直插封装
单列直插式封装。
引脚从封装一个侧面引出,排列成一条直线。
图2 SIP单列直插式封装。
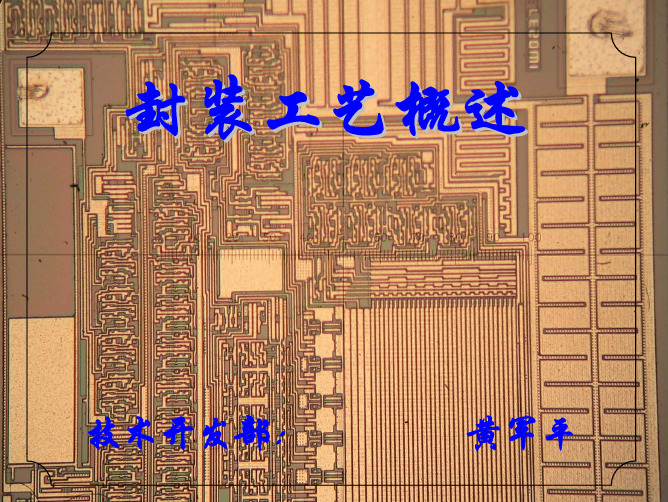


封装需要的主要材料封装是一种将物品包裹、保护或整理的过程。
不同的封装任务需要使用不同的主要材料。
以下是一些常见的封装所需的主要材料:1.包装纸:包装纸是最基本的封装材料之一、它可以是普通的纸张,也可以是特殊的纸张,如包装纸、防水纸等。
包装纸可以用来包裹不同大小的物品,保护它们免受损坏或污染。
2.包装盒:包装盒是封装物品的另一个重要材料。
它可以是纸盒、塑料盒或木盒等。
包装盒可以提供更强的保护,尤其适用于脆弱或易碎的物品。
它们还可以用于分类或整理物品,方便存储和携带。
3.塑料袋:塑料袋是常见的封装材料之一、它们可以是透明的或有颜色的,可以用来包装食品、衣物、化妆品等各种物品。
塑料袋具有防潮、防虫和防尘的功能,可以保持物品的新鲜和清洁。
4.气泡膜:气泡膜是常见的保护封装材料之一、它由一层塑料薄膜和一层气泡纸组成,可以提供良好的缓冲效果,保护物品免受震动、碰撞和压力造成的损坏。
气泡膜通常用于包装易碎物品,如玻璃制品、陶瓷制品等。
5.封箱胶带:封箱胶带是将包装纸或包装盒封闭的必备材料。
它可以是普通的胶带或特殊的封箱胶带,如防水胶带、耐高温胶带等。
封箱胶带通常具有很强的粘性,可以确保包装物品的安全和完整。
6.缠绕膜:缠绕膜是一种用于封装大型或不规则物品的材料。
它通常是一层塑料薄膜,可以通过手工或自动包装机进行缠绕。
缠绕膜可以固定物品,保护其免受损坏或松动。
7.铁丝或绳子:铁丝或绳子可以用来绑扎封装物品,提供额外的保护和稳定性。
它们可以在包装纸、包装盒或塑料袋上进行绑扎,确保物品的安全和固定。
8.填充材料:填充材料是用来填充包装盒或包装纸的空隙,以减少物品在运输过程中的摇晃和碰撞。
常见的填充材料包括泡沫颗粒、泡沫板、纸箱、气泡纸等。
以上是封装过程中常用的主要材料。
根据封装的要求和物品的特性,还可能需要其他材料来提供额外的保护和安全。
封装的目的是保护物品,确保它们在运输、存储和使用过程中的安全和完整。
常见的封装技术包括以下几种:1. BGA封装:Ball Grid Array封装,即球栅阵列封装,广泛应用于集成电路、CPU等领域,可以实现高性能、高频率、高密度的设计。
2. QFP封装:Quad Flat Package封装,即方形平面封装,适用于中小规模的周边器件和内部互连式器件。
3. QFN 封装:Quad Flat No-Leads封装,即无引脚方形平面封装,通过焊盘外侧周围的电极连接电路板,在封装尺寸上比QFP更小。
4. SOIC封装:Small Outline Integrated Circuit封装,即小外形集成电路封装,具有体积小、性能稳定、可靠性高等特点,广泛应用于各种数字电路或模拟电路产品。
5. DIP封装:Dual Inline Package封装,即双列直插式封装,是一种机械稳定性好、安装方便的封装形式,适用于各种数字集成电路。
6. CSP封装:Chip Scale Package封装,即芯片级尺寸封装,相比于BGA和QFN等封装形式,CSP更加小型化,使用范围广泛,包括无线通信、移动设备等。
7. COB封装:Chip On Board封装,即芯片贴装技术,通过将芯片直接贴装在电路板上的方式实现的一种封装形式,可以实现体积小、重量轻的设计,通常用于芯片级组装和微型设备。
封装是指将电子器件进行外部包装和保护的过程。
在封装过程中,芯片和其他元器件被放置在一个特定的封装材料中,并通过焊接或粘合等方式固定在一块基板上。
封装材料可以是塑料、陶瓷或金属等,具体的选择取决于应用需求和要求。
封装不仅仅是将芯片和其他元器件放置在一个外壳中,它还包括对电子器件进行测试、标记和质量控制等步骤。
整个封装过程旨在确保电子器件的正常运行和可靠性。
封装的意义在于保护电子器件免受环境影响,提高其可靠性和稳定性。
同时,封装也方便了电子器件的安装和维修,使其更加适应实际应用的需求。
1、BGA(ball grid array)球形触点陈列,表面贴装型封装之一。
在印刷基板的背面按陈列方式制作出球形凸点用以代替引脚,在印刷基板的正面装配LSI 芯片,然后用模压树脂或灌封方法进行密封。
也称为凸点陈列载体(PAC)。
引脚可超过200,是多引脚LSI 用的一种封装。
封装本体也可做得比QFP(四侧引脚扁平封装)小。
例如,引脚中心距为1.5mm 的360 引脚BGA 仅为31mm 见方;而引脚中心距为0.5mm 的304 引脚QFP 为40mm 见方。
而且BGA 不用担心QFP 那样的引脚变形问题。
该封装是美国Motorola 公司开发的,首先在便携式电话等设备中被采用,今后在美国有可能在个人计算机中普及。
最初,BGA 的引脚(凸点)中心距为1.5mm,引脚数为225。
现在也有一些LSI 厂家正在开发500 引脚的BGA。
BGA 的问题是回流焊后的外观检查。
现在尚不清楚是否有效的外观检查方法。
有的认为,由于焊接的中心距较大,连接可以看作是稳定的,只能通过功能检查来处理。
美国Motorola 公司把用模压树脂密封的封装称为OMPAC,而把灌封方法密封的封装称为GPAC(见OMPAC 和GPAC)。
2、BQFP(quad flat package with bumper)带缓冲垫的四侧引脚扁平封装。
QFP 封装之一,在封装本体的四个角设置突起(缓冲垫) 以防止在运送过程中引脚发生弯曲变形。
美国半导体厂家主要在微处理器和ASIC 等电路中采用此封装。
引脚中心距0.635mm,引脚数从84 到196 左右(见QFP)。
3、碰焊PGA(butt joint pin grid array)表面贴装型PGA 的别称(见表面贴装型PGA)。
4、C-(ceramic)表示陶瓷封装的记号。
例如,CDIP 表示的是陶瓷DIP。
是在实际中经常使用的记号。
5、Cerdip用玻璃密封的陶瓷双列直插式封装,用于ECL RAM,DSP(数字信号处理器)等电路。
电子元件封装大全及封装常识一、什么叫封装封装,就是指把硅片上的电路管脚,用导线接引到外部接头处,以便与其它器件连接.封装形式是指安装半导体集成电路芯片用的外壳。
它不仅起着安装、固定、密封、保护芯片及增强电热性能等方面的作用,而且还通过芯片上的接点用导线连接到封装外壳的引脚上,这些引脚又通过印刷电路板上的导线与其他器件相连接,从而实现内部芯片与外部电路的连接。
因为芯片必须与外界隔离,以防止空气中的杂质对芯片电路的腐蚀而造成电气性能下降。
另一方面,封装后的芯片也更便于安装和运输。
由于封装技术的好坏还直接影响到芯片自身性能的发挥和与之连接的pcb(印制电路板)的设计和制造,因此它是至关重要的。
来衡量一个芯片PCB技术一流是否的关键指标就是芯片面积与PCB面积之比,这个比值越吻合1越好。
PCB时主要考量的因素:1、芯片面积与封装面积之比为提高封装效率,尽量接近1:1;2、插槽必须尽量长以增加延后,插槽间的距离尽量离,以确保互不阻碍,提升性能;3、基于散热的要求,封装越薄越好。
PCB主要分成dip双列直插和smd贴片PCB两种。
从结构方面,PCB经历了最为早期的晶体管to(如to-89、to92)PCB发展至了双列直插PCB,随后由philip公司研发出来了sop大外型PCB,以后逐渐派遣吐出soj(j型插槽大外形PCB)、tsop(薄小外形PCB)、vsop(甚大外形PCB)、ssop(增大型sop)、tssop(厚的增大型sop)及sot(大外形晶体管)、soic(大外形集成电路)等。
从材料介质方面,包含金属、陶瓷、塑料、塑料,目前很多高强度工作条件市场需求的电路例如军工和宇航级别仍存有大量的金属封装。
PCB大致经过了如下发展进程:结构方面:to->dip->plcc->qfp->bga->csp;材料方面:金属、陶瓷->陶瓷、塑料->塑料;引脚形状:长引线直插->短引线或无引线贴装->球状凸点;加装方式:通孔输出设备->表面装配->轻易加装二、具体的封装形式1、sop/soicPCBsop是英文smalloutlinepackage的缩写,即小外形封装。
第一章1、专业术语:1)晶圆(wafer):由普通硅砂熔炼提纯拉制成硅柱后切成的单晶硅薄片2)集成电路(integrated circuit,IC):半导体晶圆经过平面工艺加工成元件、器件和互连线、并集成在基片表面或内部的微小型化电路或系统。
3)光刻(lithography):通过光学手段把掩膜板图形转移到晶圆上。
4)前道工序(FI process):IC芯片制造过程中,硅锭切片、晶圆光刻、外延、淀积等工艺(即所谓流片)被称为前道工序,这是IC芯片制造的最要害技术。
5)后道工序(EI process):晶圆流片后,芯片切割(即所谓划片)、封装、测试等工序。
6)线宽(Line width):IC生产工艺可达到的最小导线宽度,是IC工艺先进水平的主要指标,线宽越小,集成度就越高,即在同一面积上就集成更多电路单元。
7)摩尔定律(moore established law):芯片中的晶体管数量每隔18个月将会翻一番。
8)洁净度(merit rating):集成电路车间要控制的空气净化程度。
9)引脚数(lead count):芯片封装时输出(IO)的端子数,是集成电路的一个重要指标。
10)引脚节距(lead intercept):芯片每个引脚之间的距离。
11)封装密度(density of packaging):芯片面积与封装面积之比,是衡量一个芯片封装技术先进与否的重要指标,这个指标直接说明芯片的最终尺寸的大小,以及成本的高低,比值越接近一,封装技术越好越先进。
2、微电子封装技术特点:1)向高密度及高I/O引脚数发展,引脚由四边引出趋向面阵引出发展2)向表面组装示封装(SMP)发展,以适应表面贴装(SMT)技术及生产要求3)向高频率及大功率封装发展4)从陶瓷封装向塑料封装发展5)从单芯片封装(SCP)向多芯片封装(MCP)发展6)从只注重发展IC芯片到先发展封装技术再发展IC芯片技术技术第二章1、微电子封装的定义:是指用某种材料作为外壳安放、固定和密封半导体集成电路芯片,并用导体做引脚将芯片上的接点引出外壳1)狭义的电子封装技术定义:是指利用膜技术及微细连接技术,将半导体元器件及其他构成要素在框架或基板上布置、固定及连接,引出接线端子,并通过可塑性绝缘介质灌封固定,构成整体立体结构的工艺技术。
(最基本的)2)广义的电子封装技术定义:是指将半导体和电子元器件所具有的电子的、物理的功能,转变为能适用于设备或系统的形式,并使之为人类社会服务的科学与技术。
(功能性的)2、微电子封装的功能:1)提供机械支撑及环境保护;2)提供电流通路;3)提供信号的输入和输出通路;4)提供热通路。
3、微电子封装的要点:1)电源分配;2)信号分配;3)机械支撑;4)散热通道;5)环境保护。
4、封装级别:1)零级封装:是指半导体基片上的集成电路元件、器件、线路;更确切地应该叫未加封装的裸芯片。
来料检查清洗贴膜磨片卸膜贴片划片装片键合键和检查塑封后烘电镀打标切筋打弯切筋检验包装品质检验产品除贷2)一级封装:是指采用合适的材料(金属、陶瓷或塑料)将一个或多个集成电路芯片及它们的组合进行封装,同时在芯片的焊区与封装的外引脚间用引线键合(wire bonding,WB)、载带自动焊(tape automated bonding,TAB)、倒装片键合(flip chip bonding,FCB)三种互联技术连接,使其成为具有实际功能的电子元器件或组件。
3)二级封装技术:实际上是一种多芯片和多元件的组装,即各种以及封装后的集成电路芯片、微电子产品、以及何种类型元器件一同安装在印刷电路板或其他基板上。
4)三级封装技术:由二级封装的各个插板或插卡再共同装在一个更大的母板的组装,是一种密度更高,功能更全,复杂度更庞大的立体组装技术。
5、表面贴装技术SMT主要特点:1)高密集2)高可靠3)高性能4)高效率5)低成本SMT主要工艺:波峰焊工艺和回流焊工艺6、互连技术定义:是指实现芯片与芯片间,芯片与封装衬底间以及器件与基板间的物理量(电信号、光信号和流体新号等)连接技术。
互连技术的功能:1)保证芯片、器件与系统的电源、地和电信号的畅通;2)满足封装结构优化的需要;3)提供芯片的机械支撑和散热。
互连技术的分类三种:1:引线键合技术WB2:载带自动焊技术TAB3:倒装焊技术FCB引线键合定义:是指通过AU、Al等的微细线,将芯片电极与引线框架或布线板电路上对应的电极键合连接的技术。
分类:引线键合技术根据键合装置的自动化程度高低分为手动、半自动和全自动。
根据键合工艺特点分为:超声键合、热压键合和热超声键合。
载带自动焊技术:是一种基于金属化柔性高分子载带将芯片组装到基板上的集成电路封装技术。
倒装焊定义:是指芯片面朝下、将芯片焊区与基板焊区直接互连的技术,它是一种无线芯片互连技术。
第三章微电子封装形式分类按封装材料分,主要可分为四种形式:金属封装、陶瓷封装、塑料封装和金属陶瓷封装;按气密性分:气密封装和非气密性封装。
金属封装特点:精度高,尺寸严格;金属零件以冲、挤为主,便于大量生产;价格低廉,性能优良;芯片放置容易,应用灵活,可靠性高,可以得到大体积的空腔。
气密性封装塑料封装的主要特点:工艺简单,成本低廉,便于自动化大生产。
陶瓷封装的特点:1:气密性好,封装体的可靠性高;2:具有优秀的电性能,可实现多信号、地和电源层结构,并具有对复杂的器件进行一体化封装的能力;3:导热性性能好,可降低封装体热耗散体积限制和成本;4:烧结装配时尺寸精度差、介电系数高,价格昂贵。
SIP:单列直插式封装single in-line packageDIP:双列直插式封装dual in-lin packageZIP:Z型引脚直插式封装zigzag in-lin packageS-DIP:收缩双列直插式封装shink dual in-line packageSK-DIP:窄带双列直插式封装skinny dual in-line packagePGA:针栅阵列插入式封装pin grid arraySOP:小外形封装small out-line packageMSP:微型四方封装mini square packageQFP:四边引脚扁平封装quad flat packageFPG:玻璃(陶瓷)扁平封装flat package of glassLCCC:无引脚陶瓷封装芯片载体leadless chio ceramic carrierPLCC:塑封无引脚封装芯片载体plastic leadless chip carrierSOJ:J型引脚小外形封装small out-line J lead packageBGA:球栅阵列封装ball grid arrayCSP:芯片尺寸大小封装chio size package 芯片级封装chio scale packageTCP:载带封装tape carrier package基板技术将面临来自三个不同方面的挑战:1:微电子芯片发展的要求,即大面积化、针脚四边引出和表面贴装化、引脚阵列化和引脚间距密度化;2:元器件发展的要求,即无引线化、小型化、片式化和集成化都需要与基板一起设计和制造并制成埋入式结构;3:MEMS应用方面的要求,布线高密度化、层间互联精细化、机构的三维化/立体化。
基板选择与设计时需要重点考虑基板的材材料参数电参数热参数结构参数等,具体体现在一下方面:1:材料参数方面:介电常熟、热膨胀系数和热导率等重要参数;2:在结构方面,实现布线图形的精心化、层间互联小孔径化和电气参数最优化;3:在热性能方面,重点考虑耐热性与Si等芯片材料的热匹配和系统的良好导热性;4:电参数方面:a.减小信号传输延迟时间Tpd,b.系统内部分间特性阻抗的匹配;c.降低L、C和R的寄生效应,使引线间距最短化,使用低磁导率的导体材料、低介电常数的基板材料等;d.为了降低交调噪声,要尽量避免信号线之间距离太近和平行布置,同时为了减小此影响,应选用低介电常数的基板材料;e.电路图形设计要考虑到防止信号发射噪声。
在微电子封装中主要按照基板的集体材料来分,可以分为三类:1:有机基板:包括纸基板、玻璃布基板、复合材料基板、环氧树脂类、聚酯树脂类、耐热塑性基板和多层基板等;2:无机基板:包括金属类基板、陶瓷类基板、玻璃类基板、硅基板和金刚石基板等;3:复合基板:包括功能复合基板、结构复合基板和材料复合基板等。
陶瓷基板基本性能要求:1:电性能要求低介电常数、低介电损耗、高绝缘电阻、高绝缘击穿电压,以及高温高湿性能稳定;2:热性能要求高热导率、良好散热性、热膨胀系数与待装配器件匹配,以及优秀的耐热性能;3:机械性能要求高机械强度、良好的可加工性能、适合精细化和多层化制作工艺,以及表面光滑、变形小、无弯曲和无微裂纹等;4:其他性能要求包括:化学稳定性能好,易金属化;无吸湿性;无毒性和公害物质;成本低廉。
氧化铝基板特点:价格较低、综合性能最好。
气密性好、可靠性高应用:主要应用于HIC用基板、LSI封装用基板和多层电路基板/复合基板氮化铝基板特点:热导率高,热膨胀系数(CTE)与硅片相匹配高强度、轻质量密度应用:主要作为MCM封装的基板莫来石特点:有良好的化学稳定性、热稳定性。
高频电特性及轻质量等优点与氧化铝比其介电常数低热膨胀系数低碳化硅特点:是强共键化合物,硬度仅次于金刚石、氮化硼,而且具有优良的耐磨性、耐药品性。
热扩散系数大,而且热膨胀系数与Si更接近;但是介电常数偏高,绝缘耐压差。
应用:多用于耐压性要求不高又存在其他问题的低压电路以及VLSI高散热封装电路氧化铍特点:热导率高。
高熔点。
高强度、高绝缘性、低介电常数、低介质损耗以及良好的封装工艺适应性等特点应用:在微波技术、真空电子技术、核技术、微电子与光电子领域都收到了重视和应用,尤其是在大功率半导体器件与电路、大功率微波真空器件以及核反应堆中,他一直是制备导热元件的主流陶瓷材料。
低温共烧陶瓷LTCC 种类与特点:1:硼硅酸铅玻璃-AL2O3系特点:强度大但是含有铅2:硼硅酸玻璃+石英玻璃+堇青石系特点:具有低介电常数以及热膨胀系数可控制在于硅相近的水平。
3:硼硅酸玻璃-AL2O3-镁橄榄石系4:硼硅酸玻璃-AL2O3系5硼硅酸玻璃-AL2O3处理的氧化锆系特点是在相当宽的温度范围内,其热膨胀系数与GaAs单晶的热膨胀系数相近,因此,可作为HEMP的实装基板。
LTCC多层基板的工艺流程:流延——生瓷片——打孔——通孔填充——金属化——叠层热压——切片——排胶烧结——测试——LTCC多层基板表面贴装技术SMT基本工艺流程:丝印——点胶——贴装——固化——回流焊接——清洗——检测——返修SMT的优点:1:由于基板不采用通孔二采用埋层互连布线技术,可以留出更多的空间来布线,从何提高了布线密度;在相同的功能情况下,可以减小面积、还可以减小层数以使整个组件成本降低。