BGA基板制程简介
- 格式:ppt
- 大小:7.43 MB
- 文档页数:92

柱状BGA生产工艺柱状BGA(Ball Grid Array)是一种高密度封装技术,被广泛应用于电子产品中。
它能够提供更多的连接点,从而增加了电路板的功能,并减小了封装的体积。
下面我将介绍柱状BGA 的生产工艺。
首先,柱状BGA的制作需要准备一块基板和一颗芯片。
基板上已经做好了电路的布局,而芯片则是待封装的集成电路。
在生产开始之前,需要对基板和芯片进行清洁和检查,以确保没有任何污染物和缺陷。
接下来,我们需要在基板上涂覆一层焊膏。
焊膏是一种导电的材料,用于连接芯片和基板。
然后,将芯片放置在基板上,并使用加热和压力的方法将芯片粘贴在基板上。
接下来的步骤是焊接。
将整个基板放入一个热风炉中,通过加热融化焊膏并与芯片连接。
在焊接之前,需要调整热风炉的温度和时间,以确保焊点的质量。
完成焊接后,需要进行焊点的检查和修复。
使用显微镜检查焊点是否完整和正确。
如果发现了问题,需要使用焊锡回流炉重新加热并修复焊点。
最后一步是进行测试和封装。
将封装完的芯片连接到测试设备上,通过测试设备检测芯片的功能和性能。
如果芯片通过了测试,就可以进行最后的封装。
封装是将基板和芯片放入一个塑料壳中,以保护芯片免受物理损害和污染。
通过以上的工艺,柱状BGA的生产就完成了。
柱状BGA生产工艺具有以下优点:首先,它能够提供更高的连接密度,从而增加了电路板的功能性。
其次,柱状BGA封装体积小,适合于小型电子产品。
最后,它能够提供更高的可靠性和耐用性,减少了焊点的断裂和损坏。
总结起来,柱状BGA的生产工艺是一个复杂但关键的过程。
它需要对基板和芯片进行清洁和检查,然后涂覆焊膏,将芯片粘贴在基板上并进行焊接。
最后,进行焊点检查和修复,测试芯片的功能和性能,最后进行封装。
通过这个过程,柱状BGA能够提供更高的连接密度和可靠性,被广泛用于电子产品中。








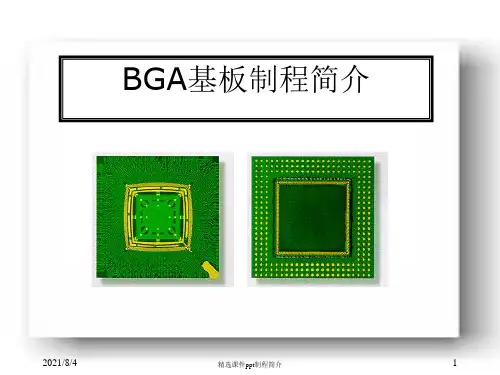

BGA 是什么?BGA 封装技术有什么特点?三大
BGA 封装工艺及流程介绍
随着市场对芯片集成度要求的提高,I/O 引脚数急剧增加,功耗也随之增大,对集成电路封装更加严格。
为了满足发展的需要,BGA 封装开始被应用于生产。
BGA 也叫球状引脚栅格阵列封装技术,它是一种高密度表面装配封装技术。
在封装底部,引脚都成球状并排列成一个类似于格子的图案,由此命名为BGA。
目前主板控制芯片组多采用此类封装技术,材料多为陶瓷。
采用BGA 技术封装的内存,可以使内存在体积不变的情况下,内存容量提高两到三倍,BGA 与TSOP 相比,具有更小体积,更好的散热性能和电性能。
两种BGA 封装技术的特点
BGA 封装内存:BGA 封装的I/O 端子以圆形或柱状焊点按阵列形式分布在封装下面,BGA 技术的优点是I/O 引脚数虽然增加了,但引脚间距并没有减小反而增加了,从而提高了组装成品率;虽然它的功耗增加,但BGA 能用可控塌陷芯片法焊接,从而可以改善它的电热性能;厚度和重量都较以前的封装技术有所减少;寄生参数减小,信号传输延迟小,使用频率大大提高;组装可用共面焊接,可靠性高。