2第二讲_芯片贴装与芯片互连
- 格式:ppt
- 大小:12.66 MB
- 文档页数:99




一、填空题1、将芯片及其他要素在框架或基板上布置,粘贴固定以及连接,引出接线端子并且通过可塑性绝缘介质灌封固定的过程为狭义封装;在次根基之上,将封装体与装配成完整的系统或者设备,这个过程称之为广义封装。
2、芯片封装所实现的功能有传递电能;传递电路信号;提供散热途径;构造保护与支持。
3、芯片封装工艺的流程为硅片减薄与切割、芯片贴装、芯片互连、成型技术、去飞边毛刺、切筋成形、上焊锡、打码。
4、芯片贴装的主要方法有共晶粘贴法、焊接粘贴法、导电胶粘贴发、玻璃胶粘贴法。
5、金属凸点制作工艺中,多金属分层为黏着层、扩散阻挡层、表层金保护层。
6、成型技术有多种,包括了转移成型技术、喷射成型技术、预成型技术、其中最主要的是转移成型技术。
7、在焊接材料中,形成焊点完成电路电气连接的物质叫做煤斜;;用于去除焊盘外表氧化物,提高可焊性的物质叫做助焊剂;在SMT中常用的可印刷焊接材料叫做锡直。
8、气密性封装主要包括了金属气密性封装、陶瓷气密性封装、玻璃气密性封装。
9、薄膜工艺主要有遮射工艺、蒸发工艺、电镀工艺、光刻工艺。
10、集成电路封装的层次分为四级分别为模块元件(MOdUIe)、⅛路卡工艺(Card)、主电路板(Board)、完整电子产品。
11、在芯片的减薄过程中,主要方法有磨削、研磨、干式抛光、化学机械平坦工艺、电化学腐蚀、湿法腐蚀、等离子增强化学腐蚀等。
12、芯片的互连技术可以分为打线键合技术、载带自动键合技术、倒装芯片键合技术。
13、DBG切割方法进展芯片处理时,首先进展在硅片正面切割一定深度切口再进展反面磨削。
14、膜技术包括了薄膜技术和厚膜技术,制作较厚薄膜时常采用丝网印刷和浆料枯燥烧结的方法O15、芯片的外表组装过程中,焊料的涂覆方法有点涂、丝网印刷、钢模板印刷三种。
16、涂封技术一般包括了顺形涂封和封胶涂封。
二、名词解释1、芯片的引线键合技术(3种)是将细金属线或金属带按顺序打在芯片与引脚架或封装基板的焊垫上而形成电路互连,包括超声波键合、热压键合、热超声波键合。





*微组装工艺*2引线键合技术WB 3载带自动焊接技术TAB 第二章芯片互连技术1概述4倒装焊技术FCB 5各种芯片互连方法的比较*微组装工艺*2.1概述芯片互连技术是将芯片直接与基板相连接的一种技术。
主要包括引线键合、载带自动焊接、倒装芯片技术。
半导体封装内部芯片和外部管脚以及芯片之间的连接起着确立芯片和外部的电气连接、确保芯片和外界之间的输入/ 输出畅通的重要作用,是整个后道封装过程中的关键。
半导体器件的失效约有1/4~1/3是由芯片互连引起的,芯片互连技术对器件长期使用的可靠性影响很大。
*微组装工艺*WB,TAB,FCB不单主要作为芯片—基板间的电气互连形式,而且还作为一种微电子封装形式,常称为“零级”封装。
从微电子封装今后的发展来看,将从有封装向少封装、无封装方向发展。
而无封装就是通常的裸芯片,若将这种无封装的裸芯片用WB,TAB,FCB的芯片互连方式直接安装到基板上,即称为板上芯片(COB)和板上TAB或板上FCB,这些统称为直接芯片安装(DCA)技术,它将在今后的微电子封装中发挥更重要的作用。
2.2 引线键合技术2.2.12.2.22.2.52.2.6*微组装工艺*一、引线键合技术引线键合技术是将半导体裸芯片(Die )焊区与微电子封装的I/O 引线或基板上的金属布线焊区(Pad )用金属细丝连接起来的工艺技术。
工作原理:提供能量破坏被焊表面的氧化层和污染物,使焊区金属产生塑性变形,使得引线与被焊面紧密接触,达到原子间引力范围并导致界面间原子扩散而形成焊合点。
焊区金属一般为AL 或Au 金属丝。
多数是1微米至数百微米直径的Au 丝、AL 丝和Si-AL 丝。
2.2.1 引线键合技术*微组装工艺*布线端子*微组装工艺*引线键合技术的特点:引线键合以工艺实现简单、成本低廉、适用多种封装形式而在连接方式中占主导地位。
引线键合技术适用于几乎所有的半导体集成电路元件,操作方便,封装密度高。
低成本、高可靠、高产量等特点使得WB成为芯片互连主要工艺方法,但引线长、压焊过重、测试性差等问题容易引起互连失效。
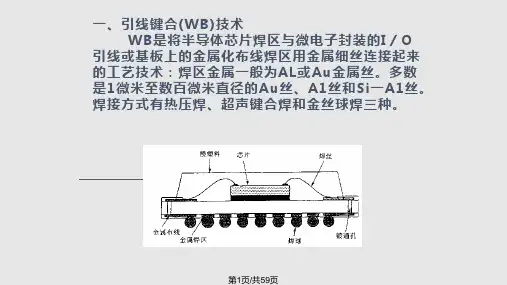

芯片粘接技术一、概述芯片粘接技术是一种将芯片与基板连接在一起的技术,常用于半导体封装和集成电路制造中。
它能够提高芯片的可靠性和稳定性,同时也可以实现更小型化、更高密度的封装。
二、芯片粘接方法1. 焊接法焊接法是最常用的芯片粘接方法之一,它将芯片与基板通过焊点连接在一起。
焊点可以分为金属焊点和锡球焊点两种类型。
金属焊点适合于大功率器件和高温环境下使用,而锡球焊点则适合于小功率器件和低温环境下使用。
2. 粘贴法粘贴法是另一种常用的芯片粘接方法,它使用粘合剂将芯片与基板连接在一起。
常见的粘合剂有环氧树脂、聚氨酯等。
这种方法优点是成本低、易于操作,缺点是可靠性较差。
3. 压合法压合法是将芯片与基板放在一起,在高压下进行连接。
这种方法可以保证连接质量,但需要特殊设备进行操作。
三、芯片粘接工艺流程1. 表面处理表面处理是芯片粘接的第一步,它可以提高连接质量。
常见的表面处理方法有金属化、去氧化、清洗等。
2. 粘接剂涂布将粘接剂涂布在基板上,注意要均匀涂布,避免出现气泡和空隙。
3. 芯片定位将芯片放在基板上,并进行定位。
定位需要非常准确,否则会影响连接质量。
4. 压合或焊接根据具体情况选择压合或焊接方法进行连接。
需要注意的是,在操作过程中要控制好温度和压力,避免芯片损坏。
5. 固化连接完成后,需要对粘合剂进行固化处理。
固化时间和温度需要按照粘合剂的要求进行控制。
6. 检验完成连接后,需要进行检验,确保连接质量符合要求。
四、芯片粘接技术应用芯片粘接技术广泛应用于半导体封装和集成电路制造中。
它可以实现更小型化、更高密度的封装,提高产品性能和可靠性。
同时也可以应用于MEMS器件、光电器件等领域。
五、总结芯片粘接技术是一种重要的连接技术,它可以提高产品性能和可靠性,实现更小型化、更高密度的封装。
在操作过程中需要注意控制好温度和压力,确保连接质量符合要求。