LED倒装芯片与倒装焊工艺.ppt
- 格式:ppt
- 大小:2.73 MB
- 文档页数:31

LED倒装技术及工艺流程分析倒装技术的工艺流程主要包括以下几个步骤:1.准备工作:首先需要准备好所需的LED芯片、PCB板、胶水、连接线等材料和设备,搭建好倒装工作台,并确认好芯片的正负极。
2.倒装工艺:将LED芯片通过电镀方式倒装到PCB上,具体工艺步骤如下:a.选择合适的胶水:根据实际需求选择合适的胶水,一般选用导热胶水或者导热硅胶进行倒装。
b.PCB加工:将PCB板经过必要的加工,包括金手指加工、焊盘/焊针喷镀锡、背面铜箔除锡等。
c.胶水上料:将胶水注入到机械注胶机中,通过专用的胶嘴将胶水点涂在PCB的焊点位置上。
d.LED芯片贴附:将LED芯片按照正负极方向和间距要求贴附到胶水涂抹的位置上,保证LED芯片与焊盘对应。
可以通过自动定位系统或者手工进行贴附。
e.固化胶水:将贴附好的LED芯片的背面放到硅胶材料或者专用的固化设备中,进行胶水的固化。
f.焊接连接线:将连接线焊接到LED芯片的正负极,一般采用无铅焊接方式。
3.测试与包装:在完成倒装过程后,对LED芯片进行测试,检测其亮度、色彩等参数是否符合要求。
通过自动或者手动测试设备进行测试。
如果有不合格的芯片,需进行更换或修复。
最后,按照客户要求进行产品包装。
倒装技术相比传统的LED贴片技术有如下优势:1.提高亮度:倒装技术可以减少PCB与LED芯片之间的电阻,提高LED灯的亮度和显示屏的像素密度。
2.降低热阻:通过使用导热胶水或者导热硅胶,可以有效地将LED芯片的热量传导到PCB板上,降低LED芯片的工作温度,提高产品的可靠性和寿命。
3.减小尺寸:倒装技术可以使LED芯片直接贴附在PCB板上,减小了整体产品的体积和厚度。
4.提高可靠性:倒装技术可以减少LED与PCB之间的线路长度,减少线路电阻,提高了产品的抗电磁干扰能力和可靠性。
5.降低生产成本:倒装技术可以提高LED灯条和显示屏的制造效率,降低生产成本。
总之,LED倒装技术是一种先进的LED封装技术,通过倒装方法将LED芯片直接连接到PCB上,可以提高亮度、降低热阻、减小尺寸、提高可靠性等优势。


LED芯片倒装封装传统正装的LED蓝宝石衬底的蓝光芯片电极在芯片出光面上的位置如图1所示。
由于p型GaN掺杂困难,当前普遍采用p型GaN上制备金属透明电极的方法,从而使电流扩散,以达到均匀发光的目的。
但是金属透明电极要吸收30%~40%的光,因此电流扩散层的厚度应减少到几百nm。
厚度减薄反过来又限制了电流扩散层在p型GaN层表面实现均匀和可靠的电流扩散。
因此,这种p型接触结构制约了LED芯片的工作电流。
同时,这种结构的pn结热量通过蓝宝石衬底导出,由于蓝宝石的导热系统为35W/(m·K)(比金属层要差),因此导热路径比较长。
这种LED芯片的热阻较大,而且这种结构的电极和引线也会挡住部分光线出光。
图1 传统蓝宝石衬底的GaN芯片结构示意图倒装封装总之,传统正装的LED芯片对整个器件的出光效率和热性能而言不是最优的。
为了克服正装的不足,美国Lumileds Lighting 公司发明了Flipchip (倒装芯片)技术,如图2 所示。
图2 倒装芯片示意图这种封装法首先制备具有适合共晶焊接的大尺寸LED芯片,同时制备相应尺寸的硅底板,并在其上制作共晶焊接电极的金导电层和引出导电层(超声波金丝球焊点)。
然后,利用共晶焊接设备将大尺寸LED芯片与硅底板焊在一起。
目前,市场上大多数产品是生产芯片的厂家已经倒装焊接好的,并装上防静电保护二极管。
封装厂家将硅底板与热沉用导热胶粘在一起,两个电极分别用一根φ3mil金丝或两根φ1mil金丝。
综上所述,在做好倒装芯片的基础上,在封装时应考虑三个问题:·由于LED是W级芯片,那么应该采用直径多大的金丝才合适?·二是怎样把倒装好的芯片固定在热沉上,是用导热胶还是用共晶焊接?·三是考虑在热沉上制作一个聚光杯,把芯片发出的光能聚集成光束。
根据热沉底板不同,目前市场上常见有两种热沉底板的倒装法:一是上述介绍的利用共晶焊接设备,将大尺寸W级LED芯片与硅底板焊接在一起,这称为硅底板倒装法。


LED倒装工艺流程分析LED(Light Emitting Diode)倒装工艺是指在LED芯片的背面倒装贴合导热基板的一种制造工艺。
倒装工艺可以提高LED芯片的散热性能,使LED灯具具有更高的光效和寿命。
以下是LED倒装工艺的主要流程:1.材料准备:LED芯片、导热胶、导热基板等材料需要提前准备好。
2.芯片背面处理:LED芯片需要经过清洗、磨砂和去膜等处理,以确保背面的平整和清洁度,以利于倒装和导热。
3.倒装机操作:将预先涂有导热胶的导热基板置于倒装机的工作台上,并进行定位。
然后将处理过的LED芯片背面面朝上放置在基板的对应位置上。
4.压力和温度控制:倒装机会施加适当的压力将LED芯片和导热胶贴合到导热基板上,并通过加热使导热胶固化。
压力和温度的控制非常重要,过高的压力或温度都可能会导致芯片损坏或背面不平整。
5.质量检验:完成倒装后的LED芯片需要进行质量检验,主要包括外观检查、电性能测试和光性能测试等。
确保倒装后的LED芯片符合规定的质量要求。
6.终检包装:合格的倒装LED芯片会进行终检,并进行包装,以保护芯片不受损。
通常采用塑料垫片和防静电袋的包装方式。
以上是LED倒装工艺的主要流程。
根据实际情况,还可以根据需要添加或调整工艺步骤。
1.散热性能好:倒装后LED芯片可以直接与导热基板接触,通过导热胶的导热性能,有效地提高LED芯片的散热性能,延长LED灯具的使用寿命。
2.光效提升:通过倒装工艺,LED芯片的背面可以减少不被光线利用的误差,光效可以得到进一步提升。
3.安装方便:倒装工艺可以减少LED灯具的体积,使其更易于安装在各种灯具内。
4.可靠性高:倒装工艺可以增加LED灯具的可靠性,减少芯片与基板之间的电连接线路的损坏和断电等问题。
然而,LED倒装工艺也存在一定的缺点,比如制程复杂、成本较高等问题。
因此,在实际应用中,需要根据实际需求和预算进行选择。
总而言之,LED倒装工艺是一种具有良好散热性能和高光效的制造工艺。
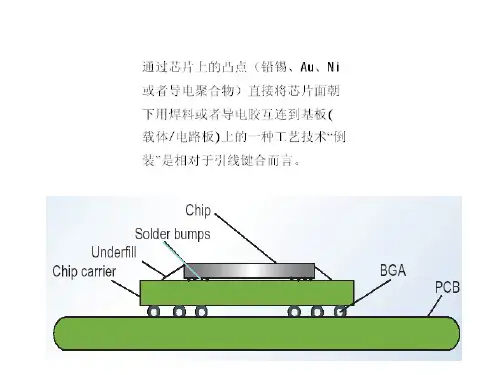




大功率LED芯片的封装(共晶焊)及倒装芯片(flip chip)美国GREE公司的1W大功率芯片(L型电极),它的上下各有一个电极。
其碳化硅(SiC)衬底的底层首先镀一层金属,如金锡合金(一般做芯片的厂家已镀好),然后在热沉上也同样镀一层金锡合金。
将LED芯片底座上的金属和热沉上的金属熔合在一起,称为共晶焊接,如图1所示。
对于这种封装方式,一定要注意当led芯片与热沉一起加热时,二者接触要好,最好二者之间加有一定压力,而且二者接触面一定要受力均匀,两面平衡。
控制好金和锡的比例,这样焊接效果才好。
这种方法做出来的LED的热阻较小、散热较好、光效较高。
这种封装方式是上、下两面输入电流。
如果与热沉相连的一极是与热沉直接导电的,则热沉也成为一个电极。
因此连接热沉与散热片时要注意绝缘,而且需要使用导热胶把热沉与散热片粘连好。
使用这种LED要测试热沉是否与其接触的一极是零电阻,若为零电阻则是相通的,故与热沉相连加装散热片时要注意与散热片绝缘。
共晶点加热温度也称为共晶点。
温度的多少要根据金和锡的比例来定:·AuSn(金80%,锡20%):共晶点为282℃,加热时间控制在几秒钟之内。
·AuSn(金10%,锡90%):共晶点为217℃,加热时间控制在几秒钟之内。
·AgSn(银3.5%,锡96.5%):共晶点为232℃,加热时间控制在几秒钟之内。
1、倒装(Flip chip)1998年Lumileds公司封装出世界上第一个大功率LED(1W LUXOEN器件),使LED器件从以前的指示灯应用变成可以替代传统照明的新型固体光源,引发了人类历史上继白炽灯发明以来的又一场照明革命。
1WLUXOEN器件使LED的功率从几十毫瓦一跃超过1000毫瓦,单个器件的光通量也从不到1个lm飞跃达到十几个lm。
大功率LED 由于芯片的功率密度很高,器件的设计者和制造者必须在结构和材料等方面对器件的热系统进行优化设计。

倒装led芯片生产工艺流程下载温馨提示:该文档是我店铺精心编制而成,希望大家下载以后,能够帮助大家解决实际的问题。
文档下载后可定制随意修改,请根据实际需要进行相应的调整和使用,谢谢!并且,本店铺为大家提供各种各样类型的实用资料,如教育随笔、日记赏析、句子摘抄、古诗大全、经典美文、话题作文、工作总结、词语解析、文案摘录、其他资料等等,如想了解不同资料格式和写法,敬请关注!Download tips: This document is carefully compiled by theeditor. I hope that after you download them,they can help yousolve practical problems. The document can be customized andmodified after downloading,please adjust and use it according toactual needs, thank you!In addition, our shop provides you with various types ofpractical materials,such as educational essays, diaryappreciation,sentence excerpts,ancient poems,classic articles,topic composition,work summary,word parsing,copy excerpts,other materials and so on,want to know different data formats andwriting methods,please pay attention!倒装 LED 芯片生产工艺流程一般包括以下步骤:1. 外延片生长在蓝宝石、碳化硅或硅等衬底上,通过化学气相沉积(CVD)或分子束外延(MBE)等方法生长外延层。
LED芯片倒装工艺原理以及应用简介倒装晶片所需具备的条件:①基材材是硅;②电气面及焊凸在元件下表面;③组装在基板后需要做底部填充。
倒装晶片的定义:其实倒装晶片之所以被称为“倒装”是相对于传统的金属线键合连接方式(Wire Bonding)与植球后的工艺而言的。
传统的通过金属线键合与基板连接的晶片电气面朝上,而倒装晶片的电气面朝下,相当于将前者翻转过来,故称其为“倒装晶片”。
倒装芯片的实质是在传统工艺的基础上,将芯片的发光区与电极区不设计在同一个平面这时则由电极区面朝向灯杯底部进行贴装,可以省掉焊线这一工序,但是对固晶这段工艺的精度要求较高,一般很难达到较高的良率。
倒装芯片与与传统工艺相比所具备的优势:通过MOCVD技术在兰宝石衬底上生长GaN基LED结构层,由P/N结髮光区发出的光透过上面的P型区射出。
由于P型GaN传导性能不佳,为获得良好的电流扩展,需要通过蒸镀技术在P区表面形成一层Ni-Au组成的金属电极层。
P区引线通过该层金属薄膜引出。
为获得好的电流扩展,Ni-Au金属电极层就不能太薄。
为此,器件的发光效率就会受到很大影响,通常要同时兼顾电流扩展与出光效率二个因素。
但无论在什麼情况下,金属薄膜的存在,总会使透光性能变差。
此外,引线焊点的存在也使器件的出光效率受到影响。
采用GaN LED倒装芯片的结构可以从根本上消除上面的问题。
倒装LED芯片技术行业应用分析:近年,世界各国如欧洲各国、美国、日本、韩国和中国等皆有LED照明相关项目推行。
其中,以我国所推广的“十城万盏”计划最为瞩目。
路灯是城市照明不可缺少的一部分,传统路灯通常采用高压钠灯或金卤灯,这两种光源最大的特点是发光的电弧管尺寸小,可以产生很大的光输出,并且具有很高的光效。
但这类光源应用在道路灯具中,只有约40%的光直接通过玻璃罩到达路面,60%的光通过灯具反射器反射后再从灯具中射出。
因此目前传统灯具基本存在两个不足,一是灯具直接照射的方向上照度很高,在次干道可达到50Lx以上,这一区域属明显的过度照明,而两个灯具的光照交叉处的照度仅为灯下中心位置的照度的20%-40%,光分布均匀度低;二是此类灯具的反射器效率一般仅为50%-60%,因此在反射过程中有大量的光损失,所以传统高压钠灯或金卤灯路灯总体效率在70-80%,均匀度低,且有照度的过度浪费。
LED芯片倒装工艺原理以及应用简介倒装晶片所需具备的条件:①基材材是硅;②电气面及焊凸在元件下表面;③组装在基板后需要做底部填充。
倒装晶片的定义:其实倒装晶片之所以被称为“倒装”是相对于传统的金属线键合连接方式(Wire Bonding)与植球后的工艺而言的。
传统的通过金属线键合与基板连接的晶片电气面朝上,而倒装晶片的电气面朝下,相当于将前者翻转过来,故称其为“倒装晶片”。
倒装芯片的实质是在传统工艺的基础上,将芯片的发光区与电极区不设计在同一个平面这时则由电极区面朝向灯杯底部进行贴装,可以省掉焊线这一工序,但是对固晶这段工艺的精度要求较高,一般很难达到较高的良率。
倒装芯片与与传统工艺相比所具备的优势:通过MOCVD技术在兰宝石衬底上生长GaN基LED结构层,由P/N结髮光区发出的光透过上面的P型区射出。
由于P型GaN传导性能不佳,为获得良好的电流扩展,需要通过蒸镀技术在P区表面形成一层Ni-Au组成的金属电极层。
P区引线通过该层金属薄膜引出。
为获得好的电流扩展,Ni-Au金属电极层就不能太薄。
为此,器件的发光效率就会受到很大影响,通常要同时兼顾电流扩展与出光效率二个因素。
但无论在什麼情况下,金属薄膜的存在,总会使透光性能变差。
此外,引线焊点的存在也使器件的出光效率受到影响。
采用GaN LED倒装芯片的结构可以从根本上消除上面的问题。
倒装LED芯片技术行业应用分析:近年,世界各国如欧洲各国、美国、日本、韩国和中国等皆有LED照明相关项目推行。
其中,以我国所推广的“十城万盏”计划最为瞩目。
路灯是城市照明不可缺少的一部分,传统路灯通常采用高压钠灯或金卤灯,这两种光源最大的特点是发光的电弧管尺寸小,可以产生很大的光输出,并且具有很高的光效。
但这类光源应用在道路灯具中,只有约40%的光直接通过玻璃罩到达路面,60%的光通过灯具反射器反射后再从灯具中射出。
因此目前传统灯具基本存在两个不足,一是灯具直接照射的方向上照度很高,在次干道可达到50Lx以上,这一区域属明显的过度照明,而两个灯具的光照交叉处的照度仅为灯下中心位置的照度的20%-40%,光分布均匀度低;二是此类灯具的反射器效率一般仅为50%-60%,因此在反射过程中有大量的光损失,所以传统高压钠灯或金卤灯路灯总体效率在70-80%,均匀度低,且有照度的过度浪费。