倒装芯片技术PPT
- 格式:ppt
- 大小:7.89 MB
- 文档页数:156

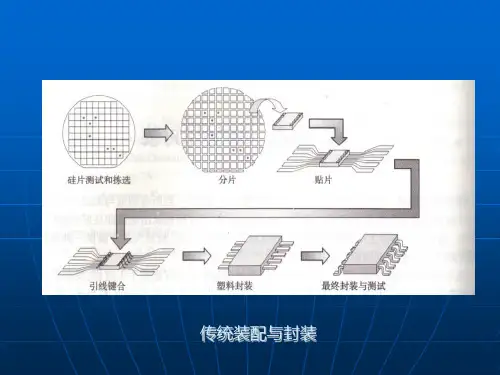

LED芯片倒装封装传统正装的LED蓝宝石衬底的蓝光芯片电极在芯片出光面上的位置如图1所示。
由于p型GaN掺杂困难,当前普遍采用p型GaN上制备金属透明电极的方法,从而使电流扩散,以达到均匀发光的目的。
但是金属透明电极要吸收30%~40%的光,因此电流扩散层的厚度应减少到几百nm。
厚度减薄反过来又限制了电流扩散层在p型GaN层表面实现均匀和可靠的电流扩散。
因此,这种p型接触结构制约了LED芯片的工作电流。
同时,这种结构的pn结热量通过蓝宝石衬底导出,由于蓝宝石的导热系统为35W/(m·K)(比金属层要差),因此导热路径比较长。
这种LED芯片的热阻较大,而且这种结构的电极和引线也会挡住部分光线出光。
图1 传统蓝宝石衬底的GaN芯片结构示意图倒装封装总之,传统正装的LED芯片对整个器件的出光效率和热性能而言不是最优的。
为了克服正装的不足,美国Lumileds Lighting 公司发明了Flipchip (倒装芯片)技术,如图2 所示。
图2 倒装芯片示意图这种封装法首先制备具有适合共晶焊接的大尺寸LED芯片,同时制备相应尺寸的硅底板,并在其上制作共晶焊接电极的金导电层和引出导电层(超声波金丝球焊点)。
然后,利用共晶焊接设备将大尺寸LED芯片与硅底板焊在一起。
目前,市场上大多数产品是生产芯片的厂家已经倒装焊接好的,并装上防静电保护二极管。
封装厂家将硅底板与热沉用导热胶粘在一起,两个电极分别用一根φ3mil金丝或两根φ1mil金丝。
综上所述,在做好倒装芯片的基础上,在封装时应考虑三个问题:·由于LED是W级芯片,那么应该采用直径多大的金丝才合适?·二是怎样把倒装好的芯片固定在热沉上,是用导热胶还是用共晶焊接?·三是考虑在热沉上制作一个聚光杯,把芯片发出的光能聚集成光束。
根据热沉底板不同,目前市场上常见有两种热沉底板的倒装法:一是上述介绍的利用共晶焊接设备,将大尺寸W级LED芯片与硅底板焊接在一起,这称为硅底板倒装法。
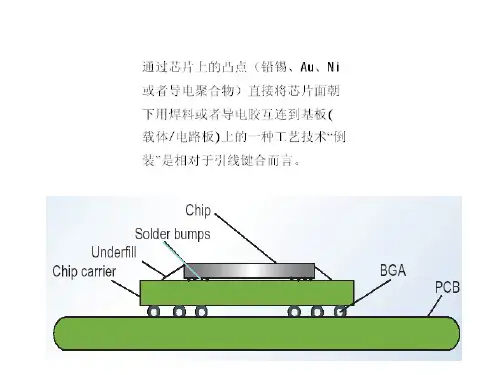







倒装芯片技术倒装芯片技术是一种常用于电子设备的制造和组装方法。
传统的芯片制造技术通常是将芯片组件焊接或粘贴到印刷电路板上,然后通过引线将其连接到其他电子元件。
这种方法简单直接,但有一些限制,例如不能制造密集的器件集成度、不能实现超高速信号传输、不能减少电路中的电磁干扰等。
倒装芯片技术通过将芯片组件倒置放置于印刷电路板上,并使用微观焊接或微弧焊技术将其连接到电路板上。
这种方法可以有效地解决传统芯片制造方法的一些限制,具有以下优点:首先,倒装芯片技术可以实现更高的器件集成度。
倒装芯片技术可以将芯片组件放置在印刷电路板的表面上,有效地减少了芯片组件的占用空间。
这意味着可以在同样的面积上集成更多的器件,从而实现更高的集成度和更复杂的电路设计。
其次,倒装芯片技术可以实现超高速信号传输。
传统的引线连接方式可能会导致信号干扰和延迟。
而倒装芯片技术将芯片组件直接连接到印刷电路板上,可以实现更短的信号路径和更快的信号传输速度,从而提高了电路的工作效率和可靠性。
第三,倒装芯片技术可以减少电路中的电磁干扰。
传统的引线连接方式会产生电磁泄漏和串扰,影响电路的稳定性和性能。
而倒装芯片技术将芯片组件直接连接到印刷电路板上,可以减少引线的长度和数量,从而降低了电磁干扰的概率,提高了电路的抗干扰能力。
此外,倒装芯片技术还有环保和成本优势。
倒装芯片技术可以减少印刷电路板的尺寸和材料使用量,从而减少了材料和能源的消耗。
同时,倒装芯片技术可以降低生产和组装的成本,提高产能和效益。
然而,倒装芯片技术也存在一些挑战和难点。
首先,倒装芯片技术对于印刷电路板的设计和制造有一定要求。
由于芯片组件放置在印刷电路板的表面上,需要考虑芯片组件的尺寸、位置和布局等因素,以确保芯片组件和其他电子元件之间的互联可靠和稳定。
其次,倒装芯片技术对于微观焊接或微弧焊技术有较高的要求。
微观焊接和微弧焊技术需要高精度的设备和操作,以确保焊接点的可靠性和稳定性。
最后,倒装芯片技术对于组装工艺和测试方法也提出了挑战。