硅通孔(TSV)工艺学习报告
- 格式:pdf
- 大小:1.74 MB
- 文档页数:20
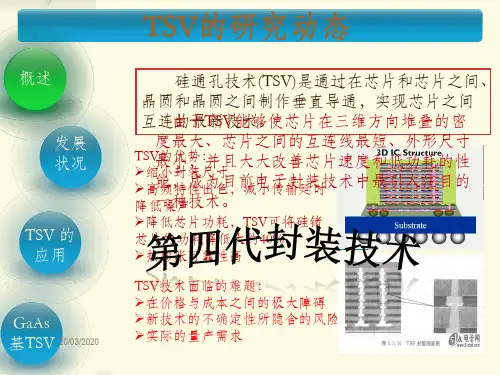

- 1 -硅通孔(TSV )转接板微组装技术研究进展*刘晓阳1,刘海燕2,于大全3,吴小龙1,陈文录1(1. 江南计算技术研究所,江苏 无锡 214083;2. 华进半导体封装先导技术研发中心有限公司,江苏 无锡 214135;3. 中国科学院微电子研究所,北京 100029)摘 要:以硅通孔(TSV )为核心的三维集成技术是半导体工业界近几年的研发热点,特别是2.5D TSV 转接板技术的出现,为实现低成本小尺寸芯片系统封装替代高成本系统芯片(SoC )提供了解决方案。
转接板作为中介层,实现芯片和芯片、芯片与基板之间的三维互连,降低了系统芯片制作成本和功耗。
在基于TSV 转接板的三维封装结构中,新型封装结构及封装材料的引入,大尺寸、高功率芯片和小尺寸、细节距微凸点的应用,都为转接板的微组装工艺及其可靠性带来了巨大挑战。
综述了TSV 转接板微组装的研究现状,及在转接板翘曲、芯片与转接板的精确对准、微组装相关材料、工艺选择等方面面临的关键问题和研究进展。
关键词:硅通孔(TSV );转接板;微组装技术;基板;2.5D/3D 集成中图分类号:TN305.94 文献标识码:A 文章编号:1681-1070(2015)08-0001-08Development of Micropackage Technology for Through SiliconVia (TSV) InterposerLIU Xiaoyang 1, LIU Haiyan 2, YU Daquan 3, WU Xiaolong 1, CHEN Wenlu 1(1. Jiangnan Institute of Computing Technology , Wuxi 214083, China ;2. National Center for Advanced Packaging , Wuxi 214135, China ;3. Institute of Microelectronics of Chinese Academy of Sciences , Beijing 100029, China )Abstract: In recent years, 3D integration technology with the key technology of through silicon via (TSV) has been a research and development hotspot of semiconductor industry. Especially, 2.5D TSV interposer technology has been provided a solution for substituting low cost small size die system package for high cost system on chip (SOC). As the medilayer, interposer achieves 3D interconnection between die to die and die to substrate, and has reduced the cost of system on chip and power consumption. In the structure of 3D package based on TSV interposer, there have been very huge challenges for micropackage technology and reliability of interposer, with new type package structuresand materials introduced, and with large size high power die and small size fine pitch microbumps applied. In the paper, the currently research of TSV interposer micropackage was summarized, including the key questions and development of warpage of interposer, pinpoint between die and interposer, materials of micropackage, and technics choice, etc.Key words: through Silicon via (TSV); interposer; micropackage; substrate; 2.5D/3D integration收稿日期:2015-5-4*基金项目:国家科技重大专项(2011ZX02709-2);国家自然科学基金(61176098)DOI:10.16257/ki.1681-1070.2015.0080电 子 与 封 装第15卷第8期- 2 -1 引言随着电子产品向小型化、高性能、高可靠等方向发展,系统集成度也日益提高。

tsv的主要工艺步骤及方法一、制造硅通孔硅通孔(TSV)的制造是TSV技术的核心步骤之一。
在这一步,通过物理或化学方法在芯片上制造出穿透硅片的孔洞,这些孔洞将用于实现芯片间的垂直互连。
有多种方法可以用来制造硅通孔,包括但不限于深反应离子刻蚀(DRIE)、激光钻孔等。
二、填充硅通孔在硅通孔制造完成后,需要对其进行填充,以实现电信号的传输。
填充材料一般选用导电金属,如铜、钨等。
填充硅通孔的方法有化学气相沉积(CVD)、物理气相沉积(PVD)和电镀等。
选择合适的填充方法需要根据实际应用需求和工艺条件来决定。
三、连接硅通孔填充完硅通孔后,需要进行硅通孔间的连接,以实现芯片间的互连。
连接方法可以采用焊接、导电胶等。
在连接过程中,需要确保连接稳定可靠,以防止在后续使用中出现脱落或接触不良等问题。
四、测试与验证在完成硅通孔的制造、填充和连接后,需要进行测试与验证,以确保TSV 技术能够满足实际应用需求。
测试内容包括但不限于:导通性能测试、机械性能测试和可靠性测试等。
通过测试与验证,可以及时发现并解决潜在的问题,提高TSV技术的可靠性和稳定性。
五、封装与集成在TSV技术应用中,封装与集成是关键步骤之一。
通过封装与集成,可以将多个芯片垂直堆叠在一起,实现更小体积、更高性能的电子系统。
在封装与集成过程中,需要考虑到散热、信号传输、电源分配等问题,以确保整个系统的稳定运行。
六、可靠性评估TSV技术的可靠性是评估其性能的重要指标之一。
可靠性评估可以通过多种方法来实现,如加速老化试验、环境适应性试验等。
通过可靠性评估,可以了解TSV技术在不同环境和工作条件下的性能表现,为后续改进和优化提供依据。
七、失效分析失效分析是TSV技术中重要的一环,通过对失效样品的检测和分析,可以了解失效的原因和机制,从而提出相应的改进措施。
失效分析方法包括扫描电子显微镜(SEM)、能谱分析(EDS)等。
通过失效分析,可以提高TSV技术的可靠性和稳定性,为实际应用提供更加可靠的解决方案。


详解TSV(硅通孔技术)封装技术硅通孔技术(Through Silicon Via,TSV)技术是一项高密度封装技术,正在逐渐取代目前工艺比较成熟的引线键合技术,被认为是第四代封装技术。
TSV 技术通过铜、钨、多晶硅等导电物质的填充,实现硅通孔的垂直电气互连。
硅通孔技术可以通过垂直互连减小互联长度,减小信号延迟,降低电容/ 电感,实现芯片间的低功耗,高速通讯,增加宽带和实现器件集成的小型化。
基于TSV 技术的3D 封装主要有以下几个方面优势:1)更好的电气互连性能,2)更宽的带宽,3)更高的互连密度,4)更低的功耗,5)更小的尺寸,6)更轻的质量。
TSV 工艺主要包括深硅刻蚀形成微孔,绝缘层/阻挡层/种子层的沉积,深孔填充,化学机械抛光,减薄、pad 的制备及再分布线制备等工艺技术。
主要工艺包括几个部分:(1)通孔的形成;(2)绝缘层、阻挡层和种子层的淀积;(3)铜的填充(电镀)、去除和再分布引线(RDL)电镀;(4)晶圆减薄;(5)晶圆/芯片对准、键合与切片。
TSV 深孔的填充技术是3D 集成的关键技术,也是难度较大的一个环节,TSV 填充效果直接关系到集成技术的可靠性和良率等问题,而高的可靠性和良率对于3D TSV 堆叠集成实用化是至关重要的。
另外一个方面为在基片减薄过程中保持良好的完整性,避免裂纹扩展是TSV 工艺过程中的另一个难点。
目前主要的技术难点分为几个方面:(1)通孔的刻蚀激光刻蚀、深反应离子刻蚀;(2)通孔的填充材料(多晶硅、铜、钨和高分子导体等)和技术(电镀、化学气相沉积、高分子涂布等);(3)工艺流程先通孔或后通孔技术;(4)堆叠形式晶圆到晶圆、芯片到晶圆或芯片到芯片;(5)键合方式直接Cu-Cu 键合、粘接、直接熔合、焊接和混合等;(6)超薄晶圆的处理是否使用载体。
目前,3D-TSV 系统封装技术主要应用于表1 TSV 三维封装应用领域经过数年研发,目前形成具有高良率、不同深宽比结构、高密度微孔、高导通率的3D 封装硅基转接板,可以广泛应用于射频、存储等芯片的三维封装领域。

半导体tsv工艺
半导体TSV工艺是一种新型的三维封装技术,它是通过在晶圆上开孔,将芯片内部的电路通过垂直连接器连接到晶圆的另一侧,从而实现芯片内部电路的三维堆叠。
TSV是Through Silicon Via的缩写,意为通过硅通孔。
半导体TSV工艺是一种先进的封装技术,它可以将多个芯片进行堆叠,从而实现更高的性能和更小的封装尺寸。
相比传统的封装技术,半导体TSV工艺具有以下优点:
1.更高的性能:半导体TSV工艺可以将多个芯片堆叠在一起,从而实现更高的性能。
由于芯片之间的距离更近,信号传输速度更快,同时也减少了信号传输的损失。
2.更小的封装尺寸:半导体TSV工艺可以将多个芯片堆叠在一起,从而实现更小的封装尺寸。
这对于移动设备等小型电子产品来说非常有利,可以实现更小巧的设计。
3.更低的功耗:半导体TSV工艺可以实现更短的信号传输路径,从而减少功耗。
这对于需要长时间使用的电子产品来说非常有利。
半导体TSV工艺的制造过程包括以下步骤:
1.晶圆准备:首先需要准备好晶圆,并在晶圆上进行刻蚀和清洗等处理,以便后续的工艺步骤。
2.TSV开孔:在晶圆上开孔,通过硅通孔将芯片内部的电路连接到晶圆的另一侧。
3.金属填充:将金属填充到开孔中,以便后续的连接。
4.封装:将多个芯片堆叠在一起,并进行封装,以保护芯片并提高性能。
半导体TSV工艺是一种非常先进的封装技术,它可以实现更高的性能和更小的封装尺寸。
随着电子产品的不断发展,半导体TSV工艺将会越来越广泛地应用于各种领域。

新型硅通孔(TSV)的电磁特性研究新型硅通孔(TSV)的电磁特性研究引言在现代电子器件中,芯片内部不同层次的互连是实现器件功能的重要组成部分。
随着半导体技术的不断发展,为了满足更高的处理速度和更大的集成度需求,三维集成电路(3D-IC)技术逐渐崭露头角。
而新型硅通孔(TSV)是实现3D-IC技术的核心部件之一。
本文将就TSV的电磁特性进行研究,探讨其在电磁波传输方面的影响。
1. TSV的定义和结构TSV即新型硅通孔(Through Silicon Via),是一种在硅晶片上实现垂直电连接的微细孔洞。
其基本结构包括上下两个金属壳,即上层金属(UM1)和下层金属(LM1),以及填充间隔层(IS1)。
TSV的孔洞通过硅基底,将上下两层金属电极连接在一起。
这种结构使得芯片内部层间互连更加紧凑,并可在芯片的不同层次之间进行电信号的高速传输。
2. TSV的电磁特性研究方法为了准确研究TSV的电磁特性,我们首先采用有限差分时域(FDTD)方法对TSV进行数值模拟,分析其在电磁波传输中的响应。
同时,为了验证数值模拟结果的准确性,我们还进行了实验测试,对TSV进行了电磁特性的测量。
通过比较实验结果和数值模拟结果,我们可以得出准确的结论。
3. TSV的电磁波传输特性在电磁波传输中,TSV会对信号的频率、传输损耗和信号延迟等产生影响。
通过对TSV的电磁特性进行研究,我们可以得到以下结论:3.1 TSV的分布电容对频率响应的影响TSV作为一种电连接通道,具有一定的分布电容。
这种分布电容导致了TSV的电磁响应在高频段产生明显的衰减。
因此,在高频信号传输中,TSV会引起传输信号的衰减和失真现象。
为了解决这个问题,可以采取优化设计方法,如增加TSV的直径或改变其结构以降低分布电容。
3.2 TSV的传输损耗TSV的传输损耗是指信号经过TSV传输时所产生的能量损耗。
传输损耗主要有两个因素:金属电极导线的电阻和附近材料的电磁耗散。

书山有路勤为径,学海无涯苦作舟应用于TGV 的ICP 玻璃刻蚀工艺研究玻璃通孔( TGV) 技术被认为是下一代三维集成的关键技术,该技术的核心为深孔形成工艺。
感应耦合等离子体(随着半导体制造工艺向深亚微米及纳米级发展,传统的光刻技术逐渐接近极限,集成电路晶体管数目的增加和特征尺寸的缩小越发缓慢和困难,摩尔定律的延续面临巨大挑战。
同时,传统封装中信号传输距离长带来的互连延迟问题日益严重,难以满足芯片高速和低功耗的要求。
为克服集成电路和传统封装面临的难题,三维集成技术应运而生。
其中硅通孔( Through Silicon Via,TSV) 技术被认为是实现三维集成最有前景的技术。
TSV 技术通过在芯片与芯片、晶圆与晶圆之间制作垂直通孔,实现芯片之间的直接互连。
它能够使芯片在三维方向堆叠的密度最大、芯片间的互连线最短、外形尺寸最小,显著提高芯片速度,降低芯片功耗,因此成为目前电子封装技术中最引人注目的一种技术。
然而,硅是一种半导体材料,TSV 周围的载流子在电场或磁场作用下可以自由移动,对邻近的电路或信号产生影响,影响芯片性能。
玻璃材料没有自由移动的电荷,介电性能优良,热膨胀系数( CTE) 与硅接近,以玻璃替代硅材料的玻璃通孔( Through Glass Via,TGV) 技术可以避免TSV 的问题,是理想的三维集成解决方案。
此外,TGV 技术无需制作绝缘层,降低了工艺复杂度和加工成本。
TGV 及相关技术在光通信、射频、微波、微机电系统、微流体器件和三维集成领域有广泛的应用前景。
TGV 技术面临的关键问题是没有类似硅的Bosch 深刻蚀工艺,难以快速制作高深宽比的玻璃深孔或沟槽。
传统的喷砂法、湿法刻蚀法和激光钻孔法等均存在一定的局限性。
感应耦合等离子体(。

TSV通孔技术研究介绍了TSV技术及其优势,针对TSV中通孔的形成,综述了国内外研究进展,提出了干法刻蚀、湿法刻蚀、激光钻孔和光辅助电化学刻蚀法(PAECE)等四种TSV通孔的加工方法,并对各种方法进行了比较,提出了各种方法的适用范围。
标签:TSV 干法刻蚀湿法刻蚀激光钻孔光辅助电化学刻蚀0 引言TSV (through silicon via)技术是穿透硅通孔技术的缩写,一般简称硅通孔技术。
图1所示是4层芯片采用载带封装方法(见图1(a))和采用TSV方法(见图1(b))封装的外形比较。
采用硅通孔TSV 技术的3D 集成方法能提高器件的数据交换速度、减少功耗以及提高输入/输出端密度等方面的性能[1-2]。
采用TSV 技术也可以提高器件的良率,因为大尺寸芯片可以分割为几个功能模块的芯片(小尺寸芯片具有更高的器件良率),再将它们进行相互堆叠的垂直集成,或者将它们在同一插入中介层上进行彼此相邻的平面集成。
1 TSV的主要技术环节硅通孔技术主要有通孔的形成、晶片减薄及TSV键合三大技术环节。
■(a)(b)图1 TSV封装的外形比较1.1 通孔的形成TSV技术的核心是在晶片上加工通孔,目前,通孔加工技术主要包括干法刻蚀、湿法腐蚀、激光钻孔以及光辅助电化学刻蚀四种。
1.2 晶片减薄为了保证通孔形成的孔径和厚度比例在一个合理的范围内,采用3D封装的晶片必须要进行减薄。
目前,比较先进的多层封装技术能够将芯片的厚度控制在100μm以下,未来的芯片厚度需要减薄到25μm-1μm近乎极限的厚度。
目前多采用磨削加工技术进行晶片减薄,为了解决减薄后晶片不发生翘曲、下垂以及表面损伤扩大以及晶片破裂等问题,在磨削过程中必须保持晶片始终保持平整状态,这也是晶片减薄技术中急需解决的问题。
1.3 TSV键合TSV键合技术是指完成通孔金属化和连接端子晶片之间的互连。
金属-金属键合技术以及高分子粘结键合技术等是其主要采用的技术,而目前最主要采用的键合技术是金属-金属键合技术。

硅通孔(TSV)电学传输特性分析与优化硅通孔(TSV)电学传输特性分析与优化摘要:硅通孔(TSV)是一种用于芯片内部互联的三维封装技术。
本文通过对TSV电学传输特性的分析与优化,探讨了TSV的制备工艺对其性能的影响,并提出了一些优化措施。
1. 引言随着芯片尺寸的不断减小和集成度的不断提高,二维封装方式逐渐不能满足芯片内部大规模互联的需求。
硅通孔(TSV)作为一种三维封装技术,能够实现芯片内部的垂直互联,为芯片的高集成度提供可能。
TSV的电学传输特性的分析与优化对于实现高性能的三维封装至关重要。
2. TSV的制备工艺TSV的制备通常包括刻蚀、填充和研磨等步骤。
刻蚀是将硅衬底上的孔洞形成的过程,可以采用干法或湿法刻蚀。
填充是将导电材料填充到TSV中,常用的填充材料有铜、银等。
研磨是将填充材料的余量删减至需要的高度,以便与芯片的上下层相连接。
制备工艺的参数设置和优化对于TSV的电学传输特性具有重要影响。
3. TSV的电学传输特性分析TSV的电学传输特性可以通过测试TSV的电阻和电容来进行分析。
电阻是TSV的主要电学性能指标之一,影响着信号传输的速度和功耗。
电阻的大小与TSV的尺寸、填充材料和制备工艺等因素有关。
电容是TSV的另一个重要性能指标,反映了TSV 的电荷传输能力。
电容的大小与TSV的尺寸、绝缘层的厚度等因素相关。
4. TSV的电学传输特性优化为了优化TSV的电学传输特性,可以采取以下措施:4.1 优化制备工艺参数制备工艺参数的优化对于TSV的电学性能具有重要影响。
如刻蚀参数的优化可以改善TSV的表面平整度,减小接触电阻。
填充材料的选择和填充参数的优化可以改善TSV的导电性能。
研磨参数的优化可以减小TSV的表面粗糙度,降低剩余电阻。
4.2 优化填充材料填充材料的选择对TSV的电阻有着重要影响。
铜是一种常用的填充材料,具有较低的电阻和较高的导电性能。
然而,铜容易产生应力,导致TSV的可靠性下降。

TSV技术发布时间:2011-8-25 10:31:47 访问次数:42521.TSV及其技术优势A1280XL-PC84CTSV(through silicon via)技术是穿透硅通孔技术的缩写,一般简称硅通孔技术,是三维集成电路中堆叠芯片实现互连的一种新的技术解决方案。
由于TSV能够使芯片在三维方向堆叠的密度最大、芯片之间的互连线最短、外形尺寸最小,并且大大改善芯片速度和低功耗的性能,成为目前电子封装技术中最引人注目的一种技术。
如图5.5.8所示是4层芯片采用带载封装方法(tape carrier package,TCP)(见图5.5.8(a))和采用TSV 方法(见图5.5.8(b))封装的外形比较。
业内人士将TSV称为继引线键合(wire bonding)、载带键合(TAB)和倒装芯片(FC)乏后的第4代封装技术。
TSV技术的优势:①缩小封装尺寸;②高频特性出色,减小传输延时、降低噪声;③降低芯片功耗,据称,TSV可将硅锗芯片的功耗降低大约40%;④热膨胀可靠性高。
2.TSV的主要技术环节1)通孔的形成晶片上的通孔加工是TSV技术的核心,目前通孔加工的技术主要有两种,一种是深反应离子刻蚀,另一种是激光打孔。
激光技术作为一种不需掩模的工艺,避免了光刻胶涂布、光刻曝光、显影和去胶等工艺步骤,已取得重大进展。
然而,未来当TSV的尺寸通孔降到lOUm以下时,激光钻孔就面临着新的挑战。
目前这两种技术的细节及其选择仍然在探索中,不过一些先期进入的厂商已经推出相应的加工设备。
此外,形成通孔后还有绝缘层、阻挡层和种子层的淀积以及孔金属化等工艺技术。
图5.5.9是6个芯片堆叠采用TSV封装的存储器示意图。
2)晶片减薄如果不用于3D封装,目前0.3~0.4mm的晶片厚度没有问题,但如果晶片用于3D封装则需要减薄,以保证形成通孔的孔径与厚度比例在合理范围,并且最终封装的厚度可以接受。
即使不考虑层堆叠的要求,单是芯片间的通乳互连技术就要求上层芯片的厚度在20~30μm,这是现有等离子开孔及金属沉积技术比较适用的厚度。
三维集成电路(3D IC)中硅通孔(TSV)链路的多场分析三维集成电路(3D IC)中硅通孔(TSV)链路的多场分析引言:随着电子技术的不断发展,集成电路的功能越来越复杂,对于电路板的布局和连接的要求也越来越高。
传统的2D集成电路已经面临着功耗、散热和信号传输等问题,为了克服这些问题,人们提出了3D集成电路(3D IC)的概念。
3D IC通过垂直堆叠多层芯片来实现更高的集成度和性能。
而硅通孔(TSV)链路作为3D IC中芯片间的关键连接组件,受到了广泛关注。
本文将对TSV链路进行多场分析,探讨其在3D IC中的性能和优化方法。
1. TSV链路的结构与工作原理TSV链路是一种通过在不同芯片间钻孔并填充导电材料的技术,用于实现芯片间的电信号传输和能量供应。
典型的TSV链路结构包括导电填充物、绝缘层以及TSV孔的孔壁。
TSV链路的工作原理是通过导电填充物提供电信号和能量传输的路径,而绝缘层则用于隔离相邻的TSV链路。
2. TSV链路的挑战与问题尽管TSV链路在3D IC中起到了关键的作用,但是它也带来了一些挑战与问题。
首先,TSV孔的填充过程需要解决填充物与孔壁之间的黏附性和填充度的问题。
其次,在高频电信号传输方面,TSV链路可能会引起信号的损耗和噪声,从而影响系统性能。
另外,由于3D IC中芯片的堆叠密度较高,TSV链路的散热问题也不可忽视。
3. TSV链路的多场分析方法为了解决上述问题,人们利用电磁场理论、热传导理论和机械力学理论等多场分析方法对TSV链路进行研究。
在电磁场方面,可以通过研究TSV链路的等效电路模型和传输线理论来分析电信号的传输损失和噪声问题。
在热传导方面,可以通过模拟TSV链路的热传导路径和热源来分析散热性能。
在机械力学方面,可以分析TSV链路在机械应力下的稳定性和可靠性。
4. TSV链路的优化方法为了提高TSV链路的性能,人们提出了一系列的优化方法。
例如,在TSV孔填充过程中可以选择合适的填充材料和填充工艺,以提高填充度和黏附性。
三维集成电路封装的TSV技术1.引言三维集成电路(3D IC)和基于硅介质的2.5D集成电路具有低功耗、性能高、高功能集成度[1–4]等优点,被认为是克服摩尔定律局限性的重要电路。
为实现3D 和2.5D芯片集成,需要几个关键技术,如硅通孔(TSV)、晶片减薄处理以及晶圆/芯片粘接等。
TSV技术具有缩短互连路径和缩小封装尺寸的优点,因此被认为是3D集成的核心。
在3D和2.5D芯片集成过程中,TSV工艺可分为三种类型。
当TSV工艺在CMOS工艺进行之前完成时,工艺进程定义为“通孔优先(via first)”;当TSV工艺在CMOS工艺进行中完成时,CMOS中间工艺和后道工艺只能在TSV工艺完成后制作;当TSV在完成CMOS过程后进行时,工艺进程定义为“通孔收尾(via last)”,在已进行CMOS工艺后的衬底正面或背面进行TSV工艺。
选择TSV作为最终方案是在半导体行业最终应用要求。
TSV技术已被开发用于许多应用领域,如MEMS、移动电话、CMOS图像传感器(CIS)、生物应用程序设备和存储器等。
人们对TSV工艺进行了大量研究。
目前,由于制造成本相对较高,TSV在三维集成电路和先进封装应用中尚未普遍实现[5,6]。
本文将介绍当TSV制作直径较小、纵横比较高时,TSV的相关重要制造过程及相关失效模式。
此外,TSV制备有许多重要过程,包括深层反应离子蚀刻(DRIE)、介电层衬底、阻挡层和种晶层、填充、化学机械抛光(CMP)和Cu暴露过程,上述关键技术将在下面详细介绍。
2.TSV刻蚀技术TSV蚀刻是3D集成技术中的关键制造工艺,而广泛使用的Bosch工艺是深硅蚀刻的首选。
Bosch蚀刻工艺的高蚀刻速率为5~10 μm/min,对光刻胶的刻蚀选择性为50-100,甚至对于氧化层掩膜高达200。
该过程通过以下步骤执行:(1)利用六氟化硫作为等离子体刻蚀剂进行硅刻蚀;(2)与C4F8等离子体气体结合,生成质量良好的钝化膜,以防止下一刻蚀步骤中的横向效应;(3)利用六氟化硫作为等离子体刻蚀剂,对掩蔽层和Si进行进一步的离子轰击定向刻蚀,以形成一个较深的刻蚀深度。
0引言三维集成封装技术被公认为是超越摩尔定律的第四代封装技术。
硅通孔(Through Silicon Via ,TSV)技术是三维封装技术的关键[1]。
摩尔定律指出,硅片上的晶体管数量大约每两年翻一番[2]。
然而,由于晶体管的缩放比例和漏电的限制[3],摩尔定律不能永远持续下去。
随着晶体管尺寸越来越小,晶体管数量越来越多,晶体管之间的间距也越来越小。
最终会引起量子隧穿效应,电子会在两根金属线之间隧穿,导致短路[4-5]。
因此,存在一个极限,超过这个极限,摩尔定律将失效。
一种实现突破传统摩尔定律的封装摩尔定律被提出,封装摩尔定律是基于三维集成封装技术提出的[6]。
TSV 技术是指在硅片上进行微通孔加工,在硅片内部填充导电材料,通过TSV 技术实现芯片与芯片之间的垂直互连,是三维封装技术的关键技术[7-8]。
与传统的金丝键合相比,TSV 的优点是节省了外部导体所占的三维空间。
TSV 技术可以使微电子芯片封装实现最紧密的连接和最小的三维结构。
此外,由于芯片之间的互连线长度的缩短,大大降低了互连延迟,从而提高了运行速度。
并且由于互连电阻的降低,电路的功耗也大大降低[9]。
TSV 不仅广泛地应用于信息技术,而且在飞机、汽车和生物医学等新领域都得到了广泛的应用,因为三维大规模集成电路具有很多优势,如高性能、低功耗、多功能、小体积[10]。
TSV 是一种颠覆性技术,被认为是实现“超越摩尔定律”的有效途径,在未来主流器件的设计和生产中会得到广泛应用。
1TSV 可靠性概述随着三维集成封装技术的发展,TSV 技术已成为三维堆叠封装中最关键的技术之一。
作为芯片与芯片之间重要的物理连接和电气连接,TSV 的可靠性无疑是决定TSV 可靠性综述王硕1,马奎1,2,杨发顺1,2(1.贵州大学大数据与信息工程学院,贵州贵阳550025;2.半导体功率器件可靠性教育部工程研究中心,贵州贵阳550025)摘要:对硅通孔(Through Silicon Via ,TSV)技术的可靠性进行了综述,主要分为三个方面:热应力,工艺和压阻效应。
硅通孔TSV关键降低成本和解决工艺路线因为工艺流程微缩和低介电值材料的限制,3D 堆叠技术被视为能否以较小尺寸制造高效能芯片的关键,而硅通孔( TSV) 可通过垂直导通整合晶圆堆叠的方式,达到芯片间的电路互连,有助于以更低的成本,提高系统的整合度与效能,是实现集成电路3D化的重要途径。
目前,各大半导体厂商均已将TSV纳入技术蓝图,TSV应用开始起步。
未来,TSV的应用将取决于制造成本的进一步降低,以及业界对TSV发展途径的认识统一。
1硅通孔TSV应用起步硅通孔TSV目前的应用主要集中在两个方面:一是网络大数据,二是内存制造领域。
TSV技术是半导体集成电路产业迈向3D时代的关键技术。
它允许半导体裸片和晶圆以较高的密度互连在一起,将传统的芯片之间引线连接的方式彻底改变,通过在芯片晶圆上开凿微型导孔来实现上下的导通。
尽管3D封装可以通过引线键合、倒装(Flip Chip )凸点等各种通路键合技术实现,但TSV技术依然是集成度最高、应用前景最广的方案。
随着各大半导体厂商陆续将TSV立体堆叠纳入技术蓝图,目前TSV应用市场已经开始启动,业界对未来TSV的应用前景十分看好。
长电科技副总经理梁新夫认为:TSV目前的应用主要集中在两个方面:一是网络大数据,这个领域对芯片性能要求很高,对价格也不是很敏感;二是内存制造领域,这个领域不断追求更大的存储容量。
市场调研机构Yole Developpement 先进封装部市场暨技术分析师Lionel Cadix 指出,3D IC通常使用TSV技术来堆栈内存和逻辑IC ,预计此类组件将快速成长;预计到2017 年应用TSV 封装的3D IC或3D-WLCSP平台的产品产值可望增长到400亿美元,占整个半导体市场的9%。
2推进低成本方案是关键相比其他解决方案成本更高,是阻碍TSV发展和实际应用的主因之一。
TSV虽然已经得到部分应用,无可否认仍然存在诸多不完善之处,这包括制造成本的降低、技术工艺的完善以及业界对其发展路径认识的统一。