半导体可靠性数学基础
- 格式:ppt
- 大小:1.72 MB
- 文档页数:35

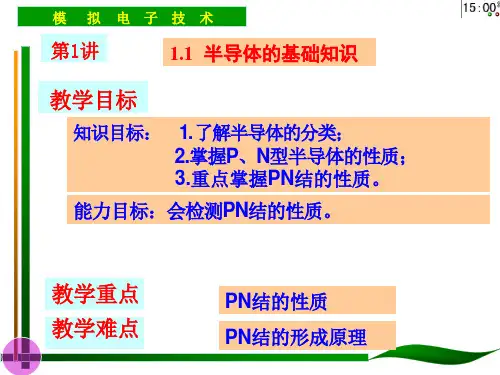



目录1.可靠性项目1.1设计过程中的可靠性1.2技术开发1.3验证和产品开发1.4试产1.5量产2.可靠性分析的基本原理2.1可靠性的定义2.2Bathtub曲线2.2.1早期失效阶段2.2.2随机失效阶段2.2.3末期失效阶段3.可靠性测试方法3.1加速老化试验3.1.1温度加速老化试验3.1.2活化能3.1.3电压加速试验3.1.4温度循环加速老化试验3.1.5适度加速老化试验4.数据分析的可靠性函数4.1可靠性函数的定义4.2失效分布函数4.3失效概率密度函数4.4失效比率函数4.5单位故障率4.6不同概率函数的应用4.6.1指数分布4.6.2简单故障率统计4.6.3Weibull 分布4.6.4对数正态分布4.6.5对数正态分布的应用5.应力测试技术5.1热载体寿命5.2电迁移5.3时间依赖的电子击穿(TDDB)6.产品应力测试的验证6.1高温寿命测试6.1.1高温栅偏压(HTGB)6.1.2高温逆向偏压(HTRB)6.1.3高温工作寿命(HTOL)6.2环境测试6.2.1Popcom效应核算6.2.2高温存储(HTS)6.2.3温度循环测试(TC)6.2.4温度湿度偏压测试(THB)6.2.5高加速温湿度老化测试(HAST)6.2.6高压炉测试(PCT)6.2.7间歇性操作寿命(IOL)备注:因课件内容较多,本人会尽快整理撰写分多期逐步更新,尽量缩短更新周期1.可靠性项目在功率器件应用中,高功率器件会经常遇到。
努力让功率器件可靠的实现它们预期的应用。
为了实现这个目标,可靠性测试将贯穿整个产品周期。
、1.1设计中的可靠性在设计阶段,特别是为了一个新的技术而又一个新的平台导入时,应执行全面的计算和模拟测试以确保设计的电参数和其他可靠性特性已最优化。
例如,当击穿电压需要改变时,模拟测试应包含所有结构的改变去最优化击穿电压,阈值电压,沟道电阻,各种寄生电容和权衡UIS稳健性等。
对于一个新的封装设计,热敏电阻时非常重要的,应执行全面的3-D有限元素分析的模拟测试。






可靠性可靠性基础基础Xie Meng-xian. (电子科大,成都市)半导体器件和集成电路的可靠性评估(即失效率预测,failure rate prediction )是一个重要的问题。
可靠性评估实际上也就是采用通过寿命试验而得到的失效的数据、来估算出器件和集成电路的有效使用寿命。
有效使用寿命即为器件和集成电路能够正常工作的平均平均平均使用使用使用时间时间(MTTF ,mean time tofailure );与此密切相关的概念是失效率失效率失效率、可靠性指标可靠性指标可靠性指标等可靠性参量。
因为通过寿命试验而获得的失效数据,往往遵从某种统计规律的分布函数——可靠性函数,所以根据这些试验数据,由可靠性函数规律出发,即可估算出器件和集成电路的MTTF和失效率等参量。
(1)失效的失效的模式模式模式::半导体器件和集成电路会由于各种原因而失效,但是失效率往往与使用时间有关。
若在经过时间t 之后未失效器件的数目为R(t),则通过寿命试验可以获得大致如图1所示的三种失效模式的函数关系:①早期失效模式;②偶发失效模式;③磨损失效模式。
在数学上可用来描述这些失效模式的函数即称为可靠性函数。
对于偶发失效的模式,比较符合实际的可靠性函数是指数函数;由此可知偶发失效的失效率是一个常数,即不管经过多长时间,器件失效的几率都是一样的;根据这种可靠性函数,可较容易地进行分析。
比偶发失效更早发生的失效称为早期失效。
大多数半导体器件和集成电路所出现的失效都属于早期失效模式。
对于这种很快就会发生失效的器件和电路,一般都可以在使用之前、通过例行试验(即采用一定条件的筛选工艺)来去除掉,以免带来后患。
磨损失效也称为疲劳失效,其特点是开始阶段的故障少,然后故障不断增加。
(2)可靠性函数可靠性函数——————统计分布统计分布统计分布::可靠性函数都是一些统计分布函数。
从统计角度来看,统计数据的分布函数有许多种,常用的有如指数分布、Gauss 分布、Γ分布、对数正态分布和Weibull 分布,它们的功能各有千秋。