IC工艺原理 制造第7章
- 格式:ppt
- 大小:11.25 MB
- 文档页数:57
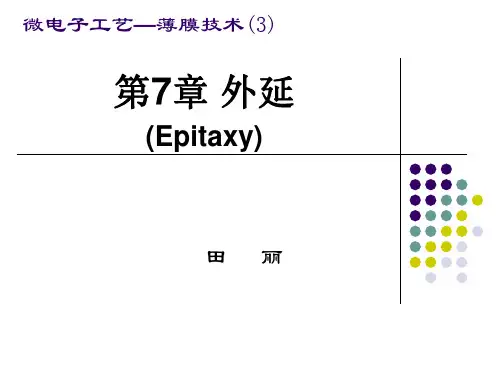





第7章薄膜工艺IC 芯片的制作过程实际上就是在硅衬底上多次反复进行薄膜形成、光刻、掺杂等加工。
大多数薄膜形成是通过淀积方式在衬底上形成薄膜,硅氧化生长的SiO 2薄膜是硅材料本身同氧气进行化学反应而成,硅的外延则是一种特殊的薄膜工艺,它只能在硅的单晶上生长硅的薄膜。
淀积的方法有两类:物理淀积与化学淀积。
真空蒸发、溅射、分子束外延等属于物理淀积,利用化学反应过程的生长方法称为化学淀积。
化学淀积分液相淀积与气相淀积,电镀就是液相淀积。
7.1 蒸发7.2 溅射7.3 化学气相淀积(CVD )7.4 外延7.5 其它薄膜生长方式7.6 金属化工艺本章内容7.1 蒸发真空腔硅圆片淀积材料坩埚机械泵初级抽气泵扩散泵冷阱放气阀早期半导体工艺的金属层全由蒸发的方式淀积。
蒸发的过程是在真空条件下,把蒸发的材料加热熔化,从固体变成液体,再变成气体。
淀积的速率同该材料的蒸汽压有关,不同的材料其蒸汽压不同。
为了得到合适的淀积速率,一般要求蒸汽压至少应为10mTorr 。
常用材料的蒸气压三种坩埚加热方式三种坩埚加热方式电阻加热方式(灯丝)源棒(放在灯丝里面)加热灯丝电阻加热方式(坩埚)淀积材料感应加热方式(坩埚)淀积材料氮化硼坩埚感应线圈电子束蒸发方式(电阻加热和感应加热都存在加热元件材料沾污的问题)淀积材料电子束偏转磁铁偏转磁铁灯丝加速栅极多组分薄膜对于蒸气压很接近的两种或多种材料,例如Al 和Cu ,可以把这些材料的混合物放在一个坩埚里蒸发,或制成合金进行蒸发。
单源蒸发硅圆片合金膜合金溶液硅圆片合金膜多源同时蒸发材料2材料1对于蒸气压相差很大的合金,如TiW ,用单源蒸发方式开始蒸发出来的蒸汽几乎是纯钛,所以很难得到正确的合金组份。
采用多源方式,一个放Ti ,一个放W ,然后同时蒸发,可以有很好的改进,但是仍留下蒸气压的问题。
硅圆片分层淀积材料1多源按次序蒸发材料2挡板对于多成分薄膜的一种替代方法就是利用挡板的打开与关闭进行按次序淀积,然后提高样品的温度让各组分互相扩散,从而形成合金。

![集成电路制造技术——原理与工艺(第二版)-第7章-PVD[43页]精选全文完整版](https://uimg.taocdn.com/038621550a4c2e3f5727a5e9856a561252d321ac.webp)



半导体工艺及芯片制造复习资料简答题与答案第一章、半导体产业介绍1 .什么叫集成电路?写出集成电路发展的五个时代及晶体管的数量?(15分)集成电路:将多个电子元件集成在一块衬底上,完成一定的电路或系统功能。
集成电路芯片/元件数 无集成1 小规模(SSI )2到50 中规模(MSI )50到5000 大规模(LSI )5000到10万 超大规模(VLSI ) 10万至U100万 甚大规模(ULSI ) 大于100万 产业周期1960年前 20世纪60年代前期 20世纪60年代到70年代前期 20世纪70年代前期到后期 20世纪70年代后期到80年代后期 20世纪90年代后期到现在2 .写出IC 制造的5个步骤?(15分)Wafer preparation (硅片准备)Wafer fabrication (硅片制造)Wafer test/sort (硅片测试和拣选)Assembly and packaging (装配和封装)Final test (终测)3 .写出半导体产业发展方向?什么是摩尔定律?(15分)发展方向:提高芯片性能一提升速度(关键尺寸降低,集成度提高,研发采用新材料),降低功耗。
提高芯片可靠性一严格控制污染。
降低成本——线宽降低、晶片直径增加。
摩尔定律指:IC 的集成度将每隔一年翻一番。
1975年被修改为:IC 的集成度将每隔一年半翻一番。
4 .什么是特征尺寸CD ? (10分)最小特征尺寸,称为关键尺寸(Critical Dimension, CD ) CD 常用于衡量工艺难易的标志。
5.什么是 More moore 定律和 More than Moore 定律?(10 分)“More Moore”指的是芯片特征尺寸的不断缩小。
从几何学角度指的是为了提高密度、性能和可靠性在晶圆水平和垂直方向上的特征尺寸的继续缩小。
与此关联的3D结构改善等非几何学工艺技术和新材料的运用来影响晶圆的电性能。