半导体热载流子效应
- 格式:docx
- 大小:3.26 KB
- 文档页数:2
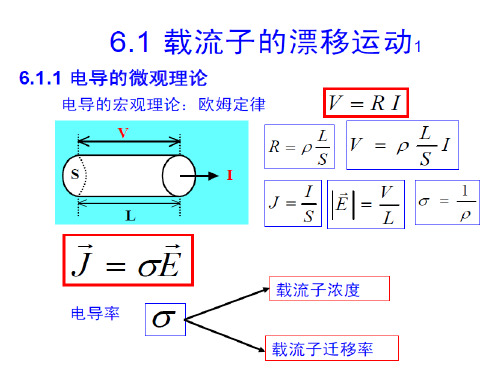

浅析半导体的热电效应冯启业222007322072003电科一班摘要:把热能转换为电能的所谓热电效应的发现已有一个半世纪的历史,这是与温度梯度的存在有关的现象,其中最重要的是温差电现象。
但是,由于金属的温差电动势很小,只是在用作测量温度的温差电偶方面得到了应用。
半导体出现后,发现它能得到比金属大得多的温差电动势,在热能与电能的转换上,可以有较高的效率,因此,在温差发电、温差致冷方面获得了发展。
由于温度梯度及电流同时存在时引起的一些现象——主要是塞贝克效应、珀尔帖效应和汤姆逊效应。
关键词:热电效应塞贝克效应珀尔帖效应汤姆逊效应正文:一、塞贝克效应塞贝克(Seeback)效应,又称作第一热电效应,它是指由于两种不同电导体或半导体的温度差异而引起两种物质间的电压差的热电现象。
在两种金属A和B组成的回路中,如果使两个接触点的温度不同,则在回路中将出现电流,称为热电流。
塞贝克效应的实质在于两种金属接触时会产生接触电势差,该电势差取决于金属的电子逸出功和有效电子密度这两个基本因素。
半导体的温差电动势较大,可用作温差发电器。
产生Seebeck效应的主要原因是热端的载流子往冷端扩散的结果。
例如p型半导体,由于其热端空穴的浓度较高,则空穴便从高温端向低温端扩散;在开路情况下,就在p型半导体的两端形成空间电荷(热端有负电荷,冷端有正电荷),同时在半导体内部出现电场;当扩散作用与电场的漂移作用相互抵消时,即达到稳定状态,在半导体的两端就出现了由于温度梯度所引起的电动势——温差电动势。
自然,p型半导体的温差电动势的方向是从低温端指向高温端(Seebeck系数为负),相反,n型半导体的温差电动势的方向是高温端指向低温端(Seebeck系数为正),因此利用温差电动势的方向即可判断半导体的导电类型。
可见,在有温度差的半导体中,即存在电场,因此这时半导体的能带是倾斜的,并且其中的Fermi 能级也是倾斜的;两端Fermi能级的差就等于温差电动势。

热载流子效应是MOS管中一种重要的失效机制。
当沟道长度减小,同时保持电源电压不变,沟道区靠近漏端附近的最大电场增加。
随着载流子从源向漏移动,它们在漏端高电场区将得到足够的动能,引起碰撞电离,一些载流子甚至能克服Si-Si02界面势垒进入氧化层,这些高能载流子不再保持它们在晶格中的热平衡状态,并且具高于热能的能量,因此称它们为热载流子。
对于正常工作中的MOSFET,沟道中的热载流子引起的效应称为热载流子效应。
当发生碰撞时,热载流子将通过电离产生次级电子一空穴对,其中电子形成了从漏到源的电流,碰撞产生的次级空穴将漂移到衬底区形成衬底电流Ib。
通过测量Ib可以很好地监控沟道热载流子和漏区电场的情况。
由于Si-Si02的界面势垒较高,注入到栅氧化层中的热载流子与碰撞电离产生的热载流子相比非常少,因此栅电流比衬底电流要低几个数量级。

热载流子效应对半导体器件的影响主要表现在以下几个方面:
对双极型器件的影响:在双极型器件中,热载流子会造成击穿电压的弛豫,同时pn极漏电流增加。
对MOS器件的影响:在MOS器件中,热载流子效应会导致mos晶体管的阈值电压、漏极电流、漏极电流ids和跨导等参数的漂移。
可靠性影响:无论是MOS器件还是双极型器件,热载流子效应都会导致磨损型失效机理的出现。
在亚微米和深亚微米器件中,热载流子效应对可靠性的危害更大。
热载流子效应的产生受到多个因素的影响,包括工作温度和电流密度等。
随着温度的升高,电子-空穴对的生成和注入增加,从而导致热载流子效应进一步加剧。
当电流密度较高时,电子-空穴对的注入增加,导致更多的载流子耗散为热能,进而引起热载流子效应。


SIC 热载流子前言半导体行业正处于快速发展的阶段,而碳化硅(SiC)作为一种新型的宽禁带半导体材料,由于其优异的物理和电学性能,正受到越来越多的关注和研究。
其中,SiC热载流子效应是SiC器件中一种重要的物理现象,它对SiC器件的性能和可靠性有很大的影响。
热载流子效应热载流子效应是指在高电场或高温条件下,半导体中的载流子(电子和空穴)获得足够的能量,从而能够克服半导体材料的带隙,从价带跃迁到导带,成为自由载流子。
这些自由载流子具有很高的能量,因此被称为“热载流子”。
SiC 中的热载流子效应SiC是一种宽禁带半导体材料,其带隙为 3.26eV,远高于硅(Si)的1.12eV。
因此,在相同电场或温度条件下,SiC中的热载流子浓度远低于Si。
然而,由于SiC具有较高的热导率和较低的热膨胀系数,因此在高功率器件中,SiC器件的结温往往高于Si器件。
因此,在高功率器件中,SiC器件的热载流子效应可能更为显著。
热载流子效应对SiC器件的影响热载流子效应对SiC器件的性能和可靠性有很大的影响。
一方面,热载流子可以导致器件的漏电流增加,从而降低器件的开关效率。
另一方面,热载流子还可以导致器件的击穿电压降低,从而降低器件的可靠性。
抑制热载流子效应的方法为了抑制热载流子效应,可以采取以下措施:减少器件的结温。
这可以通过减小器件的功耗或提高器件的散热性能来实现。
优化器件的结构。
这可以通过减小器件的沟道长度或增加器件的沟道宽度来实现。
采用特殊工艺。
这包括使用应力工程或掺杂工程来改变器件的能带结构,从而抑制热载流子效应。
结语SiC热载流子效应是SiC器件中一种重要的物理现象,它对SiC器件的性能和可靠性有很大的影响。
通过采取适当的措施,可以抑制热载流子效应,从而提高SiC器件的性能和可靠性。
ldmos 热载流子效应
LD-MOS(Lateral Double-Diffused MOS)是一种常见的金属氧化物半导体场效应晶体管,其特点是具有较低的开关电阻和较高的功率密度。
在LD-MOS中,热载流子效应是一种重要的现象,它对器件的工作性能和可靠性有着重要影响。
热载流子效应是指当LD-MOS器件工作在高功率状态下,由于电流通过通道时产生的热量,会导致通道温度升高。
随着温度的升高,载流子的迁移率会下降,从而导致电阻增加,进一步造成温度升高、电阻增加的正反馈效应,使得通道温度迅速升高,电阻急剧增加,最终导致器件失效。
为了避免热载流子效应对LD-MOS器件的影响,人们采取了一系列的措施。
首先,通过优化器件结构和材料选择,降低器件内部的热阻,提高散热效果,从而减小热载流子效应的影响。
其次,可以通过合理设计电路,控制器件工作状态,在保证器件性能的前提下,降低功率密度,减小载流子发热量,从而降低热载流子效应的影响。
还可以采用温度补偿技术来消除热载流子效应的影响。
通过在器件中引入温度传感器,实时监测通道温度的变化,并根据温度变化调整电路工作状态,以实现温度的自动补偿。
这样可以有效地降低热载流子效应的影响,提高器件的稳定性和可靠性。
LD-MOS热载流子效应是在高功率工作状态下,由于电流通过通道
时产生的热量导致的。
为了避免热载流子效应对器件的影响,需要通过优化器件结构、合理设计电路和采用温度补偿技术等措施来降低功率密度和温度升高,提高器件的稳定性和可靠性。
这样的措施不仅可以提高LD-MOS器件的性能,还可以延长其使用寿命,满足不同领域对功率器件的需求。
重庆邮电大学研究生堂下考试答卷2011-2012学年第2学期考试科目微电子器件可靠性姓名徐辉年级2011级专业微电子与固体电子学学号S11040301020120122年5月25日热载流子效应对器件可靠性的影响徐辉(重庆邮电大学光电工程学院,重庆400065)摘要:介绍了几种热载流子以及MOSFET的热载流子注入效应。
在此基础上总结了热载流子注入效应对MOS器件可靠性的影响。
随着MOS器件尺寸的缩小和集成电路规模的增大,热载流子效应显得更加显著。
最后介绍了几种提高抗热载流子效应的措施。
关键词:热载流子;热载流子注入效应;可靠性Effects of Hot-carriers Injection Effect on the ReliabilityXu Hui(College of Photoelectric Engineering,Chongqing University of Posts and Telecommunications,Chongqing,400065,P.R.China)Abstract:The effect of hot carrier and the MOSFET hot-carriers injection are reviewed.On this basis,the hot-carriers injection effect on the reliability of MOS devices are summed up.With the increasing size of MOS devices shrink in size and integrated circuits,the hot-carriers effect is even more significant.Finally,several measures to improve the thermal carrier effects are introducted. Key wards:hot carrier;hot-carriers injection effect;reliability0前言随着VLSI集成度的日益提高,MOS器件尺寸不断缩小至亚微米乃至深亚微米级,热载流子效应已成为影响器件可靠性的重要因素之一。
热载流子注入效应(HCI)是离子注入过程中可能遇到的一种现象,它会影响半导体器件的性能和可靠性。
热载流子注入效应具体包括以下几个方面:
1. 高能载流子的产生:在MOSFETs中,当电源电压未随器件尺寸缩小而等比例减小时,沟道横向电场与纵向电场会增加。
高电场加速载流子的运动,产生高能量的热载流子。
2. 载流子注入栅氧化层:当载流子的能量超过Si-SiO2的势垒高度(
3.5eV),它们可以直接注入或通过隧穿效应进入SiO2。
这会导致MOSFET的阈值电压Vth、线性区跨导gm等参数发生漂移或退化。
3. 器件性能退化:热载流子诱生的MOS器件退化是由于高能量的电子和空穴注入栅氧化层引起的,会在注入过程中产生界面态和氧化层陷落电荷,造成氧化层的损伤。
为了减轻热载流子效应对器件的影响,可以采用轻掺杂漏(LDD)工艺,即在栅极边界下方与源漏之间形成低掺杂的扩展区。
这个扩展区在源漏与沟道之间形成杂质浓度梯度,减小漏极附近的峰值电场,从而改善HCI效应和器件可靠性。
MOSFET 及其IC 的失效的失效——————热载流子效应热载流子效应Xie Meng-xian. (电子科大,成都市)对于MOSFET 及其IC ,在高温偏置条件下工作时,有可能发生阈值电压的漂移;但若在没有偏置的情况下再进行烘烤(200~250o C )几个小时之后,即可部分或者全部恢复原来的性能;不过若再加上电压工作时,性能又会产生变化。
这就是热载流子效应所造成的一种失效现象。
(1)热载流子热载流子及其及其及其效应效应效应::在小尺寸MOSFET 中,不大的源-漏电压即可在漏极端附近处形成很高的电场;特别是,当MOSFET 工作于电流饱和的放大状态时,沟道在漏极附近处被夹断(耗尽),其中存在强电场;随着源-漏电压的升高、以及沟道长度的缩短,夹断区中的电场更强。
这时,通过夹断区的载流子即将从强电场获得很大的漂移速度和动能,就很容易成为热载流子,同时这些热载流子与价电子碰撞时还可以产生雪崩倍增效应。
由于热载流子具有很大的动能和漂移速度,则在半导体中通过碰撞电离可产生出大量次级的电子-空穴对——次级热载流子;其中的电子(也包括原始电子)将流入漏极而形成输出源-漏电流(I DS ),而产生出的次级空穴将流入衬底而形成衬底电流(I sub ),如图1所示。
通过测量I sub 就可以得知沟道热电子和漏区电场的情况。
若夹断区中的一些热载流子与声子发生碰撞、得到了指向栅氧化层的动量,那么这些热载流子就有可能注入到栅氧化层中;进入到栅氧化层中的一部分热载流子,还有可能被陷于氧化层中的缺陷处,并变成为固定的栅氧化层电荷,从而引起阈值电压漂移和整个电路性能的变化。
对于发生了热载流子注入的器件,若进行烘烤的话,即可提供足够的能量,让那些被氧化层中的陷阱(缺陷)陷住的热载流子释放出来而回到硅中,从而使得器件又恢复到原来无热载流子的状态。
据此也可以判断是否热载流子效应所引起的失效。
(2)热载流子引起MOSFET 性能的退化性能的退化::热载流子对器件和IC 所造成的影响主要表现在以下两个方面。
半导体热载流子效应
半导体热载流子效应是指在半导体材料中,当温度升高时,会产生额外的载流子并增加材料的导电性能。
这个效应在半导体器件的设计和制造中起着重要的作用。
半导体材料是一种介于导体和绝缘体之间的材料,其导电性能可以通过控制载流子的数量和运动来实现。
载流子是带电粒子,可以是电子或空穴。
在常温下,半导体材料的导电性能较低,但当温度升高时,由于热激发,材料中的载流子数量会增加。
半导体热载流子效应的产生与能带结构有关。
半导体材料的能带结构决定了载流子的能量分布和运动方式。
当温度升高时,由于热激发作用,部分价带中的电子会被激发到导带中,形成新的载流子。
这些额外的载流子会增加材料的导电性能。
半导体热载流子效应对于半导体器件的性能有着重要影响。
首先,热载流子效应会导致器件的静态功耗增加。
由于温度升高导致的额外载流子,会导致器件在静态工作状态下的电流增加,从而增加功耗。
其次,热载流子效应也会影响器件的可靠性。
由于载流子数量的增加,器件中的电场和电流密度会增加,可能导致器件的损坏或寿命缩短。
为了应对半导体热载流子效应带来的问题,可以采取一些措施进行补偿或抑制。
一种常见的方法是通过材料的优化来减少热载流子效
应的影响。
例如,可以选择具有较高禁带宽度的材料,以降低载流子的生成率。
另外,还可以通过器件结构的优化来减少热载流子效应的影响。
例如,可以采用多层结构或引入能带工程来限制载流子的运动。
半导体热载流子效应是半导体材料中温度升高导致的额外载流子产生的现象。
它对半导体器件的性能和可靠性有着重要的影响。
通过合理的材料选择和器件结构设计,可以减少热载流子效应带来的负面影响,提高器件的性能和可靠性。