COB封装工艺流程课件
- 格式:ppt
- 大小:10.42 MB
- 文档页数:18

cob半导体封装工艺
cob半导体封装工艺步骤如下:
1.基板表面处理。
去除基板表面的污垢和氧化物,确保芯片能够牢固地粘贴在上面。
2.芯片粘贴。
将芯片通过胶水或焊锡等方式粘贴在基板上。
粘贴前需对芯片进行测试和校正,确保质量和性能符合要求。
3.金线连接。
用金线将芯片的焊盘与基板上的引脚连接起来,通常使用焊线机器人操作。
4.封装胶粘贴。
在芯片和基板的周围粘贴封装胶,提高芯片的保护、散热和可靠性。
5.封装胶固化。
将封装胶进行固化,常用的固化方法有热固化和紫外线固化。
6.成型和切割。
将被封装的芯片和基板进行成型和切割,得到最终的封装产品。

cob封装工艺流程COB封装工艺流程(Chip on Board Packaging Process)COB封装技术是一种将芯片直接封装在基板上的高密度封装技术。
其具有封装性能好、体积小、可靠性高等优点,广泛应用于LED照明、传感器、电子产品等领域。
下面将详细介绍COB封装工艺流程。
1. 基板准备:选用高导热性能、低光散射率的基板作为底部,如铝基板、铜基板等。
对基板进行清洁处理,确保无尘、无油污、无氧化物等。
然后将基板进行机械打磨,提高表面粗糙度,增加与芯片的黏附力。
2. 芯片去膜及粘贴:将芯片进行去膜处理,去除掉芯片背面的封装材料,以免影响封装后的散热。
然后,使用导热胶或导热膜将芯片粘贴在基板上,并进行压合,确保芯片与基板之间有良好的热导通道。
3. 绑线:将导线焊接在芯片上的金属引脚上,形成电路连接。
绑线可以使用金线、铜线等材料,并使用微焊或超声波焊接技术进行焊接。
绑线需要小心操作,确保焊接质量良好,避免短路或断路等问题。
4. 封胶:使用环氧树脂或硅胶等封装材料将芯片和绑线密封起来,提高封装的可靠性和耐久性。
封胶需要注意控制好胶体的黏度和硬度,以确保胶体的均匀性和粘合性。
封胶后,进行硬化处理,使胶体牢固固定。
5. 电气测试:对已封装的芯片进行电气特性测试,检测芯片的正常工作情况和性能参数。
测试项目包括电流、电压、功率、工作温度等。
通过电气测试,可以及时发现和排除封装过程中的缺陷和问题。
6. 光学测试:对COB封装后的芯片进行光学特性测试,评估LED亮度、发光效率、色温、色坐标等参数。
光学测试可以通过光功率计、光谱仪、色温计等设备进行。
优质的光学性能是COB封装的重要指标之一。
7. 散热处理:COB封装后的芯片需要进行散热处理,以保证其正常工作温度。
常见的散热处理方法包括散热片安装、散热背板安装等。
散热处理需要注意散热材料的选择和安装方式,以提高散热效果。
8. 包装和出厂检验:对COB封装后的芯片进行包装,常用的包装方式有盒式包装、卷式包装等。

COB工艺流程介绍COB(Chip on Board)工艺是将裸片(也叫芯片)直接粘贴在PCB (Printed Circuit Board)基板上的一种封装方式。
相比传统的芯片封装工艺,COB工艺可以提供更高的芯片密度和更好的散热性能。
本文将详细介绍COB工艺的流程。
1.准备工作:在进行COB工艺之前,需要进行准备工作。
首先是准备裸片和基板。
裸片是指经过前期处理后的芯片,去掉了冗余的晶圆边缘和背面金属等。
基板则是COB工艺中的载体,一般选用有良好导热性能和机械强度的材料制成,如陶瓷或金属。
2.芯片植入:这一步骤是将裸片植入到基板上。
通常,先在基板上涂上一层导电胶水,然后将芯片精确地放置在基板的指定位置,使其与基板上的导电胶水紧密接触。
植入芯片的过程需要非常小心,避免芯片损坏或位置偏移。
3.粘贴:一旦芯片植入完成,就需要将其粘贴在基板上。
这一步骤主要是将芯片与基板之间的空隙填充。
常用的填充材料是封装胶,其主要目的是固定芯片并提供剪切强度和压紧力。
封装胶的固化过程一般需要在高温环境下进行,以确保胶水能够快速固化和硬化。
4.线路连接:当封装胶固化后,需要对芯片进行线路连接。
这一步骤包括将芯片上的金线(Wire Bond)与基板上的连接点焊接。
金线将芯片上的引脚与基板上的焊盘连接起来,实现芯片与外部电路之间的信号传输和电气连接。
金线焊接技术需要精确控制温度和焊接力度,以确保焊点质量。
5.封装:线路连接完成后,需要对整个芯片进行封装。
一般采用环氧树脂或硅胶等材料进行封装,以保护芯片免受机械和环境的损害,并提供电气绝缘和防湿等功能。
封装过程中需要注意控制温度和压力,以确保封装剂能够充分流动并填充芯片和基板之间的空隙。
以上就是COB工艺的主要流程。
通过这一系列步骤,芯片可以有效地粘贴在基板上,并与外部电路连接起来,实现功能的实现和使用上的便利。
值得注意的是,COB工艺虽然相对传统封装工艺更加复杂,但它可以提供更高的芯片密度和更好的散热性能,适用于一些对封装厚度和散热要求更高的应用场景。

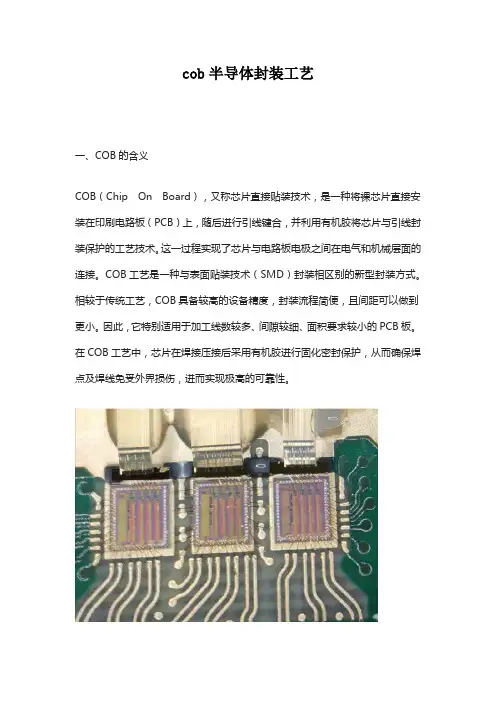
cob半导体封装工艺一、COB的含义COB(Chip On Board),又称芯片直接贴装技术,是一种将裸芯片直接安装在印刷电路板(PCB)上,随后进行引线键合,并利用有机胶将芯片与引线封装保护的工艺技术。
这一过程实现了芯片与电路板电极之间在电气和机械层面的连接。
COB工艺是一种与表面贴装技术(SMD)封装相区别的新型封装方式。
相较于传统工艺,COB具备较高的设备精度,封装流程简便,且间距可以做到更小。
因此,它特别适用于加工线数较多、间隙较细、面积要求较小的PCB板。
在COB工艺中,芯片在焊接压接后采用有机胶进行固化密封保护,从而确保焊点及焊线免受外界损伤,进而实现极高的可靠性。
二、COB封装的工艺流程及步骤:1.擦板:在COB工艺流程中,由于PCB等电子板上存在焊锡残渣和灰尘污渍,下一阶段的固晶和焊线等工序可能会导致不良产品增多和报废。
为解决此问题,厂家需对电子线路板进行清洁。
2.固晶:传统工艺采用点胶机或手动点胶,在PCB印刷线路板的IC位置上涂上适量红胶,再用真空吸笔或镊子将IC裸片正确放置在红胶上。
3.烘干:将涂好红胶的裸片放入热循环烘箱中烘烤一段时间,也可自然固化(时间较长)。
4.绑定:采用铝丝焊线机,将晶片(如LED晶粒或IC芯片)与PCB板上对应的焊盘铝丝进行桥接,即COB的内引线焊接。
5. 前测:使用专用检测工具(根据COB不同用途选择不同设备,简单的高精密度稳压电源)检测COB板,对不合格的板子进行重新返修。
6.封胶:将适量黑胶涂在绑定好的晶粒上,并根据客户要求进行外观封装。
7.固化:将封好胶的PCB印刷线路板放入热循环烘箱中恒温静置,可根据要求设定不同的烘干时间。
8.测试:采用专用检测工具对封装好的PCB印刷线路板进行电气性能测试,以区分好坏优劣。
相较于其他封装技术,COB技术具有价格低(仅为同芯片的1/3左右)、节约空间、工艺成熟等优势,因此在半导体封装领域得到广泛应用。
三、主要焊接方法1、热压焊:此方法通过加热和加压力使金属丝与焊区紧密结合。

COB工艺流程及基本要求COB工艺指将裸芯片直接粘贴在印刷电路板上,然后进行引线键合,再用有机胶将芯片和引线包封保护的工艺。
和常规工艺相比,本工艺封装密度高、工序简便。
工艺流程及基本要求清洁PCB---滴粘接胶---芯片粘贴---测试---封黑胶加热固化---测试---入库1.清洁PCB清洗后的PCB板仍有油污或氧化层等不洁部分用皮擦试帮定位或测试针位对擦拭的PCB 板要用毛刷刷干净或用气枪吹净方可流入下一工序。
对于防静电严的产品要用离子吹尘机。
清洁的目的的为了把PCB板邦线焊盘上的灰尘和油污等清除干净以提高邦定的品质。
2.滴粘接胶滴粘接胶的目的是为了防止产品在传递和邦线过程中DIE脱落在COB工序中通常采用针式转移和压力注射法针式转移法:用针从容器里取一小滴粘剂点涂在PCB上,这是一种非常迅速的点胶方法压力注射法:将胶装入注射器内,施加一定的气压将胶挤出来,胶点的大小由注射器喷口口径的大小及加压时间和压力大小决定与与粘度有关。
此工艺一般用在滴粘机或DIE BOND 自动设备上胶滴的尺寸与高度取决于芯片(DIE)的类型,尺寸,与PAD位的距离,重量而定。
尺寸和重量大的芯片胶滴量大一些,也不宜过大以保证足够的粘度为准,同时粘接胶不能污染邦线焊盘。
如要一定说是有什么标准的话,那也只能按不同的产品来定。
硬把什么不能超过芯片的1/3高度不能露胶多少作为标准的话,实没有这个必要。
3.芯片粘贴芯片粘贴也叫DIE BOND(固晶)粘DIE邦DIE 邦IC等各公司叫法不一。
在芯片粘贴中,要求真空吸笔(吸咀)材质硬度要小(也些公司采用棉签粘贴)。
吸咀直径视芯片大小而定,咀尖必须平整以免刮伤DIE表面。
在粘贴时须检查DIE与PCB型号,粘贴方向是否正确,DIE巾到PCB必须做到“平稳正”“平”就是指DIE与PCB平行贴紧无虚位“稳”是批DIE与PCB 在整个流程中不易脱落“正”是指DIE与PCB预留位正贴,不可偏扭。



cob封装工艺哎呀,说起这个cob封装工艺啊,那可真是个技术活儿。
你别看它名字听起来挺高大上的,其实呢,就是把那些小小的电子元件,比如芯片啊、电阻啊之类的,给固定在一个板子上,然后用一种特殊的胶水把它们粘得牢牢的。
这玩意儿,说简单也简单,说复杂也复杂,关键是得细心。
记得我第一次接触cob封装工艺的时候,那还是在大学实验室里。
那时候,老师让我们自己动手做一个小小的电路板,我心想,这有啥难的,不就是把几个零件粘在一起嘛。
结果,我一动手,哎呀,那胶水怎么就不听使唤呢?不是多了,就是少了,弄得我手忙脚乱的。
首先,你得把那个芯片对准位置,这可得有点眼力劲儿。
我那时候,眼睛都快贴到板子上了,就为了把那芯片放得正正的。
然后,就是涂胶水了。
这胶水啊,得涂得均匀,不能多也不能少。
我刚开始的时候,胶水总是涂多了,结果那芯片就被粘得死死的,动都动不了。
后来,我慢慢摸索出了门道,涂胶水的时候,得用那种特制的小刷子,轻轻一刷,胶水就均匀地铺开了。
等胶水干了,还得用紫外线灯照一照,让胶水固化。
这紫外线灯啊,可不能照太久,不然那胶水就硬得跟石头似的,想调整都调整不了。
我那时候,就因为照得太久了,结果那电路板都报废了。
哎,说多了都是泪啊。
不过,经过几次失败之后,我也算是摸到了点门道。
现在,我做cob 封装工艺,那可是手到擒来。
你看,先把芯片放好,然后涂胶水,再等胶水干了,用紫外线灯一照,齐活儿!这电路板,不仅结实,而且看起来还挺美观的。
所以说,这cob封装工艺,虽然听起来挺复杂的,但其实只要你细心点,多练练,也能做得像模像样的。
就像我们生活中的很多事情一样,一开始可能觉得挺难的,但只要你肯下功夫,慢慢来,总能摸到门道,最后做得得心应手。
你看,这小小的cob封装工艺,不就是一个很好的例子吗?从一开始的手足无措,到后来的游刃有余,这不就是我们成长的过程吗?所以啊,不管做什么,只要肯努力,总会有收获的。


导读:LED板上芒:片(Chip On Board f COB)HK流程肖先是正任基底表而用& 热环整树脂(一般用掺银颗粒的环氧树脂}覆盖硅片安放点,然后将硅片间接安放正在基底表面.热处理至硅片牢同地固是疋在基底为行.随后再用健焊的方法止在硅片和基底之间间接建立电气连接。
LED COB丼装ZED板上芯片(Chip On Board,COB封装流程首先是正在基底表面用导热环氧树脂(一般用掺银颗粒的环氧树脂覆盖硅片安放点,然后将硅片间接安放正在基底表面,热处理至硅片牢固地固定正在基底为行,随后再用丝焊的方法正在硅片和基底之间间接建立电气连接。
其封拆流程如下:第一步:扩晶采用扩驰机将厂商提供的零驰LED晶片薄膜均匀扩驰,使附灭正在薄膜表面紧密陈列的LED晶粒拉开,便于刺晶。
第二步:背胶将扩好晶的扩晶环放正在未刮好银浆层的背胶机面上,背上银浆。
点银浆。
适用于散拆LED芯片。
采用点胶机将适量的银浆点正在PCB印刷线路板上。
第三步:放入刺晶架将备好银浆的扩晶环放入刺晶架外,由操做员正在显微镜下将LED晶片用刺晶笔刺正在PCB印刷线路板上。
第四步:放入热循环烘箱将刺好晶的PCB印刷线路板放入热循环烘箱外恒温静放一段时间,待银浆固化后取出(不可久放,不然LED芯片镀层会烤黄,即氧化,给邦定形成困难。
如果无LED芯片邦定,则需要以上几个步骤;如果只要IC芯片邦定则取消以上步骤。
第五步:粘芯片用点胶机正在PCB印刷线路板的IC位放上适量的红胶(或黑胶, 再用防静电设备(实空吸笔或女将IC裸片准确放正在红胶或黑胶上第六步:烘干将粘好裸片放入热循环烘箱外放正在大平面加热板上恒温静放一段时间,也能够天然固化(时间较长。
第七步:邦定(打线采用铝丝焊线机将晶片(LED晶粒或IC芯片取PCB板上对当的焊盘铝丝进行桥接,即COB的内引线焊接。
第八步:前测使用公用检测工具(按不同用途的COB无不同的设备,简单的就是高精密度稳压电流检测COB板,将不合格的板女沉新返修。