教你如何调试BGA返修台的温度曲线
- 格式:doc
- 大小:18.00 KB
- 文档页数:3


效时BGA拆焊机调profile方法首先,我们要清楚有铅板及无铅板做BGA或者脚座实际跑出来的曲线应符合的标准与参考温度、时间有铅:图1即 1.从150℃到183℃的时间应该控制在80sec.与100sec.之间2.从183℃到最高温度的时间应该控制在20sec.与30sec.之间3.最高温度应控制在200℃到220℃之间效时厂商给出的上部6个段参考温度和时间如下(有铅):R(斜率即每秒升或者降的温度数)L(温度)D(恒温时间)1. 6.00℃/sec. 60℃40sec.2. 6.00℃/sec. 185℃40sec.3. 6.00℃/sec. 205℃35sec.4. 6.00℃/sec. 215℃30sec.5. 6.00℃/sec. 205℃15sec.6. 6.00℃/sec. 235-240℃30-50sec.无铅:图2即 1.从170℃到217℃的时间应该控制在110sec.与130sec.之间2.从217℃到最高温度的时间应该控制在40sec.与50sec.之间3.最高温度应控制在235℃到245℃之间效时厂商给出的上部6个段参考温度和时间如下(无铅):R(斜率即每秒升或者降的温度数)L(温度)D(恒温时间)1. 6.00℃/sec. 70℃40sec.2. 6.00℃/sec. 195℃40sec.3. 6.00℃/sec. 215℃35sec.4. 6.00℃/sec. 230℃35sec.5. 6.00℃/sec. 215℃15sec.6. 6.00℃/sec. 245-255℃50-70sec.先把上面的上部参考数据输入上部调节器里,设置的曲线基本都是如下的:图3我们在调profile时,主要是调整下部的温度,且要以上部的为参考来调下部设定曲线基本均如下:图4先将下部控制器的ctle参数调为pid(即手动调节状态)一、在pid状态下将温度调为230℃,随即开机,等实际温度到了一定的温度(有铅为120℃或者130℃,无铅为140℃或者150℃)就将温度调为0℃,并记下此时的时间,我们设定为D1。

WI-12-05 BGA返修台温度检测操作
版本修订页
第 2 页共4页
按下电脑显示屏上的软件的开始按钮,焊头下移后开始工作。
系统会按所设的温度曲线进行工作,在此阶段,对温度曲线测量,查看实测温度是否与电脑设定的温度一致,温差在±5度。
如下图:
第 3 页共4页
(T2)(TL)
(T3)
第 4 页共4页
注意事项:
1.操作过程中要注意防静电保护,必须戴防静电手镯或脚镯。
2.在拆焊芯片的过程中要注意对主板上的塑料器件的保护,防止焦或变形,相关元件用隔热胶粘好。
3.使用过程中要注意安全,如有问题必须及时通知相关人员。
第 5 页共4页。

bga回流焊温度曲线
BGA回流焊温度曲线是用于指导BGA(Ball Grid Array,球栅阵列)组件焊接过程中的温度控制。
它通常表示了在一段时间内焊接过程中的温度变化情况。
一般而言,BGA回流焊温度曲线包含以下几个主要阶段:
1. 预热阶段(Preheat Stage):此阶段温度较低,用于将PCB (Printed Circuit Board,印刷电路板)和BGA组件预热至焊接温度之前,以防止热应力造成的物理损害。
预热温度通常为100°C至150°C之间。
2. 温度上升阶段(Temperature Ramp-Up Stage):在此阶段,温度逐渐升高至焊接温度。
该阶段的温度上升速率应控制在合适的范围内,以避免导致热冲击、焊点脱落等问题。
3. 主焊接阶段(Soak Stage):一旦达到焊接温度,PCB和BGA组件将保持在该温度下一段时间,以确保焊点的熔化和焊接质量。
主焊接阶段的时间和温度根据焊接规范和BGA组件要求来确定。
4. 冷却阶段(Cooling Stage):当焊接完成后,温度将逐渐下降至室温。
冷却阶段的温度下降速率应适宜,以避免热应力引起的组件破裂或PCB变形。
每个BGA组件和PCB的焊接要求可能略有不同,因此具体的BGA回流焊温度曲线会根据特定的焊接规范和设备而有所差
异。
为了确保焊接质量,建议在进行BGA焊接之前仔细研究和遵循相关的焊接规范和厂商建议。
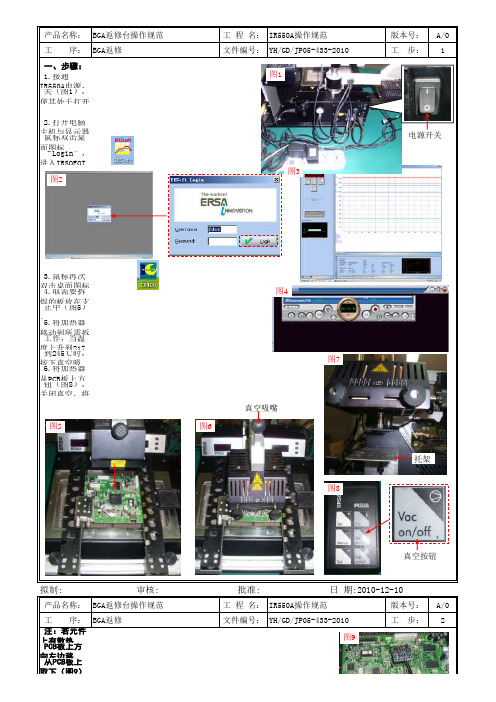

bga 回流焊温度曲线一、概述BGA(Ball Grid Array)是一种集成电路封装技术,其具有高密度、低功耗和易散热等特点。
在进行电路板维修或升级时,常常需要使用到BGA回流焊设备对BGA芯片进行焊接。
在焊接过程中,合理的温度曲线设计是保证焊接质量的关键因素之一。
本文将介绍一种适用于BGA的回流焊温度曲线的设计与实现方法。
二、温度曲线设计原则1. 预热阶段:为了使锡膏或助焊剂均匀融化,提高润湿性,应确保足够的加热时间。
2. 升温阶段:应缓慢升高温度,避免瞬间高温导致锡膏飞溅或芯片损坏。
3. 焊接阶段:在此阶段,应保持适当的温度以保证锡膏充分熔化并达到理想润湿效果。
4. 冷却阶段:为防止冷速过快导致虚焊等质量问题,应适当延长冷却时间。
三、温度曲线设定及参数说明1. 起始温度(Top Hot):设置加热开始时的最高温度,通常为250℃-300℃。
2. 恒温时间(Hold Time):在预设的温度下保持的时间,以确保锡膏或助焊剂融化并获得良好的润湿效果。
根据具体情况,一般建议在20-60秒之间选择合适的值。
3. 降温速度(Cool Down Rate):降温过程的速率控制,以防止因温度骤降导致的冷缩应力造成芯片损伤。
一般来说,应在每分钟下降约5℃左右为宜。
4. 冷却时间(Cooldown time):整个焊接过程结束后,PCB板的冷却时间,应根据实际情况进行调整,以防止焊接后由于热胀冷缩引起的不良后果。
四、实验结果与分析通过实际操作与测试,我们发现按照上述温度曲线设计的焊接工艺能够有效提升焊接质量,减少虚焊、连焊等问题。
同时,我们还观察到了在不同温度段下,锡膏的润湿性能以及芯片的热扩散情况。
这些数据为我们进一步优化温度曲线提供了依据。
五、温度曲线调整与优化在实际操作过程中,我们可能会遇到一些特殊情况,如锡膏过期、环境温湿度变化等。
此时,需要对温度曲线进行适当调整以适应这些变化。
此外,通过定期的测试和实验,我们可以对温度曲线的参数进行调整和优化,以提高焊接质量。
RD-500系列BGA 返修工作台使用操作规范文件编号:1. 目的: 保证BGA 返修台能够正确使用、维护以及保证返修BGA 的焊接和维修质量。
2. 适用范围: 公司RD-500型号以及RD-500Ⅱ型号BGA 返修台的使用、维护、调校和保养。
3. 责任:3.1 设备部负责真空气压和供电系统支持与维护。
3.2 制造工程部维修技工负责BGA 返修工作台按规范操作使用和每天的“5S ’日常保养。
3.3 制造工程部主任工程师或主管审核返修BGA 的设置参数、温度曲线标准。
4. 程序:4.1 返修台操作程序4.1.1 电源开启4.1.1.1 首先要确保返修台电源使用能够承受15A 以上电源(不可直接接到公司常用的10A 插座)。
4.1.1.2 打开电源开关 ,打开电脑,把电脑桌面上“RD500” 图标打开,显示屏界面上将会显示提示”MECHA INTALING ……”提示字幕,此时将返修站台上电源开关打开,系统将完成自检. 然后用鼠标双击图标RD500.exe ,系统完成对RD-500的检查后运行至主界面。
4.1.2 拆除和安装BGA 准备:4.1.2.1 在返修平台上固定PCBA ,在操作平台上根据PCBA 大小和形状来调整夹具宽度与限定位置,使PCBA 上需返修的BGA 元件处于发热体的正下部;4.1.2.2 根据返修BGA 元件的大小、形状选定喷咀与真空吸嘴,同时根据PCBA 板的大小选定防止受热变形支撑档杆和夹具;4.1.2.3 在显示屏界面选取返修程序,点击如图2 “Development ”图标将会出现”Profile Name ”中选定BGA 吸取或贴装温度曲线程序;4.1.2.4 根据BGA 尺寸大小和客户要求选取最适合的拔取或贴装程序,其中“Placement ”表示贴装程序,“Removal ”表示拔取程序。
4.1.2.5 顶部发热体气阀,逆-顺时针旋转旋钮可以打开气阀,气流根据芯片大小不同而设定。
使用BGA贴装元件的印刷电路板(PCB)装配中,一条优化的回流温度曲线是优质的焊点形成最重要的因素之一。
温度曲线是施加于电路装配上的温度对时间的函数的一种具体的表示。
我们根据焊接需要把加热温度设定成几个连续的加热温度段,每段称为一个温区。
几个参数影响曲线的形状,其中最关键的是加热时间和每个区的温度的温度值。
电路板在每个区所设定的温度下的时间长短,决定了在该温区下电路板温度。
每个温区所花的持续时间总和决定总共的处理时间。
每个温区的温度设定影响电路板的温度在该区的上升速度及温度值,较高的温度的在PCB与电路板的温度之间产生一个较大的温差。
增设定温度值允许机板更快地达到给定温度。
但这会带来另外一个不良的后果,电路板上因为排列元件的密度和种类不同,其热容量也不一样,过快的加热速度会让热容量小的地方温度升温快,高热容量区域温度上升缓慢,造成在同样的加热时间下过快的加热速度使电路板上温差变打,引起电路板变形,降低装配成功率和焊接可靠性。
在加热过程中合适的加温速率也是焊接控制的关键因素。
在开始作曲线步骤之前,需要下列设备和辅助工具:温度测试仪、热电偶、将热电偶附着于PCB的工具和锡膏参数表。
可从大多数主要的电子工具供应商买到温度曲线附件工具箱,这工具箱使得作曲线方便,因为它包含全部所需的附件(除了曲线仪本身)。
这中间的重点是将热电偶可靠的附着于PCB,较好的方法是使用高温焊锡如银/锡合金,焊点尽量最小。
另一种方便的方法是用少量的热化合物(也叫热导膏或热油脂)斑点覆盖住热电偶,再用高温胶带粘住固定在电路板上。
锡膏特性参数表也是必要的,其包含的信息对温度曲线是至关重要的,如:所希望的温度曲线持续时间、锡膏活性温度、合金熔点和所希望的回流最高温度。
现在我们对理想的温度曲线做一个基本的认识。
理论上理想的曲线由四个部分或区间组成,前面三个区加热、最后一个区冷却。
加热过程温区越多,越能使温度曲线的轮廓达到更准确和接近设定。
ZM-R5830返修台使用说明书编号:ZM-SMS-05-11深圳市卓茂科技有限公司SHENZHEN ZHUOMAO TECHNOLOGYCO.,LTD.前言深圳市卓茂科技有限公司是一家集研发、生产、销售为一体的国家级高新技术企业,公司自成立以来,先后获得深圳知名品牌、双软认证、商务部诚信企业AAA证书、央视网广告合作伙伴等荣誉。
凭借雄厚的技术力量、高效的经营管理、完善的销售体系、专业的售后团队,为广大客户提供更高效便捷的一站式服务!通过吸收和引进国内外领先的先进技术,不断提升自己,在 BGA /LED返修设备、清洗设备、非标自动化设备和电子产品周边辅助设备及耗材上赢得了全球10万BGA/LED返修设备客户的信赖和支持,产品销售遍及全国各大城市,并远销日本、韩国、北非、越南、东南亚、中东及欧美等国。
卓茂科技凭借自身“稳定的品质、领先的技术、全面周到的售后服务”在同行业中有很强的影响力和较高的知名度,我们将继续秉承“专业创新诚信”的经营理念,与社会各界关心和支持我公司发展的广大客户和朋友们一起不断进取,开拓创新,新的时代,我们真诚的期待,在您优越的产品生产的诸多链条中,有我们参与完成的重要一环!并让您的产品享誉全世界、惠及千家万户!您的微笑是卓茂科技永恒的追求……● 非常感谢您使用深圳市卓茂科技有限公司的 ZM-R5830 返修台。
● 为了确保您使用设备的安全和充分发挥本产品的卓越性能,在您使用之前请详细阅读本说明书。
● 由于技术的不断更新,卓茂科技有限公司保留在未事先通知的情况下对技术及产品规格进行修改的权力。
● 本说明书为随机配送的附件,使用后请妥善保管以备日后对返修台检修和维护时使用。
● 如对本设备的使用存在疑问和特殊要求,可随时与本公司联系。
全国统一服务电话:5● 本公司保留本使用说明书内容的最终解释权。
目录一、产品特点简介.......................................................................................................................................... - 3 -二、返修台的安装要求.................................................................................................................................. - 3 -三、产品规格及技术参数.............................................................................................................................. - 4 -四、外形主要结构介绍.................................................................................................................................. - 4 -(一)外部结构...................................................................................................................................... - 4 -(二)功能介绍...................................................................................................................................... - 4 - 五、程序设置及操作使用 ...................................................................................................................... - 5 -(一) “调试模式”使用方法................................................................................................................ - 5 -(二)“操作模式”使用方法................................................................................................................ - 10 - 六、外部测量电偶的使用方法.................................................................................................................... - 12 -(一) 外部电偶的作用 ................................................................................................................... - 12 -(二) 电偶的安装 ............................................................................................................................ - 12 -(三) 用电偶测量实际温度.......................................................................................................... - 12 -(四) 用外测电偶校准温度曲线.......................................................................................................... - 13 -七、植球工序............................................................................................................................................ - 14 -八、设备的维修及保养......................................................................................................................... - 15 -(一)上部发热丝的更换 ................................................................................................................. - 15 -(二)下部(第二温区)发热丝的更换.......................................................................................... - 16 -(三)下部(第三温区)发热板的更换.......................................................................................... - 16 -(四)、设备的保养................................................................................................................................ - 16 - 九、安全注意事项 .................................................................................................................................. - 17 -(一) 安全使用 ................................................................................................................................. - 17 -(二) 属于以下情况之一者.......................................................................................................... - 17 - 常用BGA焊接拆卸工艺参数表:(供参考) ................................................................................. - 18 - 有铅温度曲线焊接................................................................................................................................ - 18 - 无铅温度曲线焊接................................................................................................................................ - 19 -一、产品特点简介1 独立的三温区控温系统①上下温区为热风加热,IR预热区(350×220)为红外加热,温度精确控制在±3℃,上下温区均可设置8段升温和8段恒温控制,并能存储100组温度曲线,随时可根据不同BGA进行调用;②可对BGA芯片和PCB板同时进行热风局部加热,同时再辅以大面积的红外发热器对PCB板底部进行加热,能完全避免在返修过程中PCB板的变形;通过选择可单独使用上部温区或下部温区,并自由组合上下发热体能量;③ IR预热区可依实际要求调整输出功率,可使PCB板受热均匀;外置测温接口实现对温度的精密检测,可随时对实际采集BGA的温度曲线进行分析和校对;2多功能人性化的操作系统①该机采用高清触摸屏人机界面(可用鼠标操作),高精度温度控制系统,选用高精度K型热电偶闭环控制,实时温度曲线在触摸屏上显示;上部温区可手动前后左右方向自由移动;②配有多种不同尺寸合金热风风咀,可360°旋转,易于更换,可根据实际要求量身定制;③ BGA焊接区支撑框架,可微调支撑高度以限制PCB焊接区局部下沉;④多功能PCB定位支架,可X方向移动,PCB板定位方便快捷,同时适用异性板安装定位;⑤采用大功率横流风扇迅速对PCB板进行冷却,以防PCB板的变形;同时内置真空泵,外置真空吸笔,以方便快捷取拿BGA芯片;3优越的安全保护功能焊接或拆焊完毕后具有报警功能,在温度失控情况下,电路能自动断电,拥有双重超温保护功能。
教你如何调试BGA返修台的温度曲线
1目前smt常用的锡有两种即有铅和无铅成份为:铅Pb锡 SN 银AG 铜CU。
有铅锡珠
Sn63Pb37融点183°,无铅锡珠Sn96.5Ag3Cu0.5融点217°
3.调整温度时我们应该把测温线插进 BGA和PCB之间,并且确保测温线前端裸露的部分都插进去。
4.植球时,在对BGA表面要涂少量的助焊膏,钢网、锡球、植球台要确保清洁干燥。
5.助焊膏和锡膏在保存时都应该放在10℃的冰箱保存。
6.在做板之前要确保PCB和BGA都没有潮气,是干燥、烘烤过的。
7.国际上的环保标示是ROSS ,如果PCB中含有此标示,我们也可以认为此PCB为无铅制程所做。
8.在焊接BGA时,要在PCB上涂抹均匀助焊膏,无铅铅芯片焊接时可以稍多涂些。
9.在焊接BGA时,要注意PCB的支撑,卡板时不要卡的太紧,要预留出PCB受热膨胀的间隙。
10. 有铅锡与无铅锡的主要区别:熔点不一样。
(有铅183℃无铅217℃)有铅流动性好,无铅较差。
危害性。
无铅即环保,有铅非环保
11.助焊膏的作用1>助焊 2>去除BGA和PCB表面的杂质和氧化层,使焊接效果更加良好。
12.底部暗红外发热板清洁时不能用液体物质清洗,可以用干布、镊子、进行清洁!
温度调整详细:一般的返修用曲线分为:预热、升温、恒温、融焊、回焊五个阶段,下面介绍一下测试到曲线不合格如何调整,一般我们将曲线分为三个部分来说。
1、前期的预热和升温段为一个部分,这个部分的作用在于减少 pcb的温差,去除湿气防止起泡,防止热损坏的作用,一般温度要求是:当第二段恒温时间运行结束我们测试锡的温度要在(无铅:160~175℃,有铅:145~160℃)之间,如果偏高,就说明我们设定的升温段温度偏高,可以将升温段的温度降低些或时间缩短些。
如果偏低,可以将预热段和升温段的
温度加高些或时间加长些。
如果是存放时间较长未烘烤的pcb板可以将第一段预热的时间加长一些来烘烤板子去除湿气。
2、恒温段为一个部分,一般我们恒温段的温度设定要比升温段要低些,这样的目的就是让锡球内部的温度保持一个缓慢升温达到恒温的效果。
这个部分的作用在于活化助焊剂,去除待焊金属表面的氧化物和表面膜以及焊剂本身的挥发物,增强润湿效果,减少温差的作用。
那一般恒温段的实际测试锡的温度要求控制在(无铅:170~185℃,有铅145~160℃)如果偏高,可将恒温温度降低一些,如果偏低可以将恒温温度加高一些。
如果在我们测得的温度分析出预热时间过长或过短,可以通过加长或缩短恒温段时间来调整解决。
3、融焊和回焊为一个部分,这个部分是让锡球与pcb 焊盘良好的融合,那在这部分我们主要要达到的是焊接峰值(无铅: 235~245℃有铅: 210~220℃)如果测得温度偏高,可以降低融焊段温度或缩短融焊段的时间。
如果测得温度偏低,可以加高融焊段温度或加长融焊段的时间。
常见的bga芯片融焊段的时间我们以100秒为限,也就是说温度偏低时我们加时间,超过100秒温度还是偏低时我们就选择加高融焊段温度,假如到75秒就达到了理想峰值那么我们可以在第四段时间更改为75秒即可。
如预热时间偏短则分两种情况调整:
1、第2段(升温段)曲线结束后,如果测量温度没有达到150℃,则可以将第2段温度曲线中的目标温度(上部、下部曲线)适当提高或将其恒温时间适当延长。
一般要求第2段曲线运行结束后,测温线检测温度能够达到150℃。
2、第2段结束后,检测温度能够达到150℃,则应该将第3段(恒温段)时间延长。
预热时间少多少秒就延长多少秒。
回焊时间偏短如何处理:
1、可以将回焊段恒温时间适度增加,差多少秒就增加多少秒。
2、假如预热和回焊时间偏长则可以按上述处理方法反向处理即可。
3、将调整好的温度曲线,再次运行测试,观察加热过程中检测温度是否符合要求,加热结束后,其最高温度,预热时间,回焊时间是否符合要求,如果不符合,再次按上述方法进行调整,直到曲线符合要求为止,即可保存此条温度曲线参数,以备后用。