贾凡尼效应分析与改善
- 格式:ppt
- 大小:1.46 MB
- 文档页数:34

化学沉银的PCB 板1.Sterling TM 是什么是什么??Sterling TM 是一种化学湿制程,在线路上的裸铜面沉积一层薄金属银。
Sterling TM 是一种最终表面处理制程,也是典型的PCB 生产中最后一道化学湿制程。
Sterling TM 是MacDermid 研发实验室的专利技术,是一种取代喷锡、镀锡铅,有机保焊剂的高新技术。
2.2.为什么化学浸银可作为最终表面处理为什么化学浸银可作为最终表面处理为什么化学浸银可作为最终表面处理??当今HASL 不再适应PCB 更薄,线路更密集的设计要求,因此在功能上可供选择的产品已有很多的研究。
化镍浸金制程采用的增加,淘汰了喷锡,但是化镍浸金制程在PCB 制作上操作困难,成本昂贵。
有机保焊剂在PCB 制作上操作简易,成本低廉,但是在装配上受到限制,比如组装板电测及助焊剂匹配性。
化学浸银可让线路十分平整,适用于高密度线路,密脚距的SMT(表面贴装),BGA(球脚阵列封装)及晶片直接安装。
化学浸银操作简单,成本不高,维护少,使用相对小型设备可有高产能。
在Sterling TM银面上焊接产生铜锡合金介面层,同类的焊接点在电子业界受青睐几十年。
?3. Sterling TM制程的步骤是什么制程的步骤是什么?Sterling TM酸性清洁:去除板面污染物,为后续金属沉积做清洁处理。
清洁剂操作温度低,泡沫少,PH值为酸性不会攻击防焊绿漆。
Sterling TM表面预处理:为改良的过硫酸盐系统。
因为随后的银沉积视乎底铜的表面状况,故预处理非常重要。
有机添加剂比起普通的过硫酸盐微蚀可让铜面更光洁,通常表面预处理会咬铜5µ(20µ″)。
Sterling TM预浸:槽液不含银,其它组分与化银槽相同。
预浸防止硫化物和氯化物进入化银槽引起沉淀,也为银沉积的平整提供高度湿润的表面。
Sterling TM化银:通过置换反应在线路铜表面上沉积一层非常薄的近乎纯的银金属。
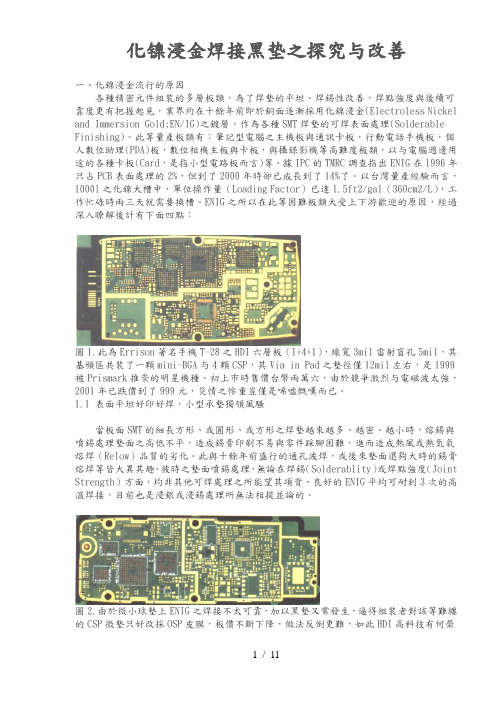
化镍浸金焊接黑垫之探究与改善一、化鎳浸金流行的原因各種精密元件組裝的多層板類,為了焊墊的平坦、焊錫性改善,焊點強度與後續可靠度更有把握起見,業界約在十餘年前即於銅面逐漸採用化鎳浸金(Electroless Nickel and Immersion Gold;EN/IG)之鍍層,作為各種SMT焊墊的可焊表面處理(Solderable Finishing)。
此等量產板類有:筆記型電腦之主機板與通訊卡板,行動電話手機板,個人數位助理(PDA)板,數位相機主板與卡板,與攝錄影機等高難度板類,以与電腦週邊用途的各種卡板(Card,是指小型電路板而言)等。
據IPC的TMRC調查指出ENIG在1996年只占PCB表面處理的2%,但到了2000年時卻已成長到了14%了。
以台灣量產經驗而言,1000l之化鎳大槽中,單位操作量(Loading Factor)已達1.5ft2/gal(360cm2/L),工作忙碌時兩三天就需要換槽。
ENIG之所以在此等困難板類大受上下游歡迎的原因,經過深入瞭解後計有下面四點:圖1.此為Errison著名手機T-28之HDI六層板(1+4+1),線寬3mil雷射盲孔5mil,其基頻區共裝了一顆mini-BGA与4顆CSP,其Via in Pad之墊徑僅12mil左右,是1999被Prismark推崇的明星機種。
初上市時售價台幣兩萬六,由於競爭激烈与電磁波太強,2001年已跌價到了999元,災情之慘重豈僅是唏噓慨嘆而已。
1.1 表面平坦好印好焊,小型承墊獨領風騷當板面SMT的細長方形、或圓形、或方形之焊墊越來越多、越密、越小時,熔錫與噴錫處理墊面之高低不平,造成錫膏印刷不易與零件踩腳困難,進而造成熱風或熱氮氣熔焊(Relow)品質的劣化。
此與十餘年前盛行的通孔波焊,或後來墊面還夠大時的錫膏熔焊等皆大異其趣。
彼時之墊面噴錫處理,無論在焊錫(Solderablity)或焊點強度(Joint Strength)方面,均非其他可焊處理之所能望其項背。


流程一以仪器直接测量焊垫铜面上OSP 皮膜的厚度。
3、当O S P 皮膜厚度偏厚时,对某些含低活性助焊剂的免洗锡膏的匹配性不佳,此乃肇因于锡膏中所含的助焊剂无法彻底清除铜面上的OSP 皮膜,导致焊锡性不良。
4、OSP 皮膜本身为不导电的皮膜,为了避免电测时测试针破坏皮膜,通常会将OSP 制程安排在电测之后。
但如此一来就必须特别注意OSP 制程微蚀段的咬蚀量,若是微蚀量控制不当,加上某些特殊设计的混合处理板面(Mixed Metal Finish PWBs)特有的贾凡尼效应(G a l v a n i c Effect)影响,甚至是品质不良必须重工者,都可能导致细线路过蚀断路而不自知。
5、对于某些特殊设计的板面,当板面上已有局部铜面进行化学镍金的表面处理存在时,必须小心的控制OSP 槽液中的铜离子浓度,以免在金面上沉积出铜层来。
但OSP 制程仍以其制程简单、成本低、焊接强度高、表面平整、可耐多次熔焊(R e f l o w S o l d e r i n g )处理等特点日益广泛的获得业界采用,成为取代传统喷锡制程的主要选择。
图1 不同的微蚀药液所创造出来的铜面微粗糙度,彼此之间有着明显的差异。
其中上左与上右虽同为硫酸/双氧水系列微蚀液,但因采用不同的安定剂,微蚀效果亦不相同。
二、 流程系列Flow SystemOS P 制程在历经业界不断的研究与改良后,目前已有多家厂商先后推出OSP 商品加入竞争的行列。
虽然各家均宣称在配方与反应机构上有其独门密技,但是在OSP 的制程流程上却没有太大的差异。
其中美商药思化学(E n t h o n e )所开发的E N T E K PLUS 制程是目前业界所扩泛采用的有机保焊剂制程之一。
笔者以ENTEK PLUS Cu-106A 的水平自动生产线为例,将OSP 的标准流程简介如后(见流程一):2.1、酸性清洁脱脂A c i d Cleaner主要功能在于去除铜面氧化物与指纹、油脂等污染,保持铜面的清洁。

一、反应机理1、化学银化学银是利用银与铜的置换反应,在焊盘表面形成薄镀层,厚度在0.1-0.5um;化学银只起可焊性保护作用,不参与焊接,焊点的形成是铜锡界面化合物。
优点:沉银表面均匀一致,适用于高密PCB,制作温度40-50摄氏度左右,对PCB的热冲击小,能满足无铅要求,可耐多次焊接。
缺点:PCB不可返工,银面易变色;线路有腐蚀风险。
2、化学锡在硫脲作为催化剂情况下,发生铜锡置换反应;在反应中,有机络合物的参与,可以减弱锡氧化、枝晶锡须的生成。
锡层的厚度控制在0.8-1.2um。
优点:沉锡表面均匀一致,适用于高密PCB,制作温度35-70摄氏度左右,对PCB的热冲击小,能满足无铅要求,可耐多次焊接。
突出特点是可焊性好;孔壁润滑性好,适合于压接和插件焊接。
缺点:废水中含有硫脲,需要特别的处理;对阻焊有攻击,对阻焊的要求高;锡须的生长暂无定论。
二、常见的失效1、化学银的贾凡尼效应贾凡尼效应包括铜与银间的置换腐蚀和电偶腐蚀。
置换腐蚀的主要因素在于化学银与阻焊连接位的阻焊undercut藏有化学银残留药水;残留的药水中含有银离子与焊盘、走线上的Cu形成腐蚀。
电偶腐蚀的机理是:铜比银活泼,由于水膜中溶解有氧,形成铜为阳极,银为阴极(被保护),发生阳极氧化反应,铜表面发生吸氧腐蚀。
规避措施:(1)走线与焊盘连接处设计成泪滴型焊盘;(2)严格控制阻焊的制成;(3)降低化学银药水中的银离子浓度;(4)改善PCB板的使用环境(避免高湿环境)。
2、化学银银面变色导致银面的变色主要有两方面。
一方面是铜面的不平整导致的。
正常的银层厚度是0.1-0.5um,当银层厚度很薄,小于0.1um,铜面的不平整度就通过银面反映出来。
不平整的银面因为反光的原因会形成颜色不良。
另一方面导致银面变色的是化学银制程中的有机物附着在表面没有被清洗掉,在空气中有机物被氧化变色附到表面,导致银面变色。
经过检测,银表面的附着物主要是碳、氧和氯,并且含量都小于1%,对可焊性的影响非常小。

浅析OSP工艺在PCB中的应用作者:熊宇王家波来源:《科学导报·学术》2020年第16期摘 ;要:抗氧化表面处理是在铜面上形成一层有机保护的可焊膜层,在加工过程中,容易出现膜面发黑及贾凡尼效应等不良问题。
本文对主流的抗氧化工艺进行了介绍,对OSP工艺的特点和工艺流程进行了较为详细的分析,并对OSP板件焊后变色机理进行了深入探讨,具有一定的借鉴价值。
关键词:OSP;PCB;热风整平1 PCB抗氧化工艺综述在印制板制作的后期阶段,已成型的板面的焊盘易氧化,从而导致焊盘上锡不良,不能形成牢固的焊点,出现虚焊,焊锡不饱满等现象。
通常的做法有物理和化学两种工艺,经过处理后的印制板能很好地弥补以上出现的缺陷。
主要的工艺方法包括:a)松香涂覆工艺工艺实质是在经过酸洗磨板烘干后板面均匀地涂上一层松香,松香分布在整个板面上,从而与空气中的氧隔离,起到防氧化的作用。
b)电化学工艺该工艺是在印制板面电镀一层不易氧化耐磨损的重金属,如镀金镀银等。
c)表面钝化工艺该工艺就是在铜表面形成一层致密的氧化膜,这层膜能阻止铜面继续氧化,也起到保护铜面的目的,适合中处理。
d)替代氧化工艺该工艺是在铜面涂上一层比铜更活拨的物质,当空气中的氧接近基板表面时,该物质首先被氧化,电子转移到已氧铜上,已氧铜获得电子被还原,从而起到防氧化的目的,也适合中处理,如三氧化铬。
e)OSP工艺OSP(有机保焊膜,又称抗氧化表面处理)是PCB符合RoHS指令要求的表面处理工艺。
OSP就工艺可简单描述为在铜面上,以化学的方法“长出”一层有机膜层,具有防氧化,耐热冲击,耐湿性,用以保护铜表面于常态环境中不再继续生锈(氧化或硫化等)。
在后续的焊接高温中,此层保护膜必须很容易被助焊剂所迅速清除,方可使露出的干净铜面在极短时间内与熔融焊锡立即结合成为牢固的焊点。
2 OSP工艺简介OSP有机保护膜是一种新型环保的有机保护膜剂,较热风整平工艺有更好的平整度和翘曲度,可以完全取代热风整平工艺及松香工艺更适合电子工艺中SMT技术发展及环保方面的要求。
毕业设计(论文)成绩评定表编号:Q/NJXX-QR-JX-39-2008学生姓名刘丹丹系部微电子班级31011P 课题名称镀银铜基板制造工艺综合成绩指导教师评语:建议成绩:指导教师:金鸿年月日评阅教师评语:建议成绩:评阅教师:年月日答辩小组评语:建议成绩:答辩小组负责人:年月日南京信息职业技术学院毕业设计论文作者刘丹丹学号 31011P 系部微电子学院专业电子电路设计与工艺题目镀银铜基板制造工艺指导教师金鸿评阅教师完成时间: 2013年5月19日毕业设计(论文)中文摘要(题目):镀银铜基板制造工艺摘要:PCB是电子工业的基本部件,印制电路板基板的选择和表面处理材料的不同都有着不同的生产范围。
本课题选择铜基板为基体材料,而银镀层反射率高,导电导热性能优良,焊接性能好。
使用镀银工艺可以很好适应科技与生产的需求,达到表面处理的最终目的。
结果表明:该工艺镀银液稳定、防变色能力强,特适合规模化生产。
关键词:印制电路板基体材料铜基板化学镀银制造工艺毕业设计(论文)外文摘要(Title): manufacturing process of silver-plated copper substrateAbstract: PCB is a basic component of the electronics industry, selection of printed circuit board substrate and surface treatment of the different materials have different production range. The copper substrate as the substrate material, while the silver coating high reflectivity, excellent thermal conductivity, good welding performance. The use of silver plating process can well adapt to technology and production needs, to achieve the ultimate goal of surface treatment.The results show that: the process of silver plating solution is stable,anti-tarnishing capability is strong, especially suitable for large scale production.Keywords:printed circuit board matrix material copper substrate chemical plating silver process目录1.引言2.化学镀银2.1 PCB基体材料的选择2.2 工艺流程3.制造工艺操作3.1 除油3.2 化学抛光3.3 镀前预处理3.3.1预镀银3.3.2防银置换处理3.4氰化物镀银3.4.1工艺规范3.4.2镀液中各成分的作用及镀液维护3.5镀后处理3.5.1中和3.5.2防变色措施4.变色后的处理5.PCB铜基板镀银过程中的贾凡尼效应5.1有关原电池的基本概念5.1.1原电池的定义5.1.2构成原电池的一般条件5.2预防措施5.3贾凡尼效应的生产控制5.4 PCB镀银中贾凡尼效应的结论结论致谢参考文献1.引言印制电路板(PCB)制造工艺的最终程序是对PCB进行表面处理。
关于賈凡尼效應原理及功能使用之整理网上查找的贾凡尼效应:賈凡尼效應是化學課本中所討論的一種電化學現象,主要是指金屬表面若有較鈍性的區域與較活性的區域共存,則活性區域的氧化速度會比純粹只有單一金屬的氧化速度更快,其原因來自於較鈍的金屬區促使氧化作用更集中於活性金屬區,而使活性金屬區的氧化速度更快,造成腐蝕,這種現象如果出現在金手指區時,由於銅面被鎳及金覆蓋,一旦覆蓋不全又經過微蝕處理,則金屬面會腐蝕的更快,因此如果鍍鎳金後仍要做微蝕的製程,這方面的問題就要特別小心,供您參考---- 来自: .tw/Client/FR/FRContent.aspx?FORUMID=16453我理解的贾凡尼效应:同一网络的镀金PAD和防焊开口下暴露的铜PAD( 即将去做OSP处理) 之间存在电位差.镀金PAD是惰性金属, 铜PAD是活性金属, 在酸性溶液下会产生电化学反应. (H+ 对金属的氧化性)活性金属的氧化反应比惰性金属强烈.当铜PAD面积/镀金PAD面积的比率越小, 电位差越强. 反应也越强烈, 所以铜PAD过量蚀刻也越厉害.所以Genesis提供这个以比值来衡量判断的功能:当此比值小于25%时候进行对OSP PAD的补偿 (因为比值越小, 过量蚀刻越大)当 Copper Area / Gold Area Max Ratio 的值 < 25 % (按截取画面为例子), Genesis会对与.gold_plating 属性的BGA PAD相连的铜PAD进行补偿.补偿的大小由以下这个文件来定义, 文件名称自定义./genesis/sys/valor_prog/dfm/galvetch.fnc/test1当 20 % < Copper Area / Gold Area Max Ratio 的值 < 40 % , 铜PAD 补偿2 mil此时, 我填的Copper Area / Gold Area Max Ratio 的值 = 39 %所以, 如果某几处的比值小于39%的时候, 才会去补偿这几处.当 40 % < Copper Area / Gold Area Max Ratio 的值 < 60 % , 铜PAD 补偿3 mil此时, 我填的Copper Area / Gold Area Max Ratio 的值 = 51 %所以, 这时会比上面的例子多若干处出来, 这些多出来被加大的PAD, 被补偿了3mil.我们还可能发现一些PAD被加大了2mil, 这是因为这些地方的Copper Area / Gold Area Max Ratio 的值处于20 % 和 40 %之间. 所以按照文件/genesis/sys/valor_prog/dfm/galvetch.fnc/test1定义, 被加大2 mil关于Copper Area / Gold Area Max Ratio 值的算法, ERF参数galvetch.erf中有定义:v_ratio_calc_mode = 0# Variable - Define the ratio calculation mode:# 0 - Calculate each OSP Pad area in the net against the biggest Gold Plated Pad area.# 1 - Calculate total OSP Pads area against total Gold Plated Pads area.。