半导体器件工艺中干法刻蚀技术的进展
- 格式:pdf
- 大小:264.14 KB
- 文档页数:9


icp与ccp干法刻蚀原理ICP与CCP干法刻蚀原理一、引言干法刻蚀是一种常用于半导体制造工艺中的刻蚀方法,其核心原理是利用化学反应或物理能量将材料表面的原子或分子移除,从而实现对材料的精确加工。
在干法刻蚀中,ICP(Inductively Coupled Plasma,感应耦合等离子体)和CCP(Capacitively Coupled Plasma,电容耦合等离子体)是两种常见的刻蚀方式。
本文将介绍ICP和CCP干法刻蚀的原理及其区别。
二、ICP干法刻蚀原理ICP干法刻蚀是利用感应耦合等离子体(ICP)产生的高能粒子对材料表面进行刻蚀。
具体过程如下:1. 高频电源产生高频电场,通过电感耦合将能量传递给气体,使气体处于等离子体状态。
2. 气体在高频电场的作用下,电离成等离子体,形成带电粒子,其中包括正离子、电子等。
3. 正离子通过感应耦合电场加速,进入气体与材料相接触的区域。
4. 高能正离子与材料表面的原子或分子碰撞,将其击出,形成刻蚀过程。
5. 刻蚀产物通过气体的扩散和抽真空系统的排除,离开刻蚀室。
ICP干法刻蚀的优点在于能够产生高浓度、高能量的等离子体,对于复杂结构的材料具有较好的刻蚀均匀性和精度。
然而,ICP干法刻蚀的设备复杂、成本高,且对材料表面的损伤相对较大。
三、CCP干法刻蚀原理CCP干法刻蚀是利用电容耦合等离子体(CCP)产生的电子和正离子对材料表面进行刻蚀。
具体过程如下:1. 电容耦合等离子体(CCP)由射频电源产生,产生的高频电场将气体电离成等离子体,形成带电粒子。
2. 电子在高频电场的作用下被加速,形成高能电子。
3. 高能电子与气体分子碰撞,使其电离,产生更多的电子和正离子。
4. 正离子通过电场加速,进入气体与材料相接触的区域。
5. 高能正离子与材料表面的原子或分子碰撞,将其击出,形成刻蚀过程。
6. 刻蚀产物通过气体的扩散和抽真空系统的排除,离开刻蚀室。
CCP干法刻蚀相对于ICP干法刻蚀来说,设备更简化、成本更低,且对材料表面的损伤较小。


【面板制程刻蚀篇】史上最全Dry Etch 分类、工艺Dry Etch工序的目的广义而言,所谓的刻蚀技术,是将显影后所产生的光阻图案真实地转印到光阻下的材质上,形成由光刻技术定义的图形。
它包含了将材质整面均匀移除及图案选择性部分去除,可分为湿式刻蚀(wet etching)和干式刻蚀(dry etching)两种技术。
湿式刻蚀具有待刻蚀材料与光阻及下层材质良好的刻蚀选择比(selectivity)。
然而,由于化学反应没有方向性,因而湿式刻蚀是各向同性刻蚀。
当刻蚀溶液做纵向刻蚀时,侧向的刻蚀将同时发生,进而造成底切(Undercut)现象,导致图案线宽失真,如下图所示。
底切现象自1970年以来,元件制造首先开始采用电浆刻蚀技术(也叫等离子体刻蚀技术),人们对于电浆化学性的了解与认识也就越来越深。
在现今的半导体集成电路或面板制造过程中,要求精确地控制各种材料尺寸至次微米大小,而且还必须具有极高的再现性,电浆刻蚀是现今技术中唯一能极有效率地将此工作在高良率下完成的技术,因此电浆刻蚀便成为半导体制造以及TFT LCD Array制造中的主要技术之一。
干式刻蚀通常指利用辉光放电(glow discharge)方式,产生包含离子、电子等带电粒子以及具有高度化学活性的中性原子、分子及自由基的电浆,来进行图案转印(pattern transfer)的刻蚀技术。
干法刻蚀是亚微米尺寸下刻蚀器件的最主要方法,广泛应用于半导体或面板前段制程。
Dry Etch 的分类及工艺的基本原理蚀刻技术中的术语1.各向同性与各向异性蚀刻( Isotropic and Anisotropic Etching)不同的蚀刻机制将对蚀刻后的轮廓(Profile)产生直接的影响。
如下图所示,纯粹的化学蚀刻通常没有方向选择性,上下左右刻蚀速度相同,蚀刻后将形成圆弧的轮廓,并在遮罩(Mask)下形成底切(Undercut),这种刻蚀被称为各向同性蚀刻。

第三代半导体器件制造工艺流程下载温馨提示:该文档是我店铺精心编制而成,希望大家下载以后,能够帮助大家解决实际的问题。
文档下载后可定制随意修改,请根据实际需要进行相应的调整和使用,谢谢!并且,本店铺为大家提供各种各样类型的实用资料,如教育随笔、日记赏析、句子摘抄、古诗大全、经典美文、话题作文、工作总结、词语解析、文案摘录、其他资料等等,如想了解不同资料格式和写法,敬请关注!Download tips: This document is carefully compiled by the editor. I hope that after you download them, they can help yousolve practical problems. The document can be customized and modified after downloading, please adjust and use it according to actual needs, thank you!In addition, our shop provides you with various types of practical materials, such as educational essays, diary appreciation, sentence excerpts, ancient poems, classic articles, topic composition, work summary, word parsing, copy excerpts,other materials and so on, want to know different data formats and writing methods, please pay attention!第三代半导体器件制造工艺流程是当今半导体产业中备受关注的一个重要领域。

两种基本的刻蚀工艺:干法刻蚀和湿法腐蚀
在半导体制造中有两种基本的刻蚀工艺:干法刻蚀和湿法腐蚀。
干法刻蚀是把硅片表面曝露于气态中产生的等离子体,等离子体通过光刻胶中开出的窗口,与硅片发生物理或化学反应(或这两种反应),从而去掉曝露的表面材料。
干法刻蚀是亚微米尺寸下刻蚀器件的最重要方法。
而在湿法腐蚀中,液体化学试剂(如酸、碱和溶剂等)以化学方式去除硅片表面的材料。
湿法腐蚀一般只是用在尺寸较大的情况下(大于3微米)。
湿法腐蚀仍然用来腐蚀硅片上某些层或用来去除干法刻蚀后的残留物。
干法刻蚀也可以根据被刻蚀的材料类型来分类。
按材料来分,刻蚀主要分成三种:金属刻蚀、介质刻蚀、和硅刻蚀。
介质刻蚀是用于介质材料的刻蚀,如二氧化硅。
接触孔和通孔结构的制作需要刻蚀介质,从而在ILD中刻蚀出窗口,而具有高深宽比(窗口的深与宽的比值)的窗口刻蚀具有一定的挑战性。
硅刻蚀(包括多晶硅)应用于需要去除硅的场合,如刻蚀多晶硅晶体管栅和硅槽电容。
金属刻蚀主要是在金属层上去掉铝合金复合层,制作出互连线。
刻蚀也可以分成有图形刻蚀和无图形刻蚀。
有图形刻蚀采用掩蔽层(有图形的光刻胶)来定义要刻蚀掉的表面材料区域,只有硅片上被选择的这一部分在刻蚀过程中刻掉。
有图形刻蚀可用来在硅片上制作多种不同的特征图形,。

刻蚀工艺技术刻蚀工艺技术是一种常用于半导体制造业和微纳加工领域的加工方法。
它通过将化学反应与物理刻蚀相结合,可实现对材料表面的高精度加工。
下面我们来详细介绍一下刻蚀工艺技术。
刻蚀工艺技术分为湿法刻蚀和干法刻蚀两种,根据所使用的刻蚀介质的不同。
湿法刻蚀是指通过液体介质对材料表面进行刻蚀,常用的刻蚀介质有酸、碱等。
干法刻蚀则是利用气体或等离子体对材料表面进行刻蚀,常用的刻蚀气体有氟化氢、氧气等。
刻蚀工艺技术的主要适用对象是硅基材料、硅化物、金属、氮化物等。
在半导体制造业中,刻蚀工艺技术被广泛应用于芯片制造的不同阶段,如图案形成、薄膜去除等。
通过刻蚀工艺技术,可以实现对芯片表面的微米级精细加工,从而得到所需的器件结构。
刻蚀工艺技术的核心是刻蚀掩膜的设计和制备。
在刻蚀过程中,刻蚀掩膜起到了保护目标区域不被刻蚀的作用。
刻蚀掩膜常使用光刻工艺制备,即通过物理或化学方法将光刻胶喷涂在材料表面上,然后通过曝光、显影等步骤形成所需的图案。
刻蚀时,掩膜可保护目标区域不受刻蚀介质侵蚀,从而实现精细加工。
刻蚀工艺技术有许多优点。
首先,刻蚀工艺技术能够实现高精度加工,可以制作出尺寸精确、结构复杂的微米级器件。
其次,刻蚀工艺技术具有较高的加工效率,能够快速完成大面积材料的加工。
此外,刻蚀工艺技术对材料的性能影响小,不会引起材料的变形、残留应力等。
然而,刻蚀工艺技术也存在一些问题。
首先,刻蚀过程中产生的废液对环境造成了一定的污染。
其次,刻蚀工艺技术对设备要求较高,需要有专门的刻蚀设备和控制系统。
此外,刻蚀后的表面粗糙度较高,需要进行后续的平整化处理。
总的来说,刻蚀工艺技术是一种重要的微纳加工方法,具有广泛的应用前景。
随着科学技术的不断发展,刻蚀工艺技术将进一步提高加工精度和效率,为微纳加工领域的发展做出更大的贡献。
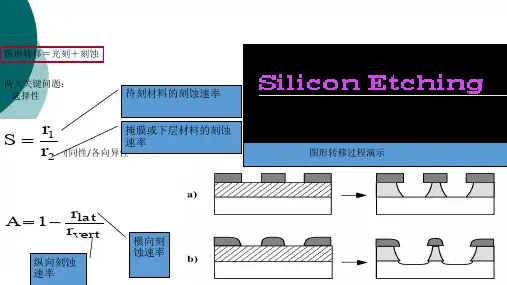

第八章干刻工艺8.1 Dry Etch工序的目的广义而言,所谓的刻蚀技术,是将显影后所产生的光阻图案忠实地转印到光阻下的材质上,形成由光刻技术定义的图形。
它包含了将材质整面均匀移除及图案选择性部分去除,可分为湿式刻蚀(wet etching)和干式刻蚀(dry etching)两种技术。
第五章中已经对湿式刻蚀进行了较详细的介绍。
湿式刻蚀具有待刻蚀材料与光阻及下层材质良好的刻蚀选择比(selectivity)。
然而,由于化学反应没有方向性,因而湿式刻蚀是各向同性刻蚀。
当刻蚀溶液做纵向刻蚀时,侧向的刻蚀将同时发生,进而造成底切(Undercut)现象,导致图案线宽失真,如下图所示。
图8.1 底切现象自1970年以来,元件制造首先开始采用电浆刻蚀技术(也叫等离子体刻蚀技术),人们对于电浆化学性的了解与认识也就越来越深。
在现今的半导体集成电路或LCD制造过程中,要求精确地控制各种材料尺寸至次微米大小,而且还必须具有极高的再现性,电浆刻蚀是现今技术中唯一能极有效率地将此工作在高良率下完成的技术,因此电浆刻蚀便成为半导体制造以及TFT LCD Array制造中的主要技术之一。
干式刻蚀通常指利用辉光放电(glow discharge)方式,产生包含离子、电子等带电粒子以及具有高度化学活性的中性原子、分子及自由基的电浆,来进行图案转印(pattern transfer)的刻蚀技术。
干法刻蚀是亚微米尺寸下刻蚀器件的最主要方法,广泛应用于半导体或LCD 前段制程。
在本章节中,将针对干刻蚀技术加以说明。
8.2 Dry Etch 的分类及工艺的基本原理8.2.1蚀刻技术中的术语1.各向同性与各向异性蚀刻( Isotropic and Anisotropic Etching)不同的蚀刻机制将对蚀刻后的轮廓(Profile)产生直接的影响。
如图8.2所示,纯粹的化学蚀刻通常没有方向选择性,上下左右刻蚀速度相同,蚀刻后将形成圆弧的轮廓,并在遮罩(Mask)下形成底切(Undercut),这种刻蚀被称为各向同性蚀刻。

半导体刻蚀⼯艺简介此保护膜可保护多晶硅的侧壁,进⽽形成⾮等向性刻蚀。
使⽤Cl2等离⼦体对多晶硅的刻蚀速率⽐使⽤F原⼦团慢很多,为兼顾刻蚀速率与选择⽐,有⼈使⽤SF6⽓体中添加SiCl4或CHCl3。
SF6的⽐例越⾼,刻蚀速率越快;⽽SiCl4或CHCl3的⽐例越⾼,多晶硅/SiO2的刻蚀选择⽐越⾼,刻蚀越趋向⾮等向性刻蚀。
除了Cl和F的⽓体外,溴化氢(HBr)也是⼀种常⽤的⽓体,因为在⼩于0.5µm的制程中,栅极氧化层的厚度将⼩于10nm,⽤HBr等离⼦体时多晶硅/SiO2的刻蚀选择⽐⾼于以Cl为主的等离⼦体。
4.⾦属的⼲法刻蚀⾦属刻蚀主要是互连线及多层⾦属布线的刻蚀,⾦属刻蚀有以下⼏个要求:⾼刻蚀速率(⼤于1000nm/min);⾼选择⽐,对掩蔽层⼤于4:1,对层间介质⼤于20:1;⾼的刻蚀均匀性;关键尺⼨控制好;⽆等离⼦体损伤:残留污染物少;不会腐蚀⾦属。
①铝的刻蚀。
铝是半导体制备中最主要的导线材料,具有电阻低、易于淀积和刻蚀等优点。
铝刻蚀通常采⽤加⼊卤化物的氯基⽓体,最常⽤的是BCl3。
因为铝在常温下表⾯极易氧化⽣成氧化铝,氧化铝阻碍了刻蚀的正常进⾏,⽽BCl3可将⾃然氧化层还原、保证刻蚀的进⾏,⽽且BCl3还容易与氧⽓和⽔反应,可吸收反应腔内的⽔汽和氧⽓,从⽽降低氧化铝的⽣成速率。
1.4质量评价⼀、⼲法刻蚀的终点监测近⼏年发展起来的⼲法刻蚀⼯艺,为了提⾼刻蚀精度,深⼊研究刻蚀机理,实现刻蚀设备的⾃动化,需要解决⼯艺过程的监控问题,特别是精确控制刻蚀终点。
因为⼲法刻蚀的选择性不如湿法,终点监控不当极易造成过腐蚀,甚⾄破坏下层图形。
早期的监控⽅法是计时法。
假设被刻蚀材料的膜厚已知,先通过实验确定刻蚀速率,然后在⼯艺过程中,由计时确定终点。
但由于影响刻蚀速率的因素太多(如压⼒、温度、流量、⽓体配⽐等),刻蚀速率难于重复(如前所述,对铝的等离⼦体刻蚀更是如此),不能满⾜⼯艺要求。
表1-1⼏种等离⼦体刻蚀终点检测⽅法⼆、⼲法刻蚀的质量检测刻蚀⼯艺的最后⼀步是进⾏检查以确保刻蚀的质量,通常都是⽤⾃动检测系统进⾏的。

石英干法刻蚀应用全文共四篇示例,供读者参考第一篇示例:石英干法刻蚀是一种常用的微纳加工技术,广泛应用于纳米加工、微加工及集成电路制造等领域。
石英干法刻蚀是一种无液相参与的刻蚀方法,其原理是在真空环境下,利用气相氟化剂对硅等材料进行氟化反应,产生气相产物,并将刻蚀产物通过真空泵除去,从而实现对材料的刻蚀。
石英干法刻蚀具有高速、高精度、高可靠性等优点,被广泛应用于微加工领域。
石英干法刻蚀的应用范围非常广泛,包括但不限于微纳加工、集成电路制造、MEMS器件制造等领域。
在微纳加工领域,石英干法刻蚀被广泛应用于制备光子晶体、微纳米结构、微纳米器件等。
在集成电路制造中,石英干法刻蚀被用于制备半导体器件、光刻版等。
在MEMS器件制造领域,石英干法刻蚀被用于制备微机械器件、声波器件等。
石英干法刻蚀在这些领域的应用,极大地推动了微纳加工技术的发展,促进了微电子工业的繁荣。
石英干法刻蚀的特点是可控性高、重复性好、工艺简单等。
石英干法刻蚀不需要使用液相刻蚀剂,避免了液相刻蚀剂对器件表面的污染,提高了器件的质量和稳定性。
石英干法刻蚀的加工环境为真空环境,减少了氧化反应,可以避免氧气对表面的影响,保证了加工的精度和速度。
石英干法刻蚀的工艺简单,不需要复杂的设备和繁琐的操作,降低了制造成本,提高了生产效率。
石英干法刻蚀的工艺流程一般包括前处理、主刻蚀、后处理等步骤。
前处理是准备待加工材料的过程,包括清洗表面、涂覆光刻胶、曝光、显影等。
主刻蚀是将材料置于真空腔内,加热并通入氟化剂进行刻蚀。
后处理是清洗刻蚀产物,并去除光刻胶等。
石英干法刻蚀的工艺流程简单易控制,适用于各种材料的加工。
石英干法刻蚀是一种重要的微纳加工技术,具有广泛的应用前景。
随着微纳加工技术的不断发展,石英干法刻蚀技术将会得到更广泛的应用,推动微电子工业的发展。
石英干法刻蚀技术的不断完善和改进,将为微纳加工领域带来更多的创新和突破。
相信在不久的将来,石英干法刻蚀将会成为微纳加工领域的主流技术,为人类社会带来更多的便利和发展机遇。
1口93卑 第3期
妇.3
1993
芏 。2一 i}工艺研究2 t J 1 。 I
半导体器件工艺中干法刻蚀技术的进展 李建中 / 3
(国家光电子工艺中t 中国科学院半导体研究所北京912t' ̄箱
]
I
100083)
【摘要】本文首先对干法刹蚀技术发展的:十余年作7回顾。列举一些对本技 术发展带有突破性意义的里程碑,并叙述干法刻蚀技术在微电子学和光电子学等重 要应用领域的作用。在发展动向方面介绍了电子迥旋共振和线圜耦合等离子体等刻 仕技术的新进展,以硬主干道式和集团式的多工艺真空联机系统设备设计的新结 构。突出说日月干法刻蚀技术今后的发展是多样化的,而且仍然方*禾艾。 美键词:微钿加工,干法刻蚀
1 回顾 1.1发晨过程
豁霹誉
在微电子学领域中,自1 948年发明晶体管,随后出现集成电路,直到整个六十年代的二 十年里,半导体器件光刻工艺中对各种材料均采用不同的试剂进行腐蚀,惯称湿法腐蚀。然 而,当器件集成度进人中规模,结构尺寸小于十微米时,惯用的湿法腐蚀由于毛细现象和各 向同性的腐蚀性就难以保证精度和重复性,迫切需要寻找新的技术途径。虽然人们早巳认识 到原子和游离基具有远强于分子的化学活性,但一直没有应用到对固体材料的腐蚀技术上。 直至六十年代末才发现氧等离子体可用于去除残留碳化物,并成功地用于等离子体去胶工艺 中。随后很快地发展了半导体器件工艺中的干法刻蚀技术。自七十年代初,以辉光放电产生 的气体等离子体进行腐蚀加工,至今二十多年,经历了多样化的发展过程,使技术不断得到 完善和创新。它的发展是与集成电路的高速发展有着密切关系的。反过来说,干法刻蚀的水 平很大程度上决定了集成电路器件性能和生产规模。 干法刻蚀是一个惯称,它指的是在低气压下与等离子体有关的腐蚀方法。而其它一些技 术,比如汽相腐蚀、激光诱导腐蚀,以及无掩模的聚焦离子束腐蚀等,虽然亦有别于“湿 法 ,但巳自成体系,一般不列入干法刻蚀之中。经过二十多年的发展,出现过多种干法刻
收稿日期。1993--07 ̄30
盯 术b O n 箍 n 工n 0 舡 细 O 散 M 维普资讯 http://www.cqvip.com 车辍f 碱一 酱f最鞋~餐 掣'看尽 ¨咄 吾}匾鲁-棼:=担f 单 嚣卅 霉廿 时 ¨晕 雀 嚣 ,I 蹿 #掣哥一 旺 百f幂一cjI. 毫I 五{ 一 嚣 匣三} ~ 导 靠七 厂—] ‘曼 譬 t 蝇 警 备 J 谴 ∞ 泰 o ‘9 m
H dL * [一 嚣 ’o 蔷 髫 1 幔 孽 鲁 幌 o 一 岳
啦 舞; [■一 8 2 t 楼 毛 件 M- 砸‘
是 嚣 _ * 篡 廿 证 幢 卧 卅 备 咄
。‘1毒 、 特 晶 鲁
o - 。o
姆 回 雾 I电 钒嚣鬟 争 呻曩* 特 廿 托窖 毒 岳针 一
o ’O 接 嘟 雾 姐童耋f g鲁 怵 甘 普 ●精 卅 o 岳 —’o 鼋 0芏 毗
要 钎 朴 抖 * ’ o. 牛 * 呈
。o I 『 匿 一
%
L J 避 冀 I § 叶 一 言
o 艟 H 留 匿 —廿 I l 璺
t 掣 鼬 冬 京 蘸 曩 篱 鼙! t
t固 世 g 盏 螽 H *
H’ 能 峨 lI÷ 廿 毒 嘲- 辩 : 盅 拳
暮 旺 堪 连 Ⅱ 嗣 .《 It, ~ 矗E
尝{暑《霹挈{ 采喀燃 嚣婶 ~ ^誊蜒 r嘉 窖_耷豫按 噬 ^ 蛰霉姆恃瑚窖 醛憎 鲢 喇 窿f| 呵,茎擎翥襄壶≤簧 礁虢饕 维普资讯 http://www.cqvip.com (3)平行板式——带低能离子轰击的游离基腐蚀; (4)反应离子式——兼有离子轰击和游离基腐蚀,是目前实验室和生产中应用最多的
结构} (5)磁控反应离子式——比反应离子式有更高的腐蚀速率' (6)三极式——可分别控制离子能量和离子密度’ (7)离子铣——对所有材料,包括铣磁和陶瓷材料均能腐蚀} (8)反应离子束——可调整离子入射角度,独立控制离子能量和离子暂度I (9)化学辅助离子束——可谣节腐蚀过程中的游离基腐蚀和离子轰击腐蚀成份。 按腐蚀原理来区分, (1)、(2)、(3)可统称为等离子体腐蚀,主要是化学反应 过程i(4)、(5)、(6)属反应离子腐蚀,是物理一化学反应过程{(7)、(8)、 (9)属离子束腐蚀,除了离子铣是纯物理过程外,其余为物理一化学反应过程。
1.2里程碑 干浩腐蚀技术的发展过程一方面与集成电路的发展有着相辅相成的作用,而它自身在厦 理和技术上也是不断开拓、完善和更新的。从表1可以看到干法刻蚀技术发展的多样性,而 且某些应用不很广泛的结构尚未列入表内。在技术发展过程中,有几个比较突出并带有突破 性意必的事件,它们不仅引导了干法刻蚀发展的主导方向,而且对集成电路和光电子器件产 业化起了决定性的作用,现简述如下 (1)平行板结构 在千法刻蚀技术发展的最初期,国筒式等离子体腐蚀的出现很快就得到重视,对硅的 腐蚀得到成功的应用,并且很快推广。但对集成电路工艺中常用的SiO 和Al的腐蚀在几年 时间里未能很好解决 究其原因,是极难实现氧化物(Al表面极易氧化)的游离基反应。而 当时对干法刻蚀的机理探讨极为肤浅,未能及时找到对策。直至出现平行板结构,引入了离 子轰击作用,促进化学键的断裂,很快就解决了集成电路的垒干法腐蚀工艺 (2)垂直侧壁腐蚀原理 1974年出现反应离子刻蚀,立即得到广泛的重视,其中主要原因是可实珊垂直侧壁腐 蚀.得到极高的刻蚀精度。尽管技术得到应 用.并且不断完善,但公认的腐蚀机理直到 八十年代初才明朗起来。这种称作侧壁钝化 原理已成为干法刻蚀中最基本的原理之一 (参见图1)。在腐蚀反应过程中会生成某 些化台物,淀积在整个曝露的材料表面。在 离子垂直入射的表面上因受离子轰击溅射而 清除掉,使游离基能与材料进行腐蚀反应。 而侧壁上未受轰击,淀积层起到腐蚀保护作 用而实现垂直腐蚀。 (3)单片工艺
l㈩ll l l F-···· F····· ●口● -,q嚏-● 甲q.~….·
图I 垂直饲煞腐蚀作用原理图 在集成电路发展处于中、小规模(基片尺寸小于3英寸)时,采用的是多片成批制作工 45
维普资讯 http://www.cqvip.com 艺。要进一步采用大基片, :工艺均匀仕问题上遇到困难,设备的利用率亦受到限制。在所 有制作工艺中,干法刘蚀魁其中困难最太的。自从改用单片工艺来提高并保证腐蚀均匀性之 后,促进了器件结构更微细化、更高集成度和更大基片尺寸的发展。在设备结构上实现智能
化和全自动化 (4)离子束 虽然离子铣早在七十年代中期就已出现,但离子束形式长期没有得到广泛重视。直到八 十年代中后期,利用带反应性的离子束实现对游离基的化学作用和离子轰击的物理作用的可 控性,以及离子入射角度的可调性,在光电子器件制作上得到了很好的应用,并成为重要的 工艺手段。尤其对激光器的制作从手工作业步八产业化起到了决定的作用。
1.3 t大领域的成功应用 微细加工技术中,干法刻蚀是当前制作最微细结构的技术之一。最大的应用领域首推微 电子学,其次是光电子学,其它如微机械和超导等方面亦有一定的应用。 干法技术的出现是由于集成电路制作工艺的需要,其发展亦是伴随集成电路的不断微细 化和高集成化而完善更新。目前已成为生产中不可欣少的关键技术,而且集成电路的器件性 能和生产水平很大程度上取决于干法技术。当前的水平是在8英寸片上用0.5微米技术制作 64MDRAM,估计到2OOO年将在12英寸上用0.12微米技术制作1GDRAM的特大集成电路。 干法刻蚀设备的投资,巳成为集成电路大规模产业化的重要部分。 光电子学起步晚于微电子学 在微结构制作上直至八十年代初才引入干法刻蚀技术,但 其应用发展较快。由于超晶格量子结掏的出现,结构的微细程度远超过微电子的要求,在技 术难度上也有较大的差异。微电子器佟:(主要是VLSI)主要要求大面积的腐蚀均匀性和较 高的刻蚀速率,以满足大批量生产的要求。面对光电子器件,除了微细度更高要求外,还要 求侧壁垂直度、腐蚀面的平整光滑、镜面腐蚀、倾角腐蚀、多样化的选择腐蚀,以及无损 伤的腐蚀表面等等。这些不同的要求都直接影响到器件的特性。长期以来,激光器的生产工 艺因解理腔面的制作而限于手工性作业,生产率和规模都难以突破。因为需要在解理腔面完成 之后把分裂成极微小(一般为0.2×0.3毫米)的器件芯片进行腔面镀膜、管芯测试和蛆装工 序。这种手工作业的技术难度和生产率之低是可想而知的。自从1991年成功地把干法刻蚀技 术应用到腔面制作之后,激光器的生产才得到突破性的解决,实现整片制作和测试,进入批 量性产业化。
2动 向 2.1高效率,嵩均匀性新技术——翱蚀技术的新发展 集成电路制作工艺中,自从采用单片工艺以来,高蚀速、高精度和高均匀性一直是撇 细加工技术发展的主要内容。随着基片尺寸不断增大,器件结构尺寸不断缩小,这些要求就 更为突出。 新的等离子体产生方式是近年来干法刻蚀技术发展的重点方面。电子回旋共振(ECR)
46
维普资讯 http://www.cqvip.com