回流焊温度曲线word版
- 格式:doc
- 大小:34.00 KB
- 文档页数:1

SMT回流焊温度曲线测试操作指导书一范文一、目的:用于指导回流焊温度曲线测试操作指示。
二、适用范围:适用于本公司SMT回流焊温度测试三、职责:无四、作业内容:4.1设定温度参数制程界限:4.1.1工程师根据锡膏型号、特殊元件规格、特殊测量位置、FPC制程以及客户的要求制定一个合理的温度曲线测试范围,包括:升温区、浸泡(保温)区、回流区、冷却区的具体参数及定义回流焊标准温度曲线4.1.2预热区:通常是指由室温升温至150度左右的区域。
在此温区,升温速率不宜过快,一般不超过3度/秒。
以防止元器件应升温过快而造成基板变形或元件微裂等现象。
4.1.3浸泡(保温)区:通常是指由110度~190度左右的区域。
在此温区,助焊剂进一步挥发并帮助基板清楚氧化物,基板及元器件均达热平衡,为高温回流做准备。
此区一般持续时间问60~120秒。
4.1.4回流区:通常是指超过217度以上温度区域。
在此温区,焊膏很快熔化,迅速浸润焊接面,并与基板PAD形成新的合金焊接层,达到元件与PAD之间的良好焊接。
此区持续时间一般设定为:45~90秒。
最高温度一般不超过250度(除有特定要求外)。
4.1.5冷却区:该区为焊点迅速降温,将焊料凝固,使焊料晶格细化,提高焊接强度。
本区降温速率一般设置为-3~-1度/秒左右。
4.2测温板的制作4.2.1采用与生产料号一致的样品板作为测温板,制作测温板时,原则上应保留必要的具有代表性的测温元器件,以保证测试测量温度与实际生产温度保持一致。
4.2.2测温板与生产料号在无法保持一致情况下,经工程师验证认可,可使用与之同类型的测温板进行测量。
4.2.3测温点应该选择最具有代表性的区域及元件,比如最大及最小吸热量的元件,零件选取优先级(如Socket->Motor->大型BGA ->小型BGA->QFP或SOP->标准Chip)除此之外,还应选择介于两者之间的一个测温区。
如图:回流焊标准测温点4.2.4 一般测温点在每板上不得少于3个,有BGA或大型IC至少选取4个,基于特殊代表型元件为首选原则选取元件。


爱迅通信工程部培训专用爱迅工程部2019.2.13目录爱迅通信工程部培训专用 回流焊工艺回流焊结构与原理SMT回流焊接流程回流焊曲线曲线说明曲线测试问题与对策清理与维护结束1回流焊工艺爱迅通信工程部培训专用 电子制造业中SMT回流炉焊接是最终实现SMT工艺的工序。
是PCBA电子線路板组装作业中的重要工序,如果没有很好的掌握它,不但会出现许多“临时故障”还会直接影响焊点的寿命回流焊是英文Reflow,是通过重新熔化预先印刷到PCB焊盘上的膏状软钎焊料,实现表面组装元器件焊端或引脚与印制板焊盘之间机械与电气连接。
回流焊是将元器件焊接到PCB板材上,是针对SMD(表面贴装器件)的焊接。
回流焊是靠热气流对焊点的作用,之所以叫"回流焊"是因为气体在焊机内循环流动产生高温达到焊接目的。
回流焊结构与原理①爱迅通信工程部培训专用 我们要了解影响热能从回流炉加热器向电路板传递的主要因素。
在通常情况下,如图所示,回流焊炉的风扇推动气体(空气或氮气)经过加热线圈,气体被加热后,通过孔板内的一系列孔口传递到产品上。
回流焊结构与原理②爱迅通信工程部培训专用 SMT回流焊炉温区的工作原理就是当组装PCB板在金属网式或双轨式输送带上,通过回焊炉各温区段的热冷行程,以达到锡膏熔融及冷却结合成为焊点的目的。
1:预热区(又名:升温区)2:恒温区(保温区/活性区)3:回流区4:冷却区回流焊结构与原理③爱迅通信工程部培训专用 当PCB进入升温区时,焊膏中的溶剂、气体蒸发掉,同时,焊膏中的助焊剂润湿焊盘、元器件端头和引脚,焊膏软化、塌落、覆盖了焊盘,将焊盘、元器件引脚与氧气隔离。
PCB进入保温区时,使PCB和元器件得到充分的预热,以防PCB突然进入焊接高温区而损坏PCB和元器件。
当PCB进入焊接区时,温度迅速上升使焊膏达到熔化状态,液态焊锡对PCB的焊盘、元器件端头和引脚润湿、扩散、漫流或回流混合形成焊锡接点。
PCB进入冷却区,使焊点凝固此;时完成了回流焊。

使用范围设备名称版本/版次:A/01页码5.3.1测出炉温曲线后,确认各温区的关键参数是否符合按本文件6.0相关标准。
如有必要再进行调整。
排小批量(10PCS板左右)试过炉。
2.2 恒温区:使产品在进入较高温度区域前达到热平衡,同时对锡膏中没有用的化学成 5.5 炉温曲线的再调整份进行进一步地挥发处理。
该工序如设置不当可能造成 ‘热坍塌’、‘连锡’ 在产品试过炉过程中,如发现过炉结果存在质量问题,需马上对炉温曲线进行调整,直到 ‘高残留物’、‘焊球’、‘润湿不良’、‘气孔’、‘立碑’等等不良现象。
满意为止。
最后需对炉温曲线进行再一次测试.5.6 批量过炉技术员全程跟进以上各过程,全部OK后,即可通知生产车间安排批量过炉.5.7 炉温曲线管控一般情况下,以电子挡的形式按客户要求保存在机器电脑中。
5.8 炉温曲线测试频率5.8.1刚转线的所有产品均需对炉温进行实测。
5.8.2正在生产的产品,每天至少安排测试一次炉温,这种情况统一 由白班进行测试. 5.8.3每次调整炉温设置参数时,均需对炉温进行重新测试;每次批量生产使用的炉温曲线如和以前不同均需在电脑中对炉温曲线进行存档。
6.0炉温曲线格式为使炉温曲线更好地发挥作用,炉温曲线的制作需使用统一的格式(见附件一)。
7.0 标准设置温度5.1.1根据PCB厚度、大小及元器件热容量大小、数量等调取已经生产过的相似产品炉温设置参数,并结合生产产品的实际情况进行适当调整。
5.2.1 制作测温板:选择结构有代表性的几个产品制作测温板,一般性的产品均可用此测温板进行测试炉温。
测温板上主要的A级物料及屏蔽盖必须有。
的温度参数和实测温度之间相差应在在±2℃以内.否则,需进行调查处理。
制定: 日期: 审核: 日期: 批准: 日期:4.0 职责:SMT技术员负责确定和调整炉温曲线并作记录。
5.0 作业内容5.1 设置炉温曲线5.2 测量炉温5.2.2 测试炉温:待炉温达到预定的设置值后即可安排对炉温进行测试。

无铅回流焊接工艺曲线,如下图
无
铅回
流焊
工艺
参
数,
如下
表
区域时间升温速率峰值温度降温速率
预热区(室温~150℃)60~150s≤2。
0℃/s
均温区(150~200℃)60~120s<1.0℃/s
回流区(>217℃)60~90s230-260℃
冷却区(Tmax~180℃) 1.0℃/s≤Slope≤4。
0℃
/s
说明:
预热区:温度由室温~150℃,温度上升速率控制在2℃/s 左右,该温区时间为60~150s。
均温区:温度由150℃~200℃,稳定缓慢升温,温度上升速率小于1℃/s,且该区域时间控制在60~120s(注意:该区域一定缓慢受热,否则易导致焊接不良).
回流区:温度由217℃~Tmax~217℃,整个区间时间控制在60~90s。
若有BGA,最高温度:240至260度以内保持约40秒。
冷却区:温度由Tmax~180℃,温度下降速率最大不能超过4℃/s。
温度从室温25℃升温到250℃时间不应该超过6 分钟.
该回流焊曲线仅为推荐值,客户端需根据实际生产情况做相应调整。
回流时间以30~90s 为目标,对于一些热容较大无法满足时间要求的单板可将回流时间放宽至120s。

PCB回流焊温度曲线的设定及优化1 引言最近几年,SMT生产技术已发生了巨大的变化,回流焊机作为SMT中一个关键设备,它的正确使用无疑能够进一步确保产品的焊接质量。
虽然PCB的回流焊接工艺被认为是一种非常成熟的技术,但是随着产品变的越来越复杂,元件尺寸从01005到50X50都有,且分布在组装密度非常高的双面PCB上,从而新的挑战也不断出现。
实践证明,优化合格的回流焊温度曲线可大大减少焊接缺陷,提高产品的直通率。
不合格的回流焊温度曲线会产生不可接受的焊点、失效的元件和整体更低的可靠性。
所以探讨回流焊温度曲线设置和优化非常有必要的。
本文将描述回流焊温度曲线设置和优化的一些方法和技巧。
2 回流焊温度曲线各个区段介绍通常把这个曲线分成四个区域,就得到了PCB在通过回流焊炉时某一个区域所经历的时间。
在这里斜率表示PCB受热后升温的速率,它是温度曲线中重要的工艺参数。
图1中四个区段,分别为定义为升温区,预热恒温区,焊接区,冷却区。
2.1升温区PCB进入回流焊链条,从室温开始受热到l50℃的区域叫做升温区。
升温区的时间设置在60-90S,斜率控制在 1-3℃/S之间。
2.2预热恒温区预热恒温区PCB表面温度由150℃平缓上升至200℃,时间窗口在60S-120S之间。
PCB板上各个部分缓缓受到热风加热,温度随时间缓慢上升,斜率在0.3-0.8℃/S之间。
2.3焊接区回流区的温度最高,SMA进入该区后迅速升温,并超出锡膏熔点约30-40℃,即板面温度瞬时达到210-230℃ (此温度又称之为峰值温度),时间约为20-30S。
2.4冷却区焊点温度从液相线开始向下降低的区段称为冷却区。
这一区域锡膏中的铅粉已经熔化并充分润湿了被焊接的表面,快速冷却会得到明亮的焊点并有良好的外形及低的接触角。
冷却速率一般为3-10℃/S。
3 回流焊温度曲线测试3.1热电偶使用说明热电偶是温度控制和达到工艺路线的必备工具,分为温区热偶和曲线测试热偶,温区热偶位于不锈钢热风加热室,固定不动,曲线热偶一般要求与PCB表面连接,否则会导致热电偶的测量值偏离PCB表面度,从而测试出不适合的温度曲线。

通过对回流焊温度曲线的分段描述,理解焊膏各成分在回流炉中不同阶段所发生的变化,给出获得最佳温度曲线的一些基本数据,并分析不良温度曲线可能造成的回流焊接缺陷。
在SMT生产流程中,回流炉参数设置的好坏是影响焊接质量的关键,通过温度曲线,可以为回流炉参数的设置提供准确的理论依据,在大多数情况下,温度的分布受组装电路板的特性、焊膏特性和所用回流炉能力的影响。
为充分理解焊膏在回流焊接的不同阶段会发生什么,产生的温度分布对焊膏组成成分的影响,以下先介绍焊膏的组成成分及其特性,再介绍获得温度曲线的方法,然后对温度曲线进行较为详细的分段简析,最后列表分析不良温度曲线可能造成的回流焊接缺陷。
(1)冷却段这一段焊膏中的铅锡粉末已经熔化并充分润湿被焊接表面,快速度地冷却会得到明亮的焊点并有好的外形及低的接触角度,缓慢冷却会使板材溶于焊锡中,而生成灰暗和毛糙的焊点,并可能引起沾锡不良和减弱焊点结合力。
(2)回流焊接段这一段把电路板带入铅锡粉末熔点之上,让铅锡粉末微粒结合成一个锡球并让被焊金属表面充分润湿。
结合和润湿是在助焊剂帮助下进行的,温度越高助焊剂效率越高,粘度及表面张力则随温度的升高而下降,这促使焊锡更快地湿润。
但过高的温度可能使板子承受热损伤,并可能引起铅锡粉末再氧化加速、焊膏残留物烧焦、板子变色、元件失去功能等问题,而过低的温度会使助焊剂效率低下,可能使铅锡粉末处于非焊接状态而增加生焊、虚焊发生的机率,因此应找到理想的峰值与时间的最佳结合,一般应使曲线的尖端区覆盖面积最小。
曲线的峰值一般为210℃-230℃,达到峰值温度的持续时间为3-5秒,超过铅锡合金熔点温度183℃的持续时间维持在20-30秒之间。
(3)保温段溶剂的沸点在125-150℃之间,从保温段开始溶剂将不断蒸发,树脂或松香在70-100℃开始软化和流动,一旦熔化,树脂或松香能在被焊表面迅速扩散,溶解于其中的活性剂随之流动并与铅锡粉末的表面氧化物进行反应,以确保铅锡粉末在焊接段熔焊时是清洁的。
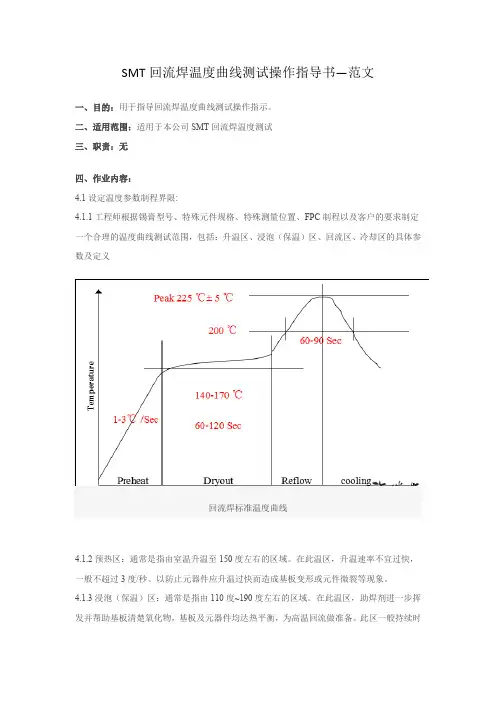
SMT回流焊温度曲线测试操作指导书—范文一、目的:用于指导回流焊温度曲线测试操作指示。
二、适用范围:适用于本公司SMT回流焊温度测试三、职责:无四、作业内容:4.1设定温度参数制程界限:4.1.1工程师根据锡膏型号、特殊元件规格、特殊测量位置、FPC制程以及客户的要求制定一个合理的温度曲线测试范围,包括:升温区、浸泡(保温)区、回流区、冷却区的具体参数及定义回流焊标准温度曲线4.1.2预热区:通常是指由室温升温至150度左右的区域。
在此温区,升温速率不宜过快,一般不超过3度/秒。
以防止元器件应升温过快而造成基板变形或元件微裂等现象。
4.1.3浸泡(保温)区:通常是指由110度~190度左右的区域。
在此温区,助焊剂进一步挥发并帮助基板清楚氧化物,基板及元器件均达热平衡,为高温回流做准备。
此区一般持续时间问60~120秒。
4.1.4回流区:通常是指超过217度以上温度区域。
在此温区,焊膏很快熔化,迅速浸润焊接面,并与基板PAD形成新的合金焊接层,达到元件与PAD之间的良好焊接。
此区持续时间一般设定为:45~90秒。
最高温度一般不超过250度(除有特定要求外)。
4.1.5冷却区:该区为焊点迅速降温,将焊料凝固,使焊料晶格细化,提高焊接强度。
本区降温速率一般设置为-3~-1度/秒左右。
4.2测温板的制作4.2.1采用与生产料号一致的样品板作为测温板,制作测温板时,原则上应保留必要的具有代表性的测温元器件,以保证测试测量温度与实际生产温度保持一致。
4.2.2测温板与生产料号在无法保持一致情况下,经工程师验证认可,可使用与之同类型的测温板进行测量。
4.2.3测温点应该选择最具有代表性的区域及元件,比如最大及最小吸热量的元件,零件选取优先级(如Socket->Motor->大型BGA ->小型BGA->QFP或SOP->标准Chip)除此之外,还应选择介于两者之间的一个测温区。
如图:回流焊标准测温点4.2.4一般测温点在每板上不得少于3个,有BGA或大型IC至少选取4个,基于特殊代表型元件为首选原则选取元件。

回流焊的回流焊接温度曲线许多旧式的炉倾向于以不同速率来加热一个装配上的不同零件,取决于回流焊接的零件和线路板层的颜色和质地。
一个装配上的某些区域可以达到比其它区域高得多的温度,这个温度变化叫做装配的D T。
如果D T大,装配的有些区域可能吸收过多热量,而另一些区域则热量不够。
这可能引起许多焊接缺陷,包括焊锡球、不熔湿、损坏元件、空洞和烧焦的残留物。
大多数新式的回流焊接炉,叫做强制对流式,将热空气吹到装配板上或周围。
这种炉的一个优点是可以对装配板逐渐地和一致地提供热量,不管零件的颜色和质地。
虽然,由于不同的厚度和元件密度,热量的吸收可能不同,但强制对流式炉逐渐地供热,其D T没有太大的差别。
另外,这种炉可以严格地控制给定温度曲线的最高温度和温度速率,其提供了更好的区到区的稳定性,和一个更受控的回流过程。
为什么和什么时候保温保温区的唯一目的是减少或消除大的D T。
保温应该在装配达到焊锡回流温度之前,把装配上所有零件的温度达到均衡,使得所有的零件同时回流。
由于保温区是没有必要的,因此温度曲线可以改成线性的升温-到-回流(RTS)的回流温度曲线。
应该注意到,保温区一般是不需要用来激化锡膏中的助焊剂化学成分。
这是工业中的一个普遍的错误概念,应予纠正。
当使用线性的RTS温度曲线时,大多数锡膏的化学成分都显示充分的湿润活性。
事实上,使用RTS温度曲线一般都会改善湿润。
升温-保温-回流(RSS)温度曲线可用于RMA或免洗化学成分,但一般不推荐用于水溶化学成分,因为RSS保温区可能过早地破坏锡膏活性剂,造成不充分的湿润。
使用RSS温度曲线的唯一目的是消除或减少D T。
如图一所示,RSS温度曲线开始以一个陡坡温升,在90秒的目标时间内大约150° C,最大速率可达2~3° C。
随后,在150~170° C之间,将装配板保温90秒钟;装配板在保温区结束时应该达到温度均衡。
保温区之后,装配板进入回流区,在183° C以上回流时间为60(± 15)秒钟。
