SMT回流焊的温度曲线
- 格式:pdf
- 大小:718.47 KB
- 文档页数:7

SMT回流焊温度曲线测试操作指导书一范文一、目的:用于指导回流焊温度曲线测试操作指示。
二、适用范围:适用于本公司SMT回流焊温度测试三、职责:无四、作业内容:4.1设定温度参数制程界限:4.1.1工程师根据锡膏型号、特殊元件规格、特殊测量位置、FPC制程以及客户的要求制定一个合理的温度曲线测试范围,包括:升温区、浸泡(保温)区、回流区、冷却区的具体参数及定义回流焊标准温度曲线4.1.2预热区:通常是指由室温升温至150度左右的区域。
在此温区,升温速率不宜过快,一般不超过3度/秒。
以防止元器件应升温过快而造成基板变形或元件微裂等现象。
4.1.3浸泡(保温)区:通常是指由110度~190度左右的区域。
在此温区,助焊剂进一步挥发并帮助基板清楚氧化物,基板及元器件均达热平衡,为高温回流做准备。
此区一般持续时间问60~120秒。
4.1.4回流区:通常是指超过217度以上温度区域。
在此温区,焊膏很快熔化,迅速浸润焊接面,并与基板PAD形成新的合金焊接层,达到元件与PAD之间的良好焊接。
此区持续时间一般设定为:45~90秒。
最高温度一般不超过250度(除有特定要求外)。
4.1.5冷却区:该区为焊点迅速降温,将焊料凝固,使焊料晶格细化,提高焊接强度。
本区降温速率一般设置为-3~-1度/秒左右。
4.2测温板的制作4.2.1采用与生产料号一致的样品板作为测温板,制作测温板时,原则上应保留必要的具有代表性的测温元器件,以保证测试测量温度与实际生产温度保持一致。
4.2.2测温板与生产料号在无法保持一致情况下,经工程师验证认可,可使用与之同类型的测温板进行测量。
4.2.3测温点应该选择最具有代表性的区域及元件,比如最大及最小吸热量的元件,零件选取优先级(如Socket->Motor->大型BGA ->小型BGA->QFP或SOP->标准Chip)除此之外,还应选择介于两者之间的一个测温区。
如图:回流焊标准测温点4.2.4 一般测温点在每板上不得少于3个,有BGA或大型IC至少选取4个,基于特殊代表型元件为首选原则选取元件。

备注:执行日期为批准日期延后一个工作日开始。
1. 目的规范SMT炉温测试方法,为炉温设定、测试、分析提供标准,确保产品质量,为炉温曲线的制作、确认和跟踪过程一致性提供准确的作业指导。
2. 适用范围适用于SMT车间所有回流焊温度设定、测试、分析及监控。
3. 用语定义3.1升温阶段:也叫预热区,是为了是元器件在焊接时所受的热冲击最小。
一般升温变化速率不能超过3℃/S,升温太快会造成元器件损伤、出现锡球现象;升温太慢锡膏会感温过度,从而没有足够的时间达到活性,通常时间控制在60S左右。
3.2恒温阶段:也叫活性阶段。
用以将PCBA从活性温度提升到所要求的回流温度,一是允许不同质量的元件在温度上同质,而是允许助焊剂活化,锡膏中挥发性物质得到有利挥发。
3.3回流阶段:也叫峰值区或最后升温区,这个区将锡膏在活性温度提升到所要求的峰值温度,加热从熔化到液体状态的过程。
此段温度设定太高或超过客户所推荐的峰值高会使PCB脱层、卷曲、元件损坏等。
3.4冷却阶段:理想的冷却曲线一般和回流曲线成镜像,越是达到镜像关系,焊点达到的固态结构越紧密,焊点的质量越高,结合完整性就越好,一般降温速率控制在4℃/S。
4. 组织和职能4.1SMT工程师4.1.1有责任和权限制定炉温测试板制作及曲线判定标准。
4.1.2有责任和权限指导工艺员如何制作温度曲线图。
4.1.3有责任和权限定义热电偶在PCB上的测试点,特别是一些关键的元件定位。
4.1.4有责任和权限基于客户要求和公司内部标准来定义温度曲线的测试频率。
4.1.5有责任和权限对炉温曲线图进行审批。
4.2SMT IPQC4.2.1有责任和权限首件确认回流焊的参数设置并对曲线进行审核。
4.2.2有责任和权限定期监控炉温曲线设置状况以保证生产过程中质量的稳定。
4.3工艺员4.3.1有责任和权限在工程师的指导下制作温度曲线并交其审批。
4.3.2有责任和权限定期监控炉温曲线设置状况以保证生产过程中质量的稳定。

回流焊温度与温度曲线设置规范
1目的
1.1指导技术人员正确设置温度
2 范围
2.1本司SMT技术人员适用
2.2本司回流焊适用
3 内容
3.1设定原则:根据锡膏、胶水供应商所提供有关锡膏、胶水的温度曲线图与性
能数据等资料作为参考,以实际生产产品不同适当设定各温区温度;
3.2设定温度依据测试温度为准,若不合格需做相应修改后再测试,直到合格为
止;
3.3无特殊要求下,本司回流焊温度曲线应符合如下条件:
3.3.1 无铅锡膏(一般以Sn96 /Ag3.5/Cu0.5、Sn96.5/ Ag3/ Cu0.5、、Sn96.5/
Ag3.5为准);
150℃-190℃之时间段为: 60ses-120ses
高于220℃之时间段为: 30 ses-90 ses;
峰值温度为:235℃~255℃
3.32胶水:130℃~155℃之间保持时间为:120 ses-180 ses
3.4我公司回流焊显示器实际温度与设置温度相差5℃以上(不含5℃)时为异常,
此时不可使用回流焊.
4 温度测试
4.1 每个班次需对运行中的回流炉进行一次温度测量确认,如有转线之机型重新设置温度曲线后需要再次测量温度达到合格。


通过对回流焊温度曲线的分段描述,理解焊膏各成分在回流炉中不同阶段所发生的变化,给出获得最佳温度曲线的一些基本数据,并分析不良温度曲线可能造成的回流焊接缺陷。
在SMT生产流程中,回流炉参数设置的好坏是影响焊接质量的关键,通过温度曲线,可以为回流炉参数的设置提供准确的理论依据,在大多数情况下,温度的分布受组装电路板的特性、焊膏特性和所用回流炉能力的影响。
为充分理解焊膏在回流焊接的不同阶段会发生什么,产生的温度分布对焊膏组成成分的影响,以下先介绍焊膏的组成成分及其特性,再介绍获得温度曲线的方法,然后对温度曲线进行较为详细的分段简析,最后列表分析不良温度曲线可能造成的回流焊接缺陷。
(1)冷却段这一段焊膏中的铅锡粉末已经熔化并充分润湿被焊接表面,快速度地冷却会得到明亮的焊点并有好的外形及低的接触角度,缓慢冷却会使板材溶于焊锡中,而生成灰暗和毛糙的焊点,并可能引起沾锡不良和减弱焊点结合力。
(2)回流焊接段这一段把电路板带入铅锡粉末熔点之上,让铅锡粉末微粒结合成一个锡球并让被焊金属表面充分润湿。
结合和润湿是在助焊剂帮助下进行的,温度越高助焊剂效率越高,粘度及表面张力则随温度的升高而下降,这促使焊锡更快地湿润。
但过高的温度可能使板子承受热损伤,并可能引起铅锡粉末再氧化加速、焊膏残留物烧焦、板子变色、元件失去功能等问题,而过低的温度会使助焊剂效率低下,可能使铅锡粉末处于非焊接状态而增加生焊、虚焊发生的机率,因此应找到理想的峰值与时间的最佳结合,一般应使曲线的尖端区覆盖面积最小。
曲线的峰值一般为210℃-230℃,达到峰值温度的持续时间为3-5秒,超过铅锡合金熔点温度183℃的持续时间维持在20-30秒之间。
(3)保温段溶剂的沸点在125-150℃之间,从保温段开始溶剂将不断蒸发,树脂或松香在70-100℃开始软化和流动,一旦熔化,树脂或松香能在被焊表面迅速扩散,溶解于其中的活性剂随之流动并与铅锡粉末的表面氧化物进行反应,以确保铅锡粉末在焊接段熔焊时是清洁的。


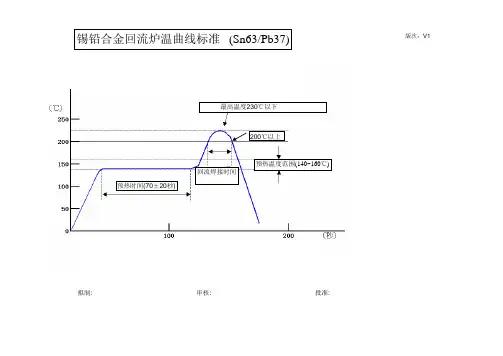
版次:V1拟制:审核:批准:锡铅合金回流炉温曲线标准(Sn63/Pb37)最高温度230℃以下预热时间(70±20秒)预热温度范围(140~160℃)回流焊接时间200℃以上版次:V3胶水固化炉温曲线标准90-150秒适用红胶规格:1、LOCTITE 3482、SOMAR IR-130拟制:审核:批准:版次:V2拟制:审核:批准:无铅回流焊炉温曲线标准(Sn-3.0Ag-0.5Cu)①热容量小的部品(上限) ②热容量大的部品(下限)回流预热冷却T =10℃之内(秒)版次:V2拟制:审核:批准:35±10Sec 是表示从进板到开始预热的时最高温度230℃以下35±10秒预热温度范围(130~150℃)200℃以上15013020023090±30秒25秒以下30±1010040秒以下无铅回流焊炉温曲线标准(Sn-8Zn-3Bi)特别要求:最大热容量部品与最小热容量部品最高温度的温差控制在10℃之内90±30Sec是表示预热从130°到达150°的时间25Sec以下是表示从150°到达200°的时间30±10Sec是表示保持200°的时40Sec以下是表示冷却从200°降至100°的时间版次:V1T=10℃之内250235MP4/I-REC无铅回流焊炉温曲线标准(Sn-3.0Ag-0.5Cu)拟制:审核:批准:①热容量小的部品(上限) ②热容量大的部品(下限)(秒)。


一、回流温度曲线在生产中地位:回流焊接是在SMT工业组装基板上形成焊接点的主要方法,在SMT工艺中回流焊接是核心工艺。
因为表面组装PCB的设计,焊膏的印刷和元器件的贴装等产生的缺陷,最终都将集中表现在焊接中,而表面组装生产中所有工艺控制的目的都是为了获得良好的焊接质量,如果没有合理可行的回流焊接工艺,前面任何工艺控制都将失去意义。
而回流焊接工艺的表现形式主要为回流温度曲线,它是指PCB的表面组装器件上测试点处温度随时间变化的曲线。
因而回流温度曲线是决定焊接缺陷的重要因素。
因回流曲线不适当而影响的缺陷形式主要有:部品爆裂/破裂、翘件、锡粒、桥接、虚焊以及生半田、PCB脱层起泡等。
因此适当设计回流温度曲线可得到高的良品率及高的可靠度,对回流温度曲线的合理控制,在生产制程中有着举足轻重的作用。
二、回流温度曲线的一般技术要求及主要形式:1.回流温度曲线各环节的一般技术要求:一般而言,回流温度曲线可分为三个阶段:预热阶段、回流阶段、冷却阶段。
①预热阶段:预热是指为了使锡水活性化为目的和为了避免浸锡时进行急剧高温加热引起部品不具合为目的所进行的加热行为。
•预热温度:依使用锡膏的种类及厂商推荐的条件设定。
一般设定在80~160℃范围内使其慢慢升温(最佳曲线);而对于传统曲线恒温区在140~160℃间,注意温度高则氧化速度会加快很多(在高温区会线性增大,在150℃左右的预热温度下,氧化速度是常温下的数倍,铜板温度与氧化速度的关系见附图)预热温度太低则助焊剂活性化不充分。
•预热时间视PCB板上热容量最大的部品、PCB面积、PCB厚度以及所用锡膏性能而定。
一般在80~160℃预热段内时间为60~120sec,由此有效除去焊膏中易挥发的溶剂,减少对元件的热冲击,同时使助焊剂充分活化,并且使温度差变得较小。
•预热段温度上升率:就加热阶段而言,温度范围在室温与溶点温度之间慢的上升率可望减少大部分的缺陷。
对最佳曲线而言推荐以0.5~1℃/sec的慢上升率,对传统曲线而言要求在3~4℃/sec以下进行升温较好。

焊料回流曲线的意思
SMT回流焊的温度曲线共包括四个温区,分别是预热区、吸热区、回流区和冷却区。
预热区通常指电路板从室温上升到150-170摄氏度的过程,它的作用是去除锡膏中的氧化物。
吸热区也叫恒温区,通常指温度比较平衡的一段曲线,在150到170摄氏度之间。
回流区是指电路板上的元器件锡膏达到最高温度值,锡融化后使元器件跟焊盘进行表面焊接,形成焊点。
冷却区的温度逐渐降低,使焊料固化,确保焊接点的稳定性。
不同的电子元器件和焊料可能需要不同的温度曲线和区域设置,以确保焊接质量和可靠性。
回流焊温度曲线的设定及异常情况分析正确设定回流焊温度曲线是获得优良焊接质关键前言红外回流焊是SMT大生产中重要的工艺环节,它是一种自动群焊过程,成千上万个焊点在短短几分钟内一次完成,其焊接质量的优劣直接影响到产品的质量和可靠性,对于数字化的电子产品,产品的质量几乎就是焊接的质量。
做好回流焊,人们都知道关键是设定回流炉的炉温曲线,有关回流炉的炉温曲线,许多专业文章中均有报导,但面对一台新的红外回流炉,如何尽快设定回流炉温度曲线呢?这就需要我们首先对所使用的锡膏中金属成分与熔点、活性温度等特性有一个全面了解,对回流炉的结构,包括加热温区的数量、热风系统、加热器的尺寸及其控温精度、加热区的有效长度、冷却区特点、传送系统等应有一个全面认识,以及对焊接对象--表面贴装组件(SMA)尺寸、组件大小及其分布做到心中有数,不难看出,回流焊是SMT工艺中复杂而又关键的一环,它涉及到材料、设备、热传导、焊接等方面的知识。
本文将从分析典型的焊接温度曲线入手,较为详细地介绍如何正确设定回流炉温度曲线,并实际介绍BGA以及双面回流焊的温度曲线的设定。
理想的温度曲线图1是中温锡膏(Sn63/Sn62)理想的红外回流温度曲线,它反映了SMA通过回流炉时,PCB上某一点的温度随时间变化的曲线,它能直观反映出该点在整个焊接过程中的温度变化,为获得最佳焊接效果提供了科学的依据,从事SMT焊接的工程技术人员,应对理想的温度曲线有一个基本的认识,该曲线由四个区间组成,即预热区、保温区/活性区、回流区、冷却区,前三个阶段为加热区,最后一阶段为冷却区,大部分焊锡膏都能用这四个温区成功实现回流焊。
故红外回流炉均设有4-5个温度,以适应焊接的需要。
图1 理想的温度曲线为了加深对理想的温度曲线的认识,现将各区的温度、停留时间以及焊锡膏在各区的变化情况,介绍如下:1、预热区预热区通常指由室温升至150℃左右的区域。
在这个区域,SMA平稳升温,在预热区,焊膏中的部分溶剂能够及时挥发,元器件特别是IC器件缓缓升温,以适应以后的高温。
SMT回流焊炉温曲线检验标准第A0版
5.1.5 每次测试的炉温曲线应按《SMT回流焊炉温曲线检验标准》图的示样进行标注。
5.2 标准曲线技术参数说明
5.2.1该曲线图为无铅环保型锡膏。
(详见下图:)
1) 升温区:是指将PCB的温度从环境温度提升到所需要的活性温度。
温度:室温-150℃
时间: 37.5-75S
升温率: 2-4℃/S
2)恒温区:是指将PCB在相对稳定的温度下加热, 使不同质量的元件达到相同温度,减少温差,同时使助焊剂活性化,挥发性的物质从锡膏中挥发掉。
温度:150℃—200℃
恒温时间:60—120S
3) 回流升温区:预热阶段结束点到焊膏熔点之间的一段升温过渡区。
温度:200℃—217℃
时间斜率:2-3℃/S
制订:审核:生效日期:。
電子產業之所以能夠蓬勃發展,表面貼焊技術(SMT, Surface MountTechnology)的發明及精進佔有極大程度的貢獻。
而回焊(Reflow)又是表面貼焊技術中最重要的技術之一。
這裡我們就試著來解釋一下回焊的一些技術與溫度設定的問題。
▲ Ramp-Soak-Spike(RSS)典型馬鞍式回流焊溫度曲線 ▲ Ramp-To-Spike(RTS) 斜升式回流焊溫度曲線電路板組裝的回流焊溫度曲線(reflow profile)共包括了預熱(pre-heat)、吸熱(Soak)、回焊(Reflow)和冷卻(Cooling)等四個大區塊,以下為個人的心得整理,如果有誤也請各位先進不吝指教。
預熱區(Pre-heat zone)預熱區通常是指由溫度由常溫升高至150°C 左右的區域﹐在這個區域﹐溫度緩升(又稱一次昇溫)以利錫膏中的部分溶劑及水氣能夠及時揮發﹐電子零件(特別是BGA 、IO 連接器零件)緩緩升溫﹐為適應後面的高溫預作準備。
但PCB 表面的零件大小不一﹐焊墊/焊盤連接銅箔面積也不同,其吸熱裎度也不一,為了避免零件內外或不同零件間有溫度不均勻的現象發生﹐以致零件變形,所以預熱區升溫的速度通常控制在1.5°C ~3°C/sec 之間。
預熱區均勻加熱的另一目的,是要使錫膏中的溶劑可以適度緩慢的揮發並活化助焊劑,因為大部分助焊劑的活化溫度大約落在150°C上下。
快速升溫有助快速達到助焊劑軟化的溫度,因此助焊劑可以快速地擴散並覆蓋到最大區域的焊點,它可以讓一些活化劑融入實際合金的液體中。
可是,升溫如果太快﹐由於熱應力的作用﹐可能會導致陶瓷電容的細微裂紋(micro crack)、PCB受熱不均而產生變形(Warpage)、空洞或IC晶片損壞﹐同時錫膏中的溶劑揮發太快﹐也會導致錫膏塌陷產生的危險。
較慢的溫度爬升則允許更多的溶劑揮發或氣體逃逸,它也使助焊劑可以更靠近焊點,減少擴散及崩塌的可能。
但是升溫太慢也會導致過度氧化而降低助焊劑的活性。
建議相關閱讀:介紹認識【錫膏(solder paste)】的基本知識爐子的預熱區一般佔加熱通道長度的1/4~1/3﹐其停留時間計算如下﹕假設環境溫度為25°C﹐若升溫斜率按照3°C/sec計算則[(150-25)/3]即為42sec﹐如升溫斜率按照1.5°C/sec計算則[(150-25)/1.5]即為85sec。
通常根據組件大小差異程度調整時間以調控升溫斜率在2°C/sec以下為最佳。
另外還有幾種不良現象都與預熱區的升溫有關係,下面一一說明:1. 塌陷:這主要是發生在錫膏融化前的膏狀階段,錫膏的黏度會隨著溫度的上升而下降,這是因為溫度的上升使得材料內的分子因熱而震動得更加劇烈所致;另外溫度迅速上升會使得溶劑(Solvent)沒有時間適當地揮發,造成黏度更迅速的下降。
正確來說,溫度上升會使溶劑揮發,並增加黏度,但溶劑揮發量與時間及溫度皆成正比,也就是說給一定的溫升,時間較長者,溶劑揮發的量較多。
因此升溫慢的錫膏黏度會比升溫快的錫膏黏度來的高,錫膏也就必較不容易產生塌陷。
2. 錫珠:迅速揮發出來的氣體會連錫膏都一起往外帶,在小間隙的零件下會形成分離的錫膏區塊,回焊時分離的錫膏區塊會融化並從零件底下冒出而形成錫珠。
3. 錫球:升溫太快時,溶劑氣體會迅速的從錫高中揮發出來並把飛濺錫膏所引起。
減緩升溫的速度可以有效控制錫球的產生。
但是升溫太慢也會導致過度氧化而降低助焊劑的活性。
4. 燈蕊虹吸現象:這個現象是焊料在潤濕引腳後,焊料從焊點區域沿引腳向上爬升,以致焊點產生焊料不足或空銲的問題。
其可能原因是錫膏在融化階段,零件腳的溫度高於PCB的銲墊溫度所致。
可以增加PCB底部溫度或是延長錫膏在的熔點附近的時間來改善,最好可以在焊料潤濕前達到零件腳與焊墊的溫度平衡。
一但焊料已經潤濕在焊墊上,焊料的形狀就很難改變,此時也不在受溫升速率的影響。
5. 潤濕不良:一般的潤濕不良是由於焊接過程中錫粉被過度氧化所引起,可經由減少預熱時錫膏吸收過多的熱量來改善。
理想的回焊時間應儘可能的短。
如果有其他因素致加熱時間不能縮短,那建議從室溫到錫膏熔點間採線性溫度,這樣回焊時就能減少錫粉氧化的可能性。
6. 虛焊或“枕頭效應”(Head-In-Pillow):虛焊的主要原因可能是因為燈蕊虹吸現象或是不潤濕所造成。
燈蕊虹吸現象可以參照燈蕊虹吸現象的解決方法。
如果是不潤濕的問題,也就是枕頭效應,這種現象是零件腳已經浸入焊料中,但並未形成真正的共金或潤濕,這個問題通常可以利用減少氧化來改善,可以參考潤濕不良的解決方法。
相關閱讀:BGA枕頭效應(head-in-pillow,HIP)發生的可能原因BGA虛焊NWO(Non-Wet-Open)形成的原因及可能解決方法7. 墓碑效應及歪斜:這是由於零件兩端的潤濕不平均所造成的,類似燈蕊虹吸現象,可以藉由延長錫膏在的熔點附近的時間來改善,或是降低升溫的速率,使零件兩端的溫度在錫膏熔點前達到平衡。
另一個要注意的是PCB的焊墊設計,如果有明顯的大小不同、不對稱、或是一方焊墊有接地(ground)又未設計熱阻(thermal relief)焊墊,而另一方焊墊無接地,都容易造成不同的溫度出現在焊墊的兩端,當一方焊墊先融化後,因表面張力的拉扯,會將零件立直(墓碑)及拉斜。
8. 空洞(Voids):主要是因為助焊劑中的溶劑或是水氣快速氧化,且在焊料固化前未即時逸出所致。
吸熱區 (Soak zone)一般將這個區域翻譯成「浸潤區」,但經白老師糾正,正確的名稱應該叫「吸熱區」,也稱「活性區」﹐在這段幾近恆溫區的溫度通常維持在150±10°C的區域﹐斜昇式的溫度通常落在150~190°C之間,此時錫膏正處於融化前夕﹐焊膏中的揮發物會進一步被去除﹐活化劑開始啟動﹐並有效的去除焊接表面的氧化物﹐PCB表面溫度受熱風對流的影響﹐讓不同大小、質地不同的零組件溫度能保持均勻溫度﹐板面溫度差△T接近最小值。
(如果PCB上的零件簡單,沒有太多複雜的零件,如BGA或大顆容易或不易吸熱零件,也就是說零件間的溫度可以輕易達到均勻,建議使用「斜昇式曲線」。
現代科技進步,有些回焊爐的效率好,可以快速均勻所有零件的溫度,也可以考慮「斜昇式曲線」。
「斜昇式曲線」的優點是希望確保錫膏融錫時所有焊點同時融錫,已達到最佳的焊接效果。
)建議相關閱讀:回流焊的爐溫曲線應該使用的是RSS?還是RTS型?溫度曲線形態接近水平狀﹐它也是評估回焊爐工藝的一個窗口﹐選擇能維持平坦活性溫度曲線的爐子將可提高焊接的效果﹐特別是防止立碑缺陷的產生,因為較不易造成融錫不一的時間差,零件兩端也就比較不會有應力不同的問題。
恆溫區通常在爐子的2﹐3區之間﹐時間維持約為60~120s﹐若時間過長會導致松香過度揮發,並造成錫膏過度氧化的問題﹐在回流焊接時失去活性和保護功能,以致焊接後造成虛焊、焊點殘留物發黑、焊點不光亮等問題。
此區域的溫度如果升溫太快,錫膏中的松香(助焊劑)就會迅速膨脹揮發,正常情況下,松香應該會慢慢從錫膏間的縫隙逸散,當松香揮發的速度過快時,就會發生氣孔、炸錫、錫珠等品質問題。
延伸閱讀:電阻電容小零件發生空焊及立碑的原因回焊區(Reflow zone)回焊區是整段回焊溫度最高的區域﹐通常也叫做「液態保持時間(TAL, time above liquids)」。
此時焊料中的錫會與焊墊上的銅或鎳因為「化學反應」而形成金屬間的化合物Cu5sn6或Ni3Sn4。
以OSP(有機保護膜)的表面處理為例﹐當錫膏融化後﹐會迅速潤濕銅層﹐錫原子與銅原子在其介面上互相滲透,初期Sn-Cu合金的結構為良好的Cu6Sn5介金屬化合物(IMC),為回焊爐子內的關鍵階段,因為裝配上的溫度梯度必須最小。
IMC的厚度在1-5μm都可以接受,但IMC太厚也不好,一般建議可以控制在1-3μm為最佳。
TAL必須保持在錫膏製造商所規定的參數之內。
産品的峰值溫度也是在這個階段達成的(裝配達到爐內的最高溫度),時間如果過長就會繼續生成Cu3Sn的不良IMC。
ENIG表面處理的板子,初期則會生成Ni3Sn4的IMC,但只會生成極少的Cu6Sn5化合物。
建議相關閱讀:何謂IMC (Intermetallic Compound)?IMC與PCB焊接強度有何關係?必須小心的是,溫度不可超過PCB板上任何溫度敏感元件的最高溫度和加熱速率承受能力。
例如,一個典型符合無鉛製程的鉭電容具有的最高溫度在260°C時最多只能持續10秒鐘。
理想狀況下應該讓裝配上所有的焊點同時、同速率達到相同的峰值溫度,以保證所有零件在爐內經歷相同的環境。
回焊的峰值溫度,通常取決於焊料的熔點溫度及組裝零件所能承受的溫度。
一般的峰值溫度應該比錫膏的正常熔點溫度要高出約25~30°C,才能順利的完成焊接作業。
如果低於此溫度,則極有可能會造成冷焊與潤濕不良的缺點。
冷卻區(Cooling zone)在回焊區之後,產品冷卻,固化焊點,將為後面裝配的工序準備。
控制冷卻速度也是關鍵的,冷卻太快可能損壞裝配,冷卻太慢將增加TAL,可能造成脆弱的焊點。
一般認為冷卻區應迅速降溫使焊料凝固。
迅速冷卻也可以得到較細的合晶結構,提高焊點的強度,使焊點光亮,表面連續並呈彎月面狀,但缺點就是較容易生成孔洞,因為有些氣體來不及逃逸。
相反的,在熔點以上緩慢的冷卻則容易導致過量的介金屬化合物(IMC)產生及較大的合晶顆粒,降低抗疲勞強度。
採用比較快的冷卻速率可以有效嚇阻介金屬化合物的生成。
在加速冷卻速度的同時須注意到零件耐衝擊的能力,一般的電容所容許的最大冷卻速率大約是4°C/sec。
過快的冷卻速率很可能會引起應力影響而產生龜裂(Crack)。
也可能引起焊墊與PCB或焊墊與焊點的剝離,這是由於零件、焊料、與焊點各擁有不同的熱膨脹係數及收縮率的結果。
一般建議的降溫速度為2~5°C/s之間。