QFP两面芯片的拆焊
- 格式:ppt
- 大小:1.05 MB
- 文档页数:12

线路板拆卸集成芯片的几种方法线路板拆卸集成芯片的几种方法吸锡器吸锡拆卸法使用吸锡器拆卸集成块,这是一种常用的专业方法,使用工具为普通吸、焊两用电烙铁,功率在35W以上。
拆卸集成块时,只要将加热后的两用电烙铁头放在要拆卸的集成块引脚上,待焊点锡融化后被吸入细锡器内,全部引脚的焊锡吸完后集成块即可拿掉。
医用空心针头拆卸法取医用8至12号空心针头几个。
使用时针头的内经正好套住集成块引脚为宜。
拆卸时用烙铁将引脚焊锡溶化,及时用针头套住引脚,然后拿开烙铁并旋转针头,等焊锡凝固后拔出针头。
这样该引脚就和印制板完全分开。
所有引脚如此做一遍后,集成块就可轻易被拿掉。
电烙铁毛刷配合拆卸法该方法简单易行,只要有一把电烙铁和一把小毛刷即可。
拆卸集成块时先把电烙铁加热,待达到溶锡温度将引脚上的焊锡融化后,趁机用毛刷扫掉溶化的焊锡。
这样就可使集成块的引脚与印制板分离。
该方法可分脚进行也可分列进行。
最后用尖镊子或小“一”字螺丝刀撬下集成块。
增加焊锡融化拆卸法该方法是一种省事的方法,只要给待拆卸的集成块引脚上再增加一些焊锡,使每列引脚的焊点连接起来,这样以利于传热,便于拆卸。
拆卸时用电烙铁每加热一列引脚就用尖镊子或小“一”字螺丝刀撬一撬,两列引脚轮换加热,直到拆下为止。
一般情况下,每列引脚加热两次即可拆下。
多股铜线吸锡拆卸法就是利用多股铜芯塑胶线,去除塑胶外皮,使用多股铜芯丝(可利用短线头)。
使用前先将多股铜芯丝上松香酒精溶液,待电烙铁烧热后将多股铜芯丝放到集成块引脚上加热,这样引脚上的锡焊就会被铜丝吸附,吸上焊锡的部分可剪去,重复进行几次就可将引脚上的焊锡全部吸走。
有条件也可使用屏蔽线内的编织线。
只要把焊锡吸完,用镊子或小“一”字螺丝刀轻轻一撬,集成块即可取下。

qfp芯片拆焊次数要求标准
1. 拆焊次数限制
为了确保qfp芯片的可靠性和稳定性,我们对拆焊次数有一定的限制。
通常情况下,qfp芯片的拆焊次数不应超过3次。
如果需要多次拆焊,应经过技术部门评估并确认相关操作规范。
2. 拆焊操作规范
在进行qfp芯片拆焊时,应遵循以下操作规范:
a. 使用合适的工具和设备,如热风枪、焊台等。
b. 在操作前对芯片进行充分的了解和研究,了解其引脚分布和布局。
c. 按照正确的顺序进行拆焊,避免对芯片造成损坏。
d. 在拆焊过程中,应注意控制温度和时间,避免过热或过长时间加热导致芯片损坏。
e. 在拆焊完成后,应对芯片进行质量检查,确保其正常工作。
3. 拆焊质量检查
在进行qfp芯片拆焊后,应对其进行质量检查,以确保其正常工作。
检查内容包括:
a. 引脚是否松动或脱落。
b. 芯片是否出现裂纹或破损。
c. 芯片功能是否正常。
如果检查中发现任何问题,应及时采取措施进行修复或更换芯片。
4. 拆焊记录管理
为了方便管理和追溯,应对QFP芯片的拆焊情况进行记录。
记录内容包括:
a. 拆焊日期、时间、人员等信息。
b. 拆焊原因、操作过程等信息。
c. 拆焊后质量检查结果等信息。
这些记录可以为我们提供完整的芯片拆焊历史和相关数据,以便后续分析和处理。
总之,在进行qfp芯片拆焊时,应严格遵守相关标准和规范,确保芯片的可靠性和稳定性。
同时,做好拆焊记录管理,以便后续分析和处理。

QFP64封装芯片拆卸与焊接示范[练习动手能力]今天为大家示范一下如何利用简单的工具将一片QFP64封装芯片的快速地拿下来然后再焊上新芯片的过程。
是这样的,正好有位用户的芯片在实验中损坏了,所以借这次机会为大家演示一下如何更换芯片。
对于没有试过更换芯片的朋友来说,不防参考一下。
我的工具非常简单,用一把20W功率的电烙铁(才15元,到处可以买的)和一些高温胶纸、焊锡等等。
声明:这只是一个演示,只供参考。
网友若要尝试,一切后果自负。
[1]在动手前,我们先做一些保护措施(看图片,有点好似做手术样子)。
首先用高温胶纸将芯片周围的电路围起来,防止在一会向芯片施加焊锡时不小心将锡点搞到其他电路器件的引脚上。
如果你没有防高温胶纸,也可以试用其他类似的胶纸(如电工胶布等等)。
将周围包好后,就可以对芯片四周加焊锡了。
加量一定要足,否则热量容易散发掉。
先加大量的焊锡到引脚上。
注意,烙铁头不能用力。
每次加热时最好不要超过10秒左右(因为这只是加焊而已)。
[2]第二步,也是最重要的一步(后面焊上芯片比这步容易很多)。
这步的原理是同时向芯片四周加不停地加热,加热后一定时间后使芯片能拿下来。
重要操作是用电烙铁对芯片四周加不停地加热,在四边加热时每边加热时间大概3-5秒时间(目的是保持锡堆中有一定温度存在)。
然后再换另一边,需要注意的就是建议不要按顺序地轮地着加热。
可以散乱地加热,移动电烙铁速度要快且要小心,不要碰撞芯片引脚和PCB引线(否则你的电路板将报废)。
当向四边加热到一定程度后,尝试用电烙铁对芯片引脚推动一下(小心)。
如果你的手拿着感烙铁感觉到芯片开始可以移动了,此时可以继续加热四周。
接下来再重复试试是否可以移动,如果可以完全移动芯片了。
就可以用电烙铁一边加热周围的锡堆将芯片推到防高温胶纸上。
以图片中的范例中,我只需几十秒时间就可以将芯片取拿下了(有时候可能会时间长一些)。
拿下芯片后,接下来要用电烙铁清掉芯片位置上的锡点。

qfn封装芯片焊接技巧
以下是 7 条关于“qfn 封装芯片焊接技巧”的内容:
1. 嘿,你知道吗,qfn 封装芯片焊接可是个细活啊!就像给小娃娃穿针引线一样,得特别小心。
比如说在焊接的时候,你得先把焊点清理得干干净净,这多重要啊!不然怎么能焊得牢固呢?就像盖房子得先打好地基一样,是不是这个理儿?
2. 哇塞,qfn 封装芯片焊接真的不容易啊!但咱可不能怕呀!你想想,焊接引脚的时候,不就像走钢丝一样吗,得稳稳当当的。
就像大厨炒菜一样,火候把握好了才能做出美味佳肴,咱焊接的火候也得拿捏准啊!能做到不?
3. 哎呀呀,qfn 封装芯片焊接可讲究技巧啦!就跟绣花似的。
你看,涂助焊剂的时候得均匀啊,不然就像脸上抹粉底没抹匀一样,多难看呀!那效果能好吗?可得注意啦!
4. 嘿呀,qfn 封装芯片焊接的时候可得细心呐!这就好比给宝贝女儿梳头发,得轻轻的、柔柔的。
温度控制不好,那可不行呀,芯片不就被烫坏啦?是不是得小心点?
5. 哇哦,qfn 封装芯片焊接真的得用心呀!好比骑自行车,得保持平衡呢。
焊接的速度也很关键哦,不能太快也不能太慢,就像跑步的节奏一样,得把握好,不然很容易出问题哟,知道不?
6. 哟呵,qfn 封装芯片焊接可不是随便搞搞就行的呀!简直就像走迷宫一样,得一步步来。
选择合适的工具就像选择称手的兵器,那可重要了!你说是不是呀?
7. 哈哈,qfn 封装芯片焊接真的得有一手啊!这就跟弹钢琴似的,每个音符都要弹准。
焊接的角度也得注意呀,稍有偏差可能就前功尽弃啦!可别小瞧了这些细节哦!我的观点就是,焊接 qfn 封装芯片需要耐心、细心和技巧,只要认真对待,就一定能做好!。
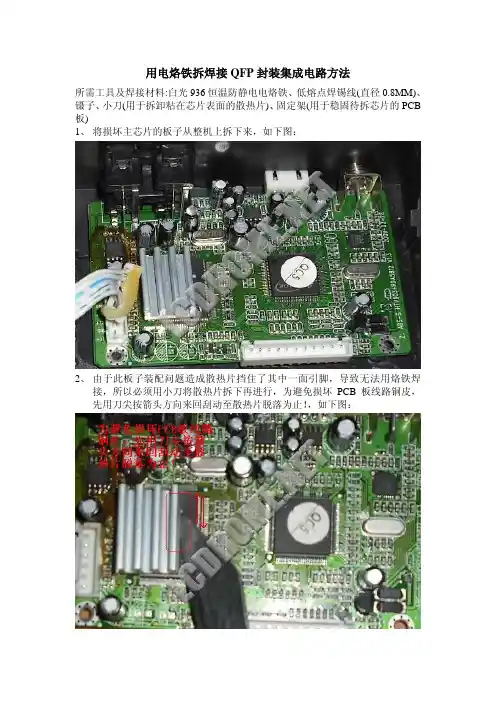
用电烙铁拆焊接QFP封装集成电路方法所需工具及焊接材料:白光936恒温防静电电烙铁、低熔点焊锡线(直径0.8MM)、镊子、小刀(用于拆卸粘在芯片表面的散热片)、固定架(用于稳固待拆芯片的PCB 板)1、将损坏主芯片的板子从整机上拆下来,如下图:2、由于此板子装配问题造成散热片挡住了其中一面引脚,导致无法用烙铁焊接,所以必须用小刀将散热片拆下再进行,为避免损坏PCB板线路铜皮,先用刀尖按箭头方向来回刮动至散热片脱落为止!,如下图:下图为成功拆除散热片后的PCB板:3、将电烙铁的温度调节至摄氏320度左右,然后往需要拆除的芯片的四面引脚加锡,见下图:然后将PCB用固定架固定好以免在来回拖动电烙铁时松动,如果找不到合适的固定架可以将PCB板子夹到自行车的车尾座上,方便又实用,电烙铁温度调整过稳定后开始往需要拆除的芯片的四面引脚加锡,直至刚好完全浸过每边的所有引脚为止,如果锡加多会漏出粘到周边的外围器为维修带来的不必要的麻烦,如果少了又拆除失败,严重还会损坏PCB线路,如下图所示:4、上面工作准备好后再将电烙铁温度调整至摄氏420度左右,以下看到的图是升温中的烙铁温度图片:5、拆焊时等温度升至稳定在420摄氏度左右时就开始为四面加满锡的芯片上面锡加热,并且需要按顺时针或逆时针方向慢慢加热熔化引脚上面的焊锡:即先加热第一排引脚至焊锡完全熔化,随即再加热第二排引脚焊锡至熔化,然后加热第三脚引脚焊锡熔化,依次类推重复以上步骤多次直至四排引脚的焊锡完全熔化,在单排引脚加热过程中需要来回移动一下电烙铁,便于均匀加热焊锡,加热方向如下图示:6、加热过程中观察四面的焊锡熔化状态,发现四面都均匀熔化后就可以用镊子在芯片的角边底下轻轻挑起芯片,直至成功拆下损坏的QFP芯片了,拆除过程中不能操之过急,以免损坏线路或焊焦PCB板子,成功拆下芯片图示:上述为拆除的过程未完待续。

qfp芯片拆焊次数要求标准简介QFP(Quad Flat Package)芯片是一种常见的表面贴装(Surface Mount Technology,简称SMT)封装形式。
在电子设备制造中,QFP芯片广泛应用于集成电路(Integrated Circuits,简称IC)的封装中。
拆焊(Desoldering)是指将原有焊接的元件从电路板上取下的过程。
本文将讨论QFP芯片的拆焊次数要求标准,以帮助人们更好地理解和正确使用QFP芯片。
1.引言QFP芯片是一种表面贴装封装形式,其引脚排列比较紧密,容易受到焊接或拆焊过程的影响。
因此,对于QFP芯片的拆焊次数有一定的要求标准。
这种要求标准主要涉及QFP芯片的结构设计、焊点可靠性和产品质量等方面。
2. QFP芯片的结构设计QFP芯片的结构设计决定了它的焊点可靠性和拆焊次数要求。
QFP 芯片通常由焊盘(Pad)、引脚(Pin)、芯片封装体和引线(Lead)组成。
焊盘和引脚之间通过引线连接,而引线连接则有助于芯片与电路板之间的电气连接。
在拆焊过程中,引线可能遭受拉力和扭矩等力量的作用,因此,结构设计必须足够强度以避免断裂或损坏,同时保证引线与焊盘之间的连接性。
3. QFP芯片的焊点可靠性焊点可靠性是QFP芯片拆焊次数要求标准的重要因素。
焊点可能受到很多因素影响,如温度循环、振动和机械应力等。
这些因素会导致焊点疲劳,从而减少焊点的可靠性。
因此,QFP芯片的拆焊次数要求标准应考虑焊点的可靠性,以保证产品在正常使用寿命内不会出现引脚断裂、引线脱焊等问题。
4.拆焊次数要求标准QFP芯片的拆焊次数要求标准通常由芯片制造商制定。
根据国际标准和行业经验,一般认为,QFP芯片的拆焊次数要求应满足以下标准:-微型QFP芯片(引脚数小于或等于100):150-200次;-标准QFP芯片(引脚数100-300):100-150次;-大型QFP芯片(引脚数大于300):50-100次。

QFN芯⽚⼿⼯焊接的⼏个技巧,芯⽚焊接⼀次成功,硬件⼯程师基础燚智能硬件开发⼤讲堂,⽤简单的语⾔,讲复杂的技术问题。
什么是QFN封装QFN,Quad Flat No-lead Package,顾名思义,四⾯⽆引脚的封装。
这⾥所谓的“⽆引脚”是指没有外露的引脚。
⼩单⽚机、蓝⽛芯⽚、升压芯⽚,灯光控制芯⽚,电源管理芯⽚等众多⼩型芯⽚采⽤QFN封装。
QFN封装的元器件,⼀般有24-48个脚,每边6-12个脚左右,间距⼀般在0.5mm。
中间有⼀⼤块接地焊盘。
表⾯上看引脚数量并不多,但实际上很难焊,容错率不⾼。
⽐BGA封装的芯⽚还难焊!如果没有合适的焊接⽅法,很多⽼硬件⼯程师都会被QFN封装给难住。
我们公司的初级硬件⼯程师,初始焊接成功率不超过10%,纯粹靠运⽓,但在采⽤了正确⽅法后,可以达到90%的⼀次成功率。
QFN芯⽚⼿⼯焊接的⼏个技巧:1、周围焊盘的锡,⽐中间焊盘的多。
2、电路板和芯⽚的周围焊盘上锡饱满均匀。
电路板上锡:电路板的焊盘上锡,跟TSOP上锡⽅式类似。
唯⼀要注意的是,中间接地焊盘点⼀点点锡就好了。
⼀定不能⿎出来。
如果不⼩⼼把中间焊盘的焊锡弄的太多了,要⽤吸锡线吸平整了。
QFN芯⽚上锡:QFN封装的焊盘,存在于芯⽚的两⾯,侧⾯和下⾯都有,类似于容阻感,QFN也需要爬锡爬到侧⾯去。
因此焊接之前先把QFN芯⽚周围的焊盘加上锡。
⼿法也是⼀样的,利⽤新焊锡丝富含助焊剂的特性,轻点引脚,即可上锡。
中间的接地焊盘同样只能点⼀点点锡。
(少于1mm长的焊锡丝锡量)焊接和⾃动归位:在焊锡和助焊剂的帮助下,QFN的芯⽚也能够⾃动归位。
热风枪把焊锡吹熔化了,轻轻的⽤镊⼦拨动芯⽚,芯⽚能够⾃动跑回来。
四个⽅向都轻推⼀下,只要不超过pin间距,能回来,既不会短路,也能够提升焊接成功率。
查看是否焊好:QFN芯⽚的电路板焊盘是超出芯⽚的,因此能够从外部观察到是否焊接好。
把助焊剂洗掉看的会更清晰。
如果每个引脚都有弧形的爬锡的痕迹,说明焊的很好,如果没有或者有个缝隙,就可能会虚焊。

QFP这种技术的中文含义叫方型扁平式封装技术(Plastic Quad Flat Package),该技术实现的CPU芯片引脚之间距离很小,管脚很细,一般大规模或超大规模集成电路采用这种封装形式,其引脚数一般都在100以上。
该技术封装CPU时操作方便,可靠性高;而且其封装外形尺寸较小,寄生参数减小,适合高频应用;该技术主要适合用SMT表面安装技术在PCB上安装布线。
目录展开编辑本段QFP封装QFP这种技术的中文含义叫方型扁平式封装技术(Plastic Quad Flat Package),该技术实现的CPU芯片引脚之间距离很小,管脚很细,一般大规模或超大规模集成电路采用这种封装形式,其引脚数一般都在100以上。
该技术封装CPU时操作方便,可靠性高;而且其封装外形尺寸较小,寄生参数减小,适合高频应用;该技术主要适合用SMT表面安装技术在PCB上安装布线。
四侧引脚扁平封装。
表面贴装型封装之一,引脚从四个侧面引出呈海鸥翼(L)型。
基材有陶瓷、金属和塑料三种。
从数量上看,塑料封装占绝大部分。
当没有特别表示出材料时,多数情况为塑料QFP。
塑料QFP 是最普及的多引脚LSI 封装。
不仅用于微处理器,门陈列等数字逻辑LSI 电路,而且也用于VTR 信号处理、音响信号处理等模拟LSI 电路。
引脚中心距有1.0mm、0.8mm、 0.65mm、0.5mm、0.4mm、0.3mm 等多种规格。
0.65mm 中心距规格中最多引脚数为304。
japon将引脚中心距小于0.65mm 的QFP 称为QFP(FP)。
但现在japon 电子机械工业会对QFP 的外形规格进行QFP了重新评价。
在引脚中心距上不加区别,而是根据封装本体厚度分为QFP(2.0mm~3.6mm 厚)、LQFP(1.4mm 厚)和TQFP(1.0mm 厚)三种。
另外,有的LSI 厂家把引脚中心距为0.5mm 的QFP 专门称为收缩型QFP 或SQFP、VQFP。

用热风枪进行SOP和QFP封装IC拆焊和焊接一、教学目标:通过本小节的学习,让学生熟悉热风枪进行SOP和QFP封装IC拆焊和焊接二、教学重点、难点:热风枪SOP和QFP封装IC拆焊和焊接三、教学过程设计:1.SOP和QFP封装IC的拆焊(1)在用热风枪拆焊贴片IC之前,一定要将手机线路板上的备用电池拆下(特别是备用电池离所拆IC较近时),否则备用电池很容易受热爆炸,对人身构成威胁。
(2)将手机线路板固定在手机维修平台上,打开带灯放大镜,仔细观察欲拆焊IC的位置和方位,并做好记录,以便焊接时恢复。
(3)用小刷子将贴片IC周围的杂质清理干净,往贴片IC管脚周围加注少许助焊剂。
(4)调好热风枪的温度和风速。
温度开关一般调至3-5档,风速开关调至2-3档。
(5)用单喷头拆卸时,应注意使喷头和所拆IC保持垂直,并沿IC周围管脚慢速旋转,均匀加热,喷头不可触及IC及周围的外围元件,吹焊的位置要准确,且不可吹跑集成电路周围的外围较小的元器件。
(6)待集成电路的管引脚焊锡全部熔化后,用医用针头或镊子将IC掀起或镊走,且不可用力,否则,极易损坏IC的锡箔。
2.SOP和QFP封装IC的焊接(1)将焊接点用平头烙铁整理平整,必要时,对焊锡较少焊点应进行补锡,然后,用酒精清洁干净焊点周围的杂质。
(2)将更换的IC和电路板上的焊接位置对好,用带灯放大镜进行反复调整,使之完全对正。
(3)先用电烙铁焊好IC的四脚,将集成电路固定,然后,再用热风枪吹焊四周。
焊好后应注意冷却,不可立即去移动IC,以免其发生位移。
(4)冷却后,用带灯放大镜检查IC的管脚有无虚焊,若有,应用尖头电烙铁进行补焊,直至全部正常为止。
(5)用无水酒精将集成电路周围清理干净。
四、课后作业或思考题:简述SOP和QFP封装IC的拆焊的整个过程?五、本节小结:1、SOP和QFP封装IC的拆焊2、SOP和QFP封装IC的焊接。

qfp封装手工焊接方法
QFP(Quad Flat Package)封装是一种表面贴装技术,它是将
芯片引脚直接焊接在PCB板的表面上,而不需要通过孔穿插
连接。
下面是手工焊接QFP封装的步骤:
1. 准备工具和材料:手持式烙铁、钳子、吸锡器、酒精清洁剂、焊锡丝、焊通剂、PCB板和QFP封装芯片。
2. 将PCB板放在工作台上,将QFP封装芯片轻轻放在PCB板的相应位置上。
3. 使用吸锡器或烙铁加热来清除QFP封装芯片引脚和PCB板
的引脚焊锡,确保焊盘和引脚干净。
4. 使用酒精清洁剂擦拭PCB板和QFP封装芯片上的引脚,以
去除任何污垢和油脂。
5. 使用烙铁预热引脚焊盘和引脚,然后使用焊通剂涂抹在焊盘上,以促进焊料的流动。
6. 取一根适当长度的焊锡丝,将焊锡丝的一端与烙铁接触,等待焊锡熔化。
7. 将熔化的焊锡移动到焊盘和引脚接触的位置,稍微加压,以确保焊锡完全覆盖焊盘和引脚。
8. 等待焊锡冷却凝固,然后用钳子将多余的焊锡剪掉。
9. 重复上述步骤,一次焊接一个引脚,确保每个引脚都焊接牢固。
10. 等待所有引脚焊接完成后,使用酒精清洁剂清洁PCB板和QFP封装芯片,以去除焊通剂和焊锡残留物。
请注意,手工焊接QFP封装是一种复杂且需要经验的工艺,如果没有经验或技术能力,建议使用自动化设备或寻求专业焊接服务来保证焊接质量。
此外,工作环境要保持整洁,并使用适当的防静电措施,以避免损坏芯片。

SMCSMD手工焊接技法【摘要】介绍了表面组装元器件手工拆焊与焊接的一些技术方法,工具的选择与使用,及需要注意的问题。
【关键词】手工焊接热风枪电烙铁SMC/SMD现代电子产品越来越多地使用表面组装元器件(SMC/SMD:Surface Mounting Components/Surface Mounting Device),利用SMT表面组装工艺或再流焊装联到电路板上。
而在产品开发、维修和电子爱好者产品制作等领域,经常遇到表面组装元器件的手工焊接。
1 工具和焊料的选择1.1 焊接工具(1)热风焊机(热风枪)。
利用热风融化焊锡或焊膏,配有不同形状的枪头;(2)电烙铁和烙铁架。
恒温焊台,具有良好接地装置,通过调节电流控制温度,配有可更换的烙铁头。
调温电烙铁,调节温度旋钮可调节温度。
普通电烙铁,有内热和外热式两种,调整烙铁头深度可调整温度。
焊接片式元器件一般选择25瓦。
常用烙铁头有凿型、锥形、蹄型、刀型等几种,加热头接触面积影响传热效率,接触面积不应超出焊盘。
烙铁架可以保护导线、物品和人体不被烫伤,有助于散热;(3)专用烙铁头。
可安在电烙铁上对芯片引脚同时加热,但尺寸规格要对应。
其它。
不锈钢镊子、吸锡带、烙铁擦(高强度纤维棉)、放大镜。
棉线手套,可以减小焊接时热量对手的热灼和铅对皮肤的污染。
1.2 焊料的选择焊料是连结被焊金属的材料。
(1)松香焊锡丝。
手工焊接常用免清洗活性焊锡丝,丝芯中助焊剂松香,在74-300℃时具有活性,加热使金属表面氧化物以金属皂形式激离。
锡62.7%、铅37.3%的配比使熔点和凝固点都在183℃,称为共晶点焊锡。
焊接片式元器件,一般选用直径0.5-0.8mm的松香焊丝。
市场上松香焊丝质量差别较大,应选择正规厂家合格产品。
表面润泽光亮有金属晶莹感的质量较好,用打火机烧锡丝头,有松香喷雾并形成晶莹光亮、有润泽剔透感的珠头;(2)焊锡膏。
由焊料金属粉末溶于浓助焊剂中制成,简称焊膏。
QF N封装芯片手工焊接方法QFN四侧无引脚扁平封装,是一种相对比较新的IC 封装形式,QFN 外观呈正方形或矩形,大小接近于CSP,很薄很轻。
元件底部具有与底面水平的焊端,在中央有一个大面积裸露焊端用来导热,围绕大面积裸露焊端的外围四周有实现电气连接的I/O 焊端,I/O 焊端有两种类型:一种只裸露出元件底部的一面,其它部分被封装在元件内;另一种焊端有裸露在元件侧面的部分。
由于其尺寸小、体积小,电气性能优越,在我所得到了越来越广泛的应用。
由于本人长期从事高密度印制板的组装及返修工作,对于QFN芯片的手工焊接及返修有一点实践经验,现与感兴趣的朋友分享一下。
一、焊接前准备1、电烙铁一般的QFN芯片都是静电敏感器件,对静电防护要求特别高,所以建议焊接前最好先对烙铁进行防静电测试,确认其符合静电防护要求。
2、加热台我们经常用的是PACE的加热台,当然也要先确认其已经良好接地并且符合静电防护要求。
3、静电手腕焊接前也需要用三用表确认其状态正常,并且良好接地。
4、其它常用工具镊子、松香笔(或自制松香水)、放大镜二、焊接步骤1、打开电烙铁及加热台以我常用的PACE烙铁为例,对焊端搪锡时,我一般把温度设置为260度左右,加热台视PCB材料及厚度选择合适的温度,一般为215度左右。
2、器件引脚与PCB焊盘搪锡这一步非常重要,锡上的好不好直接关系到焊接的质量。
上锡时,先要在QFN芯片的I/0焊端涂上一层助焊剂,然后将烙铁头擦拭干净,在烙铁头上沾少量锡(注意烙铁头上的锡一定不能太多,不然不同引脚间容易桥连),轻轻的沿着引脚排列方向拖一遍,这样在每一个引脚上就会形成一个漂亮的中间高四边略低的“枕形”焊点,然后对中央大面积裸露焊端搪锡,注意这里的锡不要搪的太多,不然容易因为中间锡的高度太高,使得I/O焊端焊不上,要尽量使得中央大面积裸露焊端与I/O焊端的搪锡高度大致一样。
到这里对于那种只裸露出元件底部的一面,其它部分被封装在元件内的QFN 芯片来说,预加工已经完成,而对于另一种焊端有裸露在元件侧面的QFN 芯片来说还没有结束。
实训项目三:手机SOP和QFP封装IC拆焊和焊接实训报告实训地点B301 时间 4.13. 实训成绩姓名班级学号指导教师签名实训目的熟练掌握手机SOP和QFP封装IC拆焊和焊接实训器材与工作环境1.手机元器件若干、手机电路板若干。
2.维修平台、防静电调温专用电烙铁、热风枪、超声波清洗器、带灯放大镜、助焊剂、清洗剂、镊子等。
3.建立一个良好的工作环境。
实训内容SOP封装IC QFP封装IC(1)QFP封装IC(2)元器件外形正方体元器件颜色黑所用拆焊工具镊子一个、助焊膏、热风枪、带灯放大镜采用的拆焊方法1、打开热风枪,并调节好温度和风力。
2、在元器件上加点助焊剂,然后用热风枪风嘴对着元器件均匀的吹送。
3、用镊子能轻轻挪动元器件,最后把元器件取出。
所用焊接工具助焊膏、镊子一个、热风枪、带灯放大镜采用的焊接方法先用电烙铁将拆焊后的电路板元器件管脚处将管脚焊锡分开,不要让其短路。
接着用热风枪加热后对元器件进行吹焊,等元器件吻合位置后移开热风枪,结束焊接。
用时20分钟详细写出某一种IC的拆焊和焊接顺序,并指出实训过程中遇到的问题及解决方法拆焊:先把热风枪调到适当温度和风力,在元器件上加点助焊剂,然后用热风枪风嘴对着元器件均匀的吹,直到用镊子能挪动元器件,最后把元器件取出。
焊接:在电路板上要焊接的管脚上加点焊锡,接着在焊接点加点助焊剂,用热风枪对着焊点吹送,再用镊子把元器件接上去,把元器件轻轻按压一阵子,最后移开热风枪,等其冷却后固定。
实训中遇到了一些问题:当在拆某些多引脚元器件时,较难将其拆除,长时间的热风枪吹送又有可能烧坏电路板和元件。
解决方法,加入较多的助焊膏,均匀地吹送,更其慢慢松动。
写出此次实训过程中的体会及感想,提出还可用其它什么方法可以实现对手机SOP 和QEP封装IC的拆焊或焊接1、热风枪的温度不能太高,否则可能会把其他元件融开,甚至会把电路板烧坏。
2、在焊接前最好要先清洁电路板表面,以便去除氧化层。
QFN封装芯片手工焊接方法
一、QFN封装芯片手工焊接
1、工具备齐
焊接QFN封装芯片,需要准备相关的工具:台式电脑、烙铁、木垫、烙铁支架、卷尺、木棍或金刚石、清洁棉签、压力夹、无氧焊锡丝、焊接钳子(建议钳子)、焊接片及焊接端子等。
2、芯片和焊盘放置位置
根据QFN封装芯片的定位孔放置芯片,然后把焊盘放在芯片下方,使得芯片的边框和焊盘的边框重合,以保证芯片的定位准确。
3、金属片拆卸
使用金刚石,先将焊盘上的金属片拆卸。
4、焊盘处理
使用木棍或金刚石,清理焊盘上的焊料,以保证焊盘的整洁,然后用清洁棉签和烙铁清理焊盘上的残留焊料,最后用木垫和烙铁将焊盘上的焊接位置处理好,以确保焊接位置的稳定。
5、焊接芯片
将芯片放在烙铁支架上,使用压力夹将芯片固定在支架上,调节烙铁的温度至200℃,然后将无氧焊锡丝放在焊接位置处,然后使用烙铁头慢慢向焊接位置处的焊锡丝润胶。
6、焊接端子
使用焊接钳子,把相应的焊接片和焊接端子夹紧,然后调节烙铁的温度至200℃,使用烙铁将焊接端子和焊接片进行焊接,焊接完成之后,用清洁棉签清理焊接位置的焊料,焊接完成。
7、焊接后处理。
手工拆焊QFP器件的方法1手工焊接基本要因影响手工焊接结果的要因主要有操作间内湿度、焊接操作手法、形成焊点焊接时间、焊接时烙铁温度、选用的烙铁头规格尺寸以及选用的焊锡丝直径等。
一个完美焊点的产生除了焊接材料具有可焊性,焊接工具(即电烙铁)功率合适,采用正确的操作方法之外,更重要的是操作者的技能水平,只有经过相当长时间的焊接练习,才能牢固掌握焊接技巧。
有些人以为用电烙铁焊接非常容易,没有什么技术含量,这是非常错误的认识,只有通过焊接实践不断用心领会,不断总结才能拥有较高的焊接技能。
1.1充分了解手工焊接要素及焊接技巧对于一个焊接操作人员来说,充分了解基本的手工焊接要素及焊接技巧是必不可少的。
烙铁头是一个储能元件,在元器件的焊接过程中,当烙铁头紧靠在相应要焊接的焊盘时,储存在烙铁头上的热能会通过金属间热传导的方式传递给焊盘,在助焊剂、焊锡丝热桥的作用下进而传递到整个焊点,焊点上实际温度逐渐升高,焊料混合物材料短时间内熔化,使焊点的温度达到所需熔融的理想状态。
在实际电路板手工焊接操作中,需要根据印制板上器件焊盘的大小,通过温控烙铁的控制器适当调整焊接温度,要根据焊点的形状大小选择尺寸相匹配的烙铁头(烙铁头的宽度与焊盘宽度相应为参考),掌握恰当的焊接时间,这些要素掌握得当以后,手工焊接出来的焊点才能达到润湿良好、光亮,可靠性才好。
焊接中烙铁主机上显示的温度与烙铁头端部的实际温度并不一致,二者之间总是存在着一定的温度差异。
另外,烙铁头的形状和尺寸是热量传递效率影响的关键因素,假如所选择的烙铁头端面尺寸偏小,这样它与焊点之间存在较小的接触面,传递的热量受限制,容易出现较为常见的冷焊;反之,倘若所选择的烙铁头端面尺寸偏大,则其存储在烙铁头端面的热量会在短时间内传递给焊点,会损坏印制电路板焊盘,出现焊盘开裂起翘现象,也易损伤焊盘四周的印制板表层,出现烫伤、白班等情况。
只有烙铁头尺寸大小合适,给焊点及时传输所需的适量热量,最终才能焊接出质量优良的焊点。