半导体物理第七章作业答案
- 格式:doc
- 大小:311.00 KB
- 文档页数:4
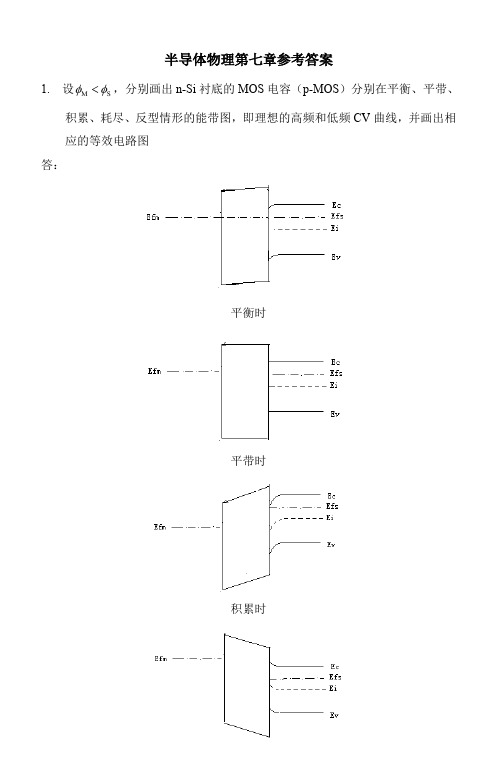
半导体物理第七章参考答案1. 设M S φφ<,分别画出n-Si 衬底的MOS 电容(p-MOS )分别在平衡、平带、积累、耗尽、反型情形的能带图,即理想的高频和低频CV 曲线,并画出相应的等效电路图 答:平衡时平带时积累时耗尽时弱反时强反时理想的高频和低频CV曲线等效电路图2. 设氧化层厚度为1μm 的Si MOS 结构的p 型衬底的掺杂浓度分别为N =1015/cm 3和1016/cm 3,比较这两种结构的耗尽层电容和MOS 电容的极小值。
答:1) 耗尽层电容由耗尽层厚度决定,而耗尽层厚度与Si 表面势有关,根据耗尽层厚度、表面势,可求得耗尽层电容为:()d Sid sdd Q C d W εψ-==又由MOS 电容为氧化层电容与耗尽层电容串联而成:dox C C C 111+= 以及栅压方程:g fb s oxV V ψ-=消去表面势s ψ,可得:C =显然,相同氧化层厚度,即相同氧化层电容,相同栅压下,衬底掺杂浓度高的MOS 结构耗尽层电容大。
2) 由C =MOS 电容的极小值出现在强反型时,此时耗尽层厚度最大,表面势为2B φ:max d W ==min maxSid d C W ε==则:1minmin 11ox d C C C -⎛⎫=+ ⎪⎝⎭当N =1015/cm 3时,12min min 1126.7ox d C F m C C μ-⎛⎫=+= ⎪⎝⎭当N =1016/cm 3时,12min min 1131.3ox d C F m C C μ-⎛⎫=+= ⎪⎝⎭3. 从物理上说明F B i C C 随氧化层厚度及掺杂浓度的变化趋势,并计算315/10cm N =,nm t ox 10=的Si MOS 结构的FB i C C 值和德拜长度。
答:由公式:11ox D FB i Si ox t L C C εε=+=+有:11FB D i iSi C L C C ε==+ 其中oxi oxC t ε=。

半导体物理与器件上海电子信息职业技术学院智慧树知到答案2024年第一章测试1.半导体材料的导电性能介于金属材料和绝缘材料之间。
()A:对 B:错答案:A2.电中性原子失去电子后带正电。
()A:错 B:对答案:B3.半导体硫化银的电阻具有负的温度系数是因为?()A:当硫化银受热时产生了更多的电子参与定向运动 B:当硫化银受热时产生了更少的电子参与定向运动答案:A4.常温下,半导体材料的电阻率在什么范围?()A:>1010Ω·cm B:10-3Ω·cm ~ 109Ω·cm C:>109Ω·cm D:<10-3Ω·cm答案:B5.是谁首先提出:将电、磁、光统归为电磁场现象的麦克斯韦方程组?()A:奥斯特 B:安培 C:麦克斯韦 D:赫兹答案:C第二章测试1.中子是带正电的。
()A:错 B:对答案:A2.中子是带负电的。
()A:错 B:对答案:A3.核外的电子是分布在能量的轨道上的()A:连续 B:不连续答案:B4.核外电子的能量是被量子化的,每份能量的大小由公式hυ确定,h是,υ表示。
()A:普朗克常量,波的频率 B:波的频率,普朗克常量答案:A5.一个主量子数是不能精确确定电子的轨道的,每个轨道里面还可以再细分,即还有分壳层,它用表示的。
()A:字母,例如s,p,d,… B:数字,例如1,2,3,…答案:A第三章测试1.N型半导体主要靠自由电子运动导电,也称为电子半导体。
()A:对 B:错答案:A2.P型半导体主要靠空穴运动导电,也称为空穴半导体。
()A:对 B:错答案:A3.PN结中载流子的运动是这样的:P型半导体中的多子空穴向N区扩散,留下不可移动的负离子;N型半导体的多子电子向P区扩散,留下不可移动的正离子。
()A:错 B:对答案:B4.在硅或锗的晶体中掺入少量的5 价杂质元素,如磷、锑、砷等,可以构成。
()A:P型半导体 B:N型半导体答案:B5.在硅或锗的晶体中掺入少量的3 价杂质元素,如硼、镓、铟等,可以构成。

半导体物理学第七版完整答案修订版IBMT standardization office【IBMT5AB-IBMT08-IBMT2C-ZZT18】第一章习题1.设晶格常数为a 的一维晶格,导带极小值附近能量E c (k)和价带极大值附近能量E V (k)分别为:E C (K )=0220122021202236)(,)(3m k h m k h k E m k k h m k h V -=-+ (1)禁带宽度;(2)导带底电子有效质量;(3)价带顶电子有效质量;(4)价带顶电子跃迁到导带底时准动量的变化解:(1)2. 晶格常数为0.25nm 的一维晶格,当外加102V/m ,107 V/m 的电场时,试分别计算电子自能带底运动到能带顶所需的时间。
解:根据:tkhqE f ∆∆== 得qE k t -∆=∆补充题1分别计算Si (100),(110),(111)面每平方厘米内的原子个数,即原子面密度(提示:先画出各晶面内原子的位置和分布图)Si 在(100),(110)和(111)面上的原子分布如图1所示:(a )(100)晶面 (b )(110)晶面(c )(111)晶面补充题2一维晶体的电子能带可写为)2cos 81cos 87()22ka ka ma k E +-=(, 式中a 为 晶格常数,试求(1)布里渊区边界;(2)能带宽度;(3)电子在波矢k 状态时的速度;(4)能带底部电子的有效质量*n m ;(5)能带顶部空穴的有效质量*p m解:(1)由0)(=dk k dE 得 an k π= (n=0,?1,?2…)进一步分析an k π)12(+= ,E (k )有极大值,ank π2=时,E (k )有极小值所以布里渊区边界为an k π)12(+=(2)能带宽度为222)()mak E k E MINMAX =-( (3)电子在波矢k 状态的速度)2sin 41(sin 1ka ka ma dk dE v -==(4)电子的有效质量能带底部 an k π2=所以m m n2*= (5)能带顶部 an k π)12(+=, 且**n p m m -=,所以能带顶部空穴的有效质量32*mm p =半导体物理第2章习题1. 实际半导体与理想半导体间的主要区别是什么答:(1)理想半导体:假设晶格原子严格按周期性排列并静止在格点位置上,实际半导体中原子不是静止的,而是在其平衡位置附近振动。

第 1 页第一章 半导体中的电子状态1. 设晶格常数为 a 的一维晶格,导带极小值附近能量 E c (k )和价带极大值附近 能量 E v (k )分别为:E c (k)=2 2h k + 3m 02h (k − m 0k1) 2和 E v (k)= 2 2h k - 6m 0322h k ; m 0m 0为电子惯性质量,k 1=1/2a ;a =0.314nm 。
试求: ①禁带宽度;②导带底电子有效质量; ③价带顶电子有效质量;④价带顶电子跃迁到导带底时准动量的变化。
[解] ①禁带宽度 Eg22h k − k =0;可求出对应导带能量极小值 E min的 k 值:根据 dEc (k ) =2h k +2( dk 3m 0m 03 ,1 )k min= k 14由题中 E C式可得:E min=E C(K)|k=k min=h k 2;m 401 由题中 E V式可看出,对应价带能量极大值 Emax 的 k 值为:k max=0;2 2 2h 2并且 E min=E V(k)|k=k max=k ;∴Eg =E min-E max=hk 1= h 21 6m 12m48m a 20 −27 20 0=×−28× (6.62 ×10) −8 2 ×× −11=0.64eV48 × 9.1 10(3.14 ×10 1.6 10②导带底电子有效质量 m n22 2 22d E C= 2h + 2h = 8h ;∴ m n= h2 / d E C =3 m 0dk 23m 0 m 0 3m 0dk 28 ③价带顶电子有效质量 m ’222d E V= −6h'=,∴ mh2/ d E V= − 1 mdk 2m 0ndk 2 6 0④准动量的改变量h△k = h (k min-k max)=3 4h k1=3h 8a2. 晶格常数为 0.25nm 的一维晶格,当外加 102V/m ,107V/m 的电场时,试分别 计算电子自能带底运动到能带顶所需的时间。

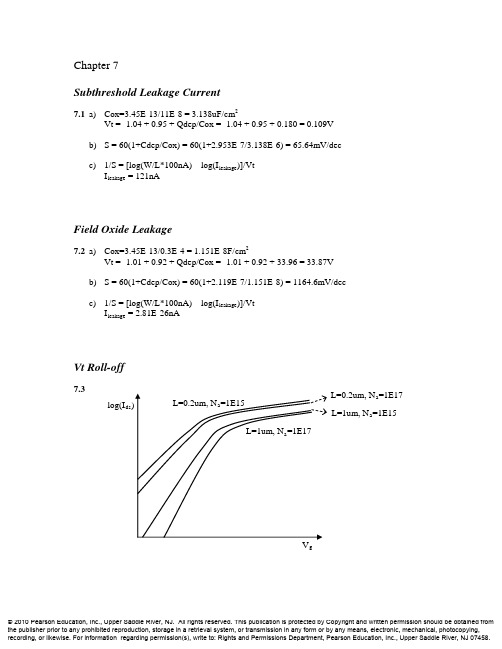
第一章习题1.设晶格常数为a 的一维晶格,导带极小值附近能量E c (k)和价带极大值附近能量E V (k)分别为:E c =0220122021202236)(,)(3m k h m k h k E m k k h m k h V -=-+ (1)禁带宽度;(2) 导带底电子有效质量; (3)价带顶电子有效质量;(4)价带顶电子跃迁到导带底时准动量的变化 解:(1)2. 晶格常数为0.25nm 的一维晶格,当外加102V/m ,107 V/m 的电场时,试分别计算电子自能带底运动到能带顶所需的时间。
解:根据:tkh qE f ∆∆== 得qE k t -∆=∆η补充题1分别计算Si (100),(110),(111)面每平方厘米内的原子个数,即原子面密度(提示:先画出各晶面内原子的位置和分布图)Si 在(100),(110)和(111)面上的原子分布如图1所示: (a )(100)晶面 (b )(110)晶面(c )(111)晶面补充题2一维晶体的电子能带可写为)2cos 81cos 87()22ka ka ma k E +-=η(, 式中a 为 晶格常数,试求(1)布里渊区边界; (2)能带宽度;(3)电子在波矢k 状态时的速度;(4)能带底部电子的有效质量*n m ;(5)能带顶部空穴的有效质量*p m解:(1)由0)(=dk k dE 得 an k π=(n=0,±1,±2…) 进一步分析an k π)12(+= ,E (k )有极大值,ank π2=时,E (k )有极小值所以布里渊区边界为an k π)12(+=(2)能带宽度为222)()ma k E k E MIN MAX η=-( (3)电子在波矢k 状态的速度)2sin 41(sin 1ka ka ma dk dE v -==ηη (4)电子的有效质量 能带底部 an k π2=所以m m n2*= (5)能带顶部 an k π)12(+=, 且**n p m m -=,所以能带顶部空穴的有效质量32*mm p =半导体物理第2章习题1. 实际半导体与理想半导体间的主要区别是什么?答:(1)理想半导体:假设晶格原子严格按周期性排列并静止在格点位置上,实际半导体中原子不是静止的,而是在其平衡位置附近振动。
第七章金属和半导体的接触1. 基本概念1)什么是金属的功函数?答:金属费米能级的电子逸出到真空中所需要的能量,即()m F m E E W −=0。
其中E 0:真空中电子的静止能量,(E F )m :金属的费米能。
随着原子序数的递增,金属的功函数呈周期性变化。
2)什么是半导体的电子亲和能?答:半导体导带底的电子逸出到真空中所需要的能量,即C 0E E −=χ。
其中E 0:真空中电子的静止能量,E C :半导体导带底的能量。
3)以金属-n 型半导体接触为例,如果金属的功函数大于半导体的功函数,即W m >W s ,则半导体表面的空间电荷、电场和表面势垒具有什么特点?如果W m >W s ,又如何呢?答:金属-n 型半导体接触,如果W m >W s ,电子从半导体流向金属。
半导体表面形成正的空间电荷区,电场方向由体内指向表面,形成表面势垒。
在势垒区,空间电荷主要由电离施主形成,电子浓度比体内低很多,为高阻区域,称为阻挡层。
如果W m <W s ,电子从金属流向半导体,势垒区电子浓度比体内大很多,为高电导区,称为反阻挡层。
4)什么是表面态对势垒的钉扎?答:表面态密度存在时,即使不与金属接触,表面也会形成势垒。
高的表面态密度,可以屏蔽金属接触的影响,使半导体势垒高度几乎与金属的功函数无关,即势垒高度被高的表面态密度钉扎(pinned )5)为什么金属-n 型半导体接触器件具有整流作用?答:外加电压V ,如果使金属的电势升高,由于n 型半导体高阻挡层为高阻区,外压V 将主要降落在阻挡层,则势垒下降,电阻下降。
反之,如果金属的电势下降,则势垒增高,势垒区电子减少(多子),电阻更高。
因此阻挡层具有类似于pn 结的整流作用。
6)以金属-n 型半导体接触为例,写出势垒宽度大于电子的平均自由程时,其扩散电流密度与电压的关系。
与pn 结的电流密度-电压关系比较,各自具有什么相同和不同的特点?答:金属-n 型半导体接触,扩散电流为⎟⎟⎠⎞⎜⎜⎝⎛−=1kT qV sD e J J ,()T k qVr D D sD D e V V qN J 02/102−⎭⎬⎫⎩⎨⎧−=εεσ 与pn 结的电流密度-电压关系比较,二者均具有单向性的特征;所不同的是,金属-n 型半导体接触的反向电流随外加电压增加呈1/2次方增加,而pn 结的反向电流不随电压变化。
固体物理与半导体物理智慧树知到课后章节答案2023年下浙江大学浙江大学第一章测试1.半导体电阻率的范围通常为()Ω·cmA:B:>10C:D:>>10答案:2.半导体的特性包括()A:导通特性B:温度敏感性C:光敏感性D:杂质敏感性答案:温度敏感性;光敏感性;杂质敏感性3.随着温度升高,半导体的电阻率一定升高()答案:错4.半导体材料的电阻率,跨越了非常大的范围,使得我们能够通过各种效应来对它们进行调制,比如,我们可以通过掺杂改变半导体的电阻率()A:对 B:错答案:对5.摩尔定律,是指单位面积的集成电路上晶体管数目,或者说集成电路的集成度,每18个月要增加一倍。
()A:错 B:对答案:对第二章测试1.半导体材料最常见的晶体结构不包括()A:纤锌矿型结构B:闪锌矿型结构C:金刚石型结构D:密堆积结构答案:密堆积结构2.描述晶体结构的最小体积重复单元的是()A:原胞B:晶胞D:基矢答案:原胞3.正四面体的对称操作有()个A:24B:32C:16D:8答案:244.晶体结构的基本特点不包括()A:周期性B:重复性C:各向异性D:单一性答案:各向异性;单一性5.各向异性不是晶体的基本特性之一。
()A:对 B:错答案:错第三章测试1.每个布里渊区的体积均相等,都等于倒格子()的体积。
A:单胞B:原胞C:晶胞D:晶体答案:原胞2.周期性边界条件决定了电子的波矢K在第()布里渊区内可取值数量与晶体的初基元胞数N相等。
A:三B:二C:四D:一答案:一3.布里渊区的特点不包括 ( )A:各个布里渊区的形状都不相同B:各布里渊区经过适当的平移,都可移到第一布里渊区且与之重合C:每个布里渊区的体积都不相等D:晶体结构的布喇菲格子虽然相同,但其布里渊区形状却不会相同答案:每个布里渊区的体积都不相等;晶体结构的布喇菲格子虽然相同,但其布里渊区形状却不会相同4.对于一定的布喇菲晶格,基矢的选择是不唯一的,但是对应的倒格子空间是唯一的。
第七章 半导体表面层和MIS 结构
(1)p 型Si 的掺杂浓度分别为N =1015/cm 3,1017/cm 3。
求表面刚刚达到强反型时的表面层电荷面密度,空间电荷层厚度和表面最大电场。
N =1015/cm 3时,
1710=N /cm 3时,
2/10)4(A F s M eN V d εε=2/10)4(A F s M B N eV Q εε-=kT eV i kT E E i F
F Fi e n e n p ==-0i A i F n N e kT n p e kT V ln ln 0==00εεεεs BM s n BM M Q Q Q E -≈+-=]/[1076.8)4(2102/10cm e N eV Q A F s M B ⨯-=-=εε︒⨯==A eN V d A F s M 32/101076.8)4(εε]/[1032.140
0cm V Q Q Q E s BM s n BM M ⨯=-≈+-=εεεε)(41.0105.110ln 026.01017
V V F =⨯=]/[1004.1)4(2122/10cm e N eV Q A
F s M B ⨯-=-=εε︒⨯==A eN V d A
F s M 32/101004.1)4(εε
(2)氧化层厚度为1μm 的Si MOS 结构的p 型衬底的掺杂浓度分别为N =1015/cm 3,1016/cm 3,比较这两种结构的氧化层电容和耗尽层电容在决定结构总电容中的作用。
N A 大d s 小, C D 大, C i 作用大。
(3)在MOS 结构C V -特性测量的应用中,平带电容有什么作用? 可根据平带电容来确定平带电压
(4)从物理上说明C FB /C i 随氧化层厚度及掺杂浓度的变化趋势。
由
图查N =1015/cm 3,d i =1000A 0的Si MOS 结构的C FB /C i 值,由此估算
德拜长度。
与直接算得的值进行比较。
d i 大, C FB /C i 更接近1; p 0大, L D 小, C FB /C i 更接近1.
查图得C FB /C i =0.7, 估算L D =1.35⨯103 A ︒
直接计算得L D =1.31⨯103 A ︒
(5)试讨论平带电压V FB 及阈值电压V T 中各个项的来源:
i BM F FB T i ox i fc ms FB C Q V V V C Q C Q V V -+='--=2;
V FB 各项的来源分别为:功函数之差、“附着”于半导体表面的电
荷、和氧化层中的电荷对半导体表面层内能带弯曲产生的影响。
V T 各项的来源分别为:平带电压、理想情况半导体内部的电压降
V s =2V F 、理想情况绝缘层上的电压降V i 。
]
/[1057.1500cm V Q Q Q E s BM s n BM M ⨯=-≈+-=εεεεD i s s i i C C d d C 11100+=+=εεεεi s D
i i s D i i FB d L C L d C εεεεεε+=+=1100020p e kT L s
D εε=
(6)对于Al-SiO 2-Si 结构,Al 的功函数4.2eV ;SiO 2的厚度为0.1μm ,
介电常数为3.8;介面固定电荷密度为5×1010/cm 2;Si 的电子亲和能为4.24eV ,p 型衬底的掺杂浓度为1.5×1015/cm 3(相应的沟道为n 型的)。
求
1)求阈电压。
2)当掺杂浓度增加为1016/cm 3,阈电压如何变化?为甚么?
3)讨论金属功函数,氧化层电荷对结构阈电压的影响。
i BM F FB T i ox i fc ms FB C Q V V V C Q C Q V V -+='--=2;
W s =χ+eV F +εg /2=5.1 eV
V C Q V V i fc ms FB 14.1-=-=
1) V C Q V V V i
BM F FB T 02.02-=-+= 2) 当掺杂浓度增加为1016/cm 3,阈电压?
3) 金属功函数增加,V ms ? 阈电压? 氧化层电荷增加,阈电压?
(7)设氧化层厚度为0.1μm ,其中钠离子的面密度为1012/cm 2。
对以下三种情形求钠离子对Si MOS 结构平带电压的贡献
1)钠离子均匀分布 2)三角形分布,金属附近最密
3)三角形分布,金属附近为零
(1)
V n N e kT n p e kT e E E V i A i F i F 3.0ln ln /)(0===-=240/1037.3cm
pF d C i i i ⨯==εε]/[1009.1)
4(2112/10cm e N eV Q A F s M B ⨯-=-=εε2)(0Q dx d x x Q i
d i ox =='⎰ρi d Q
x =)(ρ
(2)
(3)
Q =1012 e/cm 2……
(8)对于氧化层厚度为1μm 的MOS 电容,正负温偏平带电压移动20V ,求氧化层内可动离子的密度。
正温偏时:
负温偏时:
(9)对于不含可动离子的MOS 结构,平带电压与V ms 及Q f c 有关。
如何由不同氧化层厚度的相同结构的C V -特性的测量,同时确定V ms 及Q f c ?
由C V -得V FB -1/C i 曲线,该曲线斜率为-Q f c ,截距为V ms . )()(x d d a x i i -=ρdx x Q i d ⎰=0)(ρi d Q a 2=3)(0Q dx d x x Q i d i ox =='⎰ρx d a x i
=)(ρdx x Q i d ⎰=0)(ρi d Q a 2=32)(0Q dx d x x Q i d i ox =='⎰ρi ox
i f ms FB C Q C Q V V --=)2(i f ms FB C Q V V -=)1(]/[102.4)8.3)()((1010.2)(21110)2()1(cm e V V d V C V V C Q i FB i FB i FB FB i ox ⨯=∆⨯=∆=-=εμ。