CCL覆铜板制程简介
- 格式:ppt
- 大小:1.26 MB
- 文档页数:23


ccl 覆铜板(CCL 覆铜板)一、铜箔基板CCL(覆铜板)简称CCL,为PC板的重要机构组件。
它是由铜箔(皮)、树脂(肉)、补强材料(骨骼)、及其它功能补强添加物(组织)组成。
PC板种类层数应用领域纸质酚醛树脂单、双面板(&FR1,FR2)电视、显示器、电源供应器、音响、复印机、录放机、计算器、电话机、游乐器、键盘环氧树脂复合基材单、双面板(CEM1、CEM3)电视、显示器、电源供应器、高级音响、电话机、游乐器、汽车用电子产品、鼠标、电子记事本玻纤布环氧树脂单、双面板(4)适配卡、计算机外设设备、通讯设备、无线电话机、手表、游乐器玻纤布环氧树脂多层板(FR4和FR5)桌上型计算机、笔记型计算机、掌上型计算机、硬盘机、文书处理机、呼叫器、行动电话、IC卡、数字电视音响、传真机、汽车工业、军用设备二、特征码定位器CCL寻找出防病毒软件报警的PE文件(病毒、木马等)中恶意代码的位置◆强大的自动检测功能,可以定位PE文件中的多处特征码◆自由的参数设置,定制自己的手动检测◆可以选择定位精度和检测范围◆可以对某区间填充0,排除该区间的干扰◆可以浏览定位结果并保存一般印制板用基板材料可分为两大类:刚性基板材料和柔性基板材料。
一般刚性基板材料的重要品种是覆铜板。
它是用增强材料(加固材料),浸以树脂胶黏剂,通过烘干、裁剪、叠合成坯料,然后覆上铜箔,用钢板作为模具,在热压机中经高温高压成形加工而制成的。
一般的多层板用的半固化片,则是覆铜板在制作过程中的半成品(多为玻璃布浸以树脂,经干燥加工而成)。
覆铜箔板的分类方法有多种。
一般按板的增强材料不同,可划分为:纸基、玻璃纤维布基、复合基(CEM系列)、积层多层板基和特殊材料基(陶瓷、金属芯基等)五大类。
若按板所采用的树脂胶黏剂不同进行分类,常见的纸基CCI。
有:酚醛树脂(XPC、xxxpc、FR一1、FR一2等)、环氧树脂(Fe一3)、聚酯树脂等各种类型。
常见的玻璃纤维布基CCL有环氧树脂(FR-4、FR-5),它是目前最广泛使用的玻璃纤维布基类型。

覆铜板生产工艺覆铜板是一种常见的电子基板材料,广泛应用于各种电子设备和电路板的制造中。
下面将简要介绍一下覆铜板的生产工艺。
首先,覆铜板的生产开始于基材的准备。
基材通常是玻璃纤维布或金属箔,根据需求的不同会选择不同的基材。
在基材表面涂覆上一层铜箔,这一层铜箔起到了连接器件和电路之间的桥梁作用,因此质量需要保证。
接下来是图案生成。
在覆铜板上涂覆上一层光敏胶,然后将电路图案通过排版、曝光、显影等步骤转移到光敏胶上。
显影完成后,光敏胶只留下图案所需的部分。
这一步骤的关键在于曝光的准确性和显影的完整性,只有确保这两个步骤的质量,才能保证图案的准确传输。
然后是腐蚀。
将覆铜板浸入酸性腐蚀液中,只有未被光敏胶保护的部分铜箔才会被腐蚀掉。
这样就形成了所需的图案。
腐蚀需要注意的是控制腐蚀液的浓度和温度,确保腐蚀速度适中,以免损坏基材或图案。
接下来是去除光敏胶。
将覆铜板放入去胶液中,去除光敏胶,暴露出铜箔。
去胶液需要注意的是,既要彻底去除光敏胶,又要不影响铜箔的质量。
最后是钻孔和外层铜层。
将覆铜板放入钻床中,按照设计要求钻孔。
然后通过电镀方法,在铜箔上电镀一层厚度适中的铜,以加强连接点的导电性能,并且保护铜箔不被氧化。
至此,覆铜板的生产工艺基本完成。
但是需要特别注意的是,每一步骤都需要严格的质量控制,以确保最终产品的质量和可靠性。
覆铜板生产中常见的问题包括图案传输失真、腐蚀不完全、去胶不彻底等等,需要通过工艺改进和生产控制来避免这些问题的发生。
总结起来,覆铜板生产工艺包括基材准备、图案生成、腐蚀、去胶、钻孔和外层铜层等步骤。
每个步骤都需要控制好质量,确保生产出高质量的覆铜板产品。

覆铜板覆铜板的英文名为:copper clad laminate,简称为CCL,由石油木浆纸或者玻纤布等作增强材料,浸以树脂,单面或者双面覆以铜箔,经热压而成的一种产品。
是PCB的基本材料,所以也叫基材。
当它应用于生产时,还叫芯板。
目录覆铜板的结构>覆铜板的分类>常用的覆铜板材料及特点>覆铜板的非电技术指标>覆铜板的用途覆铜板的结构1.基板高分子合成树脂和增强材料组成的绝缘层压板可以作为敷铜板的基板。
合成树脂的种类繁多,常用的有酚醛树脂、环氧树脂、聚四氟乙烯等。
增强材料一般有纸质和布质两种,它们决定了基板的机械性能,如耐浸焊性、抗弯强度等。
2.铜箔它是制造敷铜板的关键材料,必须有较高的导电率及良好的焊接性。
要求铜箔表面不得有划痕、砂眼和皱褶,金属纯度不低于99.8%,厚度误差不大于±5um。
按照部颁标准规定,铜箔厚度的标称系列为18、25、35、70和105um。
我国目前正在逐步推广使用35um厚度的铜箔。
铜箔越薄,越容易蚀刻和钻孔,特别适合于制造线路复杂的高密度的印制板。
3.覆铜板粘合剂粘合剂是铜箔能否牢固地覆在基板上的重要因素。
敷铜板的抗剥强度主要取决于粘合剂的性能。
>覆铜板的分类根据PCB的不同要求和档次,主要基材——覆铜板有很多产品品种。
它们按不同的规则有不同的分类。
(1)按覆铜板不同的机械刚性划分按覆铜板的机械刚性划分,可分为刚性覆铜板和挠性覆铜板。
(2)按不同的绝缘材料、结构划分又分为有机树脂类覆铜板、金属基(芯)覆铜板、陶瓷基覆铜板。
(3)按不同的绝缘层的厚度划分则可分为常规板和薄型板。
(4)按所采用不同的增强材料划分,这种划分,当覆铜板使用某种增强材料,就将该覆铜板称为某种材料基板。
常用的不同增强材料的刚性有机树脂覆铜板有三大类:玻纤布基覆铜板;纸基覆铜板;复合基覆铜板。
另外还有特殊增强材料构成的覆铜板还有:芳酰胺纤维无纺布基覆铜板、合成纤维基覆铜板等。
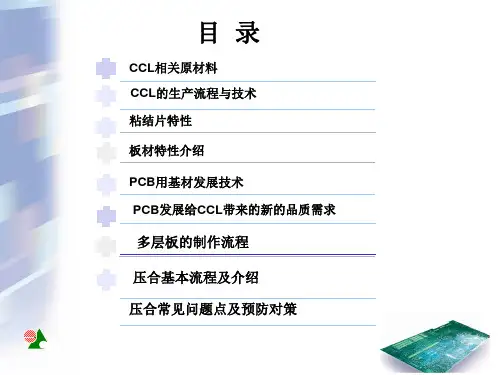

覆铜板制作过程覆铜板是一种常用于电子产品中的基材,它的制作过程经历了多个步骤,需要经过精密的操作和控制。
下面我将以人类的视角为您描述一下覆铜板的制作过程。
制作覆铜板的第一步是准备基材。
基材通常采用玻璃纤维布,它具有良好的绝缘性能和机械强度。
在制作过程中,需要将玻璃纤维布分成适当的大小,并确保表面光滑平整,以便后续的涂覆和压合工艺。
接下来,对基材进行涂覆。
涂覆工艺是将铜箔均匀地覆盖在基材表面,以形成覆铜层。
这一步骤通常使用涂覆机进行,将铜箔从卷筒中拉出,经过一系列的辊轮和刮刀,使其均匀地附着在基材上。
涂覆完成后,需要经过烘干和固化的过程,以确保覆铜层的牢固性和稳定性。
然后,进行压合工艺。
压合是将涂覆好的基材与另一片铜箔进行层叠,并通过高温高压的条件下进行加热和压制,使覆铜层与铜箔牢固地结合在一起。
这一步骤主要通过压合机来完成,其中需要控制好温度、压力和时间等参数,以确保覆铜板的质量和性能。
接着,进行镀铜工艺。
镀铜是为了增加覆铜板的导电性能和耐腐蚀性。
在这一步骤中,需要将覆铜板浸入铜盐溶液中,并通过电解的方式,使铜离子在覆铜层表面还原成金属铜,并沉积在上面。
这样就形成了一层厚度均匀的铜层,提高了覆铜板的导电性能和耐腐蚀性。
进行表面处理。
表面处理是为了提高覆铜板的焊接性能和防止氧化。
在这一步骤中,可以采用化学方法或机械方法对覆铜板进行处理。
化学方法主要是通过浸泡在酸碱溶液中,去除表面氧化层和污染物。
机械方法则是通过研磨或抛光等方式,使表面平整光滑,提高焊接性能和表面质量。
通过以上几个步骤,覆铜板的制作过程就完成了。
整个过程需要经过严格的控制和操作,以确保覆铜板的质量和性能符合要求。
覆铜板作为电子产品中的重要组成部分,在现代科技发展中发挥着重要的作用。

陶瓷覆铜板 amb工艺陶瓷覆铜板(Ceramic Copper Clad Laminate, 简称CCL)是一种用于电子电路的基板材料,它将陶瓷和铜材料结合在一起,具有优异的电气性能和机械性能。
在AMB工艺下,陶瓷覆铜板的制备过程更为精细,可以提高其性能和可靠性。
一、陶瓷覆铜板的基本结构陶瓷覆铜板由多层陶瓷介质层和内外层铜箔组成。
陶瓷介质层通常采用高纯度的氧化铝或氮化铝材料,内外层铜箔通过铜箔粘结层与陶瓷介质层紧密结合在一起。
二、AMB工艺的特点AMB工艺,即Additive Method of Buried Ceramic,是一种新兴的陶瓷覆铜板制备技术。
与传统的多层印制电路板制备工艺相比,AMB工艺具有以下特点:1. 可实现更高的线路密度:AMB工艺通过在陶瓷介质层中添加导电层,使得电路线路可以在不同层之间穿梭,从而实现更高的线路密度。
2. 降低了板厚:传统的多层印制电路板制备过程中,每增加一层电路,板厚将增加。
而AMB工艺中,陶瓷介质层可以更薄,从而降低了整个板厚。
3. 提高了信号传输速度:由于AMB工艺的线路更短,信号传输速度更快,从而提高了整个电路的工作效率。
4. 提高了电路的可靠性:陶瓷材料具有优异的机械性能和热稳定性,可以有效提高电路的抗震动、抗高温和抗湿热的能力,从而提高了整个电路的可靠性。
三、陶瓷覆铜板AMB工艺的制备过程陶瓷覆铜板AMB工艺的制备过程主要包括以下几个步骤:1. 制备陶瓷介质层:首先,选择高纯度的陶瓷材料,通过磨粉、混合和压制等工艺制备出所需的陶瓷介质层。
2. 制备导电层:在陶瓷介质层中,通过AMB工艺添加导电材料,形成导电层。
导电材料通常选择铜粉、银粉等。
3. 制备铜箔:选择高纯度的铜材料,通过化学方法或机械方法制备出所需的铜箔。
4. 组合陶瓷介质层和铜箔:将陶瓷介质层和铜箔通过粘结层进行组合,形成陶瓷覆铜板的基本结构。
5. 进行烧结和压制:将组合好的陶瓷覆铜板进行烧结和压制,使其形成坚固的整体结构。

覆铜板工艺流程
《覆铜板工艺流程》
覆铜板是电子元件制造中常用的一种材料,其工艺流程包括以下几个步骤:
1. 材料准备:首先需要准备好玻璃纤维布、铜箔、覆盖剂等材料。
玻璃纤维布是覆铜板的基材,铜箔用于覆盖在玻璃纤维布上,而覆盖剂用于保护覆铜板的表面。
2. 切割玻璃纤维布:将玻璃纤维布按照设计要求进行切割,使其大小符合实际需要。
3. 铜箔覆盖:将铜箔覆盖在玻璃纤维布上,通过加热和压力使其与基材粘合在一起。
4. 图形化覆铜板:利用光刻技术,将设计好的图形在覆铜板上形成图案。
然后通过化学蚀刻或机械雕刻的方式将不需要的铜箔部分去除,使得铜箔只残留在需要的位置上。
5. 防护处理:对覆铜板进行表面处理,以防止氧化和污染。
6. 最终检验:检查覆铜板的性能和质量,确保其符合设计要求。
以上便是覆铜板的工艺流程,该流程涉及到多种材料和工艺,需要经过多道工序才能完成最终的产品。
在电子元件制造中,覆铜板的质量和性能对整个产品的稳定性和可靠性有着重要影
响,因此在生产过程中需要严格控制每一个环节,确保产品的质量。



ccl铜箔基板技术及发展趋势介绍CCL铜箔基板技术及发展趋势介绍引言:随着电子产品的不断发展和智能化趋势的增强,高性能、高可靠性的电子基板需求不断增加。
CCL(Copper Clad Laminate,铜箔覆盖板)作为一种重要的基板材料,其技术也在不断发展。
本文将介绍CCL铜箔基板技术的基本概念以及其发展趋势。
一、CCL铜箔基板技术的基本概念CCL铜箔基板是将铜箔覆盖在绝缘材料上,形成一种具有导电性能的基板。
其主要作用是提供电子元器件之间的连接和电路布线。
CCL 铜箔基板具有优异的导电性能、机械强度和耐热性,是制造高性能电子产品的重要组成部分。
CCL铜箔基板技术的发展主要包括以下几个方面:1. 材料方面的发展随着电子产品对高速信号传输和高频率应用的需求增加,CCL铜箔基板材料也在不断发展。
传统的FR-4基板材料逐渐被高频材料取代,如PTFE(聚四氟乙烯)基板、RF(射频)基板等。
这些新型材料具有更低的介电常数和损耗,能够提供更好的信号传输性能和抗干扰能力。
2. 工艺方面的改进随着电子产品的微型化和高密度化,CCL铜箔基板的制造工艺也在不断改进。
例如,采用更薄的铜箔和更小的孔径,以提供更高的布线密度和更好的信号传输性能。
此外,还引入了更先进的光刻技术和电镀工艺,以实现更精细的线路图案和更好的连接可靠性。
3. 环保方面的要求随着环保意识的增强,CCL铜箔基板技术也在朝着环保方向发展。
传统的CCL生产过程中会产生大量的有机溶剂和废水,对环境造成一定的污染。
因此,研发更环保的CCL生产工艺和材料已经成为行业的重要趋势。
例如,采用水基清洗代替有机溶剂清洗,使用无铅焊接材料等。
二、CCL铜箔基板技术的发展趋势随着电子产品的不断发展和市场需求的变化,CCL铜箔基板技术也面临着一些发展趋势。
1. 高速信号传输的需求随着移动通信、物联网等领域的迅猛发展,对高速信号传输的需求也越来越高。
因此,CCL铜箔基板技术需要不断提高信号传输性能,以满足高速数据传输和低延迟的要求。
一、专业知识简介覆铜箔积层板(Copper Clad Laminate),简称覆铜板或基板,英文简称CCL,是电子行业的基础材料,是由介电层(树脂Resin ,玻璃纤维Glass fiber ),及高纯度的导体(铜箔Copper foil )二者所构成的复合材料(Composite material),可在其上形成导电图形。
CCL是PCB制造不可缺少的原材料之一,根据NEMA标准可划分为G10、G11、FR-4、FR-5四种环氧玻璃纤维布基覆铜板。
我们公司生产的主要为FR-4基板.CCL的分类a、按覆铜板的机械刚性分为刚性覆铜板和扰性覆铜板;b、按覆铜板的绝缘材料、结构分为有机树脂类覆铜板、金属基覆铜板、陶瓷基覆铜板;c、按覆铜板的厚度分为厚板(板厚范围在0.8~3.2mm(含Cu))、薄板(板厚范围小于0.78mm(不含Cu));d、按覆铜板的增强材料划分为玻璃布基覆铜板、纸基覆铜板、复合基覆铜板(CME-1、CME-2)。
e、按照阻燃等级划分为阻燃板与非阻燃板。
f、按覆铜板的某些性能划分为高Tg板(Tg≥170℃)、高介电性能板、高CTI板(CTI≥600V)、环保型覆铜板(无卤、无锑)、紫外光遮蔽型覆铜板。
FR两个英文字母代表Flame Retardant,表示具有阻燃性。
FR-4的定义出自NEMA规范L11-1983,是指玻纤环氧树脂的烧样本,其尺寸为5″×0.5″厚度不限的无铜箔基板(光板)。
以特定本生灯在样本斜放45°的试烧下将其点燃,随即移开火源而让加有阻燃剂的板材自行熄灭,并以秒表记录离火后“延烧”的时间。
经过十次试烧后其总延烧的时间低于50sec称为V-0,低于250sec称为V-1,凡符合V-1的玻纤环氧树脂板材即称为FR-4。
铜箔:铜箔是生产CCL和PCB的不可缺少的原材料。
按照制法的不同,可分为压延铜箔和电解铜箔两种压制覆铜板一般使用电解铜箔第 1 页共14 页电解铜箔是通过专用电解机利用电解原理连续生产初产品(称为毛箔),再对毛箔进行耐热层钝化处理加工而成。
覆铜板工艺简介Prepreg主要的几种性质•树脂流量(Resin Flow)•胶化时间(Gel time)•树脂含量(Resin Content)•比例流量(Scaled flow)•树脂流量(Resin Flow)流量试验法Flow test-与经纬斜切截取4 inch见方的胶片四张精称后再按原经向对经向或纬对纬的上下迭在一起,在已预热到170°±2.8°之压床用200±25PSI去压10分钟,待其熔合及冷却后,在其中央部份冲出直径3.192 inch的圆片来,精称此圆片重量,然后计算胶流之百分流量为:原样重××100Flow=((原重-圆片重)×2)÷原样重式中分子相减之差即表示流出去的胶量,因原面积为16 inch 2,而压后所冲之圆片面积为(3.196÷22)2×3.14×2=16.045 inch 2, 故可以解释为压后圆片以外的东西是"流"出去的•胶化时间(Gel time)•胶片中的树脂为半硬化的B-Stage 材料,在受到高温后即会软化及流动,经过一段软化而流动的时间后,又逐渐吸收能量而发生聚合反应使得黏度增大再真正的硬化成为C-Stage 材料。
上述在压力下可以流动的时间,或称为可以做赶气及填隙之工作时间,称为胶化时间或可流胶时间。
当此时段太长时会造成板中应有的胶流出太多, 不但厚度变薄浪费成本而且造成铜箔直接压到玻纤布上使结构强度及抗化性不良;但此时间太短时则又无法在赶完板藏气之前因黏度太大无法流动而形成气泡(air bubble) 现象。
•树脂含量(Resin Content)定义:指胶片中除了玻璃布以外之胶所占之重量比可以用以下两种方法测量之烧完法(Burn Out) 处理重量法(Treated Weight) Prepreg 的两端30mm 以上,靠近中央的位置,取对玻纤方向成45度,大小100mm ×100mm 的试样,用冲模冲出试验片。