晶圆切割刀片技术资料
- 格式:pdf
- 大小:3.37 MB
- 文档页数:34

By Dianne Shi and Ilan Weisshas本文介绍,先进圭寸装(advaneed packaging的后端工艺(back-end)之一:xx 圆切片(wafer dicing)。
在过去三十年期间,切片(dieing)系统与刀片(blade)已经不断地改进以对付工艺的挑战和接纳不同类型基板的要求。
最新的、对生产率造成最大影响的设备进展包括:采用两个切割(two cuts)同时进行的、将超程(overtravel)减到最小的双轴(dual-spindle)切片系统,代表性的有日本东精精密的AD3000T和AD2000T;自动心轴扭力监测和自动冷却剂流量调节能力。
重大的切片刀片进步包括一些刀片,它们用于很窄条和/或较高芯片尺寸的晶圆、以铜金属化的晶圆、非常薄的晶圆、和在切片之后要求表面抛光的元件用的晶圆。
许多今天要求高的应用都要求设备能力和刀片特性两方面都最优化的工艺,以尽可能最低的成本提供尽可能高的效率。
最近,日本东精精密又向市场推出了非接触式的激光切割设备ML200和ML300 型切片机制(The Dicing Mechanism)硅晶圆切片工艺是在“后端”装配工艺中的第一步。
该工艺将晶圆分成单个的芯片,用于随后的芯片接合(die bon di ng)、弓I线接合(wire bonding)和测试工序。
一个转动的研磨盘(刀片)完成切片(dicing)。
一根心轴以高速,30,000~60,000rpm (83~175m/sec的线性速度)转动刀片。
该刀片由嵌入电镀镍矩阵黏合剂中的研磨金刚石制成。
在芯片的分割期间,刀片碾碎基础材料(晶圆),同时去掉所产生的碎片。
材料的去掉沿着晶方(dice)的有源区域之间的专用切割线(迹道)发生的。
冷却剂(通常是去离子水)指到切割缝内,改善切割品质,和通过帮助去掉碎片而延长刀片寿命。
每条迹道(street)的宽度(切口)与刀片的厚度成比例。
关键工艺参数硅圆片切割应用的目的是将产量和合格率最大,同时资产拥有的成本最小。

本文介绍,先进封装(advanced packaging)的后端工艺(back-end)之一:晶圆切片(wafer dicing)。
在过去三十年期间,切片(dicing)系统与刀片(blade)已经不断地改进以对付工艺的挑战和接纳不同类型基板的要求。
最新的、对生产率造成最大影响的设备进展包括:采用两个切割(two cuts)同时进行的、将超程(overtravel)减到最小的双轴(dual-spindle)切片系统,代表性的有日本东精精密的AD3000T和AD2000T;自动心轴扭力监测和自动冷却剂流量调节能力。
重大的切片刀片进步包括一些刀片,它们用于很窄条和/或较高芯片尺寸的晶圆、以铜金属化的晶圆、非常薄的晶圆、和在切片之后要求表面抛光的元件用的晶圆。
许多今天要求高的应用都要求设备能力和刀片特性两方面都最优化的工艺,以尽可能最低的成本提供尽可能高的效率。
最近,日本东精精密又向市场推出了非接触式的激光切割设备ML200和ML300型切片机制(The Dicing Mechanism)硅晶圆切片工艺是在“后端”装配工艺中的第一步。
该工艺将晶圆分成单个的芯片,用于随后的芯片接合(die bonding)、引线接合(wire bonding)和测试工序。
一个转动的研磨盘(刀片)完成切片(dicing)。
一根心轴以高速,30,000~60,000rpm(83~175m/sec的线性速度)转动刀片。
该刀片由嵌入电镀镍矩阵黏合剂中的研磨金刚石制成。
在芯片的分割期间,刀片碾碎基础材料(晶圆),同时去掉所产生的碎片。
材料的去掉沿着晶方(dice)的有源区域之间的专用切割线(迹道)发生的。
冷却剂(通常是去离子水)指到切割缝内,改善切割品质,和通过帮助去掉碎片而延长刀片寿命。
每条迹道(street)的宽度(切口)与刀片的厚度成比例。
关键工艺参数硅圆片切割应用的目的是将产量和合格率最大,同时资产拥有的成本最小。
可是,挑战是增加的产量经常减少合格率,反之亦然。


晶圆激光切割工艺技术晶圆激光切割工艺技术是一种将激光技术应用于半导体制造过程中的一种切割方法。
它通过利用激光的热效应,将激光束聚焦到晶圆材料上,从而可以实现高精度、高效率的切割。
在晶圆激光切割工艺技术中,首先需要选择合适的激光源。
常见的激光源有固体激光器、气体激光器和半导体激光器等。
不同的激光源具有不同的特点和适用范围,需要根据实际需求进行选择。
在切割过程中,激光束可以通过透镜等光学元件进行聚焦,从而可以实现高能量密度的激光束。
晶圆材料会在激光束的照射下被加热,其温度逐渐升高。
当温度达到晶圆材料的熔点时,材料开始熔化,并随着激光束的扫描,不断形成切割孔洞。
晶圆激光切割工艺技术具有以下几个优点。
首先,由于激光束是非接触式的切割方法,因此可以避免因切割过程中与晶圆材料接触而引起的污染和损伤。
同时,激光束的直径非常小,可以实现非常细小的切割孔洞,从而可以实现高分辨率和高精度的切割。
此外,晶圆激光切割工艺技术还具有切割速度快、切割质量高和可靠性强的特点。
由于激光切割是通过热效应实现的,因此可以实现非常高效率的切割。
同时,由于激光束的能量集中在非常小的空间范围内,可以实现非常小的切割孔洞,从而得到更高的切割质量。
此外,激光切割具有高可靠性,可以适应各种复杂形状和材料的切割需求。
然而,晶圆激光切割工艺技术也存在一些挑战和难点。
首先,由于激光切割需要对晶圆材料进行加热,因此可能会引起晶圆材料的热应力,从而影响材料的性能和可靠性。
此外,激光切割过程中会产生大量的热量和烟尘,需要进行有效的散热和烟尘处理。
同时,晶圆激光切割工艺技术的设备和操作都需要非常高的技术要求,对操作人员的技术水平和经验要求非常高。
总的来说,晶圆激光切割工艺技术是一种高效、高精度的切割方法,广泛应用于半导体制造领域。
随着激光技术的不断发展和创新,相信晶圆激光切割工艺技术将会越来越成熟和完善,为半导体制造业的发展提供强有力的支持。

晶圆激光切割与刀片切割工艺介绍
1.晶圆激光切割工艺
(1)调节激光器参数,包括激光功率、脉冲宽度和重复频率等。
(2)将激光束通过透镜聚焦到晶圆表面上,形成高能量密度的小区域。
(3)控制激光束在晶圆上移动,沿着待切割的线路进行切割。
(4)激光照射到晶圆上,局部区域熔化或气化,形成切割线。
(5)通过剥离或折断等方式将晶圆切割成小尺寸的芯片或器件。
2.刀片切割工艺
刀片切割是利用金刚石刀片或金属刀片沿切割线切割晶圆。
其主要原理是通过刀片与晶圆的接触,施加切割力以分割晶圆。
刀片切割的工艺流程如下:
(1)选择合适的刀片材料和形状,并通过润滑液使其表面光滑,以减少切割阻力。
(2)安装刀片至切割机中,对刀片进行调整和校对。
(3)将晶圆放置在切割机工作台上,并固定好。
(4)启动切割机,使刀片与晶圆接触并施加切割力。
(5)刀片沿待切割的线路切割晶圆,直至完全分割。
刀片切割的优点是设备成本相对较低、切割效果稳定,且切割线宽度可控。
然而,刀片切割的切割速度较慢,且对刀片磨损较大,需要经常更换。
综上所述,晶圆激光切割与刀片切割是常见的硅晶圆切割工艺。
晶圆激光切割适用于要求高精度和高速切割的应用,而刀片切割适用于设备成本较低以及切割线宽度要求可控的应用。
在具体应用中,需要根据切割要求、设备条件和经济成本等因素选择合适的切割工艺。

芯圆切割(Wafer Dicing)6 WX7^$R3^7\)T$K本文介绍,IC封装(packaging)的后端工艺(back-end)之一:xx圆切片(wafer dicing)。
* t#n"r)T2o3e2o在过去三十年期间,切片(dicing)系统与刀片(blade)已经不断地改进以对付工艺的挑战和接纳不同类型基板的要求。
最新的、对生产率造成最大影响的设备进展包括:使两个切割(twocuts)同时进行的、将超程(overtravel)减到最小的双轴(dual-spindle)切片系统;自动心轴扭力监测和自动冷却剂流量调节能力。
重大的切片刀片进步包括一些刀片,它们用于很窄条和/或较高芯片尺寸的晶圆、以铜金属化的晶圆、非常薄的晶圆、和在切片之后要求表面抛光的元件用的晶圆。
许多今天要求高的应用都要求设备能力和刀片特性两方面都最优化的工艺,以尽可能最低的成本提供尽可能高的效率。
切片机制(The Dicing Mechanism)硅晶圆切片工艺是在“后端”装配工艺中的第一步。
该工艺将晶圆分成单个的芯片,用于随后的芯片接合(diebonding)、引线接合(wire bonding)和测试工序。
一个转动的研磨盘(刀片)完成切片(dicing)。
一根心轴以高速,30,000~60,000rpm (83~175m/sec的线性速度)转动刀片。
该刀片由嵌入电镀镍矩阵黏合剂中的研磨金刚石制成。
在芯片的分割期间,刀片碾碎基础材料(晶圆),同时去掉所产生的碎片。
材料的去掉沿着晶方(dice)的有源区域之间的专用切割线(迹道)发生的。
冷却剂(通常是去离子水)指到切割缝内,改善切割品质,和通过帮助去掉碎片而延长刀片寿命。
每条迹道(street)的宽度(切口)与刀片的厚度成比例。
关键工艺参数# [# }9F/?*g* X( r5r8N#~:w1e3^.k2};s(x硅圆片切割应用的目的是将产量和合格率最大,同时资产拥有的成本最小。


By Dianne Shi and Ilan Weisshas本文介绍,先进封装(advanced packaging)的后端工艺(back-end)之一:xx圆切片(wafer dicing)。
在过去三十年期间,切片(dicing)系统与刀片(blade)已经不断地改进以对付工艺的挑战和接纳不同类型基板的要求。
最新的、对生产率造成最大影响的设备进展包括:采用两个切割(two cuts)同时进行的、将超程(overtravel)减到最小的双轴(dual-spindle)切片系统,代表性的有日本东精精密的AD3000T和AD2000T;自动心轴扭力监测和自动冷却剂流量调节能力。
重大的切片刀片进步包括一些刀片,它们用于很窄条和/或较高芯片尺寸的晶圆、以铜金属化的晶圆、非常薄的晶圆、和在切片之后要求表面抛光的元件用的晶圆。
许多今天要求高的应用都要求设备能力和刀片特性两方面都最优化的工艺,以尽可能最低的成本提供尽可能高的效率。
最近,日本东精精密又向市场推出了非接触式的激光切割设备ML200和ML300型切片机制(The Dicing Mechanism)硅晶圆切片工艺是在“后端”装配工艺中的第一步。
该工艺将晶圆分成单个的芯片,用于随后的芯片接合(die bonding)、引线接合(wire bonding)和测试工序。
一个转动的研磨盘(刀片)完成切片(dicing)。
一根心轴以高速,30,000~60,000rpm (83~175m/sec的线性速度)转动刀片。
该刀片由嵌入电镀镍矩阵黏合剂中的研磨金刚石制成。
在芯片的分割期间,刀片碾碎基础材料(晶圆),同时去掉所产生的碎片。
材料的去掉沿着晶方(dice)的有源区域之间的专用切割线(迹道)发生的。
冷却剂(通常是去离子水)指到切割缝内,改善切割品质,和通过帮助去掉碎片而延长刀片寿命。
每条迹道(street)的宽度(切口)与刀片的厚度成比例。
关键工艺参数硅圆片切割应用的目的是将产量和合格率最大,同时资产拥有的成本最小。

晶圆划片工艺简介划片工艺流程晶圆经过前道工序后芯片制备完成,还需要经过切割使晶圆上的芯片分离下来,最后进行封装。
不同厚度晶圆选择的晶圆切割工艺也不同:厚度100um以上的晶圆一般使用刀片切割;厚度不到100um的晶圆一般使用激光切割,激光切割可以减少剥落和裂纹的问题,但是在100um以上时,生产效率将大大降低;厚度不到30um的晶圆则使用等离子切割,等离子切割速度快,不会对晶圆表面造成损伤,从而提高良率,但是其工艺过程更为复杂;刀片切割(Blade dicing or blade sawing)刀片切割(锯切)过程中,保护膜的附着与摘除(图片来自网络)为了保护晶圆在切割过程中免受外部损伤,事先会在晶圆上贴敷胶膜,以便保证更安全的“切单”。
“背面减薄(Back Grinding)”过程中,胶膜会贴在晶圆的正面。
但与此相反,在“刀片”切割中,胶膜要贴在晶圆的背面。
而在共晶贴片(Die Bonding,把分离的芯片固定在PCB或定架上)过程中,贴会背面的这一胶膜会自动脱落。
切割时由于摩擦很大,所以要从各个方向连续喷洒DI水(去离子水)。
而且,叶轮要附有金刚石颗粒,这样才可以更好地切片。
此时,切口(刀片厚度:凹槽的宽度)必须均匀,不得超过划片槽的宽度。
很长一段时间,锯切一直是被最广泛使用的传统的切割方法,其最大的优点就是可以在短时间内切割大量的晶圆。
然而,如果切片的进给速度(Feeding Speed)大幅提高,小芯片边缘剥落的可能性就会变大。
因此,应将叶轮的旋转次数控制在每分钟30000次左右。
晶圆划片机晶圆切割时,经常遇到较窄迹道(street)宽度,要求将每一次切割放在迹道中心几微米范围内的能力。
这就要求使用具有高分度轴精度、高光学放大和先进对准运算的设备。
当用窄迹道切割晶圆时,应选择尽可能最薄的刀片。
可是,很薄的刀片(20µm)是非常脆弱的,更容易过早破裂和磨损。
结果,其寿命期望和工艺稳定性都比较厚的刀片差。
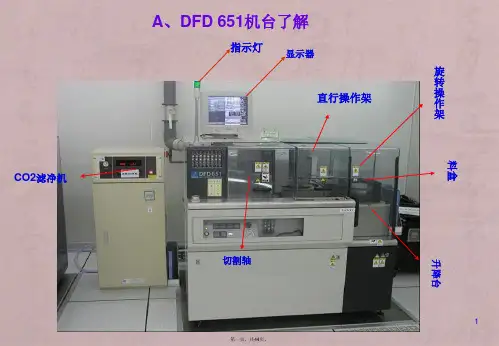

晶圆切割刀参数
晶圆切割刀是一种用于将晶圆切割成单个芯片的工具,其参数可能因不同的制造商和用途而有所差异。
以下是一些常见的晶圆切割刀参数:
1. 刀片材质:晶圆切割刀的刀片通常由硬质合金、钻石或其他耐磨材料制成,以确保其具有足够的硬度和耐磨性。
2. 刀刃形状:刀刃的形状可以是平直的、弯曲的或锯齿状的,具体取决于所需的切割效果和晶圆的材料。
3. 切割速度:切割速度是指刀片在切割晶圆时的移动速度,通常以每分钟多少毫米(mm/min)来表示。
4. 切割深度:切割深度是指刀片切入晶圆的深度,它影响到切割的质量和效率。
5. 刀片尺寸:刀片的尺寸包括长度、宽度和厚度,这些参数需要与晶圆的尺寸和切割要求相匹配。
6. 刀柄类型:刀柄用于固定刀片,常见的刀柄类型包括手动刀柄、自动刀柄和真空刀柄等。
7. 压力控制:一些晶圆切割刀具有压力控制功能,可以调整切割时施加在刀片上的压力,以实现更好的切割效果。
这些参数只是一些常见的示例,实际的晶圆切割刀参数可能因具体的应用和制造商而有所不同。
在选择和使用晶圆切割刀时,建议参考相关的产品规格和使用说明,以确保其满足你的需求。