晶圆切割挑晶过程流程图
- 格式:xlsx
- 大小:18.07 KB
- 文档页数:3
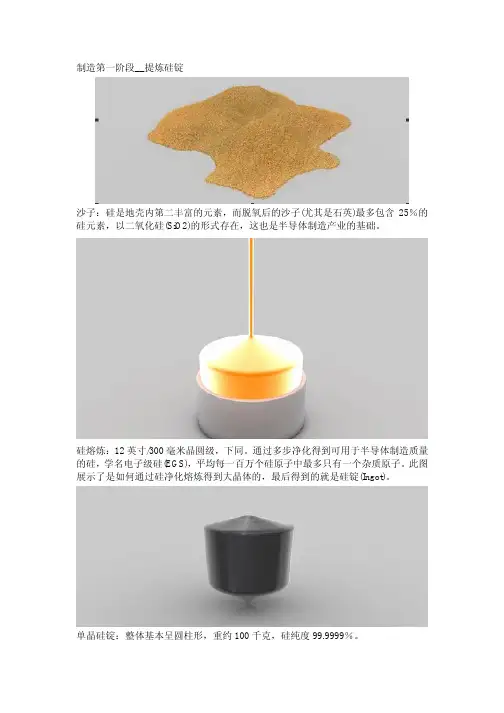
制造第一阶段__提炼硅锭沙子:硅是地壳内第二丰富的元素,而脱氧后的沙子(尤其是石英)最多包含25%的硅元素,以二氧化硅(SiO2)的形式存在,这也是半导体制造产业的基础。
硅熔炼:12英寸/300毫米晶圆级,下同。
通过多步净化得到可用于半导体制造质量的硅,学名电子级硅(EGS),平均每一百万个硅原子中最多只有一个杂质原子。
此图展示了是如何通过硅净化熔炼得到大晶体的,最后得到的就是硅锭(Ingot)。
单晶硅锭:整体基本呈圆柱形,重约100千克,硅纯度99.9999%。
硅锭切割:横向切割成圆形的单个硅片,也就是我们常说的晶圆(Wafer)。
晶圆:切割出的晶圆经过抛光后变得几乎完美无瑕,表面甚至可以当镜子。
事实上,所有的芯片公司自己并不生产这种晶圆,而是从第三方半导体企业那里直接购买成品,然后利用自己的生产线进一步加工,比如现在主流的45nm HKMG(高K金属栅极)。
光刻胶(Photo Resist):图中蓝色部分就是在晶圆旋转过程中浇上去的光刻胶液体,类似制作传统胶片的那种。
晶圆旋转可以让光刻胶铺的非常薄、非常平。
光刻:光刻胶层随后透过掩模(Mask)被曝光在紫外线(UV)之下,变得可溶,期间发生的化学反应类似按下机械相机快门那一刻胶片的变化。
掩模上印着预先设计好的电路图案,紫外线透过它照在光刻胶层上,就会形成微处理器的每一层电路图案。
一般来说,在晶圆上得到的电路图案是掩模上图案的四分之一。
光刻:由此进入50-200纳米尺寸的晶体管级别。
一块晶圆上可以切割出数百个处理器,不过从这里开始把视野缩小到其中一个上,展示如何制作晶体管等部件。
晶体管相当于开关,控制着电流的方向。
现在的晶体管已经如此之小,一个针头上就能放下大约3000万个。
制造第四阶段_光刻胶的使命溶解光刻胶:光刻过程中曝光在紫外线下的光刻胶被溶解掉,清除后留下的图案和掩模上的一致。
蚀刻:使用化学物质溶解掉暴露出来的晶圆部分,而剩下的光刻胶保护着不应该蚀刻的部分。

切单(Singulation),一个晶圆被分割成多个半导体芯片的工艺SKhynixNewsroom一个晶圆要经历三次的变化过程,才能成为一个真正的半导体芯片:首先,是将块儿状的铸锭切成晶圆;在第二道工序中,通过前道工序要在晶圆的正面雕刻晶体管;最后,再进行封装,即通过切割过程,使晶圆成为一个完整的半导体芯片。
可见,封装工序属于后道工序,在这道工序中,会把晶圆切割成若干六面体形状的单个芯片,这种得到独立芯片的过程被称作做“切单(Singulaton)”,而把晶圆板锯切成独立长方体的过程则叫做“晶片切割(Die Sawing)”。
近来,随着半导体集成度的提高,晶圆厚度变得越来越薄,这当然给“切单”工艺也带来了不少难度。
一、晶圆切割(Wafer Dicing)的发展历程图1. 晶圆切割方法的发展历程(切单)下载图片前道和后道工序通过各种不同方式的互动而进一步发展:后道工序的进化可以决定晶圆上die单独分离出的六面体小芯片)的结构和位置,以及晶片上焊盘(电连接路径)的结构和位置;与之相反,前端工艺的进化则改变了后端工艺中的晶圆背面减薄和“晶片切割(Die Sawing)”晶圆的流程和方法。
因此,封装的外观日益变得精巧,会对后端工艺带来很大的影响。
而且,根据包装外观的变化,切割次数、程序和类型也会发生相应的变化。
▶请参见“轻、薄、短、小”,半导体封装的演变(“Light, Thin, Short and Small”, The Development of Semiconductor Packages)。
那么,现在就让我们一起通过芯片“切单”的演化过程,来看看五种切割方法吧。
二、划片切割(Scribe Dicing)图2. 早期的划片切割法:划片后进行物理上的分割(Breaking)@直径为6英寸以下的的晶圆下载图片早期,通过施加外力切割的“掰开(Breaking)”是唯一可以把晶圆分割成六面形的Die的切割法。



晶圆切割制程晶圆切割制程:绷⽚→切割→ UV照射晶圆切割(Dicing),也叫划⽚(Die Sawing),是将⼀个晶圆上单独的die通过⾼速旋转的⾦刚⽯⼑⽚(也有激光切割技术)切割开来,形成独⽴的单颗的晶⽚,为后续⼯序做准备。
绷⽚(Wafer Mounter),是⼀个切割前的晶圆固定⼯序,在晶圆的背⾯贴上⼀层蓝膜,并固定在⼀个⾦属框架(Frame)上,以利于后⾯切割。
在贴膜的过程中要加60℃~80℃温度,使蓝膜能牢固粘贴在晶圆上(⼀般实际加⼯过程时贴膜后放⼊烘烤箱烘烤),防⽌切割过程由于粘贴不牢造成die飞出。
切割过程中需要⽤DI离⼦⽔冲去切割产⽣的硅渣和释放静电,DI离⼦⽔由CO2纯⽔机制备。
将⼆氧化碳⽓体溶于离⼦⽔中,降低⽔的阻抗,从⽽利于释放静电。
UV照射是⽤紫外线照射切割完的蓝膜,降低蓝膜的粘性,⽅便后续挑粒。
切割分为半切和全切两种。
半切是切割4/5晶圆厚度,不会切透晶圆,然后⽤机械⽅式(铜棒滚过)使其⾃动裂⼝形成独⽴die。
这种⽅式费⽤低,⼀般⽤于挑粒装盒的⽅式中,可以不⽤贴蓝膜,但容易发⽣背崩。
全切即将晶圆切透,切割前要贴膜,会切割到蓝膜。
这种⽅式⼀般⽤在选择晶⽚留蓝膜上出货的客户。
每个die之间会留有间隙,成为切割道(saw street),⼑⽚沿着切割道切割。
晶圆划⽚⼯艺的重要质量缺陷因为硅材料的脆性,机械切割⽅式会对晶圆的正⾯和背⾯产⽣机械应⼒,结果在芯⽚的边缘产⽣正⾯崩⾓(FSC—Front Side Chipping)及背⾯崩⾓(BSC—Back Side Chipping)。
正⾯崩⾓和背⾯崩⾓会降低芯⽚的机械强度,初始的芯⽚边缘裂隙在后续的封装⼯艺中或在产品的使⽤中会进⼀步扩散,从⽽可能引起芯⽚断裂。
另外,如果崩⾓进⼊了⽤于保护芯⽚内部电路、防⽌划⽚损伤的密封环(Seal Ring)内部时,芯⽚的电⽓性能和可靠性都会受到影响。
封装⼯艺设计规则限定崩⾓不能进⼊芯⽚边缘的密封圈。

晶圆激光切割工艺嘿,朋友们!今天咱来唠唠晶圆激光切割工艺这档子事儿。
你说这晶圆啊,就像是一块超级大的集成电路宝藏,里面藏着无数的小秘密和小惊喜。
而激光切割呢,就好比是一把神奇的小剪刀,专门来对付这块大宝藏。
想象一下,那细细的激光束,就像一个超级厉害的小战士,精准地冲向晶圆,要把它切割成我们想要的形状和大小。
这可不容易啊!要是稍有偏差,那可就全完蛋啦。
在进行晶圆激光切割的时候,那可真是要打起十二分的精神。
就好像我们走路一样,得一步一步稳稳当当的。
首先呢,得选好合适的激光参数,这就像是给小战士配上最称手的武器。
激光的波长啦、功率啦、聚焦啦,这些都得好好琢磨琢磨。
要是参数没调好,那不就跟拿着把钝刀去砍柴一样,费劲得很呐!然后呢,还得注意晶圆的固定。
你想啊,如果晶圆在那晃来晃去的,激光还怎么能切得准呢?这就好比是你在写字的时候,纸要是乱动,那字能写好吗?所以啊,一定要把晶圆固定得稳稳的,让它乖乖地待在那,等着激光来给它“动手术”。
还有哦,环境也很重要呢!不能有太多的灰尘啊、杂质啊什么的。
这就好像我们做饭,要是厨房里脏兮兮的,做出来的饭能好吃吗?所以要保持一个干净整洁的环境,让激光切割能够顺利进行。
在这个过程中,每一个环节都不能马虎。
就跟盖房子一样,一块砖一块砖都得砌好,不然房子可就要倒啦!咱可不能让好不容易加工的晶圆毁在最后一步呀。
说真的,晶圆激光切割工艺真的是一项超级神奇又超级重要的技术。
它让那些小小的电子元件能够乖乖地排列在晶圆上,为我们的生活带来各种便利。
从手机到电脑,从电视到汽车,哪里都有它的身影。
咱再想想,如果没有这么厉害的技术,那我们的生活得变成啥样啊?手机可能会变得超级大,电脑可能会慢得像蜗牛,汽车可能都开不起来啦!所以啊,可别小看了这小小的激光切割工艺,它可有着大本事呢!总之呢,晶圆激光切割工艺就像是一个隐藏在科技世界里的小魔法师,默默地为我们创造着奇迹。
我们得好好研究它、掌握它,让它为我们的生活变得更加美好!怎么样,朋友们,是不是觉得很有意思呀?。



IC产业可分为设备业、设计业、加工业和支撑业(包括硅晶圆、各种化学试剂、气体、引线框架等)。
IC加工业本身按其顺序可分为光掩膜业、制造业(包括IDM#模式和Foundry##模式)、封装业和测试业。
IC制造流程见图一。
LED晶片生產流程圖:晶圆的生产工艺流程:从大的方面来讲,晶圆生产包括晶棒制造和晶片制造两大步骤,它又可细分为以下几道主要工序(其中晶棒制造只包括下面的第一道工序,其余的全部属晶片制造,所以有时又统称它们为晶柱切片后处理工序):晶棒成长 -- 晶棒裁切与检测 -- 外径研磨 -- 切片 -- 圆边 -- 表层研磨 -- 蚀刻 -- 去疵 -- 抛光 -- 清洗 -- 检验 -- 包装1、晶棒成长工序:它又可细分为:1)、融化(Melt Down):将块状的高纯度复晶硅置于石英坩锅内,加热到其熔点1420°C以上,使其完全融化。
2)、颈部成长(Neck Growth):待硅融浆的温度稳定之后,将〈1.0.0〉方向的晶种慢慢插入其中,接着将晶种慢慢往上提升,使其直径缩小到一定尺寸(一般约6mm左右),维持此直径并拉长100-200mm,以消除晶种内的晶粒排列取向差异。
3)、晶冠成长(Crown Growth):颈部成长完成后,慢慢降低提升速度和温度,使颈部直径逐渐加大到所需尺寸(如5、6、8、12吋等)。
4)、晶体成长(Body Growth):不断调整提升速度和融炼温度,维持固定的晶棒直径,只到晶棒长度达到预定值。
5)、尾部成长(Tail Growth):当晶棒长度达到预定值后再逐渐加快提升速度并提高融炼温度,使晶棒直径逐渐变小,以避免因热应力造成排差和滑移等现象产生,最终使晶棒与液面完全分离。
到此即得到一根完整的晶棒。
2、晶棒裁切与检测(Cutting & Inspection):将长成的晶棒去掉直径偏小的头、尾部分,并对尺寸进行检测,以决定下步加工的工艺参数。
3、外径研磨(Surface Grinding & Shaping):由于在晶棒成长过程中,其外径尺寸和圆度均有一定偏差,其外园柱面也凹凸不平,所以必须对外径进行修整、研磨,使其尺寸、形状误差均小于允许偏差。