半导体光刻工艺介绍
- 格式:ppt
- 大小:1.78 MB
- 文档页数:55

半导体光刻工艺介绍
半导体光刻工艺是半导体制造中最为重要的工序之一。
主要作用是将图形信息从掩模版(也称掩膜版)上保真传输、转印到半导体材料衬底上。
以下是光刻工艺的主要步骤:
硅片清洗烘干:湿法清洗+去离子水冲洗+脱水烘焙(热板150~250℃,1~2分钟,氮气保护)。
涂底:气相成底膜的热板涂底。
旋转涂胶:静态涂胶(Static)。
软烘:真空热板,85~120℃,30~60秒。
对准并曝光:光刻机通常采用步进式 (Stepper)或扫描式 (Scanner)等,通过近紫外光 (Near Ultra-Violet,NUV)、中紫外光 (Mid UV,MUV)、深紫外光(Deep UV,DUV)、真空紫外光 (Vacuum UV,VUV)、极短紫外光 (Extreme UV,EUV)、X-光 (X-Ray)等光源对光刻胶进行曝光,使得晶圆内产生电路图案。
后烘:PEB,Post Exposure Baking。
显影:Development。
硬烘:Hard Baking。
光刻工艺的基本原理是利用涂敷在衬底表面的光刻胶的光化学反应作用,记录掩模版上的器件图形,从而实现将集成器件图形从设计转印到衬底的目的。


光刻工艺知识点总结光刻工艺是半导体制造工艺中的重要环节,通过光刻技术可以实现微米级甚至纳米级的精密图案转移至半导体芯片上,是芯片制造中最关键的工艺之一。
光刻工艺的基本原理是利用光学原理将图案投射到光刻胶上,然后通过化学蚀刻将图案转移到芯片表面。
下面将对光刻工艺的知识点进行详细总结。
一、光刻工艺的基本原理1. 光刻胶光刻胶是光刻工艺的核心材料,主要由树脂和溶剂组成。
树脂的种类和分子结构直接影响着光刻胶的分辨率和对光的敏感度,而溶剂的选择和比例则会影响着光刻胶的黏度、流动性和干燥速度。
光刻胶的选择要根据不同的工艺要求,如分辨率、坚固度、湿膜厚度等。
2. 掩模掩模是用来投射光刻图案的模板,通常是通过电子束刻蚀或光刻工艺制备的。
掩模上有所需的图形样式,光在通过掩模时会形成所需的图案。
3. 曝光曝光是将掩模上的图案投射到光刻胶表面的过程。
曝光机通过紫外线光源产生紫外线,通过透镜将掩模上的图案投射到光刻胶表面,形成图案的暗部和亮部。
4. 显影显影是通过化学溶液将光刻胶上的图案显现出来的过程。
曝光后,光刻胶在图案暗部和亮部会有不同的化学反应,显影溶液可以去除未暴露的光刻胶,留下所需的图案。
5. 蚀刻蚀刻是将图案转移到硅片上的过程,通过化学腐蚀的方式去除光刻胶未遮盖的部分,使得图案转移到硅片表面。
二、光刻工艺中的关键技术1. 分辨率分辨率是指光刻工艺能够实现的最小图案尺寸,通常用实际图案中两个相邻细线或空隙的宽度之和来表示。
分辨率受到光刻机、光刻胶和曝光技术等多个因素的影响,是衡量光刻工艺性能的重要指标。
2. 等效焦距等效焦距是光刻机的重要参数,指的是曝光光学系统的有效焦距,影响光刻图案在光刻胶表面的清晰度和分辨率。
3. 曝光剂量曝光剂量是指单位面积上接收的光能量,通常用mJ/cm^2或μC/cm^2来表示。
曝光剂量的选择对分辨率和光刻胶的副反应有重要影响。
4. 曝光对位精度曝光对位精度是指光刻胶上已存在的图案和新的曝光对位的精度,是保证多层曝光图案对位一致的重要因素。


半导体光刻工艺流程
半导体光刻是制造半导体元件的关键步骤之一,其工艺流程大致包括:
1. 硅片准备:将硅片清洗干净并进行表面平整化处理。
2. 底片涂覆:将涂覆剂涂覆在硅片上,使其形成一层平整的覆盖层。
3. 硬化:将底片经过紫外光或热处理硬化,使其形成固定的图案形状。
4. 掩膜对准:将掩膜对准底片,以保证图案的精度和准确性。
5. 曝光:将底片暴露在紫外光下,使得未被硬化的部分被光化学反应所影响,形成表面的图案。
6. 显影:将底片进行显影处理,将未受光化学反应影响的部分去除,形成所需的图案形状。
7. 洗涤:将底片进行洗涤处理,将化学物质清洗干净,以保证元件的纯度和质量。
8. 检验与测试:对半导体元件进行检验测试,以保证其符合设计和性能要求。
整个工艺流程需要精密的仪器设备和复杂的程序控制,以确保半导体元件的高质量制造。

详解半导体的光刻工艺全过程光刻工艺过程一般的光刻工艺要经历硅片表面清洗烘干、涂底、旋涂光刻胶、软烘、对准曝光、后烘、显影、硬烘、刻蚀、检测等工序。
1、硅片清洗烘干(Cleaning and Pre-Baking)方法:湿法清洗+去离子水冲洗+脱水烘焙(热板150~2500C,1~2分钟,氮气保护)目的:a、除去表面的污染物(颗粒、有机物、工艺残余、可动离子);b、除去水蒸气,是基底表面由亲水性变为憎水性,增强表面的黏附性(对光刻胶或者是HMDS-〉六甲基二硅胺烷)。
2、涂底(Priming)方法:a、气相成底膜的热板涂底。
HMDS蒸气淀积,200~2500C,30秒钟;优点:涂底均匀、避免颗粒污染;b、旋转涂底。
缺点:颗粒污染、涂底不均匀、HMDS用量大。
目的:使表面具有疏水性,增强基底表面与光刻胶的黏附性。
3、旋转涂胶(Spin-on PR Coating)方法:a、静态涂胶(Static)。
硅片静止时,滴胶、加速旋转、甩胶、挥发溶剂(原光刻胶的溶剂约占65~85%,旋涂后约占10~20%);b、动态(Dynamic)。
低速旋转(500rpm_rotation per minute)、滴胶、加速旋转(3000rpm)、甩胶、挥发溶剂。
决定光刻胶涂胶厚度的关键参数:光刻胶的黏度(Viscosity),黏度越低,光刻胶的厚度越薄;旋转速度,速度越快,厚度越薄;影响光刻胶厚度均运性的参数:旋转加速度,加速越快越均匀;与旋转加速的时间点有关。
一般旋涂光刻胶的厚度与曝光的光源波长有关(因为不同级别的曝光波长对应不同的光刻胶种类和分辨率):I-line最厚,约0.7~3μm;KrF的厚度约0.4~0.9μm;ArF的厚度约0.2~0.5μm。
4、软烘(Soft Baking)方法:真空热板,85~120℃,30~60秒;目的:除去溶剂(4~7%);增强黏附性;释放光刻胶膜内的应力;防止光刻胶玷污设备;边缘光刻胶的去除(EBR,Edge Bead Removal)。

半导体制造工艺第章光刻光刻是半导体制造工艺中的一个重要步骤。
在半导体芯片制造的过程中,需要将芯片图形化,将设计图案复制到硅片的表面上。
这个步骤就需要光刻技术。
光刻的定义和原理光刻是利用光学系统在硅片表面上生成不同图案的一项技术。
简单来说,就是将持有芯片光掩模的基片放在硅片表面上,并利用紫外线等光源使光掩模的芯片图形投影到硅片表面上,从而完成芯片的形状和结构。
光刻机的主要部分是光源、光学系统,以及涂层沉积和烘烤系统。
硅片表面被涂上光刻胶,并使用紫外线等光源使光刻胶暴露在某些角度上,使辐射透过掩模辐射到涂在硅片表面上的光刻胶。
被照射的部分得到曝光后,经过一定的处理,剩下的部分形成所需的芯片结构。
光刻胶会在这个过程中起到纹路转移的作用,是传统光防蚀工艺及化学机械平整(CMP)处理工艺的重要保护层。
光刻机的类型目前光刻机主要分为:接触式光刻机(Contact)、非接触式光刻机(Non-contact)以及半接触光刻机(Semi-contact)。
根据不同的光掩模和涂层材料,选择不同类型的光刻机可以实现不同的功能需求。
•接触式光刻机接触式光刻机是光刻机的最早类型,利用距离近到可以接触到硅片表面的光掩模,将所需芯片结构投影到硅片表面。
这种方式比较慢,且容易产生挂膜现象,造成芯片质量下降。
但是设计和制造成本相对较低,因此在一些低端应用场景中还在使用。
•非接触式光刻机非接触式光刻机则是直接将掩模和硅片分开一定的距离,利用掩模上的光结构将所需图案投影到硅片表面。
这种光刻机的缺点就是昂贵和对粘附的材料要求更高。
因此,非接触式光刻机主要应用于高端芯片制造行业。
•半接触光刻机半接触光刻机则是将掩模和硅片之间留出一定的距离,既能够保证光防蚀层的不变性,又能够在一些场景下提升芯片制造的速度。
光刻胶的选择与性能光刻胶的选择与性能直接关系到芯片的最终质量。
不同的光刻胶材料对于不同的工艺流程具有不同的优势和劣势。
•碳链长度不同的光刻胶中含有的碳链长度不同,碳链长度决定了光刻胶对于制造工艺中反后效应的抑制效果。

半导体光刻技术原理
半导体光刻技术是一种制造集成电路(IC)的关键工艺,其原理
可以概括为以下几个步骤:
1. 光刻胶涂覆:首先,在半导体晶片表面涂覆一层光刻胶,光
刻胶是一种感光聚合物材料。
这一步的目的是将光刻胶涂覆在晶片上,形成一个平整的薄膜。
2. 接触或光刻机对齐:将掩膜(即芯片的图案)和晶片通过接
触方式或光刻机对齐,确保图案准确地投射到光刻胶层上。
3. 曝光:通过强光源,将光刻胶层中未被掩模遮挡的部分进行
曝光,使其变化。
在半导体中,光刻胶中有两种常见的类型:正型光
刻胶和负型光刻胶。
正型光刻胶在曝光后变得难以溶解,而负型光刻
胶在曝光后变得容易溶解。
4. 显影:将已曝光的光刻胶表面进行显影处理。
对正型光刻胶
来说,通过显影剂将未曝光区域的光刻胶去除,暴露出底部的晶片表面。
对负型光刻胶来说,未曝光的区域的光刻胶被保留下来。
5. 刻蚀或镀膜:通过化学刻蚀或物理镀膜等方式,将暴露的晶
片表面进行加工,例如在半导体中形成导线或沟槽等细微结构。
这一
步骤通常需要使用一系列化学和物理过程。
通过上述步骤的重复,可以逐步在晶片上形成多层结构,最终制
造出具有丰富功能的集成电路芯片。
这样的芯片可以完成各种计算和
存储任务,成为现代电子设备的核心。


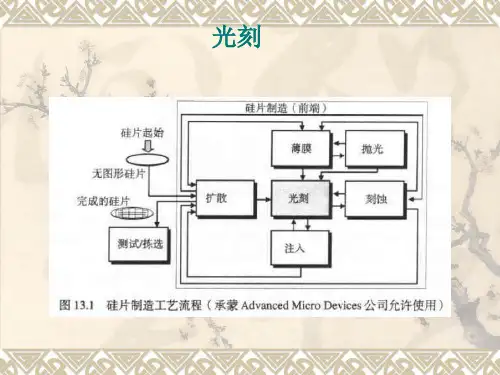
光刻工艺流程光刻工艺是半导体制造中至关重要的一步,它通过光刻胶和光刻机将芯片上的图形转移到硅片上。
光刻工艺的精准度和稳定性直接影响着芯片的质量和性能。
下面将介绍光刻工艺的主要流程和关键步骤。
1. 掩膜制备。
在光刻工艺中,首先需要准备好掩膜。
掩膜是一种透明的基板,上面覆盖着光刻胶,并且有芯片图形的透明部分。
掩膜的制备需要经过光刻胶的旋涂、烘烤和曝光三个步骤,以确保掩膜上的图形清晰可见。
2. 曝光。
曝光是光刻工艺中最关键的一步。
在曝光过程中,掩膜上的图形会被光刻机上的紫外光照射到覆盖在硅片上的光刻胶上。
曝光的时间和强度需要精确控制,以确保图形的清晰度和精准度。
3. 显影。
曝光后,需要将硅片放入显影液中进行显影。
显影液会溶解掉光刻胶中未曝光部分的部分,从而在硅片上形成所需的图形。
显影时间的控制非常重要,它直接影响着图形的精准度和清晰度。
4. 清洗。
经过显影后,硅片需要进行清洗。
清洗的目的是去除掉显影液残留在硅片上的化学物质,以及光刻胶的残留物。
清洗后的硅片表面应该干净无尘,确保后续工艺的顺利进行。
5. 检测。
最后,经过光刻工艺的硅片需要进行检测。
检测的主要目的是确认图形的精准度和清晰度是否符合要求。
只有通过检测的硅片才能进入下一步的工艺流程,否则需要进行修正或者重新进行光刻工艺。
光刻工艺流程是半导体制造中不可或缺的一部分,它直接影响着芯片的性能和质量。
通过精确控制每一个步骤,可以确保光刻工艺的稳定性和可靠性。
希望本文对光刻工艺流程有所帮助,谢谢阅读。