半导体工艺整理资料
- 格式:docx
- 大小:306.73 KB
- 文档页数:12

半导体工艺期末总结一、引言半导体工艺是指将半导体材料制备成电子器件的过程,它是半导体技术的重要组成部分。
随着电子技术的不断发展,半导体工艺在各个领域中扮演着至关重要的角色。
本文将对半导体工艺进行总结,包括工艺流程、材料制备、设备使用等方面的内容。
二、半导体工艺流程半导体工艺流程是整个制造过程的核心部分。
一般而言,半导体工艺流程主要包括掩膜制备、腐蚀与刻蚀、沉积与生长、光刻涂胶与曝光、清洗与去胶等多个步骤。
这些流程步骤各自有不同的工艺条件、设备和材料要求,需要进行精确的操作与控制。
1. 掩膜制备掩膜制备是半导体工艺流程的起始步骤。
通常情况下,掩膜是通过光刻技术在硅片表面制备的。
光刻是一种利用光敏材料对光进行化学反应的技术,常用的光刻材料有光刻胶、光刻膜等。
光刻涂胶是在硅片上涂敷光刻胶,然后对光刻胶进行光刻曝光,形成所需形状的掩膜图案。
2. 腐蚀与刻蚀腐蚀与刻蚀是用来改变材料表面形貌与物理性质的工艺步骤。
常用的刻蚀方法有湿刻蚀和干刻蚀两种。
湿刻蚀是利用化学液体对材料进行腐蚀,常用的湿刻蚀液有硝酸、氟酸等。
干刻蚀是利用离子束或等离子体对材料表面进行刻蚀,常用的干刻蚀设备有反应离子刻蚀机 (RIE) 和平衡磁控溅射机 (PECVD)。
3. 沉积与生长沉积与生长是制备薄膜或材料电子元件的基础步骤。
主要包括化学气相沉积 (CVD)、物理气相沉积 (PVD)、溅射等技术。
其中,化学气相沉积是在封闭容器中将前体材料的气体传送到衬底上,沉积出所需的薄膜。
物理气相沉积是利用溅射或热蒸发的方式将材料沉积在衬底上,通常需要较高的真空度。
4. 光刻涂胶与曝光光刻涂胶与曝光是半导体工艺中重要的步骤,用来制备掩膜。
通常,涂胶需要先将硅片进行清洗,然后通过旋涂机将光刻胶涂敷在硅片表面。
之后,将涂敷光刻胶的硅片放入光刻机中进行曝光。
曝光是利用掩膜上的图案通过光照到硅片表面,使光刻胶进行固化形成掩膜图案。
5. 清洗与去胶清洗与去胶是半导体工艺中的最后步骤,用来去除不需要的杂质与胶层。

1.氧化(炉)(Oxidation)对硅半导体而言,只要在高于或等于1050℃的炉管中,如图2-3所示,通入氧气或水汽,自然可以将硅晶的表面予以氧化,生长所谓干氧层(dryz/gate oxide)或湿氧层(wet /field oxide),当作电子组件电性绝缘或制程掩膜之用。
氧化是半导体制程中,最干净、单纯的一种;这也是硅晶材料能够取得优势的特性之一(他种半导体,如砷化镓 GaAs,便无法用此法成长绝缘层,因为在550℃左右,砷化镓已解离释放出砷)硅氧化层耐得住850℃ ~ 1050℃的后续制程环境,系因为该氧化层是在前述更高的温度成长;不过每生长出1 微米厚的氧化层,硅晶表面也要消耗掉0.44微米的厚度。
以下是氧化制程的一些要点:(1)氧化层的成长速率不是一直维持恒定的趋势,制程时间与成长厚度之重复性是较为重要之考量。
(2)后长的氧化层会穿透先前长的氧化层而堆积于上;换言之,氧化所需之氧或水汽,势必也要穿透先前成长的氧化层到硅质层。
故要生长更厚的氧化层,遇到的阻碍也越大。
一般而言,很少成长2微米以上之氧化层。
(3)干氧层主要用于制作金氧半(MOS)晶体管的载子信道(channel);而湿氧层则用于其它较不严格讲究的电性阻绝或制程罩幕(masking)。
前者厚度远小于后者,1000~ 1500埃已然足够。
(4)对不同晶面走向的晶圆而言,氧化速率有异:通常在相同成长温度、条件、及时间下,{111}厚度≥{110}厚度>{100}厚度。
(5)导电性佳的硅晶氧化速率较快。
(6)适度加入氯化氢(HCl)氧化层质地较佳;但因容易腐蚀管路,已渐少用。
(7)氧化层厚度的量测,可分破坏性与非破坏性两类。
破坏性量测是在光阻定义阻绝下,泡入缓冲过的氢氟酸(BOE,Buffered Oxide Etch,系 HF与NH4F以1:6的比例混合而成的腐蚀剂)将显露出来的氧化层去除,露出不沾水的硅晶表面,然后去掉光阻,利用表面深浅量测仪,得到有无氧化层之高度差,即其厚度。

半导体加工工艺流程文献综述范文半导体加工工艺流程是一个相当复杂但又极具魅力的领域。
一、晶圆制造。
1.1 原料准备。
晶圆是半导体的基础。
硅是最常用的原料,就像盖房子的砖头一样重要。
从沙子中提炼出硅,这个过程就像是从矿石里淘金,经过多道工序,把硅提纯到极高的纯度。
纯度不够的硅就像掺了沙子的面粉,做不出好面包,对于半导体来说那是绝对不行的。
1.2 晶体生长。
这一步就像是培育一颗超级种子。
通过提拉法或者区熔法等技术,让硅原子按照特定的晶格结构排列起来,形成单晶硅棒。
这晶体就像是精心雕琢的艺术品,每一个原子的排列都得恰到好处,容不得半点马虎。
二、光刻。
2.1 光刻胶涂覆。
光刻胶就像是给晶圆穿上的一层特殊外衣。
把光刻胶均匀地涂覆在晶圆表面,这要求就像给蛋糕抹奶油一样平整光滑。
如果光刻胶涂得不好,后续的图案就没法精准地印上去,整个工序就会乱了套,就像衣服没穿好,出门就会闹笑话一样。
2.2 曝光。
这是光刻的关键步骤。
通过掩模版,就像一个精准的模板一样,利用紫外线等光源对光刻胶进行曝光。
这就好比用印章在白纸上盖章,要把图案精准地印在光刻胶上。
曝光的精度那可是差之毫厘谬以千里,稍微有点偏差,整个芯片的电路就会乱成一锅粥。
2.3 显影。
显影就像是冲洗照片一样。
把曝光后的晶圆放到显影液里,没被曝光的光刻胶就会被溶解掉,留下来的光刻胶图案就是我们想要的电路图案。
这个过程得小心翼翼,要是显影过度或者不足,那前面的努力就都白费了,真是竹篮打水一场空。
三、蚀刻。
3.1 干蚀刻。
干蚀刻就像是用一把非常精细的刻刀,在晶圆表面进行雕刻。
它通过等离子体等技术,把不需要的部分去除掉,只留下光刻胶保护下的部分。
这就要求刻刀得非常锋利而且精准,不然就会刻坏了不该刻的地方,那可就成了成事不足败事有余。
3.2 湿蚀刻。
湿蚀刻是利用化学溶液来进行蚀刻的方法。
这有点像把东西泡在特殊的药水里,让不需要的部分慢慢溶解掉。
湿蚀刻也得把握好度,不然就会把该留下的也给溶解了,那就好比是捡了芝麻丢了西瓜。
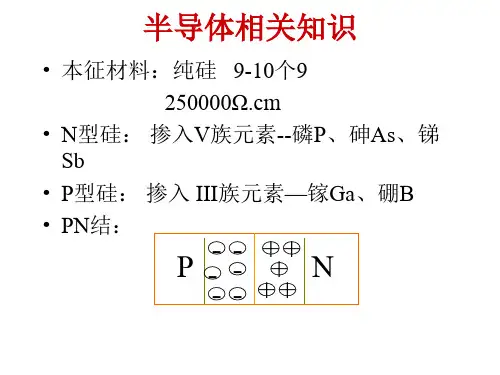

三.热分解淀积氧化热分解氧化薄膜工艺是利用含硅的化合物经过热分解反应,在硅片表面淀积一层二氧化硅薄膜的方法。
这种方法的优点是:基片本身不参与形成氧化膜的反应,而仅仅作为淀积二氧化硅氧化膜的衬底。
衬底可以是硅也可以不是硅而是其它材料片。
如果是硅片,获得二氧化硅膜也不消耗原来衬底硅,而保持硅片厚度不变,这是与热氧化法最根本的区别。
因为这种方法可以在较低的温度下应用,所以被称作“低温淀积”。
常用的热分解淀积氧化膜反应源物质(硅化合物)有正硅酸乙脂和硅烷两种。
现分别介绍如下:1.正硅酸乙脂热分解淀积淀积源的温度控制在20 o C左右,反应在真空状态下进行,真空度必须在10—2×133.3Pa以上,淀积时间根据膜厚决定。
淀积得到的二氧化硅氧化膜不如热生长的致密。
但如果在真空淀积之后经过适当的增密处理可使其质量有所改善;方法是硅片在反应炉内加热升温到850~900o C半小时左右,之后再在干燥的氮、氩或氧气氛中继续加热一段时间即可.2.硅烷热分解淀积反应方程式:SiH4 + 2O2→SiO2↓+ 2H2O↑(300~400 o C) 以上两种热分解淀积氧化膜的方法实际上是一种化学气相淀积(CVD)工艺。
前一种是低压CVD(LPCVD);后一种是常压CVD(APCVD).特别是后一种硅烷加氧气淀积二氧化硅的方法,是目前生产中天天在用的常规工艺。
以后我们将有专门的章节讲解CVD工艺.第二节SiO2薄膜的质量与检测二氧化硅工艺质量是半导体器件质量的基础。
下面就氧化质量要求,工艺检测,常见质量问题及对策等几个方面进行讨论。
一.质量要求SiO2薄膜质量优劣对器件性能和产品成品率都有很大影响.通常要求薄膜表面无斑点、裂纹、白雾、发花和针孔等缺陷;厚度要求在指标范围内,且保持均匀一致;结构致密,薄膜中可动离子特别是钠离子量不得超标。
二.检测方法1.厚度测量要求精度不高时,可用比色法、磨蚀法测量;精度高时,可用双光干涉法,电容-电压法检测。

半导体工艺知识点总结半导体工艺这事儿啊,就像一场超级精细的魔术表演。
咱先说说半导体材料这一块吧。
硅,那可是半导体世界里的大明星,就像一场演唱会里的主唱一样重要。
它的特性特别适合用来做半导体器件。
不过你可别以为硅就是唯一的主角啦,还有像锗啊之类的材料也在这个大舞台上有自己的戏份呢。
这半导体材料啊,就像是盖房子的砖头,没有好砖头,房子肯定盖不结实,同理,没有合适的半导体材料,后面那些神奇的半导体器件就无从谈起啦。
光刻技术呢,这可是半导体工艺里的一把神奇画笔。
光刻就像是在微观世界里搞艺术创作。
光刻机能把设计好的电路图案精确地印到硅片上,这个精度啊,那是超级高的。
你要是把硅片想象成一块超级小的画布,光刻技术就是那个能在上面画出超级精细图案的神来之笔。
这就好比刺绣,普通的刺绣可能针法粗糙一点没关系,可这半导体光刻啊,就像是苏绣里最精细的那种,一针一线都不能差,稍微有点偏差,整个电路可能就废了。
蚀刻工艺也很关键呢。
蚀刻就像是一个超级精准的雕刻师,把不需要的部分一点一点地去除掉,只留下我们想要的电路结构。
这就像做木雕一样,木雕师傅拿着刻刀,一点点地把多余的木头削掉,最后呈现出精美的木雕作品。
半导体蚀刻也是这个道理,只不过它是在微观层面上进行的,那难度可比木雕大多了。
再说说掺杂工艺吧。
掺杂就像是给半导体材料注入灵魂。
往纯净的半导体材料里加入一些杂质原子,就好像给一杯白开水加点糖或者盐一样,一下子就改变了它的性质。
这一改变可不得了,能让半导体具备我们想要的电学特性,像是导电性之类的。
这就好比一个人原本很内向,突然给他注入了一些开朗的元素,整个人的性格就变得不一样了,在半导体这里,就是电学性能发生了变化。
封装工艺呢,这就是给做好的半导体芯片穿上保护的外衣。
芯片就像一个娇弱的小宝宝,需要好好保护起来。
封装就像是给小宝宝做一个坚固又舒适的小房子。
这个小房子不仅要保护芯片不受外界环境的影响,像温度、湿度之类的,还要能方便芯片和外界进行连接,就像房子要有门和窗户一样,芯片封装也要有引脚之类的东西来实现电气连接。

半导体工艺基本知识半导体工艺啊,就像是一场微观世界里的奇妙魔术。
咱们先从硅片说起吧。
硅片就好比是盖房子的地基,整个半导体世界都建立在它之上。
硅呢,是一种很神奇的材料,在沙子里就能找到它的身影。
你说神不神?把沙子变成能做半导体的硅片,这得经过多少道工序啊。
就像把一块普通的石头打磨成一颗璀璨的宝石一样不容易。
这硅片得做得平平整整、干干净净的,哪怕一点点小杂质或者小凸起,那对后面的工艺来说,就像在一碗好汤里掉进了一粒老鼠屎一样,坏了整锅汤。
掺杂工艺也很有趣。
这就像是给硅片这个大集体里安排不同职责的成员。
往硅片里掺入一些特殊的元素,就像在一群人中安排几个特别的角色一样。
这些被掺进去的元素会改变硅片的电学性质,让它能实现各种各样的功能。
比如说,本来硅片可能比较老实,不太导电,但是一掺杂之后,就像给它注入了活力,变得能很好地导电了。
这感觉就像是给一个内向的人注入了自信,突然就变得活跃起来了。
蚀刻工艺又是什么样的呢?它有点像雕刻家拿着刻刀在作品上精雕细琢。
把不需要的部分去掉,留下我们想要的电路结构。
这个过程得小心翼翼的,要是不小心多刻掉了一点,那就像厨师做菜的时候盐放多了一样,整个味道就不对了。
芯片的性能也就受到影响了。
薄膜沉积工艺呢,就像是给硅片穿上一层一层的衣服。
这些衣服可有讲究了,不同的薄膜有着不同的功能。
有的是为了绝缘,就像冬天穿的棉衣,把寒冷隔开;有的是为了传导电流,就像电线外面的那层皮,起着保护和传导的作用。
每一层薄膜都得均匀地覆盖在硅片上,如果有薄有厚,那就像衣服穿得歪歪扭扭的,既不美观也不实用。
在半导体工艺的世界里,清洁度是至关重要的。
这就好比咱们住的房子,如果到处都是灰尘垃圾,肯定住着不舒服。
在半导体制造车间里,一点点灰尘都可能毁掉一个芯片。
所以那里的环境得保持得超级干净,工作人员都得穿着特殊的工作服,就像一群白色的小精灵在微观世界里忙碌着。
半导体工艺涉及到的设备也很复杂昂贵。
那些设备就像是一个个巨大的怪兽,静静地蹲在那里,等着人们去操作它们。

半导体的生产工艺流程(精)什么是半导体半导体是一种电子特性介于导体和绝缘体之间的固体材料。
它具备一部分导体材料的性质,如可对电流进行某种程度上的控制,同时又保留了部分绝缘材料的性质,如电阻值较高。
由于半导体具备这些特性,它成为了现代电子工业中不可或缺的材料之一。
半导体生产的基本流程半导体的生产工艺流程日趋复杂,但基本的工艺流程依然是从硅田采购到成品的集成电路,一般包含以下几个基本步骤:1.半导体材料生长2.晶圆加工3.掩膜制作4.晶圆刻蚀5.金属化6.化学机械研磨7.微影光刻8.其他工序如离子注入、退火等半导体材料生长半导体材料生长是制造半导体器件的第一步。
硅材料生长主要采用CVD或单晶生长法,CVD是一种化学气相沉积方法,通过反应气体在衬底表面沉积。
而锗的生长则使用另一种方法——分子束外延法,将纯净的气态的锗芯片熔化以后喷到介质上,并通过化学反应来沉积到介质表面。
相比之下,单晶生长法是生长单晶硅的主要方法,它使铸锭通过高温坩埚中的液体硅进行熔硅石化学反应,得到单晶硅,并通过磨削和切割等多个工艺步骤得到晶圆。
晶圆加工晶圆加工是将生长出的单晶硅切成薄片(通常厚度为0.3~0.75mm),通过化学改性等方式得到半导体材料。
该过程中硅片会被加热,然后用钨丝切成薄片,一般需要晶片翻转,重复切削,直至得到标准的直径200mm或更大的薄片。
掩膜制作光刻技术是制造集成电路的核心工艺之一。
它通过将光刻胶覆盖在晶圆表面,然后将加工好的掩膜对准涂有光刻胶的晶片,利用紫外线照射胶层,然后用化学方法去除未凝固的光刻胶,实现对半导体片的局部改性。
晶圆刻蚀刻蚀是制造半导体器件的另一个核心工艺之一。
该工艺主要通过使用化学液体或离子束等方法进行化学或物理改性,以清除不需要的表面材料,留下所需形状的导电区域和非导电区域。
通常包括干法刻蚀、湿法刻蚀和离子束刻蚀等方法。
金属化金属化是将晶圆表面金属化来保护芯片和连接电路,通常采用电子束蒸发或物理气相沉积等方式将金属材料加热,使其蒸发后再沉积在晶圆表面。

半导体加⼯⼯艺(复习整理)⼀、半导体衬底1、硅是⽬前半导体中⽤的最多的⼀种衬底材料2、硅的性能:屈服强度7x109 N/m2 弹性模量 1.9x1011 N/m2 密度2.3 g/cm3热导率 1.57 Wcm-1°C-1 热膨胀系数2.33x10-6 °C-1 电阻率(P) n-型 1 - 50 ?.cm 电阻率(Sb) n-型0.005 -10?.cm 电阻率(B) p-Si 0.005 -50 ?.cm 少⼦寿命30 -300 µs 氧5 -25 ppm 碳 1 - 5 ppm 缺陷<500 cm-2 直径Up to 200 mm 重⾦属杂质< 1 ppb3、硅的纯化SiO2+2C?Si(冶⾦级)+2CO、Si+3HCl SiHCl3+H2、2SiHCl3(蒸馏后的)+2H2 2Si(电⼦级)+6HCl4、直拉法单晶⽣长(p19):多晶硅放在坩埚中,加热到1420oC将硅熔化,将已知晶向的籽晶插⼊熔化硅中然后拔出。
硅锭旋转速度20r/min 坩埚旋转速度10r/min 提升速度:1.4mm/min (φ100mm) 掺杂P、B、Sb、As5、芯⽚直径增⼤, 均匀性问题越来越突出6、区熔法晶体⽣长(p28):主要⽤于制备⾼纯度硅或⽆氧硅。
⽣长⽅法:多晶硅锭放置在⼀个单晶籽晶上,多晶硅锭由⼀个外部的射频线圈加热,使得硅锭局部熔化,随着线圈和熔融区的上移,单晶籽晶上就会往上⽣长单晶。
特点:电阻率⾼、⽆杂质沾污、机械强度⼩,尺⼨⼩。
7、⼆、热氧化1、SiO2的基本特性:热SiO2是⽆定形的、良好的电绝缘材料、⾼击穿电场、稳定和可重复的Si/SiO2界⾯、硅表⾯的⽣长基本是保形的、杂质阻挡特性好、硅和SiO2的腐蚀选择特性好。
2、热氧化原理:反应⽅程:Si(固体)+O2(⽓体)-->SiO23、含Cl氧化:氧化过程中加⼊少量的HCl 或TCE(三氯⼄烯):减少⾦属沾污、改进Si/SiO2界⾯性能(P70)4、氧化中消耗硅的厚度:1umSI被氧化——>2.17umSIO25、热氧化的影响因素:温度、⽓氛(⼲氧、⽔汽、HCl)、压⼒、晶向、掺杂6、⾼压氧化:对给定的氧化速率,压⼒增加,温度可降低;温度不变的情况下,氧化时间可缩短7、氧化层的缺陷:表⾯缺陷:斑点、⽩雾、发花、裂纹体内缺陷:针孔、氧化层错8、氧化诱⽣堆垛层错:三、扩散1、掺杂在半导体⽣产中的作⽤:形成PN结;形成电阻;形成欧姆接触;形成双极形的基区、发射区、集电区,MOS管的源、漏区和对多晶硅掺杂;形成电桥作互连线2、扩散的定义:在⾼温下,杂质在浓度梯度的驱使下渗透进半导体材料,并形成⼀定的杂质分布,从⽽改变导电类型或杂质浓度。

半导体⼯艺整理资料第⼀章微电⼦⼯艺引论1.硅⽚、芯⽚的概念硅⽚:制造电⼦器件的基本半导体材料硅的圆形单晶薄⽚芯⽚:由硅⽚⽣产的半导体产品2.* 什么是微电⼦⼯业技术?微电⼦⼯业技术主要包括哪些技术?微电⼦⼯艺技术:在半导体材料芯⽚上采⽤微⽶级加⼯⼯艺制造微⼩型化电⼦元器件和微型化电路技术。
包括超精细加⼯技术、薄膜⽣长和控制技术、⾼密度组装技术、过程检测和过程控制技术等3.集成电路制造涉及的5 个⼤的制造阶段的内容集成电路制造阶段:硅⽚制备、芯⽚制造、芯⽚测试/ 拣选、装配与封装、终测4. IC⼯艺前⼯序,IC⼯艺后⼯序,以及IC⼯艺辅助⼯序IC⼯艺前⼯序:薄膜制备技术:主要包括外延、氧化、化学⽓相淀积、物理⽓相淀积(如溅射、蒸发)等掺杂技术:主要包括扩散和离⼦注⼊等技术图形转换技术:主要包括光刻、刻蚀等技术IC⼯艺后⼯序:划⽚、封装、测试、⽼化、筛选IC⼯艺辅助⼯序:超净⼚房技术;超纯⽔、⾼纯⽓体制备技术;光刻掩膜版制备技术;材料准备技术5.微芯⽚技术发展的主要趋势提⾼芯⽚性能(速度、功耗)提⾼芯⽚可靠性(低失效)降低芯⽚成本(减⼩特征尺⼨,增加硅⽚⾯积,制造规模)6.什么是关键尺⼨(CD)?芯⽚上的物理尺⼨特征称为特征尺⼨特别是硅⽚上的最⼩特征尺⼨,也称为关键尺⼨或CD第⼆章半导体材料1 .本征半导体和⾮本征半导体的区别是什么?本征半导体:不含任何杂质的纯净半导体,其纯度在99.999999%(8~10个9)2 .为何硅被选为最主要的半导体材料?硅材料:硅的丰裕度——制造成本低熔点⾼(1412 0C)――更宽的⼯艺限度和⼯作温度范围SiO2的天然⽣成3. GaAs相对硅的优点和缺点各是什么?优点:a)⽐硅更⾼的电⼦迁移率,⾼频微波信号响应好⼀⼀⽆线和⾼速数字通信b)抗辐射能⼒强――军事和空间应⽤c)电阻率⼤――器件隔离容易实现d)发光⼆极管和激光器主要缺点a)没有稳定的起钝化保护作⽤的⾃然氧化层b)晶体缺陷⽐硅⾼⼏个数量级c)成本⾼第三章圆⽚的制备1.两种基本的单晶硅⽣产⽅法直拉法(CZ法)、区熔法2.晶体缺陷根据维数可分为哪四种?a) 点缺陷—空位、⾃填隙等b) 线缺陷—位错c) ⾯缺陷—层错d) 体缺陷3.* 画出圆⽚制备的基本⼯艺步骤流程图,并给出其任意三个步骤的主要作⽤晶体⽣长、整型、切⽚、磨⽚倒⾓、刻蚀、抛光、清洗、检查、包装磨⽚和倒⾓:切⽚完成后,传统上要进⾏双⾯的机械磨⽚以除去切⽚时留下的损伤,达到硅⽚两⾯⾼度的平⾏及平坦;硅⽚边缘抛光修整(⼜叫倒⾓)可使硅⽚边缘获得平滑的半径周线切⽚:对于200mm 的硅⽚,切⽚是⽤带有⾦刚⽯切割边缘的内圆切割机来完成的。

工艺考试复习:整理者(butterflying 2011‐1‐11)1.在半导体技术发展的过程中有哪些重要事件?(一般)晶体管的诞生集成电路的发明平面工艺的发明CMOS技术的发明2.为什么硅是半导体占主导的材料?有哪些硅基薄膜?(一般)硅材料:优良的半导体特性、稳定的电的、化学的、物理的及机械的性能(特性稳定的金刚石晶体结构、良好的传导特性、优异的工艺加工能力、研究最透彻的材料、具有一系列的硅基化合物)(总结:半导体性、电、物理、化学、机械性)硅基薄膜:外延硅薄膜、多晶硅薄膜、无定形硅薄膜、SiO2与Si3N4介质膜、SiGe薄膜、金属多晶硅膜3. 微电子技术发展基本规律是什么?(重要)摩尔定律(Moore’s Law):芯片内的晶体管数量每18个月~20个月增加1倍――集成电路的集成度每隔三年翻两番,器件尺寸每三年增加0.7 倍,半导体技术和工业呈指数级增长。
特征尺寸缩小因子,250→180→130→90→65→45→32→22→16(nm)等比例缩小比率(Scaling down principle):在MOS器件内部恒定电场的前提下,器件的横向尺寸、纵向尺寸、电源电压都按照相同的比例因子k缩小,从而使得电路集成度k2倍提高,速度k倍提高,功耗k2倍缩小。
MOS管阻抗不变,但连线电阻和线电流密度都呈k倍增长。
(阈值电压不能缩得太小,电源电压要保持长期稳定)(总结:尺寸、电源电压变为1/k,集成度变为k^2.速度变为k倍。
(掺杂浓度变为k倍)Device miniaturization by “ Scaling‐down Principle”− Device geometry‐L g, W g, t ox, x j ⋅ 1/k− Power supply‐V dd ⋅1/k− Substrate doping‐N ⋅ k®Device speed ⋅ k® Chip density ⋅ k24. 什么是ITRS ?(重要)International Technology Roadmap for Semiconductors国际半导体技术发展蓝图技术节点:DRAM半间距Technology node = DRAM half pitch5. 芯片制造的主要材料和技术是什么?(一般)Si材料:大直径和低缺陷的单晶硅生长、吸杂工艺、薄膜的外延生长、SiGe/Si异质结、SOI 介质薄膜材料和工艺:热氧化、超薄高K栅氧化薄膜生长、互连的低K介质;高分辨率光刻:电子束掩膜版、光学光刻(电子束曝光EBL)、匹配光刻。
半导体主要生产工艺
半导体主要生产工艺包括:
晶圆制备:晶圆是半导体制造的基础,其质量直接影响到后续工艺的进行和最终产品的性能。
薄膜沉积:薄膜沉积技术是用于在半导体材料表面沉积薄膜的过程。
刻蚀与去胶:刻蚀是将半导体材料表面加工成所需结构的关键工艺。
离子注入:离子注入是将离子注入半导体材料中的关键工艺。
退火与回流:退火与回流是使半导体材料内部的原子或分子的运动速度减缓,使偏离平衡位置的原子或分子回到平衡位置的工艺。
金属化与互连:金属化与互连是利用金属材料制作导电线路,实现半导体器件间的电气连接的过程。
测试与封装:测试与封装是确保半导体器件的质量和可靠性的必要环节。
半导体的工艺的四个重要阶段是:
原料制作阶段:为制造半导体器件提供必要的原料。
单晶生长和晶圆的制造阶段:为制造半导体器件提供必要的晶圆。
集成电路晶圆的生产阶段:在制造好的晶圆上,通过一系列的工艺流程制造出集成电路。
集成电路的封装阶段:将制造好的集成电路封装起来,便于安装和使用。
半导体材料有以下种类:
元素半导体:在元素周期表的ⅢA族至IVA族分布着11种具有半导性的元素,其中C表示金刚石。
无机化合物半导体:分二元系、三元系、四元系等。
有机化合物半导体:是指以碳为主体的有机分子化合物。
非晶态与液态半导体。
半导体工艺步骤一、半导体工艺步骤概述半导体工艺是将硅片或其他半导体材料加工成各种电子器件的过程。
它包括了多个步骤,每个步骤都是为了实现特定的工艺要求。
下面将详细介绍半导体工艺的各个步骤。
二、硅片制备硅片是半导体器件的基础材料,它是通过将硅矿石经过多道工序提炼、纯化而得到的。
首先,将硅矿石破碎成小颗粒,然后经过酸浸、熔炼和晶体生长等工序,最终得到纯净度极高的硅单晶。
然后将硅单晶锯成薄片,形成硅片。
三、清洗和去除杂质在进行后续的工艺步骤之前,硅片需要进行清洗和去除杂质的处理。
这一步骤旨在保证硅片表面的纯净度和平整度,以便后续步骤的顺利进行。
清洗通常使用酸碱溶液和超纯水进行,可以去除表面的有机和无机污染物。
四、表面氧化表面氧化是将硅片表面形成一层氧化硅薄膜的过程。
这一步骤可以使用热氧化或化学气相沉积等方法。
氧化硅薄膜可以用作绝缘层,保护硅片表面,并提供后续工艺步骤的基础。
五、光刻光刻是将图案投影到硅片上的工艺步骤。
首先,在硅片上涂覆一层光刻胶,然后使用掩膜板和紫外光照射,使光刻胶在曝光区域发生化学反应。
然后,通过显影和清洗,去除未曝光区域的光刻胶,形成所需的图案。
六、蚀刻蚀刻是通过化学反应去除硅片表面的一部分材料,以形成所需的结构。
蚀刻可以分为湿法蚀刻和干法蚀刻两种。
湿法蚀刻使用酸或碱溶液进行,而干法蚀刻则使用气体等化学物质进行。
蚀刻可以用来开凿孔洞、形成导线等。
七、沉积沉积是将材料沉积到硅片表面的工艺步骤。
沉积可以分为物理气相沉积(PVD)和化学气相沉积(CVD)两种。
PVD将固态材料蒸发或溅射到硅片上,而CVD通过化学反应将气态材料沉积到硅片上。
沉积可以用来形成导线、绝缘层等。
八、电镀电镀是将金属沉积到硅片表面的工艺步骤。
首先,在硅片上涂覆一层金属种子层,然后将硅片浸入含有金属离子的电解液中,通过电流使金属离子还原并沉积到硅片上。
电镀可以用来形成导线、连接器等。
九、退火退火是在高温下对硅片进行热处理的工艺步骤。
半导体制作工艺1:清洗1.1:可以接受的颗粒尺寸的粗略法则:可动离子必须小于器件特征尺寸的一半.1.2:可动离子沾污(MIC)的危害及最典型、最为普遍的MIC;MIC沾污迁移到栅结构的二氧化硅界面,改变开启晶体管的所要的阈值电压;MIC是化学性质活泼的碱金属,电离的离子在电学测试和运输很久后沿器件移动,引起器件在使用期间失效。
最典型最普遍的MIC是锂,钠,钾。
1.3:有机物沾污带来的问题;表面清洗不彻底,使得诸如金属杂质之类的沾污在清洗之后仍完整保留于硅片表面。
1.4:自然氧化层及清除方法;硅片曝露于室温下的空气或含氧的去离子水中,硅片表面将被氧化,此氧化层是自然氧化层。
优点:保护器件。
缺点:增加接触电阻。
自然氧化层清洗:将硅片表面曝露于含HF酸的混合液中,使硅片表面完全被氢原子终止,在空气中有很好的稳定性,避免了再次被氧化。
1.5:湿法清洗的基本步骤;清洗一般原则:3#_去离子水_1#_去离子水_2#去离子水_王水_去离子水.先去有机物,再去离子玷污,最后去原子玷污.1#碱性清洗液:NH4OH:H2O2:H2O=1:1:5~1:2:72#酸性清洗液:HCL:H2O2:H2O=1:1:6~1:2:83#氧化清洗液:H2SO4(浓):H2O2=3:11.6:有机物清洗:根据有分子结构相似相溶的原理;清洗步骤:四氯化炭—甲苯—丙酮—洒精—纯水,处理过程中可以加入超声,处理后通常用强氧化化剂再处理一次,然后水洗:冷水15次,热水15次,冷水15次。
扩散2.1:扩散有哪几种方式;各有什么特点;扩散中中制结的杂质都是哪些杂质.替位式扩散:半径较大的杂质原子只能替代半导体原子而占据格点位置,再周围的空信(空格点)进行扩散;近邻处有无空位是替位式扩散的前提。
硅替位式杂质:硼,铝,镓,铟,磷,砷,铋。
间隙式扩散:半径小的杂质原子经过半导体的晶格间隙扩散。
硅间隙式杂质:金,银,铜,铁,铌。
2.2:杂质浓度分布图形;恒定表面源扩散及有限表面源扩散.2.3:结深的具体定义:N(X,T)=NB.硅片表面到扩散杂质浓度与衬底杂质浓度一致处的距离是结深。
半导体工艺技术基础知识半导体工艺技术是制造半导体器件的关键技术之一,是现代电子产业发展的重要支撑。
以下是关于半导体工艺技术的基础知识。
半导体材料是一种介于导体与绝缘体之间的材料。
常见的半导体材料包括硅(Si)和砷化镓(GaAs)等。
半导体材料的导电性能受温度、掺杂物浓度和外加电场等因素的影响。
半导体材料的电导率可以通过掺杂来调控,将杂质原子(掺杂剂)添加到半导体材料中,可以使其导电性能得到改善。
半导体器件的制造通过一系列的工艺步骤完成。
首先,需要通过杂质掺杂的方法,改变半导体材料的导电性能。
常见的掺杂方法包括离子注入和溅射。
离子注入是将掺杂剂离子加速到高能量,并注入到半导体材料中,从而改变其电导率。
溅射是将掺杂剂材料蒸发,经过激发后,附着到半导体材料表面,改变其导电性能。
掺杂完成后,需要进行退火处理,使掺杂剂均匀分布在半导体材料中。
之后,需要进行光刻工艺,将器件的图形转移到半导体材料表面,形成光刻胶,再通过光照的方式选择性地去除部分光刻胶。
光刻胶的选择和图形的设计对器件的最终性能具有重要影响。
接下来是蚀刻工艺,通过湿法或干法将半导体材料表面的非需要部分去除,形成所需的器件结构。
湿法蚀刻使用化学液体,干法蚀刻使用高能粒子束。
蚀刻结束后,需要进行清洗工艺,去除蚀刻产生的杂质。
最后是沉积工艺,将需要的金属或绝缘体沉积在半导体材料上,形成金属引线或绝缘层等。
沉积工艺包括物理气相沉积(PVD)和化学气相沉积(CVD)等。
半导体工艺技术的基础知识不仅包括以上的材料和工艺步骤,还包括器件设计和测试等方面的知识。
器件设计需要根据需求和性能要求,选择合适的材料和工艺方法。
器件测试需要使用一系列的测试仪器,评估器件的性能和可靠性。
总之,半导体工艺技术是现代电子产业必不可少的一部分。
掌握半导体工艺技术的基础知识,对于理解和应用半导体器件具有重要的意义。
半导体工艺讲解(1)--掩模和光刻(上)概述光刻工艺是半导体制造中最为重要的工艺步骤之一。
主要作用是将掩膜板上的图形复制到硅片上,为下一步进行刻蚀或者离子注入工序做好准备。
光刻的成本约为整个硅片制造工艺的1/3,耗费时间约占整个硅片工艺的40~60%。
光刻机是生产线上最贵的机台,5~15百万美元/台。
主要是贵在成像系统(由15~20个直径为200~300mm的透镜组成)和定位系统(定位精度小于10nm)。
其折旧速度非常快,大约3~9万人民币/天,所以也称之为印钞机。
光刻部分的主要机台包括两部分:轨道机(Tracker),用于涂胶显影;扫描曝光机(Scanning )光刻工艺的要求:光刻工具具有高的分辨率;光刻胶具有高的光学敏感性;准确地对准;大尺寸硅片的制造;低的缺陷密度。
光刻工艺过程一般的光刻工艺要经历硅片表面清洗烘干、涂底、旋涂光刻胶、软烘、对准曝光、后烘、显影、硬烘、刻蚀、检测等工序。
1、硅片清洗烘干(Cleaning and Pre-Baking)方法:湿法清洗+去离子水冲洗+脱水烘焙(热板150~2500C,1~2分钟,氮气保护)目的:a、除去表面的污染物(颗粒、有机物、工艺残余、可动离子);b、除去水蒸气,是基底表面由亲水性变为憎水性,增强表面的黏附性(对光刻胶或者是HMDS-〉六甲基二硅胺烷)。
2、涂底(Priming)方法:a、气相成底膜的热板涂底。
HMDS蒸气淀积,200~2500C,30秒钟;优点:涂底均匀、避免颗粒污染;b、旋转涂底。
缺点:颗粒污染、涂底不均匀、HMDS用量大。
目的:使表面具有疏水性,增强基底表面与光刻胶的黏附性。
3、旋转涂胶(Spin-on PR Coating)方法:a、静态涂胶(Static)。
硅片静止时,滴胶、加速旋转、甩胶、挥发溶剂(原光刻胶的溶剂约占65~85%,旋涂后约占10~20%);b、动态(Dynamic)。
低速旋转(500rpm_rotation per minute)、滴胶、加速旋转(3000rpm)、甩胶、挥发溶剂。
半导体复习资料整理1.电⼦和空⽳也可以通过杂质电离⽅式产⽣,当电⼦从施主能级跃迁到导带时产⽣导带电⼦;当电⼦从价带激发到受主能级时产⽣价带空⽳等。
与此同时,还存在着相反的过程,即电⼦也可以从⾼能量的量⼦态跃迁到低能量的量⼦态,并向晶格放出⼀定能量,从⽽使导带中的电⼦和价带中的空⽳不断减少,这⼀过程称为载流⼦的复合。
n型Si 中的杂质离化区2.掺杂浓度和温度对载流⼦浓度和费⽶能级的影响:掺有某种杂质的半导体的载流⼦浓度和费⽶能级由温度和杂质浓度所决定。
对于杂质浓度⼀定的半导体,随着温度的升⾼,载流⼦则是从以杂质电离为主要来源过渡到以本征激发为主要来源的过程,相应地,费⽶能级则从位于杂质能级附近逐渐移近禁带中线处。
譬如n型半导体,在低温弱电离区时,导带中的电⼦是从施主杂质电离产⽣的;随着温度升⾼,导带中的电⼦浓度也增加,⽽费⽶能级则从施主能级以上往下降到施主能级以下;当下降到以下若⼲时,施主杂质全部电离,导带中的电⼦浓度等于施主浓度,处于饱和区;再升⾼温度,杂质电离已经不能增加电⼦数,但本征激发产⽣的电⼦迅速增加着,半导体进⼊过渡区,这时导带中的电⼦由数量级相近的本征激发部分和杂质电离部分组成,⽽费⽶能级则继续下降;当温度再升⾼时,本征激发成为载流⼦的主要来源,载流⼦浓度急剧上升,⽽费⽶能级下降到禁带中线处这时就是典型的本征激发。
对于p型半导体,作相似的讨论,在受主浓度⼀定时,随着温度升⾼,费⽶能级从在受主能级以下逐渐上升到禁带中线处,⽽载流⼦则从以受主电离为主要来源转化到以本征激发为主要来源当温度⼀定时,费⽶能级的位置由杂质浓度所决定,例如n型半导体,随着施主浓度的增加,费⽶能级从禁带中线逐渐移向导带底⽅向。
对于p型半导体,随着受主浓度的增加费⽶能级从禁带中线逐渐移向价带顶附近。
这说明,在杂质半导体中,费⽶能级的位置不但反映了半导体导电类型,⽽且还反映了半导体的掺杂⽔平。
对于n型半导体,费⽶能级位于禁带中线以上,越⼤,费⽶能级位置越⾼。
第一章微电子工艺引论1.硅片、芯片的概念硅片:制造电子器件的基本半导体材料硅的圆形单晶薄片芯片:由硅片生产的半导体产品2.* 什么是微电子工业技术?微电子工业技术主要包括哪些技术?微电子工艺技术:在半导体材料芯片上采用微米级加工工艺制造微小型化电子元器件和微型化电路技术。
包括超精细加工技术、薄膜生长和控制技术、高密度组装技术、过程检测和过程控制技术等3.集成电路制造涉及的5 个大的制造阶段的内容集成电路制造阶段:硅片制备、芯片制造、芯片测试/ 拣选、装配与封装、终测4. IC工艺前工序,IC工艺后工序,以及IC工艺辅助工序IC工艺前工序:薄膜制备技术:主要包括外延、氧化、化学气相淀积、物理气相淀积(如溅射、蒸发)等掺杂技术:主要包括扩散和离子注入等技术图形转换技术:主要包括光刻、刻蚀等技术IC工艺后工序:划片、封装、测试、老化、筛选IC工艺辅助工序:超净厂房技术;超纯水、高纯气体制备技术;光刻掩膜版制备技术;材料准备技术5.微芯片技术发展的主要趋势提高芯片性能(速度、功耗)提高芯片可靠性(低失效)降低芯片成本(减小特征尺寸,增加硅片面积,制造规模)6.什么是关键尺寸(CD)?芯片上的物理尺寸特征称为特征尺寸特别是硅片上的最小特征尺寸,也称为关键尺寸或CD第二章半导体材料1 .本征半导体和非本征半导体的区别是什么?本征半导体:不含任何杂质的纯净半导体,其纯度在99.999999%(8~10个9)2 .为何硅被选为最主要的半导体材料?硅材料:硅的丰裕度——制造成本低熔点高(1412 0C)――更宽的工艺限度和工作温度范围SiO2的天然生成3. GaAs相对硅的优点和缺点各是什么?优点:a)比硅更高的电子迁移率,高频微波信号响应好一一无线和高速数字通信b)抗辐射能力强――军事和空间应用c)电阻率大――器件隔离容易实现d)发光二极管和激光器主要缺点a)没有稳定的起钝化保护作用的自然氧化层b)晶体缺陷比硅高几个数量级c)成本高第三章圆片的制备1.两种基本的单晶硅生产方法直拉法(CZ法)、区熔法2.晶体缺陷根据维数可分为哪四种?a) 点缺陷—空位、自填隙等b) 线缺陷—位错c) 面缺陷—层错d) 体缺陷3.* 画出圆片制备的基本工艺步骤流程图,并给出其任意三个步骤的主要作用晶体生长、整型、切片、磨片倒角、刻蚀、抛光、清洗、检查、包装磨片和倒角:切片完成后,传统上要进行双面的机械磨片以除去切片时留下的损伤,达到硅片两面高度的平行及平坦;硅片边缘抛光修整(又叫倒角)可使硅片边缘获得平滑的半径周线切片:对于200mm 的硅片,切片是用带有金刚石切割边缘的内圆切割机来完成的。
对于300mm 的硅片,用线锯来切片。
厚度一般在775± 25 微米清洗:半导体硅片必须被清洗使得在发送给芯片制造厂之前达到超净的洁净状态第四章沾污控制1.净化间污染分类净化间沾污、颗粒、金属杂质、有机物沾污、自然氧化层、静电释放( ESD) 2.半导体制造中,可以接受的颗粒尺寸的粗略法则必须小于最小器件特征尺寸的一半3.金属污染的主要来源a) 化学溶液b) 半导体制造中的各种工序,如:离子注入c) 化学品与传输管道反应d) 化学品与容器反应4.* 超净服的目标超净服系统的目标是满足以下职能标准:a) 对身体产生的颗粒和浮质的总体抑制b) 超净服系统颗粒零释放c) 对ESD的零静电积累d) 无化学和生物残余物的释放5.什么是可动离子污染可动离子沾污( MIC):a) 金属杂质以离子形式出现,且是高度活动性b) 危害半导体工艺的典型金属杂质是碱金属。
如钠,就是最常见的可移动离子沾污物,而且移动性最强6.静电释放的概念及带来的问题静电释放( ESD):a) 也是一种形式的沾污,因为它是静电荷从一个物体向另一个物体未经控制地转移,可能损坏芯片b) 半导体制造中特别容易产生静电释放,因为硅片加工保持在较低的湿度中静电释放带来的问题:a)发生在几个纳秒内的静电释放能产生超过1A的峰值电流蒸发金属导线和穿透氧化层击穿栅氧化层的诱因b)吸附颗粒到硅片表面颗粒越小,静电的吸引作用就越明显器件特征尺寸的缩小,更需要严格控制硅片放电7.芯片生产厂房的7种污染源空气、人、厂房、水、工艺用化学品、工艺气体、生产设备&硅片表面的颗粒数与工艺步骤数之间的关系图9. 硅片清洗目标硅片清洗的目标--- 去除所有表面沾污颗粒、有机物、金属、自然氧化层第五章工艺腔内的气体控制1 .工艺用气体通常分为哪两类?通用气体:氧气(02)、氮气(N2)、氢气(H2)、氦气(He)和氩气(Ar),纯度要控制在7个9 (99.99999%)以上特殊气体:指一些工艺气体以及其它在半导体集成电路制造中比较重要的气体,纯度要控制在4个9 (99.99%)以上2. 常见的初级泵和高级泵常见的两种初级泵:a)干性机械泵b)增压/调压泵:可处理大量气体而不需要润滑剂,增压器通常被称为罗茨增压泵常见的两种高真空泵:a)加速分子泵(涡轮泵):是一种多用途、可靠的洁净泵,运作机理是机械化的压缩b)冷凝泵:是一种俘获式泵,它通过使气体凝结并俘获在泵中的方式去除工艺腔体中的气体3. 质量流量计(MFC)的概念利用气体的热传输特性,直接测量进入腔体的质量流量比率,来控制进入腔体的气流4. 残气分析器(RGA )最常用的用途和基本构成用途:用来检验残留在已清空系统中的气体分子的类型、检漏、工艺中的故障查询 基本构成:一个离子发生器、一个孔径、一个分析器和一个探测器。
第六章 氧化1 . 氧化物的两种生产方式 热氧化生长、淀积2. 氧化层在芯片制造中有哪几方面的应用? 保护器件免受划伤和隔离污染 限制带电载流子场区隔离(表面钝化) 栅氧或储存器单元结构中的介质材料 掺杂中的注入掩蔽 金属导电层间的介质层 3 . 表面钝化的概念SiO2可以通过束缚Si 的悬挂键,从而降低它的表面态密度,这种效果称为表面钝化 能防止电性能退化,并减少由潮湿、离子或其他外部污染物引起的漏电流的通路4. 关于热氧化的两个化学反应 干氧氧化在没有水汽的氛围里进行,化学反应方程式为:Si (固)+ O2 (气)T SiO2 (固) 湿氧氧化有水汽参与,氧化反应速率较快,化学反应方程式为:Si (固)+ 2H2O (水汽SiO2 (固)+ 2H2 (气)5. * 氧化物生产 初始阶段: O 与 Si 反应,在硅表面生成二氧化硅生成 继续氧化:生成的 SiO2 将阻挡 O 原子与 Si 原子直接接触,所以其后的继续氧化是 原子通过扩散穿过已生成的二氧化硅层,向Si 一侧运动到达界面进行反应而增厚的线性阶段氧化物生长厚度:X=(B/A )t 抛物线阶段 X=(Bt )1/2 X:氧化物生长厚度B/A:为线性速率系数,温度升高系数增大 B :抛物线速率系数 t :为生长时间 第七章 掺杂 掺杂的两种方法热扩散 :利用高温驱动杂质穿过硅的晶格结构。
这种方法受到时间和温度的影响 离子注入 :a 通过高压离子轰击把杂质引入硅片b 现代晶片制造中几乎所有掺杂工艺都是使用离子注入 2. 列举半导体制造中常用的四种杂质,并说明是N 型还是P 型。
镓P3. 扩散发生需要的两个必要的条件 浓度差、过程所必须得能量4. 热扩散的三个步骤,以及它们的作业预淀积 :为整个扩散过程建立浓度梯度、炉温一般800~1000 0C推进:将由预淀积引入的杂质作为扩散源,在高温下进行扩散。
目的是为了控制表面浓 度和扩散深度 1000~1250 0C 激活:稍为升高炉温,使杂质原子与晶格中的硅原子键合5. * 离子注入的优缺点 离子注入的优点:精确控制杂质含量、很好的杂质均匀性、对杂质穿透深度有很好的控 制、产生单一离子束、低温工艺、注入的离子能穿过薄膜、无固溶度极限 离子注入的主要缺点:a ) 高能杂质离子轰击硅原子将对晶体结构产生损伤(可用高温退火进行修复)b ) 注入设备的复杂性 (这一缺点被注入机对剂量和深度的控制能力及整体工艺的灵活 性弥补) 6. 重要的离子输入参数 剂量、射程O21.7. 剂量和能量的公式Q=(It)/(enA)I 为束流,单位是库仑每秒(安培)t 为注入时间,单位是秒e 是电子电荷,等于1.6 x 10-19 库仑n是离子电荷(比如B+等于1)A 是注入面积,单位是cm28. 离子输入设备的5 个主要子系统离子源、引出电极(吸极)和离子分析器、加速管、扫描系统、工艺室9. 退火的目的是什么?高温退火和RTA哪个更优越退火能够加热被注入硅片,修复晶格缺陷;还能使杂质原子移动到晶格点,将其激活RTA更优越,此方法不会导致杂质的扩散,快速的升温过程和短暂的持续时间能够在晶格缺陷的修复、激活杂质和最小化杂质扩散三者间取得优化10. 描述沟道效益。
控制沟道效益的4 种方法当注入离子未与硅原子碰撞减速,而是穿透了晶格间隙时,就发生了沟道效应4 种方法:倾斜硅片、掩蔽氧化层、硅预非晶化、使用质量较大的原子11. 列举10 个使用离子注入的掺杂工艺深埋层、倒掺杂阱、穿通阻挡层、阈值电压调整、轻掺杂漏区(LDD)、源漏注入、多晶硅栅、沟槽电容器、超浅结、绝缘体上硅(SOI)第八章光刻1. 光刻的概念及其本质光刻指的是将图形转移到一个平面的任一复制过程光刻的本质是把临时电路结构复制到以后要进行刻蚀和离子注入的硅片上2. *光刻工艺的8 个基本步骤气相成底膜、旋转涂胶、软烘、对准和曝光、曝光后烘焙、显影、坚膜烘焙、显影检查3. 光刻胶的概念以及其目的光刻胶的概念:一种有机化合物,受紫外光曝光后,在显影液中的溶解度会发生变化 光刻胶的目的a ) 将掩模版图案转移到硅片表面顶层的光刻胶中b )在后续工艺中,保护光刻胶下面的材料(如刻蚀或离子注入的阻挡层) 光刻胶显影参数显影温度、显影时间、显影液量、当量浓度、清洗、排风、硅片吸盘*正胶和负胶的显影结果正性光刻胶:曝光区域溶解于显影液,显影后图形与掩模版图形一样 负性光刻胶:曝光区域不溶解于显影液,显影后图形与掩模版图形相反 常用于光学光刻的两种紫外光源 汞灯 准分子激光反射切口、驻波的概念,抗反射涂层的作用反射切口:在刻蚀形成的垂直侧墙表面,反射光入射到不需要曝光的光刻胶中就会形成 反射切口 驻波的概念:入射光与反射光发射干涉引起、弓I 起随光刻胶厚度变化的不均匀曝光 抗反射涂层的作用:减小光反射和阻止光干涉 NA处中."表示特殊应用的因子’范間是0 6七&化土光源的波长NA =曝光系统的数值孔径这,公式表示在光空屮疔三个参数崽响分琲光划腔上儿何图形胸陡力:1+波长丸N 数值孔径MA 3.工艺因子k9. 从早期的硅片制造以来光刻设备可分为哪五代?列举任意两种的优越点接触式光刻机、接近式光刻机、扫描投影光刻机、分步重复光刻机、步进扫描光刻机 接触式光刻机:图像失真小,图形分辨率高接近式光刻机:掩模版不与光刻胶直接接触,大大减小了沾污 10. 可能成功代替光学光刻技术的 4种光刻技术极紫外(EUV )光刻技术角度限制投影电子束光刻技术(SCALPEL 离子束投影光刻技术(IPL ) X 射线光刻技术 第九章刻蚀1. 刻蚀的概念及基本目的刻蚀:用化学或物理方法有选择地从硅片表面去除不需要的材料的过程 基本目的:在涂胶的硅片上正确地复制掩模图形 2. 两种基本的刻蚀工艺干法刻蚀、湿法腐蚀3. 等离子体的概念 等离子体又叫做电浆, 是由部分电子被剥夺后的原子及原子被电离后产生的正负4. 5. 6. 7. 8.*分辨率的概念以及计算电子组成的离子化气体状物质,它广泛存在于宇宙中,常被视为是除去固、液、气外,物质存在的第四态。