张焱森 半导体电阻率测量实验
- 格式:docx
- 大小:1.88 MB
- 文档页数:11

材料物理性能实验六四探针法测半导体电阻率引言:材料的电阻率是衡量材料导电性能的重要指标之一、在半导体材料中,由于带电载流子的特殊特性,其电阻率与探测方法有一定的关联。
因此,对于半导体材料的电阻率测试与分析是十分关键的。
实验目的:通过四探针法测量半导体样品的电阻率,分析半导体电阻率的特点。
实验器材与材料:1.半导体样品2.四探针测试仪3.电源4.万用表5.连接线实验步骤:1.将四探针测试仪的四个探针插入半导体样品的表面,探针之间应呈正方形或矩形排列,并保持一定的间距。
2.打开四探针测试仪,选择合适的电流和电压范围,并进行零点校准。
3.调节电源,使电流通过半导体样品。
4.采集电压和电流的数值,并记录下来。
5.换一个电流方向,重复步骤46.将采集到的数据带入电阻率的计算公式,并计算出半导体样品的电阻率。
7.执行多次实验,取平均值得到更准确的结果。
数据处理:根据步骤6,将采集到的电压和电流数值带入下面的公式计算半导体样品的电阻率:ρ=(V*a)/(I*l)其中,ρ为电阻率,V为电压,I为电流,a为电流方向上的电流距离,l为垂直电流方向上的电流距离。
讨论与分析:通过实验测量得到的半导体样品的电阻率与其物理性质有关。
半导体的电阻率通常较高,且受温度的影响较大。
在常温下,半导体的电阻率通常较大,因为带电载流子在晶体内处于散乱运动的状态,导致电阻增大。
当温度升高时,带电载流子的能量增大,散射减少,电阻率减小。
此外,不同类型的半导体(n型或p型)其电阻率也有所不同。
实验注意事项:1.进行四探针法测量时,应保持探针与半导体样品的接触良好,防止有氧化层或其他杂质影响测量结果。
2.在调节电流和电压范围时,应注意不要超过半导体样品所能承受的最大值,以免损坏样品。
3.进行多次实验取平均值时,应尽量保持实验条件的一致性,以获得准确的结果。
结论:通过实验测量得到的半导体样品电阻率可用于分析半导体的导电特性。
半导体的电阻率通常较高且温度敏感。

半导体热敏电阻特性研究实验报告半导体热敏电阻特性研究实验报告引言:半导体热敏电阻是一种基于半导体材料的温度敏感性元件,其电阻值随温度的变化而变化。
本实验旨在研究半导体热敏电阻的特性,并探索其在温度测量和控制中的应用。
实验一:热敏电阻与温度关系的测量在本实验中,我们选择了一种常见的热敏电阻材料,并使用了恒流源和数字温度计来测量其电阻值与温度之间的关系。
首先,我们将热敏电阻与恒流源相连,并将电流保持在恒定值。
然后,我们使用数字温度计测量不同温度下的电阻值。
通过多次测量,我们得到了一组电阻-温度数据。
根据实验数据,我们绘制了电阻-温度曲线。
结果显示,热敏电阻的电阻值随温度的升高而下降,呈现出明显的负温度系数特性。
这意味着热敏电阻在高温下具有较低的电阻值,在低温下具有较高的电阻值。
实验二:热敏电阻在温度测量中的应用在实验一的基础上,我们进一步探索了热敏电阻在温度测量中的应用。
我们设计了一个简单的温度测量电路,将热敏电阻与电压源和电压测量仪相连。
通过测量电压测量仪的输出电压,我们可以间接地推算出热敏电阻的电阻值,从而得知温度。
实验结果表明,该方法能够较准确地测量温度,且具有较高的灵敏度和稳定性。
实验三:热敏电阻在温度控制中的应用除了温度测量,热敏电阻还可以应用于温度控制。
我们设计了一个简单的温度控制电路,其中包括热敏电阻、比较器和加热元件。
当温度超过设定阈值时,热敏电阻的电阻值会下降,导致比较器输出高电平信号,进而控制加热元件的工作。
当温度降低到设定阈值以下时,热敏电阻的电阻值上升,比较器输出低电平信号,停止加热。
实验结果表明,该温度控制电路能够实现对温度的自动控制,具有较高的精度和稳定性。
这种基于热敏电阻的温度控制方法在实际应用中具有广泛的潜力。
结论:通过本次实验,我们研究了半导体热敏电阻的特性,并探索了其在温度测量和控制中的应用。
实验结果表明,热敏电阻具有良好的温度敏感性能,可广泛应用于各种温度相关的领域。


半导体物理实验指导书(材料学专业)许德富乐山师范学院物理与电子工程学院实验一、四探针法测量高导电率材料的电导率一.前言在科研和现今社会生活的许多场合,大量使用导电材料和电阻合金。
监测电阻或导电率随外界条件的变化也是材料的相变研究、环境的温度、湿度、气氛等的监测和控制的重要手段。
材料精确的电阻或电阻率数据以及了解不同电场条件下电流在不同尺寸、不同形状的导体中的分布在电子电路以及其它工程设计中也是必不可少的。
因此材料以及电功能器件的电阻或电阻率的精确测量成为了重要的物理实验之一,也是工程技术人员必须掌握的基本技能。
电阻率所针对的对象是导电或电阻材料,一般是通过测定特定形状的材料电阻值后计算得出。
对于功能器件一般只测量其电阻值。
而环境(温度、湿度、气氛)或材料状态对电阻或电阻率的影响测量则一般是将材料或器件放于特定的环境之中,通过改变环境参数测定电阻或电阻率的变化。
上述所有操作归结为一点,即电阻的测量。
由于目前还没有不使用电而间接精确测量电阻的方法,因此电阻与其它物理参数测量相比的最突出特点是必须将被测材料或器件连接在电路之中,电路之中的导线、导线接头或器件触点接触电阻、测量仪表的内阻以及与被测电阻间的连接关系,阻值比例等多种因素都会对影响测量结果的精确度。
在许多情况下,测量误差是不可忽略的。
为了提高电阻测量的精确度,对于不同阻值范围的材料或器件设计了不同的测量方法。
例如采用三电极系统测量MΩ级以上的高电阻,采用电桥法测量Ω和KΩ级的电阻等。
但在高导电率材料或小电阻器件的电阻测量之中,不仅电路中的接触电阻不可以忽略不计,甚至导线的电阻都不是无穷小量。
而在电桥测量方法中也难以找到与被测电阻值相当的小电阻与之相匹配。
有些试样的尺寸很小(薄膜)或很大(大块样品或大尺寸板状样品)又不允许拆剪成合适尺寸时更是如此。
近代物理学中,对于微电阻或小电阻,特别是电阻率的测量,常使用四点探针(Four point probe)来完成。

半导体电阻率测量实验201509064272 张焱森一、实验目的通过用四探针法测量半导体晶片的电阻率,了解半导体材料的基本电学特性与材料中载流子浓度和迁移率的关系,掌握一种测量半导体材料的电阻率并进一步分析其掺杂浓度的实验研究方法。
二、实验原理一、半导体电阻率及主要影响因素半导体是一种导电能力介于导体和绝缘体之间的材料,固体材料按导电能力的分类见表3.2-1。
完全不含杂质且无晶格缺陷的纯净半导体称为本征半导体,其导电能力主要由材料的本征激发决定,通常电阻率偏大且很难调控其电学性质,因此本征半导体材料用途范围很小。
表3.2-1 材料按导电能力的分类杂质与缺陷对半导体材料的性能有很大的影响,它们在很大程度上决定了半导体材料的电学性质,通过控制杂质的加入量即可控制半导体材料的导电性能。
以硅为例,对于理想的单晶硅材料来说,它的晶体结构呈金刚石结构,每一个硅原子与相邻的四个原子之间共用电子形成共价键。
对于这种理想结构的半导体材料,由于可以自由移动的电荷很少,因此导电性较弱。
图3.2-1 半导体材料硅的掺杂示意图 如果采用磷元素掺杂,一个磷原子取代硅原子在晶体中的位置,由于磷原子有5个价电子,形成1个多余的价电子和正电中心磷离子(见图3.2-1)。
多余的价电子很容易挣脱正电中心的束缚进入导带,成为导电电子在晶格中自由运动。
像磷这样的五价元素在硅中电离时,能够释放出导电电子并形成正电中心,称它们为施主杂质或N 型杂质。
对掺有施主杂质的半导体材料,导电主要靠导带电子进行,这种半导体称为N 型半导体。
如果采用三价元素硼进行掺杂,将形成负电中心硼离子和一个空位。
这个空位很容易从价带获得一个价电子成键,在价带中形成一个空穴。
这种能从价带得到电子的杂质原子称为受主杂质或P 型杂质。
对掺有受主杂质的半导体材料,导电主要靠空穴进行,这种半导体称为P 型半导体。
图3.2-2 300K 温度下硅半导体材料的电阻率与杂质浓度的关系曲线电阻率ρ的大小决定于半导体载流子浓度n 和载流子迁移率μ:1/n q ρμ=,其中q 为电子电荷,载流子浓度n 和载流子迁移率μ均与杂质浓度和温度有关,所以半导体电阻率随杂质浓度和温度而异。
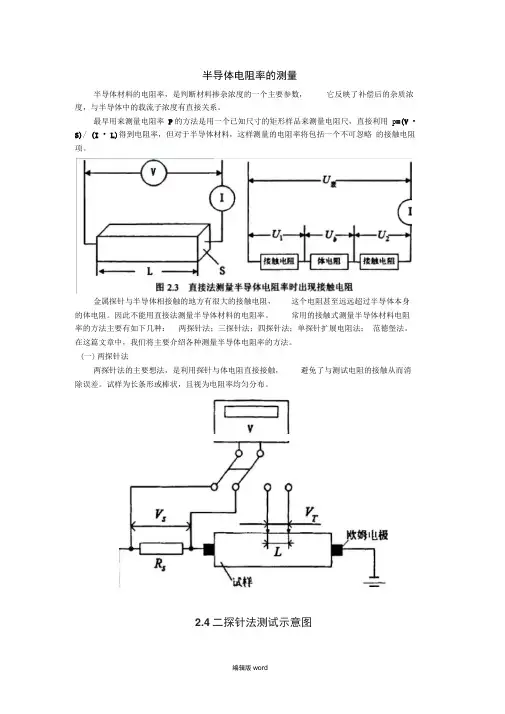
半导体电阻率的测量半导体材料的电阻率,是判断材料掺杂浓度的一个主要参数,它反映了补偿后的杂质浓度,与半导体中的载流子浓度有直接关系。
最早用来测量电阻率P的方法是用一个已知尺寸的矩形样品来测量电阻尺,直接利用p=(V • S)/ (I • L)得到电阻率,但对于半导体材料,这样测量的电阻率将包括一个不可忽略的接触电阻项。
金属探针与半导体相接触的地方有很大的接触电阻,这个电阻甚至远远超过半导体本身的体电阻。
因此不能用直接法测量半导体材料的电阻率。
常用的接触式测量半导体材料电阻率的方法主要有如下几种:两探针法;三探针法;四探针法;单探针扩展电阻法;范德堡法。
在这篇文章中,我们将主要介绍各种测量半导体电阻率的方法。
(一)两探针法两探针法的主要想法,是利用探针与体电阻直接接触,避免了与测试电阻的接触从而消除误差。
试样为长条形或棒状,且视为电阻率均匀分布。
2.4二探针法测试示意图利用高阻抗的电压计测量电阻上的电压从而得到流过半导体的电流,再利用电压计测得 半导体上流过单位长度的电压压降,再测得长度L ,从而得到p = (V*S ) /(l*L ),S 为试样表 面积。
(二)三探针法三探针法适用于测量相同导电类型, 低阻衬底的外延层材料的电阻率。
该方法是利用金 属探针与半导体材料接触处的反向电流. 电压特性、测定击穿时的电压来获得材料电阻率的知识的。
金半接触反向偏置时, 外电压几乎全部降在接触处,空间电荷区中电场很大, 载流 子在电场作用下与晶格原子发生碰撞电离。
随着外电场增加,发生雪崩击穿,击穿电压与掺 杂浓度有关,具体关系由经验公式给出,再根据电阻率与杂质浓度的关系图线, 从而可以得到材料的电阻率。
(三)四探针法直线四探针法是用针距约为 1毫米的四根探针同时压在样品的平整表面上,。
利用恒流 源给I 、4探针通以一个小电流,然后用高输入阻抗的电位差计、电子毫伏计或数字电压表 测量电压。
利用高阻值电压计测得 2、3探针间的电压值, 从而根据公式 尸V 23 *C/I 。

半导体热敏电阻的电阻—温度特性实验原理 1. 半导体热敏电阻的电阻—温度特性:某些金属氧化物半导体(如:Fe3O4、MgCr2O4 等)的电阻与温度的关系满足式(1)RT = R∞ eB T(1)式中 RT 是温度为 T 时的热敏电阻阻值,R∞ 是 T 趋于无穷时热敏电阻的阻值①,B 是热敏电阻的材料常数, T 为热力学温度。
热敏电阻对温度变化反应的灵敏度一般由电阻温度系数α来表示。
根据定义,电阻温度系数可由式(2)来决定:α=1 dRT RT dT(2)由于这类热敏电阻的α值为负,因此被称为负温度系数(NTC)热敏电阻,这也是最常见的一类热敏电阻。
2. 惠斯通电桥的工作原理半导体热敏电阻的工作阻值范围一般在 1~106Ω,需要较精确测量时常用电桥法,惠斯通电桥是一种应用很广泛的仪器。
惠斯通电桥的原理如图 1 所示。
四个电阻 R0 、 R1 、R2 和 R x 组成一个四边形,其中 R x 就是待测电阻。
在四边形的一对对角 A 和C 之间连接电源;而在另一对对角 B 和 D 之间接入检流计 G。
当 B 和 D 两点电势相等时,G 中无电流通过,电桥便达到了平衡。
平衡时必D R1 RxSGAGCR2 R B ER0Sb图 1 惠斯通电桥原理图图 2 惠斯通电桥面板图①由于(1)式只在某一温度范围内才适用,所以更确切的说R∞ 仅是公式的一个系数,而并非实际 T 趋于无穷时热敏电阻的阻值。
有 Rx =R1 R R0 , 1 和 R0 都已知, R x 即可求出。
R0 为标准可变电阻,由有四个旋钮的电 R2 R2阻箱组成,最小改变量为 1Ω。
R1 称电桥的比率臂,由一个旋钮调节,它采用十进制固定 R2值,共分 0.001,0.01,0.1,1,10,100,1000 七挡。
测量时应选择合适的挡位,保证测量值有 4 位有效数。
电桥一般自带检流计,如图 2 所示,如果有特殊的精度要求也可外接检流计,本实验采用外接的检流计来判断电桥的平衡。


半导体实验报告
《半导体实验报告》
摘要:
本实验旨在研究半导体材料的电学性质,通过测量半导体材料的电阻率和载流子浓度,探讨其在电子学领域的应用。
实验结果表明,半导体材料具有较高的电阻率和可控制的载流子浓度,适用于制作各种电子器件。
引言:
半导体材料是一种介于导体和绝缘体之间的材料,具有独特的电学性质。
在现代电子学领域,半导体材料被广泛应用于各种器件中,如晶体管、二极管等。
本实验旨在通过测量半导体材料的电阻率和载流子浓度,探讨其在电子学领域的应用。
实验方法:
1. 准备实验所需的硅片样品和测量设备。
2. 测量不同温度下硅片的电阻率,并绘制电阻率随温度变化的曲线。
3. 通过霍尔效应测量硅片中的载流子浓度,并计算出载流子浓度的大小。
实验结果:
1. 实验结果表明,硅片的电阻率随温度的变化呈现出一定的规律性,且在一定温度范围内变化较小。
2. 通过霍尔效应测量得到硅片中的载流子浓度为10^16 cm^-3,说明硅片中的载流子浓度较高。
讨论:
根据实验结果,可以得出以下结论:
1. 半导体材料的电阻率随温度的变化较小,适用于制作稳定性较高的电子器件。
2. 半导体材料具有较高的载流子浓度,可以通过控制载流子浓度来实现对器件
性能的调节。
结论:
本实验通过测量半导体材料的电阻率和载流子浓度,得出了半导体材料在电子
学领域的应用潜力。
半导体材料具有稳定的电学性质,适用于制作各种电子器件,对于现代电子学领域具有重要的意义。

实验三 四探针法测量半导体电阻率、薄层电阻一. 实验目的与意义电阻率是半导体材料的重要电学参数,它能反映半导体内浅能级替位杂质的浓度。
薄层电阻是用来表征半导体掺杂浓度的一个重要工艺参数,也可用来表示半导体薄膜的导电性。
测量电阻率和薄层电阻的方法有很多种,如二探针法、扩展电阻法等。
而四探针法是目前广泛采用的标准方法,它具有操作方便,精度较高,对样品的几何形状无严格要求等优点。
本实验的目的是使学生掌握四探针法测量半导体电阻率和薄层电阻原理、方法;熟悉四探针测试仪;并能针对半导体样品的不同几何尺寸进行测量数值的修正。
二. 实验原理设样品电阻率ρ均匀,样品几何尺寸相对于探针间的距离可看成半无穷大。
引入点电流源的探针其电流强度为I ,则所产生的电力线有球面对称性,即等位面是以点电流源为中心的半球面,如图3-1所示。
在以r 为半径的半球上,电流密度j 的分布是均匀的。
图3-1 探针与被测样品接触点的电流分布22rIj π=(3-1) 若E 为r 处的电场强度,则22r I j E πρρ== (3-2) 取r 为无穷远处的电位ф为零,并利用 drd E φ-=,则有:⎰⎰⎰∞∞-=-=)(022r rr r drI Edr d ϕπρϕ (3-3) ()rIr πρφ2=(3-4) Ir式(3-2)就是半无穷大均匀样品上离开点电流源距离r 的点的电位与探针流过的电流和样品电阻率的关系式,它代表了一个点电流对距离为r 处的点的电势的贡献。
图3-2 四根探针与样品接触示意图对于图3-2所示的情形,四根探针位于样品中央,电流从探针1流入,从探针4流出,则可将1和4探针认为是点电流源,由式(3-3)得到探针2和3的电位为:⎪⎪⎭⎫ ⎝⎛-=24122112r r I πρϕ (3-5)⎪⎪⎭⎫⎝⎛-=34133112r r I πρϕ (3-6) 探针2、3电位差为:3223ϕϕ-=V ,由此得出样品电阻率为:I V C r r r r I V 231341324122311112=⎪⎪⎭⎫⎝⎛+--=-πρ (3-7) 式(3-7)就是利用直流四针探法测量电阻率的普遍公式。

测量半导体材料电阻率的实验操作指南实验目的:通过测量半导体材料的电阻率,了解其导电性质,为半导体物理实验提供基础数据。
实验器材:1. 数字电压表2. 恒流源3. 多用途电路板4. 导线5. 半导体样品(如硅)6. 实验电源实验步骤:1. 实验准备:a. 将实验电源连接到电路板上,并将电路板插入电源插座。
b. 将恒流源连接到实验电路板上的恒流插座,并将电流设置为合适的数值。
c. 使用导线将数字电压表连接到电路板上的电压测量插座。
2. 样品准备:a. 将半导体样品清洁干净,并确保无尘或油污附着。
b. 使用绝缘胶套将样品夹持在电路板上,确保电流不会泄漏。
3. 测量电阻率:a. 打开实验电源,确保电路正常工作。
b. 使用电流源提供稳定的恒定电流。
c. 使用数字电压表测量样品上的电压。
d. 记录电流值和相应的电压值。
e. 反复测量几组数据,确保结果的准确性和可靠性。
4. 分析结果:a. 根据测得的电流和电压值,计算样品的电阻值。
b. 根据电阻值和样品的几何尺寸参数,计算出样品的电阻率。
c. 分析数据,观察不同条件下半导体材料的电阻率变化。
注意事项:1. 在操作实验电源时,务必按照正确的步骤操作,避免电流过大或其他不安全因素导致的意外。
2. 在夹持样品时,应确保样品与电路板的接触良好,避免接触不良对结果的影响。
3. 测量过程中应注意防止任何外部因素对实验结果的干扰,如电磁波、温度变化等。
实验结果的分析和讨论:通过实验测量得到的电阻率数据可以用于探索半导体材料的导电机制及其特性。
通过对不同条件下的测量数据进行分析和比较,我们可以得到以下结论:1. 不同温度下的电阻率变化:通过调节实验条件中的温度,我们可以研究半导体材料的温度依赖性质。
随着温度升高,电阻率可能会增加或减小,这取决于半导体材料的类型以及其杂质等级。
2. 光照对电阻率的影响:光照可以改变半导体材料的电子能带结构,从而影响其导电性质。
通过将样品置于不同光照条件下进行测量,我们可以研究半导体的光敏特性。
实验报告一、实验目的和任务1、掌握四探针法测量半导体材料方阻的基本原理和方法;2、掌握半导体电阻率的测量方法。
二、实验原理测试原理:直流四探针法测试原理简介如下: ⑴体电阻率测量:图1 四探针法测量原理图当 1、2、3、4 四根金属探针排成一直线时,并以一定压力压在半导体材料上时,在 1、4 两根探针间通过电流 I ,则在 2、3 探针间产生电位差 V 。
材料电阻率 ()VCcm Iρ=Ω⋅ (1) 式中 C 为探针修正系数,由探针的间距决定。
当试样电阻率分布均匀,试样尺寸满足半无穷大条件时()12122321111C cm S S S S S S π=+--++ (2)三、实验设备SX1934 型数字式四探针测试仪1、电气原理SX1944 型数字式四探针测试仪电气部分原理方框图如图2 所示。
图22、结构特征仪器根据测试需要,可安放在一般工作台上或者手持。
探头经过精密加工,探针为耐磨材料碳化钨所制成,配用宝石导套,使测量误差大为减少,且可以提高寿命。
探头内有弹簧压力装置,测试架内还有高度粗调、细调及压力自锁装置。
主机为仪器主要电气部分所在,在其面板结构如图3 所示。
图3 面板示意图1、数字显示板;2 、电阻率/ 方块电阻选择按键;3、电阻率或方块电阻/电流选择按键;4 、电流极性选择按键;5、电流量程按键;6 、电流粗调;7、电流细调;8 、探头插座;主机后盖板设有交流220V 电源插座和保险丝座。
如图 4 所示。
图4 主机后盖板示意图四、实验结论这次实验通过四探针法测量不同尺寸硅片的电阻率和方块电阻,掌握四探针法测量半导体材料方阻的基本原理和方法和半导体电阻率的测量方法。
本次实验由于是在电脑用软件联机操作,所以操作较为简单使用,测试前无需根据样品电阻率决定电流量程,使用“自动电流量程”功能自动选择合适,软件告知测试电流应设置为多少。
将 SX1944 四探针测试仪的探头压在被测样品表面,让探针与样品接触良好,此时应注意探头不要压的太低,避免损坏探头。
《半导体物理》实验指导书(2022年版)半导体物理实验指导书信息工程学院电子科学与技术教研室2022目录实验一:霍尔效应1实验二:四探针法测量半导体电阻率及薄层电阻6实验三:椭偏法测薄膜厚度和折射率9附录A:《RTS-8型双电测四探针测试仪用户手册》11附录B:《WJZ/WJZ-Ⅱ型多功能激光椭圆偏振仪使用手册》30I实验一霍尔效应一、实验目的1.了解霍尔器材对材料要求的知识;2.学习用“对称测量法”消除副效应的影响,测量试样的VH~IS曲线;3.学会确定试样的导电类型,载流子浓度以及电导率。
二、仪器设备QS-H型霍尔效应实验组合仪三、实验原理1.导体材料霍尔系数的确定由霍尔电压VH与磁感应强度B的关系,VHB和d,可计算出霍尔系数RHISB知,只要测出VH以及知道IS、dRHVHd(1)ISB2.导体材料导电类型的确定若实验中能测出IS、B的方向,就可判断VH的正负,决定霍尔系数的正负,从而判断出半导体的导电类型。
当RH0时,样品属N型(载流子为电子),反之则为P型(载流子为空穴)。
3.导体材料载流子浓度的确定由霍尔系数RH如果知道VH、IS、B,就可确定该材料的载流子浓度。
根据电导率与载流子浓度n以及迁移率之间的关系ne知,通过实验测出值即可求出1VHd,可得neISBIBnS(2)VHdeRH(3)4.霍尔组件对材料的要求根据上述可知,要得到大的霍尔电压,关键是要选择霍尔系数大(即迁移率高、电阻率亦较高)的材料。
因RH,就金属导体而言,和均很低,而不良导体虽高,但极小,因而上述两种材料的霍尔系数都很小,不能用来制造霍尔组件。
半导体高,适中,是制造霍尔元件较理想的材料,由于电子的迁移率比空穴的迁移率大,所以霍尔元件都采用N型材料,其次霍尔电压的大小与材料的厚度成反比,因此薄膜型的霍尔组件的输出电压较片状要高得多。
5.实验中的副效应及其消除方法在产生霍尔效应的同时,还存在一些与温度、电极与半导体接触处的接触电阻有关的效应,这些效应也会在霍尔元件的上下侧面产生电位差。
半导体物理实验报告《半导体物理实验报告》摘要:本实验通过测量半导体材料的电阻率和霍尔系数,研究了半导体的电学性质。
实验结果表明,半导体材料的电阻率随温度的变化呈现出特定的规律,而霍尔系数则与半导体材料的载流子类型和浓度有着密切的关系。
通过实验数据的分析,我们得出了半导体材料的电子迁移率和载流子浓度的数值,并对半导体的电学特性进行了深入的研究。
引言:半导体材料因其在电子学领域的重要应用而备受关注。
通过对半导体材料的电学性质进行研究,可以深入了解其内在的物理机制,为半导体器件的设计和制备提供重要的参考。
本实验旨在通过测量半导体材料的电阻率和霍尔系数,研究半导体的电学性质,并对实验结果进行分析和讨论。
实验方法:1. 准备实验所需的半导体样品和测量设备;2. 测量半导体样品在不同温度下的电阻率,并绘制出电阻率随温度变化的曲线;3. 使用霍尔效应测量半导体样品的霍尔系数,并计算出半导体的载流子类型和浓度;4. 对实验数据进行分析,得出半导体材料的电子迁移率和载流子浓度的数值。
实验结果和讨论:通过实验测量和数据分析,我们得出了半导体材料的电阻率随温度变化的规律,以及半导体的载流子类型和浓度。
实验结果表明,半导体材料的电阻率随温度的升高呈现出指数型的变化规律,这与半导体材料的能带结构和载流子浓度有着密切的关系。
同时,霍尔系数的测量结果也表明,半导体材料的载流子类型和浓度对其电学性质有着重要的影响。
通过对实验数据的分析,我们得出了半导体材料的电子迁移率和载流子浓度的数值,并对半导体的电学特性进行了深入的研究。
结论:本实验通过测量半导体材料的电阻率和霍尔系数,研究了半导体的电学性质,得出了半导体材料的电子迁移率和载流子浓度的数值,并对半导体的电学特性进行了深入的研究。
实验结果对于深入了解半导体材料的内在物理机制,以及为半导体器件的设计和制备提供了重要的参考。
实验二半导体电阻率和方阻测量的研究一、实验意义电阻率是半导体材料的重要电学参数之一, 可以反映出半导体内浅能级替位杂质浓度,薄层电阻是表征半导体掺杂浓度的一个重要工艺参数。
测量电阻率与薄层电阻的方法很多,如二探针法、扩展电阻法等。
而四探针法是目前广泛采用的标准方法,它具有操作方便,精度较高,对样品的几何形状无严格要求等特点。
二、实验目的1、了解四探针电阻率测试仪的基本原理;2、了解的四探针电阻率测试仪组成、原理和使用方法;3、能对给定的物质进行实验,并对实验结果进行分析、处理。
三、实验原理测量 原理:将四根排成一条直线的探针以一定的压力垂直地压在被测样品表面上,在 1、4 探针间通以电流 I(mA),2、3 探针间就产生一定的电压 V(mV)(如图1)。
测量此电压并根据测量方式和样品的尺寸不同,可分别按以下公式计算样品的电阻率、方块电阻、电阻: `①. 薄圆片(厚度≤4mm)电阻率:图1.直线四探针法测试原理图 ↓4↑⨯=IVρF (D/S )╳F (W/S )╳W ╳Fsp Ω·cm …(1) 其中:D —样品直径,单位:cm 或mm ,注意与探针间距S 单位一致;S —平均探针间距,单位:cm 或mm ,注意与样品直径D 单位一致(四探针头合格证上的S 值); W —样品厚度,单位:cm ,在F(W/S)中注意与S 单位一致; Fsp —探针间距修正系数(四探针头合格证上的F 值);F(D/S)—样品直径修正因子。
当D →∞时,F(D/S)=4.532,有限直径下的F(D/S)由附表B 查出: F(W/S)—样品厚度修正因子。
W/S<0.4时,F(W/S)=1;W/S>0.4时,F(W/S)值由附表C 查出; I —1、4探针流过的电流值,选值可参考表5.2(第6页表5.2); V —2、3探针间取出的电压值,单位mV ;②. 薄层方块电阻R□:R□=⨯IVF (D/S )╳F (W/S )╳Fsp Ω/□…(2) 其中:D —样品直径,单位:cm 或mm ,注意与探针间距S 单位一致;S —平均探针间距,单位:cm 或mm ,注意与样品直径D 单位一致(四探针头合格证上的S 值); W —样品厚度,单位:cm ,在F(W/S)中注意与S 单位一致; Fsp —探针间距修正系数(四探针头合格证上的F 值);F(D/S)—样品直径修正因子。
半导体霍尔系数与电导率测量13应用物理(1)班 杨礴 2013326601111一、实验目的1.了解霍尔效应实验原理以及有关霍尔器件对材料要求的知识2.测量试样的导电类型、载流子浓度以及迁移率二、实验原理霍尔效应的测量是研究半导体性质的重要实验方法。
利用霍尔效应,可以确定半导体的导电类型和载流子浓度。
利用霍尔系数和电导率的联合测量,可以用来研究半导体的导电机制(本征导电和杂质导电)和散射机制(晶格散射和杂质散射),进一步确定半导体的迁移率、禁带宽度、杂质电离能等基本参数。
测量霍尔系数随温度的变化,可以确定半导体的禁带宽度、杂质电离能及迁移率的特性。
1、 霍尔效应和霍尔系数设一块半导体的x 方向上有均匀的电流流过,在z 方向上加有磁场,则在这块半导体的y 方向上出现一横向电势差,这种现象被称为“霍尔效应”, 称为“霍尔电压”,所对应的横向电场称为“霍尔电场”。
霍尔电场强度的大小与流经样品的电流密度和磁感应强度的乘积成正比:式中比例系数称为“霍尔系数”。
半导体样品的长、宽、厚分别为l 、a 、b ,半导体载流子(空穴)的浓度为p ,它们在电场作用下,以平均漂移速度沿x 方向运动,形成电流。
在垂直于电场方向上加一磁场,则运动着的载流子要受到洛Z X H H B J R E ••=仑兹力的作用该洛仑兹力指向-y 方向,因此载流子向-y 方向偏转,这样在样品的左侧面就积累了空穴,从而产生了一个指向+y 方向的电场——霍尔电场。
当该电场对空穴的作用力q 与洛仑兹力相平衡时,空穴在y 方向上所受的合力为零,达到稳态。
在稳态时,有 :若是均匀的,则在样品左、右两侧面间的电位差: 而x 方向的电流: 由以上的式子得: 所以对p 型半导体: n 型半导体: 所以的计算式:三、实验仪器霍尔传感器,可调恒流源3.5A ,可调恒流源10mA ,电磁线圈5A四、实验内容1.测量霍尔电压V H 和霍尔电流I S 的关系(1)按要求连接导线。
半导体电阻率测量实验201509064272 张焱森一、实验目的通过用四探针法测量半导体晶片的电阻率,了解半导体材料的基本电学特性与材料中载流子浓度和迁移率的关系,掌握一种测量半导体材料的电阻率并进一步分析其掺杂浓度的实验研究方法。
二、实验原理一、半导体电阻率及主要影响因素半导体是一种导电能力介于导体和绝缘体之间的材料,固体材料按导电能力的分类见表3.2-1。
完全不含杂质且无晶格缺陷的纯净半导体称为本征半导体,其导电能力主要由材料的本征激发决定,通常电阻率偏大且很难调控其电学性质,因此本征半导体材料用途范围很小。
表3.2-1 材料按导电能力的分类杂质与缺陷对半导体材料的性能有很大的影响,它们在很大程度上决定了半导体材料的电学性质,通过控制杂质的加入量即可控制半导体材料的导电性能。
以硅为例,对于理想的单晶硅材料来说,它的晶体结构呈金刚石结构,每一个硅原子与相邻的四个原子之间共用电子形成共价键。
对于这种理想结构的半导体材料,由于可以自由移动的电荷很少,因此导电性较弱。
图3.2-1 半导体材料硅的掺杂示意图 如果采用磷元素掺杂,一个磷原子取代硅原子在晶体中的位置,由于磷原子有5个价电子,形成1个多余的价电子和正电中心磷离子(见图3.2-1)。
多余的价电子很容易挣脱正电中心的束缚进入导带,成为导电电子在晶格中自由运动。
像磷这样的五价元素在硅中电离时,能够释放出导电电子并形成正电中心,称它们为施主杂质或N 型杂质。
对掺有施主杂质的半导体材料,导电主要靠导带电子进行,这种半导体称为N 型半导体。
如果采用三价元素硼进行掺杂,将形成负电中心硼离子和一个空位。
这个空位很容易从价带获得一个价电子成键,在价带中形成一个空穴。
这种能从价带得到电子的杂质原子称为受主杂质或P 型杂质。
对掺有受主杂质的半导体材料,导电主要靠空穴进行,这种半导体称为P 型半导体。
图3.2-2 300K 温度下硅半导体材料的电阻率与杂质浓度的关系曲线电阻率ρ的大小决定于半导体载流子浓度n 和载流子迁移率μ:1/n q ρμ=,其中q 为电子电荷,载流子浓度n 和载流子迁移率μ均与杂质浓度和温度有关,所以半导体电阻率随杂质浓度和温度而异。
300K 温度下硅半导体材料的电阻率与杂质浓度的关系曲线如图3.2-2所示。
轻掺杂时(杂质浓度小于1016 cm -3),可以认为室温下杂质全部电离,载流子浓度近似等于杂质浓度,而迁移率随杂质的变化不大,可以认为是常数。
因而电阻率随杂质浓度成简单反比关系,在对数坐标图上近似为直线。
当杂质浓度增高时,曲线严重偏离直线,主要原因有二:一是杂质在室温下不能全部电离,在重掺杂的简并半导体中情况更加严重;二是迁移率随杂质浓度的增加将显著下降。
利用图3.2-2可以方便地进行硅半导体电阻率和杂质浓度的换算。
由于半导体的载流子浓度和迁移率随温度变化,因此电阻率受温度影响较大,图3.2-3所示为硅电阻率与温度关系曲线示意图。
在低温区(AB段),不仅由于杂质电离产生的载流子浓度随温度升高而增加,而且迁移率主要取决于杂质散射,它也随温度升高而增加,因此半导体材料的电阻率随温度升高显著下降。
在中温区(BC段),由于杂质已经全部电离,但本征激发尚不明显,载流子浓度基本不变,而迁移率主要受晶格散射影响,它会随温度升高而下降,因此半导体材料的电阻率随温度升高缓慢增加。
在高温区(C段),由于本征激发产生的载流子浓度随温度升高而急剧增加,使电导率增加的因素远远大于迁移率下降的影响,因此半导体材料的电阻率随温度升高急剧下降。
温度高到本征导电起主要作用时,一般器件就不能正常工作,它就是器件的最高工作温度,如硅器件的最高工作温度为250℃。
图3.2-3 硅电阻率与温度关系曲线示意图二、四探针法测量电阻率L. Valdes首先利用四探针法解决了测量任意形状半导体材料的电阻率的问题,他给出了半无限材料及不同类型边界条件(导电边界及绝缘边界)的解,其中包括探针与样品边界平行或垂直时的有限边界及样品有限厚度的修正系数与曲线。
此后,A. Uhlir全面考虑并计算了有限尺寸样品边界条件的修正。
F. Smith又将此法用来测量二维圆形及矩形的薄层材料的电阻(方块电阻)。
四探针法的测量范围为10-3~104Ω·cm,能分辨毫米级材料的均匀性,适用于测量半导体体材料、异型层、外延材料及扩散层、离子注入层的电阻率,并能够提供一个迅速的、不破坏的、较准确的测量。
图3.2-4 四探针法排列示意图四根金属探针排成一条直线,压在一块任意形状的、半无限大的半导体平坦表面上,如图3.2-4所示。
探针引入的点电流源的电流强度为I ,那么对于半无穷大样品上的这个点电流源而言,样品中的等电位面是一个球面,对于离开点电流源半径为r 的P 点,其电流密度j 可以表示为22Ij r π= (3.2-1)其中22r π为半球等位面的面积。
P 点的电场强度2()()2I dV r E r j r drρρπ===- (3.2-2) 式中ρ是材料的电阻率。
由于P 点电场强度()E r 的负值等于电势()V r 对位移的导数,若设无穷远处电位为零,则P 点处的电位1()()2r I V r E r dr rρπ∞=-=⎰ (3.2-3) 则当电流由探针1,4通过时,根据点源迭加原理,某一点的电位应是不同点源产生的电位的和,因此探针2,3的电位分别为:212322()I I V S S S ρρππ=-+ (3.2-4) 31232()2I I V S S S ρρππ=-+ (3.2-5) 所以探针2,3间的电位差为2312231211112I V V V S S S S S S ρπ⎛⎫∆=-=+-- ⎪++⎝⎭(3.2-6)若四探针在同一平面的同一直线上,且123S S S S ===时,由上式可得= 2VS I ρπ∆⎛⎫ ⎪⎝⎭。
(3.2-7) 这就是常见的直流等间距四探针法测电阻率的公式。
如果样品不是半无限导体,则由探针流入导体的电流为边界表面反射(非导电边界)或吸收(导电边界),结果分别使电压探针处的电位升高或降低。
因此,在这种情况下电阻率的测量值高于或低于材料的真实值,称为表观电阻率0ρ。
它与材料真实电阻率ρ的关系为0 =..C D ρρ, (3.2-8)式中..C D 称为修正因子或修正除数。
在非导电边界情况下,修正除数..C D 为 ..=1+2S S S C D M M W W W ⎡⎤⎛⎫⎛⎫- ⎪ ⎪⎢⎥⎝⎭⎝⎭⎣⎦, (3.2-9) 式中 ()112n M n λ∞=⎛⎫= ⎝∑。
(3.2-10) 当样品厚度W 与探针间距S 可以相比时,修正系数..C D 可以用函数N 来表示,.2ln 22S S S C D N N W W W ⎡⎤⎛⎫⎛⎫=+- ⎪ ⎪⎢⎥⎝⎭⎝⎭⎣⎦, (3.2-11) 式中 ()()()10122,n N iH i n λππλ∞==∑ (3.2-12) ()()10iH ix 是Hankel 函数。
当样品厚度W ≤2S 时,则 ()..2ln 2S C D W=。
(3.2-13) 代入式(3.2-8)得1 = 4.53,ln 2V V W W I Iρ∆∆≅ (3.2-14) 这就是常用的半导体晶片电阻率的测量公式。
在样品无限薄的情况下,可视为二维平面,从上式可得到面电阻率S ρ为4.53ln 2S VV W I Iρπρ∆∆==≅。
(3.2-15) 这就是常用的方块电阻公式,S ρ的单位为欧姆,通常用符号Ω/□表示。
它表示一个正方形薄层的电阻。
值得注意的是,它与正方形边长的大小无关,所以取名为方块电阻。
三、 实验设备本实验的测试装置是RTS-8型四探针测试仪(广州四探针公司),如图3.2-5所示,主要由探针测试台、四探针测试系统、程序控制系统等组成。
图3.2-5 RTS-8型四探针测试仪在测试仪电路中,电流由稳定度为±0.1%、能够通过0.01~100mA 电流、连续可调的恒流源供给,电压表采用电位差计或数字电压表。
在探针设计中,要求采用耐磨材料、探针等距配置、并使之具有小的游移误差。
在探针上需负荷适当的负载,以减小金属与半导体材料间的接触电阻。
一般选择具有较高杨氏模量的金属材料如钨、碳化钨或其它硬质合金材料。
在测量过程中,需注意下述问题:(1)半无限大的样品,是指厚度及任一探针距样品最近边缘的距离,至少要比探针间距S 大四倍以上的样品。
如果上述条件不能满足则需进行边界条件的修正。
(2)为了增加表面复合速度,避免少子注入,待测样品的表面需经粗磨或喷砂处理。
少子注入对测量结果的影响取决于测量电流、探针间距以及少子寿命等,电流大,针距小,少子寿命长,影响就大。
(3)在测定高阻材料及光敏材料时,由于光电导及光压效应会严重影响电阻率的测量,因此需在暗室中进行。
(4)需在电场强度E≤1V/cm的弱场下进行测量,电场太大会使载流子迁移率降低,导致电阻率的测量值增大。
(5)测试电流不宜过大,否则在样品中会引起温度梯度,而产生一个热电压干扰测量信号。
因此,在测量时,测试电流要尽可能低,但必须保证电压的测试精度。
采用较小的测量电流也可减少少子注入的机率。
(6)探针与半导体材料之间应保持良好接触,可通过选择合适的探针材料及采用适当的探针压力来达到。
对于体材料,探针压力一般选取1~2kg;对于薄层或外延材料,一般选取200g左右。
(7)在室温附近,由于半导体材料的电阻率与温度有关,因此测试环境尽量保持恒温。
四、实验内容1.测量给定硅片样品的电阻率和薄层电阻。
薄圆片方块2.测量同一样品八个不同的对称点,计算电阻率不均匀度。
由实验结果得电阻率的不均匀度为7.09%。
3.根据硅电阻率与杂质浓度的关系曲线估算所测硅片的掺杂浓度。
1016cm-3五、实验注意事项1.对于尺寸较小的样品,需要考虑边缘效应的影响,对测量结果进行适当的修正。
2.测试环境尽量保持恒温和弱电磁场,避免强光照射。
六、思考题1.分析电阻率误差的来源。
温度、湿度、硅片制作不均匀、系统误差。
2. 如果只用两根探针既作电流探针又作电压探针,是否能够对样品进行准确的测量,为什么?不能。
因为只用两根探针既作电流探针又作电压探针,就不能消除势垒所产生的影响。