晶圆级芯片封装技术(WL-CSP)电子教案
- 格式:ppt
- 大小:1.22 MB
- 文档页数:22

晶圆级封装的工艺流程概述说明1. 引言1.1 概述晶圆级封装是一种先进的封装技术,它将多个组件和集成电路(IC) 封装在同一个晶圆上,从而提高了芯片的集成度和性能。
相比传统的单芯片封装方式,晶圆级封装具有更高的密度、更短的信号传输路径和更低的功耗。
因此,晶圆级封装已经成为微电子领域中一项重要且不断发展的技术。
1.2 文章结构本文将对晶圆级封装的工艺流程进行全面地概述说明。
首先,在引言部分,我们将对该主题进行简要概述并介绍文章结构。
接下来,在第二部分中,我们将详细阐述晶圆级封装的工艺概述以及相关的工艺步骤、特点与优势。
然后,在第三部分中,我们将探讨实施晶圆级封装工艺时需要考虑的关键要点,包括设计阶段、加工阶段和测试与质量管控方面的要点与技术要求。
在第四部分中,我们将介绍晶圆级封装工艺流程中常见问题及其解决方法,并提出提高封装可靠性的方法和策略,以及工艺流程改进与优化的建议。
最后,在第五部分中,我们将总结回顾晶圆级封装工艺流程,并展望未来晶圆级封装技术的发展方向和趋势。
1.3 目的本文的目的是全面介绍晶圆级封装的工艺流程,提供读者对该领域较为详细和系统的了解。
通过对每个章节内容的详细阐述,读者可以获得关于晶圆级封装工艺流程所涉及到的各个方面的知识和技术要求。
同时,通过对常见问题、解决方法以及未来发展方向等内容的探讨,读者可以更好地理解该技术在微电子领域中的重要性,并为相关研究和应用提供参考。
2. 晶圆级封装的工艺流程:2.1 工艺概述:晶圆级封装是一种先将芯片进行封装,然后再将封装好的芯片与其他组件进行连接的封装技术。
其主要目的是提高芯片的集成度和可靠性,并满足不同应用领域对芯片包装技术的需求。
晶圆级封装工艺拥有多个步骤,其中包括材料准备、焊膏印刷、IC贴装、回流焊接等过程。
2.2 工艺步骤:(1)材料准备:首先需要准备好用于晶圆级封装的相关材料,如底部基板、球柵阵列(BGA)、波士顿背面图案(WLCSP)等。

集成电路芯片封装技术培训课程1. 介绍集成电路芯片封装技术是现代电子产品制造过程中必不可少的一环。
芯片封装是将半导体芯片封装在一种外部材料中,以保护芯片并为其提供机械和电气连接。
本文档旨在介绍集成电路芯片封装技术培训课程的内容和目标。
2. 课程目标本课程旨在使学生掌握以下内容:•了解集成电路芯片封装的基本概念和工艺流程。
•理解不同类型的芯片封装及其应用。
•掌握芯片封装的设计和制造流程。
•学习封装材料的选择和应用。
•了解封装工艺中的质量控制和测试方法。
•探索未来集成电路芯片封装技术的发展趋势。
3. 课程大纲3.1 芯片封装概述•集成电路芯片封装的定义和重要性。
•芯片封装的基本概念和分类。
•封装与电路设计的关系。
3.2 芯片封装的工艺流程•模具制备和背胶。
•焊盘制备和焊球粘贴。
•晶片粘贴和固化。
•封装材料填充和密封。
•焊盘球冷焊和热焊接。
•焊接后的清洗和测试。
•封装设计的基本原则。
•封装设计软件的使用。
•BGA、QFP、LGA等封装类型的特点和适用场景。
•PCB设计与芯片封装的协同工作。
3.4 封装材料的选择与应用•封装材料的基本要求。
•封装胶的种类和特点。
•封装材料在封装工艺中的应用。
3.5 芯片封装的质量控制与测试•质量控制的基本概念和方法。
•封装过程中常见的质量问题和解决方法。
•封装产品的测试方法和标准。
•新型芯片封装技术的出现和应用。
•3D封装和系统级封装的发展趋势。
•集成电路芯片封装技术对于电子产品制造的影响。
4. 学习方法本课程采用理论讲解、案例分析和实践操作相结合的方式进行教学。
学生可以通过听课、参与讨论、完成实验项目等形式进行学习。
此外,课程还提供一些参考资料和实践指导,帮助学生深入理解和应用所学知识。
5. 学习评估为了评估学生的学习成果,本课程将进行以下评估方式:•课堂参与和讨论。
•实验项目的完成情况。
•期末考试。
6. 结束语本文档介绍了集成电路芯片封装技术培训课程的内容和目标。
通过学习此课程,学生将能全面了解集成电路芯片封装的基本概念、工艺流程和设计原则。

晶圆级封装产业(WLP)晶圆级封装产业(WLP),晶圆级封装产业(WLP)是什么意思一、晶圆级封装(Wafer Level Packaging)简介晶圆级封装(WLP,Wafer Level Package) 的一般定义为直接在晶圆上进行大多数或是全部的封装测试程序,之后再进行切割(singulation)制成单颗组件。
而重新分配(redistribution)与凸块(bumping)技术为其I/O绕线的一般选择。
WLP一、晶圆级封装(Wafer Level Packaging)简介晶圆级封装(WLP,Wafer Level Package) 的一般定义为直接在晶圆上进行大多数或是全部的封装测试程序,之后再进行切割(singulation)制成单颗组件。
而重新分配(redistribution)与凸块(bumping)技术为其I/O绕线的一般选择。
WLP封装具有较小封装尺寸(CSP)与较佳电性表现的优势,目前多用于低脚数消费性IC的封装应用(轻薄短小)。
晶圆级封装(WLP)简介常见的WLP封装绕线方式如下:1. Redistribution (Thin film), 2. Encapsulated Glass substrate, 3. Goldstud/Copper post, 4. Flex Tape等。
此外,传统的WLP封装多采用Fan-in 型态,但是伴随IC信号输出pin 数目增加,对ball pitch的要求趋于严格,加上部分组件对于封装后尺寸以及信号输出脚位位置的调整需求,因此变化衍生出Fan-out 与Fan-in + Fan-out 等各式新型WLP封装型态,其制程概念甚至跳脱传统WLP封装,目前德商英飞凌与台商育霈均已经发展相关技术。
二、WLP的主要应用领域整体而言,WLP的主要应用范围为Analog IC(累比IC)、PA/RF(手机放大器与前端模块)与CIS(CMOS Ima ge Sensor)等各式半导体产品,其需求主要来自于可携式产品(iPod, iPhone)对轻薄短小的特性需求,而部分NOR Flash/SRAM也采用WLP封装。
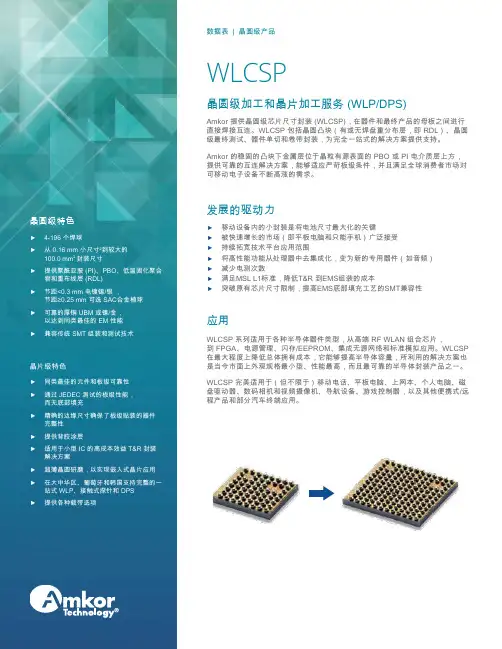
WLCSP晶圆级加工和晶片加工服务 (WLP/DPS)Amkor 提供晶圆级芯片尺寸封装 (WLCSP),在器件和最终产品的母板之间进行直接焊接互连。
WLCSP 包括晶圆凸块(有或无焊盘重分布层,即 RDL)、晶圆级最终测试、器件单切和卷带封装,为完全一站式的解决方案提供支持。
Amkor 的稳固的凸块下金属层位于晶粒有源表面的 PBO 或 PI 电介质层上方, 提供可靠的互连解决方案,能够适应严苛板级条件,并且满足全球消费者市场对可移动电子设备不断高涨的需求。
发展的驱动力� 移动设备内的小封装是将电池尺寸最大化的关键� 被快速增长的市场(即平板电脑和只能手机)广泛接受� 持续拓宽技术平台应用范围� 将高性能功能从处理器中去集成化,变为新的专用器件(如音频)� 减少电测次数� 满足MSL L1标准,降低T&R 到EMS组装的成本�突破原有芯片尺寸限制,提高EMS底部填充工艺的SMT兼容性应用WLCSP 系列适用于各种半导体器件类型,从高端 RF WLAN 组合芯片,到 FPGA、电源管理、闪存/EEPROM、集成无源网络和标准模拟应用。
WLCSP 在最大程度上降低总体拥有成本,它能够提高半导体容量,所利用的解决方案也是当今市面上外观规格最小型、性能最高,而且最可靠的半导体封装产品之一。
WLCSP 完美适用于(但不限于)移动电话、平板电脑、上网本、个人电脑、磁盘驱动器、数码相机和视频摄像机、导航设备、游戏控制器,以及其他便携式/远程产品和部分汽车终端应用。
数据表 | 晶圆级产品WLCSPCSPn3CSP nl 再钝化层凸块 (BoR) 为无需重新布线的器件提供可靠、高成本效率的真正芯片尺寸封装。
BoR 采用具备一流电气/机械特性的再钝化聚合物层。
另外,它还增加了 UBM,而焊接凸块也直接置于晶粒 I/O 焊盘上方。
CSP nl 采用行业标准的表面贴装组装和回流焊技术。
CSP nl 再钝化层凸块CSP nl 重布线层凸块选项增加电镀铜重布线层 (RDL), 将 I/O 焊盘连接至 JEDEC/EIAJ 标准节距,消除了针对 CSP 应用重新设计传统部件的必要性。


什么是晶圆级芯片封装WLCSP
随着移动电子产品趋向轻巧、多功能、低功耗发展,为了在更小的封装面积下容纳更多的引脚数,因而发展出晶圆级芯片封装WLCSP。
它具备更多的功能集成、在体积、成本和性能方面更具优势,可以应用在移动电话、蓝牙产品、医疗设备、射频收发器、电源管理单元、音频放大器和GPS模块使用。
什么是晶圆级芯片封装WLCSP呢?
大家可能比较熟悉BGA,CSP就是小型的BGA,外形和球间距比BGA小,球间距小于0.8毫米的BGA称为CSP,或者封装面积和里面芯片的面积之比小于1.2。
至于WLCSP,就是晶圆级CSP,即是大型的倒装晶片,中间没有载体,焊球直接植于硅基材上,一般焊球间距为0.4至0.8毫米间。
由于晶圆级芯片封装的密间距,其敏感度远远超过BGA。
那么,在组装晶圆级芯片封装这种具有焊球直径小、焊球间距小、外形尺寸小的元器件特征时,厂家要注意什么呢?环球仪器提出了什么解决方案呢?
晶圆级芯片封装的装配流程
目前有两种工艺,一种是锡膏装配,但为了避免“桥连”或“少锡”缺陷,环球仪器建议采用助焊剂浸蘸的方法进行组装。
工艺流程:
拾取晶圆级芯片封装
浸蘸助焊剂
贴装晶圆级芯片封装
回流焊接
底部填充(如有需要)
在这里先集中讨论浸蘸助焊剂流程,环球仪器建议采用助焊剂薄膜浸蘸方式,即在元器件贴装前浸蘸一定厚度的助焊剂薄膜,使每个焊球上附着一定量的助焊剂。
采用助焊剂薄膜浸蘸的两大优点:。


集成电路封装与测试课程教案课程编号:总学时:48 周学时:适用年级专业(学科类):10微电子开课时间:2012-2013 学年第1 学期使用教材:《微电子封装技术》(修订版)中国电子学会生产技术学会组编授课教师姓名:刘炜课题:第1章概论教学目标:通过本章教学,使学生掌微电子封装的基本定义,三级封装的概念,封装对于微电子产品的作用,以及封装工艺在现代微电子工艺技术中的重要性。
教学重点:微电子的三级封装概念教学难点:封装对于微电子产品的作用教具、教学素材准备:多媒体课件教学方法:课堂面授教学时数:3学时教学过程:(教师授课思路、设问及讲解要点)一、从整个集成电路的工艺流程入手,引出本课程要讲授的内容,即微电子封装技术。
介绍微电子封装技术的定义及其在整个微电子产品产业链中的重要地位。
二、介绍我国的微电子封装产业发展现状。
中国正在成为世界IC封装基地之一。
世界半导体封装产值的90%在亚洲,主要在东亚和东南亚的日本、马来西亚、台湾、菲律宾、韩国。
中国的半导体封装产量年增长率约为40%~50%,产值年增长率约为25%。
国际上排名前十位的半导体厂,基本都在大陆设立封装厂。
世界上排名前四名的封装代加工厂都已在中国设厂。
Amkor Technologies、日月光(ASE)、矽品科技(SPIL)、金朋(ChipPac-STATS),急需封装测试技术人才。
截止2002年,国内封装年产值过10亿元的有2家(Motorola、Samsung),过5亿元的有9家;年封装IC产值超亿块的已有12家,超过10亿块的有3家(江苏长电、深圳赛意法、上海金朋);一般国内企业的产品档次低,平均封装单价在0.1~0.6元/块;新型封装、特殊封装、军用品封装的平均封装单价高。
三、介绍微电子封装技术的分级。
详细介绍三级封装的内涵和外延,是学生能够直观深刻的理解三级封装的含义。
同时,突出本课程要讲授的内容主要集中在零级和一级封装领域内。
四、介绍封装的主要功能:信号分配、功率分配、热耗散(使结温处于控制范围之内)和防护(对器件的芯片和互连进行机械、电磁、化学等方面的防护),以及空间转换。



一、教学目标1. 理解封装芯片的基本概念和作用。
2. 掌握封装芯片的常用方法和步骤。
3. 熟悉封装芯片的设备、材料和工具。
4. 能够独立完成封装芯片的操作。
二、教学内容1. 封装芯片的基本概念2. 封装芯片的类型和分类3. 封装芯片的常用方法4. 封装芯片的设备、材料和工具5. 封装芯片的操作步骤6. 封装芯片的质量检测与评价三、教学过程1. 导入新课教师通过展示封装芯片的实物或图片,引导学生了解封装芯片的基本概念和作用,激发学生的学习兴趣。
2. 讲解封装芯片的类型和分类教师详细讲解封装芯片的类型和分类,如QFP、BGA、LGA等,让学生对封装芯片有一个全面的认识。
3. 讲解封装芯片的常用方法教师介绍封装芯片的常用方法,如手工封装、机械封装、激光封装等,让学生了解不同方法的优缺点。
4. 讲解封装芯片的设备、材料和工具教师介绍封装芯片所需的设备、材料和工具,如焊锡、烙铁、显微镜、焊锡膏等,让学生了解封装芯片的操作环境。
5. 讲解封装芯片的操作步骤教师详细讲解封装芯片的操作步骤,包括芯片的清洗、焊锡膏的涂覆、焊接、检验等,让学生掌握封装芯片的操作流程。
6. 练习操作教师组织学生进行封装芯片的练习操作,让学生在实际操作中掌握封装芯片的技能。
7. 检验与评价教师对学生的封装芯片作品进行检验,评价封装质量,指出不足之处,并给予改进建议。
8. 总结与反思教师总结封装芯片的教学内容,引导学生反思封装芯片在实际应用中的重要性,提高学生的实际操作能力。
四、教学评价1. 学生对封装芯片的基本概念、类型、方法和操作步骤的掌握程度。
2. 学生在实际操作中封装芯片的质量和效率。
3. 学生对封装芯片的设备、材料和工具的了解程度。
4. 学生对封装芯片的检验与评价能力的提高。
五、教学资源1. 教学课件:封装芯片的基本概念、类型、方法和操作步骤等。
2. 教学视频:封装芯片的操作演示。
3. 实物教具:封装芯片的实物、设备、材料和工具等。