盲孔之填孔技术
- 格式:ppt
- 大小:4.39 MB
- 文档页数:28
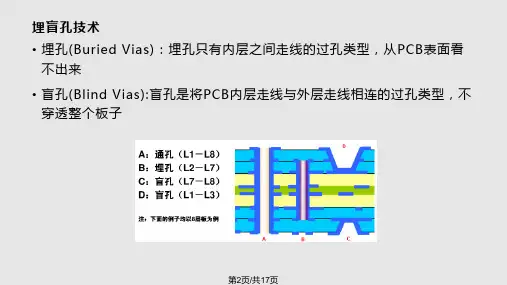


1前言高密度互连技术(High Density Interconnect Technology ,HDI )是为了适应电子产品向更轻、更薄、速度快、频率高方向发展的要求,满足微型器件小型化和封装技术高密度化的需求而发展起来的一种综合性、新型的为电子封装载体制造技术[1]。
20世纪九十年代初期,日本、美国开创应用高密度技术,经过十几年的发展,DI 板得到了长足的发展,尤其是近年来国内3G 手机市场的拉动,给DI 板注入了持续的发展动力。
提高电镀填盲孔效果的研究Pa pe r Code:A-088朱凯何为陈苑明陶志华(电子科技大学,四川成都610054)陈世金徐缓(博敏电子股份有限公司,广东梅州514000)摘要随着电子产品的持续发展,H D I 印制电路板的应用越来越广泛,本文通过正交实验优化电镀填孔工艺参数,并通过控制变量法研究了通孔孔径及位置对盲孔电镀填孔效果的影响,并以金相显微镜分析盲孔的凹陷度作为考察指标。
研究结果表明采用优化参数能够降低盲孔填充凹陷度,通孔对盲孔的填孔电镀效果会产生影响,随着通孔孔径的增大,对盲孔的填孔电镀越有利,同时实验还发现,若在孔金属化后通孔孔壁与盲孔底部铜层电导通有利于盲孔的填孔。
关键词高密度互连技术;电镀填孔;通孔中图分类号:TN41文献标识码:A 文章编号:1009-0096(2013)增刊-0150-06The study on improving microvia-lling platingZHU Kai HE W ei CHEN Y uan-ming T AO Zhi-hua CHEN Shi-jin X U Hua nAbst rac t With the electronic products continuous improvement,HDI has extensive application in PCB.In this paper,optimizing process parameters through orthogonal experiment was used for improving microvia-liing ef ciency,and the effect of through-hole size and place on microvia-lling plating had been study by control variable method,besides,the via lling effect was proved by metallographic slicing test.Research results show that the microvia with lower dimple can be completed well by the optimum technology,and the dimple reduced while through-hole pere size increased,and it was bene cial to microvia-lling plating if through-hole and the bottom of microvia were conductive after hole metallization.Key words HDI;Microvia -Filling P la ting;Through-HoleH H电镀填孔技术是目前高密度互连以及任意层互连技术主要采用的工艺,也是实现批量生产所使用的最广泛的工艺[2]。

高纵横比盲孔电镀铜填孔技术改进
高纵横比盲孔电镀铜填孔技术改进
夏海谢慈育丁杰郝意
【摘要】摘要随着盲孔填孔产品及工艺的发展,越来越多的注意力被放在了高纵横比微盲孔的填孔技术开发上。
目前高纵横比微盲孔填孔中经常出现包芯,面铜厚等问题。
本文研究了通过特殊的分子结构设计以及工艺改进,极大的改善了高纵横比微盲孔的填孔表现。
【期刊名称】印制电路信息
【年(卷),期】2018(026)012
【总页数】4
【关键词】关键词盲孔填孔;高纵横比;电镀铜;添加剂
0 前言
印制电路板在电子设备中提供电子元器件电气沟通的渠道,由它们构成的三维铜线路网络为每一个芯片、电容及电阻等器件能够正常工作提供了可靠保证[1]。
水平方向的铜线路可以由加减铜来完成,垂直方向的铜线路则一般依靠通盲孔以及相互的叠孔来实现[2]。
针对孔径较小的微孔,目前通孔的填孔是业界的一个重点,如果需要实现多层之间在垂直方向的电气相通,一般是采用叠孔的方式来实现,然而多层的叠孔会出现成本大且孔对位等问题。
盲孔填孔技术一般是针对厚径比小于0.8的“浅”盲孔,而厚径比大于0.8,甚至大于1的“深”盲孔填孔是业界急切想要开发的一项技术[3]。
目前填孔技术虽然可以实现纵横比大于1:1的高纵横比微盲孔填孔,但在一定程度上要解决叠孔还可能存在如何有效的降低企业生产成本及孔对位产生的安全隐患问题。
1 添加剂材料设计与作用原理。

高密度互连印制板电镀填盲孔技术陈世金 罗 旭 覃 新 韩志伟 徐 缓(博敏电子股份有限公司,广东 梅州 514768)摘 要 主要介绍了电镀填盲孔的过程机理和影响填孔效果的因素,重点探讨了电镀设备、电镀参数、添加剂等对电镀填孔效果的影响,突出讲解了电镀填盲孔技术的控制重点和难点等内容。
关键词 印制电路板;电镀填孔;添加剂;阳极;填充率中图分类号:TN41 文献标识码:A 文章编号:1009-0096(2013)07-0041-08Research on blind via fi lling plating technologyfor HDI in PCB manufacturingCHEN Shi-jin LUO Xu QIN Xin HAN Zhi-wei XU HuanAbstract In this article, the mechanism of blind via filling plating, the effecting factors to copper fi lling result were introduced, such as plating equipment, parameters, additive effect to the via fi lling plating. The main control process and the dif fi culties points of the blind via fi lling plating were specially illustrated.Key words Printed Circuit Board; Via Filling Plating; Additive; Anode; Filling Power1 前言随着智能手机、平板电脑等消费类电子产品不断向轻便化、小型化的趋势发展,这将推动PCB 不断向更高、更密集化布局方向发展。

深盲孔电镀铜填充的空洞机理研究
陆敏菲;朱凯;钟荣军;王蒙蒙
【期刊名称】《印制电路信息》
【年(卷),期】2024(32)4
【摘要】电镀铜填孔技术被广泛用于高密度互连(HDI)板、封装基板和先进封装中,其中填孔的缺陷和效率问题是目前产业应用过程中最关注的两个方面。
重点研究了孔径约110μm、孔深约180μm的深盲孔电镀填孔过程中的空洞问题。
首先从理论上分析了填孔过程中镀层生长方式和空洞产生的原因;然后通过哈林槽电镀试验,结合加速剂局部预吸附技术,发现了盲孔底部加速剂和Cu^(2+)传质不足是深盲孔填孔产生空洞的关键原因。
研究表明:加速剂局部预吸附技术不仅可以缩短深盲孔电镀填孔时间,而且可以有效地降低深盲孔产生填孔空洞的风险;此外,通过提高气流量、镀液温度或Cu^(2+)浓度来加强深盲孔孔底Cu^(2+)传质对深盲孔填孔是非常必要的。
【总页数】8页(P20-27)
【作者】陆敏菲;朱凯;钟荣军;王蒙蒙
【作者单位】深南电路股份有限公司
【正文语种】中文
【中图分类】TN41
【相关文献】
1.MPS和氯离子在电镀铜盲孔填充工艺中的作用机理
2.加速剂局部预吸附提升电镀铜填充深盲孔技术研究
3.利用电镀铜填充微米盲孔与通孔之应用
4.《利用电镀铜填充微米盲孔与通孔之应用》-文彩图
5.镀铜填充盲孔的低电阻测试模块应用
因版权原因,仅展示原文概要,查看原文内容请购买。

盲孔和埋孔工艺流程Blind hole and buried hole processes are commonly used in manufacturing and construction industries to create holes that do not go all the way through the material. These processes have their own unique advantages and applications, depending on the specific requirements of the project.盲孔和埋孔工艺流程在制造和建筑行业中被广泛使用,用于创建不完全穿透材料的孔。
这些工艺根据项目的具体要求具有各自独特的优势和应用。
Blind holes are holes that only partially penetrate the material, leaving a bottom to the hole. They are commonly used for creating a space for a screw head to sit flush with the material surface or for creating a precision bore. The blind hole process involves drilling a hole that does not go through the entire thickness of the material, which can be advantageous when a clean finish is required on one side of the material.盲孔是只部分穿透材料的孔,留有底部。
它们通常用于为螺钉头埋在材料表面上或创建一个精密孔。


电镀盲孔填孔不良分析目前多阶HDI板的层间互连大多采用微孔叠孔及交错连接方式设计,一般采用电镀铜填孔方式进行导通,但电镀填盲孔技术与传统电镀有一定差别,且在工艺参数,流程设计,设备方面更有严格要求,填孔过程中出现空洞、凹陷、漏填也是厂内控制的难点,下面将厂内填孔缺陷进行分析,提供些填孔不良的思路;一、填孔不良分析:针对厂内填孔不良切片分析分类,统计如下:序号缺陷分类不良图片不良比例1 凹陷75%2 漏填15%3 空洞5%二、原因分析:通过切片分析确认,不良主要为凹陷、漏填、空洞,其中凹陷、漏填比例较高,其次为空洞,现针对厂内填孔不良可能原因进行分析.2.1添加剂浓度失调:盲孔的填孔主要是通过添加剂中各组成分的协调作用、吸附差异平衡化完成,浓度失控势必会造成添加剂在盲孔内吸附平衡的破坏影响填孔效果.2.2打气喷管堵塞:填孔槽打气大小直接影响到填孔过程中孔内药水交换效果,若打气效果差必然会造成孔内药水交换导致填孔效果欠佳凹陷值偏大.2.3导电性不良:夹头或挂具损坏、飞靶和V型座接触不好,导致电流分布不均,板内电流小区域必然会出现盲孔凹陷或漏填现象.2.4填孔前微蚀异常:填孔前微蚀不足均可能导致个别盲孔孔内导电不良,孔内电阻偏高,在填孔时不利于添加剂分布导致填孔失败.2.5板子入槽时变形导致局部盲孔突起,局部盲孔漏填或凹陷.2.6泵浦吸入口漏气,必然会造成大量空气进入槽内,通过过滤泵循环过滤将起泡带入整个槽内通过气流进入盲孔,阻碍孔内药水交换导致盲孔漏填现象.三、效果验证:实验前通过对药水调整至最佳状态,检查打气管道、夹头(挂具)、打气状况,维修设备接触不良处并用稀硫酸清洗、微蚀速率控制在20—30u”,保证板为垂直状态后进行填孔测试,测试结果无异常.四、结论:通过改善前后对比可以看出:厂内填孔不良主要为药水浓度、打气、导电性、填孔前微蚀量异常及槽内有气泡导致填孔异常,当然影响盲孔填孔异常的因素还有很多,只有平时做到长期监控,细心维护设备,认真排查造成填孔不良的每一个可能因素,才能真正运用好填孔技术,解决厂内填孔异常.。