全面盲孔之填孔技术.ppt
- 格式:ppt
- 大小:3.32 MB
- 文档页数:28
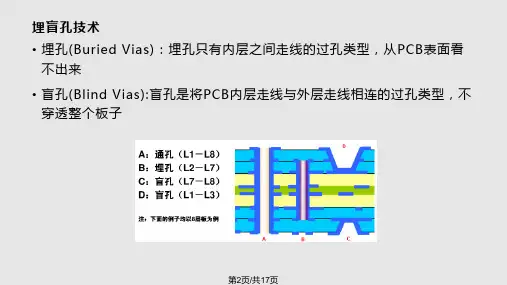



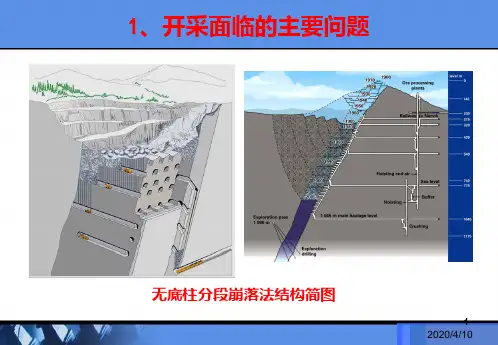

印制电路板(PCB)微盲孔填充及通孔金属化技术电子产品向轻、薄、短、微型化的发展趋势要求印制线路板及包装材料的空间体积向更小型化发展,高密度互连(HDI)技术已经成为发展的必然趋势。
线路板的功能可靠性很大程度上取决于直接金属化、微盲孔填充及通孔金属化的品质。
为改善流程的性能,人们往往会提高工艺流程的复杂程度,使用不同类型的添加剂,这使流程更加难以控制。
另外,PPR脉冲电镀技术作为一种解决方案已被应用,最终还是要通过功能性化学品的氧化还原保护作用来维持添加剂的稳定性。
一项新的技术已经问世,此技术简单而又能有效地控制流程,可实现微孔填充与通孔金属化同步进行,已经在整板电镀和图形电镀的应用中得到了证实与认可。
该技术可应用于传统垂直起落的浸入式直流电镀生产线。
另外,此项新技术添加剂的使用量少,从而延长了镀液使用寿命,流程品质也易于管理与控制。
引言线路板在机加工之后的微、通孔板,孔壁裸露的电介质必须经过金属化和镀铜导电处理,毫无疑问,其目的是为了确保良好的导电性和稳定的性能,特别是在定期热应力处理后。
在印制线路板电介质的直接金属化概念中,ENVISIONHDI工艺在HDI印制线路板的生产中被认为是高可靠性、高产量的环保工艺。
这项新工艺可使微盲孔填充及通孔金属化同步进行,使用普通的直流电源就具有优异的深镀能力。
另外一些研究显示,CUPROSTARCVF1不改变电源及镀槽设计的条件下仍能保证填盲孔,不影响通孔电镀的性能。
本文总结了CUPROSTAR CVF1最新研发结果、工艺的潜能以及对不同操作控制条件的兼容性,描述了微盲孔和通孔的物理特性和导电聚合体用于硬板和软板的直接金属化技术新的发展方向以及与CVF1电镀的兼容性。
CUPROSTARCVF1半一站垂直浸入式工艺(表1),可利用现有的电镀设备(直流电源和可溶性阳极)进行微孔填铜。
常规的电镀液中含有活化剂和抑制剂(甚至还含有整平剂),CUPROSTAR CVF1的两种添加剂是分开的:预浸液中只含有活化剂,镀液中只含有抑制剂。

盲孔和埋孔工艺流程Blind hole and buried hole processes are commonly used in manufacturing and construction industries to create holes that do not go all the way through the material. These processes have their own unique advantages and applications, depending on the specific requirements of the project.盲孔和埋孔工艺流程在制造和建筑行业中被广泛使用,用于创建不完全穿透材料的孔。
这些工艺根据项目的具体要求具有各自独特的优势和应用。
Blind holes are holes that only partially penetrate the material, leaving a bottom to the hole. They are commonly used for creating a space for a screw head to sit flush with the material surface or for creating a precision bore. The blind hole process involves drilling a hole that does not go through the entire thickness of the material, which can be advantageous when a clean finish is required on one side of the material.盲孔是只部分穿透材料的孔,留有底部。
它们通常用于为螺钉头埋在材料表面上或创建一个精密孔。




二十盲/埋孔谈到盲/埋孔,首先从传统多层板说起。
标准的多层板的结构,是含内层线路及外层线路,再利用钻孔,以及孔内金属化的制程,来达到各层线路之内部连结功能。
但是因为线路密度的增加,零件的封装方式不断的更新。
为了让有限的PCB面积,能放置更多更高性能的零件,除线路宽度愈细外,孔径亦从DIP 插孔孔径1 mm缩小为SMD的0.6 mm,更进一步缩小为0.4mm以下。
但是仍会占用表面积,因而又有埋孔及盲孔的出现,其定义如下:A. 埋孔(Buried Via)见图示20.1,内层间的通孔,压合后,无法看到所以不必占用外层之面积B. 盲孔(Blind Via)见图示20.1,应用于表面层和一个或多个内层的连通20.1埋孔设计与制作埋孔的制作流程较传统多层板复杂,成本亦较高,图20.2显示传统内层与有埋孔之内层制作上的差异,图20.3则解释八层埋孔板的压合迭板结构. 图20.4则是埋孔暨一般通孔和PAD大小的一般规格20.2盲孔设计与制作密度极高,双面SMD设计的板子,会有外层上下,I/O导孔间的彼此干扰,尤其是有VIP(Via-in-pad)设计时更是一个麻烦。
盲孔可以解决这个问题。
另外无线电通讯的盛行, 线路之设计必达到RF(Radio frequency)的范围, 超过1GHz以上. 盲孔设计可以达到此需求,图20.5是盲孔一般规格。
盲孔板的制作流程有三个不同的方法,如下所述A.机械式定深钻孔传统多层板之制程,至压合后,利用钻孔机设定Z轴深度的钻孔,但此法有几个问题a.每次仅能一片钻产出非常低b.钻孔机台面水平度要求严格,每个spindle的钻深设定要一致否则很难控制每个孔的深度c.孔内电镀困难,尤其深度若大于孔径,那几乎不可能做好孔内电镀。
上述几个制程的限制,己使此法渐不被使用。
B.逐次压合法(Sequential lamination)以八层板为例(见图20.6),逐次压合法可同时制作盲埋孔。
首先将四片内层板以一般双面皮的方式线路及PTH做出(也可有其它组合;六层板+双面板、上下两双面板+内四层板)再将四片一并压合成四层板后,再进行全通孔的制作。