半导体集成电路常见封装缩写(精)
- 格式:doc
- 大小:190.50 KB
- 文档页数:13

常见封装缩写解释bldh888 发表于: 2010-4-23 22:04 来源: 半导体技术天地1. DIP(dual in-line PACkage)双列直插式封装。
插装型封装之一,引脚从封装两侧引出,封装材料有塑料和陶瓷两种。
DIP 是最普及的插装型封装,应用范围包括标准逻辑IC,存贮器LSI,微机电路等。
引脚中心距2.54mm,引脚数从6 到64。
封装宽度通常为15.2mm。
有的把宽度为7.52mm和10.16mm 的封装分别称为skinny DIP 和slim DIP(窄体型DIP)。
但多数情况下并不加区分,只简单地统称为DIP。
另外,用低熔点玻璃密封的陶瓷DIP 也称为Cerdip(见Cerdip)。
BGA是英文Ball Grid Array Package的缩写,即球栅阵列封装。
SOP小型外引脚封装Small Outline Package r¬o0c[hi^M 4srs?}JSSOP收缩型小外形封装Shrink Small Outline Package P pBI%{p)与SOP的区别:近似小外形封装,但宽度要比小外形封装更窄,可节省组装面积的新型封装。
2. DIP(dual tape carrier PACkage)同上。
日本电子机械工业会标准对DTCP 的命名(见DTCP)。
QTCP(quad tape carrier PACkage)四侧引脚带载封装。
TCP 封装之一,在绝缘带上形成引脚并从封装四个侧面引出。
是利用TAB 技术的薄型封装(见TAB、TCP)。
COB(chip on board)板上芯片封装,是裸芯片贴装技术之一,半导体芯片交接贴装在印刷线路板上,芯片与基板的电气连接用引线缝合方法实现,芯片与基板的电气连接用引线缝合方法实现,并用树脂覆盖以确保可靠性。
虽然COB 是最简单的裸芯片贴装技术,但它的封装密度远不如TAB 和倒片焊技术。
JLCC(J-leaded chip carrier)J 形引脚芯片载体。

封装类型缩写含义封装类型SIP :Single-In-Line PackageDIP :Dual In-line Package 双列直插式封装CDIP:Ceramic Dual-In-line Package 陶瓷双列直插式封装PDIP:Plastic Dual-In-line Package 塑料双列直插式封装SDIP :Shrink Dual-In-Line PackageQFP :Quad Flat Package 四方扁平封装TQFP :Thin Quad Flat Package 薄型四方扁平封装PQFP :Plastic Quad Flat Package 塑料方型扁平封装MQFP :Metric Quad Flat PackageVQFP :Very Thin Quad Flat PackageSOP :Small Outline Package 小外型封装SSOP :Shrink Small-Outline Package 缩小外型封装TSOP :Thin Small-Outline Package 薄型小尺寸封装TSSOP :Thin Shrink Small-Outline PackageQSOP :Quarter Small-Outline PackageVSOP :Very Small Outline PackageTVSOP :Very Thin Small-Outline PackageLCC :Leadless Ceramic Chip Carrier 无引线芯片承载封装LCCC :Leadless Ceramic Chip CarrierPLCC :Plastic Leaded Chip Carrier 塑料式引线芯片承载封装BGA :Ball Grid Array 球栅阵列CBGA :Ceramic Ball Grid ArrayuBGA :Micro Ball Grid Array 微型球栅阵列封装PGA :Pin Grid ArrayCPGA :Ceramic Pin Grid Array 陶瓷PGA PPGA :Plastic Pin Grid ArrayMCM :Multi Chip Model 多芯片模块SMD(surface mount devices) ——表面贴装器件。

常⽤集成电路名词缩写汇总(第⼆版)重要说明整个集成电路的设计和⽣产链路很长,相关专有名称很多;本⽂对常见的集成电路相关的名词缩写进⾏了汇总,特别聚焦与集成电路设计领域,意在整理常⽤的数字电路/DC/PT/ICC/DFV/DFT/RTL/ATE相关⽅⾯的知识点,⽅便⼤家快速学习和掌握相关知识,⽅便⼤家查询;同时希望对学⽣将来的培训/⾯试等活动给予最⼤的帮助;⽂章按照字母排序的⽅式进⾏编排,⽅便⼤家查询;本次⽂章内容为第⼆次发布,我们将定期更新,逐步完善;欢迎⼤家提供相关信息⾄xgcl_wei微信号,帮助我们逐步完善内容,⽅便更多的⼈查询和使⽤,感谢您的参与,谢谢!英⽂全称中⽂说明ABV Assertion based verification基于断⾔的验证AES Advanced Encryption Standard⾼级加密标准,是美国政府采⽤的⼀种区块加密标准ADC Analog-to-Digital Converter指模/数转换器或者模数转换器AHB Advanced High Performance Bus⾼级⾼性能总线ALF Advanced Library Format先进(时序)库格式ALU Arithmetic and logic unit算数逻辑单元AMBA Advanced Microcontroller Bus Architecture⾼级微控制器总线体系ANT antenna天线效应AOP Aspect Oriented Programming⾯向⽅⾯编程APB Advanced Peripheral Bus⾼级外部设备总线API Application Programming Interface应⽤程序编程接⼝APR Auto place and route⾃动布局布线ARM Advanced RISC Machines 英国Acorn公司(ARM公司的前⾝)设计的低功耗成本的第⼀款RISC微处理器。
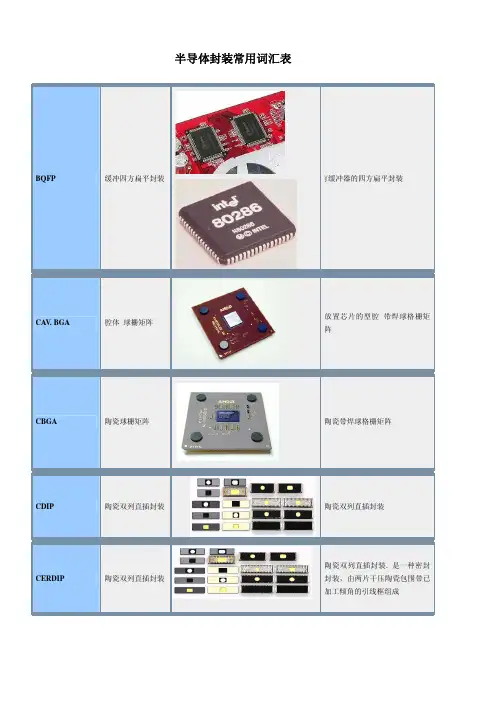
半导体封装常用词汇表BQFP缓冲四方扁平封装有缓冲器的四方扁平封装CA V . BGA 腔体 球栅矩阵放置芯片的型腔 带焊球格栅矩阵CBGA 陶瓷球栅矩阵陶瓷带焊球格栅矩阵CDIP陶瓷双列直插封装陶瓷双列直插封装CERDIP陶瓷双列直插封装陶瓷双列直插封装. 是一种密封封装,由两片干压陶瓷包围带已加工倾角的引线框组成CERPAK陶瓷组件式封装结构与Cerdip 相似。
但引脚外形是未加工的扁平形。
引脚从两边或是四边引出。
Chip ScalePackaging芯片尺寸级封装是一种高密度封装,封装尺寸近似芯片尺寸,有更高的芯片/封装面积比率(大于50%)COB芯片板上贴装芯片直接贴装在电路板上CPGA 陶瓷针栅阵列陶瓷针栅阵列CQUADJ 形陶瓷四方封装J 形引脚陶瓷四方封装CQFP 陶瓷四方扁平封装陶瓷四方扁平封装DCA芯片直接贴装芯片直接贴装DIP Dia D/A双列封装 直径 芯片贴装腔体双列封装 直径 芯片贴装腔体Epoxy Seal E/O环氧树脂密封 只是末端一种非气密性的密封方法。
将周边用硫化环氧树脂与封装密封。
. 只是末端Flip Chip 倒装芯片 半导体芯片倒置(面朝下)封装连接到基板或是电路板。
通常在芯片外围(在键合盘上)带有焊球或是设计成矩阵形.FritSeal GR/GRDH/S L/F LD熔接密封接地端热沉引线架引线一种气密密封的方法,将陶瓷盖板用重熔的玻璃与陶瓷封装密封连接接地端热沉引线架引线LDCC有引线芯片载体有引线芯片载体LLCC无引线芯片载体无引线芯片载体MBGA金属球栅阵列封装金属球栅阵列封装mBGA微球形格栅阵列微球形格栅阵列MCM-PBGA多芯片模块-塑料球栅阵列多芯片模块-塑料球栅阵列MCP Mfg多芯片封装生产商多芯片封装生产商MQFP公制四方扁平封装公制四方扁平封装MQUAD NC NEO Ni金属四方扁平封装 无注释 仅靠末端 镍金属四方扁平封装 无注释 仅靠末端 镍lPBGA 塑料球栅阵列塑料球栅阵列PMCM 塑料多芯片模块塑料多芯片模块PQFP塑料四方扁平封装塑料四方扁平封装PDIP 塑料双列封装塑料双列封装PGA 针栅阵列针栅阵列PLCC Proj PPGA 塑料有引线芯片载体 凸缘 塑料针栅阵列塑料有引线芯片载体 焊接凸缘 塑料针栅阵列PWB 印刷电路板 印刷电路板QFP S/R四方扁平封装 密封环一种表面安装封装,四边均有引线,封装体可以是陶瓷,金属或是塑料。

半导体行业的英单词和术语1. Semiconductor(半导体):指一种导电性能介于导体和绝缘体之间的材料,广泛应用于电子器件中。
3. Integrated Circuit(集成电路):简称IC,将大量的微小电子元件(如晶体管、电阻、电容等)集成在一块半导体芯片上。
4. Transistor(晶体管):一种半导体器件,具有放大信号和开关功能,是现代电子设备的基础组件。
5. Diode(二极管):一种具有单向导通特性的半导体器件,常用于整流、稳压等电路。
6. MOSFET(金属氧化物半导体场效应晶体管):一种常见的晶体管类型,广泛应用于放大器和开关电路。
7. CMOS(互补金属氧化物半导体):一种集成电路技术,采用NMOS和PMOS晶体管组合,具有低功耗、高集成度等优点。
8. Wafer(晶圆):指经过切割、抛光等工艺处理的半导体材料,用于制造集成电路。
9. Photolithography(光刻):在半导体制造过程中,利用光刻技术将电路图案转移到晶圆上的过程。
10. Etching(刻蚀):在半导体制造过程中,通过化学反应或物理方法去除晶圆表面不需要的材料。
11.掺杂(Doping):在半导体材料中引入其他元素,以改变其导电性能。
12. Chip(芯片):指经过封装的集成电路,是电子设备的核心组成部分。
13. PCB(印刷电路板):一种用于支撑和连接电子元件的板材,上面布满了导电线路。
14. Moore's Law(摩尔定律):指集成电路上可容纳的晶体管数量大约每两年翻一番,预测了半导体行业的发展趋势。
15. EDA(电子设计自动化):指利用计算机软件辅助设计电子系统,包括电路设计、仿真、验证等环节。
16. Foundry(代工厂):专门为其他公司生产半导体芯片的企业。
17. Semiconductor Equipment Manufacturer(半导体设备制造商):为半导体行业提供生产设备的公司。

半导体常用缩写词汇汇总EPI 外延PM 设备维护与保养PCW 工艺冷却水PMC 生产计划与物料控制PLC 可编程序控制控制器H2 氢气Sb 锑N2 氮气As 砷SiHCl3(TCS)三氯氢硅 B 硼PH3 磷烷CMOS 互补金属氧化物半导体HCl 氯化氢CMP 化学机械抛光Hg 汞(水银)ESD静电释放HNO3 硝酸H2O2双氧水HF 氢氟酸MOS 金属氧化物半导体SPC 统计过程控制PCM 工艺控制监测MRB 异常评审委员会PCN 工艺变更通知单CAB 变更评审委员会ECN 工程变更通知单OCAP 失效控制计划。
指制程过程中失控时所应采取的对应措施。
是一种受控文件,包含造成异常的因素等PSG 磷硅玻璃TF 薄膜PVD物理气相淀积PHO 光刻PCB 印刷电路板DIF 扩散RF 射频II 注入UV紫外线CVD 化学气相淀积VPE气相外延SPV 扩散长度Bubbler 鼓泡器CD 关键尺寸EMO 设备紧急按钮CD-SEM 线宽扫描电镜ScrubbLer 尾气处理器ETCH 刻蚀(腐蚀)Coat 包硅H2-BAKE 氢气烘烤SRP 外延层纵向电阻率分布1号液:(NH4OH:H2O2:H2O)NH4OH : H2O2 : H2O=1 : 2 : 7,2号液:(HCl:H2O2:H2O)HCl : H2O2 : H2O=1 : 2 : 53号液(Caros清洗液):(H2SO4:H2O2) H2SO4 : H2O2=3 : 1,4#号液:H2O:HF=10:1CV:电容-电压测试BOE混酸:氟化铵氢氟酸混合腐蚀液液CZ:切克劳斯基直拉法Wafer:抛光片FZ:区熔方法THK:膜厚Rs:电阻TTV:总厚度偏差TIR:平整度STIR:局部平整度LTO:背封BOW:弯曲度CHIP:崩边SLIP:滑移线MARK:痕迹WARP:翘曲度CRACK:裂纹SPOT: 斑点HAZE:发雾CROWN:皇冠,边缘突起物OISF:氧化诱生层错ORG: 掺As单晶抛光片O2含量径向均匀性OSF:氧化层错BMV:气体流量控制阀LIFE TIME:寿命POINT DEFECT: 点缺陷Integrated circuit:集成电路epitaxial layer:外延层Buried layer:埋层interface:界面Diameter:直径chemical vapor polish 化学气相抛光Polished surface :表面抛光back side ;反面Front side :正面INJ:引入气体流量DIL:稀释气体流量Autodoping:自掺杂Sccm:毫升/每分钟Slm:升/每分钟CDA:压缩空气PN2:工艺氮气Cable:电缆MES:生产过程执行管理系统SFC:生产车间集中MDC:生产数据及设备状态信息采集分析管理系统PDM:制造过程数据文档管理系统MSA:量具测量系统分析KPI:关键表现指标, 销售指标Alarm :报警MSA: 使用数据统计和图表的方法对测量系统的分辨率和误差进行分析QA: 指质量管理、品质的保证、质量的评估/评价QC: 指质量检验和控制、分析、改善和不合格品控制人员的总称OOC/oos:OOS:检验结果偏差超过规格、不合格OOC : 产品质量失去控制,需要采取返工、召回等手段。

集成电路封装
集成电路封装,又称芯片封装,是指将集成电路芯片进行封装,以提供保护、连接和连接外部电路的功能。
常见的集成电路封装有以下几种类型:
1. 对顶焊接(DIP)封装:这是最早也是最常见的封装形式之一,通常用于较低密度和较低频率的应用。
它采用两排引脚,可以直接插入插座或焊接到电路板上。
2. 表面贴装技术(SMT)封装:这是目前最常用的封装技术,广泛应用于各种电子设备中。
SMT封装可以有效提高集成度和组装效率,减小封装体积和重量。
3. 高级封装:随着技术的发展,出现了一些更高级的封装形式,例如球形阵列封装(BGA)、无引脚封装(LGA)和封装在柔性基板上的芯片(COF)等。
这些封装形式主要用于高密度、高速和复杂电路的应用。
封装的选择会根据应用需求、电路复杂性、可靠性和成本
等因素进行评估和决策。
不同的封装形式有各自的优缺点,需要根据具体的设计要求和制造工艺选择适合的封装。

PCB封装常用标注符号及缩写随着电子技术的发展,PCB(Printed circuit board)在电子产品中的应用越来越广泛。
在PCB设计中,封装是一个重要的环节,它决定了电子元器件在PCB上的布局和连接方式。
为了方便工程师们在PCB设计时进行标注和识别,常用的标注符号和缩写是必不可少的。
本文将介绍PCB封装常用标注符号及缩写,帮助工程师们更好地理解和应用。
1.标注符号在PCB设计中,常用的标注符号包括芯片封装、晶振封装、电解电容封装、电感封装等。
下面是常用的标注符号及其含义:(1)芯片封装QFN:Quad flat no-leadQFP:Quad flat packageBGA:Ball grid arraySOP:Small outline packageLGA:Land grid array(2)晶振封装U2/U3:晶振SMDHC/HC-49S:晶振贴片封装(3)电解电容封装C1/C2:电解电容SMD/ElecCap:贴片电解电容(4)电感封装L1/L2:电感SMD/Inductor:贴片电感以上标注符号可以在PCB设计图纸中使用,帮助工程师们清晰地识别不同封装的元件,从而更好地进行布局和连接。
2.缩写除了标注符号外,在PCB设计中常用的缩写也是必不可少的。
下面是一些常见的缩写及其含义:(1)元器件名称R:电阻C:电容L:电感U:集成电路D:二极管Q:晶体管(2)封装类型SMD:表面贴装封装THD:插件式封装THT:穿孔式封装(3)封装形式DIP:双列直插式封装SOP:小尺寸带引脚封装SSOP:窄小尺寸带引脚封装QSOP:超窄小尺寸带引脚封装这些缩写可以缩短元器件名称和封装类型,在PCB设计中起到简化标注的作用,提高工程师们的工作效率。
3.总结在PCB设计中,标注符号和缩写是必不可少的一部分,它们可以帮助工程师们清晰地识别和理解不同元器件的封装类型和特性。
本文介绍了常用的标注符号和缩写,希望能够为工程师们在PCB设计中提供一些参考。


70种半导体封装形式半导体封装是将芯片封装在保护性外壳中,以便在电路板上使用。
根据封装形式的不同,可以分为多种类型。
以下是大约70种常见的半导体封装形式:1. Dual in-line package (DIP)。
2. Quad Flat Package (QFP)。
3. Thin Quad Flat Package (TQFP)。
4. Small Outline Integrated Circuit (SOIC)。
5. Shrink Small Outline Package (SSOP)。
6. Plastic Leaded Chip Carrier (PLCC)。
7. Ball Grid Array (BGA)。
8. Land Grid Array (LGA)。
9. Quad Flat No-Lead (QFN)。
10. Dual Flat No-Lead (DFN)。
11. Chip scale package (CSP)。
12. Dual in-line package (DIP)。
13. Zigzag in-line package (ZIP)。
14. Pin Grid Array (PGA)。
15. Ceramic Dual in-line package (CDIP)。
16. Ceramic Leadless Chip Carrier (CLCC)。
17. Ceramic Quad Flat Package (CQFP)。
18. Dual Flat Package (DFP)。
19. Flat Package (FP)。
20. Grid Array Package (GAP)。
21. Pin Grid Array (PGA)。
22. Single in-line package (SIP)。
23. Single in-line pin package (SIPP)。
24. Single in-line memory module (SIMM)。

半导体几种封装及应用范围半导体器件的封装形式是指将半导体芯片固定在封装材料中,以提供电气连接和保护芯片的外部结构。
不同的半导体器件具有不同的封装形式,主要根据器件的类型、尺寸、功率和应用需求等来选择。
目前常见的半导体器件封装形式包括以下几种:1. DIP封装(Dual in-line package)DIP封装是最早应用的一种半导体器件封装形式,其引脚排列成两行,中间有一定间距,适用于大多数集成电路、逻辑器件和传感器等。
DIP封装的优点是结构简单、成本低廉、可手动焊接,但体积较大,不适合高集成度和高密度的应用。
2. 焊盘封装(QFP)焊盘封装是现代集成电路器件最常见的一种封装形式,其引脚布置成矩形,边缘有焊盘用于焊接。
QFP封装广泛应用于微处理器、存储器、FPGA等,具有密度高、功耗低、带宽大、易于自动焊接等优点。
3. 表面贴装封装(SMT)表面贴装封装是目前半导体器件最常用的一种封装形式,尤其适用于小尺寸、高集成度和高频率的应用。
SMT封装将芯片焊接在PCB表面,通过焊接球或焊锡膏与PCB的焊盘连接。
SMT封装包括BGA(Ball Grid Array)、CSP(Chip Scale Package)等多种形式,广泛应用于手机、平板电脑、相机、无线通信等领域。
4. 射频封装(RF)射频封装主要针对射频器件的特殊性需求,如天线、射频放大器等。
射频封装要求引脚的长度和布线特性具有低损耗、高速度和低串扰的特点,常见的射频封装形式包括QFN、MSOP等。
5. 高功率封装(Power)高功率封装适用于功率器件和功率集成电路等高功率应用,主要解决散热、这样设计和电气特性的问题。
常见的高功率封装形式包括TO封装、DPAK封装、SOT 封装等。
半导体器件的封装形式根据应用需求的不同,还可以细分为塑封、金属封装、陶瓷封装等多个不同的材料类型。
此外,封装形式还可以根据引脚的连接方式、数量和排列方式等因素进行分类。
半导体常用缩写词汇汇总EPI 外延PM 设备维护与保养PCW 工艺冷却水PMC 生产计划与物料控制PLC 可编程序控制控制器H2 氢气Sb 锑N2 氮气As 砷SiHCl3(TCS)三氯氢硅 B 硼PH3 磷烷CMOS 互补金属氧化物半导体HCl 氯化氢CMP 化学机械抛光Hg 汞(水银)ESD静电释放HNO3 硝酸H2O2双氧水HF 氢氟酸MOS 金属氧化物半导体SPC 统计过程控制PCM 工艺控制监测MRB 异常评审委员会PCN 工艺变更通知单CAB 变更评审委员会ECN 工程变更通知单OCAP 失效控制计划。
指制程过程中失控时所应采取的对应措施。
是一种受控文件,包含造成异常的因素等PSG 磷硅玻璃TF 薄膜PVD物理气相淀积PHO 光刻PCB 印刷电路板DIF 扩散RF 射频II 注入UV紫外线CVD 化学气相淀积VPE气相外延SPV 扩散长度Bubbler 鼓泡器CD 关键尺寸EMO 设备紧急按钮CD-SEM 线宽扫描电镜ScrubbLer 尾气处理器ETCH 刻蚀(腐蚀)Coat 包硅H2-BAKE 氢气烘烤SRP 外延层纵向电阻率分布1号液:(NH4OH:H2O2:H2O)NH4OH : H2O2 : H2O=1 : 2 : 7,2号液:(HCl:H2O2:H2O)HCl : H2O2 : H2O=1 : 2 : 53号液(Caros清洗液):(H2SO4:H2O2) H2SO4 : H2O2=3 : 1,4#号液:H2O:HF=10:1CV:电容-电压测试BOE混酸:氟化铵氢氟酸混合腐蚀液液CZ:切克劳斯基直拉法Wafer:抛光片FZ:区熔方法THK:膜厚Rs:电阻TTV:总厚度偏差TIR:平整度STIR:局部平整度LTO:背封BOW:弯曲度CHIP:崩边SLIP:滑移线MARK:痕迹WARP:翘曲度CRACK:裂纹SPOT: 斑点HAZE:发雾CROWN:皇冠,边缘突起物OISF:氧化诱生层错ORG: 掺As单晶抛光片O2含量径向均匀性OSF:氧化层错BMV:气体流量控制阀LIFE TIME:寿命POINT DEFECT: 点缺陷Integrated circuit:集成电路epitaxial layer:外延层Buried layer:埋层interface:界面Diameter:直径chemical vapor polish 化学气相抛光Polished surface :表面抛光back side ;反面Front side :正面INJ:引入气体流量DIL:稀释气体流量Autodoping:自掺杂Sccm:毫升/每分钟Slm:升/每分钟CDA:压缩空气PN2:工艺氮气Cable:电缆MES:生产过程执行管理系统SFC:生产车间集中MDC:生产数据及设备状态信息采集分析管理系统PDM:制造过程数据文档管理系统MSA:量具测量系统分析KPI:关键表现指标, 销售指标Alarm :报警MSA: 使用数据统计和图表的方法对测量系统的分辨率和误差进行分析QA: 指质量管理、品质的保证、质量的评估/评价QC: 指质量检验和控制、分析、改善和不合格品控制人员的总称OOC/oos:OOS:检验结果偏差超过规格、不合格OOC : 产品质量失去控制,需要采取返工、召回等手段。
半导体集成电路封装术语1 范围本文件规定了半导体集成电路封装在生产制造、工程应用和产品交验等方面使用的基本术语。
本文件适用于与半导体集成电路封装相关的生产、科研、教学和贸易等方面的应用。
2 规范性引用文件下列文件中的内容通过文中的规范性引用而构成本文件必不可少的条款。
其中,注日期的引用文件,仅该日期对应的版本适用于本文件;不注日期的引用文件,其最新版本(包括所有的修改单)适用于本文件。
GB/T 7092 半导体集成电路外形尺寸GB/T 9178 集成电路术语3 通用术语GB/T 9178界定的以及下列术语和定义适用于本文件。
3.1封装 package半导体集成电路的全包封或部分包封体,它提供:——机械保护;——环境保护;——外形尺寸。
封装可以包含或提供引出端,它对集成电路的热性能产生影响。
3.2底座 header封装体中用来安装半导体芯片并已具备了芯片焊接(粘接)、引线键合和引出端等功能的部分,它是封装结构的基体。
3.3底板 base在陶瓷或金属封装中,构成底座的一种片状陶瓷或金属零件。
3.4盖板(管帽) cap在陶瓷封装或金属底座上,采用金属或陶瓷制成片状或帽状结构,封接后对整个封装形成密封的一个零件。
3.5密封环 seal ring装在陶瓷封装表面上的一个金属或陶瓷件,在其上可焊接一个用于密封的盖板。
3.6引线框架 leadframes采用冲制或刻蚀工艺制造,使具有一定几何图形和规定外形尺寸,提供陶瓷封装、塑料封装或陶瓷熔封引出线的一个或一组金属零件。
引线框架各部位名称见图1a)、图1b)和图1c)。
a)陶瓷封装引线框架b)塑料封装引线框架(成型后)c ) 陶瓷熔封封装引线框架图1 引线框架3.7引线 lead安装在封装底板上用于电接触的金属线。
3.8引岀端 terminal封装上电接触的外接点,通常指引出线或端子。
3.9引岀端识别标志 terminal visual index鉴别第一引出端位置的参考特征(例如标记、凹槽、缺口、切角、凹陷或键等)。
《集成电路缩写》收集了一些常用的集成电路英文缩写及对应的全称和中文,希望对大家有用。
ICIntegrated Circuit 缩写,集成电路ICDSIC Design Service 缩写,芯片设计服务IPIntellectual Property 缩写, 知识产权,在芯片设计中指对某种设计技术的专利SoCSystem on Chip缩写, 指单芯片系统设计,是当今混合信号IC设计的趋势ASICApplication Special Integrated Circuit缩写, 指专用集成电路VLSIVery Large Scale Integrated circuit 缩写, 指超大规模集成电路DSPDigital Signal Processing 缩写, 指数字信号处理RFRadiation Frequency 缩写, 指发射频率,简称射频FPGAField Programmable Gate Array缩写, 指现场可编程门阵列CPLDComplex Programmable Logic Device, 即复杂可编程器件。
FEFront End 缩写, 前端,通常指IC设计中的前道逻辑设计阶段,并不是规范化用法BEBack End 缩写, 后端,通常指IC设计中的后道布局布线(Layout)阶段,并不是规范化用法MPWMultiple Project Wafer缩写, 多项目晶圆投片,指在同一种工艺的不同芯片放在同一块晶圆(Wafer)上流片,是小公司节省成本的有效手段EDAElectronic Design Automation缩写,电子设计自动化,现在IC设计中用EDA 软件工具实现布线,布局VHDLVHSIC(Very High Speed IC) Hardware Description Language 缩写, 硬件描述语言,用于实现电路逻辑设计的专用计算机语言RTLRegister Transformation Level 缩写, 寄存器传输级Netlist门级网表,一般是RTL Code经过综合工具综合而生成的网表文件Foundry指芯片制造加工厂的代工业务,负责将设计完成的芯片生产出来DFTDesign For Test 缩写, 为了增强芯片的可测性而采用的一种设计方法STAStatic Timing Analysis缩写, 即静态时序分析CADComputer Aided Design缩写, 即计算机辅助设计NRENon Recuuring Engineering缩写,不反复出现的工程成本BISTBuild in system test, 即内建测试系统ASSPApplication-specific standard product 缩写,一种有着广泛应用范围的ASIC芯片RISCReduced Instruction System Computer缩写LVSLayout versus Schematic 缩写,是在IC Design经过Layout后检查其版图与门级电路是否一致DRCDesign Rule Check缩写, 是在IC Design经过Layout后检查其版图是否符合设计规则ERCElectronic Rule Check缩写, 是在IC Design经过Layout后检查其版图是否符合电气规则OPCOptical and Process Correction缩写,即光刻工艺修正ATPGAuto Test Pattern Generator缩写, 是一个测试向量自动生成工具,生成的测试向量会给测试厂作测试芯片用LVDSLow Voltage Differential Signaling缩写, 是一种低摆幅的差分信号技术,它使得信号能在差分PCB线对或平衡电缆上以几百Mbps的速率传输,其低压幅和低电流驱动输出实现了低噪声和低功耗ADCAnalog to Digital Convert缩写, 一般用作模拟信号到数字信号的转换电路DACDigital to Analog Convert缩写, 一般用作数字信号到模拟信号的转换电路PLLPhase Locked Loop缩写, 一般用作时钟倍频电路。
半导体工艺英文缩写半导体工艺是半导体行业中的一个重要领域,涉及到半导体材料和器件的制造过程。
由于该领域技术含量高,专业术语较多,因此人们常常使用英文缩写来简化表达。
下面是一些常见的半导体工艺英文缩写及其解释:1.CMOS: 压缩氧化法半导体互补金属-氧化物半导体CMOS是一种常见的半导体工艺,它使用压缩氧化法在半导体材料上形成金属-氧化物半导体结构。
这种结构可以实现低功耗、低电压操作,并且在集成电路中应用广泛。
2.PVD: 物理气相沉积物理气相沉积是一种半导体材料薄膜制备的技术,它利用物理过程将固体材料转化为气体,然后在半导体表面沉积成薄膜。
这种技术可以实现高质量的薄膜制备,并且广泛用于半导体器件的制造。
3.CVD: 化学气相沉积化学气相沉积是一种半导体材料薄膜制备的技术,它利用化学反应将气体转化为固体材料,并在半导体表面沉积成薄膜。
这种技术可以实现较高的沉积速度和较大的沉积面积,并且在集成电路制造中得到广泛应用。
4.RTP: 快速热退火快速热退火是一种半导体工艺,它通过快速升温和冷却的方式来进行热处理。
这种工艺可以实现材料的结晶、再结晶和晶格调控,从而提高半导体器件的电学性能和稳定性。
5.DUV: 深紫外深紫外是一种波长较短的紫外光,通常用于半导体制造中的光刻工艺。
它具有较高的分辨率和较小的曝光误差,可以实现微细结构的制造和高精度印刷。
6.BEOL: 背端工艺背端工艺是指半导体制造中从晶圆电路层到封装层的工艺步骤,主要包括金属线路的布线、电压与数据传输的测试、集成电路封装等工作。
这些工艺步骤对于确保电路的正常运行和稳定性至关重要。
7.FEOL: 前端工艺前端工艺是指半导体制造中从晶圆加工到背端工艺之前的工艺步骤,主要包括晶圆清洁、刻蚀、沉积、光刻、扩散等工作。
这些工艺步骤对于制备高质量的半导体材料和器件起着关键作用。
总结起来,半导体工艺英文缩写是半导体行业中常用的专业术语,它简化了表达,加快了交流。
半导体常用缩写词汇汇总EPI 外延PM 设备维护与保养PCW 工艺冷却水PMC 生产计划与物料控制PLC 可编程序控制控制器H2 氢气Sb 锑N2 氮气As 砷SiHCl3(TCS)三氯氢硅 B 硼PH3 磷烷CMOS 互补金属氧化物半导体HCl 氯化氢CMP 化学机械抛光Hg 汞(水银)ESD静电释放HNO3 硝酸H2O2双氧水HF 氢氟酸MOS 金属氧化物半导体SPC 统计过程控制PCM 工艺控制监测MRB 异常评审委员会PCN 工艺变更通知单CAB 变更评审委员会ECN 工程变更通知单OCAP 失效控制计划。
指制程过程中失控时所应采取的对应措施。
是一种受控文件,包含造成异常的因素等PSG 磷硅玻璃TF 薄膜PVD物理气相淀积PHO 光刻PCB 印刷电路板DIF 扩散RF 射频II 注入UV紫外线CVD 化学气相淀积VPE气相外延SPV 扩散长度Bubbler 鼓泡器CD 关键尺寸EMO 设备紧急按钮CD-SEM 线宽扫描电镜ScrubbLer 尾气处理器ETCH 刻蚀(腐蚀)Coat 包硅H2-BAKE 氢气烘烤SRP 外延层纵向电阻率分布1号液:(NH4OH:H2O2:H2O)NH4OH : H2O2 : H2O=1 : 2 : 7,2号液:(HCl:H2O2:H2O)HCl : H2O2 : H2O=1 : 2 : 53号液(Caros清洗液):(H2SO4:H2O2) H2SO4 : H2O2=3 : 1,4#号液:H2O:HF=10:1CV:电容-电压测试BOE混酸:氟化铵氢氟酸混合腐蚀液液CZ:切克劳斯基直拉法Wafer:抛光片FZ:区熔方法THK:膜厚Rs:电阻TTV:总厚度偏差TIR:平整度STIR:局部平整度LTO:背封BOW:弯曲度CHIP:崩边SLIP:滑移线MARK:痕迹WARP:翘曲度CRACK:裂纹SPOT: 斑点HAZE:发雾CROWN:皇冠,边缘突起物OISF:氧化诱生层错ORG: 掺As单晶抛光片O2含量径向均匀性OSF:氧化层错BMV:气体流量控制阀LIFE TIME:寿命POINT DEFECT: 点缺陷Integrated circuit:集成电路epitaxial layer:外延层Buried layer:埋层interface:界面Diameter:直径chemical vapor polish 化学气相抛光Polished surface :表面抛光back side ;反面Front side :正面INJ:引入气体流量DIL:稀释气体流量Autodoping:自掺杂Sccm:毫升/每分钟Slm:升/每分钟CDA:压缩空气PN2:工艺氮气Cable:电缆MES:生产过程执行管理系统SFC:生产车间集中MDC:生产数据及设备状态信息采集分析管理系统PDM:制造过程数据文档管理系统MSA:量具测量系统分析KPI:关键表现指标, 销售指标Alarm :报警MSA: 使用数据统计和图表的方法对测量系统的分辨率和误差进行分析QA: 指质量管理、品质的保证、质量的评估/评价QC: 指质量检验和控制、分析、改善和不合格品控制人员的总称OOC/oos:OOS:检验结果偏差超过规格、不合格OOC : 产品质量失去控制,需要采取返工、召回等手段。
半导体集成电路常见封装缩写解释1. DIP(dual in-line PACkage)双列直插式封装。
插装型封装之一,引脚从封装两侧引出,封装材料有塑料和陶瓷两种。
DIP 是最普及的插装型封装,应用范围包括标准逻辑IC,存贮器LSI,微机电路等。
引脚中心距2.54mm,引脚数从6 到64。
封装宽度通常为15.2mm。
有的把宽度为7.52mm和10.16mm 的封装分别称为skinny DIP 和slim DIP(窄体型DIP)。
但多数情况下并不加区分,只简单地统称为DIP。
另外,用低熔点玻璃密封的陶瓷DIP 也称为Cerdip(见C erdip)。
BGA是英文Ball Grid Array Package的缩写,即球栅阵列封装。
SOP小型外引脚封装Small Outline Package ro0c[hi^M 4srs?}JSSOP收缩型小外形封装Shrink Small Outline Package P-pBI%{p)与SOP的区别:近似小外形封装,但宽度要比小外形封装更窄,可节省组装面积的新型封装。
2. DIP(dual tape carrier PACkage)同上。
日本电子机械工业会标准对DTCP 的命名(见DTCP)。
QTCP(quad tape carrier PACkage)四侧引脚带载封装。
TCP 封装之一,在绝缘带上形成引脚并从封装四个侧面引出。
是利用TAB 技术的薄型封装(见TAB、TCP)。
COB(chip on board)板上芯片封装,是裸芯片贴装技术之一,半导体芯片交接贴装在印刷线路板上,芯片与基板的电气连接用引线缝合方法实现,芯片与基板的电气连接用引线缝合方法实现,并用树脂覆盖以确保可靠性。
虽然COB 是最简单的裸芯片贴装技术,但它的封装密度远不如TAB 和倒片焊技术。
JLCC(J-leaded chip carrier)J 形引脚芯片载体。
指带窗口CLCC 和带窗口的陶瓷QFJ 的别称(见CLCC 和QFJ)。
部分半导体厂家采用的名称。
QTP(quad tape carrier PACkage)四侧引脚带载封装。
日本电子机械工业会于1993 年4 月对QTCP 所制定的外形规格所用的名称(见TCP)。
SO(small out-line)SOP 的别称。
世界上很多半导体厂家都采用此别称。
(见SOP)。
SOI(small out-line I-leaded PACkage)I 形引脚小外型封装。
表面贴装型封装之一。
引脚从封装双侧引出向下呈I 字形,中心距1.27mm。
贴装占有面积小于SOP。
日立公司在模拟IC(电机驱动用IC)中采用了此封装。
引脚数26。
SOW(Small Outline PACkage(Wide-Jype))宽体SOP。
部分半导体厂家采用的名称。
SH-DIP(shrink dual in-line PACkage)同SDIP。
部分半导体厂家采用的名称。
SIL(single in-line)SIP 的别称(见SIP)。
欧洲半导体厂家多采用SIL 这个名称。
SIMM(single in-line memory module)单列存贮器组件。
只在印刷基板的一个侧面附近配有电极的存贮器组件。
通常指插入插座的组件。
标准SIMM 有中心距为2.54mm 的30 电极和中心距为1.27 mm 的72 电极两种规格。
在印刷基板的单面或双面装有用SOJ 封装的1 兆位及4 兆位DRAM 的SIMM 已经在个人计算机、工作站等设备中获得广泛应用。
至少有30~40%的DRAM 都装配在SIMM 里。
DSO(dual small out-lint)双侧引脚小外形封装。
SOP 的别称(见SOP)。
部分半导体厂家采用此名称。
SOIC(small out-line integrated circuit)SOP 的别称(见SOP)。
国外有许多半导体厂家采用此名称。
SIP(single in-line PACkage)单列直插式封装。
引脚从封装一个侧面引出,排列成一条直线。
当装配到印刷基板上时封装呈侧立状。
引脚中心距通常为2.54mm,引脚数从2 至23,多数为定制产品。
封装的形状各异。
也有的把形状与ZIP 相同的封装称为SIP。
SQL(Small Out-Line L-leaded PACkage)按照JEDEC(美国联合电子设备工程委员会)标准对SOP 所采用的名称(见SOP)。
QUIP(quad in-line PACkage)四列引脚直插式封装。
引脚从封装两个侧面引出,每隔一根交错向下弯曲成四列。
引脚中心距1.27mm,当插入印刷基板时,插入中心距就变成2.5mm。
因此可用于标准印刷线路板。
是比标准DIP 更小的一种封装。
日本电气公司在台式计算机和家电产品等的微机芯片中采用了些种封装。
材料有陶瓷和塑料两种。
引脚数64。
SK-DIP(skinny dual in-line PACkage)DIP 的一种。
指宽度为7.62mm、引脚中心距为2.54mm 的窄体DIP。
通常统称为DIP(见DIP)。
SOJ(Small Out-Line J-Leaded PACkage)J 形引脚小外型封装。
表面贴装型封装之一。
引脚从封装两侧引出向下呈J 字形,故此得名。
通常为塑料制品,多数用于DRAM 和SRAM 等存储器LSI 电路,但绝大部分是DRAM。
用SOJ封装的DRAM 器件很多都装配在SIMM 上。
引脚中心距1.27mm,引脚数从20 至40(见SIMM)。
CQFP(quad fiat PACkage with guard ring)带保护环的四侧引脚扁平封装。
塑料QFP 之一,引脚用树脂保护环掩蔽,以防止弯曲变形。
在把LSI 组装在印刷基板上之前,从保护环处切断引脚并使其成为海鸥翼状(L 形状)。
这种封装在美国Motorola 公司已批量生产。
引脚中心距0.5mm,引脚数最多为208 左右。
H-(with heat sink)表示带散热器的标记。
例如,HSOP 表示带散热器的SOP。
LCC(Leadless chip carrier)无引脚芯片载体。
指陶瓷基板的四个侧面只有电极接触而无引脚的表面贴装型封装。
是高速和高频IC 用封装,也称为陶瓷QFN 或QFN-C(见QFN)。
SL-DIP(slim dual in-line PACkage)DIP 的一种。
指宽度为10.16mm,引脚中心距为2.54mm 的窄体DIP。
通常统称为DIP。
SONF(Small Out-Line Non-Fin)无散热片的SO P。
与通常的SOP 相同。
为了在功率IC 封装中表示无散热片的区别,有意增添了NF(non-fin)标记。
部分半导体厂家采用的名称(见SOP)。
SDIP(shrink dual in-line PACkage)收缩型DIP。
插装型封装之一,形状与DIP 相同,但引脚中心距(1.778mm)小于DIP(2.54mm),因而得此称呼。
引脚数从14 到90。
也有称为SH-DIP 的。
材料有陶瓷和塑料两种。
FQFP(fine pitch quad flat PACkage)小引脚中心距QFP。
通常指引脚中心距小于0.65mm 的QFP(见QFP)。
部分导导体厂家采用此名称。
CPAC(globe top pad array carrier)美国Motorola 公司对BGA 的别称(见BGA)。
SMD(surface mount devices)表面贴装器件。
偶而,有的半导体厂家把SOP 归为SMD(见SOP)。
QUIL(quad in-line)QUIP 的别称(见QUIP)。
DICP(dual tape carrier PACkage)双侧引脚带载封装。
TCP(带载封装)之一。
引脚制作在绝缘带上并从封装两侧引出。
由于利用的是TAB(自动带载焊接)技术,封装外形非常薄。
常用于液晶显示驱动LSI,但多数为定制品。
另外,0.5mm 厚的存储器LSI 簿形封装正处于开发阶段。
在日本,按照EIAJ(日本电子机械工业)会标准规定,将DICP 命名为DTP。
pin grid array(surface mount type)表面贴装型PGA。
通常PGA 为插装型封装,引脚长约3.4mm。
表面贴装型PG A 在封装的底面有陈列状的引脚,其长度从1.5mm 到2.0mm。
贴装采用与印刷基板碰焊的方法,因而也称为碰焊PGA。
因为引脚中心距只有1.27mm,比插装型PGA 小一半,所以封装本体可制作得不怎么大,而引脚数比插装型多(250~5 28),是大规模逻辑LSI 用的封装。
封装的基材有多层陶瓷基板和玻璃环氧树脂印刷基数。
以多层陶瓷基材制作封装已经实用化。
flip-chip倒焊芯片。
裸芯片封装技术之一,在LSI 芯片的电极区制作好金属凸点,然后把金属凸点与印刷基板上的电极区进行压焊连接。
封装的占有面积基本上与芯片尺寸相同。
是所有封装技术中体积最小、最薄的一种。
但如果基板的热膨胀系数与LSI 芯片不同,就会在接合处产生反应,从而影响连接的可靠性。
因此必须用树脂来加固LSI 芯片,并使用热膨胀系数基本相同的基板材料。
FP(flat PACkage)扁平封装。
表面贴装型封装之一。
QFP 或SOP(见QFP 和SOP)的别称。
部分半导体厂家采用此名称。
SOF(small Out-Line PACkage)小外形封装。
表面贴装型封装之一,引脚从封装两侧引出呈海鸥翼状(L 字形)。
材料有塑料和陶瓷两种。
另外也叫SOL 和DFP。
SOP 除了用于存储器LSI 外,也广泛用于规模不太大的ASSP 等电路。
在输入输出端子不超过10~40 的领域,SOP 是普及最广的表面贴装封装。
引脚中心距1.27mm,引脚数从8~44。
另外,引脚中心距小于1.27mm 的SOP 也称为SSOP;装配高度不到1.27mm 的SOP 也称为TSOP(见SSOP、TSOP)。
还有一种带有散热片的SOP。
LGA(land grid array)触点陈列封装。
即在底面制作有阵列状态坦电极触点的封装。
装配时插入插座即可。
现已实用的有227 触点(1.27mm 中心距)和447 触点(2.54mm 中心距)的陶瓷LGA,应用于高速逻辑LSI 电路。
LGA 与QFP 相比,能够以比较小的封装容纳更多的输入输出引脚。
另外,由于引线的阻抗小,对于高速LSI 是很适用的。
但由于插座制作复杂,成本高,现在基本上不怎么使用。
预计今后对其需求会有所增加。
MCM(multi-chip module)多芯片组件。
将多块半导体裸芯片组装在一块布线基板上的一种封装。
根据基板材料可分为MCM-L,MCM-C 和MCM-D 三大类。