光刻工艺讲义
- 格式:pdf
- 大小:498.26 KB
- 文档页数:20





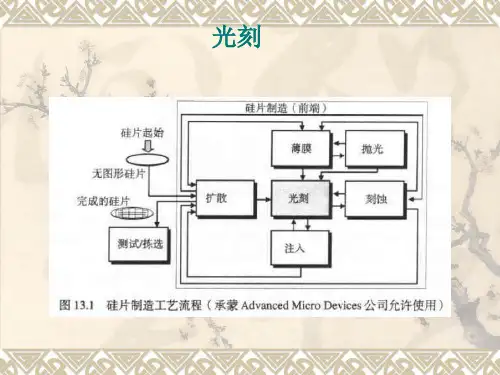


光刻工艺培训教程2009年10月31日星期六15:51一. 总纲1. 什么是光刻?对光刻总的质量要求是什么?光刻就是将掩膜版上的几何图形转移到涂有一层光刻胶的硅片表面的工艺过程。
对光刻总的质量要求为:①条宽符合指标要求②套刻精度符合指标要求③胶厚符合指标要求④无缺陷⑤胶图形具有较好的抗腐蚀能力2. 在我们生产线的工艺中,一般有那些光刻工序层次?其中那些是关键层,为什么称之为关键层?对不同的工艺流程,光刻的层次可能会有所不同,一个典型的1.0微米单多晶双铝工艺一般需要有如下的光刻层次:阱,有源区,场注,多晶,N-LDD,N+S/D,P+S/D,接触孔,孔注,金属-1,通孔,金属-2,钝化孔。
其中,有源区,多晶,接触孔,金属-1,通孔,金属-2我们称之为关键层。
之所以称之为关键层,是因为这些层次的光刻:①直接影响器件的电学性能或对最终成品率有重大影响②条宽要求最严格③套刻精度要求最严格3. 典型的光刻流程。
一个典型的光刻全过程为:硅片表面预处理→涂胶(去边)→前烘→(对位)曝光→PEB烘→显影→后烘→显检(测量)二. 涂胶前处理1. 涂胶前为什么要进行增粘处理?一般可利用亲水/疏水理论对其进行解释。
由于衬底表面吸水存在氢氧基团,使疏水的光刻胶无法与亲水的硅片表面结合良好。
通常的方法是使用hydroxy getter化学方法去除表面的OH基团,一般采用alkylsilane compounds,如HMDS.2. 使用烘箱进行HMDS增粘处理要注意那些问题?使用烘箱进行HMDS增粘处理的注意事项:①预处理完的硅片应在一定的时间内尽快涂胶,以免表面吸附空气中的水分,降低增粘效果。
但同时也要充分冷却,因硅片的温度对胶厚有很大的影响。
②反复预处理反而会降低增粘效果。
③HMDS的瓶盖打开后,其寿命有限,一定要尽快用完。
三. 涂胶1. 对涂胶总的质量要求是什么?对涂胶总的质量要求为:①胶厚符合指标要求②均匀性符合指标要求③缺陷少④去边整齐⑤硅片背面沾污小2. 涂胶的典型过程。



第六章光刻工艺第六章
第一节引言---集成电路中的图形
集成电路发展趋势
引言---基本概念(1)光刻
正胶光刻与负胶光刻引言-基本概念(2)VLSI对光刻工艺的要求光刻工艺控制
第二节光刻胶---化学性质与作用光刻胶的组成
光刻胶的分类正胶和负胶的显影后剖面
第三节光学光刻
光刻前的表面处理
自高温炉管取出的氧化片应立即涂胶,
HMDS Priming(涂底)光刻胶的粘附性要求
涂胶
前烘
对准曝光光学光刻
紫外光谱范围的划分
曝光后烘烤(PEB)
驻波效应
显影后烘
光刻分辨率(1)光刻分辨率(2)
实际的光学系统分辨率受光刻胶和曝光系光刻分辨率(3)光学光刻---对准曝光系统
接触/接近式对准曝光系统示意图接触式对准曝光系统(1)接触式对准曝光系统(2)接近式对准曝光系统
接触/接近式对准曝光系统的分辨率接触/接近式对准曝光系统的缺点投影式对准曝光系统
透射式扫描投影对准曝光系统示意图扫描投影对准曝光系统(1)
扫描投影对准曝光系统(3)扫描投影对准曝光系统(2)
曝光:曝光灯发出的光束经聚光灯和滤光片后,
分步重复式投影曝光系统(1)步进式投影曝光示意图
分步重复式投影曝光系统(2)分步重复式投影曝光系统(3)分步重复式投影曝光系统(4)常用的几种曝光方式(1)
常用的几种曝光方式(2)常用的几种曝光方式(3)光刻机的质量指标光刻质量检查
线宽检查和套刻对准图形举例
掩模版相关技术介绍
对准测量图形
掩模版的基本结构
基材是石英玻璃:具有低膨胀系数、低钠
光刻掩模版结构示意图第四节光学光刻的限制及光刻新技术展望光学光刻的限制多层光刻胶结构
变形照明技术(1)变形照明技术(2)相移式掩模版技术非光学光刻技术
X-ray曝光系统电子束曝光系统。