Si_3N_4膜pH-ISFET输出特性研究
- 格式:pdf
- 大小:1.29 MB
- 文档页数:4

西南交通大学硕士研究生学位论文第20页3.3薄膜表面形貌分析图3-3Ti-N薄膜的表面形貌(a)1#。
P№/P^,=0.08,Ubi椰=150V,P,MS=5.030hm(b)3#,P№/P^r:0.17,Ubm--150V,P,MS=3.503nm(c)4#,P№/P.,:o.25,Ubm=150V,PnJS=2.988nm(d)5#,Pm/P^,:0.17,Ub-.=50V。
P¥IS=5.526nm图3—3为不同工艺参数下制备的Ti州薄膜的三维原子力显微镜图片。
从图片可以观察到,随着R√P^,的增加(1#,3#,4#),氮化钛薄膜越来越平滑,表面粗糙度依次减小(从5.030nto减小为3.503nm,最后减小至2.988nm)。
从AFM长的磨损寿命(2it),继而开始不断下降。
薄膜的磨损寿命随氮气/氩气分压比的变化趋势与薄膜复合硬度随氮气/氩气分压比的变化趋势一致。
可见薄膜的硬度与薄膜的耐磨损性能关系密切。
薄膜硬度越高,薄膜抗磨损能力越强。
从磨痕的光学照片分析出TiN薄膜的磨损机理是微观切削与疲劳磨损的综合作用。
所以当薄膜相结构中存在亚稳态的Ti:N相时,薄膜硬度显著提高,薄膜的耐磨损性能也达到最优。
图3-6TiN/TidAl·V磨痕形貌(a)l#,P*/P,一=O.08(b)2#,P√P^r=o.i0(c)3#,%/P^r-o.17(d)4#。
%/P,,=0.25西南交通大学硕士研究生学位论文第30页从图谱中看到Ti/TiN多层膜主要由TiN(111),TIN(200),Ti(002),Ti(101)等结构组成,同时在图谱中还出现了峰强较弱,峰形很宽的Ti2N和TiNo3相结构。
非饱和的TiNx相的形成主要是因为多层膜制备过程中,纯Ti层和TiN层之间的转换过程,溅射过程一直在进行,而此时氮气流量却在0seem到8sccm之间变化,由于靶中毒和氮气流量的变化造成不饱和TiNx相的形成。

Si3N4基陶瓷的制备及性能研究的开题报告
一、选题背景及意义
Si3N4基陶瓷具有高温强度、耐磨损、抗氧化、耐腐蚀等特殊性能,在航天、航空、汽车和电子等领域应用广泛。
然而,目前Si3N4基陶瓷
制备及性能研究中仍存在一些问题,如制备工艺不稳定、性能需进一步
提高等。
因此,本研究旨在探究一种高效、稳定的Si3N4基陶瓷制备工艺,
以及针对其性能进行深入研究,为该陶瓷材料的应用提供新的理论依据
和实践经验。
二、研究方法和步骤
1. 实验室合成Si3N4基陶瓷原材料;
2. 采用不同的制备工艺制备Si3N4基陶瓷,如热压烧结、电子束熔
化等;
3. 对制备工艺中的参数进行优化;
4. 对不同制备工艺得到的Si3N4基陶瓷进行性能测试,如力学性能
测试、烧蚀性能测试、氧化性能测试等;
5. 对比不同制备工艺得到的Si3N4基陶瓷性能,并分析其差异原因。
三、预期结果
通过本研究,预计可以找到一种高效稳定的Si3N4基陶瓷制备工艺,并且取得优异的力学性能、烧蚀性能和氧化性能等方面的表现。
同时,
也可以为该陶瓷的应用提供理论依据和实践经验。
四、研究意义
1. 在航天、航空、汽车和电子等领域提高Si3N4基陶瓷的应用性能;
2. 探索新的Si3N4基陶瓷制备工艺,提高其制备效率和稳定性;
3. 为其他陶瓷材料的制备和性能研究提供借鉴。


利用CMOS技术实现pH离子敏场效应晶体管作为测量溶液离子组分及浓度的敏感元件,相对当前应用于医疗诊断检测的离子电极挑选技术(ISE)具有体积小、全固态、低功耗和便于集成的优点[1]。
鉴于目前各类的研制趋向于微型化﹑集成化和智能化的进展方向,将ISFET传感器的敏感单元与信号读取集成于同一芯片也就成为了业界对此类传感器的讨论热点。
ISFET器件与结构极其相像,而工艺已经成为微工业的主流创造工艺;因此,利用CMOS技术,便可实现ISFET与信号处理电路及其他敏感单元的阵列集成。
2 ISFET器件结构及电学特性ISFET是离子敏感、挑选电极创造技术与固态微电子学相结合的产物。
最初,此类器件由MOSFET改良而成(金属栅或多晶硅被离子敏感膜代替), 比较两者结构1所示。
用法时,离子敏感膜和电解质溶液共同形成器件的栅极,溶液与敏感膜之间产生的电化学势ψ,将使FET的阈值VTh发生调制效应,使沟道电导发生变幻[3]。
选取不同的敏感膜可以检测不同离子的浓度(如K+,Na+,Ca2+,Cl-,H+,Br-等)。
目前讨论最为成熟的是对H+敏感膜的讨论,通常选取的材料有SiO2,Si3N4,Al2O3或Ta2O5等[4],都能对溶液pH值的变幻产生比较敏捷的响应。
以Si3N4为敏感材料的n沟道ISFET的VTh受pH影响的表达式为[5](临时忽视衬底体效应的影响)而n沟道MOSFET的阈值电压为VTh(n)=φES--2φf (2)上述两式中,φES为与电极相连的电介质与半导体之间的功函数;Qss 是绝缘体与半导体界面的单位面积的表面态电荷密度;Qsc是半导体沟道耗尽区域单位面积的电荷;φf是体硅的费米势;S是pH敏感层的敏捷系数。
此外,pHpzc是ISFET绝缘层零电荷的pH值。
尽管ISFET 与MOSFET阈值电压不尽相同,但是相像的物理结构打算了两者具有相第1页共5页。
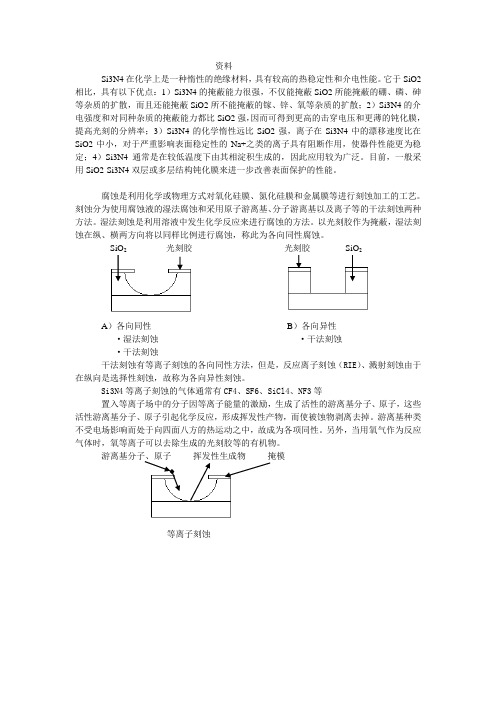
资料Si3N4在化学上是一种惰性的绝缘材料,具有较高的热稳定性和介电性能。
它于SiO2相比,具有以下优点:1)Si3N4的掩蔽能力很强,不仅能掩蔽SiO2所能掩蔽的硼、磷、砷等杂质的扩散,而且还能掩蔽SiO2所不能掩蔽的镓、锌、氧等杂质的扩散;2)Si3N4的介电强度和对同种杂质的掩蔽能力都比SiO2强,因而可得到更高的击穿电压和更薄的钝化膜,提高光刻的分辨率;3)Si3N4的化学惰性远比SiO2强,离子在Si3N4中的漂移速度比在SiO2中小,对于严重影响表面稳定性的Na+之类的离子具有阻断作用,使器件性能更为稳定;4)Si3N4通常是在较低温度下由其相淀积生成的,因此应用较为广泛。
目前,一般采用SiO2-Si3N4双层或多层结构钝化膜来进一步改善表面保护的性能。
腐蚀是利用化学或物理方式对氧化硅膜、氮化硅膜和金属膜等进行刻蚀加工的工艺。
刻蚀分为使用腐蚀液的湿法腐蚀和采用原子游离基、分子游离基以及离子等的干法刻蚀两种方法。
湿法刻蚀是利用溶液中发生化学反应来进行腐蚀的方法。
以光刻胶作为掩蔽,湿法刻蚀在纵、横两方向将以同样比例进行腐蚀,称此为各向同性腐蚀。
SiO2光刻胶光刻胶SiO2A)各向同性B)各向异性·湿法刻蚀·干法刻蚀·干法刻蚀干法刻蚀有等离子刻蚀的各向同性方法,但是,反应离子刻蚀(RIE)、溅射刻蚀由于在纵向是选择性刻蚀,故称为各向异性刻蚀。
Si3N4等离子刻蚀的气体通常有CF4、SF6、SiCl4、NF3等置入等离子场中的分子因等离子能量的激励,生成了活性的游离基分子、原子,这些活性游离基分子、原子引起化学反应,形成挥发性产物,而使被蚀物剥离去掉。
游离基种类不受电场影响而处于向四面八方的热运动之中,故成为各项同性。
另外,当用氧气作为反应气体时,氧等离子可以去除生成的光刻胶等的有机物。
挥发性生成物掩模等离子刻蚀氮化硅是一种具有很高的化学稳定性的绝缘材料,它比二氧化硅更加耐酸,除HF和热磷酸能缓慢地腐蚀它外,其他的酸几乎不与它反应.但是氮化硅对强碱和氧化剂是不稳定的.由于氮化硅膜致密,气体和水气难以透入,疏水性好,针孔密度低,导热性能比SiO2好.氮化硅的掩蔽能力很强,不仅能掩蔽二氧化硅所能掩蔽的硼、磷、砷等杂质的扩散,而且还能掩蔽二氧化硅所不能掩蔽的镓、锌和氧等杂质的扩散;氮化硅的介电强度和对同种杂质的掩蔽能力都比二氧化硅强,因而得到更高的击穿电压和更薄的钝化膜,提高光刻的分辨率。

资料Si3N4在化学上是一种惰性的绝缘材料,具有较高的热稳定性和介电性能。
它于SiO2相比,具有以下优点:1)Si3N4的掩蔽能力很强,不仅能掩蔽SiO2所能掩蔽的硼、磷、砷等杂质的扩散,而且还能掩蔽SiO2所不能掩蔽的镓、锌、氧等杂质的扩散;2)Si3N4的介电强度和对同种杂质的掩蔽能力都比SiO2强,因而可得到更高的击穿电压和更薄的钝化膜,提高光刻的分辨率;3)Si3N4的化学惰性远比SiO2强,离子在Si3N4中的漂移速度比在SiO2中小,对于严重影响表面稳定性的Na+之类的离子具有阻断作用,使器件性能更为稳定;4)Si3N4通常是在较低温度下由其相淀积生成的,因此应用较为广泛。
目前,一般采用SiO2-Si3N4双层或多层结构钝化膜来进一步改善表面保护的性能。
腐蚀是利用化学或物理方式对氧化硅膜、氮化硅膜和金属膜等进行刻蚀加工的工艺。
刻蚀分为使用腐蚀液的湿法腐蚀和采用原子游离基、分子游离基以及离子等的干法刻蚀两种方法。
湿法刻蚀是利用溶液中发生化学反应来进行腐蚀的方法。
以光刻胶作为掩蔽,湿法刻蚀在纵、横两方向将以同样比例进行腐蚀,称此为各向同性腐蚀。
SiO2光刻胶光刻胶SiO2A)各向同性B)各向异性·湿法刻蚀·干法刻蚀·干法刻蚀干法刻蚀有等离子刻蚀的各向同性方法,但是,反应离子刻蚀(RIE)、溅射刻蚀由于在纵向是选择性刻蚀,故称为各向异性刻蚀。
Si3N4等离子刻蚀的气体通常有CF4、SF6、SiCl4、NF3等置入等离子场中的分子因等离子能量的激励,生成了活性的游离基分子、原子,这些活性游离基分子、原子引起化学反应,形成挥发性产物,而使被蚀物剥离去掉。
游离基种类不受电场影响而处于向四面八方的热运动之中,故成为各项同性。
另外,当用氧气作为反应气体时,氧等离子可以去除生成的光刻胶等的有机物。
挥发性生成物掩模等离子刻蚀氮化硅是一种具有很高的化学稳定性的绝缘材料,它比二氧化硅更加耐酸,除HF和热磷酸能缓慢地腐蚀它外,其他的酸几乎不与它反应.但是氮化硅对强碱和氧化剂是不稳定的.由于氮化硅膜致密,气体和水气难以透入,疏水性好,针孔密度低,导热性能比SiO2好.氮化硅的掩蔽能力很强,不仅能掩蔽二氧化硅所能掩蔽的硼、磷、砷等杂质的扩散,而且还能掩蔽二氧化硅所不能掩蔽的镓、锌和氧等杂质的扩散;氮化硅的介电强度和对同种杂质的掩蔽能力都比二氧化硅强,因而得到更高的击穿电压和更薄的钝化膜,提高光刻的分辨率。
si3n4陶瓷的相对磁导率和电导率解释说明1. 引言1.1 概述本篇文章旨在探讨si3n4陶瓷的相对磁导率和电导率,从而深入了解该材料在不同领域中的应用。
通过对si3n4陶瓷的定义、影响因素以及应用领域进行分析,可以为进一步研究和开发新型陶瓷材料提供参考。
1.2 文章结构本文将分为五个主要部分进行阐述。
首先,引言部分将概述文章的背景和目标。
其次,将重点介绍si3n4陶瓷的相对磁导率,并探讨其定义与解释、影响因素以及应用领域。
然后,进一步讨论si3n4陶瓷的电导率,包括其定义与解释、影响因素以及具体应用领域。
接下来,在实验方法与结果分析部分,我们将介绍实验设计与操作步骤,并对结果数据进行整理和分析。
最后,我们将得出结论,并总结si3n4陶瓷的相对磁导率和电导率方面的重要性和应用前景。
1.3 目的本文旨在全面了解si3n4陶瓷在相对磁导率和电导率方面的性质。
通过对其相对磁导率和电导率的定义、影响因素以及应用领域的研究,我们可以更好地理解该材料的特点和潜力。
同时,本文还将介绍一种实验方法来测定si3n4陶瓷的相对磁导率和电导率,并对实验结果进行分析和讨论。
通过这些工作,我们可以为未来的陶瓷材料研究提供参考,并拓宽该领域的应用范围。
2. si3n4陶瓷的相对磁导率2.1 定义与解释si3n4陶瓷的相对磁导率是指材料在外加磁场下的响应能力,即其吸收和重新释放磁场的性质。
相对磁导率通常用符号μr表示,是单位体积内磁感应强度与外加磁场强度之比。
2.2 影响因素si3n4陶瓷的相对磁导率受多种因素影响。
其中最主要的因素是材料本身的结构及其内部微观特征。
例如,晶体结构中存在的缺陷、晶粒尺寸和形态、晶界等都会对相对磁导率产生影响。
此外,温度变化和外加电场也可以改变si3n4陶瓷的相对磁导率。
2.3 应用领域由于si3n4陶瓷具有较高的绝缘性能和优异的机械性能,它在许多领域有着广泛应用。
相对磁导率作为si3n4陶瓷性能的一个指标,在以下应用方面起到重要作用:1) 电子器件:由于si3n4陶瓷的绝缘性能,它可以用作电子器件的绝缘材料和基座。