【资料】集成电路制造工艺流程(漫画)汇编
- 格式:ppt
- 大小:7.51 MB
- 文档页数:48






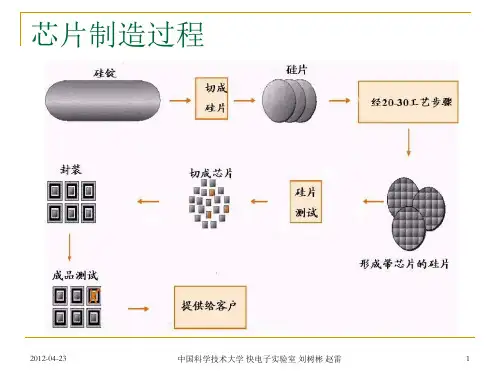


集成电路制造工艺流程介绍集成电路已经在各行各业中发挥着非常重要的作用,是现代信息社会的基石。
集成电路设计:一般英文称为IC,integrated circuit,涉及对电子器件 例如晶体管、电阻器、电容器等)、器件间互连线模型的建立。
所有的器件和互连线都需安置在一块半导体衬底材料之上,这些组件通过半导体器件制造工艺 例如光刻等)安置在单一的硅衬底上,从而形成电路。
集成电路的制作,是将设计好的电路图通过众多复杂的工艺构建在事先准备好的硅片上,最后进行封测的过程。
这一过程需要半导体材料、设备、洁净工程等上游产业链作为支撑。
成电路设计与制造的主要流程一颗芯片的诞生,可分为芯片设计、芯片制造和封装三个环节。
一、芯片设计客户提出设计要求,IC设计工程师完成逻辑电路的设计,将设计图转化成电路图,进行软件测试验证,看是否符合客户需求,最后将电路图以光罩的形式制作出来,用于下一步制造使用。
二、芯片制造IC制造分为两大环节:晶圆制造和晶圆加工。
晶圆(wafer),是制造各式电脑芯片的基础。
我们可以将芯片制造想象成用乐高积木盖房子,即由一层又一层的堆叠,完成自己期望的造型(也就是各式芯片)。
为了做出一座完美、稳固的房子,我们需要有一个良好的地基,也就是一个平稳的基板。
对芯片制造来说,这个基板就是“晶圆”。
晶圆制造就是利用二氧化硅作为原材料制作单晶硅硅片的过程。
单晶硅片的生产流程是:拉晶--滚磨--线切割--倒角--研磨--腐蚀--热处理--边缘抛光--正面抛光--清洗--检测--外延等步骤,其中拉晶、研磨和抛光是保证半导体硅片质量的关键。
晶圆加工:指在晶圆上制作逻辑电路的过程,在硅片上进行扩散、沉积、光刻、刻蚀、离子注入、抛光、金属化等操作,这些都是在晶圆洁净厂房进行的。
三、IC封测对晶圆进行减薄、切割、贴片、引线键合、封装、测试的过程。
半导体制造最后一个制程为测试,测试制程可分成初步测试与最终测试,其主要目的除了为保证顾客所要的货无缺点外,也将依规格划分IC的等级。
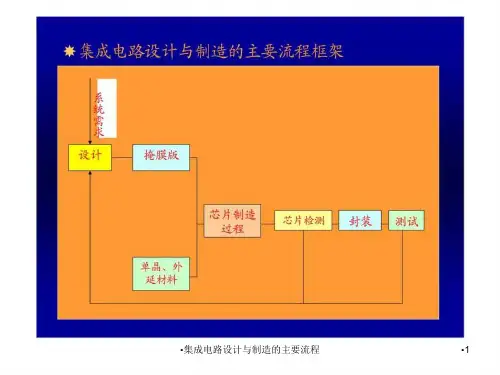

集成电路制造工艺流程1.晶圆制造( 晶体生长-切片-边缘研磨-抛光-包裹-运输 )晶体生长(Crystal Growth)晶体生长需要高精度的自动化拉晶系统。
将石英矿石经由电弧炉提炼,盐酸氯化,并经蒸馏后,制成了高纯度的多晶硅,其纯度高达0.99999999999。
采用精炼石英矿而获得的多晶硅,加入少量的电活性“掺杂剂”,如砷、硼、磷或锑,一同放入位于高温炉中融解。
多晶硅块及掺杂剂融化以后,用一根长晶线缆作为籽晶,插入到融化的多晶硅中直至底部。
然后,旋转线缆并慢慢拉出,最后,再将其冷却结晶,就形成圆柱状的单晶硅晶棒,即硅棒。
此过程称为“长晶”。
硅棒一般长3英尺,直径有6英寸、8英寸、12英寸等不同尺寸。
硅晶棒再经过研磨、抛光和切片后,即成为制造集成电路的基本原料——晶圆。
切片(Slicing) /边缘研磨(Edge Grinding)/抛光(Surface Polishing)切片是利用特殊的内圆刀片,将硅棒切成具有精确几何尺寸的薄晶圆。
然后,对晶圆表面和边缘进行抛光、研磨并清洗,将刚切割的晶圆的锐利边缘整成圆弧形,去除粗糙的划痕和杂质,就获得近乎完美的硅晶圆。
包裹(Wrapping)/运输(Shipping)晶圆制造完成以后,还需要专业的设备对这些近乎完美的硅晶圆进行包裹和运输。
晶圆输送载体可为半导体制造商提供快速一致和可靠的晶圆取放,并提高生产力。
2.沉积外延沉积 Epitaxial Deposition在晶圆使用过程中,外延层是在半导体晶圆上沉积的第一层。
现代大多数外延生长沉积是在硅底层上利用低压化学气相沉积(LPCVD)方法生长硅薄膜。
外延层由超纯硅形成,是作为缓冲层阻止有害杂质进入硅衬底的。
过去一般是双极工艺需要使用外延层,CMOS技术不使用。
由于外延层可能会使有少量缺陷的晶圆能够被使用,所以今后可能会在300mm晶圆上更多采用。
9.晶圆检查Wafer Inspection (Particles)在晶圆制造过程中很多步骤需要进行晶圆的污染微粒检查。