根据紫外-可见光谱计算半导体能带Eg
- 格式:doc
- 大小:20.50 KB
- 文档页数:2

第五章固体材料的能带结构和光响应性能5.1半导体能带宽度的测定及其与粒子尺度的关系54.1半导体能带宽度Eg值的测量*半导体的光化学吸收性能直接与其禁带宽度Eg值有关。
对于单一的半导体,其禁带宽度Eg —般为固定值,只有当材料的晶粒尺寸小到纳米级时,Eg值才会增加,即出现最子尺度效应。
而对于负载或复合型的半导体,其Eg值既受到载体分散对半导体晶粒尺度减小的影响,又受到由于半导体复合引起的能量变化的影响,进而直接改变整个材料的紫外光响应性能。
因此对材料的Eg值进行测量,研究材料Eg值的变化,对于测定光催化的紫外光响应性能具有重要的意义。
目前,常用的方法是采用紫外可见漫反射光谱仪及Kubella-munk函数卩(心)对材料的Eg值进行估算I®。
K・M函数可表示为:Fg = Q-RH2Rg = KIS(5-1)其中&为测得的反射率,心=Rurnphf(卜2)K为吸收系数,S为散射系数。
假定散射系数对于所测样品均匀一致的前提下,心可以得到均衡吸收。
将函数尸(心)的吸收曲线的切线外延至吸收等于零,则可确定相应半导体的吸光阀值Eg.在实验的测定中,由于紫外一可见漫反射光谱仪能直接输出的曲线图F(心)~2,故可直接将其转化为相应的曲线(F(&>h-2〜,并做吸收带边的切线与X轴的交点来确定其Eg值。
其中hv 为入射光子的能蚤,可表示为:h% 犷1240/心)(5-3)以Ti6的能带宽度Eg值的测量为例。
MU(Mir)图54 TiO 2的Fg ~久曲线图Fig.5-1 theF (RJ~2 figure ofTiO 2将上述测得的曲线图尸仗)"直接转化为相应的曲线(m )hp )2〜2, 并做吸收带边的切线与X 轴的交点来确定其Eg 值。
800 「― .......................... ‘Q ------------- ------------------------------------------------------- —图&2TiO 2的F (X )~九曲线图Fig.5-2 theFgJ 〜兄 figure of TiO 2即测得TiCh 的Eg 值为3.21eV,同理,测得TiO 2/SiCh 的Eg 值为3.68 eV.。

半导体材料光学带隙的计算计算半导体材料的光学带隙有多种方法,下面将介绍几种常用的方法:1.线性光学吸收谱法(LOA)线性光学吸收谱法是通过测量半导体材料在紫外-可见光范围内的吸收光谱来计算光学带隙。
这种方法基于光与材料中电子的相互作用,根据材料吸收光的能量与光学带隙之间的关系来计算带隙。
这种方法相对简单,可以得到相对准确的结果,但只适用于直接带隙材料。
2.激发态光吸收法(ESA)激发态光吸收法是通过测量材料在光激发下的光吸收谱来计算光学带隙。
这种方法适用于间接带隙材料,它考虑了光激发引起的电子能级变化。
通常,材料在低温下通过光激发形成激发态,然后测量其吸收光谱来计算带隙。
这种方法比较复杂,需要进行光谱拟合和数据处理,但可以得到更准确的结果。
3.电子能谱方法电子能谱方法是通过计算材料中电子的能量态密度来计算光学带隙。
这种方法通常使用基于密度泛函理论(Density Functional Theory,DFT)的第一性原理计算方法。
在计算中,需要考虑电子间相互作用、自旋-轨道耦合等因素。
由于计算的复杂性和计算结果的依赖于近似方法,这种方法通常用于研究特殊材料的带隙特性。
4.傅里叶变换红外光谱法(FTIR)傅里叶变换红外光谱法是一种通过测量半导体材料在红外光谱范围内的光吸收谱来计算光学带隙的方法。
这种方法适用于间接带隙材料,可以考虑光与材料中声子的相互作用,更准确地计算带隙。
总结来说,计算半导体材料的光学带隙需要根据具体材料的特性选择适合的方法。
实验方法包括线性光学吸收谱法和激发态光吸收法,理论方法包括电子能谱方法和傅里叶变换红外光谱法。
各种方法都有其适用的范围和计算复杂度,需要根据研究目的和材料特点选择合适的方法进行计算。

根据紫外可见光谱计算半导体能带E gDocument number【SA80SAB-SAA9SYT-SAATC-SA6UT-SA18】根据紫外-可见光谱计算半导体能带Eg光学吸收系数满足方程:α=(A/hν)(hν-Eg)1/2,其中A 是比例常数,hν是光子能量,Eg是ZnO的能隙。
Eg可以通过画(αhν)2与hν的曲线,然后把线性部分延长到α=0得出。
这些数据先用excel计算出来,再导入origin画出曲线图,然后做切线,切线与和横坐标的交点数值就是禁带宽度在origin中做曲线的切线的话~那个切点是怎么确定的下一个画切线的插件targent,它会自动画,切点选一个最陡峭的点1.薄膜:需要的数据:薄膜厚度d,透过谱T%,并且还要知道半导体是直接还是间接型。
首先需要求吸收系数(absorption coefficiency, a)a=-ln(T%)/dAα=dhv的计算在origin里进行,大概可以使用hv=1240/(wavelength(nm))得到间接半导体:纵坐标为(ahv)^2,横坐标为hv直接半导体:纵坐标为(ahv)^(1/2),横坐标为hv最后,做出曲线的切线(这方面我是自己拉一条直线),与横轴的交点就是Eg。
2.粉体:需要的数据:粉体的漫反射谱Rx。
同样也需要换算成吸收系数,使用a=(1-Rx)2/2Rx (这个就是Kubelka-Munk Function)。
其他的就是按照薄膜同样的方法进行了。
当然,这些方法都是近似的,其中还会存在粉体颗粒对光的散射,薄膜岛状结构对光的散射而对最后结果产生的误差,所以,在研究化学和材料方面可以作为一定知道的数据。
方法1:利用紫外可见漫反射测量中的吸光度与波长数据作图,利用截线法做出吸收波长阈值λg(nm),利用公式 Eg=1240/λg (eV) 计算禁带宽度。
方法2:利用(Ahν)2 对 hν做图,利用直线部分外推至横坐标交点,即为禁带宽度值。

根据紫外-可见光谱计算半导体能带Eg根据紫外-可见光谱计算半导体能带Eg光学吸收系数满足方程:α=(A/hν)(hν-Eg)1/2,其中 A 是比例常数,hν是光子能量,Eg 是ZnO的能隙。
Eg可以通过画(αhν)2与hν的曲线,然后把线性部分延长到α=0得出。
这些数据先用excel计算出来,再导入origin画出曲线图,然后做切线,切线与和横坐标的交点数值就是禁带宽度在origin中做曲线的切线的话~那个切点是怎么确定的下一个画切线的插件targent,它会自动画,切点选一个最陡峭的点1.薄膜:需要的数据:薄膜厚度d,透过谱T%,并且还要知道半导体是直接还是间接型。
首先需要求吸收系数(absorption coefficiency, a)a=-ln(T%)/dAα=dhv的计算在origin里进行,大概可以使用hv=1240/(wavelength(nm))得到间接半导体:纵坐标为(ahv)^2,横坐标为hv直接半导体:纵坐标为(ahv)^(1/2),横坐标为hv最后,做出曲线的切线(这方面我是自己拉一条直线),与横轴的交点就是Eg。
2.粉体:需要的数据:粉体的漫反射谱Rx。
同样也需要换算成吸收系数,使用a=(1-Rx)2/2Rx (这个就是Kubelka-Munk Function)。
其他的就是按照薄膜同样的方法进行了。
当然,这些方法都是近似的,其中还会存在粉体颗粒对光的散射,薄膜岛状结构对光的散射而对最后结果产生的误差,所以,在研究化学和材料方面可以作为一定知道的数据。
方法1:利用紫外可见漫反射测量中的吸光度与波长数据作图,利用截线法做出吸收波长阈值λg(nm),利用公式Eg=1240/λg (eV) 计算禁带宽度。
方法2:利用(Ahν)2 对hν做图,利用直线部分外推至横坐标交点,即为禁带宽度值。
也可利用(Ahν)0.5对hν做图,利用直线部分外推至横坐标交点,即为禁带宽度值。
前者为间接半导体禁带宽度值,后者为直接半导体禁带宽度值。
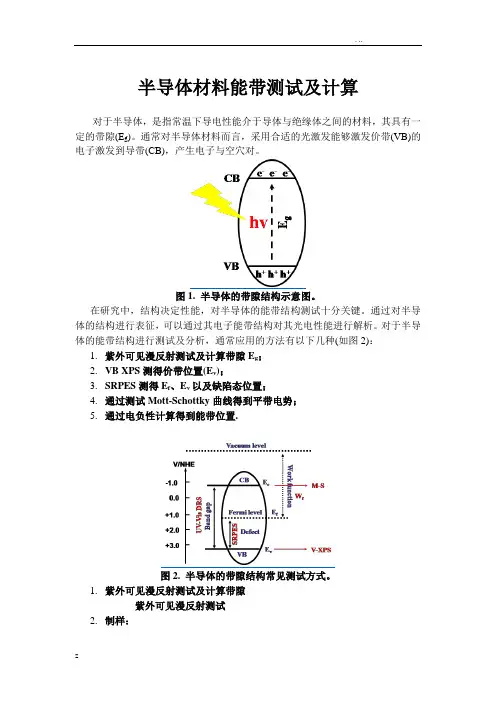
半导体材料能带测试及计算对于半导体,是指常温下导电性能介于导体与绝缘体之间的材料,其具有一定的带隙(E g)。
通常对半导体材料而言,采用合适的光激发能够激发价带(VB)的电子激发到导带(CB),产生电子与空穴对。
图1. 半导体的带隙结构示意图。
在研究中,结构决定性能,对半导体的能带结构测试十分关键。
通过对半导体的结构进行表征,可以通过其电子能带结构对其光电性能进行解析。
对于半导体的能带结构进行测试及分析,通常应用的方法有以下几种(如图2):1.紫外可见漫反射测试及计算带隙E g;2.VB XPS测得价带位置(E v);3.SRPES测得E f、E v以及缺陷态位置;4.通过测试Mott-Schottky曲线得到平带电势;5.通过电负性计算得到能带位置.图2. 半导体的带隙结构常见测试方式。
1.紫外可见漫反射测试及计算带隙紫外可见漫反射测试2.制样:背景测试制样:往图3左图所示的样品槽中加入适量的BaSO4粉末(由于BaSO4粉末几乎对光没有吸收,可做背景测试),然后用盖玻片将BaSO4粉末压实,使得BaSO4粉末填充整个样品槽,并压成一个平面,不能有凸出和凹陷,否者会影响测试结果。
样品测试制样:若样品较多足以填充样品槽,可以直接将样品填充样品槽并用盖玻片压平;若样品测试不够填充样品槽,可与BaSO4粉末混合,制成一系列等质量分数的样品,填充样品槽并用盖玻片压平。
图3. 紫外可见漫反射测试中的制样过程图。
1.测试:用积分球进行测试紫外可见漫反射(UV-Vis DRS),采用背景测试样(BaSO4粉末)测试背景基线(选择R%模式),以其为background测试基线,然后将样品放入到样品卡槽中进行测试,得到紫外可见漫反射光谱。
测试完一个样品后,重新制样,继续进行测试。
•测试数据处理数据的处理主要有两种方法:截线法和Tauc plot法。
截线法的基本原理是认为半导体的带边波长(λg)决定于禁带宽度E g。



半导体材料能带测试及计算对于半导体,是指常温下导电性能介于导体与绝缘体之间的材料,其具有一定的带隙(E g)。
通常对半导体材料而言,采用合适的光激发能够激发价带(VB)的电子激发到导带(CB),产生电子与空穴对。
图1. 半导体的带隙结构示意图。
在研究中,结构决定性能,对半导体的能带结构测试十分关键。
通过对半导体的结构进行表征,可以通过其电子能带结构对其光电性能进行解析。
对于半导体的能带结构进行测试及分析,通常应用的方法有以下几种(如图2):1.紫外可见漫反射测试及计算带隙E g;2.VB XPS测得价带位置(E v);3.SRPES测得E f、E v以及缺陷态位置;4.通过测试Mott-Schottky曲线得到平带电势;5.通过电负性计算得到能带位置.图2. 半导体的带隙结构常见测试方式。
1.紫外可见漫反射测试及计算带隙紫外可见漫反射测试2.制样:背景测试制样:往图3左图所示的样品槽中加入适量的BaSO4粉末(由于BaSO4粉末几乎对光没有吸收,可做背景测试),然后用盖玻片将BaSO4粉末压实,使得BaSO4粉末填充整个样品槽,并压成一个平面,不能有凸出和凹陷,否者会影响测试结果。
样品测试制样:若样品较多足以填充样品槽,可以直接将样品填充样品槽并用盖玻片压平;若样品测试不够填充样品槽,可与BaSO4粉末混合,制成一系列等质量分数的样品,填充样品槽并用盖玻片压平。
图3. 紫外可见漫反射测试中的制样过程图。
1.测试:用积分球进行测试紫外可见漫反射(UV-Vis DRS),采用背景测试样(BaSO4粉末)测试背景基线(选择R%模式),以其为background测试基线,然后将样品放入到样品卡槽中进行测试,得到紫外可见漫反射光谱。
测试完一个样品后,重新制样,继续进行测试。
•测试数据处理数据的处理主要有两种方法:截线法和Tauc plot法。
截线法的基本原理是认为半导体的带边波长(λg)决定于禁带宽度E g。



半导体材料能带测试及计算对于半导体,是指常温下导电性能介于导体与绝缘体之间的材料,其具有一定的带隙(E g)。
通常对半导体材料而言,采用合适的光激发能够激发价带(VB)的电子激发到导带(CB),产生电子与空穴对。
图1. 半导体的带隙结构示意图。
在研究中,结构决定性能,对半导体的能带结构测试十分关键。
通过对半导体的结构进行表征,可以通过其电子能带结构对其光电性能进行解析。
对于半导体的能带结构进行测试及分析,通常应用的方法有以下几种(如图2):1.紫外可见漫反射测试及计算带隙E g;2.VB XPS测得价带位置(E v);3.SRPES测得E f、E v以及缺陷态位置;4.通过测试Mott-Schottky曲线得到平带电势;5.通过电负性计算得到能带位置.图2. 半导体的带隙结构常见测试方式。
1.紫外可见漫反射测试及计算带隙紫外可见漫反射测试2.制样:背景测试制样:往图3左图所示的样品槽中加入适量的BaSO4粉末(由于BaSO4粉末几乎对光没有吸收,可做背景测试),然后用盖玻片将BaSO4粉末压实,使得BaSO4粉末填充整个样品槽,并压成一个平面,不能有凸出和凹陷,否者会影响测试结果。
样品测试制样:若样品较多足以填充样品槽,可以直接将样品填充样品槽并用盖玻片压平;若样品测试不够填充样品槽,可与BaSO4粉末混合,制成一系列等质量分数的样品,填充样品槽并用盖玻片压平。
图3. 紫外可见漫反射测试中的制样过程图。
1.测试:用积分球进行测试紫外可见漫反射(UV-Vis DRS),采用背景测试样(BaSO4粉末)测试背景基线(选择R%模式),以其为background测试基线,然后将样品放入到样品卡槽中进行测试,得到紫外可见漫反射光谱。
测试完一个样品后,重新制样,继续进行测试。
•测试数据处理数据的处理主要有两种方法:截线法和Tauc plot法。
截线法的基本原理是认为半导体的带边波长(λg)决定于禁带宽度E g。
半导体材料能带测试及计算对于半导体,是指常温下导电性能介于导体与绝缘体之间的材料,其具有一定的带隙(E g)。
通常对半导体材料而言,采用合适的光激发能够激发价带(VB)的电子激发到导带(CB),产生电子与空穴对。
图1. 半导体的带隙结构示意图。
在研究中,结构决定性能,对半导体的能带结构测试十分关键。
通过对半导体的结构进行表征,可以通过其电子能带结构对其光电性能进行解析。
对于半导体的能带结构进行测试及分析,通常应用的方法有以下几种(如图2):1.紫外可见漫反射测试及计算带隙E g;2.VB XPS测得价带位置(E v);3.SRPES测得E f、E v以及缺陷态位置;4.通过测试Mott-Schottky曲线得到平带电势;5.通过电负性计算得到能带位置.图2. 半导体的带隙结构常见测试方式。
1.紫外可见漫反射测试及计算带隙紫外可见漫反射测试2.制样:背景测试制样:往图3左图所示的样品槽中加入适量的BaSO4粉末(由于BaSO4粉末几乎对光没有吸收,可做背景测试),然后用盖玻片将BaSO4粉末压实,使得BaSO4粉末填充整个样品槽,并压成一个平面,不能有凸出和凹陷,否者会影响测试结果。
样品测试制样:若样品较多足以填充样品槽,可以直接将样品填充样品槽并用盖玻片压平;若样品测试不够填充样品槽,可与BaSO4粉末混合,制成一系列等质量分数的样品,填充样品槽并用盖玻片压平。
图3. 紫外可见漫反射测试中的制样过程图。
1.测试:用积分球进行测试紫外可见漫反射(UV-Vis DRS),采用背景测试样(BaSO4粉末)测试背景基线(选择R%模式),以其为background测试基线,然后将样品放入到样品卡槽中进行测试,得到紫外可见漫反射光谱。
测试完一个样品后,重新制样,继续进行测试。
•测试数据处理数据的处理主要有两种方法:截线法和Tauc plot法。
截线法的基本原理是认为半导体的带边波长(λg)决定于禁带宽度E g。
半导体材料能带测试及计算对于半导体,是指常温下导电性能介于导体与绝缘体之间的材料,其具有一定的带隙(E g)。
通常对半导体材料而言,采用合适的光激发能够激发价带(VB)的电子激发到导带(CB),产生电子与空穴对。
图1. 半导体的带隙结构示意图。
在研究中,结构决定性能,对半导体的能带结构测试十分关键。
通过对半导体的结构进行表征,可以通过其电子能带结构对其光电性能进行解析。
对于半导体的能带结构进行测试及分析,通常应用的方法有以下几种(如图2):1.紫外可见漫反射测试及计算带隙E g;2.VB XPS测得价带位置(E v);3.SRPES测得E f、E v以及缺陷态位置;4.通过测试Mott-Schottky曲线得到平带电势;5.通过电负性计算得到能带位置.图2. 半导体的带隙结构常见测试方式。
1.紫外可见漫反射测试及计算带隙紫外可见漫反射测试2.制样:背景测试制样:往图3左图所示的样品槽中加入适量的BaSO4粉末(由于BaSO4粉末几乎对光没有吸收,可做背景测试),然后用盖玻片将BaSO4粉末压实,使得BaSO4粉末填充整个样品槽,并压成一个平面,不能有凸出和凹陷,否者会影响测试结果。
样品测试制样:若样品较多足以填充样品槽,可以直接将样品填充样品槽并用盖玻片压平;若样品测试不够填充样品槽,可与BaSO4粉末混合,制成一系列等质量分数的样品,填充样品槽并用盖玻片压平。
图3. 紫外可见漫反射测试中的制样过程图。
1.测试:用积分球进行测试紫外可见漫反射(UV-Vis DRS),采用背景测试样(BaSO4粉末)测试背景基线(选择R%模式),以其为background测试基线,然后将样品放入到样品卡槽中进行测试,得到紫外可见漫反射光谱。
测试完一个样品后,重新制样,继续进行测试。
•测试数据处理数据的处理主要有两种方法:截线法和Tauc plot法。
截线法的基本原理是认为半导体的带边波长(λg)决定于禁带宽度E g。
半导体材料能带测试及计算对于半导体,是指常温下导电性能介于导体与绝缘体之间的材料,其具有一定的带隙(E g)。
通常对半导体材料而言,采用合适的光激发能够激发价带(VB)的电子激发到导带(CB),产生电子与空穴对。
图1. 半导体的带隙结构示意图。
在研究中,结构决定性能,对半导体的能带结构测试十分关键。
通过对半导体的结构进行表征,可以通过其电子能带结构对其光电性能进行解析。
对于半导体的能带结构进行测试及分析,通常应用的方法有以下几种(如图2):1.紫外可见漫反射测试及计算带隙E g;2.VB XPS测得价带位置(E v);3.SRPES测得E f、E v以及缺陷态位置;4.通过测试Mott-Schottky曲线得到平带电势;5.通过电负性计算得到能带位置.图2. 半导体的带隙结构常见测试方式。
1.紫外可见漫反射测试及计算带隙紫外可见漫反射测试2.制样:背景测试制样:往图3左图所示的样品槽中加入适量的BaSO4粉末(由于BaSO4粉末几乎对光没有吸收,可做背景测试),然后用盖玻片将BaSO4粉末压实,使得BaSO4粉末填充整个样品槽,并压成一个平面,不能有凸出和凹陷,否者会影响测试结果。
样品测试制样:若样品较多足以填充样品槽,可以直接将样品填充样品槽并用盖玻片压平;若样品测试不够填充样品槽,可与BaSO4粉末混合,制成一系列等质量分数的样品,填充样品槽并用盖玻片压平。
图3. 紫外可见漫反射测试中的制样过程图。
1.测试:用积分球进行测试紫外可见漫反射(UV-Vis DRS),采用背景测试样(BaSO4粉末)测试背景基线(选择R%模式),以其为background测试基线,然后将样品放入到样品卡槽中进行测试,得到紫外可见漫反射光谱。
测试完一个样品后,重新制样,继续进行测试。
•测试数据处理数据的处理主要有两种方法:截线法和Tauc plot法。
截线法的基本原理是认为半导体的带边波长(λg)决定于禁带宽度E g。
半导体材料能带测试及计算对于半导体,是指常温下导电性能介于导体与绝缘体之间的材料,其具有一定的带隙(E g)。
通常对半导体材料而言,采用合适的光激发能够激发价带(VB)的电子激发到导带(CB),产生电子与空穴对。
图1. 半导体的带隙结构示意图。
在研究中,结构决定性能,对半导体的能带结构测试十分关键。
通过对半导体的结构进行表征,可以通过其电子能带结构对其光电性能进行解析.对于半导体的能带结构进行测试及分析,通常应用的方法有以下几种(如图2):1.紫外可见漫反射测试及计算带隙E g;2.VB XPS测得价带位置(E v);3.SRPES测得E f、E v以及缺陷态位置;4.通过测试Mott—Schottky曲线得到平带电势;5.通过电负性计算得到能带位置。
图2。
半导体的带隙结构常见测试方式。
1.紫外可见漫反射测试及计算带隙紫外可见漫反射测试2.制样:背景测试制样:往图3左图所示的样品槽中加入适量的BaSO4粉末(由于BaSO4粉末几乎对光没有吸收,可做背景测试),然后用盖玻片将BaSO4粉末压实,使得BaSO4粉末填充整个样品槽,并压成一个平面,不能有凸出和凹陷,否者会影响测试结果.样品测试制样:若样品较多足以填充样品槽,可以直接将样品填充样品槽并用盖玻片压平;若样品测试不够填充样品槽,可与BaSO4粉末混合,制成一系列等质量分数的样品,填充样品槽并用盖玻片压平。
图3。
紫外可见漫反射测试中的制样过程图。
1.测试:用积分球进行测试紫外可见漫反射(UV-Vis DRS),采用背景测试样(BaSO4粉末)测试背景基线(选择R%模式),以其为background测试基线,然后将样品放入到样品卡槽中进行测试,得到紫外可见漫反射光谱。
测试完一个样品后,重新制样,继续进行测试.•测试数据处理数据的处理主要有两种方法:截线法和Tauc plot法。
截线法的基本原理是认为半导体的带边波长(λg)决定于禁带宽度E g。
. ..z半导体材料能带测试及计算对于半导体,是指常温下导电性能介于导体与绝缘体之间的材料,其具有一定的带隙(E g)。
通常对半导体材料而言,采用合适的光激发能够激发价带(VB)的电子激发到导带(CB),产生电子与空穴对。
图1. 半导体的带隙结构示意图。
在研究中,结构决定性能,对半导体的能带结构测试十分关键。
通过对半导体的结构进行表征,可以通过其电子能带结构对其光电性能进行解析。
对于半导体的能带结构进行测试及分析,通常应用的方法有以下几种(如图2):1.紫外可见漫反射测试及计算带隙E g;2.VB XPS测得价带位置(E v);3.SRPES测得E f、E v以及缺陷态位置;4.通过测试Mott-Schottky曲线得到平带电势;5.通过电负性计算得到能带位置.图2. 半导体的带隙结构常见测试方式。
1.紫外可见漫反射测试及计算带隙紫外可见漫反射测试2.制样:背景测试制样:往图3左图所示的样品槽中加入适量的BaSO4粉末(由于BaSO4粉末几乎对光没有吸收,可做背景测试),然后用盖玻片将BaSO4粉末压实,使得BaSO4粉末填充整个样品槽,并压成一个平面,不能有凸出和凹陷,否者会影响测试结果。
否者会影响测试结果。
样品测试制样:若样品较多足以填充样品槽,可以直接将样品填充样品槽并用盖玻片压平;若样品测试不够填充样品槽,可与BaSO4粉末混合,制成一系列等质量分数的样品,填充样品槽并用盖玻片压平。
列等质量分数的样品,填充样品槽并用盖玻片压平。
图3. 紫外可见漫反射测试中的制样过程图。
1.测试:用积分球进行测试紫外可见漫反射(UV-Vis DRS),采用背景测试样(BaSO4粉末)测试背景基线(选择R%模式),以其为background测试基线,然后将样品放入到样品卡槽中进行测试,得到紫外可见漫反射光谱。
测试完一个样品后,重新制样,继续进行测试。
重新制样,继续进行测试。
•测试数据处理数据的处理主要有两种方法:截线法和Tauc plot法。
根据紫外-可见光谱计算半导体能带Eg
光学吸收系数满足方程:α=(A/hν)(hν-Eg)1/2,其中 A 是比例常数,hν是光子能量,Eg 是ZnO的能隙。
Eg可以通过画(αhν)2与hν的曲线,然后把线性部分延长到α=0得出。
这些数据先用excel计算出来,再导入origin画出曲线图,然后做切线,切线与和横坐标的交点数值就是禁带宽度
在origin中做曲线的切线的话~那个切点是怎么确定的
下一个画切线的插件targent,它会自动画,切点选一个最陡峭的点
1.薄膜:需要的数据:薄膜厚度d,透过谱T%,并且还要知道半导体是直接还是间接型。
首先需要求吸收系数(absorption coefficiency, a)
a=-ln(T%)/d
A
α=
d
hv的计算在origin里进行,大概可以使用hv=1240/(wavelength(nm))得到
间接半导体:纵坐标为(ahv)^2,横坐标为hv
直接半导体:纵坐标为(ahv)^(1/2),横坐标为hv
最后,做出曲线的切线(这方面我是自己拉一条直线),与横轴的交点就是Eg。
2.粉体:需要的数据:粉体的漫反射谱Rx。
同样也需要换算成吸收系数,使用a=(1-Rx)2/2Rx (这个就是Kubelka-Munk Function)。
其他的就是按照薄膜同样的方法进行了。
当然,这些方法都是近似的,其中还会存在粉体颗粒对光的散射,薄膜岛状结构对光的散射而对最后结果产生的误差,所以,在研究化学和材料方面可以作为一定知道的数据。
方法1:利用紫外可见漫反射测量中的吸光度与波长数据作图,利用截线法做出吸收波长阈值λg(nm),
利用公式Eg=1240/λg (eV) 计算禁带宽度。
方法2:利用(Ahν)2 对hν做图,利用直线部分外推至横坐标交点,即为禁带宽度值。
也可利用(Ahν)0.5
对hν做图,利用直线部分外推至横坐标交点,即为禁带宽度值。
前者为间接半导体禁带宽度值,后者为直
接半导体禁带宽度值。
A (Absorbance) 即为紫外可见漫反射中的吸光度。
方法3:利用(αhν)2 对hν做图,利用直线部分外推至横坐标交点,即为禁带宽度值。
也可利用(αhν)0.5
对hν做图,利用直线部分外推至横坐标交点,即为禁带宽度值。
前者为间接半导体禁带宽度值,后者为
直接半导体禁带宽度值。
α(Absorption Coefficient ) 即为紫外可见漫反射中的吸收系数。
α与A成正比。
方法4:利用[F(R∞)hν]2 对hν做图,利用直线部分外推至横坐标交点,即为禁带宽度值。
也可利用
[F(R∞)hν]0.5 对hν做图,利用直线部分外推至横坐标交点,即为禁带宽度值。
前者为间接半导体禁带宽度
值,后者为直接半导体禁带宽度值。
1.先测样品的厚度d
2.根据公式α=2.303*Abs/d,计算就可以得到吸收系数α
公式里的d,对于液体来说,一般指的是比色皿的厚度;对于固体来说,不论是薄膜还是板,应该分别指膜厚和板厚;若是粉末的话,通常指将粉末压片后的厚度。
而α=2.303*Abs/d这个公式,一般情况都是适用的。