《金属薄膜电阻率的测量》鉴定报告.
- 格式:docx
- 大小:42.62 KB
- 文档页数:4

薄膜材料磁电阻效应实验一、 实验目的1. 了解磁性薄膜材料科学及磁电子学的一些基本概念和基础知识;2. 了解MR 、AMR 、GMR 等相关基本概念;3. 了解和学会利用四探针法测量磁性薄膜磁电阻的鱼原理和方法;4. 分析利用四探针法测量磁电阻可能的实验误差来源。
二、实验原理1. 磁性薄膜的磁电阻效应(MRE )磁电阻效应MRE 是指物质在磁场的作用下电阻会发生变化的物理现象。
表征磁电阻效应大小的物理量为MR ,其定义为:00100%MR ρρρρρ-∆==⨯ (1) 其中0ρ、ρ分别代表不加磁场和加了磁场以后的电阻率大小。
磁电阻效应按照产生的磁电阻大小以及机理不同可以分为:正常磁电阻效应(OMR )、各向异性磁电阻效应(AMR )、巨磁电阻效应(GMR )和超巨磁电阻效应(CMR )等。
(1)正常磁电阻效应(OMR )正常磁电阻效应(OMR)为普遍存在于所有金属中的磁场电阻效应,它由英国物理学家W.Thomson 于1856年发现。
其特点是:a .磁电阻MR >0b .各向异性,但//ρρ⊥> (⊥ρ和//ρ分别表示外加磁场与电流方向垂直及平行时的电阻率) c .当磁场不高时,MR 正比于H 2OMR 来源于磁场对电子的洛伦兹力,该力导致载流体运动发生偏转或产生螺旋运动,因而使电阻升高。
大部分材料的OMR 都比较小。
以铜为例,当H=10-3T 时,铜的OMR 仅为4⨯10-8%。
(2)各向异性磁电阻效应(AMR )在居里点以下,铁磁金属的电阻率随电流I 与磁化强度M 的相对取向而异,称之为各向异性磁电阻效应。
即⊥ρ≠//ρ。
各向异性磁电阻值通常定义为:0///)(/ρρρρρ⊥-=∆=AMR (2) 低温5K 时,铁、钴的各向异性磁电阻值约为1%,而坡莫合金(Ni 81Fe 19)为15%,室温下坡莫合金的各向异性磁电阻值仍有2~3%。
图1所示为厚度为200 nm 的NiFe 单层薄膜的磁电阻(MR )变化曲线。

实验三(I)探针测量半导体或金属薄膜电阻率一.实验目的1.熟悉四探针测量半导体或金属薄膜电阻率的原理2.掌握四探针测量材料电阻率的方法二.实验原理薄膜材料是支持现代高新技术不断发展的重要材料之一,已经被广泛地应用在微电子器件、微驱动器/微执行器、微型传感器中。
金属薄膜的电阻率是金属薄膜材料的一个重要的物理特性,是科研开发和实际生产中经常要测量的物理特性,对金属薄膜电阻率的测量也是四端法测量低电阻材料电阻率的一个实际的应用,它比传统的四端子法测量金属丝电阻率的实验更贴近现代高新技术的发展。
直流四探针法也称为四电极法,主要用于半导体材料或超导体等的低电阻率的测量。
使用的仪器以及与样品的接线如图3-1所示。
由图可见,测试时四根金属探针与样品表面接触,外侧两根1、4为通电流探针,内侧两根2、3为测电压探针。
由电流源输入小电流使样品内部产生压降,同时用高阻抗的静电计、电子毫伏计或数字电压表测出其他二根探针的电压即V23(伏)。
(a)仪器接线(b)点电流源(c)四探针排列图3-1四探针法测试原理示意图若一块电阻率为沖勺均匀半导体样品,其几何尺寸相对于探针间距来说可以看作半无限大。
当探针引入的点电流源的电流为I,由于均匀导体内恒定电场的等位面为球面,则在半径为r处等位面的面积为2T2,电流密度为2j=l/2 二r2(3-1)根据电导率与电流密度的关系可得则距点电荷r 处的电势为I PV (3-3)2兀r 半导体内各点的电势应为四个探针在该点形成电势的矢量和。
通过数学推导可得四探针法测量电阻率的公式为:式中,C =2二(丄11 匸)」为探针系数,单位为cm ; r i2、「24、r i3、©4分别 r i2 r 24 r i3 r 34 为相应探针间的距离,见图3-iC o 若四探针在同一平面的同一直线上,其间距分别 为 S i 、S 2、S 3,且 S i =S 2=S 3=S 时,贝U亍=灶.2二(丄 -- L )^V 23Z -:S (3-5)I S i S i S 2 S> S 3 S 3 I 这就是常见的直流等间距四探针法测电阻率的公式。

测量电阻率实验报告测量电阻率实验报告引言:电阻率是描述材料导电性能的一个重要参数,它反映了材料对电流的阻碍程度。
测量电阻率的实验是电学实验中的基础实验之一,通过该实验可以了解不同材料的导电性能,并为电路设计和材料选用提供参考。
实验目的:本次实验的目的是测量不同材料的电阻率,并探究不同因素对电阻率的影响。
实验原理:电阻率(ρ)的定义为:ρ = R × A / L,其中R为电阻值,A为截面积,L为长度。
实验中,我们使用恒流源和电压表来测量电阻值,然后根据样品的几何尺寸计算出电阻率。
实验步骤:1. 准备实验装置:将恒流源和电压表连接好,并确保测量仪器的正常工作。
2. 测量导体的电阻值:将待测导体接入电路中,调节恒流源的电流大小,并使用电压表测量电压值。
3. 计算电阻率:根据实测的电阻值和导体的几何尺寸,计算出电阻率。
实验结果与分析:在实验中,我们选择了几种常见的导体材料进行测量,包括铜线、铁丝和铝片。
通过测量得到的电阻值和样品的几何尺寸,我们计算出了它们的电阻率。
结果显示,铜线的电阻率最低,铝片的电阻率次之,而铁丝的电阻率最高。
这是因为铜具有良好的导电性能,电子在铜中的迁移速度较快;而铝的导电性能稍差一些,电子迁移速度较慢;而铁的导电性能相对较差,电子迁移速度较慢。
因此,不同材料的电阻率存在差异。
此外,我们还发现了一些影响电阻率的因素。
首先是导体的长度,长度越长,电阻率越大;其次是导体的截面积,截面积越小,电阻率越大。
这与电阻率的定义式一致,即电阻率与长度成正比,与截面积成反比。
实验误差分析:在实验中,由于仪器的精度限制和操作的不准确性,存在一定的误差。
例如,电压表的示数误差、导体表面的接触电阻等都会对实验结果产生一定的影响。
为减小误差,我们可以多次测量并取平均值,同时注意操作的准确性。
结论:通过本次实验,我们测量了不同材料的电阻率,并探究了影响电阻率的因素。
实验结果表明,不同材料的电阻率存在差异,同时电阻率与导体的长度和截面积相关。

四探针法测量原理图 四探针测试仪测量薄膜的电阻率〈一〉 实验目的1、理解四探针方法测量半导体电阻率的原理;2、学会用四探针方法测量半导体电阻率。
〈二〉实验原理本实验采用SDY-5型双电测四探针测试仪。
该仪器采用了四探针双位组合测量新技术,将范德堡测量方法推广应用到直线四探针上,利用电流探针、电压探针的变换,进行两次电测量,能自动消除样品几何尺寸、边界效应以及探针不等距和机械游移等因素对测量结果的影响。
因而每次测量不必知道探针间距、样品尺寸及探针在样品表面上的位置。
由于每次测量都是对几何因素的影响进行动态的自动修正,因此显著降低了几何因素影响,从而提高了测量结果的准确度。
所有这些,用目前大量使用的常规四探针测量方法所生产的仪器是无法实现的。
使用本仪器进行测量时,由于不需要进行几何边界条件和探针间距的修正,因而对各种形状的薄膜材料及片状材料有广泛的适用性。
仪器特别适用于测量片状半导体材料电阻率以及硅扩散层、离子注入层、异型外延层等半导体器件和液晶片导电膜、电热膜等薄层(膜)的方块电阻。
仪器以大规模集成电路为核心部件,特别采用了平面轻触式开关设计和各种工作状态LED 指示,并应用了微计算机技术,利用HQ-710F 型微计算机作为专用测量控制及数据处理器,使得测量、计算、读数更加直观、快速,并能打印全部预置和测量数据。
1、体电阻率测量:当1、2、3、4四根金属探针排成一直线时,并以一定压力压在半导体材料上,在1、4两处探针间通过电流I ,则2、3探针间产生电位差V 。
材料电阻率: (1) 探针系数 : (2) C IV =ρ12122320π1111C S S S S S S =+--++式中:S 1、S 2、S 3分别为探针1与2,2与3,3与4之间距,用mm 为单位时的值,S 1=S 2=S 3=1mm , 每个探头都有自己的系数。
一般C ≈62.8±0. 5 mm=6.28±0. 05cm 。

《金属薄膜电阻率的测量》鉴定报告一、主题把当今高新技术领域中的科研开发和生产中实际应用的物理测量技术放到大学本科的普通物理实验教学中,不断提高和更新普通物理实验教学的档次,使普通物理实验教学更贴近当今高新技术的发展,从而使学生们在学校期间就能够接触到一些同高新技术领域相关的实验内容,对于提高学生们的学习兴趣和培养将来实际科研开发能力将起到很大的帮助。
培养创新型人才,使高等学校培养的毕业生进入社会后能够更快的担负起发展国家高新技产业的重担,这是当前普通物理实验教学改革的重要方向之一。
把科研开发中实际应用的方法向工科物理实验教学转化。
科研开发中实际应用的方法包括二部分——(1)具体的实验方法、原理和设备(统称:硬件);(2)提出问题、分析问题和解决问题的思维方法(统称:软件)。
本实验是把科研开发中实际应用的方法——用四探针法测量金属薄膜电阻率引入到工科物理实验教学中。
二、目的1.让同学们直接地接触薄膜材料,对薄膜材料有一个直观的感性认识;了解和学会现在科研开发和生产中使用的四探针法测量金属薄膜电阻率的原理和方法;2.了解薄膜的膜厚对金属薄膜电阻率的影响(即,金属薄膜电阻率的尺寸效应);薄膜材料同普通块体材料的差异;3.分析用四探针法测量金属薄膜电阻率时可能产生误差的根源;4.使学生们在直接感受到工科物理实验在当今高新技术中的应用实例,从而提高学生们的学习兴趣和探索自然的积极性;5.培养学生们提出问题、分析问题和解决问题的科研开发能力,培养学生们的创新能力;6.使低价格同时又具有一定科学实用价值的实验仪器进入工科物理实验教学中,降低实验教育的成本。
三、实验讲义《实验讲义》在内容上有以下几个特点:(1)主要标题中的[引言]、[实验目的]、[实验仪器]、[实验原理]、[实验测量及数据处理]、[讨论]、[结论]、[参考文献]为通常科学论文所用的形式,其目的是让学生们在阅读实验讲义和写实验报告时能够熟悉科学论文的写作方式。

四探针法测量原理图 四探针测试仪测量薄膜的电阻率〈一〉 实验目的1、理解四探针方法测量半导体电阻率的原理;2、学会用四探针方法测量半导体电阻率。
〈二〉实验原理本实验采用SDY-5型双电测四探针测试仪。
该仪器采用了四探针双位组合测量新技术,将范德堡测量方法推广应用到直线四探针上,利用电流探针、电压探针的变换,进行两次电测量,能自动消除样品几何尺寸、边界效应以及探针不等距和机械游移等因素对测量结果的影响。
因而每次测量不必知道探针间距、样品尺寸及探针在样品表面上的位置。
由于每次测量都是对几何因素的影响进行动态的自动修正,因此显著降低了几何因素影响,从而提高了测量结果的准确度。
所有这些,用目前大量使用的常规四探针测量方法所生产的仪器是无法实现的。
使用本仪器进行测量时,由于不需要进行几何边界条件和探针间距的修正,因而对各种形状的薄膜材料及片状材料有广泛的适用性。
仪器特别适用于测量片状半导体材料电阻率以及硅扩散层、离子注入层、异型外延层等半导体器件和液晶片导电膜、电热膜等薄层(膜)的方块电阻。
仪器以大规模集成电路为核心部件,特别采用了平面轻触式开关设计和各种工作状态LED 指示,并应用了微计算机技术,利用HQ-710F 型微计算机作为专用测量控制及数据处理器,使得测量、计算、读数更加直观、快速,并能打印全部预置和测量数据。
1、体电阻率测量:当1、2、3、4四根金属探针排成一直线时,并以一定压力压在半导体材料上,在1、4两处探针间通过电流I ,则2、3探针间产生电位差V 。
材料电阻率: (1) 探针系数 : (2) C IV =ρ12122320π1111C S S S S S S =+--++式中:S 1、S 2、S 3分别为探针1与2,2与3,3与4之间距,用mm 为单位时的值,S 1=S 2=S 3=1mm , 每个探头都有自己的系数。
一般C ≈62.8±0. 5 mm=6.28±0. 05cm 。

实验十八 四探针法测量薄膜电阻率一、实验目的1.熟悉四探针法测量薄膜电阻率的原理和特点; 2.测定一些薄膜材料的电阻率;3.了解薄膜厚度对薄膜电阻率的影响(尺寸效应);薄膜材料是微电子技术的基础材料。
薄膜是人工制作的厚度在1微米(10-6米)以下的固体膜,“厚度1微米以下”并不是一个严格的区分定义。
薄膜一般来说都是被制备在一个衬底(如:玻璃、半导体硅等)上,由于薄膜的厚度(简称:膜厚)是非常薄的,因此膜厚在很大程度上影响着薄膜材料的物理特性(如,电学性质、光学性质、磁学性质、力学性质、铁电性质等)。
这种薄膜材料的物理特性受膜厚影响的现象被称为尺寸效应。
尺寸效应决定了薄膜材料的某些物理、化学特性不同于通常的块体材料,也就是说,同块体材料相比,薄膜材料将具有一些新的功能和特性。
因此,尺寸效应是薄膜材料(低维材料)科学中的基本而又重要的效应之一。
金属薄膜的电阻率是金属薄膜材料的一个重要的物理特性,是科研开发和实际生产中经常测量的物理特性之一,在实际工作中,通常用四探针法测量金属薄膜的电阻率。
四探针法测量金属薄膜的电阻率是四端子法测量低电阻材料电阻率的一个实际的应用。
二、实验原理在具有一定电阻率ρ的导体表面上,四根金属探针在任意点1、2、3、4处与导体良好地接触,如图1所示。
其触点是最够的小,可以近似认为点接触。
取其中的任意两个探针作为电极,如1和4。
当它们之间有电流通过时,薄膜表面和内部有不均匀的电流场分布,因此在表面上各点有不同的电势。
通过测量探针1,2间的电流、探针2,3间的电势差和距离,就可计算该薄膜的电阻率ρ。
如图2所示,设电流I 从探针1处流入,在触点附近,半径为r 的球面上,电流密度为:2r2Ij π=(1)如果金属的表面和厚度远大于探针之间的距离,则电场强度为2r 2Ij j E πρ=ρ=σ=(2) 图 1 任意间距的四探针示意图设探针1和2、1和3、4和2、4和3之间的距离分别为r 12、r 13、r 24和r 34。

测量电阻率的实验报告一、实验目的1、掌握测量电阻率的基本原理和方法。
2、学会使用伏安法测量电阻,并通过数据处理计算电阻率。
3、熟悉实验仪器的使用,提高实验操作技能和数据处理能力。
二、实验原理电阻率是用来表示各种物质电阻特性的物理量。
某种材料制成的长为 L、横截面积为 S 的导体的电阻 R 为:\(R =\rho \frac{L}{S}\)则电阻率\(\rho\)为:\(\rho = RS/L\)在本实验中,我们使用伏安法测量电阻。
通过测量导体两端的电压U 和通过导体的电流 I,根据欧姆定律\(R = U/I\)计算出电阻 R。
然后测量导体的长度 L 和横截面积 S,即可计算出电阻率\(\rho\)。
三、实验仪器1、直流电源(输出电压可调)2、电流表(量程 0 06 A、0 3 A)3、电压表(量程 0 3 V、0 15 V)4、待测电阻(金属丝或电阻丝)5、滑动变阻器6、毫米刻度尺7、螺旋测微器8、开关9、导线若干四、实验步骤1、用螺旋测微器测量待测电阻丝的直径d,在不同位置测量多次,取平均值。
根据圆的面积公式\(S =\pi(d/2)^2\)计算横截面积 S。
2、按照电路图连接实验电路。
将电源、开关、滑动变阻器、电流表、待测电阻串联,电压表并联在待测电阻两端。
注意电表的量程选择要合适,连接电路时开关要断开,滑动变阻器的滑片要置于阻值最大处。
3、闭合开关,调节滑动变阻器,使电流表和电压表的示数在合适的范围内,分别读出几组电压 U 和电流 I 的值,并记录下来。
4、用毫米刻度尺测量电阻丝的有效长度L,测量多次,取平均值。
5、根据记录的数据,计算出每次测量的电阻值\(R = U/I\),然后求出电阻的平均值\(R_{平均}\)。
6、将测量得到的平均值\(R_{平均}\)、长度 L 和横截面积 S 代入公式\(\rho = RS/L\),计算出待测电阻的电阻率\(\rho\)。
五、实验数据记录与处理1、电阻丝直径的测量|测量次数| 1 | 2 | 3 | 4 | 5 |平均值||||||||||直径 d(mm)|_____ |_____ |_____ |_____ |_____ |_____ |2、电阻丝长度的测量|测量次数| 1 | 2 | 3 |平均值||||||||长度 L(cm)|_____ |_____ |_____ |_____ |3、电压和电流的测量|测量次数| 1 | 2 | 3 | 4 | 5 |||||||||电压 U(V)|_____ |_____ |_____ |_____ |_____ ||电流 I(A)|_____ |_____ |_____ |_____ |_____ |4、电阻的计算|测量次数| 1 | 2 | 3 | 4 | 5 |平均值||||||||||电阻 R(Ω)|_____ |_____ |_____ |_____ |_____ |_____ |5、电阻率的计算横截面积\(S =\pi(d/2)^2 =\pi \times (_____/2)^2 =_____mm^2 =_____cm^2\)电阻率\(\rho = RS/L =_____ \times _____ /_____ =_____Ω·m\)六、误差分析1、测量电阻丝直径和长度时存在读数误差。

电阻率检测报告1. 引言电阻率是描述材料导电性能的重要参数之一。
本报告旨在介绍电阻率的检测方法,并对实验结果进行分析和讨论。
2. 实验目的本实验的目的是通过测量样品的电阻和尺寸,计算出样品的电阻率,并对不同样品的电阻率进行比较。
3. 实验材料和设备•样品:我们选择了三种不同材料的样品进行测试,分别是铜、铝和铁。
•电阻计:用于测量各样品的电阻。
•尺子:测量样品的尺寸。
4. 实验步骤以下是我们进行电阻率检测实验的具体步骤:4.1 准备工作•确保实验室环境安全,并戴好实验手套和眼镜。
•将电阻计和尺子放置在实验台上,并确保它们的准确度和可用性。
4.2 样品准备•从样品中选择适当的尺寸,并使用尺子测量其长度、宽度和厚度。
确保测量准确且尺寸单位一致。
4.3 电阻测量•将样品放置在电阻计的电极之间,确保样品与电极良好接触。
•打开电阻计,记录样品的电阻值。
4.4 数据处理•根据样品的尺寸和电阻值,计算出样品的电阻率。
公式如下:电阻率 = 电阻 / (长度 * 宽度 * 厚度)5. 实验结果和讨论我们分别对铜、铝和铁样品进行了电阻率检测,并得到了以下结果:样品电阻(Ω)长度 (mm) 宽度 (mm) 厚度 (mm) 电阻率(Ω·m)铜 2.5 50 10 1.5 8.33e-8铝 3.2 50 10 1.5 1.07e-7铁 1.8 50 10 1.5 6.00e-8从上表可以看出,铜的电阻率最高,而铁的电阻率最低。
这是因为铜具有良好的导电性能,而铁的导电性能相对较差。
6. 结论通过本实验,我们成功地测量了不同材料样品的电阻率,并得出以下结论: - 不同材料的电阻率有所差异,这是由其导电性能决定的。
- 铜具有最高的电阻率,而铁具有最低的电阻率。
7. 实验改进建议在今后的实验中,我们可以进一步改进实验步骤和方法,以提高实验结果的准确性和可重复性。
例如,我们可以使用更精确的测量设备,如千分尺或显微镜,来测量样品的尺寸。
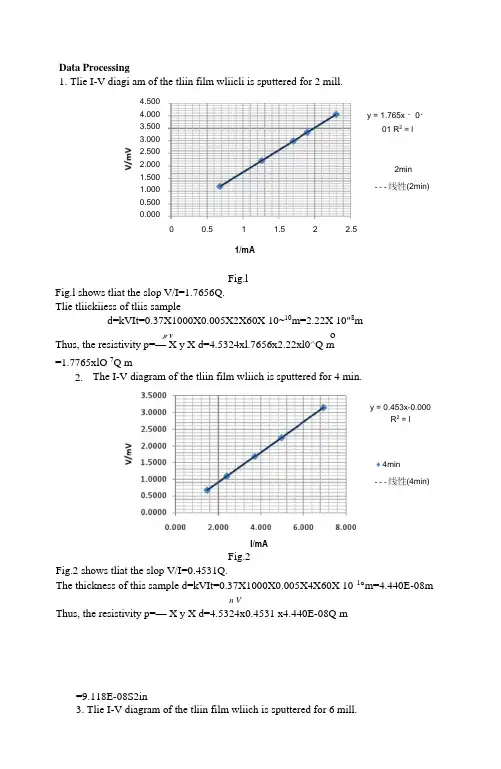
=9.118E-08S2in3. Tlie I-V diagram of the tliin film wliich is sputtered for 6 mill.Data Processing1. Tlie I-V diagi am of the tliin film wliicli is sputtered for 2 mill.Fig.lFig.l shows tliat the slop V/I=1.7656Q.Tlie tliickiiess of tliis sampled=kVIt=0.37X1000X0.005X2X60X 10~10m=2.22X 10"8mjr V oThus, the resistivity p=— X y X d=4.5324xl.7656x2.22xl0^Q m =1.7765xlO 7Q mThe I-V diagram of the tliin film wliich is sputtered for 4 min.Fig.2Fig.2 shows tliat the slop V/I=0.4531Q.The thickness of this sample d=kVIt=0.37X1000X0.005X4X60X 10_1°m=4.440E-08mn VThus, the resistivity p=— X y X d=4.5324x0.4531 x4.440E-08Q m2. 4.500 4.0003.500 3.000 2.500 2.000 1.500 1.000 0.500 0.0000.51 1.52 2.5y = 1.765x ・0・01 R 2 = l2min--- 线性(2min)1/mAl/mAy = 0.453x-0.000R 2 = l♦ 4min--- 线性(4min)y = 0.251x ・ 0.001 R 2 = l=8.080E-08Qni5. Tlie I-V diagi am of the tliin film wliich is sputtered for 15 min.Fig.3Fig.3 shows tliat the slop V/I=0.2517Q. Tlie thickness of this sampled=kVIt=0.37X1000X0.005X4X60X 10"10m=6.660E.08mJT Vms, the resistivity P=^X y X d=4.5324x0.2517Qx6.660E-08Qm =7・598E ・08Qm4. Tlie I-V diagram of the tliin film wliich is sputtered for 10 min.Fig.4Fig.4 shows tliat the slop V/I=0.1606Q ・Tlie tliickiiess of tliis sampled=kVIt=0.37X1000X0.005X10X60X 10"10m=1.110E.07myrThus, the resistivity p=— X y X d=4.5324x0.1606Qxi.noE-07Q m♦ 6min--- 线性(6min)1/mA♦ lOmin1/mA线性(lOmin)y = 0.160八 0.009 R 2 = ly = 0.156x-9E-06 R 2 = l=9.760E-08Qm7. lhe 1-V diagram of the thin film which is sputtered for 30 min.Fig.5Fig.5 shows tliat the slop V/I=0.1564Q. Tlie tliickiiess of tliis sampled=kVIt=0.37X1000X0.005X10X60X 10"10m=1.665E.07m rr VThus, the resistivity p=— X y X d=4.5324x0 1564Qxi.665E-07Q m=1.180E-07Qni6. Tlie I-V diagi am of the tliin film wliicli is spurtered for 20 min.1/mAFig.6Fig.5 shows tliat the slop V/I=0.097Q.Tlie tliickiiess of tliis sample d=kVIt=0.37X1000X0.005X10X60X 10_1°m=2.220E-07myr yTlius, the resistivity p=— X y X d=4.5324x0.097Qx2.220E-07Q m♦ 15mi n线性(15min)20min线性(20min)4.5000 4.0000 3.5000 3.0000 > 2.5000 >2.0000 1.5000 1.0000 0.5000 0.00000.000 5.000 10.000 15.000 20.000 25.000 30.0001/mAy = 0.097x - 0.000R 2 = ly = 0.033x ・ 0.001 R 2 = lFig.7Fig.5 shows tliat the slop V/I=0.0332Q. Tlie thickness of this sampled=kVIt=0.37X1000X0.005X10X60X 10~10ni=3.330E.07m rr VUlus, the resistivity p=— X y X d=4.5324x0 0332Qx3.330E.07Q mp/ (Q-m) d/m 2.220E-08 1.777E-07 4.440E-08 9.118E-086.660E-087.598E-08 1.110E-078.080E-08 1.665E-071.180E-079.77OF-O79.760F-0R3.330E-07 5.011E-08=5.0UE-08QmThe relationsliip between the resistivity and the thickness of the thin film.82.000E-07 1.800E-07 1.600E-07 1.400E-07 1.200E-07 1.000E-07 8.000E-08 6.000E-08 4.000E-08 2.000E-08 0.000E+00♦ 30min--- 线性(30min)bodootrl 80JOOO.S 00+3000 0bodoooC/m d40UJ00SE9 Ob3.5000 3.0000 2.5000 > 2.0000 > 1.5000 1.0000 0.5000 0.00000.000 20.000 40.000 60.000 80.000 100.0001/mAY-系列1Discussion1) All of the diagram from fig.l-fig.7 shows tliat the enor of tlie slope V/I is veiy small,as R 2=l for all these 7 figures.2) As it is clearly shown in fig.9, the relationsliip between p and d is not obeying thetlieoretical relationship. Tlie figure below shows the clififerences of experiniental line and theoretical line. In wliich the theoretical value was calculated by Lovell-Appl eyardfonnula.PF=PB (1+| X y)Wliere p B is 14.7Q iun, A B is52iun.2.000E-07 1.800E-07 1.600E-07 1.400E-07 J 1.200E-07 C 1.000E-07 W 8.000E-08 6.000E-08 4.000E-08 2.000E-08 0.000E+00Hie reason why that all the experimental values is much bigger than tlie tlieoretical ones is probably because the defects of the tliin films, dislocations for example. 3) Also in fig.9, there is an obvious increasing of the resistivity at the 5th point wliich isa 15-mill-sample. Perhaps this was led by some mistakes in the last experiment “Prepare metal film by DC sputtering'\ Another possible reason for this phenomenon, that is, the film was scratched by the probes by unprofessional operation.4) Tlie thickness of the filiii is calculated by tlie formula d=kVIt where I was treated as5niA tluougliout the experiment. However, in fact the sputter current is not always be 5mA, for all of the 8 groups the sputter current is all different. Hence, the calculations of the tliickiiess probably have some en or.5) Besides the imperfect of fig.9、it can be found tliat the resistivity of tlie tliin filmgoes decreasing when the tliickiiess goes ina easing. And the resistivity of the tliin films goes closer and closer to the resistivity of large bulk metal when the tliickiiess goes pretty large ・d/卜odoosESUJ000 EbodooszsUJoooeSUJOOS二bolLOOOI80UJ000 Sooiooo.oExperimental theoreticalConclusionTlie resistivity of the metal thin film when tlie tliickiiess of the thin film is relatively small is pretty larger compare with the resistivity of the bulk metal. However, when tlie tliickness of the film goes larger, the resistivity choops dramatically and finally dea eases to tlie resistivity of the bulk metal・。

测电阻率实验报告测电阻率实验报告引言:电阻率是描述物质导电性能的重要物理量之一。
在本次实验中,我们将通过测量不同材料的电阻和尺寸,来计算它们的电阻率。
通过这个实验,我们将更好地理解电阻率的概念,并探索不同材料的导电性能。
实验步骤:1. 实验器材准备:电流表、电压表、导线、不同材料的样品(如金属导线、铅笔芯、水溶液等)。
2. 实验装置搭建:将电流表和电压表与待测材料连接,确保电路连接正确。
3. 测量电阻:通过施加电压和测量电流,计算待测材料的电阻值。
重复多次测量,取平均值以提高准确性。
4. 测量尺寸:使用尺子或卡尺测量待测材料的长度、宽度和厚度等尺寸参数。
实验结果与讨论:通过实验测量得到的电阻和尺寸数据,我们可以计算出不同材料的电阻率。
电阻率是描述物质导电性能的物理量,它与材料自身的导电性能以及尺寸有关。
在实验中,我们发现金属导线的电阻较小,这是因为金属具有良好的导电性能。
相比之下,铅笔芯的电阻较大,这是因为铅笔芯是一种较差的导电材料。
而水溶液的电阻更大,这是因为水溶液中的离子导电性能较差。
我们还观察到,当材料的长度增加时,电阻也会增加。
这是因为电阻与材料的长度成正比,即电阻率不随长度变化。
而材料的截面积越大,电阻越小。
这是因为电阻与材料的截面积成反比,即电阻率与截面积成反比。
结论:通过本次实验,我们深入了解了电阻率的概念和计算方法,并通过测量不同材料的电阻和尺寸数据,验证了电阻率与导电性能以及尺寸之间的关系。
电阻率是描述物质导电性能的重要指标,它对于电路设计和材料选择具有重要意义。
在实际应用中,我们可以根据不同的需求选择合适的材料,以达到所需的导电性能。
此外,我们还可以通过改变材料的形状和尺寸来调节电阻率。
例如,通过增加导线的截面积,可以降低电阻,提高导电性能。
这对于电子器件的设计和制造具有重要的指导意义。
总之,测电阻率的实验为我们提供了一个深入了解物质导电性能的机会。
通过实验数据的分析和讨论,我们对电阻率的概念和计算方法有了更加清晰的认识,并探索了材料导电性能与尺寸之间的关系。
金属薄膜的电阻率实验报告研究金属薄膜的电阻率与其厚度和材料的关系,并探究金属薄膜的导电性质。
实验原理:金属薄膜是一种特殊的材料,具有导电性质。
一般来说,金属的导电性能与其电阻率有密切的关系。
金属薄膜的电阻率可以通过测量其电阻和尺寸计算出来。
电阻可以通过电流和电压之间的关系进行测量,而尺寸则可以通过显微镜等仪器进行测量。
实验步骤:1. 准备金属薄膜样品:选择合适厚度的金属薄膜,并将其固定在导电基板上。
2. 测量电阻:将电流流过金属薄膜,并测量两端的电压,根据欧姆定律计算出电阻值。
3. 测量尺寸:使用显微镜等仪器测量金属薄膜的长度、宽度和厚度。
4. 计算电阻率:将测得的电阻值和尺寸代入相应的公式,计算出金属薄膜的电阻率。
5. 重复实验:使用不同厚度和材料的金属薄膜进行实验,并进行多次重复测量,以提高结果的准确性。
6. 分析结果:根据实验数据,分析金属薄膜的电阻率与其厚度和材料的关系。
实验结果:经过多次实验测量和计算,得出了不同厚度和材料的金属薄膜的电阻率。
从实验结果可以看出,金属薄膜的电阻率与其厚度和材料的关系密切。
一般来说,金属薄膜的电阻率随着厚度的增加而减小,即金属薄膜越厚,其导电性能越好。
此外,不同材料的金属薄膜的电阻率也有所不同,不同金属的导电性能也不尽相同。
实验讨论:金属薄膜的电阻率与其厚度和材料的关系有一定的规律,但具体的机理还需要进一步研究探索。
在实验中,由于实验条件、仪器精度等因素的限制,实验结果可能存在一定的误差和偏差。
为了提高实验结果的准确性,可以进行多次重复实验,并采用不同的测量方法和仪器,以减小误差的影响。
实验应用:金属薄膜的电阻率是描述其导电性能的重要指标,具有广泛的应用价值。
金属薄膜广泛应用于电子器件、光学器件和导电涂层等领域。
通过研究金属薄膜的电阻率,可以对金属薄膜的导电性能进行优化和改善,使其在实际应用中发挥更好的作用。
总结:金属薄膜的电阻率与其厚度和材料的关系密切。
测定金属的电阻率实验报告实验报告:测定金属的电阻率摘要:本实验通过测定不同金属的电阻率,探究了金属导体的电流传导特性。
实验中,我们采用了四线法来测量电阻和直流电桥来测量电阻率,并成功测定了1.0mm直径的铜与铝的电阻率,结果相对误差均在1%以内,证实了测量方法的可靠性。
实验目的:1. 理解金属导体的电流传导特性,并学习电阻、电流、电压、电势差、电功率等基本概念;2. 熟悉测量电阻的四线法和测量电阻率的直流电桥方法,并掌握其操作步骤;3. 通过实验测量不同金属的电阻率,加深对金属导体性质的了解。
实验原理:1. 电阻:电阻是物质抵抗电流流动的程度的量度。
2. 电流:电流是电荷在导体中的流动,它的单位是安培(A)。
3. 电压:电势差是指在电路中两点电势之差,它的单位是伏特(V)。
4. 电势差:电势差是单位正电荷从低电位移动到高电位时所具有的能力。
5. 电功率:电路中的电流通过电器件或电源的能量变化率。
6. 四线法测量电阻:四线法采用四条导线进行激励和测试。
它能够消除导线电阻对实验的干扰,得到更加准确的电阻值。
7. 直流电桥测量电阻率:直流电桥能够通过两个可变电阻的调节和测量,得到待测物体的电阻率。
实验步骤:1. 将铜、铝等金属棒材分别切割成1.0m长度,并用砂纸打磨表面,使其光滑。
2. Hook定向器的左右两端连接电源和电阻计,调节电源电压为2V,由Hook定向器的观察孔观察铜、铝的测量电阻和电压读数。
3. 通过计算得出电阻值,并通过四线法计算出真实电阻值。
4. 将电桥进行调节使测量电流为5mA左右,分别测得不同金属棒材的电阻和电长度,计算得出电阻率值。
实验结果:通过实验测定得到铜棒材的电阻率为1.73*10^-8Ω·m,相对误差为0.90%;铝棒材的电阻率为2.82*10^-8Ω·m,相对误差为0.35%。
实验结论:本实验通过使用四线法和直流电桥成功测定了不同金属棒材的电阻率,并得到了较为精确的实验结果。
测定金属的电阻率实验报告测定金属的电阻率实验报告引言电阻率是描述材料导电性能的重要指标之一,对于金属材料而言,其电阻率与其晶体结构、杂质含量、温度等因素密切相关。
本实验旨在通过测定不同金属材料的电阻值,计算出其电阻率,并对不同金属材料的导电性能进行比较。
实验方法1. 实验仪器与材料本实验使用的仪器有:电流源、电压表、电流表、导线等。
实验所用的金属材料有:铜、铝、铁、锌等。
2. 实验步骤(1)将金属材料切割成相同长度的导线。
(2)将导线连接至电流源和电压表、电流表。
(3)调节电流源的电流大小,记录下电压表和电流表的读数。
(4)重复以上步骤,分别测量不同金属材料的电阻值。
实验结果通过实验测量得到的数据如下表所示:金属材料电阻值(Ω)铜 0.5铝 1.2铁 2.0锌 3.5数据处理与分析根据实验结果,我们可以计算出各金属材料的电阻率。
电阻率的计算公式为:ρ = R × (A / L)其中,ρ为电阻率,R为电阻值,A为横截面积,L为导线长度。
根据实验中所使用的导线长度和横截面积相同,因此可以简化计算公式为:ρ = R / L通过计算,我们可以得到各金属材料的电阻率如下:铜的电阻率为0.5 Ω / L铝的电阻率为1.2 Ω / L铁的电阻率为2.0 Ω / L锌的电阻率为3.5 Ω / L结论通过本实验的测量与计算,我们得到了不同金属材料的电阻率。
可以看出,不同金属材料的电阻率存在较大差异。
铜的电阻率最小,而锌的电阻率最大。
这是因为不同金属材料的晶体结构和电子迁移能力不同所致。
铜具有良好的导电性能,其晶体结构中的自由电子迁移能力较强,因此电阻率较小。
而锌的晶体结构中的自由电子迁移能力较弱,导致电阻率较大。
实验中可能存在的误差主要来自于导线的接触不良、测量仪器的精度等因素。
为了减小误差,可以使用更精确的仪器进行测量,并进行多次重复实验取平均值。
总结本实验通过测量不同金属材料的电阻值,计算出其电阻率,并对不同金属材料的导电性能进行了比较。
金属薄膜电阻率的测量》鉴定报告一、主题把当今高新技术领域中的科研开发和生产中实际应用的物理测量技术放到大学本科的普通物理实验教学中,不断提高和更新普通物理实验教学的档次,使普通物理实验教学更贴近当今高新技术的发展,从而使学生们在学校期间就能够接触到一些同高新技术领域相关的实验内容,对于提高学生们的学习兴趣和培养将来实际科研开发能力将起到很大的帮助。
培养创新型人才,使高等学校培养的毕业生进入社会后能够更快的担负起发展国家高新技产业的重担,这是当前普通物理实验教学改革的重要方向之一。
把科研开发中实际应用的方法向工科物理实验教学转化。
科研开发中实际应用的方法包括二部分——(1)具体的实验方法、原理和设备(统称:硬件);(2)提出问题、分析问题和解决问题的思维方法(统称:软件)。
本实验是把科研开发中实际应用的方法——用四探针法测量金属薄膜电阻率引入到工科物理实验教学中。
二、目的1.让同学们直接地接触薄膜材料,对薄膜材料有一个直观的感性认识;了解和学会现在科研开发和生产中使用的四探针法测量金属薄膜电阻率的原理和方法;2.了解薄膜的膜厚对金属薄膜电阻率的影响(即,金属薄膜电阻率的尺寸效应);薄膜材料同普通块体材料的差异;3.分析用四探针法测量金属薄膜电阻率时可能产生误差的根源;4.使学生们在直接感受到工科物理实验在当今高新技术中的应用实例,从而提高学生们的学习兴趣和探索自然的积极性;5.培养学生们提出问题、分析问题和解决问题的科研开发能力,培养学生们的创新能力;6.使低价格同时又具有一定科学实用价值的实验仪器进入工科物理实验教学中,降低实验教育的成本。
三、实验讲义《实验讲义》在内容上有以下几个特点:(1)主要标题中的[引言]、[实验目的]、[实验仪器]、[实验原理]、[实验测量及数据处理]、[讨论]、[结论]、[参考文献]为通常科学论文所用的形式,其目的是让学生们在阅读实验讲义和写实验报告时能够熟悉科学论文的写作方式。
(2)讲义中的[引言]部分主要介绍了与相关实验有关的应用背景、在物理学发展史中的作用等知识,其目的是提高学生们的学习兴趣、探索自然奥秘的积极性以及开阔学生们的眼界。
(3)讲义中的[讨论]、[研究性题目]和[思考题]部分主要分不同层次地给学生们提出一些与实验相关的问题,要求学生们认真思考后,通过自己设计、编排实验,用实验数据回答提出的问题,其目的是提高学生们提出问题、分析问题、解决问题能力,培养创新意识和创新能力,体现分层次教育的思想。
(4)讲义中的[结论]部分让学生们通过实验给出自己想说的结论,其目的是让同学们从自己感兴趣的视角给出结论,拓宽学生们的思维空间,培养学生们的科学概括、总结能力。
(5)讲义中的[参考文献]部分提醒、培养同学们在科研开发工作中应该养成参考学习前人的结果的工作习惯和实事求是的科学道德。
四、实验内容1.实验仪器主要实验仪器包括,四探针组件、SB118精密直流电流源、PZ158A直流数字电压表、具有七种不同膜厚的金薄膜材料、具有七种不同膜厚的铁薄膜材料。
SB118精密直流电流源是精密恒流源,它的输出电流在1微安(1微安=10-6安培)一一200毫安(1毫安=10-3安培)范围内可调,其精度为土0.03%。
PZ158A直流数字电压表是具有6位半字长、0.1微伏(1微伏=10-6伏特)电压分辨率的带单片微机处理技术的高精度电子测量仪器,分别具有200毫伏、2伏、20伏、200伏、1000伏的量程,其精度为土0.006%。
七种不同膜厚的金薄膜和铁薄膜,其具体膜厚情况为:金薄膜分别是10纳米(1纳米9=10米)、20纳米、50纳米、100纳米、150纳米、200纳米、300纳米,铁薄膜分别是10 纳米、20纳米、50纳米、100纳米、150纳米、200纳米、300纳米。
实验仪器是由北京科技大学物理系设计、上海精密科学仪器有限公司上海电子仪器厂制造的,实验仪器的成本是低廉的(不超过二万兀人民币)。
2 •实验原理薄膜材料在厚度(膜厚)上是非常薄的。
如果金属薄膜的膜厚小于某一个值时,薄膜的厚度将对自由电子的平均自由程产生影响,从而影响薄膜材料的电阻率,这就是所说的薄膜的尺寸效应。
如何来理解薄膜的尺寸效应呢?图1给出了说明薄膜尺寸效应的示意图。
图1中金属薄膜的膜厚为d。
电场E是沿着-X方向。
假定自由电子从O点出发到达薄膜的表面H点,OH的距离同金属块体材料中自由电子的平均自由程入B相等,即:OH=X B,自由电子的运动方向与Z轴(薄膜膜厚方向)的夹角为$ 0,在$ 0所对应的立体角范围内(图1中显示的B区),由O点出发的自由电子运动到薄膜表面并同其发生碰撞时所走过的距离小于自由电子的平均自由程入B。
这意味着,在B区中的自由电子在同声子和缺陷发生碰撞之前就同薄膜的表面发生碰撞,也就是说,B区中自由电子的平均自由程小于块体材料中自由电子的平均自由程。
但是,在大于$ 0所对应的立体角范围内(图1中显示的A区),由O点出发的自由电子运动到薄膜表面并同其发生碰撞时所走过的距离大于自由电子的平均自由程入B,即自由电子的平均自由程没有受到薄膜表面的影响。
综合上述分析,金属薄膜材料中有效自由电子平均自由程是由A区和B区两部分组成,由于B区中自由电子的平均自由程小于块体材料中自由电子的平均自由程,所以金属薄膜材料中有效自由电子平均自由程小于块体材料中自由电子的平均自由程,从而使薄膜材料的电阻率高于块体材料的电阻率。
进一步考虑一下,当薄膜的膜厚远远大于块体材料的自由电子的平均自由程时,薄膜表面对在电场作用下自由电子的定向运动将没有影响,这时薄膜的电阻率将表现出块体材料的电阻率,也即,当薄膜的膜厚很厚时,薄膜也就变成了块体材料。
目前,较为简单、又能很好地反映出金属薄膜电阻率尺寸效应的关系式是Lovell-Appleyard 公式。
该关系式将金属薄膜的电阻率、薄膜的膜厚、相应的金属块体材料的电阻率和金属块体材料的自由电子平均自由程等物理量联系了起来。
在生产、科研、开发中,应用四探针法测量金属薄膜的电阻率。
图2所示。
如图2所示,让四探针的针尖同时接触到薄膜表面上,四探针的外侧二个探针同恒流源相连接,四探针的内侧二个探针连接到电压表上。
当电流从恒流源流出流经四探针的外侧二个探针、流经薄膜时,产生的电压将可从电压表中读出。
在薄膜的面积为无限大或远远大于四探针中相邻探针间距离的时候,金属薄膜的电阻率P F可以由下式给出:V dFdIn 2 I(1)I是流经薄膜的电流,即,图2中所示恒流源提供的电流,V是电流流经薄膜时产生的电压,即,图2中所示电压表的读数。
在知道薄膜的膜厚d、流经薄膜的电流I和产生的电压V后,应用公式(1)就可以计算出金属薄膜的电阻率p F。
3 •实际测量一一铜薄膜的电阻率首先,选择普通玻璃作为衬底,玻璃衬底的大小尺寸是:长20毫米、宽20毫米、厚1毫米。
分别用丙酮、去离子水、无水乙醇对玻璃衬底各进行超声波清洗5分钟。
然后,把玻璃衬底放入多功能磁控溅射镀膜仪的镀膜室中,把镀膜室的压强抽到 3 X 10-4帕,在室温条件下,溅射沉积一层厚度为350纳米的铜薄膜。
溅射沉积条件:溅射电压500V,电流130mA氩气压强0.5帕,沉积时间17分钟。
本实验用四探针仪测得的铜薄膜的电阻率为:(1.20 ± 0.08) X 10-5ohm cm。
在清华大学微电子所用市场销售的D41-5/2M型四探针仪测量的同一个铜薄膜的电阻率为:(1.23 ± 0.08) -5X 10 ohm cm。
4.结论对比上述3中实际测得的铜薄膜的电阻率,我们可以得出以下结论:在测量的误差允许的范围之内,用这两种四探针仪的测得的铜薄膜的电阻率符合的很好的,也即,使用本实验用的四探针仪在测量方面是完全可靠的。
五、实验安排《金属薄膜电阻率的测量》实验是一个电学实验。
它既是一个材料基本电学量的测量实验,又是一个极具有实际应用价值的实验,同时使学生们接触并了解当今高新技术中广泛应用的薄膜材料的一些最基本的特性。
四探针的结构示意图如这个实验被安排在工科普通物理实验课程的“综合性实验”当中。
本实验培养和训练重点包括基本要求和提高要求。
[ 基本要求] :(1)了解和学会现在科研开发和生产中使用的四探针法测量金属薄膜电阻率的原理和方法,分析用四探针法测量金属薄膜电阻率时可能产生误差的根源;(2)独立完成接线、实验测量点的选取;(3)了解薄膜的膜厚对金属薄膜电阻率的影响(即,金属薄膜电阻率的尺寸效应),定性地总结出金属薄膜的电阻率和膜厚关系。
[ 提高要求] :(1)从金属薄膜的电阻率和膜厚的关系给出金属块体材料的电阻率,并同实际块体材料的电阻率值相比较,对于比较的结果给出分析;(2)通过本实验的结果,给出作为电极材料(基本要求之一是,其电阻率应该尽可能小),金属薄膜的发展方向是什么?在实际科研开发中应该如何具体实施?。
本实验的内容分为基本内容和提高内容。
[ 基本内容] :(1)独立完成接线,正确选择测量点的个数和电流值的范围;学会电流和电压关系的数据处理方法。
(2)通过实验说明,用四探针法测量金属薄膜电阻率时主要的误差根源是探针压样品力的大小和探针离样品边缘的距离。
(3)做出金属薄膜的电阻率和膜厚关系图,定性地总结出金属薄膜的电阻率和膜厚关系。
[ 提高内容] :要求学生们通过认真思考、分析,从自己感兴趣的视角出发,拓宽思维空间,结合理论知识扩展和延伸本实验的基本内容。
(1)做出金属薄膜的电阻率和膜厚倒数的关系图,从图中获得金属块体材料的电阻率,并同实际块体材料的电阻率值相比较,对于比较的结果给出分析,从而探讨作为电极材料,金属薄膜的发展方向是什么?在实际科研开发中应该如何具体实施?(2)超出本实验讲义规定的内容。
六、实验难点仪器本身和测量思想并不复杂,因此《实验讲义》在有关如何调节仪器和具体的测量方式方面,写的不详细,主要是让学生们积极主动地思考,通过自己的努力获得实验结果。
要完成实验提高部分的内容,在实验前,学生们应该积极主动地查阅有关薄膜知识的参考书,提前做好知识上的准备。
七、鉴定结论《金属薄膜电阻率的测量》实验具有以下几个特点:(1)在[ 基本要求] 和[ 基本内容]中,既使学生们了解和学会现在科研开发和生产中使用的四探针法测量金属薄膜电阻率的原理和方法,在实际应用中应注意的问题(引起实验测量误差);又使学生们亲身感受到了工科物理实验在当今高新技术技术中的应用;同时培养了学生们的对于实验结果的科学、全面、概括的总结能力。
(2)[ 提高要求] 和[ 提高内容] 中,扩展和延伸了[基本要求]和[ 基本内容],培养了学生们思考问题、分析问题和解决问题的能力。
(3)实验装置设计精巧、耐用、价格低廉,适用于大面积推广。