化学镀铜配方分析_分析检
- 格式:doc
- 大小:17.00 KB
- 文档页数:3

化学镀铜2008-04-03 11:12在化学镀中,化学镀铜是十分重要的镀种。
随着电子工业的发展,特别是电子计算机,电子通讯设备,以及家用电器的高速发展,双面和多层印刷电路板的需求量很大。
而印刷板的孔金属化,从导电性、可焊性、镀层韧性和经济性等综合要求来说,非铜莫属。
另外其它非金属材料(如塑料、陶瓷等),化学镀铜应用亦很广泛。
今后,非金属材料的金属化方面,化学镀铜应用亦很广泛。
今后,非金属材料的金属化方面,化学镀铜的用量约占90%以上。
化学镀铜液从稳定性划分,可分为低稳定性的化学镀铜和高稳定性的化学镀铜;从沉积速度来分,又可分为低速率和高速率的化学镀铜。
前者沉积速率一般为2~4μm/h;后者一般为10μm/h。
高速率化学镀铜一般用于半加成法或全加成法直接镀厚铜。
工艺上已由高温高速发展为低温高速。
近年来又出现了差示镀铜法,即印制板上通孔壁上的化学铜层厚度约为复铜层上化学铜层厚度的3~5倍,既降低了金属铜的消耗,又降低了成本,称之为化学镀铜发展史上的第四个里程碑。
化学镀铜液一般由铜盐、络合剂、还原剂和稳定剂组成。
一、化海陆空镀铜的工艺规范(见表3-1-9)表3-1-9 化学镀铜的工艺规范二、镀液的配制化学镀铜液均应分成A、B两组镀液分别配制,使用前才混合在一起,最后加入稳定剂,调整pH值。
A组包括硫酸铜和甲醛,可用蒸馏水或去离子水先溶解计算量的硫酸铜,然后加入计算量的甲醛。
B组包括络合剂如EDTA钠盐、酒石酸盐;碱性物如氢氧化钠、碳酸钠。
先用纯水溶解碱性物质,然后加入络合剂。
混合时,在搅拌下将A组徐徐加入B组镀液中,开始可能有氢氧化铜沉淀产生,搅拌中会逐渐溶解,此时铜呈络离子状态存在。
将镀液过滤于生产槽中,稀至总体积,调整pH值,最后加入稳定剂,即可使用。
三、化学镀铜的简单原理化学镀铜的历程可概括如下:自催化反应Cu2++2HCHO+4OH-Cu0+2HCOO-+H2↑+2H2O (1)反应(1)中的阴极反应为Cu2++2e→Cu0阳极反应为2HCHO+4OH-→2HCOO-+H2↑+2H2O+2e-除上述主反应外,还会发生如下副反应2Cu2++HCHO+5OH-→Cu2O↓+HCOO-+3H2O (2)Cu2O+H2O→Cu0↓+Cu2++2OH-(3)反应(2)为化学镀铜液中均相氧化还原反应,所产生的Cu2O在碱性液中还会发生反应(3)的岐化反应而形成铜原子。

实验四光亮电镀铜一、目的及要求1、熟悉电镀小试的装置和仪器设备。
2、掌握光亮镀铜溶液的配制及预镀工艺。
3、进行赫尔槽试验,分析光亮剂影响。
二、仪器、化学试剂直流电源、电炉、控温仪、赫尔槽及试片、电解铜板;硫酸铜、硫酸、镀铜光亮剂、镀镍溶液、镍阳极。
三、实验步骤1、工艺流程试片准备――酸洗――水洗――除油――水洗――浸蚀――预镀镍――(或铜锡合金)――水洗――酸性亮铜――水洗2、溶液配方及工艺条件预镀镍溶液:硫酸镍: 120~140g/L氯化钠: 7~9 g/L硼酸: 0~40 g/L无水硫酸钠: 50~80 g/L十二烷基硫酸钠: 0.01~0.02 g/LpH: 5.0~6.0温度: 30~50℃电流密度: 0.8~1.5A/dm2酸性亮铜溶液:硫酸铜: 200~220 g/L硫酸(1.84): 60~70 g/L四氢噻唑硫酮: 5×10-4~3×10-3 g/L盐酸: 0.02~0.08 g/L十二烷基硫酸钠: 0.05~0.2 g/L温度: 10~30℃(室温)电流密度: 1~4 A/dm2搅拌:阴极移动3、用赫尔槽实验观察光亮剂对同层质量影响,记录试验情况。
五、思考问题及要求1、酸性亮铜电镀前为什么要进行预镀?预镀工艺有哪几种?2、溶液pH对铜层质量有什么影响?4、以论文形式写出光亮剂对镀层质量影响为内容的实验报告。
附录用有机玻璃板自制赫尔槽赫尔槽结构简单,制造和使用方便。
目前国内外已广泛应用于电镀实验和工厂生产的质量管理,特别是应用于光亮电镀添加剂的控制,成为电镀工作者不可缺少的工具,267ml赫尔槽尺寸如图。
材料:有机玻璃;槽深:65;厚:3-5一、目的要求掌握有机玻璃黏结技术,自制267ml赫尔槽二、药品与材料:有机玻璃板3~5mm厚钢锯、细纱布180~270#、脱脂棉。
100ml棕色试剂瓶1个三氯化烷、乙醇三、有机玻璃黏结剂配制:配方:三氯甲烷95ml乙醇1~2 ml有机玻璃碎块或碎屑5克。

酸性光亮镀铜工艺及配方一、酸性镀铜光亮剂特点:1、快速出光,特好的填平度,即使低电流密度区也可得到极高的填平度。
2、广泛的电流密度范围均可得到镜面亮度。
3、工作温度范围宽,18—< xmlnamespace prefix ="st1" ns ="urn:schemas-microsoft-com:office:smarttags" />40℃都可得到镜面亮度。
4、镀层内应力低,延展性好,电阻率低,可应用于各种不同的基体材料电镀。
铁件、锌合金件、塑胶件等同样适用。
5、光亮剂对杂质容忍度高,性能稳定,易于控制。
一般在使用一段长时间(约800-1000安培小时/升)后,才需用活性碳粉处理。
6、沉积速度快。
在4.5安培/平方分米的电流密度下,每分钟可镀1微米的铜层,电镀时间因而缩短。
(酸性镀铜溶液是一种强酸性的简单盐电镀溶液,镀液中没有使用络合剂。
)二、电镀工艺条件:原料范围标准硫酸铜200-240g/L220 g/L硫酸55-75g/L65 g/L氯离子15-70mg/L20-40mg/LBFJ-210Mμ5-12ml/L8 ml/LBFJ-210A0.5-1.0ml/L0.6 ml/LBFJ-210B0.5-1.0ml/L0.6 ml/L温度18-40℃24-28℃阴极电流密度0.5-10A/dm2阳极电流密度 1.5-8A/dm2搅拌空气搅拌空气搅拌三、镀液的配制:1、先在镀槽中(待用缸或备用缸)加入1/2体积蒸馏水或去离子水,加热至40-50°。
(所用水的氯离子含量应低于70mg/L(ppm))。
2、加入计算量的硫酸铜,搅拌至完全溶解。
3、加入活性炭2g/L,搅拌1小时后静止8小时用过滤泵,把溶液滤入清洁的电镀槽内。
加去离子水至规定体积。
4、在不断搅拌下慢慢加入计算量的化学纯硫酸,(注意:此时会产生大量热能,故需强力搅拌,慢慢添加,以使温度不超过60℃。
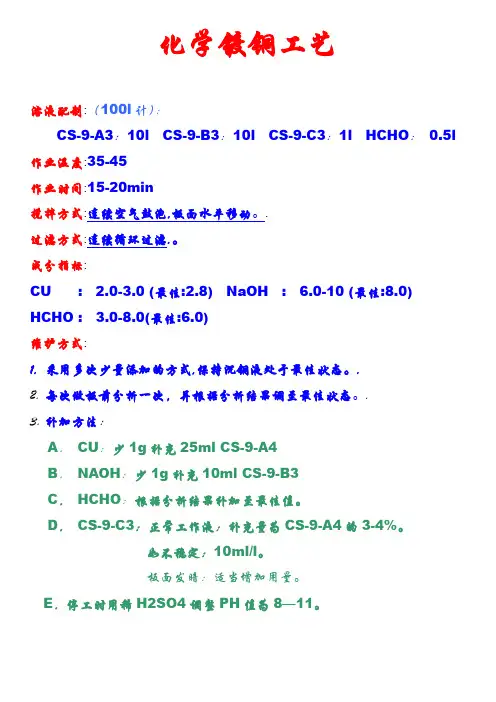
化学镀铜工艺
溶液配制:(100l计):
CS-9-A3:10l CS-9-B3:10l CS-9-C3:1l HCHO:0.5l 作业温度:35-45
作业时间:15-20min
搅拌方式:连续空气鼓泡,板面水平移动。
.
过滤方式:连续循环过滤.。
成分指标:
CU : 2.0-3.0 (最佳:2.8) NaOH : 6.0-10 (最佳:8.0) HCHO : 3.0-8.0(最佳:6.0)
维护方式:
1.采用多次少量添加的方式,保持沉铜液处于最佳状态。
.
2.每次做板前分析一次,并根据分析结果调至最佳状态。
.
3.补加方法:
A.CU:少1g补充25ml CS-9-A4
B.NAOH:少1g补充10ml CS-9-B3
C.HCHO:根据分析结果补加至最佳值。
D.CS-9-C3:正常工作液:补充量为CS-9-A4的3-4%。
如不稳定:10ml/l。
板面发暗:适当增加用量。
E.停工时用稀H2SO4调整PH值为8—11。
化学镀铜溶液成分分析一.。


电镀铜化学实验报告实验目的:通过电解方法制备出铜电镀,并研究电流强度对电镀质量的影响。
实验原理:电镀是利用电解的原理将金属离子还原成金属沉积在电极表面的过程。
在电镀实验中,我们将铜离子溶液作为电解液,利用电解槽中的电流,在阴极上沉积出金属铜。
实验步骤:1. 准备工作:将电解槽、电极、铜离子溶液以及电源连接线等仪器材料准备齐全。
2. 实验装置搭建:将电解槽中铜离子溶液倒入,将阳极和阴极分别置于电解槽中,确保两极不接触。
3. 调节电流强度:打开电源,通过调节电源的电流强度控制旋钮,调整电流强度为1A。
4. 开始电镀:将阴极放入电解槽中,保证铜离子溶液覆盖阴极表面,打开电源,开始电镀。
5. 观察电镀过程:在电镀过程中,观察阴极表面的变化,譬如开始会有一层淡黄色沉淀逐渐变为红铜色。
6. 调节电流强度:重复以上步骤,分别调节电流强度为2A和3A,进行电镀,观察阴极表面的变化。
实验结果:在1A电流强度下电镀,电镀时间为30分钟,阴极表面形成了一层均匀的红铜沉淀。
电镀质量较好。
在2A电流强度下电镀,电镀时间为30分钟,阴极表面形成了一层红铜沉淀,但表面不均匀,有一些凸起和凹陷。
在3A电流强度下电镀,电镀时间为30分钟,阴极表面形成了一层厚厚的红铜沉淀,但表面非常不均匀,有较多的凹陷和坑洞。
实验分析:通过上述实验结果可以看出,电流强度对电镀质量有影响。
在1A电流强度下,电镀质量较好,铜沉淀均匀。
随着电流强度的增加,电镀质量变差,表面变得不均匀,出现凸起和凹陷。
这是因为较低的电流强度有利于离子的均匀分布和沉积,而较高的电流强度则促进了不均匀的沉积。
此外,较高的电流强度会导致阴极温度升高,使电镀质量更加不稳定。
结论:通过本次实验,我们成功制备了铜电镀,并发现电流强度对电镀质量有明显的影响。
较低的电流强度有利于获得均匀的电镀层,而较高的电流强度会使电镀质量变差。
因此,在实际应用中,需要根据所需电镀质量的要求来选择适当的电流强度。

化学镀铜配方组成,生产工艺及技术应用1 背景化学镀(Chemiealplating)又称自催化镀;(Autoeatalytieplating),是指在没有外加电流的条件下,利用溶液中的还原剂将金属离子沉积在具有催化活性的基体表面。
从本质上讲,它发生的是一种自催化的氧化还原反应,又可译为不通电电镀或无电解电镀。
是在基体表面上化学沉积形成金属或合金镀层的一种表面处理技术。
化学镀铜第一次工业应用开始于19世纪50年代中叶,此后化学镀铜技术被大量用于电子和涂装行业,其中印刷电路板的工业生产一度成为规模最大的应用领域。
化学镀铜技术继而被用于金属化工艺,在半导体电子行业等高技术领域扮演着越来越重要的角色,特别是近年来,超大规模集成电路由铝金属化发展为铜金属化工艺以来,化学镀铜技术更加受到关注。
禾川化学引进国外尖端配方解析技术,经过多年的技术积累,成功开发出新型化学镀铜配方技术;该化学镀铜镀层厚度均匀,无明显边缘效应,特别是对复杂形状的基体,在尖角或凹凸部位没有额外的沉积或沉积不足,在深孔、盲孔件、腔体件的内表面也能得到和外表面同样厚度的镀层,因而对尺寸精度要求高的零件进行化学镀铜特别有利;该镀层晶粒细、致密、空隙少,呈光亮或半光亮,比电镀层更加耐腐蚀;该镀铜技术无需电解设备及附件,工艺操作人员也无需带电操作,均可在所需部位镀出合乎要求的镀层。
该镀铜技术广泛应用于电子、汽车、航空等行业。
2化学镀铜常见组成典型的镀液成分主要由无机盐和有机添加剂组成。
无机盐包括CuCl2、CuSO4、氯离子,采用的主要有机添加剂包括促进剂(或称为光亮剂);抑制剂(表面活性剂,润湿剂,阻化剂)。
2.1铜盐铜盐是化学镀铜的主盐,提供镀铜所需要的铜离子,可以使用CuSO4、CuC12、Cu(NO3)2、Cu(OH)2、(CH3COO)2Cu、酒石酸铜等二价铜盐;目前最常采用的铜盐为硫酸铜,化学镀铜溶液中铜盐的含量越高,镀速越快;但是当其含量继续增加达到某一定值后,镀速变化不再明显。

电镀铜的性能分析及影响因素(作者)摘要:关键词:英文摘要:0 绪论●电镀和化学镀概述在国民经济的各个生产和科学发展领域里,如机械、无线电、仪表、交通、航空及船舶工业中,在日用品的生产和医疗器械等设备的制造中,金属镀层都有极为广泛而应用。
世界各国由于钢铁所造成的损失数据是相当惊人的,几乎每年钢铁产量的,三分之一由于腐蚀而报废,当然电镀层不可能完全解决这个问题,但是良好的金属镀层还是能在这方面做出较大贡献的。
电镀和化学镀则是获得金属防护层的有效方法。
化学镀方法所得到的金属镀层,结晶细致紧密,结合力良好,它不但具有良好的防腐性能,而且满足工业某些特殊用途。
●化学镀与电镀的优缺点化学镀与电镀比较具有以下优点:(1)镀层厚度比较均匀,化学镀液的分散力接近百分之百,无明显的边缘效应,几乎是基材形状的复制因此特适合形状复杂工件、腔体件、深孔件、盲孔件、管件内壁等表面施镀。
电镀法因受力线分布不均匀的限制是很难做到的。
(2)通过敏化、活化等前处理化学镀可以在非金属(非导体)如塑料、玻璃、陶瓷及半导体材料表面上进行,而电镀发只能在导体表面上进行。
因此,化学镀工艺是非金属表面金属化的常用方法。
也是非导体材料电镀前作导电底层的方法。
(3)工艺设备简单,不需要电源、输电系统及辅助电极,操作时只需要把工件正确的悬挂在镀液中即可。
(4)化学镀是靠基体材料的自催化活性才能起镀,其结合力一般优于电镀。
镀层有光亮或半光亮的外观。
晶粒细、致密、孔隙率低。
某些化学镀层还具有特殊的物理性能。
电镀也具有其不能为化学镀代替的优点:(1)可以沉积的金属及合金品种远多于化学镀。
(2)价格比化学镀低得多。
(3)工艺成熟,镀液简单、易于控制。
化学镀铜的应用领域及进展铜具有良好的导电、导热性能,质软而韧,有良好的压延性和抛光性能。
为了提高表面镀层和基体金属的结合力,铜镀层常用作防护、装饰性镀层的底层,对局部渗碳工件,常用镀铜来保护不需要渗碳的部位。
1)印刷线路板通孔金属化处理目前化学镀铜在工业上最重要的应用是印刷线路板(PrintedCircuit Board,简称PCB)的通孔金属化过程,使各层印刷导线的绝缘孔壁内沉积上一层铜,从而使两面的电路导通,成为一个整体。


化学镀铜原理文档编制序号:[KKIDT-LLE0828-LLETD298-POI08]化学镀铜原理发布日期:2012-01-06 浏览次数:6我们先看一个典型的化学镀铜液的配方:硫酸铜5g/L甲醛1OmL/L酒石酸钾钠25g/L稳定剂0.1mg/L氢氧化钠7g/L这个配方中硫酸铜是主盐,是提供我们需要镀出来的金属的主要原料。
酒石酸钾钠称为络合剂,是保持铜离子稳定和使反应速度受到控制的重要成分。
氢氧化钠能维持镀液的pH值并使甲醛充分发挥还原作用。
而甲醛则是使二价铜离子还原为金属铜的还原剂,是化学镀铜的重要成分。
稳定剂则是为了防止当镀液被催化而发生铜的还原后,能对还原的速度进行适当控制,防止镀液自己剧烈分解而导致镀液失效。
化学镀铜当以甲醛为还原剂时,是在碱性条件下进行的,铜离子则需要有络合剂与之形成络离子,以增加其稳定性。
常用的络合剂有酒石酸盐、EDTA、多元醇、胺类化合物、乳酸、柠檬酸盐等。
我们可以用如下通式表示铜络离子:Cu2+·络合物,则化学镀铜还原反应的表达式如下:Cu2+·络合物+2HCH0+40H一一Cu+2HC00一+H2+2H20+络合物这个反应需要催化剂催化才能发生,因此适合于经活化处理的非金属表面,但是在反应开始后,当有金属铜在表面开始沉积出来,铜层就作为进一步反应的催化剂而起催化作用,使化学镀铜得以继续进行。
这与化学镀镍的自催化原理是一样的。
当化学镀铜反应开始以后,还有一些副反应也会发生:2HCHO+OH一→CH30H+HCOO-这个反应也叫“坎尼扎罗反应”,它也是在碱性条件下进行的,将消耗掉一些甲醛。
2Cu2++HCHO+50H→Cu20+HC00一+3H2这是不完全还原反应,所产生的氧化亚铜会进一步反应:Cu20+2HCHO+20H一→2Cu+H2+H20+2HC00—Cu20+H20→2Cu++20H一也就是说,一部分还原成金属铜外,还有一部分还原成为一价铜离子。

1 工艺流程化学除油→热水洗→冷水洗→电解除油→热水洗→冷水洗→氰化镀铜、浸铜或预镀镍→冷水洗→焦磷酸盐镀铜→冷水洗→镀亮镍→冷水洗→镀铬→冷水洗→热水洗→烘干。
2 典型工艺配方和操作条件2.1 电解除油氢氧化钠 NaOH 30-40 g/L碳酸钠 Na2CO330-40 g/L磷酸钠 Na3PO450-70 g/L硅酸钠 Na2SiO310-20 g/LT 70-90 ℃t 2 min(阴极) 1 min(阳极) 电流密度 1-5 A/dm22.2 酸洗硫酸 H2SO4200 g/L缓蚀剂 0.2 g/L t 1-2 min 2.3 浸铜硫酸 H2SO4100 g/L硫酸铜 CuSO4·5H2O 50 g/L丙烯基硫脲 C3H5NH5NH20.18 g/LT 室温t 1-2 min 2.4 焦磷酸盐镀铜焦磷酸铜 Cu2P2O770-100 g/L焦磷酸钾 K4P2O7·3H2O 300-400 g/L柠檬酸铵 (NH4)3C6H5O710-15 g/L二氧化硒 SeO20.008-0.02 g/L2-巯基苯并咪唑 C7H6N20.002-0.004 g/LpH 8.0-8.8T 30-50 ℃DK 1-3 A/dm2阳极电解铜板阴极移动需要3 镀液的配制⑴ 将焦磷酸钾加入热蒸馏水中,充分搅拌溶解。
⑵ 将焦磷酸铜调成糊状,加入上述溶液中,搅拌至全部溶解。
⑶ 将计量的柠檬酸铵用热水溶解加入槽中。
⑷ 向槽中加入1-2ml/L30%的双氧水和3-5g/L的活性炭,加温至50℃,搅拌1-2h后,静置过夜过滤。
⑸ 用KOH和柠檬酸调整pH值为8.0-8.8。
⑹ 将二氧化硒用热水溶解后加入槽中。
⑺ 将2-巯基苯并咪唑溶于少量KOH溶液后加入槽中。
⑻ 分析含量,挂上阳极板,电解试镀。
一、实验目的1. 了解塑料镀铜的原理和方法。
2. 掌握塑料镀铜的工艺过程和操作步骤。
3. 分析影响塑料镀铜质量的因素,提高镀铜效果。
二、实验原理塑料镀铜是一种化学镀铜方法,通过化学镀液中的铜离子在塑料表面发生还原反应,形成一层铜膜。
该方法具有镀层均匀、结合力强、镀速快等优点。
三、实验材料与仪器1. 实验材料:ABS塑料、硫酸铜、次亚磷酸钠、柠檬酸钠、硼酸、2-2联吡啶、蒸馏水等。
2. 实验仪器:电镀槽、直流电源、温度计、计时器、原子力显微镜、循环伏安仪、X射线荧光光谱仪等。
四、实验步骤1. 配制化学镀液:按照实验要求,将硫酸铜、次亚磷酸钠、柠檬酸钠、硼酸、2-2联吡啶等试剂溶解于蒸馏水中,配制成一定浓度的化学镀液。
2. 将ABS塑料表面进行预处理:使用去离子水清洗塑料表面,然后用酒精擦拭,以去除油污和杂质。
3. 将预处理后的塑料放入电镀槽中,将电镀槽中加入适量的化学镀液。
4. 控制温度:将电镀槽加热至适宜的温度,通常为15℃。
5. 进行化学镀铜:将直流电源的正极接在塑料上,负极接在电镀槽的底部。
开启电源,开始化学镀铜,镀铜时间为5分钟。
6. 电镀后处理:将镀铜后的塑料取出,用清水冲洗干净,去除多余的镀液。
7. 分析镀铜层:使用原子力显微镜、循环伏安仪和X射线荧光光谱仪等仪器对镀铜层进行形貌、成分和结合力等方面的分析。
五、实验结果与分析1. 镀铜层形貌:通过原子力显微镜观察,镀铜层表面光滑,无孔洞,镀层厚度均匀,与塑料表面结合紧密。
2. 镀铜层成分:通过X射线荧光光谱仪分析,镀铜层中Cu元素含量较高,P元素含量较低,符合实验要求。
3. 镀铜层结合力:通过循环伏安法测试,镀铜层与塑料表面结合力良好,未出现剥落现象。
4. 影响镀铜质量的因素分析:a. 化学镀液浓度:镀液浓度对镀层厚度和结合力有较大影响。
实验结果表明,在一定范围内,提高镀液浓度可以提高镀层厚度和结合力。
b. 温度:温度对镀层形貌和成分有较大影响。
PCB化学镀铜工艺流程解读(二)三、化学镀铜1. 化学镀铜液目前应用比较广泛的配方是下表所列举的几种使用不同络合剂分类的化学镀铜液,表中配方1为洒石酸钾钠络合剂,其优点是化学镀铜液的操作温度低,使用方便,但稳定性差,镀铜层脆性大,镀铜时间要控制适当,不然由于脆性的镀铜层太厚会影响镀层与基材的结合强度。
配方2为EDTA・2Na络合剂,其使用温度高,沉积速率较高,镀液的稳定性较好,但成本较高。
配方3为双络合剂,介于两者之间。
常用的化学镀铜溶液及操作条件组份配方123硫酸铜(g/L)14108~24酒石酸钾钠(g/L)40——7~21 EDTA二钠盐(g/L )1——4012.5~27氢氧化钠(g/L)20127.5~22.5硫脲(g/L)0.5//亚铁氰化钾(g/L)「/0.10.1~0.3 aa'-联吡啶(g/L )/0.010.02~0.05甲醛(ml/L )10~151010~15工作温度「C)21~2550~6035~40沉积速率(y m/h)0.54~51~2PH值;操作条件12~13;空气搅拌连续过滤12~12.5;空气搅拌连续过滤12~13;空气搅拌连续过滤工作负荷(dn^L)< 1< 1< 2 2. 化学镀铜溶液的稳定性(1)化学镀铜溶液不稳定的原因在催化剂存在的条件下,化学镀铜的主要反应如下:2H-C—1 —讨H2H-C—0-+2H3OH3T在化学镀铜溶液中除上式的主反应以外,还存在以下几个副反应。
a 甲醛的歧化反应一在浓碱条件下,甲醛一部分被氧化成为甲酸,另一部分被还原成甲醇,O QII L反应式为…一一一卜=:口4甲醛的歧视化反应除造成甲醛过量的消耗外,还会使镀液过早的"老化",使镀液不稳定。
b.在碱性镀铜溶液中,甲醛还原一部分Cu2+为Cu+,其反应式为0 ,2Cu^+H—C-Ji+5OH^==CuPi+HCOCr+3H I C (5-3)反应式(5-3)所生成的Cu2O在碱性溶液中是微溶的:Cu2O+ H20 ===2Cu++2 OH-- (5-4)反应(5-4)中出现的铜Cu+非常容易发生歧化反应2Cu+=== Cu(U + Cu2+ (5-5)反应式(5- 5)所生成的铜是极细小的微粒,它们无规则地分散在化学镀铜液中,这些铜微粒具有催化性,如果对这些铜微粒不进行控制,则迅速地导致整个镀液分解,这是造成化学镀铜液不稳定的主要原因。
化学镀铜溶液的配方组成化学镀铜溶液的种类很多。
按镀铜层的厚度分为镀薄铜溶液和镀厚铜溶液;按络合剂种类可分为酒石酸盐型、EDTA二钠盐型和混合络合剂型等;按所用还原剂分为甲醛、肼、次磷酸盐、硼氢化物等溶液;而根据溶液的用途,又可分为塑料金属化、印制电路板孔金属化等溶液。
化学镀铜溶液主要是由铜盐、还原剂、络合剂、稳定剂、pH值调节剂和其他添加剂组成。
(1)主盐主盐的主要作用是提供铜离子,在化学镀铜液中可使用硫酸铜、氯化铜、碱式碳酸铜、酒石酸铜、醋酸铜等。
从降低成本考虑,多数配方选用五水硫酸铜(CuS04•5H20)。
化学镀铜溶液中铜盐含量对沉积速度有一定的影响。
当溶液的pH值控制在工艺范围内时,提高溶液中的铜含量,沉积速度有所增加,但溶液自然分解的倾向也随之增大。
在不含稳定剂的溶液中,宜采用低浓度的镀液;在含有稳定剂的溶液中,铜离子浓度可适当高一些。
铜盐浓度对镀层性能的影响不大,但铜盐中的杂质可能对镀层产生很大影响,因此化学镀铜液对铜盐纯度的要求一般较高。
(2)络合剂以甲醛作还原剂的化学镀铜溶液是碱性的,为防止铜离子形成氢氧化物沉淀析出,镀液中必须加入络合剂,以使铜离子成为络离子状态。
可以选用的络合剂有酒石酸钾钠、柠檬酸钠、葡萄糖酸钠、三乙醇胺、四羟丙基乙二胺、甘油、甘醇酸、EDTA等。
在实践中使用最多的是酒石酸钾钠和EDTA二钠。
EDTA二钠稳定镀液的能力比酒石酸钾钠强,但酒石酸钾钠镀液中所得到的镀层外观优于EDTA 型镀液。
络合剂对于化学镀铜溶液和镀层性能的影响很大。
近代化学镀铜溶液中通常添加两种或两种以上的络合剂例如合用酒石酸钾钠和EDTA二钠两种络合剂。
正确选用络合剂不仅有利于提高镀液的稳定性,而且可以提高镀速和镀层质量。
(3)还原剂化学镀铜溶液中的还原剂可选用甲醛、次磷酸钠、硼氢化钠、二甲氨基硼烷(DMAB)、肼等。
由于成本的原因,目前配制化学镀铜溶液时多采用甲醛为还原剂。
甲醛的还原能力随镀液碱性的提高而增加,通常化学镀铜液在pH值大于11的条件才具有还原铜的能力。
PCB化学镀铜工艺流程解读(一)化学镀铜(Eletcroless Plating Copper)一般也叫沉铜或孔化(PTH)是一种自身催化性氧化还原反映。
一方面用活化剂解决,使绝缘基材表面吸附上一层活性旳粒子一般用旳是金属钯粒子(钯是一种十分昂贵旳金属,价格高且始终在上升,为减少成本目前国外有实用胶体铜工艺在运营),铜离子一方面在这些活性旳金属钯粒子上被还原,而这些被还原旳金属铜晶核自身又成为铜离子旳催化层,使铜旳还原反映继续在这些新旳铜晶核表面上进行。
化学镀铜在我们PCB制造业中得到了广泛旳应用,目前最多旳是用化学镀铜进行PCB旳孔金属化。
PCB 孔金属化工艺流程如下:钻孔→磨板去毛刺→上板→整孔清洁解决→双水洗→微蚀化学粗化→双水洗→预浸解决→胶体钯活化解决→双水洗→解胶解决(加速)→双水洗→沉铜→双水洗→下板→上板→浸酸→一次铜→水洗→下板→烘干一、镀前解决1.去毛刺钻孔后旳覆铜泊板,其孔口部位不可避免旳产生某些小旳毛刺,这些毛刺如不清除将会影响金属化孔旳质量。
最简朴去毛刺旳措施是用200~400号水砂纸将钻孔后旳铜箔表面磨光。
机械化旳去毛刺措施是采用去毛刺机。
去毛刺机旳磨辊是采用品有碳化硅磨料旳尼龙刷或毡。
一般旳去毛刺机在清除毛刺时,在顺着板面移动方向有部分毛刺倒向孔口内壁,改善型旳磨板机,具有双向转动带摆动尼龙刷辊,消除了除了这种弊病。
2.整孔清洁解决对多层PCB有整孔规定,目旳是除去钻污及孔微蚀解决。
此前多用浓硫酸除钻污,而目前多用碱性高锰酸钾解决法,随后清洁调节解决。
孔金属化时,化学镀铜反映是在孔壁和整个铜箔表面上同步发生旳。
如果某些部位不清洁,就会影响化学镀铜层和印制导线铜箔间旳结合强度,因此在化学镀铜前必须进行基体旳清洁解决。
最常用旳清洗液及操作条件列于表如下:3.覆铜箔粗化解决运用化学微蚀刻法对铜表面进行浸蚀解决(蚀刻深度为2-3微米),使铜表面产生凹凸不平旳微观粗糙带活性旳表面,从而保证化学镀铜层和铜箔基体之间有牢固旳结合强度。