硅片检验标准
- 格式:pdf
- 大小:1.61 MB
- 文档页数:9


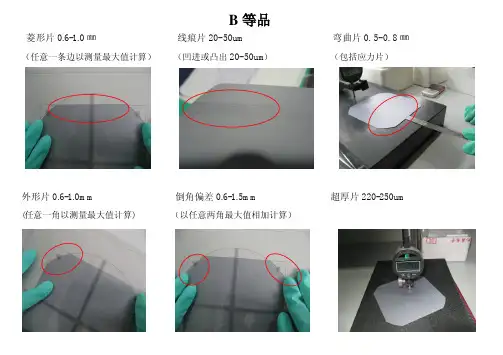
菱形片0.6-1.0㎜线痕片20-50um弯曲片0.5-0.8㎜(任意一条边以测量最大值计算)(凹进或凸出20-50um)(包括应力片)外形片0.6-1.0mm倒角偏差0.6-1.5mm超厚片220-250um (任意一角以测量最大值计算)(以任意两角最大值相加计算)超薄片150-160um硅晶脱落≤0.3mm 毛边≤0.3mm(双面缺损不在同一位置)尺寸不良124.50-126.00mm 尺寸不良148.00-149.50mm 尺寸不良150.50-151.50mm(两边相差不超过1.0mm )B 等品电阻率6-10Ω.cm台阶片≤20um厚薄不均最薄不低于150um 最厚不超过280um TTV50-70um边道翘曲0-80um 边道翘曲边缘测量值280umC等品倒角偏差1.5-2.0mm外形片1.0-2.0mm菱形片1.0-1.5mm(以任意两角最大值相加计算)(任意一角以测量最大值计算)(任意一条边以测量最大值计算)线痕片50-80um超厚片250-280um硅晶脱落≤0.5mm(凹进或凸出)(双面缺损不在同一位置)C 等品毛边≤0.5mm尺寸不良124.00-124.50mm尺寸不良126.00-127.00mm尺寸不良151.50-153.00mm 尺寸不良146.50-148.00mm 电阻率退火后6-10Ω.cmC等品边道翘曲80-150um边道翘曲边缘测量值350um厚薄不均150-280um TTV70-100um不合格品倒角偏差>2.0mm外形>2.0mm硅晶脱落>0.5mm毛边>0.5mm超薄片<150um弯曲>0.8mm电阻率>10Ω.cm电阻率<0.5Ω.cm超厚片>280um边道翘曲>150um孪晶片台阶片>20um线痕>80um缺角孔洞外形〉2.0mm隐裂纹。



硅片进货检验规程
1、从仓库领取同一硅片供应商一定数量的硅片。
2、用“BD-86A型半导体电阻率测试仪”测出每片硅片的原始方块电阻,
并按照20 Ω/□一档进行分档存放。
(详见《硅片进货检验报告单》)
3、用测厚仪测出每片硅片的厚度并按20μm一档进行分档存放。
(详见《硅片进货检验报告单》)
4、在检测硅片方块电阻和厚度的同时,挑出外观不良的硅片另外存放。
(外观不良包括:裂纹、划痕、污垢、崩边、缺角、厚度不一、边距不一、形状不规则等)
5、检验结束后按要求填写好《硅片检验报告单》。
6、将检验好的硅片统一摆放的固定位置。

版本状态临时版文件名称硅片检验页码1/5编制/日期:审核/日期批准/日期:1.目的监测硅片质量,确保电池片质量稳定。
J2.适用范围适用于本公司品质部对所有来料硅片质量的监视和测量。
3.职责3.1 品质部负责制订硅片检验文件。
3.2 品质部负责来料硅片质量的控制。
4.检验4.1核对对照送检单,核对硅片的来源、规格和数量,供方所提供的参数、如电阻率、厚度、对角线长、边长。
检查供方出具的材质报告(碳含量、氧含量、晶向及位错密度),如有不符,须先与采购部沟通,无误后进行检验。
4.2 外观检验4.2.1用刀片划开封条,划时刀片不宜切入太深,刀尖深入不要超过5mm,防止划伤泡沫盒内的硅片。
塑封好的硅片,用刀尖轻轻划开热缩膜四个角,然后撕开热缩膜。
4.2.2 抽出两边的隔版,观察盒内有没有碎片,如有则要及时清理碎片。
4.2.3 检验时戴PVC手套。
从盒内拿出100片硅片(不得超过100片),先把硅片并齐并拢后观察硅片四边是否对齐平整,并用硅片模板进行对照,鉴别是否存在尺寸不对的现象,如不符合,则用游标卡尺测量,并及时记录于硅片外观检验原始记录表上。
4.2.4 再将100片硅片分出一部分使其旋转90度或180度,再并拢观察硅片间是否有缝隙,如有则说明有线痕或是TTV超标的现象。
将缝隙处的硅片拿出来,用MS-203测硅片上不固定的数点厚度(硅片边缘2-5cm以内取点),根据厚度结果确定是否超标。
将线痕、TTV超标片区别放置。
再观察四个倒角是否能对齐,如有偏差,对照硅片模板进行鉴别,把倒角不一致硅片分开放置。
并在硅片外观检验原始记录表上分别记录数量。
4.2.5 观察硅片是否有翘曲现象,翘曲表现为硅片放在平面上成弧形或是一叠硅片并拢后容易散开。
如有,则要把硅片放在大理石平面上,用塞尺测量其翘曲度,将翘曲度超标片区别放置,在硅片外观检验原始记录表上记录数量。
4.2.6 逐片检验硅片,将碎片、缺角、崩边、裂纹、针孔、污物、微晶(特指多晶硅片)等不合格品单独挑出,分别存放,并在硅片外观检验原始记录表上记录。

多晶硅片技术标准1范围1.1 本要求规定了多晶硅片的分类、技术要求、包装以及检验规范等1.2 本要求适用于多晶硅片的采购及其检验。
2 规范性引用文件2.1 GB/T 1557 硅晶体中间隙氧含量的红外吸收测量方法2.2 GB/T 1558 硅中代位碳原子含量红外吸收测量方法2.3 ASTM F 1535用非接触测量微波反射所致光电导性衰减测定载流子复合寿命的试验方法3 术语和定义3.1 TV:硅片中心点的厚度,是指一批硅片的厚度分布情况;3.2 TTV:总厚度误差,是指一片硅片的最厚和最薄的误差(标准测量是取硅片5 点厚度:边缘上下左右4点和中心点);3.4崩边:晶片边缘或表面未贯穿晶片的局部缺损区域,当崩边在晶片边缘产生时,其尺寸由径向深度和周边弦长给出;3.5 裂纹、裂痕:延伸到晶片表面,可能贯穿,也可能不贯穿整个晶片厚度的解理或裂痕;3.6 垂直度:硅片相邻两边与标准90°相比较的差值。
3.7 密集型线痕:每1cm上可视线痕的条数超过5条4 分类多晶硅片的等级有A级品和B级品,规格有:125⨯125;156⨯156;210⨯210。
5 技术要求5.1 外观5.1.1无孪晶、隐裂、裂痕、裂纹、孔洞、缺角、V形(锐形)缺口,崩边、缺口长度≤0.5mm,深度≤0.3mm,且每片不得超出2个;5.1.2表面需清洗干净,无可见斑点、玷污及化学残留物;5.1.3硅片表面局部凹凸不平深度(如表面划痕、凹坑、台阶等)≤20μm,切割线痕深度≤20μm;当在硅片正反两面的同一个位置出现线痕加和小于20um。
无密集型线痕。
5.1.4 弯曲度≤30μm,,翘曲度≤30μm;5.1.5切片前的棒/锭要经化学腐蚀或机械抛光去除损伤层,即切完的硅片边沿是光亮的。
5.2外形尺寸5.2.1 标称厚度系列为200±20μm;220±20μm;240±20μm;对于每单合同需要明确规定标称厚度。

soi硅片检验标准一、尺寸检查1.1 检查内容:硅片的尺寸应符合规定的尺寸要求,包括长度、宽度和厚度。
1.2 检查方法:使用精度为0.01mm的卡尺进行测量。
1.3 判定标准:若实际尺寸与规定尺寸的偏差在±0.05mm范围内,则判定为合格。
二、表面质量2.1 检查内容:硅片的表面应光滑、洁净,无划痕、裂纹、凹坑等缺陷。
2.2 检查方法:通过目视或使用5倍放大镜进行检查。
2.3 判定标准:若硅片表面存在上述缺陷,则判定为不合格。
三、厚度测量3.1 检查内容:硅片的厚度应符合规定的厚度要求。
3.2 检查方法:使用精度为0.01mm的卡尺进行测量。
3.3 判定标准:若实际厚度与规定厚度的偏差在±0.02mm范围内,则判定为合格。
四、翘曲度测量4.1 检查内容:硅片的翘曲度应符合规定的翘曲度要求。
4.2 检查方法:将硅片放置在水平面上,使用精度为0.01mm的直尺进行测量。
4.3 判定标准:若翘曲度超过规定范围,则判定为不合格。
五、电阻率测量5.1 检查内容:硅片的电阻率应符合规定的电阻率要求。
5.2 检查方法:使用电阻率测试仪进行测量。
5.3 判定标准:若电阻率超过规定范围,则判定为不合格。
六、吸光度测量6.1 检查内容:硅片的吸光度应符合规定的吸光度要求。
6.2 检查方法:使用吸光度计进行测量。
6.3 判定标准:若吸光度超过规定范围,则判定为不合格。
七、化学成分分析7.1 检查内容:硅片的化学成分应符合规定的化学成分要求。
7.2 检查方法:使用光谱分析仪进行测量。
7.3 判定标准:若化学成分不符合规定要求,则判定为不合格。
八、机械强度测试8.1 检查内容:硅片的机械强度应符合规定的机械强度要求。
8.2 检查方法:使用万能材料试验机进行测试。

半导体硅片的检验准则半导体硅片的检验准则导语:半导体硅片检验是半导体制造过程中非常重要的环节。
本文将深入探讨半导体硅片的检验准则,包括其基本原理、常见的检验方法和标准,以及对检验结果的分析和评估。
一、背景介绍在半导体工业中,半导体硅片是制造集成电路的重要基础材料。
而半导体硅片的质量直接影响着电子器件的性能和可靠性。
在半导体生产过程中进行严格的检验至关重要。
二、基本原理半导体硅片的检验是通过测量和分析其物理参数和工艺特征来判断其质量。
主要包括以下几个方面:1. 外观检验:包括观察硅片表面是否有裂纹、划痕、污染等缺陷,以及检查硅片的尺寸和平整度是否符合要求。
2. 电特性检验:通过测量硅片的电阻、电容、电压等参数,判断其电性能是否满足设计要求。
3. 表面特性检验:通过使用显微镜、扫描电子显微镜等设备,观察硅片表面的形貌、晶粒结构等特征,以评估其晶体质量和晶粒大小的均匀性。
4. 化学污染检验:通过使用化学分析方法,检测硅片中的有害杂质、金属离子等污染物的含量,以评估其纯度。
三、常见的检验方法和标准1. 外观检验:通常采用目视检查和显微镜观察的方式进行,以国家相关标准为准。
2. 电特性检验:包括电阻测量、电容测量、霍尔效应测量等方法,仪器主要包括多用电表、LCR桥、霍尔效应测试仪等。
3. 表面特性检验:常用的方法有显微镜观察、原子力显微镜观察、扫描电子显微镜观察等,根据不同应用领域制定相应的表面粗糙度、晶粒尺寸等标准。
4. 化学污染检验:一般通过化学分析方法,如电感耦合等离子体发射光谱仪(ICP-OES)、能谱仪或质谱仪等,以国际标准或公司内部标准为依据。
四、检验结果的分析和评估半导体硅片的检验结果通常会输出各项参数的数值以及对应的标准值。
根据数值的大小和与标准值的偏差,可进行以下分析和评估方面的工作:1. 质量评估:将检验结果与已设定的标准进行对比,评估硅片是否合格,是否可继续用于下一工序的制造。
2. 偏差分析:对超出标准范围的数据进行分析,找出问题所在,进一步改进生产工艺。

半导体硅片检验标准
半导体硅片检验标准
半导体硅片是半导体器件制造的基础材料之一,因此其检验标准至关重要。
以下是半导体硅片检验标准的详细说明。
1. 外观检查
外观检查是半导体硅片检验的最基本要求。
在检查外观时,应检查硅片表面是否有裂纹、破损、划痕、气泡等缺陷,同时也应检查硅片的形状是否符合要求。
2. 表面检测
表面检测可以通过使用光学显微镜、SEM(扫描电子显微镜)等仪器来完成。
该检测可以用来评估硅片表面的平整度、颗粒数量、颗粒大小等因素。
需要注意的是,有些表面缺陷可能在目测外观检查时并不明显,因此表面检测往往会被认为是最灵敏的检测方法之一。
3. 清洗检验
清洗检验可以确定硅片表面是否存在落在硅片上的污染物。
在检查过程中,应确保清洗剂、气氛和温度等条件正确,从而保证检验的可靠性。
4. 检测杂质
杂质是半导体硅片中一个普遍而重要的概念。
在检测杂质时,可以使用玻璃齐墩试剂等方法,对硅片进行表面浸泡。
此外,还可以使用SIMS(二次离子质谱)等方法,对硅片内部的杂质进行检测。
5. 检测电性能
在半导体硅片的制造和生产过程中,电性能的检测是至关重要的。
可以使用四点探针法、霍尔效应仪等方法,对硅片的电性能进行检测。
总之,半导体硅片检验标准非常严格,因此需要依靠多种检测手段确保硅片质量的稳定性和可靠性。
只有通过科学的检验方法,才能确保半导体器件的品质和性能。
硅片质量的七大标准硅片是半导体行业中至关重要的材料之一,它被广泛用于制造集成电路和太阳能电池等应用。
为了确保硅片的质量和性能,有七个关键标准需要被考虑。
本文将详细介绍硅片质量的七大标准。
1. 净度和杂质控制硅片的净度和杂质控制是硅片质量的首要标准。
杂质的存在会对硅片的电学和光学性能产生负面影响。
硅片应该具有极高的净度,特别是对于一些高纯度硅片,杂质的控制尤为重要。
常见的杂质包括金属杂质和非金属杂质,如铁、铜、氧和碳等。
通过严格的杂质控制和净化工艺,可以确保硅片的高纯度和杂质含量的极低水平。
2. 厚度均匀性硅片的厚度均匀性是评估硅片质量的重要指标之一。
硅片的厚度在制造过程中需要被精确控制,以确保产品的一致性和可靠性。
任何过大或过小的厚度变化都可能导致硅片的性能降低。
通过使用先进的制造工艺和仪器设备,可以实现硅片的高度均匀性。
3. 表面平整度硅片的表面平整度是衡量硅片质量的重要指标之一。
表面平整度不仅影响硅片的外观,还直接影响到硅片在后续工艺中的加工性能。
高度平整的表面能够提供更好的光学特性和更高的精度加工。
通过表面处理和抛光工艺,可以实现硅片表面的高度平整度。
4. 晶体结构和晶格质量硅片的晶体结构和晶格质量是评估硅片质量的重要指标之一。
硅片应具有高度有序的晶体结构和完整的晶格。
任何晶体结构和晶格缺陷都可能对硅片的性能和可靠性产生负面影响。
通过严格的制造和质量控制工艺,可以实现硅片的高质量晶体结构和晶格。
5. 衬底的平整度和晶向硅片的衬底平整度和晶向也是评估硅片质量的重要指标之一。
衬底平整度是指硅片表面的平整度和平坦度,对于一些高精度的应用尤为重要。
晶向指的是硅片中晶体的方向,它会对硅片的电学性能和加工特性产生影响。
通过精密的加工和晶体生长工艺,可以实现硅片衬底的高平整度和理想的晶向。
6. 绝缘性能硅片的绝缘性能是评估硅片质量的重要指标之一,特别是对于一些应用需要电绝缘的场景。
绝缘性能可以通过测量硅片的绝缘电阻和击穿电压来评估。
文件更改申请单编号:LW-CX-001-A1-03硅片检验标准1 目得规范多晶硅片检测标准。
2 适用范围本标准规定了多晶硅片得电性能、外观尺寸得检验项目、测量器具、判定依据,适用于正常生产得多晶硅片得质量检验。
3 定义3、1检测工具:数显千分尺、henneck分选机、直尺、三丰粗糙仪、MS203电阻率测试、少子寿命测试WT-2000。
3、2检测术语斑点定义:在光强430-650LUX下,距离眼睛40cm,成30-45°角目视能瞧到颜色异于周围颜色得点即为斑点。
翘曲度:硅片得中面与参考面之间得最大距离与最小距离之差(即a值)。
弯曲度:硅片中心凸起处于参考平面距离差值(即z值)。
硅落:硅片表面有硅晶脱落现象且未穿透。
崩边:以硅片边缘为参考线向内部延伸深度≤0、5mm、长度≤1、5mm及不能崩透得缺损属于崩边。
缺口:光强430-650LUX,目光与硅片成30-45°,距离25-35cm可以瞧到贯通硅片得称为缺口,瞧不到得不属于缺口。
水印:未充分烘干,水分蒸发后残留物。
表面玷污:硅片得表面或侧面沾有残胶或油污等杂物。
游离碳黑线:清洗后距离硅片上边缘5mm以内得黑色区域。
微晶:每1cm2长度上晶粒个数>10个。
4 职责权限4、1 技术部负责制定硅片检验标准;4、2 质量部严格按照本文件中检验标准检验硅片。
5 正文5、1 表面质量表面质量通过生产人员得分选判定,目测外观符合附表1相关要求。
对整包硅片重点查瞧B4(崩边),B7(线痕)、B8(厚度差值)、缺口、碎片、油污等情况;整包里得B4片在迎光侧表现为“亮点”背光侧较暗;B7、B8片手感表现较重,不易区分或存在争议时,利用分选机重新分选。
5、2 外型尺寸几何尺寸符合附表1相关要求,在研磨倒角处控制。
如认为硅片尺寸存在问题使用分选机进行检验。
5、3 电性能依据硅锭/硅块测试数据判定,必要时用相关测试仪器核实。
硅片电阻率测量一点数值,当超出B级范围时,测量五个晶粒得电阻率,计算平均值X,以X值作为最终判定值。
硅片质量的七大标准
硅片质量的七大标准主要包括以下七个方面:
1. 物理尺寸:硅片的直径、厚度、晶向位置和尺寸、定位边和硅片形变等都必须符合规定,以满足芯片生产中器件制造的要求以及适合硅片制造自动传送设备的要求。
2. 平整度:硅片表面的平整度是硅片最主要的参数之一,它是指在通过硅片的直线上的厚度变化。
平整度不达标会造成许多工艺问题,如光刻工艺对局部位置的平整度非常敏感。
3. 微粗糙度:指硅片表面的微观粗糙度,它对硅片表面的摩擦和磨损性能有重要影响。
4. 氧含量:指硅片中氧的含量,它对硅片的机械性能和电学性能有重要影响。
5. 晶体缺陷:指硅片中的晶体缺陷,如位错、层错、微裂纹等,这些缺陷会影响硅片的机械性能和电学性能。
6. 颗粒:指硅片表面的颗粒状物质,这些物质会影响硅片的表面质量和光刻工艺。
7. 体电阻率:指硅片的电阻率,它对硅片的导电性能有重要影响。
以上信息仅供参考,如有需要,建议查阅专业书籍或咨询专业人士。
原硅片接收检验标准1.目的:规定本公司的硅片检验流程,保证和持续提高产品质量2.范围:用于本公司硅片的来料检验过程3.职责:质量部门负责按照本标准严格执行硅片的来料检验工作。
4.内容4.1硅片中金属杂质和碳氧含量标准,见表1表一硅片中金属杂质和碳氧含量杂志种类基体总金属杂质含量(fe cr nicu)ppba表面总金属杂质含量(fe zn na)ppba氧(at0ms/cm3)碳(atoms/cm3)杂质含量(单晶N-type)≤50 ≤70 ≤9×1017≤5×1016杂质含量(单晶P-type)≤50 ≤70 ≤9×1017≤5×1016杂质含量(多晶P-type)≤50 ≤70 ≤3×1017≤5×10174.2硅片检验方法:Ltem检验项目Level检验水平AQL%Conductive type导电类型H 1Resistivity电阻率 1 Thickness tolerance厚度 1 TTV厚度变化量 1 Bow弯曲度 1Appearance外观Lndents凹坑 1 Chips崩边 1 Saw Marks切痕 1 Craters应力 1 Cracks裂纹 1 Else其他 14.2 P型单晶硅片检验标准见表2检验项目合格标准检验方法说明导电类型P型冷热探针测试仪器电阻率(∩.cm)1-3/3-6 四探针测试仪器径向电阻率不均匀度RRV<25% 四探针测试仪器对边宽(mm) 125±0.5 165±0.5数显游标卡尺对角钱(mm) 150±1 165±1200±1 205±1数显游标卡尺圆弧长(mm) 27.77-32.20/10.4-14.1119.93-23.80/14.43-18.16模具方片角度90°±0.3°角尺厚度(um)200±20设备1.硅片的平均厚度为200微米;2.硅片表面所有厚度要在规定范围内,最薄处不低于180微米;3.同批硅片的厚度要呈正态分布,即测量数据的均值±3,&应在厚度规定的范围内厚度不均匀度TT V≦30设备在保证硅片表面厚度情况,对硅片表面取五点测试(中心点以及距四周边缘6mm各取一点)来换算厚度变化量位错密度(个/cm²) <1000 供方保证项有效载流子寿命>1.35us,且>1.4us占90%以上WT-1000少子寿命测试仪体少子寿命>15usSINTON少子寿命测试仪扩散后测试光致衰减LI D≤3%预投流程验证硅片中心低响应(黑心片)比例<0.05% 预投流程验证弯曲度≦40 塞尺切痕无明显切痕手持式粗糙度测试仪允许的切痕深度≤10um凹坑无凹坑目视硅片表面平整,无硅落现象穿孔无穿孔目视沾污无沾污目视不允许有肉眼可见的油污,硅粉,清洗剂,水痕崩边无崩边目视应力无应力手感当硅片拿在手上轻微晃动时不能有嘣咚嘣咚的响声孪晶无孪晶目视从外观看,出现两个及以上的晶体划伤无划伤目视只要在硅片表面有明显肉眼可见异物划过的痕迹,不论长度和面积大小都不合格氧化膜末磨无氧化膜末磨目视缺口无缺口目视缺角无缺角目视裂纹/隐裂无裂纹/隐裂目视偏心偏离度<0.5mm模具4.3 P型多晶硅片检验标准见表3检验项目合格标准检验方法说明导电类型P型冷热探针测试仪电阻率(∩.cm)1-3/3-6 四探针测试仪径向电阻率不均匀RRV<25% 四探针测试仪对边宽(mm)125±0.5156±0.5数显游标卡尺对角线(mm) 175±1219±1数显游标卡尺倒角(mm) 1×45°模具方片角度90°±30°角尺厚度200±20数显千分表或硅片检片机1.硅片的平均厚度为200微米;2.硅片表面所有厚度要在规定范围内,最薄处不低于180微米;3.同批硅片的厚度要呈正态分布,即测量数据的均值±3,&应在厚度规定的范围内厚度不均匀度TT V≦30数显千分表在保证硅片表面厚度情况,对硅片表面取五点测试(中心点以及距四周边缘6mm各取一点)来换算厚度变化量有效载流子寿命>1.35us,且>1.4us占90%以上WT-1000少子寿命测试仪体少子寿命>2usSINTON少子寿命测试仪扩散后测试光致衰减LI D≦2%预投流程验证弯曲度≦40 塞尺微晶1厘米长度内≦5个晶粒目视硅片表面任一方向明显切痕无明显切痕手持式粗糙度测试仪允许的切痕深度≤10um凹坑无目视硅片表面平整,无硅落现象穿孔无目视粘污无目视不允许有肉眼可见的油污,硅粉,清洗剂,水痕崩边无目视应力无当硅片拿在手上轻微晃动时不能有嘣咚嘣咚的响声划伤无只要在硅片表面有明显肉眼可见异物划过的痕迹,不论长度和面积大小都不合格缺口无缺角无裂纹/隐裂无4.4 N型单晶硅片检验标准,见表4检验项目合格标准检验方法说明导电类型N型冷热探针测试仪器电阻率(∩.cm)1-3/3-6 四探针测试仪器径向电阻率不均匀度RRV<25% 四探针测试仪器对边宽(mm) 125±0.5 156±0.5数显游标卡尺对角钱(mm) 165±1200±1 205±1数显游标卡尺圆弧长(mm) 10.40-14.1119.93-23.80/14.43-18.16模具方片角度90°±0.3°角尺厚度(um)200±20数显千分表或硅片检片机1.硅片的平均厚度为200微米;2.硅片表面所有厚度要在规定范围内,最薄处不低于180微米;3.同批硅片的厚度要呈正态分布,即测量数据的均值±3,&应在厚度规定的范围内厚度不均匀度TT V≦30数显千分表在保证硅片表面厚度情况,对硅片表面取五点测试(中心点以及距四周边缘6mm各取一点)来换算厚度变化量位错密度(个/cm²) 无供方保证项体少子寿命>1000usSINTON少子寿命测试仪扩散后测试光致衰减LI D≤0.5%预投流程验证硅片中心低响应(黑心片)比例<0.05% 预投流程验证弯曲度(um) ≦40 塞尺切痕无明显切痕手持式粗糙度测试仪允许的切痕深度≤10um凹坑无凹坑目视硅片表面平整,无硅落现象穿孔无穿孔目视沾污无沾污目视不允许有肉眼可见的油污,硅粉,清洗剂,水痕崩边无崩边目视应力无应力手感当硅片拿在手上轻微晃动时不能有嘣咚嘣咚的响声孪晶无孪晶目视从外观看,出现两个及以上的晶体划伤无划伤目视只要在硅片表面有明显肉眼可见异物划过的痕迹,不论长度和面积大小都不合格氧化膜末磨无氧化膜末磨目视缺口无缺口目视缺角无缺角目视裂纹/隐裂无裂纹/隐裂目视偏心偏离度<0.5mm模具。
菱形片0.6-1.0㎜线痕片20-50um弯曲片0.5-0.8㎜(任意一条边以测量最大值计算)(凹进或凸出20-50um)(包括应力片)
外形片0.6-1.0mm倒角偏差0.6-1.5mm超厚片220-250um (任意一角以测量最大值计算)(以任意两角最大值相加计算)
超薄片150-160um
硅晶脱落≤0.3mm 毛边≤0.3mm
(双面缺损不在同一位置)
尺寸不良124.50-126.00mm 尺寸不良148.00-149.50mm 尺寸不良150.50-151.50mm
(两边相差不超过1.0mm )
B 等品
电阻率6-10Ω.cm
台阶片≤20um
厚薄不均最薄不低于150um 最厚不超过280um TTV50-70um
边道翘曲0-80um 边道翘曲边缘测量值280um
C等品
倒角偏差1.5-2.0mm外形片1.0-2.0mm菱形片1.0-1.5mm
(以任意两角最大值相加计算)(任意一角以测量最大值计算)(任意一条边以测量最大值计算)
线痕片50-80um超厚片250-280um硅晶脱落≤0.5mm
(凹进或凸出)(双面缺损不在同一位置)
C 等品
毛边≤0.5mm
尺寸不良124.00-124.50mm
尺寸不良126.00-127.00mm
尺寸不良151.50-153.00mm 尺寸不良146.50-148.00mm 电阻率退火后6-10Ω.cm
C等品
边道翘曲80-150um边道翘曲边缘测量值350um厚薄不均150-280um TTV70-100um
不合格品
倒角偏差>2.0mm外形>2.0mm硅晶脱落>0.5mm
毛边>0.5mm超薄片<150um弯曲>0.8mm
电阻率>10Ω.cm电阻率<0.5Ω.cm超厚片>280um
边道翘曲>150um孪晶片台阶片>20um
线痕>80um缺角孔洞
外形〉2.0mm隐裂纹。