培训教材-半导体封装工艺简介 130425
- 格式:ppt
- 大小:4.29 MB
- 文档页数:42



半导体封装学习资料1、半导体封装定义:半导体封装是指将通过测试的晶圆按照产品型号及功能需求加工得到独立芯片的过程。
封装过程为:来自晶圆前道工艺的晶圆通过划片工艺后被切割为小的晶片(Die),然后将切割好的晶片用胶水贴装到相应的基板(引线框架)架的小岛上,再利用超细的金属(金锡铜铝)导线或者导电性树脂将晶片的接合焊盘(Bond Pad)连接到基板的相应引脚(Lead),并构成所要求的电路;然后再对独立的晶片用塑料外壳加以封装保护,塑封之后还要进行一系列操作,封装完成后进行成品测试,通常经过入检Incoming、测试Test和包装Packing等工序,最后入库出货。
2、半导体封装简介:半导体生产流程由晶圆制造、晶圆测试、芯片封装和封装后测试组成。
塑封之后,还要进行一系列操作,如后固化(Post Mold Cure)、切筋和成型(Trim&Form)、电镀(Plating)以及打印等工艺。
典型的封装工艺流程为:划片装片键合塑封去飞边电镀打印切筋和成型外观检查成品测试包装出货。
3、各种半导体封装形式的特点和优点:3.1、DIP双列直插式封装DIP(DualIn-line Package)是指采用双列直插形式封装的集成电路芯片,绝大多数中小规模集成电路(IC)均采用这种封装形式,其引脚数一般不超过100个。
采用DIP封装的CPU 芯片有两排引脚,需要插入到具有DIP结构的芯片插座上。
当然,也可以直接插在有相同焊孔数和几何排列的电路板上进行焊接。
DIP封装的芯片在从芯片插座上插拔时应特别小心,以免损坏引脚。
DIP封装具有以下特点:1.适合在PCB(印刷电路板)上穿孔焊接,操作方便。
2.芯片面积与封装面积之间的比值较大,故体积也较大。
Intel系列CPU中8088就采用这种封装形式,缓存(Cache)和早期的内存芯片也是这种封装形式。
3.2、QFP塑料方型扁平式封装和PFP塑料扁平组件式封装半导体封装QFP(Plastic Quad Flat Package)封装的芯片引脚之间距离很小,管脚很细,一般大规模或超大型集成电路都采用这种封装形式,其引脚数一般在100个以上。

半导体封装学习资料1、半导体封装定义:半导体封装是指将通过测试的晶圆按照产品型号及功能需求加工得到独立芯片的过程。
封装过程为:来自晶圆前道工艺的晶圆通过划片工艺后被切割为小的晶片(Die),然后将切割好的晶片用胶水贴装到相应的基板(引线框架)架的小岛上,再利用超细的金属(金锡铜铝)导线或者导电性树脂将晶片的接合焊盘(Bond Pad)连接到基板的相应引脚(Lead),并构成所要求的电路;然后再对独立的晶片用塑料外壳加以封装保护,塑封之后还要进行一系列操作,封装完成后进行成品测试,通常经过入检Incoming、测试Test和包装Packing等工序,最后入库出货。
2、半导体封装简介:半导体生产流程由晶圆制造、晶圆测试、芯片封装和封装后测试组成。
塑封之后,还要进行一系列操作,如后固化(Post Mold Cure)、切筋和成型(Trim&Form)、电镀(Plating)以及打印等工艺。
典型的封装工艺流程为:划片装片键合塑封去飞边电镀打印切筋和成型外观检查成品测试包装出货。
3、各种半导体封装形式的特点和优点:3.1、DIP双列直插式封装DIP(DualIn-line Package)是指采用双列直插形式封装的集成电路芯片,绝大多数中小规模集成电路(IC)均采用这种封装形式,其引脚数一般不超过100个。
采用DIP封装的CPU 芯片有两排引脚,需要插入到具有DIP结构的芯片插座上。
当然,也可以直接插在有相同焊孔数和几何排列的电路板上进行焊接。
DIP封装的芯片在从芯片插座上插拔时应特别小心,以免损坏引脚。
DIP封装具有以下特点:1.适合在PCB(印刷电路板)上穿孔焊接,操作方便。
2.芯片面积与封装面积之间的比值较大,故体积也较大。
Intel系列CPU中8088就采用这种封装形式,缓存(Cache)和早期的内存芯片也是这种封装形式。
3.2、QFP塑料方型扁平式封装和PFP塑料扁平组件式封装半导体封装QFP(Plastic Quad Flat Package)封装的芯片引脚之间距离很小,管脚很细,一般大规模或超大型集成电路都采用这种封装形式,其引脚数一般在100个以上。

术培训课程•封装技术概述•封装材料选择与性能要求•芯片与基板连接技术•封装工艺流程详解•先进封装技术探讨•封装设备选型及使用注意事项•封装质量管理与可靠性评估方法目录封装技术概述封装定义与作用封装定义封装作用保护芯片免受外部环境的影响,如温度、湿度、机械应力等;为芯片提供稳定的电气连接和信号传输;实现芯片与外部器件的连接和互操作。
封装技术发展历程中期封装技术早期封装技术逐渐出现塑料封装和陶瓷封装,体积减小、重量减轻、成本降低。
现代封装技术SOP 封装小外形封装,引脚从两侧引出,体积小、重量轻,适合表面贴装。
BGA 封装3D 封装将多个芯片在垂直方向上堆叠起来,通过穿硅通孔等技术实现芯片间的互连,可大幅提高集成度和性能。
DIP 封装双列直插式封装,引脚从两侧引出,插装方便,但封装密度较低。
QFP 封装CSP 封装芯片尺寸封装,引脚间距极小,可实现与裸片相近的尺寸和性能。
010203040506常见封装类型及其特点封装材料选择与性能要求铜铝金030201陶瓷塑料玻璃密封材料环氧树脂低成本、良好的密封性和绝缘性,广泛用于中低端封装。
硅橡胶高弹性、耐高低温、良好的密封性,用于高端封装和特殊环境。
聚酰亚胺高热稳定性、良好的绝缘性和机械强度,用于高端封装。
导电性能绝缘性能热稳定性能机械性能性能要求及测试方法芯片与基板连接技术超声键合利用超声波振动能量实现芯片与基板的连接,适用于对温度敏感的材料和微小间距的连接。
热压键合利用高温和压力将芯片与基板连接,适用于大规模生产,具有高效率和高可靠性的特点。
激光键合利用激光能量局部加热芯片和基板实现连接,具有高精度和高灵活性的特点。
1 2 3金丝球焊铜丝压焊铝丝压焊载带自动键合技术(TAB)内引线TAB01外引线TAB02多层TAB03对连接后的芯片进行拉力、剪切力等机械性能测试,以评估连接的牢固程度。
机械性能测试电性能测试环境适应性测试可靠性寿命测试对连接后的芯片进行电阻、电容等电性能测试,以评估连接的电气性能。



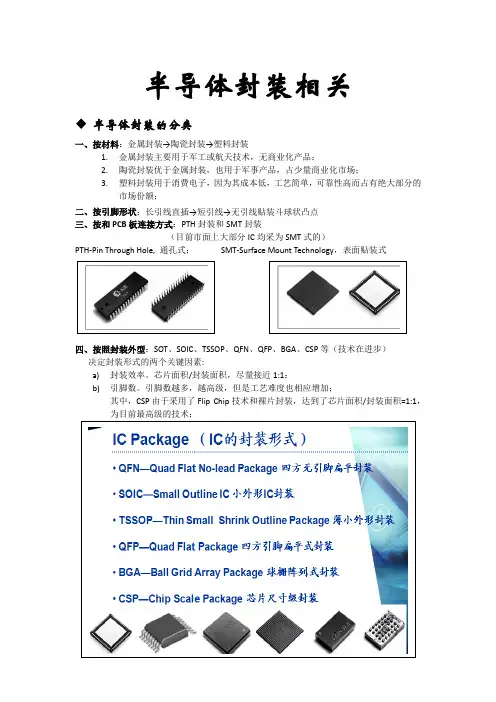
半导体封装相关 半导体封装的分类一、按材料:金属封装→陶瓷封装→塑料封装1. 金属封装主要用于军工或航天技术,无商业化产品;2. 陶瓷封装优于金属封装,也用于军事产品,占少量商业化市场;3. 塑料封装用于消费电子,因为其成本低,工艺简单,可靠性高而占有绝大部分的市场份额;二、按引脚形状:长引线直插→短引线→无引线贴装斗球状凸点三、按和PCB 板连接方式:PTH 封装和SMT 封装(目前市面上大部分IC 均采为SMT 式的)PTH-Pin Through Hole, 通孔式; SMT-Surface Mount Technology ,表面贴装式四、按照封装外型:SOT 、SOIC 、TSSOP 、QFN 、QFP 、BGA 、CSP 等(技术在进步) 决定封装形式的两个关键因素:a) 封装效率。
芯片面积/封装面积,尽量接近1:1; b) 引脚数。
引脚数越多,越高级,但是工艺难度也相应增加;其中,CSP 由于采用了Flip Chip 技术和裸片封装,达到了芯片面积/封装面积=1:1,为目前最高级的技术;◆半导体封装技术的发展历程50年代的TO型圆形金属封装70年代,芯片封装流行的是双列直插封装(DIP)、单列直插封装(SIP)、针栅阵列封装(PGA)等都属于通孔插装式安装器件80年代,表面贴装技术(SMT)的封装形式兴起,主要有小外型封装(SOP),引线间距为1.27mm、塑料片式载体(PLCC),引线间距为1.27mm、四边引线扁平封装(QFP)等。
最终四边引线扁平封装(QFP)成为主流的封装形式(0.3mm已是QFP引脚间距的极限)其后相继出现了各种改进型,如TQFP(薄型QFP)、VQFP(细引脚间距QFP)、SQFP(缩小型QFP)、PQFP(塑封QFP)、Tape QFP(载带QFP)和$OJ(J型引脚小外形封装)、TSOP(薄小外形封装)、VSOP(甚小外形封装)、SSOP(缩小形SOP)、TSSOP(薄的缩小型SOP)等90年代,以面阵排列、球形凸点为引脚、封装密度大为提高的BGA(焊球阵列封装)便应运而生。

