常用PCB封装图解
- 格式:doc
- 大小:600.50 KB
- 文档页数:14


常用集成电路芯片封装图三极管封装图LQFP BQFP PQFPSC-70SOJSSOPSOP TQFP常见集成电路(IC)芯片的封装SIP(Single In-line Package)单列直插式封装PGA(Pin Grid Array Package)插针网格阵列封装PLCC(Plastic leaded.CSP(Chip Scale Package)芯片缩放式封装DIP,SIP,SOP,TO,SOT元件封裝形式(图)各元器件封装形式图解,不知道有没有人发过.暂且放上!CDIP-----Ceramic Dual In-Line PackageCLCC-----Ceramic Leaded Chip CarrierCQFP-----Ceramic Quad Flat PackDIP-----Dual In-Line PackageLQFP-----Low-Profile Quad Flat PackMAPBGA------Mold Array Process Ball Grid ArrayPBGA-----Plastic Ball Grid ArrayPLCC-----Plastic Leaded Chip CarrierPQFP-----Plastic Quad Flat PackQFP-----Quad Flat PackSDIP-----Shrink Dual In-Line PackageSOIC-----Small Outline Integrated PackageSSOP-----Shrink Small Outline PackageDIP-----Dual In-Line Package-----双列直插式封装。
插装型封装之一,引脚从封装两侧引出,封装材料有塑料和陶瓷两种。
DIP是最普及的插装型封装,应用范围包括标准逻辑IC,存贮器LSI,微机电路等。
PLCC-----Plastic Leaded Chip Carrier-----PLCC封装方式,外形呈正方形,32脚封装,四周都有管脚,外形尺寸比DIP封装小得多。

目次前言目次11OTHER:P1.11.1 GND:P1.21.2HOLE:P1.31.3 星月孔:P1.41.4 NOTES:P1.51.5 BAR CODE:P1.61.6 ESD:P122SMD:P2.72.1 球形触点陈列 BGA P2.82.2贴装电容回流焊库命名 SC P5.92.3贴装电感回流焊库命名 SL P5.102.4贴装电阻回流焊库命名 SR P5.112.5贴装二极管回流焊库命名 SD P5.122.6贴装钽电容回流焊库命名 STC P5.132.7贴装功率电感回流焊库命名 SPL P5.142.8贴装保险管回流焊库命名 SF P5.152.9小外形晶体管回流焊库命名 SOT P5.162.10贴装滤波器回流焊库命名 SFLT P5.172.11贴装晶体回流焊库命名 SX P5.182.12贴装变压器回流焊库命名 STFM P6.192.13 J 引线小外形封装IC 回流焊库命名 SOJ P6P6 .202.14塑封有引线芯片载体及其插座回流焊库命名PLCC/JPLCC.212.15小外形封装IC 回流焊库命名 SOP P7.222.16贴装继电器回流焊库命名 SRLY P8.232.17四方扁平封装IC 回流焊库命名 QFP P933THD(插装器件)P11.243.1插装电池 BAT P11.253.2插装无极性电容器 CAP P11.263.3插装有极性圆柱状电容器 CAPC P11.273.4插装有极性方形电容器 CAPR P11.283.5插装电感器 IND P11.293.6插装保险管(含管座)FUSE P12.303.7插装LED显示器 LED P12.313.8插装电位器 POT P12.323.9 插装电阻器 RES P12.333.10插装压敏电阻 VSR P12.343.11插装继电器 RLY P12.353.12插装整流桥 RTF P12 .363.13插装传感器 SEN P12 .373.14插装散热器 HSK P13 .383.15插装滤波器 FLT P13 .393.16插装晶体 XTAL P13 .403.17插装振荡器 OSC P13 .413.18 插装变压器 TFM P14 .423.19双列直插封装(不含厚膜) DIP P14 .433.20屏蔽盒 SHIELD P15 .443.21风扇 FAN P15 .453.22插装光模块 LASER P16 .463.23插装电源模块 PW P20 .473.24单列直插封装(不含厚膜) SIP P29 44CONNECT P30 .484.1D型电缆连接器 DB P30 .494.2插针 HEAD P32 .504.3开关 DSW P32 .514.4扁平电缆连接器 IDC P33 .524.5数据通信口 MJ P34 .534.6压接型欧式连接器 PDIN P36 .544.7SIMM/DIMM插座 SIM/DIM P38 .554.8压接型 2mmFB连接器 PFB P39 .564.9压接型2mmHM连接器 PHM P40 .574.10压接型HS3连接器 PHS P42 .584.11压接型 HM-ZD连接器 PZD P42 .594.12电源连接器 PWC P42 .604.13贴装双边缘连接器 SED P43PCB封装库图例按插件(THD)/贴片(SMD)/连接器(CONNECT)及其它杂类(OTHER)来分类1OTHER:包括各种安装孔、接地孔、定位光标、条码,以及PCB设计时使用的各类图框、 NOTE表格、各种规范的PCB加工文字说明(如阻抗控制、BGA塞孔说明等)、生产工艺提示(如ESD标记,波峰焊过板方向)1.1GND:1.1HOLE:HOLE*为非金属化孔,用于安装孔、定位孔。
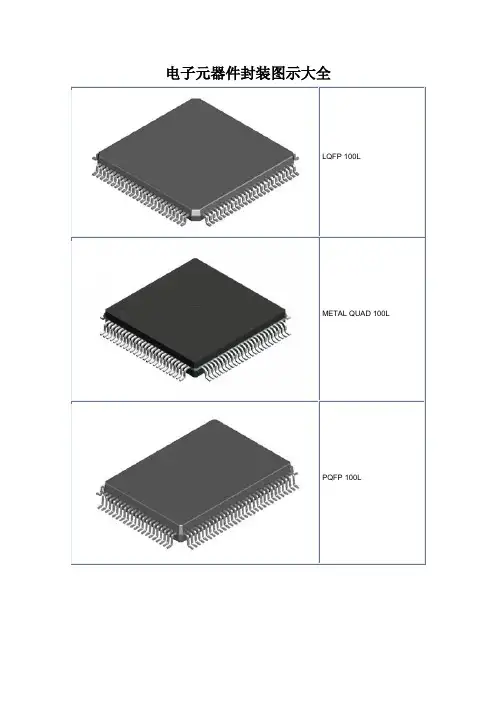
电子元器件封装图示大全LQFP 100LMETAL QUAD 100LPQFP 100LQFPQuad Flat PackageQFPQuad Flat Package TQFP 100LRIMMRIMMFor DirectRambus SBGASC-70 5LSDIPSIMM30SIMM30PinoutSIMM30Single In-line MemoryModuleSIMM72SIMM72PinoutSIMM72Single In-line MemoryModuleSIMM72Single In-line MemoryModuleSIPSingle Inline PackageSLOT 1For intel Pentium II Pentium III & Celeron CPUSLOT AFor AMD Athlon CPU SNAPTKSNAPTKSNAPZPSO DIMMSmall Outline Dual In-line Memory ModuleSOSmall Outline PackageSOCKET 370For intel 370 pin PGA Pentium III & Celeron CPUSOCKET 423For intel 423 pin PGA Pentium 4 CPUSOCKET 462/SOCKET A For PGA AMD Athlon & Duron CPUSOCKET 7For intel Pentium & MMX Pentium CPUSOHSOJ 32LSOJSOP EIAJ TYPE II 14L SOT143SOT220SOT220SOT223SOT223SOT23SOT23/SOT323 SOT25/SOT353 SOT26/SOT363 SOT343SOT523 SOT89 SOT89 SSOP 16L SSOPSocket 603FosterLAMINATE TCSP 20L Chip Scale PackageTO18TO220TO247TO252TO263/TO268 TO264TO3TO5TO52TO71TO72TO78TO8TO92TO93TO99TSOPThin Small Outline PackageTSSOP or TSOP IIThin Shrink Outline PackageLAMINATE UCSP 32L Chip Scale PackageuBGAMicro Ball Grid ArrayuBGAMicro Ball Grid ArrayVL BusVESA Local BusXT Bus8bitZIPZig-Zag Inline PackageGull Wing LeadsHSOP28ISAIndustry StandardArchitectureITO220ITO3pJ-STD J-STDJoint IPC / JEDEC StandardsJEPJEPJEDEC Publications JESD JESDJEDEC StandardsJLCCLCCLDCCLGALLP 8LaLQFPPCDIPPCI 32bit 5V Periphera l Compone nt Interconn ectPCI 64bit 3.3V Periphera l Compone nt Interconn ectPCMCIA PDIPPGA Plastic Pin Grid ArrayPLCC PQFPPS/2PS/2 mouse port pinoutPSDIP DIMM 168 DIMM DDRDIMM168Dual In-lineMemoryModule DIMM168DIMM168PinoutDIMM184For DDRSDRAMDual In-lineMemoryModuleDIPDual InlinePackageDIP-tabDual InlinePackagewith MetalHeatsinkEIA EIA JEDEC formulat ed EIA Standar dsEISAExtended ISA FBGAFDIPFTO220Flat PackAC'97AC'97v2.2 specification 全面规格AGP 3.3V Accelerated Graphics Port Specification 2.0 全面规格AGP PROAcceleratedGraphics PortPROSpecification1.01全面规格AGPAcceleratedGraphics PortSpecification 2.0全面规格AMRAudio/ModemRiserAX078AX14C-Bend LeadCERQUADCeramic Quad FlatPackCLCCCNR Communication and Networking Riser Specification Revision 1.2 CPGACeramic Pin Grid ArrayCeramic CaseLAMINATE CSP 112LChip Scale PackageBGABall Grid ArrayEBGA 680LLBGA 160L PBGA 217L Plastic Ball Grid ArraySBGA 192L TSBGA 680LCLCC CNR Communication and Networking RiserCPGA Ceramic Pin Grid Array DIP Dual Inline PackageDIP-tab Dual Inline Packagewith Metal HeatsinkFBGAFDIP FTO-220 Flat Pack HSOP-28 ITO-220 ITO-3P JLCC LCC LDCC LGA LQFP PCDIPPGA Plastic Pin Grid Array PLCC PQFP PSDIP LQFP 100L METAL QUAD 100L PQFP 100L QFP Quad Flat Package SOT143 SOT220SOT223 SOT223SOT23 SOT23/SOT323SOT25/SOT353 SOT26/SOT363 SOT343 SOT523 SOT89 SOT89Socket 603 Foster LAMINATE TCSP 20L Chip ScalePackageTO252 TO263/TO268 QFP Quad Flat Package TQFP 100LSBGA SC-70 5LSDIP SIP Single Inline Package SO Small Outline Package SOJ 32L SOJ SOP EIAJ TYPE II 14LSOT220 SSOP 16LTO247 SSOPTO18 TO220TO264 TO3TO5 TO52TO71 TO72TO78 TO8TO92 TO93TO99 TSOP Thin Small Outline PackageTSSOP or TSOP II Thin ShrinkuBGA Micro Ball Grid Array Outline PackageuBGA Micro Ball Grid Array ZIP Zig-Zag Inline Package BQFP132 C-Bend LeadCERQUAD Ceramic Quad FlatCeramic Case PackLAMINATE CSP 112L ChipGull Wing Leads Scale PackagePDIP PLCCSNAPTK SNAPTKSNAPZP SOHAMRAudio/Modem Riser AX078AX14BGABall Grid Array BQFP132TEPBGA 288LC-Bend LeadCERQUADCeramic Quad FlatPackCLCCCPGACeramic Pin GridArrayCeramic Case DIMM168DIP-tabDual Inline Package with Metal HeatsinkEIA EIA JEDEC formulated EIA StandardsFBGA FDIP FTO220 Flat PackGull Wing LeadsHSOP28ISAIndustry Standard ArchitectureITO220ITO3pJ-STD J-STDJoint IPC / JEDEC StandardsJEP JEP JEDEC PublicationsJESD JESD JEDEC StandardsJLCCPCDIPPCMCIA PDIPPQFPPS/2PS/2mouse portpinoutPSDIPQFPQuad FlatPackageQFPQuad FlatPackageSBGASDIPSIMM30SIMM30Single In-line Memory Module SIMM72SIMM72Single In-line Memory ModuleSIMM72Single In-line Memory ModuleSIPSingle Inline PackageSLOT 1For intel Pentium II Pentium III &Celeron CPUSLOT AFor AMD Athlon CPUSNAPTKSNAPTKSNAPZPSO DIMMSmall Outline Dual In-line Memory ModuleSOSmall Outline PackageSOCKET 370For intel 370 pin PGA Pentium III & Celeron CPUSOCKET 423For intel 423 pin PGA Pentium 4 CPUSOCKET 462/SOCKET AFor PGA AMD Athlon & Duron CPUSOCKET 7For intel Pentium & MMX Pentium CPUSOHSOJSOT143SOT220SOT220SOT223SOT223SOT23SOT23/SOT323 SOT25/SOT353 SOT26/SOT363 SOT343SOT523SOT89SOT89SSOPSocket 603FosterTO18TO220TO247TO252TO263/TO268 TO264TO3TO5TO52TO71TO72TO78TO8TO92TO93TO99TSOPThin Small Outline PackageTSSOP or TSOP IIThin Shrink Outline PackageuBGAMicro Ball Grid ArrayuBGAMicro Ball Grid ArrayVL BusVESA Local BusXT Bus8bitZIPZig-Zag Inline Package。

C-(cerami c)表示陶瓷封装的记号。
例如,CDIP 表示的是陶瓷DIP。
是在实际中经常使用的记号。
1、BGA(ball grid array)球形触点陈列,表面贴装型封装之一。
在印刷基板的背面按陈列方式制作出球形凸点用以代替引脚,在印刷基板的正面装配L SI 芯片,然后用模压树脂或灌封方法进行密封。
也称为凸点陈列载体(PAC)。
引脚可超过200,是多引脚LS I 用的一种封装。
封装本体也可做得比QF P(四侧引脚扁平封装)小。
例如,引脚中心距为1.5mm 的360 引脚BGA 仅为31mm见方;而引脚中心距为0.5mm 的304 引脚QFP为40mm见方。
而且BGA不用担心QFP那样的引脚变形问题。
该封装是美国Motor ola 公司开发的,首先在便携式电话等设备中被采用,今后在美国有可能在个人计算机中普及。
最初,BGA 的引脚(凸点)中心距为1.5mm,引脚数为225。
现在也有一些LSI厂家正在开发500 引脚的BGA。
BGA 的问题是回流焊后的外观检查。
现在尚不清楚是否有效的外观检查方法。
有的认为,由于焊接的中心距较大,连接可以看作是稳定的,只能通过功能检查来处理。
美国Moto rola公司把用模压树脂密封的封装称为O MPAC,而把灌封方法密封的封装称为GPA C(见OMPAC和GPAC)。
①CPAC(globetop pad arraycarrie r)美国Moto rola公司对BGA的别称(见BGA)。
②PAC(pad arraycarrie r)凸点陈列载体,BGA 的别称(见BGA)。
③OPMAC(over molded pad arraycarrie r)模压树脂密封凸点陈列载体。
美国Moto rola公司对模压树脂密封BG A 采用的名称(见BGA)。

C-(ceramic)表示陶瓷封装的记号。
例如,CDIP 表示的是陶瓷DIP。
是在实际中经常使用的记号。
1、BGA(ball grid array)球形触点陈列,表面贴装型封装之一。
在印刷基板的背面按陈列方式制作出球形凸点用以代替引脚,在印刷基板的正面装配LSI 芯片,然后用模压树脂或灌封方法进行密封。
也称为凸点陈列载体(PAC)。
引脚可超过200,是多引脚LSI 用的一种封装。
封装本体也可做得比QFP(四侧引脚扁平封装)小。
例如,引脚中心距为1.5mm 的360 引脚BGA 仅为31mm 见方;而引脚中心距为0.5mm 的304 引脚QFP 为40mm 见方。
而且BGA 不用担心QFP 那样的引脚变形问题。
该封装是美国Motorola 公司开发的,首先在便携式电话等设备中被采用,今后在美国有可能在个人计算机中普及。
最初,BGA 的引脚(凸点)中心距为1.5mm,引脚数为225。
现在也有一些LSI 厂家正在开发500 引脚的BGA。
BGA 的问题是回流焊后的外观检查。
现在尚不清楚是否有效的外观检查方法。
有的认为,由于焊接的中心距较大,连接可以看作是稳定的,只能通过功能检查来处理。
美国Motorola 公司把用模压树脂密封的封装称为OMPAC,而把灌封方法密封的封装称为GPAC(见OMPAC 和GPAC)。
①CPAC(globe top pad array carrier)美国Motorola 公司对BGA 的别称(见BGA)。
②PAC(pad array carrier)凸点陈列载体,BGA 的别称(见BGA)。
③OPMAC(over molded pad array carrier)模压树脂密封凸点陈列载体。
美国Motorola 公司对模压树脂密封BGA 采用的名称(见BGA)。
脚中心距有0.55mm 和0.4mm 两种规格。
目前正处于开发阶段。
2、QFP系列QFP(quad flat package)四侧引脚扁平封装。


C-(ceramic)表示陶瓷封装的记号。
例如,CDIP 表示的是陶瓷DIP。
是在实际中经常使用的记号。
1、BGA(ball grid array)球形触点陈列,表面贴装型封装之一。
在印刷基板的背面按陈列方式制作出球形凸点用以代替引脚,在印刷基板的正面装配LSI 芯片,然后用模压树脂或灌封方法进行密封。
也称为凸点陈列载体(PAC)。
引脚可超过200,是多引脚LSI 用的一种封装。
封装本体也可做得比QFP(四侧引脚扁平封装)小。
例如,引脚中心距为1.5mm 的360 引脚BGA 仅为31mm 见方;而引脚中心距为0.5mm 的304 引脚QFP 为40mm 见方。
而且BGA 不用担心QFP 那样的引脚变形问题。
该封装是美国Motorola 公司开发的,首先在便携式电话等设备中被采用,今后在美国有可能在个人计算机中普及。
最初,BGA 的引脚(凸点)中心距为1.5mm,引脚数为225。
现在也有一些LSI 厂家正在开发500 引脚的BGA。
BGA 的问题是回流焊后的外观检查。
现在尚不清楚是否有效的外观检查方法。
有的认为,由于焊接的中心距较大,连接可以看作是稳定的,只能通过功能检查来处理。
美国Motorola 公司把用模压树脂密封的封装称为OMPAC,而把灌封方法密封的封装称为GPAC(见OMPAC 和GPAC)。
①CPAC(globe top pad array carrier)美国Motorola 公司对BGA 的别称(见BGA)。
②PAC(pad array carrier)凸点陈列载体,BGA 的别称(见BGA)。
③OPMAC(over molded pad array carrier)模压树脂密封凸点陈列载体。
美国Motorola 公司对模压树脂密封BGA 采用的名称(见BGA)。
脚中心距有0.55mm 和0.4mm 两种规格。
目前正处于开发阶段。
2、QFP系列QFP(quad flat package)四侧引脚扁平封装。
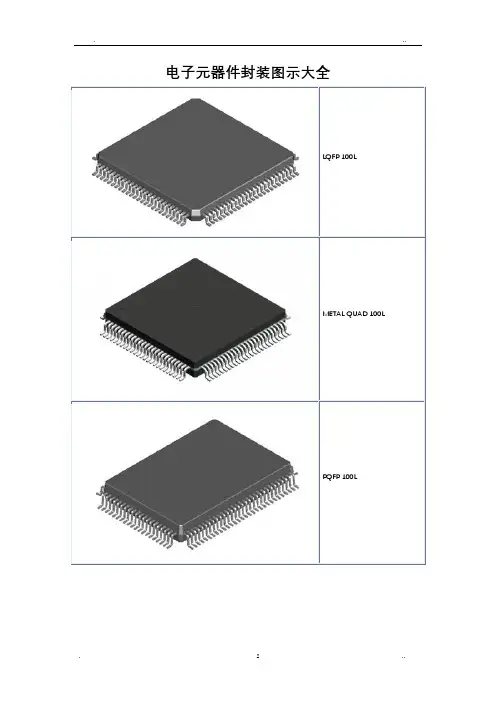
电子元器件封装图示大全LQFP 100LMETAL QUAD 100LPQFP 100LQFPQuad Flat PackageQFPQuad Flat PackageTQFP 100LRIMMRIMMFor DirectRambus SBGASC-70 5LSDIPSIMM30SIMM30PinoutSIMM30Single In-line MemoryModuleSIMM72SIMM72PinoutSIMM72Single In-line MemoryModuleSIMM72Single In-line MemoryModuleSIPSingle Inline PackageSLOT 1For intel Pentium II Pentium III & Celeron CPUSLOT AFor AMD Athlon CPU SNAPTKSNAPTKSNAPZPSO DIMMSmall Outline Dual In-line Memory ModuleSOSmall Outline PackageSOCKET 370For intel 370 pin PGA Pentium III & Celeron CPUSOCKET 423For intel 423 pin PGA Pentium 4 CPUSOCKET 462/SOCKET A For PGA AMD Athlon & Duron CPUSOCKET 7For intel Pentium & MMX Pentium CPUSOHSOJ 32LSOJSOP EIAJ TYPE II 14L SOT143SOT220SOT220SOT223SOT223SOT23SOT23/SOT323 SOT25/SOT353 SOT26/SOT363 SOT343SOT523 SOT89 SOT89 SSOP 16L SSOPSocket 603FosterLAMINATE TCSP 20L Chip Scale PackageTO18TO220TO247TO252TO263/TO268 TO264TO3TO5TO52TO71TO72TO78TO8TO92TO93TO99TSOPThin Small Outline PackageTSSOP or TSOP IIThin Shrink Outline PackageLAMINATE UCSP 32L Chip Scale PackageuBGAMicro Ball Grid ArrayuBGAMicro Ball Grid ArrayVL BusVESA Local BusXT Bus8bitZIPZig-Zag Inline PackageGull Wing LeadsHSOP28ISAIndustry StandardArchitectureITO220ITO3pJ-STDJ-STDJoint IPC / JEDEC StandardsJEPJEPJEDEC PublicationsJESDJESDJEDEC StandardsJLCCLCCLDCCLGALLP 8LaLQFPPCDIPPCI 32bit 5V Periphera l Compone nt Interconn ectPCI 64bit 3.3V Periphera l Compone nt Interconn ectPCMCIA PDIPPGA Plastic Pin Grid ArrayPLCC PQFPPS/2PS/2mouseportpinoutPSDIP DIMM 168 DIMM DDRDIMM168Dual In-lineMemoryModule DIMM168DIMM168PinoutDIMM184For DDRSDRAMDual In-lineMemoryModuleDIPDual InlinePackageDIP-tabDual InlinePackagewith MetalHeatsinkEIA EIA JEDEC formulat ed EIA Standard sEISAExtended ISA FBGAFDIPFTO220Flat PackAC'97AC'97v2.2 specification 详细规格AGP 3.3V Accelerated Graphics Port Specification 2.0 详细规格AGP PROAcceleratedGraphics PortPROSpecification 1.01详细规格AGPAcceleratedGraphics PortSpecification 2.0详细规格AMRAudio/ModemRiserAX078AX14C-Bend LeadCERQUADCeramic Quad FlatPackCLCCCNR Communication and Networking Riser Specification Revision 1.2CPGACeramic Pin Grid ArrayCeramic CaseLAMINATE CSP 112L Chip Scale PackageBGABall Grid ArrayEBGA 680LLBGA 160L PBGA 217L Plastic Ball Grid ArraySBGA 192L TSBGA 680LCLCC CNR Communication and Networking RiserCPGA Ceramic Pin Grid Array DIP Dual Inline PackageDIP-tab Dual Inline Packagewith Metal HeatsinkFBGAFDIP FTO-220 Flat Pack HSOP-28 ITO-220 ITO-3P JLCC LCC LDCC LGA LQFP PCDIPPGA Plastic Pin Grid Array PLCC PQFP PSDIP LQFP 100L METAL QUAD 100L PQFP 100L QFP Quad Flat Package SOT143 SOT220SOT223 SOT223SOT23 SOT23/SOT323SOT25/SOT353 SOT26/SOT363 SOT343 SOT523 SOT89 SOT89Socket 603 Foster LAMINATE TCSP 20L Chip ScalePackageTO252 TO263/TO268 QFP Quad Flat Package TQFP 100LSBGA SC-70 5LSDIP SIP Single Inline Package SO Small Outline Package SOJ 32L SOJ SOP EIAJ TYPE II 14LSOT220 SSOP 16LTO247 SSOPTO18 TO220TO264 TO3TO5 TO52TO71 TO72TO78 TO8TO92 TO93TO99 TSOP Thin Small Outline PackageTSSOP or TSOP II Thin ShrinkuBGA Micro Ball Grid Array Outline PackageuBGA Micro Ball Grid Array ZIP Zig-Zag Inline Package BQFP132 C-Bend LeadCERQUAD Ceramic Quad FlatCeramic Case PackLAMINATE CSP 112L Chip ScaleGull Wing Leads PackagePDIP PLCCSNAPTK SNAPTKSNAPZP SOHAGP 3.3V Accelerated Graphics PortSpecification 2.0详细规格AGP PRO Accelerated Graphics Port PRO Specification 1.01详细规格AGPAccelerated Graphics PortSpecification 2.0详细规格AMRAudio/Modem Riser AX078AX14BGABall Grid ArrayBQFP132EBGA 680L详细规格LBGA 160L详细规格PBGA 217LPlastic Ball Grid Array 详细规格SBGA 192L详细规格TEPBGA 288L TEPBGA 288L详细规格TSBGA 680L详细规格C-Bend LeadCERQUADCeramic Quad FlatPackCLCCCNR Communication and Networking Riser Specification Revision 1.2详细规格CPGACeramic Pin Grid ArrayCeramic CaseLAMINATE CSP 112L Chip Scale Package 详细规格DIMM 168详细规格DIMM DDR详细规格DIMM168 Dual In-line Memory Module详细规格DIMM168DIMM168 Pinout详细规格DIMM184For DDR SDRAM Dual In-line Memory Module详细规格DIPDual Inline Package详细规格DIP-tabDual Inline Package with Metal HeatsinkEIA EIAJEDEC formulated EIA StandardsEISA Extended ISA 详细规格FBGAFDIPFTO220Flat PackGull Wing LeadsHSOP28ISAIndustry Standard ArchitectureITO220ITO3pJ-STD J-STDJoint IPC / JEDECStandardsJEP JEP JEDEC PublicationsJESDJESDJEDECStandardsJLCC PCDIPPCI 32bit 5V Peripheral Component Interconnect 详细规格PCI 64bit 3.3V Peripheral Component Interconnect 详细规格PCMCIA PDIPPGAPlastic Pin GridArray详细规格PLCC详细规格PQFPPS/2PS/2mouse portpinoutPSDIPLQFP 100L详细规格METAL QUAD100L详细规格PQFP 100L详细规格QFPQuad FlatPackageQFPQuad FlatPackageTQFP 100L详细规格SBGASC-70 5L详细规格SDIPSIMM30SIMM30Pinout详细规格SIMM30Single In-line Memory Module SIMM72SIMM72Pinout详细规格SIMM72Single In-line Memory ModuleSIMM72Single In-line Memory ModuleSIPSingle Inline PackageSLOT 1For intel Pentium II Pentium III & Celeron CPUSLOT AFor AMD Athlon CPUSNAPTKSNAPTKSNAPZPSO DIMMSmall Outline Dual In-line Memory ModuleSOSmall Outline PackageSOCKET 370For intel 370 pin PGA Pentium III & Celeron CPUSOCKET 423For intel 423 pin PGA Pentium 4 CPUSOCKET 462/SOCKET AFor PGA AMD Athlon & Duron CPUSOCKET 7For intel Pentium & MMX Pentium CPUSOHSOJ 32L详细规格SOJSOP EIAJ TYPE II 14L 详细规格SOT143SOT220SOT220SOT223SOT223SOT23SOT23/SOT323SOT25/SOT353 SOT26/SOT363 SOT343SOT523SOT89SOT89SSOP 16L详细规格SSOPSocket 603FosterLAMINATE TCSP 20L Chip Scale Package 详细规格TO18TO220TO247TO252TO263/TO268 TO264TO3TO5TO52TO71TO72TO78TO8TO92TO93TO99TSOPThin Small Outline PackageTSSOP or TSOP IIThin Shrink Outline PackageLAMINATE UCSP 32LChip Scale Package详细规格uBGAMicro Ball Grid ArrayuBGAMicro Ball Grid ArrayVL BusVESA Local BusXT Bus8bitZIPZig-Zag Inline Package。

印制电路板(PCB)的常见结构印制电路板(PCB)的常见结构可以分为单层板(single Layer PCB)、双层板(Double Layer PCB)和多层板(Multi Layer PCB)三种.一、单层板single Layer PCB单层板(single Layer PCB)是只有一个面敷铜,另一面没有敷铜的电路板。
元器件一般情况是放置在没有敷铜的一面,敷铜的一面用于布线和元件焊接,如图所示。
单层板single Layer PCB结构示意图二、双层板Double Layer PCB双层板(Double Layer PCB)是一种双面敷铜的电路板,两个敷铜层通常被称为顶层(Top Layer)和底层(Bottom Layer),两个敷铜面都可以布线,顶层一般为放置元件面,底层一般为元件焊接面,如图所示。
双层板Double Layer PCB结构示意图三、多层板Multi Layer PCB多层板(Multi Layer PCB)就是包括多个工作层面的电路板,除了有顶层(Top Layer)和底层(Bottom Layer)之外还有中间层,顶层和底层与双层面板一样,中间层可以是导线层、信号层、电源层或接地层,层与层之间是相互绝缘的,层与层之间的连接往往是通过孔来实现的。
以四层板为例,如图2 3 4 所示。
这个四层板除了具有顶层和底层之外,内部还具有一个地层和一个图2 3 4 四层板结构四层板PCB结构示示意图而六层板的结构还要比四层板多出两个内层,其结构如图2 3 6 所示。
六层板PCB结构示意图尽管Protel DXP支持72层板的设计,但在实际的应用中,一般六层板已经能够满足电路设计的要求,不必将电路板设计成更多层结构。
PCB布线完成后应该检查的项目当设计完成一个PCB的时候,就需要检查这块PCB的一些相关的地方,因为,一块PCB,除了电气性能没有问题外,还有其他的一些相关的影响因素,本文介绍一些在设计完PCB后,应该检查的项目,希望给PCB设计人员参考。

BA-BR1225-SMD(1 : 1)BA-BR3032-SMD(1 : 3)BA-CR1616-SMD(1 : 2)BA-CR2032-SMD(1 : 2)BGA-160-1.00(1 : 2)BGA-196-1.00(1 : 2)BGA-255-1.00(1 : 2)BGA-256+16-1.27(1 : 3)BGA-256-1.00(1 : 2)BGA-312+16-1.27(1 : 3)BGA-388-1.27(1 : 3)BGA-456-1.00(1 : 2)BGA-48-0.80(1 : 1)BGA-64-1.00(1 : 2)BGA352-1.27(1 : 3)BPA09C0402(4 : 1)C0603(4 : 1)C0805(4 : 1)C0805-W(4 : 1)C1206(4 : 1)C1206-W(4 : 1)C1210(3 : 1)C1210-W(3 : 1)C1812(3 : 1)C1812-W(2 : 1)C2220(2 : 1)CA-RIFA-SPC(1 : 1)CA-SI-MKT-A(2 : 1)CA-SI-MKT-B(2 : 1)CA-SI-MKT-C(2 : 1)CA-SI-MKT-DCA-SI-MKT-E(1 : 1)CA-SI-MKT-F(1 : 1)CA-WIMA-SMD-2824(1 : 1)CE-PHIL-131(1 : 1)CE-PHIL-CS085-A(3 : 1)CER-NCC-J80(1 : 1)CER-NIC-UD-10X10(1 : 1)CER-NIC-UD-8X10(1 : 1)CER-NIC-UG-12.5(1 : 2)CER-PANA-A(2 : 1)CER-PANA-B(2 : 1)CER-PANA-C(1 : 1)CER-PANA-D(1 : 1)CER-PANA-E(1 : 1)CER-PANA-F(1 : 1)CER-PANA-GCER-PANA-H16(1 : 2)CER-PANA-J16(1 : 2)CER-PANA-K16(1 : 2)CER-PHIL-1012(1 : 1)CER-PHIL-1014(1 : 1)CER-PHIL-153CLV-0405(2 : 1)CER-PHIL-153CLV-0605(1 : 1)CER-SANYO-B6(1 : 1)CER-SANYO-E7(1 : 1)CER-SANYO-F8(1 : 2)CL-BOUR-CM20(4 : 1)CL-BOUR-CM32(4 : 1)CL-BOUR-CM45(3 : 1)CL-BOUR-SDR0603(1 : 1)CL-BOUR-SDR0805(1 : 1)CL-BOUR-SDR1006CL-BOUR-SSR1205(1 : 2)CL-COILC-1008LS(4 : 1)CL-COILC-1812CS(3 : 1)CL-CTR-CTX110602(1 : 3)CL-CTR-CTX210602(1 : 3)CL-CTR-CTXNNN-4(1 : 2)CL-CTR-DO3316(1 : 1)CL-CTR-DO5022(1 : 2)CL-MEGG-3631(1 : 2)CL-MOTOC-MAB1311(1 : 1)CL-MOTOC-MND0403(1 : 1)CL-MOTOC-MND0504(1 : 1)CL-MURA-BLM41(4 : 1)CL-MURA-LQG21C(4 : 1)CL-MURA-LQH1N(4 : 1)CL-MURA-LQH3CCL-MURA-LQH4N(4 : 1)CL-PANA-ELJ-PA(4 : 1)CL-PANA-PCC-N6(1 : 2)CL-PD75(1 : 1)CL-PULSE-P043X(2 : 1)CL-SCHO-LM259X(1 : 2)CL-SI-B82790-N2(2 : 1)CL-SIMID-2220-A(2 : 1)CL-SIMID01(4 : 1)CL-SIMID02(4 : 1)CL-SIMID03(3 : 1)CL-SUMI-CD54(1 : 1)CL-SUMI-CDRH125(1 : 1)CL-SUMI-CDRH4D18(2 : 1)CL-SUMI-CMD-8N(1 : 1)CL-TDK-NLC565050CL-TDK-SLF7032(1 : 1)CL-TOKO-5CA(1 : 1)CL-TOKO-D52FU(2 : 1)CT-0402(4 : 1)CT-0603(4 : 1)CT-0805(4 : 1)CT-1206(4 : 1)CT-1210(3 : 1)CT-EIA-3216(4 : 1)CT-EIA-3528(3 : 1)CT-EIA-6032(3 : 1)CT-EIA-7343(2 : 1)CT-IEC-A(4 : 1)CT-IEC-B(3 : 1)CT-IEC-C(3 : 1)CT-IEC-DCT-PHIL-099-A(4 : 1)CT-PHIL-099-B(4 : 1)CT-PHIL-099-C(3 : 1)CT-PHIL-099-D(2 : 1)CT-PHIL-D-W(1 : 1)CT-VISHAY-594-C(1 : 2)CT-VISHAY-594-D(1 : 2)CT-VISHAY-594-R(1 : 3)CT-VISHAY-595-T(2 : 1)D2PAK(1 : 1)DI-IR-D71(1 : 1)DIP16-SMD(1 : 2)DIP20-SMD(1 : 2)DIP4-SMD(1 : 2)DIP4-SMD-OPTO(1 : 1)DIP6-SMD-OPTODIP8-SMD-OPTO(1 : 1)DMP8(1 : 1)DO-213AA(4 : 1)DO-213AB(4 : 1)DO-214AA(3 : 1)DO-214AA-W(2 : 1)DO-214AB(1 : 1)DO-214AB-BIDIR(1 : 1)DO-214AC(4 : 1)DO-214AC-BIDIR(4 : 1)DO-214BA(4 : 1)FI-MURA-NFM39R(2 : 1)FI-MURA-NFM40R(2 : 1)FI-MURA-NFM41R(2 : 1)FI-MURA-NFM60R(4 : 1)FI-MURA-NFM61RFI-SYFER-E01-1806(4 : 1)FI-TDK-ACF(4 : 1)FI-TDK-ACF321825(4 : 1)FI-TDK-ACT4532(2 : 1)FI-TUSO-4701(3 : 1)FP-128-HIT(1 : 2)FP-32D(1 : 2)FP24(1 : 2)FP28(1 : 2)FP6/4(1 : 1)FPT-8P-FUJIT(1 : 1)FU-BOUR-MF-MSM020(3 : 1)FU-BOUR-MF-SM075(2 : 1)FU-BOUR-MF-SM150(1 : 1)FU-BOUR-MF-USMD035(3 : 1)FU-NANOFUSEFU-RAYC-MSMDC020(3 : 1)FU-RAYC-MSMDC050(3 : 1)FU-RAYC-MSMDM200(3 : 1)FU-RAYC-SMD100(2 : 1)FU-RAYC-SMD150(1 : 1)FU-RAYC-SMD200(1 : 1)FU-RAYC-USMD005(3 : 1)JUMPER-0805(4 : 1)L0603(4 : 1)L0805(4 : 1)L1206(4 : 1)L1210(3 : 1)L1806(4 : 1)L1810(3 : 1)L1812(3 : 1)LD-0805LD-1206(4 : 1)LD-CERLED-CR10SR(4 : 1)LD-CITI-CL-150(4 : 1)LD-CITI-CL-170(4 : 1)LD-CITI-CL-220(4 : 1)LD-CITI-CL-260(4 : 1)LD-FAIRC-QTLP630C(4 : 1)LD-FAIRC-QTLP650C(4 : 1)LD-HSDL-1000(1 : 1)LD-HSMX-C670(4 : 1)LD-KING-KM2520(4 : 1)LD-KING-KM2520-9(4 : 1)LD-KING-KPT-1608(4 : 1)LD-LIGI-LG-190(4 : 1)LD-LUXEON-LXHL-BW01(1 : 1)LD-NICHIA-NSCW100LD-ROHM-SML-210(4 : 1)LD-SI-LSG-T770(2 : 1)LD-SI-L_A670(2 : 1)LD-SI-T670(3 : 1)LD-SI-T770(3 : 1)LD-STAN-1105W-REV(4 : 1)LD-STAN-1111C(4 : 1)LD-STAN-1111R(4 : 1)LD-STAN-PY1101(3 : 1)LD-TEMI-TLM_310(3 : 1)LD-VISH-TFDU4100(2 : 1)LQFP-100-OPTI(1 : 2)LQFP-128(1 : 2)LQFP-48-FAIRC(1 : 1)MELF-D(4 : 1)MICRO6MICROMELF-D(4 : 1)MINIMELF-D(4 : 1)MLF-32-0.5(1 : 1)MO-C&D-NTE(1 : 1)MO-MELC-IMX7-M(1 : 2)MQFP-144-1-SI(1 : 3)MQFP-44-2-SI(1 : 2)MQFP-80-1-SI(1 : 2)MSO8(1 : 1)MSOP10(1 : 1)MSOP8(1 : 1)OP-FAIRC-H11A(1 : 1)OP-HCPL-0201(1 : 1)OP-SI-ILD207(1 : 1)OP-TOSH-TLP181(1 : 1)OP-TOSH-TLP281-4OP-VISH-TCMT11(1 : 1)OP-VISH-TCUT1200(2 : 1)P-DSO-20-10(1 : 2)PAD100-SMD(4 : 1)PAD100X150-SMD(4 : 1)PLCC-20(1 : 1)PLCC-28(1 : 2)PLCC-32(1 : 2)PLCC-44(1 : 2)PLCC-52(1 : 2)PLCC-68(1 : 2)PLCC-84(1 : 3)PO-BOUR-3224J(2 : 1)PO-BOUR-3224W(2 : 1)PO-BOUR-3314G(1 : 1)PO-BOUR-3314JPO-BOUR-3314S(1 : 1)PO-BOUR-3374(2 : 1)PO-PANA-EVM1F(1 : 1)POWERSO-10(1 : 2)PQFP-100(1 : 2)PQFP-128-ANALOG(1 : 4)PQFP-132-INTEL(1 : 3)PQFP-160-PLX(1 : 4)PQFP-176-PLX(1 : 3)PQFP-208-PLX(1 : 4)PQFP-208-TI(1 : 3)PQFP-44-ALTERA(1 : 2)PQFP-44-SI(1 : 2)PQFP-48-TI(1 : 1)PQFP-64(1 : 2)PQFP-80-CONEXANTPQFP-80-EZ(1 : 2)PQT-80(1 : 2)PSOP3-20(1 : 2)QFP-100-NAT(1 : 2)QFP-100B-HIT(1 : 2)QFP-132-MOTO(1 : 3)QFP-144A-ATMEL(1 : 3)QFP-160-PHIL(1 : 4)QFP-160-XILINX(1 : 4)QFP-208-XILINX(1 : 3)QFP-240-XILINX(1 : 4)QFP-32-SONY(1 : 1)QFP-44-P910-OKI(1 : 2)QFP-44-PHIL(1 : 2)QFP-44A-ATMEL(1 : 2)QFP-48QFP-80A-HIT(1 : 2)QSOP16(1 : 1)QT100-XILINX(1 : 2)R-PDSO-G20(1 : 1)R0402(4 : 1)R0603(4 : 1)R0805(4 : 1)R0805-W(4 : 1)R1206(4 : 1)R1206-W(4 : 1)R1218(2 : 1)R2010(4 : 1)R2512(2 : 1)R2512-W(2 : 1)RE-ARC241(2 : 1)RE-ARC241-CIRRE-ARV342(3 : 1)RE-ARV342-CIR(3 : 1)RE-BOUR-2QSP16(1 : 1)RE-BOUR-4816(1 : 1)RE-MEGG-SL1(3 : 1)RE-MELF(4 : 1)RE-MICROMELF(4 : 1)RE-MINIMELF(4 : 1)RE-MNR14(2 : 1)RE-MNR14-CIR(2 : 1)RE-PANA-ERD25TL(2 : 1)RE-PANA-EXBA(2 : 1)RE-RNA310(3 : 1)RL-CLARE-MRF4-02(1 : 1)RL-NEC-EE2-NU(1 : 1)RM8S-PDSO-G8(1 : 1)S-PQFP-48-TI(1 : 1)SC-59(2 : 1)SC-CC20-SMD(1 : 2)SC-CC28-SMD(1 : 2)SC-CC32-SMD(1 : 2)SC-CC44-SMD(1 : 3)SC-CC52-SMD(1 : 2)SC-CC68-SMD(1 : 3)SC70-5(3 : 1)SC70-6(3 : 1)SC82AB(2 : 1)SI-P-DSO-20-10(1 : 2)SI-P-DSO-20-9(1 : 2)SI-P-DSO-28-9(1 : 2)SI-P-TO263-15-1SMA(4 : 1)SMA-BIDIR(4 : 1)SMB(3 : 1)SMB-BIDIR(3 : 1)SMC(1 : 1)SMC-BIDIR(1 : 1)SO14(1 : 1)SO14-W(1 : 1)SO14-WM(1 : 1)SO14L(1 : 1)SO14L-CERPAK(1 : 1)SO16(1 : 1)SO16-OPTO(1 : 1)SO16-W(1 : 1)SO16-WM(1 : 1)SO16LSO16L-W(1 : 1)SO18L(1 : 1)SO20L(1 : 1)SO20M(1 : 1)SO24L(1 : 1)SO28L(1 : 1)SO28XL(1 : 2)SO32L(1 : 1)SO32XL(1 : 2)SO32XXL(1 : 2)SO4(1 : 1)SO4-OPTO(1 : 1)SO4-OPTO-W(1 : 1)SO4N-CLARE(1 : 1)SO8(1 : 1)SO8-OPTOSO8-POWERPAK-1(1 : 1)SO8-POWERPAK-2(1 : 1)SO8-W(1 : 1)SO8-WM(1 : 1)SO8L(1 : 1)SOD106A(4 : 1)SOD106A-W(2 : 1)SOD110(4 : 1)SOD123(4 : 1)SOD15(1 : 1)SOD323(4 : 1)SOD6(3 : 1)SOD6-BIDIR(3 : 1)SOD80(4 : 1)SOD80-W(4 : 1)SOD87SOD87S(4 : 1)SOJ24(1 : 1)SOJ28(1 : 2)SOJ32(1 : 2) SOJ36-400(1 : 2) SOJ44-400(1 : 2) SOP-44(1 : 3) SOP24-OKI(1 : 2) SOT143(2 : 1) SOT143R(2 : 1) SOT223(1 : 1) SOT223-5(1 : 1)SOT23(2 : 1) SOT23-5(2 : 1) SOT23-6(2 : 1) SOT23-WSOT23A(2 : 1) SOT23A-W(2 : 1) SOT23B(2 : 1) SOT23B-W(2 : 1) SOT23C(2 : 1) SOT23C-W(2 : 1) SOT23D(2 : 1) SOT23D-W(2 : 1) SOT23E(2 : 1) SOT23E-W(2 : 1) SOT23L-6(2 : 1)SOT26(2 : 1) SOT26-MINI(3 : 1) SOT26L(2 : 1) SOT323(3 : 1) SOT323ASOT323B(3 : 1)SOT323C(3 : 1)SOT323D(3 : 1)SOT323E(3 : 1)SOT353(3 : 1)SOT363(3 : 1)SOT428(1 : 1)SOT89(1 : 1)SOT89-5(1 : 1)SOT89A(1 : 1)SOT89A-W(2 : 1)SP-OWE-SMUS-8027(1 : 1)SP-SMI(1 : 1)SP-STAR-MNT-03A(1 : 1)SSOP14(1 : 1)SSOP16SSOP16-S(1 : 1)SSOP20(1 : 1)SSOP20M(1 : 1)SSOP24(1 : 1)SSOP24M(1 : 1)SSOP28(1 : 1)SSOP28M(1 : 1)SSOP48(1 : 1)SW-ALCO-GDH06S(1 : 1)SW-ALCO-GDH08S(1 : 1)SW-ALPS-SKRK(3 : 1)SW-AUGAT-ADF08S(1 : 2)SW-AUGAT-FSMSM(3 : 1)SW-BOUR-7914J(2 : 1)SW-BOUR-STMW-6(1 : 1)SW-C&K-KT11-SMSW-DIPT-DM-8(1 : 2)SW-DIPT-DTSM-6(1 : 1)SW-DIPT-DTSMW(1 : 1)SW-DOME-12MM(1 : 1)SW-DOME-8MM(1 : 1)SW-FOLIE-7MM(1 : 1)SW-FOLIE-7MM-M(1 : 1)SW-FOLIE-A(1 : 1)SW-FOLIE-A-OPEN(1 : 1)SW-FOLIE-AM(1 : 1)SW-FOLIE-B(1 : 1)SW-FOLIE-B2(1 : 1)SW-FOLIE-MELSEN(1 : 1)SW-FOLIE-R8(1 : 1)SW-ITT-KSC-J(1 : 1)SW-ITT-KSMSW-JDF-219-4(1 : 2)SW-JDF-219-6(1 : 2)SW-JDF-219-8(1 : 2)SW-MEC-3FS(1 : 1)SW-OMRON-B3S-10(1 : 1)SW-PANA-EVQPUJ(2 : 1)SW-PANA-EVQPUJ-M(2 : 1)SW-SHIN-SW1AB-260(2 : 1)SW-TMEC-DT010-P11AB(1 : 1)TESTPOINT-0.8(4 : 1)TESTPOINT-1.1(4 : 1)TESTPOINT-1.5(4 : 1)TO-252AA(1 : 1)TO-263(1 : 1)TO-263-15(1 : 2)TO-263-5TO-263-5/4(1 : 1)TO-263-7(1 : 1)TO-263AB(1 : 1)TQ-100-XILINX(1 : 2)TQFP-100-ALTERA(1 : 2)TQFP-100-ISSI(1 : 2)TQFP-100-MOTO(1 : 2)TQFP-128(1 : 3)TQFP-144-ALTERA(1 : 3)TQFP-144-EXAR(1 : 3)TQFP-176-ATMEL(1 : 3)TQFP-32A-ATMEL(1 : 1)TQFP-44-ANALOG(1 : 2)TQFP-44-LATTICE(1 : 2)TQFP-48-SMSC(1 : 1)TQFP-64-ATMELTQFP-64-CYGNAL(1 : 2)TQFP-64-SIL-IMAGE(1 : 2)TQFP-64-TI(1 : 2)TR-MACOM-ETC1(1 : 1)TR-PULSE-PE68624(1 : 1)TR-PULSE-SMT4(1 : 2)TR-VALOR-ST5085(1 : 2)TSOC6(1 : 1)TSOP-32(1 : 2)TSOP-32-BA(1 : 2)TSOP-40(1 : 2)TSOP-48(1 : 2)TSOP-86(1 : 2)TSOP-II-32(1 : 2)TSOP-II-44(1 : 2)TSOP-II-48TSOP-II-50(1 : 2)TSOP-II-54(1 : 2)TSSOP14(1 : 1)TSSOP16(1 : 1)TSSOP20(1 : 1)TSSOP24(1 : 1)TSSOP28(1 : 1)TSSOP38(1 : 1)TSSOP48(1 : 1)TSSOP56(1 : 2)TZ-AVX-MG064(2 : 1)UTP-5(1 : 1)VA-SIOV-CU3225(1 : 1)VA-SIOV-CU4032(1 : 1)VQFP-144-CIRRUS(1 : 3)VQFP-44-XILINXVSO-40(1 : 2)VSO-56(1 : 2)XT-86SMX(1 : 1)XT-91SMX(2 : 1)XT-ABRA-ABMM(1 : 1)XT-ABRACON-ASV(1 : 1)XT-ADVA-ACT9200(1 : 1)XT-AVX-PBRC-A(3 : 1)XT-CP12A(1 : 1)XT-EPSON-SG8002(1 : 1)XT-GEYER-KX327(1 : 1)XT-HC49-SMD(2 : 1)XT-HOSO-HCX-6SB(1 : 1)XT-HYQ-MIN(1 : 1)XT-IQXO-71(1 : 1)XT-MA-506XT-MCM-250(1 : 1)XT-MS1(2 : 1)XT-MURA-CSBFB_J-1(1 : 1)XT-MURA-CSTCC(2 : 1)XT-PANA-EFOP-W(1 : 1)XT-PANA-EFOS(2 : 1)XT-PANA-EFOS-W(2 : 1)XT-RALT-RSM200S(1 : 1)XT-SARONIX-CFPP-72(1 : 1)XT-SARONIX-S1700(1 : 1)XT-SMQ(1 : 1)XT-WATCH-B-SMD(3 : 1)AG(1 : 1)BA-1(2 : 1)BA-2(1 : 2)BA-BR1225-1HD(1 : 2)BA-CR2/3AA(1 : 2)BA-CR2032(1 : 2)BA-CR2032-V(1 : 1)BA-CR2430(1 : 2)BA-KEYS-103(1 : 2)BA-KEYS-105(1 : 3)BA-KEYS-500(1 : 2)BZW04(3 : 1)BZW04-BI(3 : 1)BZW06(2 : 1)BZW06-BI(2 : 1)CA-15-5CA-17.5-5(2 : 1)CA-32.5-8(1 : 1)CA-50-105-40(3 : 1)CA-AVX-SR15(4 : 1)CA-AVX-SR17(4 : 1)CA-AVX-SR20(4 : 1)CA-AVX-SR21(4 : 1)CA-AVX-SR27(3 : 1)CA-AVX-SR30(4 : 1)CA-AVX-SR40(4 : 1)CA-AVX-SR50(2 : 1)CA-PHIL-808-10(1 : 1)CA-PHIL-808-7.5(1 : 1)CA-PHIL-KP462-1(2 : 1)CA-PME271-10.2(3 : 1)CA-PMR205CB-210(2 : 1)CB-417(2 : 1)CB-417-BI(2 : 1)CE-PHIL-11-50(2 : 1)CE-PHIL-11-H-50(1 : 2)CE-PHIL-11-H2-50(1 : 2)CE-PHIL037-11(2 : 1)CE-PHIL037-11-H(1 : 2)CE-PHIL037-11-H2(1 : 2)CE-PHIL037-12(1 : 1)CE-PHIL037-12-H(1 : 2)CE-PHIL037-12-H2(1 : 2)CE-PHIL037-13(1 : 1)CE-PHIL037-13-H(1 : 2)CE-PHIL037-13-H2(1 : 2)CE-PHIL037-14CE-PHIL037-14-H(1 : 2)CE-PHIL037-14-H2(1 : 2)CE-PHIL037-15(1 : 1)CE-PHIL037-15-H(1 : 2)CE-PHIL037-15-H2(1 : 2)CE-PHIL037-16(1 : 1)CE-PHIL037-16-H(1 : 2)CE-PHIL037-16-H2(1 : 2)CE-PHIL037-17(1 : 1)CE-PHIL037-17-H(1 : 2)CE-PHIL037-17-H2(1 : 2)CE-PHIL037-18(1 : 1)CE-PHIL037-18-H(1 : 3)CE-PHIL037-18-H2(1 : 3)CE-PHIL037-19(1 : 2)CE-PHIL037-19-HCE-PHIL037-19-H2(1 : 3)CE-PHIL037-20(1 : 2)CE-PHIL037-20-H(1 : 3)CE-PHIL037-20-H2(1 : 3)CEA04-15(2 : 1)CEA05-15(2 : 1)CEA05-17.5(2 : 1)CEA06-15(2 : 1)CEA07-25(1 : 1)CEA08-15(1 : 1)CEA08-25(1 : 1)CEA10-25(1 : 1)CEA10-30(1 : 1)CEA10-35(1 : 1)CEA13-35(1 : 1)CEA15-35CEA17-38(1 : 2) CEA17-40(1 : 2) CEA18-35(1 : 2) CEA18-45(1 : 2) CEA21-45(1 : 2) CER04-20(3 : 1) CER05-15(2 : 1) CER05-20(2 : 1) CER05-50(2 : 1) CER06-20(2 : 1) CER06-25(2 : 1) CER06-50(2 : 1) CER065-25(2 : 1) CER07-20(1 : 1) CER07-25(1 : 1) CER07-50CER08-35(1 : 1)CER08-50(1 : 1)CER10-35(1 : 1)CER10-50(1 : 1)CER11-25(1 : 1)CER11-50(1 : 1)CER11.5-50(1 : 1)CER13-50(1 : 1)CER16-50(1 : 2)CER16-50-75(1 : 2)CER16-75(1 : 2)CER18-50(1 : 2)CER18-75(1 : 2)CER19-0(1 : 2)CER21-50(1 : 2)CER27-10-SNAP CER35-10-SNAP(1 : 3)CEV04-25(3 : 1)CEV05-25(2 : 1)CEV06-35(2 : 1)CEV07-50(1 : 1)CEV08-50(1 : 1)CEV10-75(1 : 1)CEV13-75(1 : 1)CEV15-100(1 : 2)CEV18-100(1 : 2)CL-A-11.5-26.5(1 : 1)CL-A-25-75(4 : 1)CL-A-40-125(2 : 1)CL-A-52-175(2 : 1)CL-A-65-100(2 : 1)CL-BIFILARCL-BOUR-PT122-A(1 : 2)CL-PULSE-KM20(1 : 1)CL-PULSE-KM30(1 : 1)CL-RAD08-5(1 : 1)CL-RAD10-10(1 : 1)CL-RAD10-5(1 : 1)CL-RAD13-7(1 : 1)CL-RAD9-5(1 : 1)CL-SI-B65545-B9(1 : 2)CL-SI-B65808(1 : 2)CL-SI-B65816(1 : 4)CL-SI-B78108(2 : 1)CL-SI-B82111-B-C11(1 : 1)CL-SI-B82111-B-C21(1 : 1)CL-SI-B82111-E(1 : 1)CL-SI-B82131CL-SI-B82145(2 : 1)CL-SI-B82500-A10(1 : 1)CL-SI-B82721-A(1 : 3)CL-SI-B82722-A(1 : 3)CL-SI-B82723-A(1 : 4)CL-SI-B82724-A(1 : 7)CL-SI-B82725-A(1 : 4)CL-SI-B82725-J(1 : 4)CL-T60405-R6100(1 : 3)CL-TDK-ZJY-2P(1 : 1)CL-V-11.5(1 : 1)CMK100-15(1 : 1)CMK100-15/10/5(1 : 1)CMK105-225(1 : 1)CMK110-225(1 : 1)CMK115-275CMK135-275(1 : 2) CMK150-275(1 : 2)CMK25-5(4 : 1)CMK30-5(4 : 1) CMK30-5/10/15(2 : 1)CMK30-75(4 : 1)CMK35-5(3 : 1)CMK40-10(3 : 1) CMK40-10-75(3 : 1) CMK40-50/75(3 : 1)CMK40-75(3 : 1)CMK45-5(2 : 1)CMK50-10(2 : 1)CMK50-15(2 : 1)CMK50-5(2 : 1) CMK50-5-6-7CMK50-75(2 : 1)CMK60-10(2 : 1)CMK60-15(2 : 1) CMK60-225(1 : 1)CMK60-5(2 : 1) CMK60-5-75(2 : 1)CMK60-75(2 : 1)CMK70-15(1 : 1)CMK72-5(1 : 1)CMK75-15(1 : 1) CMK75-205(1 : 1)CMK85-15(1 : 1) CMK85-15/10/5(1 : 1) CMK85-225(1 : 1)CMK90-15(1 : 1)CNY37CT-20R(2 : 1)CT-25-30R(4 : 1)CT-25R(2 : 1)CT-50R(2 : 1)CT-SI-B45185-B(2 : 1)CU40-15(2 : 1)CV-PHIL-808(1 : 1)CX23-5(2 : 1)CX234-5(2 : 1)DC-JACK(1 : 1)DI-FAGOR-7(1 : 1)DI-FAGOR-9(1 : 1)DI-FAGOR-DIL(1 : 1)DI-GBU10XX(2 : 1)DI-GBU4X(1 : 1)DI-GI-BRIDGE DI-KBU6XX(1 : 1)DI-PBU80X(1 : 1)DI-RB15(1 : 1)DI-SBU4XX(1 : 1)DIP10(1 : 1)DIP14(1 : 2) DIP14(4)(1 : 2) DIP14(8)(1 : 2)DIP16(1 : 2) DIP16(8)(1 : 2)DIP18(1 : 2)DIP20(1 : 2)DIP22(1 : 2) DIP22-400(1 : 2)DIP24(1 : 3) DIP24-400DIP24-600(1 : 3) DIP28-300(1 : 3) DIP28-600(1 : 3) DIP32-600(1 : 3)DIP4(1 : 1) DIP4(14)(1 : 2) DIP40-600(1 : 4) DIP48-600(1 : 5) DIP50-900(1 : 5) DIP52-600(1 : 5) DIP52-900(1 : 5)DIP6(1 : 1) DIP6-400(1 : 1) DIP64-900(1 : 6)DIP8(1 : 1) DO-15DO-201-BI(1 : 1)DO-201AD(1 : 1)DO-204(2 : 1)DO-204-BI(2 : 1)DO-220(1 : 1)DO-220-DOWN(1 : 2)DO-34(4 : 1)DO-35(3 : 1)DO-35-3(4 : 1)DO-35-6(2 : 1)DO-35-6MM(4 : 1)DO-35-V(2 : 1)DO-41(3 : 1)DO-41-3-4-5(2 : 1)DO-41-5(2 : 1)DO-41-6DO-41-8(1 : 1)DO-41-V(2 : 1)F126(2 : 1)F126-V(2 : 1)FI-MURA-BNX002(1 : 1)FI-MURA-DS306(4 : 1)FI-MURA-DS310(3 : 1)FI-MURA-DSS306(3 : 1)FI-MURA-DSS310(1 : 1)FI-MURA-DSS710(1 : 1)FI-MURA-DST306(4 : 1)FI-MURA-DST310(2 : 1)FI-TDK-ZJSR(4 : 1)FU-ATO-4450715(1 : 1)FU-AUTO-1(2 : 1)FU-BOUR-MF-R010FU-BOUR-MF-R020(4 : 1)FU-BOUR-MF-R050(4 : 1)FU-BOUR-MF-R135(4 : 1)FU-BOUR-MF-R300(2 : 1)FU-BOUR-MF-R500(2 : 1)FU-BOUR-MF-R800(1 : 1)FU-CLIPS-5X20(1 : 1)FU-CLIPS-5X20-2(1 : 1)FU-CLIPS-5X20-3(1 : 1)FU-CLIPS-5X20-3A(1 : 1)FU-CLIPS-63X32-3(1 : 1)FU-LITT-354251(1 : 1)FU-LITT-PT75(1 : 1)FU-PICOFUSE(3 : 1)FU-RAYC-RUE250(4 : 1)FU-RAYC-RXE030FU-RAYC-RXE075(2 : 1)FU-RS-415-014(1 : 1)FU-SCHU-OG-0031(1 : 1)FU-SHUR-FPG4(1 : 1)FU-SOCKET1(1 : 1)FU-WICKM-19652(1 : 1)FU-WICKM-TR5(1 : 1)HD-1(1 : 1)ISOTOP(1 : 3)L6202C(1 : 3)LD-10MM(1 : 1)LD-3MM(4 : 1)LD-3MM-DOWN(2 : 1)LD-3SPEC(2 : 1)LD-3STAG(2 : 1)LD-5MMLD-5MM-DOWN(2 : 1)LD-5MM-DOWN-M(2 : 1)LD-5MM-DUAL(2 : 1)LD-5MM-DUAL-DOWN(2 : 1)LD-5MM-SQR(2 : 1)LD-5STAG(1 : 1)LD-BIVAR-FLPR(2 : 1)LD-HDSP-5300-A(1 : 2)LD-HDSP-555X(1 : 2)LD-HDSP-75XX(1 : 1)LD-HDSP-A150(1 : 1)LD-HDSP-U2XX(1 : 1)LD-HLMP-4000(2 : 1)LD-HLMP-4000-A(1 : 1)LD-HLMP-6320/S(2 : 1)LD-HP-T1LD-KING-L130WCP(1 : 1)LD-KING-L934S(1 : 2)LD-KING-SA56(1 : 2)LD-LTC-2623(1 : 3)LD-LTL-32X3A(4 : 1)LD-LTL-92X3A(2 : 1)LD-LTL2685(1 : 1)LD-LTS-3401(1 : 3)LD-LTS2X01(1 : 1)LD-MARL-T1-2(2 : 1)LD-ORE5001(1 : 1)LD-ORE5002(1 : 2)LD-QT-MV5X164(1 : 1)LD-SI-LEDMONT5A(2 : 1)LD-SI-LU5351(2 : 1)LD-SI-PD443XLD-VISH-TSOP18XX(2 : 1)MO-COSEL-DCH(1 : 8)MO-COSEL-DCU1(1 : 2)MO-COSEL-ZUS6(1 : 3)MO-MELC-IMP3(1 : 3)MO-MELC-IMS7(1 : 2)MO-MELC-IMX4(1 : 3)MO-MELC-IMX7(1 : 2)MO-NEWP-DCC-NMES(1 : 1)MO-NEWP-NKA-S(2 : 1)MO-NEWP-NMA-S(2 : 1)MO-NEWP-NMA0505D(1 : 2)MO-NEWP-NME0505D(1 : 2)MO-NEWP-NMH0515D(1 : 1)MULTIWATT-11(1 : 1)OP-PC817PAD100(4 : 1)PAD45(4 : 1)PAD60(4 : 1)PASMRK(1 : 1)PGA-68PA(1 : 2)PO-BOUR-3005P(1 : 1)PO-BOUR-3006P(1 : 1)PO-BOUR-3006W(1 : 1)PO-BOUR-3006Y(1 : 1)PO-BOUR-3057P(1 : 1)PO-BOUR-3057Y(1 : 1)PO-BOUR-3082P(2 : 1)PO-BOUR-3250P(1 : 1)PO-BOUR-3250W(1 : 1)PO-BOUR-3250W-66(2 : 1)PO-BOUR-3260H PO-BOUR-3260W(2 : 1)PO-BOUR-3262P(1 : 1)PO-BOUR-3266W(2 : 1)PO-BOUR-3290H(2 : 1)PO-BOUR-3290P(1 : 1)PO-BOUR-3290W(2 : 1)PO-BOUR-3296W(2 : 1)PO-BOUR-3296Y(1 : 1)PO-BOUR-3296Z(1 : 1)PO-BOUR-3299P(1 : 1)PO-BOUR-3299W(1 : 1)PO-BOUR-3299X(1 : 1)PO-BOUR-3299Y(1 : 1)PO-BOUR-3299Z(2 : 1)PO-BOUR-3306P(1 : 1)PO-BOUR-3306WPO-BOUR-3309P(1 : 1)PO-BOUR-3309W(1 : 1)PO-BOUR-3310P(1 : 1)PO-BOUR-3323P(1 : 1)PO-BOUR-3323S(1 : 1)PO-BOUR-3323U(2 : 1)PO-BOUR-3323W(1 : 1)PO-BOUR-3323X(1 : 1)PO-BOUR-3329H(2 : 1)PO-BOUR-3329P(1 : 1)PO-BOUR-3329S(1 : 1)PO-BOUR-3329W(1 : 1)PO-BOUR-3329X(2 : 1)PO-BOUR-3339H(1 : 1)PO-BOUR-3339P(1 : 1)PO-BOUR-3339WPO-BOUR-3362P(1 : 1)PO-BOUR-3386F(1 : 1)PO-BOUR-3386H(2 : 1)PO-BOUR-3386P(1 : 1)PO-BOUR-3386W(2 : 1)PO-BOUR-3386X(2 : 1)PO-BOUR-VA05H(1 : 1)PO-BOUR-VA05V(1 : 1)PO-DIPL-377(1 : 1)PO-LORLIN-MDST-R(1 : 2)PO-PHIL-CRC16DBL(1 : 3)PO-PHIL-EMP10-H(1 : 2)PO-PHIL-EMP10-V(1 : 1)PO-PHIL-OCP10-H(1 : 1)PO-PHIL-OCP10-V(2 : 1)PO-PIHER-N6SPO-RADI-P15H(1 : 2)PO-RADI-P15H-12.5(1 : 2)PO-RADI-P15V(1 : 1)PO-RADI-T10FH(1 : 1)PO-ROHM-CIP160C(1 : 2)PO-ROHM-CIP20C(1 : 3)PO-ROHM-EP20(1 : 2)PO-ROHM-EP20C(1 : 2)PO-ROHM-P20EC(1 : 2)RE-3W-KP292-0(1 : 1)RE-5W(1 : 1)RE-AC01(2 : 1)RE-AC03-7(2 : 1)RE-AC04(1 : 1)RE-AC05(1 : 1)RE-AC07RE-BPC10(1 : 1)RE-DIPL-210(1 : 1)RE-MODU-MI-A(2 : 1)RE-PHIL-NTC-642(3 : 1)RE-PHIL-VDR-593(2 : 1)RE-PR01(2 : 1)RE-PR01-3-4-5(2 : 1)RE-PR02(2 : 1)RE-PR03(1 : 1)RE-PTC-SI-4MM(2 : 1)RE-R25-5(2 : 1)RE-R25-6(2 : 1)RE-R25-7(2 : 1)RE-R25V(4 : 1)RE-R50-225(1 : 1)RE-REH17RE-RW16(4 : 1)RE-RW16-6MM(4 : 1)RE-RW16V(4 : 1)RE-RW16V-A(4 : 1)RE-RW25(3 : 1)RE-RW25V(4 : 1)RE-SI-B59990(3 : 1)RE-VTM-KWV4(1 : 1)RE-WELW-OAR-3(2 : 1)RL-ELES-SGR282(1 : 1)RL-ELES-SGR462(1 : 1)RL-ELES-SVR762(1 : 1)RL-FIND-40.61(1 : 1)RL-FIND-56.34(1 : 3)RL-FUJI-FBR244(1 : 1)RL-FUJI-NARL-HAML-HE221A(1 : 1)RL-HELLA-4(1 : 3)RL-HELLA-5(1 : 3)RL-MEDE-SIL12-72(2 : 1)RL-NAIS-TQ2(1 : 1)RL-NEC-MR331(1 : 2)RL-NEC-MR603(1 : 1)RL-OMRO-G2R-SPDT(1 : 1)RL-OMRO-G2R-SPST(1 : 1)RL-OMRON-G5A(1 : 2)RL-OMRON-G5V-2(1 : 2)RL-OMRON-G6A-234(1 : 2)RL-OMRON-G6A-434(1 : 3)RL-OMRON-G6B-21(1 : 2)RL-OMRON-G6H-2(1 : 1)RL-REEDRELAY1RL-REEDRELAY2(1 : 2)RL-SCHRACK-PE51(1 : 1)RL-SCHRACK-RT42(1 : 1)RL-SCHRACK-RY61(1 : 1)RL-SDS-DK1A-L2(1 : 2)RL-SDS-ST(1 : 2)RL-SI-V23012(1 : 2)RL-SI-V23026-A(1 : 1)RL-SI-V23040-A(1 : 2)RL-SI-V23061(1 : 2)RL-SI-V23101-DA(1 : 1)RL-SI-V23105(1 : 1)RL-SI-V23106(1 : 1)RL-SI-V23127-A(1 : 2)RL-SPDT1(1 : 1)RL-STC-47RL-STC-51(1 : 2)RL-ZETT-AZ692(1 : 1)RL-ZETT-AZ725(1 : 1)SC-BAT-CR20XX(1 : 3)SC-CC28(1 : 2)SC-CC32(1 : 2)SC-CC44(1 : 2)SC-CC68(1 : 3)SC-CC84(1 : 3)SC-ZIF-QFP100(1 : 3)SC-ZIF-QFP80(1 : 3)SI-P5330-B403(1 : 1)SIP-10P(1 : 2)SIP-11P(1 : 2)SIP-12P(1 : 2)SIP-13PSIP-14P(1 : 3) SIP-15P(1 : 3) SIP-16P(1 : 3) SIP-17P(1 : 3) SIP-18P(1 : 4) SIP-19P(1 : 4) SIP-1P(4 : 1) SIP-20P(1 : 4) SIP-2P(4 : 1) SIP-2P-5(4 : 1) SIP-3P(4 : 1) SIP-4P(2 : 1) SIP-5P(1 : 1) SIP-6P(1 : 1) SIP-7P(1 : 1) SIP-8PSIP-9P(1 : 2)SOD-57(1 : 1)SOD-57-V(3 : 1)SOD-64(1 : 1)SOD81(3 : 1)SP-1(1 : 4)SP-SAT-1050(1 : 3)SP-SEP2232A(1 : 2)SP-STAR-QMB-06(1 : 2)SP-STAR-QMB-111(1 : 1)SP-STAR-TMB(1 : 1)SQUARE-2.0I(4 : 1)SW-ALPS-SPUJ1912(1 : 1)SW-AUGAT-TPA11-V(2 : 1)SW-AUGAT-TPB11-C(1 : 1)SW-BOUR-3315C-2SW-BOUR-7906H(1 : 1)SW-BOUR-DIGCON-B(1 : 3)SW-C&K-1101(2 : 1)SW-C&K-7100(1 : 1)SW-C&K-7200(1 : 1)SW-C&K-EP11A(1 : 1)SW-C&K-R100(1 : 2)SW-C&K-T100(2 : 1)SW-C&K-T100-AV(1 : 1)SW-C&K-T200(1 : 1)SW-C&K-T200-AV(1 : 1)SW-C&K-TP11(2 : 1)SW-C&K-TP12(2 : 1)SW-CTS-194-4(1 : 1)SW-CTS-194-8(1 : 1)SW-DIGITAST-SESW-DIP-1(1 : 1)SW-DIP-2(1 : 1)SW-DIP-4(1 : 1)SW-DIP-4-A(1 : 1)SW-DIP-6(1 : 1)SW-DIP-6-SPDT(1 : 1)SW-DIP-8(1 : 1)SW-DIP-8-SPDT(1 : 1)SW-DIP-ROT(1 : 1)SW-EAO-1K2(4 : 1)SW-ELMA-01-1X12(1 : 2)SW-ELMA-01-2X6(1 : 2)SW-ISOSTAT-D6(1 : 1)SW-ITV-19N5XX(2 : 1)SW-LORLIN-1X12(1 : 2)SW-LORLIN-2X6SW-LORLIN-3X4(1 : 2)SW-MEC-3ETL(1 : 1)SW-MEC-3FTL6XX(1 : 1)SW-MEC-8P(1 : 1)SW-MEC-SPST(1 : 1)SW-OHTO-1X3(1 : 1)SW-OHTO-2X3(1 : 1)SW-OMRON-B3F-10(1 : 1)SW-OMRON-B3F-40(1 : 1)SW-OMRON-B3W-4150(1 : 2)SW-RAFI15(1 : 2)SW-RAFI15-LED(1 : 2)SW-RAFI19(1 : 2)SW-SCHU-PMS(1 : 1)SW-SI-A60-A1(1 : 1)SW-SI-A60-A3SW-SPEC-SDES-8(1 : 2)SW-ZIPPY-TS06(1 : 1)TERM-07(3 : 1)TESTPIN(4 : 1)TO-100(1 : 1)TO-126(2 : 1)TO-126(2)(2 : 1)TO-126(2)-DOWN(1 : 2)TO-126-DOWN(1 : 2)TO-220(2 : 1)TO-220(2)(2 : 1)TO-220(2)-DOWN(1 : 2)TO-220-5(2 : 1)TO-220-5-DOWN(1 : 2)TO-220-5A(1 : 1)TO-220-5A-DOWN。
常用集成电路芯片封装图doc文档可能在WAP端浏览体验不佳。
建议您优先选择TXT,或下载源文件到本机查看。
PCB 元件库命名规则2.1 集成电路(直插)用DIP-引脚数量+尾缀来表示双列直插封装尾缀有N 和W 两种,用来表示器件的体宽N 为体窄的封装,体宽300mil,引脚间距2.54mm W 为体宽的封装, 体宽600mil,引脚间距 2.54mm 如:DIP-16N 表示的是体宽300mil,引脚间距2.54mm 的16 引脚窄体双列直插封装 2.2 集成电路(贴片)用SO-引脚数量+尾缀表示小外形贴片封装尾缀有N、M 和W 三种,用来表示器件的体宽N为体窄的封装,体宽150mil,引脚间距 1.27mm M 为介于N 和W 之间的封装,体宽208mil,引脚间距1.27mm W 为体宽的封装, 体宽300mil,引脚间距 1.27mm 如:SO-16N 表示的是体宽150mil,引脚间距1.27mm 的16 引脚的小外形贴片封装若SO 前面跟M 则表示为微形封装,体宽118mil,引脚间距0.65mm 2.3 电阻 2.3.1 SMD 贴片电阻命名方法为:封装+R 如:1812R 表示封装大小为1812 的电阻封装2.3.2 碳膜电阻命名方法为:R-封装如:R-AXIAL0.6 表示焊盘间距为0.6 英寸的电阻封装 2.3.3 水泥电阻命名方法为:R-型号如:R-SQP5W 表示功率为5W 的水泥电阻封装 2.4 电容 2.4.1 无极性电容和钽电容命名方法为:封装+C 如:6032C 表示封装为6032 的电容封装 2.4.2 SMT 独石电容命名方法为:RAD+引脚间距如:RAD0.2 表示的是引脚间距为200mil 的SMT 独石电容封装 2.4.3 电解电容命名方法为:RB+引脚间距/外径如:RB.2/.4 表示引脚间距为200mil, 外径为400mil 的电解电容封装 2.5 二极管整流器件命名方法按照元件实际封装,其中BAT54 和1N4148 封装为1N4148 2.6 晶体管命名方法按照元件实际封装,其中SOT-23Q 封装的加了Q 以区别集成电路的SOT-23 封装,另外几个场效应管为了调用元件不致出错用元件名作为封装名 2.7 晶振HC-49S,HC-49U 为表贴封装,AT26,AT38 为圆柱封装,数字表规格尺寸如:AT26 表示外径为2mm,长度为8mm 的圆柱封装 2.8 电感、变压器件电感封封装采用TDK 公司封装 2.9 光电器件 2.9.1 贴片发光二极管命名方法为封装+D 来表示如:0805D 表示封装为0805 的发光二极管 2.9.2 直插发光二极管表示为LED-外径如LED-5 表示外径为5mm 的直插发光二极管2.9.3 数码管使用器件自有名称命名 2.10 接插件 2.10.1 SIP+针脚数目+针脚间距来表示单排插针,引脚间距为两种:2mm,2.54mm 如:SIP7-2.54 表示针脚间距为 2.54mm 的7 针脚单排插针 2.10.2 DIP+针脚数目+针脚间距来表示双排插针,引脚间距为两种:2mm,2.54mm 如:DIP10-2.54 表示针脚间距为2.54mm 的10 针脚双排插针 2.10.3 其他接插件均按E3 命名 2.11 其他元器件详见《Protel99se 元件库清单》3 SCH 元件库命名规则3.1 单片机、集成电路、二极管、晶体管、光电器件按照器件自有名称命名 3.2 TTL74 系列和COMS 系列是从网上找的元件库,封装和编码需要在画原理图时重新设定 3.3 电阻 3.3.1 SMD 电阻用阻值命名,后缀加-F 表示1%精度,如果一种阻值有不同的封装,则在名称后面加上封装如:3.3-F-1812 表示的是精度为1%,封装为1812,阻值为 3.3 欧的电阻 3.3.2 碳膜电阻命名方法为:CR+功率-阻值如:CR2W-150 表示的是功率为2W,阻值为150 欧的碳膜电阻 3.3.3 水泥电阻命名方法为:R+型号-阻值如:R-SQP5W-100 表示的是功率为5W,阻值为100 欧的水泥电阻 3.3.4 保险丝命名方法为:FUSE-规格型号,规格型号后面加G 则表示保险管如:FUSE-60V/0.5A 表示的是60V,0.5A 的保险丝 3.4 电容3.4.1 无极性电容用容值来命名,如果一种容值有不同的封装,则在容值后面加上封装。
PowerPCB 元件封装制作图文详解!新手一定要看!PowerPCB 元件封装制作图文详解!***************************************************我们习惯上将设计工作分为三大阶段,指的是前期准备阶段、中间的设计阶段以及后期设计检查与数据输出阶段。
前期准备阶段的最重要的任务之一就是制作元件,制作元件需要比较专业的知识,我们会在下一部教程中专门介绍。
但是学会了做元件只是第一步,因为元件做好后还必须保存起来,保存的场所就是我们现在要讨论的元件库,而且在PowerPCB 中只有将元件存放到元件库中之后,才能调出使用。
因此做元件与建元件库操作是密不可分的,有时还习惯将两个操作合而为一,统称为建库。
建库过程中的重要工作之一就是对元件库的管理,可以想像一个功能强大的元件库,至少要能满足设计者的下列几方面的要求:必须能够随意新建元件库、具有较强的检索功能、可以对库中的内容进行各种编辑操作、可以将元件库中的内容导入或者是导出等等。
下面我们将分几小节对PowerPCB 元件库的各种管理功能进行详细讨论。
一,PowerPCB 元件库基本结构1.元件库结构在深入讨论之前,有必要先熟悉PowerPCB 的元件库结构,在下述图9-1 已经打开的元件库管理窗口下,我们可以清晰地看到四个图标,它们分别代表PowerPCB 的四个库,这是PowerPCB 元件库的的一个重要特点。
换句话说,每当新建一个元件库时,其实都有四个子库与之对应。
有关各个库的含义请仔细阅读图9-1 说明部分。
图9-1 各元件库功能说明例如我们新建了一个名为FTL 的库后,在Padspwr 的Lib 目录下就会同时出现四个名称相同但后缀名各异的元件库,如图9-2 分别为:FTL.pt4 :PartType 元件类型库FTL.pd4 :PartDecal 元件封装库FTL.ld4 :CAE 逻辑封装库FTL.ln4 :Line 线库这是Padspwr 的Lib 目录下的所有元件库的列表,在这里可以找到所有元件库,包括系统自带的与客户新建的库。
PCB中常见的元器件封装大全一、常用元器件:1.元件封装电阻 AXIAL2.无极性电容 RAD3.电解电容 RB-4.电位器 VR5.二极管 DIODE6.三极管 TO7.电源稳压块78和79系列 TO-126H和TO-126V8.场效应管和三极管一样9.整流桥 D-44 D-37 D-4610.单排多针插座 CON SIP11.双列直插元件 DIP12.晶振 XTAL1电阻:RES1,RES2,RES3,RES4;封装属性为axial系列无极性电容:cap;封装属性为RAD-0.1到rad-0.4电解电容:electroi;封装属性为rb.2/.4到rb.5/1.0电位器:pot1,pot2;封装属性为vr-1到vr-5二极管:封装属性为diode-0.4(小功率)diode-0.7(大功率)三极管:常见的封装属性为to-18(普通三极管)to-22(大功率三极管)to-3(大功率达林顿管)电源稳压块有78和79系列;78系列如7805,7812,7820等;79系列有7905,7912,7920等.常见的封装属性有to126h和to126v整流桥:BRIDGE1,BRIDGE2: 封装属性为D系列(D-44,D-37,D-46)电阻:AXIAL0.3-AXIAL0.7 其中0.4-0.7指电阻的长度,一般用AXIAL0.4瓷片电容:RAD0.1-RAD0.3。
其中0.1-0.3指电容大小,一般用RAD0.1电解电容:RB.1/.2-RB.4/.8 其中.1/.2-.4/.8指电容大小。
一般<100uF用RB.1/.2,100uF-470uF用RB.2/.4,>470uF用RB.3/.6二极管:DIODE0.4-DIODE0.7 其中0.4-0.7指二极管长短,一般用DIODE0.4发光二极管:RB.1/.2集成块:DIP8-DIP40, 其中8-40指有多少脚,8脚的就是DIP8贴片电阻0603表示的是封装尺寸与具体阻值没有关系但封装尺寸与功率有关通常来说0201 1/20W0402 1/16W0603 1/10W0805 1/8W1206 1/4W电容电阻外形尺寸与封装的对应关系是:0402=1.0x0.50603=1.6x0.80805=2.0x1.21206=3.2x1.61210=3.2x2.51812=4.5x3.22225=5.6x6.5零件封装是指实际零件焊接到电路板时所指示的外观和焊点的位置。
集成电路封装形式介绍(图解)BGA BGFP132 CLCCCPGA DIP EBGA 680LFBGA FDIP FQFP 100LJLCC BGA160L LCCLDCC LGA LQFPLQFP100L Metal Qual100L PBGA217LPCDIP PLCC PPGAPQFP QFP SBA 192LTQFP100L TSBGA217L TSOPCSPSIP:单列直插式封装.该类型的引脚在芯片单侧排列,引脚节距等特征与DIP基本相同.ZIP:Z型引脚直插式封装.该类型的引脚也在芯片单侧排列,只是引脚比SIP粗短些,节距等特征也与DIP基本相同.S-DIP:收缩双列直插式封装.该类型的引脚在芯片两侧排列,引脚节距为1.778mm,芯片集成度高于DIP.SK-DIP:窄型双列直插式封装.除了芯片的宽度是DIP的1/2以外,其它特征与DIP相同.PGA:针栅阵列插入式封装.封装底面垂直阵列布置引脚插脚,如同针栅.插脚节距为2.54mm或1.27mm,插脚数可多达数百脚.用于高速的且大规模和超大规模集成电路.SOP:小外型封装.表面贴装型封装的一种,引脚端子从封装的两个侧面引出,字母L状.引脚节距为1.27mm.MSP:微方型封装.表面贴装型封装的一种,又叫QFI等,引脚端子从封装的四个侧面引出,呈I字形向下方延伸,没有向外突出的部分,实装占用面积小,引脚节距为1.27mm.QFP:四方扁平封装.表面贴装型封装的一种,引脚端子从封装的两个侧面引出,呈L字形,引脚节距为1.0mm,0.8mm,0.65mm,0.5mm,0.4mm,0.3mm,引脚可达300脚以上.SVP:表面安装型垂直封装.表面贴装型封装的一种,引脚端子从封装的一个侧面引出,引脚在中间部位弯成直角,弯曲引脚的端部与PCB键合,为垂直安装的封装.实装占有面积很小.引脚节距为0.65mm,0.5mm.LCCC:无引线陶瓷封装载体.在陶瓷基板的四个侧面都设有电极焊盘而无引脚的表面贴装型封装.用于高速,高频集成电路封装.PLCC:无引线塑料封装载体.一种塑料封装的LCC.也用于高速,高频集成电路封装.SOJ:小外形J引脚封装.表面贴装型封装的一种,引脚端子从封装的两个侧面引出,呈J字形,引脚节距为1.27mm.BGA:球栅阵列封装.表面贴装型封装的一种,在PCB的背面布置二维阵列的球形端子,而不采用针脚引脚.焊球的节距通常为1.5mm,1.0mm,0.8mm,与PGA相比,不会出现针脚变形问题.CSP:芯片级封装.一种超小型表面贴装型封装,其引脚也是球形端子,节距为0.8mm,0.65mm,0.5mm等.TCP:带载封装.在形成布线的绝缘带上搭载裸芯片,并与布线相连接的封装.与其他表面贴装型封装相比,芯片更薄,引脚节距更小,达0.25mm,而引脚数可达500针以上.介绍:1 基本元件类型Basic Component Type盒形片状元件(电阻和电容)Box Type Solder ComponentResistor and Capacitor小型晶体管三极管及二极管SOTSmall Outline TransistorTransistor and Diodeelf类元件Melf type Component [Cylinder]Sop元件Small outline package小外形封装TSop元件Thin Sop薄形封装SOJ元件Small Outline J-lead Package 具有丁形引线的小外形封装QFP元件Quad Flat Package方形扁平封装PLCC元件Plastic Leaded Chip Carrier 塑料有引线芯片载体 BGABall Grid Array 球脚陈列封装球栅陈列封装CSPChip Size Package芯片尺寸封装2特殊元件类型Special Component Type钽电容( Tantalium Capacitor)铝电解电容(Aalminum Electrolytic Capacitor ) 可变电阻( Variable Resistor )针栅陈列封装BGABin Grid Array连接器ConnectorIC卡连接器IC Card Connector附BGA 封装的种类APBGAPlastic BGA塑料BGABCBGACeramic BGA陶瓷BGACCCGACeramic Column Grid Array陶瓷柱栅陈列DTBGATape Automated BGA载带自动键合BGAEMBGA微小BGA注芯片的封装技术已经历了好几代的变迁从DIPQFPPGABGA到CSP再到MCM技术指标一代比一代先进包括芯片面积与封装面积之比越来越接近于1适用频率越来越高耐温性能越来越好引脚数增多引脚间距减少重量减少可靠性提高使用更加方便等(MCMMulti Chip Model 多芯片组件)英汉缩语对照SMTSurface Mount Technology 表面贴装技术SMDSurface Mounting Devices 表面安装器件SMBSurface Mounting Printed Circuit Board 表面安装印刷板DIP Dual-In-Line Package 双列直插式组件THTThough Hole Mounting Technology插装技术PCB Printed Circuit Board 印刷电路板SMC Surface Mounting Components表面安装零件PQFP Plastic Quad Flat Package 塑料方形扁平封装SOIC Small Scale Integrated Circuit小外形集成电路LSI Large Scale Integration 大规模集成注意芯片封装图鉴封装大致经过了如下发展进程:结构方面:DIP封装(70年代)->SMT工艺(80年代LCCC/PLCC/SOP/QFP)->BGA封装(90年代)->面向未来的工艺(CSP/MCM) 材料方面:金属、陶瓷->陶瓷、塑料->塑料;引脚形状:长引线直插->短引线或无引线贴装->球状凸点;装配方式:通孔插装->表面组装->直接安装一.TO 晶体管外形封装TO(Transistor Out-line)的中文意思是“晶体管外形”。
常用集成电路芯片封装图doc文档可能在WAP端浏览体验不佳。
建议您优先选择TXT,或下载源文件到本机查看。
PCB 元件库命名规则2.1 集成电路(直插)用DIP-引脚数量+尾缀来表示双列直插封装尾缀有N 和W 两种,用来表示器件的体宽N 为体窄的封装,体宽300mil,引脚间距2.54mm W 为体宽的封装, 体宽600mil,引脚间距 2.54mm 如:DIP-16N 表示的是体宽300mil,引脚间距2.54mm 的16 引脚窄体双列直插封装 2.2 集成电路(贴片)用SO-引脚数量+尾缀表示小外形贴片封装尾缀有N、M 和W 三种,用来表示器件的体宽N为体窄的封装,体宽150mil,引脚间距 1.27mm M 为介于N 和W 之间的封装,体宽208mil,引脚间距1.27mm W 为体宽的封装, 体宽300mil,引脚间距 1.27mm 如:SO-16N 表示的是体宽150mil,引脚间距1.27mm 的16 引脚的小外形贴片封装若SO 前面跟M 则表示为微形封装,体宽118mil,引脚间距0.65mm 2.3 电阻 2.3.1 SMD 贴片电阻命名方法为:封装+R 如:1812R 表示封装大小为1812 的电阻封装2.3.2 碳膜电阻命名方法为:R-封装如:R-AXIAL0.6 表示焊盘间距为0.6 英寸的电阻封装 2.3.3 水泥电阻命名方法为:R-型号如:R-SQP5W 表示功率为5W 的水泥电阻封装 2.4 电容 2.4.1 无极性电容和钽电容命名方法为:封装+C 如:6032C 表示封装为6032 的电容封装 2.4.2 SMT 独石电容命名方法为:RAD+引脚间距如:RAD0.2 表示的是引脚间距为200mil 的SMT 独石电容封装 2.4.3 电解电容命名方法为:RB+引脚间距/外径如:RB.2/.4 表示引脚间距为200mil, 外径为400mil 的电解电容封装 2.5 二极管整流器件命名方法按照元件实际封装,其中BAT54 和1N4148 封装为1N4148 2.6 晶体管命名方法按照元件实际封装,其中SOT-23Q 封装的加了Q 以区别集成电路的SOT-23 封装,另外几个场效应管为了调用元件不致出错用元件名作为封装名 2.7 晶振HC-49S,HC-49U 为表贴封装,AT26,AT38 为圆柱封装,数字表规格尺寸如:AT26 表示外径为2mm,长度为8mm 的圆柱封装 2.8 电感、变压器件电感封封装采用TDK 公司封装 2.9 光电器件 2.9.1 贴片发光二极管命名方法为封装+D 来表示如:0805D 表示封装为0805 的发光二极管 2.9.2 直插发光二极管表示为LED-外径如LED-5 表示外径为5mm 的直插发光二极管2.9.3 数码管使用器件自有名称命名 2.10 接插件 2.10.1 SIP+针脚数目+针脚间距来表示单排插针,引脚间距为两种:2mm,2.54mm 如:SIP7-2.54 表示针脚间距为 2.54mm 的7 针脚单排插针 2.10.2 DIP+针脚数目+针脚间距来表示双排插针,引脚间距为两种:2mm,2.54mm 如:DIP10-2.54 表示针脚间距为2.54mm 的10 针脚双排插针 2.10.3 其他接插件均按E3 命名 2.11 其他元器件详见《Protel99se 元件库清单》3 SCH 元件库命名规则3.1 单片机、集成电路、二极管、晶体管、光电器件按照器件自有名称命名 3.2 TTL74 系列和COMS 系列是从网上找的元件库,封装和编码需要在画原理图时重新设定 3.3 电阻 3.3.1 SMD 电阻用阻值命名,后缀加-F 表示1%精度,如果一种阻值有不同的封装,则在名称后面加上封装如:3.3-F-1812 表示的是精度为1%,封装为1812,阻值为 3.3 欧的电阻 3.3.2 碳膜电阻命名方法为:CR+功率-阻值如:CR2W-150 表示的是功率为2W,阻值为150 欧的碳膜电阻 3.3.3 水泥电阻命名方法为:R+型号-阻值如:R-SQP5W-100 表示的是功率为5W,阻值为100 欧的水泥电阻 3.3.4 保险丝命名方法为:FUSE-规格型号,规格型号后面加G 则表示保险管如:FUSE-60V/0.5A 表示的是60V,0.5A 的保险丝 3.4 电容3.4.1 无极性电容用容值来命名,如果一种容值有不同的封装,则在容值后面加上封装。
如:0.47UF-0805C 表示的是容值为0.47UF,封装为0805C 的电容3.4.2 SMT 独石电容命名方法为:容值-PCB 封装如:39PF-RAD0.2 表示的是容值为39PF,引脚间距为200mil 的SMT 独石电容3.4.3 钽电容命名方法为:容值/耐压值,如果参数相同,只有封装不同,则在耐压值后面加“_封装”如:220UF/10V 表示的是容值为220UF,耐压值为10V 的钽电容3.4.4 电解电容命名方法为:容值/耐压值_E 如:47UF/35V_E 表示的是容值为47UF,耐压值为35V 的电解电容 3.5 晶振 3.5.1 用振荡频率作为SCH 名称 3.6 电感3.6.1 用电感量作为SCH 名称,如果电感量相同,封装不同,则在电感量后面加封装来区分如:22UH-NLFC3225表示电感量为22UH,封装为NLFC3225 的电感 3.7 接插件 3.7.1 SCH 命名和PCB 命名一致3.8 其他元器件3.8.1 命名详见《Protel99se 元件库清单》显示字数:500 1000 1500 3000 4500三极管封装图LQFP BQFP PQFPSC-70SOJSSOPSOP TQFP常见集成电路(IC)芯片的封装SIP(Single In-line Package)PGA(Pin Grid Array Package)PLCC(Plastic leaded Chip Carrier).CSP (Chip Scale Package)DIP,SIP,SOP,TO,SOT元件封裝形式(图)各元器件封装形式图解, 不知道有没有人发过. 暂且放上!CDIP-----Ceramic Dual In-Line PackageCLCC-----Ceramic Leaded Chip CarrierCQFP-----Ceramic Quad Flat PackDIP-----Dual In-Line PackageLQFP-----Low-Profile Quad Flat PackMAPBGA------Mold Array Process Ball Grid ArrayPBGA-----Plastic Ball Grid ArrayPLCC-----Plastic Leaded Chip CarrierPQFP-----Plastic Quad Flat PackQFP-----Quad Flat PackSDIP-----Shrink Dual In-Line PackageSOIC-----Small Outline Integrated PackageSSOP-----Shrink Small Outline PackageDIP-----Dual In-Line Package-----双列直插式封装。
插装型封装之一,引脚从封装两侧引出,封装材料有塑料和陶瓷两种。
DIP是最普及的插装型封装,应用范围包括标准逻辑IC,存贮器LSI,微机电路等。
PLCC-----Plastic Leaded Chip Carrier-----PLCC封装方式,外形呈正方形,32脚封装,四周都有管脚,外形尺寸比DIP封装小得多。
PLCC封装适合用SMT表面安装技术在PCB上安装布线,具有外形尺寸小、可靠性高的优点。
PQFP-----Plastic Quad Flat Package-----PQFP封装的芯片引脚之间距离很小,管脚很细,一般大规模或超大规模集成电路采用这种封装形式,其引脚数一般都在100以上。
SOP-----Small Outline Package------1968~1969年菲为浦公司就开发出小外形封装(SOP)。
以后逐渐派生出SOJ(J型引脚小外形封装)、TSOP(薄小外形封装)、VSOP(甚小外形封装)、SSOP(缩小型SOP)、TSSOP(薄的缩小型SOP)及SOT(小外形晶体管)、SOIC(小外形集成电路)等。
常见的封装材料有:塑料、陶瓷、玻璃、金属等,现在基本采用塑料封装。
按封装形式分:普通双列直插式,普通单列直插式,小型双列扁平,小型四列扁平,圆形金属,体积较大的厚膜电路等。
按封装体积大小排列分:最大为厚膜电路,其次分别为双列直插式,单列直插式,金属封装、双列扁平、四列扁平为最小。
两引脚之间的间距分:普通标准型塑料封装,双列、单列直插式一般多为2.54±0.25 mm,其次有2mm(多见于单列直插式)、1.778±0.25mm(多见于缩型双列直插式)、1.5±0.25mm,或1.27±0.25mm(多见于单列附散热片或单列V型)、1.27±0.25mm(多见于双列扁平封装)、1±0.15mm(多见于双列或四列扁平封装)、0.8±0.05~0.15mm(多见于四列扁平封装)、0.65±0.03mm(多见于四列扁平封装)。
双列直插式两列引脚之间的宽度分:一般有7.4~7.62mm、10.16mm、12.7mm、15.24mm 等数种。
双列扁平封装两列之间的宽度分(包括引线长度:一般有6~6.5±mm、7.6mm、10.5~10.65mm等。
四列扁平封装40引脚以上的长×宽一般有:10×10mm(不计引线长度)、13.6×13.6±0.4mm(包括引线长度)、20.6×20.6±0.4mm(包括引线长度)、8.45×8.45±0.5mm(不计引线长度)、14×14±0.15mm(不计引线长度)等。