电子科技大学微电子器件实验讲义
- 格式:pdf
- 大小:1.03 MB
- 文档页数:26

微电子器件授课教案第一章:微电子器件概述1.1 微电子器件的定义与发展历程1.2 微电子器件的基本原理与分类1.3 微电子器件在现代科技领域的应用1.4 本章小结第二章:半导体物理基础2.1 半导体的基本概念与特性2.2 半导体材料的制备与分类2.3 PN结的形成与特性2.4 本章小结第三章:二极管与三极管3.1 二极管的结构、原理与特性3.2 二极管的应用电路3.3 三极管的结构、原理与特性3.4 三极管的应用电路3.5 本章小结第四章:场效应晶体管4.1 场效应晶体管的基本概念与结构4.2 场效应晶体管的原理与特性4.3 场效应晶体管的应用电路4.4 本章小结第五章:集成电路及其应用5.1 集成电路的基本概念与分类5.2 集成电路的制备工艺5.3 常见集成电路举例5.4 集成电路的应用与发展趋势5.5 本章小结第六章:金属-半导体器件6.1 金属-半导体结的形成与特性6.2 MOSFET(金属-氧化物-半导体场效应晶体管)的基本原理6.3 MOSFET的制备工艺与结构类型6.4 MOSFET的应用电路与特性分析6.5 本章小结第七章:集成电路设计基础7.1 数字集成电路设计概述7.2 逻辑门与逻辑电路设计7.3 触发器与时序逻辑电路设计7.4 模拟集成电路设计基础7.5 本章小结第八章:微电子器件的封装与测试8.1 微电子器件封装技术概述8.2 常见封装形式及其特点8.3 微电子器件的测试方法与设备8.4 测试结果的分析与评价8.5 本章小结第九章:微电子器件的可靠性9.1 微电子器件可靠性的基本概念9.2 影响微电子器件可靠性的因素9.3 提高微电子器件可靠性的措施9.4 可靠性测试与评估方法9.5 本章小结第十章:微电子器件的发展趋势10.1 微电子器件技术的创新点10.2 微电子器件在新领域的应用10.3 我国微电子器件产业的发展现状与展望10.4 本章小结重点和难点解析一、微电子器件的定义与发展历程难点解析:对微电子器件的理解需要从其定义出发,明确其作为一种电子器件的特殊性,以及其发展的历程和分类。
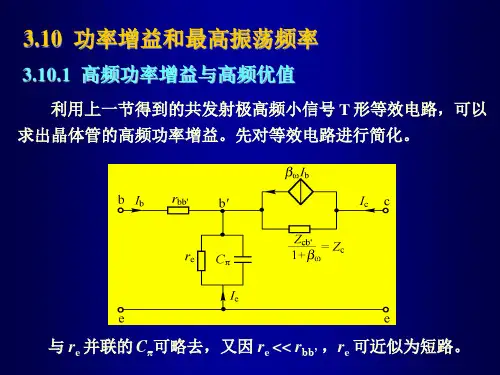


微电子器件实验指导书微电子技术教学部编写光电工程学院微电子技术教学部2004年2月一.实验的地位、作用和目的:《微电子器件实验》课是微电子学与固体电子学专业本科教学中的重要教学实践环节。
目的是帮助学生理解课堂上学到的基本原理和知识,并掌握晶体管基本参数的测量方法,提供实际动手能力,以适应社会的需求。
基本原理及课程简介:微电子器件课程讲述了基本的半导体器件BJT、JFET、MOSFET的物理结构和工作原理,它主要针对半导体器件的主要电参数讲述其测量方法和原理。
它包含了三个实验:双极晶体管击穿特性测试、双极晶体管直流放大特性测试、晶体管特征频率的测量。
二.实验方式及基本要求1.教师在课堂上讲解实验的基本原理、仪器使用、测试内容及实验要求,交代实验注意事项。
2.学生分4人一组进行实验,要求必须自己动手做实验,然后独立完成实验报告。
三.实验考核及实验报告:1.学生在做完一个实验后,需要独立处理实验数据,认真写实验报告(内容包含实验原理、实验步骤和实验结果),在做实验前还必须预习;2.实验指导教师根据学生实验完成情况及实验报告情况打分,然后综合各次实验给出最后考核成绩。
编著者:杨虹、唐政维、冯世娟试验一 测量双极晶体管的直流放大特性一.试验目的1.学习晶体管特性图式仪的使用。
2.测量晶体管的0β值。
二.实验原理1.双极晶体管的电流放大作用当晶体管处于有源放大区(发射结正偏,集电结反偏)时,其电流的组成为: 图一 晶体管中的各种电流成分E nE pE I I I =+C nC CBO I I I =+B pE VB CBO I I I I =+-其中nE nC VB I I I =+E C B I I I ∴=+。
我们定义:0nC EI I α=,共基极直流电流增益。
0α总是小于1(0α应尽量接近1)。
0C E CBO I I I α∴=+。
定义:0001nC B I I αβα==-,共射极直流电流增益。

电子科技大学《微电子器件》课程教学大纲课程编号:65030145适用专业:电子科学与技术集成电路设计与集成系统学时数:72(含实验12)学分数:4.5先修课程:《半导体物理》考核方式:考试执笔者:张庆中编写日期:2006年4月一、课程性质和任务本课程的授课对象是“电子科学与技术(微电子技术方向)”专业和“集成电路设计与集成系统”专业的本科生,属于专业方向选修课。
本课程的目的是使学生掌握二极管、双极型与场效应晶体管的基本理论,这些内容都是本领域高级专业技术人员所必须掌握的。
本课程同时也是本专业其它后续课程如《集成电路原理》等的先修课程。
二、课程教学内容和要求1、理论教学(60学时)基本半导体方程(3学时):掌握一维形式的泊松方程、电子与空穴的电流密度方程、电子与空穴的连续性方程,掌握基本半导体方程的主要简化形式。
PN结(18学时):了解突变结与线性缓变结、PN结的平衡状态,理解空间电荷区的形成,了解耗尽近似的适用性(自学),掌握内建电场与扩散电势差、PN结在正向及反向电压下的能带图、少子分布与伏安特性,理解正向导通电压、大注入效应,掌握PN结的击穿特性、PN结的势垒电容与扩散电容、交流小信号参数与等效电路、PN结的开关特性。
这部分内容的重点是PN结空间电荷区的形成、耗尽层宽度与扩散电势差的推导与计算、PN结伏安特性的推导、势垒电容与扩散电容的概念及其计算、PN结的交流小信号参数与等效电路、少子存储效应、雪崩击穿的概念及击穿电压的计算。
这部分内容的难点是PN结内建电场的计算、少子分布的推导与少子分布图、大注入时的内建电场与Webster效应、扩散电容表达式的推导、雪崩倍增因子的推导等。
双极型晶体管(25学时):了解均匀基区与缓变基区,理解晶体管的基区输运系数与发射结注入效率,掌握晶体管的直流电流放大系数,理解发射区重掺杂效应,了解异质结双极晶体管、倒向晶体管,掌握埃伯斯-莫尔方程、晶体管直流输入输出特性方程及特性图、基区宽度调变效应、晶体管的各种反向电流与击穿电压、理解基极电阻,掌握交流小信号基区输运系数注入效率电流放大系数等随频率的变化关系,理解交流小信号电流电压方程及等效电路、掌握高频晶体管的特征频率、最大功率增益与最高振荡频率,了解基区扩展效应(自学),了解发射极电流集边效应(自学)。

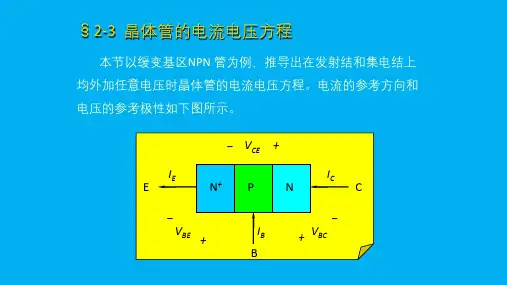

电子科技大学实验报告(实验)课程名称微电子器件实验三:晶体管特征频率的测量分析学生姓名:学号:201203*******指导教师:刘继芝实验地点:211楼605实验时间:2015、6、18一、实验室名称: 微电子器件实验室二、实验项目名称:晶体管特征频率的测量分析三、实验学时:3四、实验原理:晶体管放大系数与频率的关系如下: ()βωωωωββj jm b +-=1exp 0 ()[]21201βββf f += 直接在利用晶体管放大系数β为1的条件测量晶体管特征频率T f 较为困难,而利用下式,根据图中αβf f f <<的线性关系则可在较低频率测量特征频率T f ,这就是“増益—带宽”积的测量方法。
βββf f f T 0==,五、实验目的:掌握晶体管T f 的“増益—带宽”积的测试原理,并熟练地运用T f 测试仪测试双极晶体管的特征频率。
六、实验内容:1、 在规定Vce, Ie 偏置下测晶体管特征频率T f 。
2、 Vce 置定值,测量T f —Ie 关系。
3、 Ie 置定值,测量T f —Ie 关系。
4、 发射结并数pF 电容,观察特征频率T f 变化七、实验器材(设备、元器件):QT16高频小功率晶体管T f 测试仪、高频小功率双极晶体管八、实验步骤:a.熟悉晶体管特征频率测试仪的测量范围,信号源工作频率,然后开机预热。
b. 从器件手册上查出所选器件的范围。
c.确定信号源工作频率,校准仪器d.按实验方法所述进行测量。
九、实验数据及结果分析:a 、特征频率分别与Ie 、Vce 的关系如下图:b 、特征频率与并联电容的关系如下:十、实验结论:通过测试,可以知道:高频小功率NPN 晶体管的特征频率与工作状态密切相关,在一定的偏置下可以达到最大值,这对电路设计具有指导意义。
另一方面,结电容对晶体管的特征频率影响极大,小的发射结电容可以获得高的特征频率。
十一、总结及心得体会:晶体管特征频率f定义为共射极输出交流短路电流放大系数 随频率下降到T1时的工作频率,是晶体管的重要参数。

重点与难点第1章半导体器件基本方程一般来说要从原始形式的半导体器件基本方程出发来求解析解是极其困难的,通常需要先对方程在一定的具体条件下采用某些假设来加以简化,然后再来求其近似解。
随着半导体器件的尺寸不断缩小,建立新解析模型的工作也越来越困难,一些假设受到了更大的限制并变得更为复杂。
简化的原则是既要使计算变得容易,又要能保证达到足够的精确度。
如果把计算的容易度与精确度的乘积作为优值的话,那么从某种意义上来说,对半导体器件的分析问题,就是不断地寻找具有更高优值的简化方法。
要向学生反复解释,任何方法都是近似的,关键是看其精确程度和难易程度。
此外,有些近似方法在某些条件下能够采用,但在另外的条件下就不能采用,这会在后面的内容中具体体现出来。
第2章PN结第2.1节PN结的平衡状态本节的重点是PN结空间电荷区的形成、内建电势的推导与计算、耗尽区宽度的推导与计算。
本节的难点是对耗尽近似的理解。
要向学生强调多子浓度与少子浓度相差极其巨大,从而有助于理解耗尽近似的概念,即所谓耗尽,是指“耗尽区”中的载流子浓度与平衡多子浓度或掺杂浓度相比可以忽略。
第2.2节PN结的直流电流电压方程本节的重点是对PN结扩散电流的推导。
讲课时应该先作定性介绍,让学生先在大脑中建立起物理图象,然后再作定量的数学推导。
当PN结上无外加电压时,多子的扩散趋势正好被高度为qV bi的势垒所阻挡,电流为零。
外加正向电压时,降低了的势垒无法阻止载流子的扩散,于是构成了流过PN结的正向电流。
正向电流的电荷来源是P区空穴和N区电子,它们都是多子,所以正向电流很大。
外加反向电压时,由于势垒增高,多子的扩散变得更困难。
应当注意,“势垒增高”是对多子而言的,对各区的少子来说,情况恰好相反,它们遇到了更深的势阱,因此反而更容易被拉到对方区域去,从而构成流过PN结的反向电流。
反向电流的电荷来源是少子,所以反向电流很小。
本节的难点是对有外加电压时势垒区两旁载流子的运动方式的理解、以及电子(空穴电流向空穴(电子电流的转化。

电子科技大学微固学院标准实验报告(实验)课程名称微电子器件电子科技大学教务处制表电子科技大学实验报告学生姓名:学号:指导教师:张有润实验地点:211楼605 实验时间:2017.6.12一、实验室名称:微电子器件实验室二、实验项目名称:双极型晶体管直流特性的测量三、实验学时:3四、实验原理:1、如图1所示,晶体管特征图示仪提供Vce的锯齿波扫描电压和Ib的阶梯变化,且两者一一对应,便产生Ib 从Ib0、Ib1、Ib2等Vce从零到最大值的曲线族。
从而测量晶体管的直流特性。
基本测试原理电路如图2所示,测试时用逐点测试的方法把一条条的曲线描绘出来。
图1 图22、输入特性曲线和输入电阻Ri在共射晶体管电路中,输出交流短路时,如图3,输入电压和输入电流之比为Ri,即:图33、输出特性曲线、β和h FEβ、hFE也可用共射晶体管的转移特性进行测量。
这种曲线可直接观察β的线性好坏。
4、饱和压降VCES和正向压降VBESVCES和VBES是功率管的重要参数,对开关管尤其重要。
VCES是共射晶体管饱和态时C—E间的压降。
VBES是共射晶体管饱和态时B—E间的压降。
一般硅管的VBES=0.7-0.8V,锗管的VBES=0.3-0.4V。
VCES的大小与衬底材料和测试条件有一定的关系。
VBES与芯片表面的铝硅接触情况有关,铝硅合金不好,或光刻引线孔时残留有薄氧化层都会导致VBES过大。
5、反向击穿电压BVCBO、BVCEO和BVEBO外延片制作的双极晶体管的反向击穿电压VB(一般指BVCEO或BVCBO)既与外延层电常数=∂∂=CEVBBEi IVR阻率ρ有关,也与结的曲率半径和表面状况等因素有关。
当高阻集电区厚度Wc小于BVCBO 所对应的势垒宽度XmB时,VB还与WC有关。
所以提高晶体管反向耐压可采取提高ρ、WC,减小二氧化硅中表面电荷密度,采用圆角基区图形,深结扩散、甚至采用台面结构、扩展电极或加电场限制环等措施。

微电子器件授课教案第一章:微电子器件概述1.1 教学目标了解微电子器件的基本概念和分类掌握微电子器件的发展历程和趋势理解微电子器件在现代科技领域的应用1.2 教学内容微电子器件的定义和特点微电子器件的分类及性能指标微电子器件的发展历程和趋势微电子器件在现代科技领域的应用1.3 教学方法采用讲授和互动讨论相结合的方式,引导学生了解微电子器件的基本概念和分类通过案例分析,使学生掌握微电子器件的发展历程和趋势利用实际应用场景,让学生理解微电子器件在现代科技领域的重要作用第二章:半导体物理基础2.1 教学目标掌握半导体的基本性质和导电机制了解半导体物理中的重要概念和原理理解半导体器件的工作原理和性能特点2.2 教学内容半导体的基本性质和导电机制半导体物理中的重要概念和原理半导体器件的工作原理和性能特点2.3 教学方法通过讲解和示例,让学生掌握半导体的基本性质和导电机制利用实验和仿真,使学生了解半导体物理中的重要概念和原理结合具体器件,让学生理解半导体器件的工作原理和性能特点第三章:二极管和三极管3.1 教学目标掌握二极管和三极管的结构、原理和性能学会分析二极管和三极管在不同电路中的应用了解二极管和三极管的发展趋势和新型器件3.2 教学内容二极管和三极管的结构和工作原理二极管和三极管的性能参数和测试方法二极管和三极管在不同电路中的应用二极管和三极管的发展趋势和新型器件3.3 教学方法通过讲解和示例,让学生掌握二极管和三极管的结构和工作原理利用实验和仿真,使学生了解二极管和三极管的性能参数和测试方法结合具体应用案例,让学生学会分析二极管和三极管在不同电路中的应用介绍二极管和三极管的发展趋势和新型器件,激发学生的学习兴趣和探究精神第四章:集成电路和微电子技术了解集成电路的基本概念和分类掌握集成电路的设计和制造工艺理解微电子技术的发展和应用领域4.2 教学内容集成电路的基本概念和分类集成电路的设计和制造工艺微电子技术的发展和应用领域4.3 教学方法采用讲解和互动讨论相结合的方式,引导学生了解集成电路的基本概念和分类通过案例分析和实验,使学生掌握集成电路的设计和制造工艺利用实际应用场景,让学生理解微电子技术的发展和应用领域第五章:微电子器件的应用5.1 教学目标了解微电子器件在不同领域的应用掌握微电子器件的选型和使用方法理解微电子器件在现代科技中的重要作用5.2 教学内容微电子器件在电子设备中的应用微电子器件在通信系统中的应用微电子器件在计算机领域的应用微电子器件在其他领域的应用通过讲解和示例,让学生了解微电子器件在不同领域的应用利用实验和仿真,使学生掌握微电子器件的选型和使用方法结合具体应用场景,让学生理解微电子器件在现代科技中的重要作用第六章:功率器件和功率集成电路6.1 教学目标掌握功率器件的结构、原理和性能了解功率集成电路的基本概念和分类理解功率器件和功率集成电路在电力电子领域的应用6.2 教学内容功率器件的结构和工作原理功率器件的性能参数和测试方法功率集成电路的基本概念和分类功率器件和功率集成电路在电力电子领域的应用6.3 教学方法通过讲解和示例,让学生掌握功率器件的结构和工作原理利用实验和仿真,使学生了解功率器件的性能参数和测试方法结合具体应用案例,让学生了解功率集成电路的基本概念和分类介绍功率器件和功率集成电路在电力电子领域的应用,激发学生的学习兴趣和探究精神第七章:传感器和微电子器件7.1 教学目标了解传感器的基本概念和分类掌握传感器的原理和性能理解传感器和微电子器件在智能化领域的应用7.2 教学内容传感器的基本概念和分类传感器的原理和性能传感器和微电子器件在智能化领域的应用7.3 教学方法采用讲解和互动讨论相结合的方式,引导学生了解传感器的基本概念和分类通过案例分析和实验,使学生掌握传感器的原理和性能利用实际应用场景,让学生理解传感器和微电子器件在智能化领域的应用第八章:光电器件和光电子集成电路8.1 教学目标掌握光电器件的结构、原理和性能了解光电子集成电路的基本概念和分类理解光电器件和光电子集成电路在光通信领域的应用8.2 教学内容光电器件的结构和工作原理光电器件的性能参数和测试方法光电子集成电路的基本概念和分类光电器件和光电子集成电路在光通信领域的应用8.3 教学方法通过讲解和示例,让学生掌握光电器件的结构和工作原理利用实验和仿真,使学生了解光电器件的性能参数和测试方法结合具体应用案例,让学生了解光电子集成电路的基本概念和分类介绍光电器件和光电子集成电路在光通信领域的应用,激发学生的学习兴趣和探究精神第九章:微电子器件的可靠性9.1 教学目标了解微电子器件的可靠性基本概念掌握微电子器件的可靠性参数和测试方法理解微电子器件可靠性对系统的影响9.2 教学内容微电子器件的可靠性基本概念微电子器件的可靠性参数和测试方法微电子器件可靠性对系统的影响9.3 教学方法采用讲解和互动讨论相结合的方式,引导学生了解微电子器件的可靠性基本概念通过案例分析和实验,使学生掌握微电子器件的可靠性参数和测试方法利用实际应用场景,让学生理解微电子器件可靠性对系统的影响第十章:微电子器件的发展趋势10.1 教学目标了解微电子器件的最新发展动态掌握未来微电子器件的技术发展趋势理解微电子器件对现代社会的影响10.2 教学内容微电子器件的最新发展动态未来微电子器件的技术发展趋势微电子器件对现代社会的影响10.3 教学方法通过讲解和示例,让学生了解微电子器件的最新发展动态利用实验和重点和难点解析:1. 微电子器件的分类和性能指标:学生需要理解不同类型微电子器件的特点和应用场景,以及如何评估它们的性能。
微电子器件授课教案第一章:微电子器件概述1.1 微电子器件的定义与分类1.2 微电子器件的发展历程1.3 微电子器件的基本原理1.4 微电子器件的应用领域第二章:半导体物理基础2.1 半导体的基本概念2.2 半导体的能带结构2.3 半导体材料的制备与分类2.4 半导体器件的掺杂原理第三章:晶体管器件3.1 晶体管的基本原理3.2 晶体管的结构与类型3.3 晶体管的制备与加工3.4 晶体管的性能参数及应用第四章:集成电路概述4.1 集成电路的基本概念4.2 集成电路的分类与结构4.3 集成电路的制备工艺4.4 集成电路的应用领域第五章:微电子器件的可靠性5.1 微电子器件可靠性的基本概念5.2 微电子器件失效的原因及机制5.3 微电子器件可靠性提升的方法5.4 微电子器件的可靠性测试与评估第六章:二极管器件6.1 二极管的基本原理与结构6.2 二极管的制备与掺杂6.3 二极管的性能参数及测试6.4 二极管的应用领域第七章:场效应晶体管(FET)7.1 FET的基本原理与结构7.2 FET的制备与加工7.3 FET的性能参数及特性曲线7.4 FET的应用领域及发展趋势第八章:双极型晶体管(BJT)8.1 BJT的基本原理与结构8.2 BJT的制备与掺杂8.3 BJT的性能参数及工作原理8.4 BJT的应用领域及发展趋势第九章:集成电路设计9.1 集成电路设计的基本流程9.2 数字集成电路设计9.3 模拟集成电路设计9.4 集成电路设计工具与方法第十章:微电子器件的封装与测试10.1 微电子器件封装的基本概念10.2 常见封装形式及其特点10.3 微电子器件的测试方法10.4 微电子器件的质量控制与可靠性提升第十一章:功率半导体器件11.1 功率半导体器件的分类与原理11.2 功率晶体管和功率二极管11.3 绝缘栅双极型晶体管(IGBT)11.4 功率集成电路与模块第十二章:微波半导体器件12.1 微波半导体器件的分类与原理12.2 微波二极管和微波三极管12.3 微波集成电路与系统12.4 微波半导体器件的应用第十三章:光电子器件13.1 光电子器件的基本原理13.2 激光二极管与光检测器13.3 光电子集成电路与系统13.4 光电子器件的应用与发展第十四章:半导体存储器14.1 存储器的基本原理与分类14.2 随机存取存储器(RAM)14.3 只读存储器(ROM)与闪存14.4 存储器系统与新技术第十五章:微电子器件的进展与未来15.1 微电子器件的技术发展趋势15.2 纳米电子学与量子器件15.3 生物医学微电子器件15.4 环境与能源相关的微电子器件重点和难点解析第一章:微电子器件概述重点:微电子器件的定义、分类和应用领域。
电子科技大学实验报告(实验)课程名称微电子器件实验二:场效应晶体管直流特性的测试学生姓名:学号:*************指导教师:***实验地点:211楼605实验时间:2015、6、一、实验室名称:微电子器件实验室二、实验项目名称:场效应晶体管直流特性的测试三、实验学时:3四、实验原理:1. 实验仪器实验仪器为XJ4810图示仪,与测量双极晶体管直流参数相似,但由于所检测的场效应管是电压控制器件,测量中须将输入的基极电流改换为基极电压,这可将基极阶梯选择选用电压档(伏/级);也可选用电流档(毫安/级),但选用电流档必须在测试台的B-E间(相当于场效应管的G.S之间)外接一个电阻(如接1kΩ电阻),将输入电流转换成输入电压。
测量时将场效应管的管脚与双极管脚一一对应,即S(源极)对应E(发射极);G(栅极)对应B(基极);D(漏极)对应C(集电极)。
值得注意的是,测量MOS管时,若没有外接电阻,必须避免阶梯选择直接采用电流档,以防止损坏管子。
另外,由于场效应管输入阻抗很高,在栅极上感应出来的电荷很难通过输入电阻泄漏掉,电荷积累会造成电位升高。
尤其在极间电容较小的情况下,常常在测试中造成MOS管感应击穿,使管子损坏或指标下降。
因而在检测MOS管时,应尽量避免栅极悬空,且源极接地要良好,交流电源插头也最好采用三眼插头,并将地线(E 接线柱)与机壳相通。
存放时,要将管子三个电极引线短接。
2. 参数定义(1)输出特性与转移特性输出特性曲线(I DS-V DS)即漏极特性曲线,它与双极管的输出特性曲线相似,如图2-1所示。
在曲线中,工作区可分为三部分:I 是可调电阻区(或称非饱和区);Ⅱ是饱和区;Ⅲ是击穿区。
转移特性曲线为I DS-V DS之间的关系。
转移特性反映场效应管栅极的控制能力。
由于结型场效应晶体管都属于耗尽型,且栅源之间相当于一个二极管,所以当栅压正偏(V GS>0)并大于 0.5V时,转移特性曲线开始弯曲,如图2-2中正向区域虚线所示。
1-11-21-1 1-21XJ4810231XJ4810XJ48101-312350Hz456XJ4810XJ4810[1]1-3 XJ481023DG6 npn1R iR iCE V B BEi I V R 3DG6V CE = 10V Q R i 1- 40~10V++0.1~1kx 0 .1V/ y0.1mA/x 1V/10V x 0.1V/V CE =10V 1-5 .200101.002.0310V V B BEi CE I V R1-4 1-52h FEh FE 1- 40~50V++0.1~1kx 2V/y 2mA/0.02mA/1-611002.02.21001.010********BC V CE V mA C I B C V CE V mA C I FE I I I I h h FE h FE 1-7x1-6 1-7I B g I BB I CE cV I g ""--2mA/I ECB V E CI I 3V CES V BESV CES V BES V CES C --E V BES B --E V BES =0.7~0.8V V BES =0.3~0.4V V CES V BES V BES1-4I C =10mA I B =1mA0~50V0.5~1K++x 0.05V/y 1mA/0.1mA// 101011I C =10mA V CE V CES 1-8V CES =0.15V y x 0.1V/1-9I B =1mA V BE V BES 1-9V BES = 0.78V1-8 V CES 1-9 V BES4BV CBO BV CEO BV EBOV B BV CEO BV CBO c Wc BV CBO x mB V B W C c W CBV CBO C --B BV CEOC --EBV CBO ----C --BBV CEO ---- C --EBV EBO ----E --B n o CBO CEO BV BV 1/npn n = 4Nc N B BV CBO BV CEO BV EBO C B N N BV CBO BV EBO BV CEO3DG6BV CBO BV CEO I C =100A BV EBO I E =100A 1-100~200V BV CBO BV CEO0~20V BV EBO+5~50kx 10V/BV CBO BV CEO1V/BV EBOy 0.1mA/1-11BV CBO =70V BV CEO =40V BV EBO =7V1-101-115I CBO I CEO I EBOI CBO I CEO I EBO I CEOI D I G I SI G I D I D I GXJ4810XJ4810JS2B I CBO I CEO I EBOI CBO----C--BI CEO----C--EI EBO----E--B3AX31B1-101-120~50V--1~10Kx1V/y0.01~0.5mA1-12311-131-1421-1531-16P n1-1741-18p --n n1-191-2051-21a b1-21a c W c r cs V CES1-21b ""r cbn1-13 1-14 1-151-16 1-171-18 1.19 1.201.21a 1.21b11XJ48102 3DG6C 3AX 31B 3AX 31B 1--13DG61--2P CM mW I CM (mA) T jm () BV CBOVBV CEO V BV EBO V I CBO (A) I CEO (A) I EBO (A) h FE 125125 75 30 18 10 12 600 12 40~130I C =ImA Ic=2mA I E =1mA V CB =6V V CE =6V V EB =6V V CE =1V I C =100mAP CM mW I CM (mA) BV CBO (V) BV CEO (V) BV EBO (V) V CES (V) V BES (V) h FE 100 20 45 20 4 0.35 1 20I C =100A I C =100A I E =100A I C =10mA I B =1mA I C =10mA I B =1mA V CE =10V I C =3mA2115min2npn pnp3 0~10V4y --/5x/6XJ4810//""7V CES V BESXJ4810pnp npnV CE=0.3V I C=1mA81--2 3DG6h FEh FE BV CBO BV CEO BV EBO V CES V BES93AX31B h FE BV CBO BV CEO BV EBO I CBO I CEO I EBO[1] XJ4810"""""FET "JFET MISFET --MOS MOSFETMOSp n JFET p n MOSFET FET XJ4810XJ48101.XJ4810//B-E G.S 1kS E G B D CMOSMOS MOSE2.1I DS V DS 2-1II DS V DS V GS 0 0.5V 2-2MOS SiO 22-22-1n MOSFET 2-2n MOSFET2I DSSV GS =0V DS V GS = 03(g m )CV GSDSm DS V I g1V S 1S=1A/V """-1"4V P V TV P V DS50AV T V DSMOS5BV DSV GS I DS BV DSV GS BV DS V GS=0BV DS 6BV GSp--n BV EBO MOSSi02XJ4810MOS BV GSXJ4810n MOSFET3D01n JFET3DJ61. n MOS3D0112-3E0~50V+1kX2V/Y0.2mA/-0.2mA/E-B1k0.2V/2-1V GS0V GS0I DSS V GS=0V V DS=10VV GS=0x V DS=10VY I DSS""V GS=0 V DS=10V I DSSE B ""I DSSg m V GS =0V V DS =10Vg m g m I DS =I DSS g m 2-1V GS =0V DS =10VVV GSDS m DS V I g 10I DS 3mA V p I DS =10A V DS =10V-0.2V I DS =10A V DS =10V V P I DS =10A YBV DS0~200V x 5V/10V/x BV DS2 200 xXJ4810V DS =10V 10V x 2V/V GS =010V X ""2-4V GS 0V GS =10VV GS =0I DSS g m I DS =10A V GS V P Y 0.01mA/V PY 0.5mA/2-42-3 n MOS2-4 n MOSS D2n3DJ6MOS1MOS2-50.5mA/0.6V2BV GSp--nBV EBOMOS2-5 n3p MOS3CO13D01XJ48101--1mA/3D01I DSS g m V T BV DS I DSS3D0121mA/3D013D013CO1MOSFET3DJ6MOSMOS1NPN L R B R -BB V +CC Vb V b ic i 212.BB V CEO I +CC Vtt0 t0 t1 t2 t3 t4 t5 0t+B V CES V CS I2B V 1B I CS I 2B I3C id t C i 0.1CS Ir t C i 0.1CS I 0.9CS I s t C i 0.9CS If t C i 0.9CS I 0.1CS Id t +r t on t s t +f t off t""nb b t b Qi d dQ 1 b Q n-BB V JO V 0.5V CC V +BB V CC V -JO V 1B I0 tt31)1.0ln()7.1(][)1()0(][)1()0(11111111)1()1()1()1(CSB DC B DC TC l r DC n n cB TODEn n cB TEDEdI I I C R DCJO CC DCBB CC n I C V DEJO DEBB n I C Vt V V V V V V V V V V CCee(2)DE V DC V c n e n 1/21/3r t JO V F V 0.7V)9.01.0ln()7.11(11CSB DC CSB DC TC L rDC r I I I I C R t 3)9.0ln()7.11()ln(22221CSB DC CS B DC TC L T DC CS B DC B DC B DC s s I I I I C R I I I I t 4s ,C W >PC L s PC C W PC L s CW 2/2pc L PC pc L)1.09.0ln()7.11(22CSB DC CSB DC TC L rDC f I I I I C R t 5[1]TE C TC C T f DC1B I 2B I CS I4BJ2961""""""""""51B I 2B I""A B""A B ""1423DG1231B I 2B I 3C I4BJ29613DK4B I =10MA C I =100MA141 4232BJ29611 52 """"""3 "-"NPN """+"s t f t off t4 56 ""B I B I ""C I C I7 """"""6(a)(b)(a)NPN s t f t off t PNP d t r t on t 6(b)NPN d t r t on t PNP s t f t off t89 """" 10 """"12 d t r ton t s t f t off t31233DG123DK4[1] p.239,1980.[2] p.120,1979.[3] p.708,1983.t f ||1t f t f ""t f t f CE V E I=bb j jm /1)/exp(0(1)||=2/120])/(1[f f (2)=]/)/([m arctg (3)f <<f 0 f =f ||=0/2, ||3dBf >>f ||f =0f ||=1T f T f =||f =0f(4)a f <500MHz T f a f /(1+m)T f =a f (26.4)f <<f <a fT f ""||f f ||||~f (-6dB)/1|||| =1T f f <<f <<a f ||26.1T f T f1:)2//(221Tc cs mc b b Te e T C r l v D W C r f=)(2e d b e (5)T f T f 2aCE V T f E I 2b E I T f CE V-100 30 20 10 40-6dB/e kT/q E I (5)2a2(b)1T f =)1.(2e d b Te EC I q kT (6) E I <CM I b ,d ,c E I T f E I 1/T f 1/E I Te C b +d +cT f 26.3f <<f <a f=C=CT f """"||""T f T f ""||T f ||3T f 3""T f T f ||f T f :QG-25400MHz 400~4000MHz QG 1610MHz 30MHz 100MHz 100~1000MHz T f f <<f <a f1.CE V ,E I T f2. CE V E I T f ~E I3. E I CE V T f ~CE V4.pF5.Te C ,b +d +c6.1~4 .1.2.T f3.12 34.T f 5CE V .T f ~E I 6. E I T f ~CE V7.pF 4,5,6 8.""9.4,5,6,71.4,5,6,7,9||2.T f ~CE V ,T f ~E I 1/T f ~1/E I3.1/T f ~1/E I Te C ,b +d +c4.5,6,71.2.3.f =3f f =5f T f4.T f。