电离总剂量效应对浮栅型Flash存储器擦写耐久与数据保持特性的影响研究
- 格式:pdf
- 大小:1.81 MB
- 文档页数:7

90nm浮栅型P-FLASH器件总剂量电离辐射效应研究朱少立;汤偲愉;刘国柱;曹立超;洪根深;吴建伟;郑若成【摘要】研究了基于90 nm eFLASH工艺制备的浮栅型P-Channel FLASH单元的总剂量电离辐射效应,主要研究了FLASH单元随总剂量增加的变化规律及鳊程/擦除时间对FLASH单元抗总剂量能力的影响.研究表明:随着总剂量的增加,浮栅型P-FLASH器件“开”态驱动能力(Idsat)、“关”态漏电(Ioff)及跨导(gm)未发生明显退化,但“擦除/编程”态的阈值窗口明显减小,且呈现“鳊程”态阈值电压(TP)下降幅度较“擦除”态(VTE)快的特征;编程/擦除时间的增加会导致FLASH单元阈值电压漂移量,对鳊程态FLASH单元,鳊程时间的增大导致阈值电压漂移量增大,而对于擦除态器件FLASH单元,擦除时间的增加导致阈值电压漂移量减小.综上所述,总剂量的增加仅引起浮栅型P-FLASH单元阈值电压的漂移,即浮栅内电荷的转移;编程/擦除时间的增加导致FLASH单元阈值电压漂移量的差异,主要是由于编程/擦除应力时间的增加导致隧道氧化层及界面处陷阱电荷的引入所引起的.【期刊名称】《电子与封装》【年(卷),期】2018(018)008【总页数】6页(P36-40,43)【关键词】浮栅型P-FLASH;总剂量电离效应;编程/擦除时间;阈值电压漂移【作者】朱少立;汤偲愉;刘国柱;曹立超;洪根深;吴建伟;郑若成【作者单位】中国电子科技集团公司第五十八研究所,江苏无锡214035;中国电子科技集团公司第五十八研究所,江苏无锡214035;中国电子科技集团公司第五十八研究所,江苏无锡214035;中国电子科技集团公司第五十八研究所,江苏无锡214035;中国电子科技集团公司第五十八研究所,江苏无锡214035;中国电子科技集团公司第五十八研究所,江苏无锡214035;中国电子科技集团公司第五十八研究所,江苏无锡214035【正文语种】中文【中图分类】TN3061 引言非易失性存储器特别是FLASH存储器具有高速度、大容量、低功耗以及高可靠性等特点,目前,FLASH存储器已经逐步应用于卫星遥感、航天探测等对可靠性要求十分严格的辐照空间应用中[1]。

自然空间环境中总剂量电离辐射引起的MOS器件性能衰降K.F.Galloway;R.D.Schrimpf;黄益全
【期刊名称】《微电子学》
【年(卷),期】1991(21)1
【摘要】本文详细地综述了自然空间环境中总剂量电离辐照引起的MOS器件性能衰降;MOS介质经受电离辐射期间产生的界面和氧化物电荷使得大量器件电特性发生变化;所观察到的辐射影响包括MOSFET的阈值电压漂移、沟道迁移降低、驱动性能损失和漏泄电流增大;在自然空间环境中,当总剂量以非常低的剂量率积累时,界面和氧化物俘获电荷之间可以综合折衷。
【总页数】7页(P46-52)
【关键词】MOS器件;电离辐照;性能衰降;MOSFET
【作者】K.F.Galloway;R.D.Schrimpf;黄益全
【作者单位】亚利桑那大学电气与计算机工程系
【正文语种】中文
【中图分类】TN386.1
【相关文献】
1.12位LC2MOS工艺数模转换器总剂量电离辐射效应 [J], 王信;陆妩;郭旗;吴雪;席善斌;邓伟;崔江维;张晋新
2.剂量率对MOS器件总剂量辐射性能的影响 [J], 朱小锋;周开明;徐曦
3.90nm浮栅型P-FLASH器件总剂量电离辐射效应研究 [J], 朱少立;汤偲愉;刘国
柱;曹立超;洪根深;吴建伟;郑若成
4.高压SOIp LDMOS器件电离辐射总剂量效应研究 [J], 马阔;乔明;周锌;王卓
5.总剂量辐射对硅双极和MOS器件性能的影响 [J], 蔡俊;傅义珠
因版权原因,仅展示原文概要,查看原文内容请购买。

第27卷 第1期2006年1月半 导 体 学 报CHIN ESE J OURNAL OF SEMICONDUCTORSVol.27 No.1J an.,2006通信作者.Email :baopinghe @ 2005208214收到,2005209225定稿ν2006中国电子学会大规模集成电路浮栅ROM 器件总剂量辐射效应何宝平1,2, 周荷琴1 郭红霞2 周 辉2 罗尹虹2 姚志斌2 张凤祁2(1中国科学技术大学,合肥 230026)(2西北核技术研究所,西安 710024)摘要:提出了一种大规模集成电路总剂量效应测试方法:在监测器件和电路功能参数的同时,监测器件功耗电流的变化情况,分析数据错误和器件功耗电流与辐射总剂量的关系.根据该方法利用60Co γ射线进行了浮栅ROM 集成电路(A T29C256)总剂量辐照实验,研究了功耗电流和出错数量在不同γ射线剂量率辐照下的总剂量效应,以及参数失效与功能失效时间随辐射剂量率的变化关系,并利用外推实验技术预估了电路在空间低剂量率环境下的失效时间.关键词:大规模集成电路;总剂量效应;低剂量率;失效时间PACC :6180E ;7340Q EEACC :2560R 中图分类号:TN38611 文献标识码:A 文章编号:025324177(2006)01201212051 引言目前我国航天器上已经大量使用大规模集成电路,然而,空间辐射环境中的带电粒子和电子产生的电离总剂量效应会导致大规模集成电路功能异常,严重影响航天器的可靠性及在轨寿命.近年来,大规模集成电路的总剂量辐射效应一直是国外辐射效应研究领域的热点[1,2],国内在小规模电路的效应机理、实验测量以及模拟方法等方面取得了一定的成绩[3~6].我们以往的总剂量效应研究都是针对中小规模集成电路,特别是门电路,大规模集成电路(存储器和CPU 等)的总剂量效应如何测试,抗总剂量水平如何评价,这些都是需要解决的问题.国外尚无统一规范的实验方法,目前国内对于大规模集成电路的总剂量效应研究尚处于探索阶段.大规模集成电路浮栅ROM 器件(主要是FL ASH ROM 和EEPROM )在单一的工作电压下,就可以完成读出、擦除和写入功能,克服了原有只读存储器(ROM )的不足;而且和静态随机存取存储器(SRAM )相比,其存储的数据是非挥发性的,即使掉电,也不会丢失数据.因此,浮栅ROM 集成电路已被广泛应用于包括航天器在内的各领域的电子系统中,开展浮栅ROM 集成电路的总剂量辐射效应研究具有重大的现实意义和应用价值.本文给出了初步的大规模集成电路总剂量效应的测试方法,并利用该方法对大规模集成电路浮栅ROM 器件总剂量辐射效应进行了研究.2 总剂量效应测试方法总剂量效应一个重要的敏感参数就是阈值电压,对于门电路、反相器等中小规模集成电路,主要测试其阈值电压随辐照剂量的变化.对于单个晶体管,可以得到氧化物陷阱导致的阈值电压漂移量和界面陷阱电荷导致的阈值电压漂移量.然而,对于由成千上万只nMOS 和pMOS 晶体管组成的大规模集成电路,仅有几十个管脚,目前尚无有效的方法来测量某个晶体管的阈值电压.因此,适用于小规模集成电路的总剂量效应测试方法无法应用于大规模集成电路.如果许多nMOS 晶体管的准静态电流增大,就会导致器件的功耗电流增大.随辐射电离总剂量的继续增加,阈值电压漂移越来越大,原本应该截止的晶体管导通(或相反)时,器件会出现逻辑功能错误,引起数据错误或运算错误.浮栅ROM 集成电路的集成度高,采用传统的方法测量内部某个晶体管的敏感参数(如阈值电压)不太容易,因此我们提出初步的总剂量效应测试方法:在线监测器件和电路功能参数的同时,监测器件功耗电流的变化情况.器件在进行辐照前,每个字节写入数据,在辐照过程中循环读取存储单元中的数据,与辐照前作比较,记录出错单元,统计出错类型和数量,同时监测器件功耗电流的变化情况,分析数据错误和器件功耗电流与辐射总剂量效应的变化关半 导 体 学 报第27卷系.3 辐射实验辐照实验是在西北核技术研究所的4000居里Co260γ源上进行,辐照温度为室温,利用UN IDOS 剂量仪标定的辐照剂量率有:50rad(Si)/s,16156rad (Si)/s,2193rad(Si)/s,0126rad(Si)/s四种.实验电路为浮栅ROM集成电路A T29C256,分两类:一类为A T29C256(9911),另一类为A T29C256(9939).辐照前每个字节写入数据“55H”,即:“0”与“1”相互间隔.在加电(+5V)状态下辐照,用存储器辐照效应测试系统和电流测试系统动态连续、实时监测被测电路的功能和功耗电流的大小,实时读取数据,统计出错单元的数量和功耗电流值,辐照结束后,继续室温在线监测半小时.4 实验结果4.1 总剂量辐射效应我们根据以往的研究了解到,受辐射的非加固CMOS器件,能够在栅氧化层中诱导产生氧化物陷阱电荷累积,这种累积的电荷能够引起CMOS晶体管阈值电压发生漂移.但是,辐射同样也会在场氧化层中发生氧化物陷阱电荷的积累,这样的电荷积累导致器件漏电情况增加.因此,对于许多非加固的集成电路来讲,功耗电流是一个敏感的辐射损伤参数.实验中,我们把功耗电流作为浮栅ROM集成电路一个辐射敏感参数,来研究其总剂量辐射效应.同时,利用存储器测试系统实时、在线监测集成电路出错数量与辐照剂量的变化,研究电路功能与辐照剂量的关系.图1,2分别给出了浮栅ROM集成电路A T29C256在不同剂量率辐照下,功耗电流和出错数量随时间的变化关系.因为集成电路辐照后第一个测量点的功耗电流与辐照前相比,基本没发生什么变化,它可以反映电路辐照前的电流情况,故图1中没有给出辐照前的数据点.图2给出的是辐照后翻转数与时间的变化关系,因为辐照前电路的翻转数为零.从图1,2中可以看出,剂量积累到一定程度,功耗电流逐渐增大,当电流增大到一定值时,出现数据错误.电路出现数据错误有个累积剂量阈值,当累积剂量小于某一个值时,无数据错误.当累积剂量达到一定值时,开始出现数据错误.随着累积剂量的增加,错误数量迅速增加.功耗电流和出错数量都随着辐照时间的增加而逐渐增加.这主要是因为γ辐射在浮栅及其周围的绝缘层内电离产生电子空穴对.图1 不同剂量率辐照下,功耗电流随辐照时间的变化Fig.1 At radiation of different dose rates,A T29C256 supply current versus time电子空穴在电场的作用下漂移,在界面处形成界面陷阱电荷,使晶体管的阈值电压向负方向漂移.当界面陷阱电荷积累到一定程度,使原来截止的晶体管导通,存储单元的状态发生变化,出现数据错误.由于界面陷阱电荷的积累需要一定的剂量积累,因此,错误的发生存在累积剂量阈值.随着γ累积剂量的增加,阈值电压漂移的晶体管数目增加,错误数量增加.刚开始出错时的错误单元和数据,错误数量及错误地址都不确定,即在某一时刻错误多,而在下一时刻,错误反而少了;某一单元在这一时刻出错,而在下一时刻却是正确的,出现不确定错误.这是由于阈值电压漂移量不大时,晶体管处于截止和导通的临界状态,没有使存储单元由一种状态彻底变为相反状态.在存储单元状态彻底改变之前的一段时间内,其状态是不确定的.实验中发现A T29C256器件的数据错误全是由“0”变成“1”,这时候对应的浮栅晶体管由截止变为导通,导致功耗电流增大.这种由“0”变成“1”的现221第1期何宝平等: 大规模集成电路浮栅ROM器件总剂量辐射效应图2 不同剂量率辐照下,错误数量随辐照时间的变化Fig.2 At radiation of different dose rates,A T29C256 error number versus time象随辐照时间的增加而增加,所以功耗电流随辐照时间的增加而增加.为了研究浮栅ROM器件29C256辐照后高温退火特性,我们将剂量率(50rad(Si)/s)辐照失效的浮栅ROM29C256器件置于70℃和100℃环境中进行高温退火,实验结果如图3所示.比较图2和图3,一方面可以看出,图2中50rad(Si)/s辐照结束时,器件出错数约为104位,而在70℃和100℃环境中开始退火时的出错数约为103位,这主要是因为器件在室温放置1h后出现退火恢复效应所致.另一方面可以看出,室温25℃环境下,器件出错数随退火时间的增加而减少,表现出明显的恢复效应,而100℃环境下出错数恢复比70℃要快,并且出错数开始随着退火时间的增加而增加,退火1000s后,出错数随退火时间的增加而开始减少,对于这种高温退火异常的详细解释,有待于进一步深入研究.4.2 空间低剂量率效应预估实验室条件下研究浮栅ROM集成电路图3 不同温度下,A T29C256出错数量随退火时间的变化Fig.3 At70℃and100℃,A T29C256error number versus anneal timeA T29C256不同剂量率下的辐射响应,目的是确定电路在剂量率降低的辐射响应趋向.本文介绍了一种利用实验室高剂量率辐射实验数据来外推空间低剂量率的辐射响应方法.该方法的主要思想是:根据定义的失效判据,将每一种剂量率辐射结果外推到失效定义值,可以得到不同剂量率辐射下的失效时间.然后将失效时间拟合成剂量率的函数,进而可以预估空间低剂量率的失效时间.在本研究中,我们定义浮栅ROM集成电路(A T29C256)失效判据:功耗电流超过100mA或者出错数超过10%为失效,也就是说,出错数超过25600为失效.图4(a),(b)分别给出了A T29C256(9911)集成电路不同剂量率辐照下,功耗电流和出错数的拟合、外推以及失效时间的提取过程.根据定义的失效判据,我们将从图4 (a)、(b)中提取的在不同剂量率辐照下的失效时间进行拟合,得到如下方程:T=10(A lg D+B)(1)其中 T为失效时间;D为辐照剂量率rad(Si)/s, A,B为常数.表1给出了拟合A T29C256(9911)和A T29C256(9939)实验数据,满足方程(1)的A,B 常数.表1 A T29C256(9911)和A T29C256(9939)满足方程(1)的常数A,BTable1 Constant A and B of equation(1)forA T29C256(9911)and A T29C256(9939)器件类型A T29C256(9911)A T29C256(9939)A B A B按功耗电流拟合-0.967 4.643-1.620 5.486按出错数量拟合-0.970 4.297-1.791 5.276利用方程(1)和表1中的数据,我们给出了浮栅ROM集成电路A T29C256失效时间随辐照剂量率的关系,见图5.对于典型的10-3rad(Si)/s空间剂321半 导 体 学 报第27卷图4 不同剂量率辐照下,实验数据的拟合和外推结果 (a)功耗电流;(b)出错数量Fig.4 Under different dose rate irradiation,fitting and extrapolation of experimental data量率环境,A T29C256(9911)电路按照功耗电流数据预估电路的失效时间约为314×107s,按照出错数预估电路的失效时间约为210×107s;A T29C256 (9939)电路按照功耗电流数据预估电路的失效时间约为212×1010s,按照出错数预估电路的失效时间约为414×1010s.5 结束语上述研究表明,对于大规模集成电路浮栅ROM器件,采取在监测器件和电路功能参数的同时监测器件功耗电流变化这一方法是可行的,有利于分析大规模集成电路总剂量效应.而且在我们并不详细了解其辐射损伤机理的情况下,在实验室条件下根据不同剂量率辐射的功耗电流和出错数量,利用外推技术可以预估集成电路在空间低剂量率的辐射效应.图5 A T29C256集成电路失效时间随辐射剂量率的变化Fig.5 Time to failure versus dose rate for A T29C256参考文献[1] Nguyen D N,Guertin S M,Swift G M,et al.Radiationeffect s on advanced flash memories.IEEE Trans Nucl Sci,1999,46(6):1744[2] Lelis A J,Murrill S R,Oldham T R,et al.Radiation responseof advanced commercial SRAMs.IEEE Trans Nucl Sci,1996,43(6):3103[3] Yao Yujuan,Zhang Zhengxuan,Jiang Jinghe,et al.Bias an2nealing of radiation induced positive trapped charges in metaloxide semiconductor transistor.Chinese Journal of Semicon2ductors,2000,21(4):378(in Chinese)[姚育娟,张正选,姜景和,等.MOS晶体管中辐照引起的陷阱正电荷的强压退火.半导体学报,2000,21(4):378][4] He Baoping,G ong Jiancheng,Wang Guizhen,et al.Isot hermaland isochronal annealing characteristics in irradiated MOS de2vices.Chinese Journal of Semiconductors,2004,25(3):302(inChinese)[何宝平,龚建成,王桂珍,等.CMOS器件的等时、等温退火效应.半导体学报,2004,25(3):302][5] He Baoping,Yao Yujuan,Peng Honglun,et al.Influence oftemperatures and radiation dose rate on CMOS device charac2teristic parameter.Chinese Journal of Semiconductors,2001,22(6):779(in Chinese)[何宝平,姚育娟,彭宏论,等.环境温421第1期何宝平等: 大规模集成电路浮栅ROM器件总剂量辐射效应度、电离辐射剂量率对NMOSFET器件特性参数的影响.半导体学报,2001,22(6):779][6] He Baoping,Wang Guizhen,Zhou Hui,et al.PredictingnMOS device radiation response at different dose rates inγ2rays environment.Acta Physica Sinica,2003,52(1):188(in Chinese)[何宝平,王桂珍,周辉,等.nMOS器件不同剂量率γ射线辐射响应的理论预估.物理学报,2003,52(1):188]Total Dose E ffect of Large2Scale Integrated Circuit Floating G ate ROM DevicesHe Baoping1,2, ,Zhou Heqin1,Guo Hongxia2,Zhou Hui2,L uo Y inhong2,Yao Zhibin2,and Zhang Fengqi2(1Universit y of Science and Technology of China,Hef ei 230026,China)(2N ort hwest I nstit ute of N uclear Technology,X i’an 710613,China)Abstract:A method for testing total dose effects is presented for VL SI.The consumption current of the device is measured. Meanwhile,the f unction parameters of the device and circuit are also measured.The relations between data errors,consumption current and total radiation dose are analyzed.Ionizing radiation experiments are performed on floating gate ROM devices by u2 sing60Coγ2rays as prescribed by this test method.The experimental aim is to examine the radiation response at various dose rates.The parameters and function failure of the devices as f unction of dose rate are studied.By extrapolation,we predict the failure time of a floating gate ROM device in a space radiation environment.K ey w ords:very large scale integrated circuits;total dose effect;low dose rate;failure timePACC:6180E;7340Q EEACC:2560RArticle ID:025324177(2006)0120121205Corresponding aut hor.Email:baopinghe@ Received14August2005,revised manuscript received25September2005ν2006Chinese Institute of Electronics521。

摘要摘要随着空间技术、核科学和微纳电子技术的不断发展, 越来越多的电子器件被广泛应用于航空、航天及战略武器系统中,遭受着恶劣辐射环境的严重考验。
辐射环境中的高能粒子和射线射入半导体器件的氧化区,造成电离损伤,产生氧化层陷阱电荷,从而诱发总剂量(Total Ionizing Dose,TID)效应。
新工艺技术的出现,如绝缘体上硅(SOI)和高k介质层,使得TID成为引起微电子器件性能退化甚至功能失效最主要的辐射效应。
本文以高k栅全耗尽SOI(Fully Depleted SOI,FD-SOI)MOSFET和环栅纳米线晶体管(Gate All-Around Nanowire Transistor,GAA-NWT)研究对象,对其总剂量效应以及相应的加固技术进行了深入系统的研究,主要工作及研究结果如下。
一、提出了一种线性能量转移(Linear Energy Transfer,LET)的高斯—对数模型,推导了辐射场中材料吸收剂量的计算表达式,并基于此对高k材料的辐射敏感性进行了分析。
基于对大量LET试验数据的分析,通过对对数变换后的LET数据进行高斯函数拟合,得出了计算任意粒子在硅中LET的简化表达式,并在此基础上计算了粒子在硅中射程及Bragg峰值,其计算结果与实验数据吻合较好。
提出一种利用LET表达式计算任意初始能量下粒子在硅中Bragg曲线的简化方法,通过使用粒子剩余能量建立起粒子入射深度与LET之间的数学关系,不仅极大地减少了计算耗时,而且与TRIM计算结果吻合度较高。
推导了单向平行辐射场和一般辐射场中材料吸收剂量的计算表达式,建立起粒子通量与吸收剂量之间的数学关系,并在此基础上,计算了HfO2与SiO2在相同辐射环境中的吸收剂量之比,定量分析了HfO2对总剂量辐射的敏感性。
二、对浮体FD-SOI器件的总剂量(Total Ionizing Dose,TID)效应进行了TCAD 仿真,并详细分析了浮体FD-SOI器件TID效应的影响因素。

0引言空间环境中存在的一些高能粒子(包括质子、中子、重离子和α粒子等)会对航天航空系统中半导体器件造成辐射损伤,威胁着航天器的安全。
空间辐射效应主要分为三类:总剂量效应、位移损伤效应和单粒子效应。
当单个高能粒子入射到半导体器件中,与器件的灵敏区域相互作用产生的电子-空穴对被器件收集所引发的器件功能异常或者器件损坏就是单粒子效应,包括单粒子翻转、单粒子闭锁、单粒子功能中断和单粒子瞬态等。
随着半导体器件的特征尺寸不断缩小,单粒子效应越来越显著,并已经成为影响宇航电子系统正常工作的主要因素。
Flash 存储器的基本单元是基于浮栅工艺的MOS管,它有两个栅:一个控制栅和一个位于沟道和控制栅之间的浮栅。
按照Flash 内部架构以及技术实现特点,可以将其分为NOR 型和NAND 型。
NOR Flash 各单元间是并联的,它传输效率高,读取速度快,具有片上执行功能,作为重要的程序和FPGA 位流存储器,大量应用于各型号航天系统。
NAND 型Flash 各存储单元间是串联的,它比NOR 架构有更高的位密度,每位的成本更低。
NAND Flash 的非易失性、低功耗、低成本、低重量等特性也使其在航天系统中得到了应用。
故对Flash 存储器的单粒子效应评价至关重要。
地面高能粒子模拟实验是目前单粒子效应研究中最常用的实验方法,它能较好地反映器件的辐射特性,常用的地面模拟源有粒子加速器提供的重离子束或质子束、252Cf 裂片模拟源、14MeV 中子源等,本文讨论的内容都是针对重离子辐照实验开展的。
目前国内单粒子效应试验均依据QJ10005标准开展,但标准中没有给出具体效应的测试方法,传统测试方法中缺失了对器件存储区与外围电路的效应区分和不同影响考虑,故本文对国内外Flash 存储器单粒子效应实验中常见效应及其测试区分方法进行综述,总结分析测试流程,为相关测试实验研究提供参考。
∗基金项目:装备领域预研基金(41402040301);军用电子元器件科研项目(1905WK0014)Flash 存储器单粒子效应测试研究综述∗黄姣英,王乐群,高成(北京航空航天大学,北京100191)摘要:随着Flash 存储器在航天系统中的大量应用,其单粒子效应评价至关重要。

目录一、辐射环境 (2)1.1 范艾伦辐射带 (2)1.1.1 内辐射带(Inner Belt) (3)1.1.2 外辐射带(Outer Belt) (3)1.2 宇宙线辐射环境 (3)1.2.1 银河宇宙线 (3)1.2.2 太阳宇宙线 (3)1.3 核爆辐射环境 (4)1.4 存在电离总剂量辐射的环境 (4)二、总剂量辐射损伤的产生机理 (4)三、电离总剂量辐射对器件的影响 (6)3.1 总剂量辐射对 NMOS 晶体管关态漏电流的影响 (6)3.2 总剂量辐射对 VDMOS 晶体管 1/f 噪声的影响 (7)3.3 总剂量辐射对 SRAM 静态功耗电流的影响 (8)3.4 总剂量辐射对 SRAM 功能的影响 (9)四、针对辐射损伤所采取的辐射加固方法 (9)4.1 环形栅结构 (10)4.2 H 形栅结构 (13)4.3 P+保护环 (15)4.4 厚场氧旁附加薄场氧层 (16)电离总剂量辐射效应及加固方法解析起草人:丛忠超一、辐射环境辐射环境主要包括空间自然辐射环境和人造辐射环境两种。
其中,空间辐射环境又可以分为范.艾伦辐射带和宇宙射线两种,而人造辐射环境主要是指核武器爆炸和地面辐射模拟源两种。
下面针对上述辐射环境进行详细介绍。
1.1 范艾伦辐射带所谓地球辐射带就是指那些存在于地球周围的高能粒子集中的区域,一般存在于近层宇宙空间中,即距离地球 100 公里到几百公里的空间。
它是由美国科学家詹姆斯·范艾伦于1958年根据美国第一颗卫星的空间粒子探测得出结果推测发现的,因此被称为范·艾伦辐射带。
范.艾伦辐射带是由地磁场俘获高达几兆电子伏的电子以及高达几百兆电子伏的质子组成,其中只有很少百分比像O+这样的重粒子,其分布结构图如 2.1 所示。
由图可知,高能质子与高能电子主要分布在两个对称的集中区域,在赤道附近呈环状绕着地球,并向极地弯曲,这两个区域分别被称为内辐射带和外辐射带,简称内带与外带,其中距离地球较近的称为内带,距离地球较远的称为外带,它们共同组成了范艾伦辐射带,下面将分别介绍内带与外带。



《半导体器件电离辐射总剂量效应》读书记录目录一、内容概览 (2)1.1 背景介绍 (3)1.2 研究目的与意义 (4)二、半导体器件电离辐射总剂量效应的基本概念 (5)2.1 半导体器件的电离辐射效应 (6)2.2 总剂量效应的定义与分类 (7)2.3 电离辐射对半导体器件的影响机制 (8)三、半导体器件电离辐射总剂量效应的理论基础 (9)3.1 半导体物理基础 (10)3.2 电离辐射与物质相互作用的理论 (12)3.3 总剂量效应的计算方法 (13)四、半导体器件电离辐射总剂量效应的应用 (14)4.1 在集成电路上的应用 (16)4.2 在薄膜器件上的应用 (17)4.3 在光电探测器上的应用 (19)五、实验方法与结果分析 (20)5.1 实验设备与材料 (22)5.2 实验方法与步骤 (23)5.3 实验结果与讨论 (25)六、半导体器件电离辐射总剂量效应的挑战与展望 (26)6.1 研究中的挑战 (27)6.2 未来研究方向与应用前景 (29)七、结论 (30)7.1 主要研究成果与发现 (31)7.2 对半导体器件发展的意义与影响 (33)一、内容概览本书主要围绕半导体器件的电离辐射效应展开,详细介绍了从辐射对半导体器件的直接影响到长期性能退化的整个过程。
从辐射对半导体器件的直接效应开始讲起,包括电离辐射引起的晶格损伤、点缺陷和电离缺陷的形成与复合等。
这部分内容为理解辐射对半导体器件的影响提供了基础。
本书深入探讨了半导体器件在电离辐射下的长期性能变化,特别是通过实验和模拟手段,揭示了辐射诱导的阈值电压变化、漏电流增加和击穿电压降低等现象的物理机制,并讨论了这些现象对器件性能和稳定性的影响。
书中还涉及了辐射对半导体器件制备工艺的影响,如掺杂分布的演变、表面态的改变以及氧化层质量的下降等问题。
还分析了辐射对集成电路可靠性的影响,包括软错误率上升、单粒子效应和总剂量效应等。
本书总结了半导体器件电离辐射效应的研究现状和发展趋势,指出了未来研究方向和应用前景。
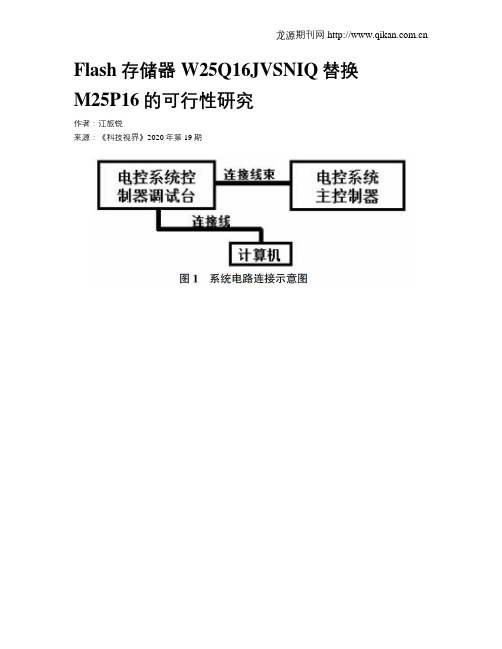
Flash存储器W25Q16JVSNIQ替换M25P16的可行性研究作者:江旅锐来源:《科技视界》2020年第19期摘要在工程机械电控系统开发过程中,由于原用Flash存储器M25P16停产,对电控系统存储功能的开发带来了消极的影响。
本文通过实验,对Flash存储器W25Q16JVSNIQ与M25P16的存储功能性能进行对比测试,研究Flash存储器W25Q16JVSNIQ是否可以替代M25P16进行使用。
关键词Flash存储器;W25Q16JVSNIQ;M25P16;可行性中图分类号: TG44 ; ; ; ; ; ;文献标识码: ADOI:10.19694/ki.issn2095-2457.2020.19.0630 引言Flash存储器W25Q16JVSNIQ为空间有限的系统提供了存储解决方案,25Q系列提供的灵活性和性能远远超过普通的串行闪存设备。
随着Flash存储器M25P16的停产,W25Q16JVSNIQ的使用价值得到越来越多的重视,且二者的封装完全相同,因此,在替换方案的便利性上具备一定的优势。
但行业内对使用Flash存储器W25Q16JVSNIQ替换M25P16的可行性缺乏研究,本课题的研究,为使用Flash存储器W25Q16JVSNIQ替换M25P16的可行性提供必要的数据支撑,具有重要的理论意义和工程应用价值。
1 实验方法通过焊接手段将Flash存储器安装在电控系统主控制器电路板上,主要针对Flash存储器W25Q16JVSNIQ和M25P16的擦除数据(包括全片擦除和Sector擦除)、写数据和读数据等基本功能性能进行对比测试,各项操作指令均由控制器发出。
系统电路连接示意图如图1,实验环境温度为23.6℃,湿度为90.1%,测试流程如图2。
本文针对Flash存储器W25Q16JVSNIQ和M25P16的基本存储功能性能进行试验,为减少误差,提高试验的准确性,先对M25P16进行测试,每次试验进行3次,然后取3次试验结果的平均值,完成测试后,将M25P16替换为W25Q16JVSNIQ,按照相同的测试过程、测试要求进行测试。

辐射效应中的总剂量效应和单粒⼦效应
总剂量效应 TID
γ光⼦或⾼能离⼦在集成电路的材料中电离产⽣电⼦空⽳对. 电⼦空⽳随即发⽣复合、扩散和漂
移,最终在氧化层中形成氧化物陷阱电荷或者在氧化层与半导体材料的界⾯处形成界⾯陷阱电荷,使
器件的性能降低甚⾄失效. γ光⼦或⾼能离⼦在单位质量的材料中电离沉积的能量称作剂量,单位rad
或Gy.随着剂量的增加,器件性能逐渐降低;当剂量积累到⼀定程度时, 器件功能失效. 因此, 这种现象
称为电离总剂量效应。
对⼀个元器件来讲,有三个参数决定了元器件所受辐射的类型及强度:
1,粒⼦辐射积分通量单位为粒⼦/平⽅厘⽶。
2,剂量率,它表明了单位时间内材料从⾼能辐射环境中吸收的能量,其单位为拉德/秒(rad/s)
3,总剂量,它是材料从⾼能环境中吸收的能量,单位为拉德(硅)(rad/(Si)).
单粒⼦效应
Single event effect,⼜称单事件效应。
⾼能带电粒⼦在器件的灵敏区内产⽣⼤量带电粒⼦的现象。
它属于电离效应。
当能量⾜够⼤的粒⼦射⼊集成电路时,由于电离效应(包括次级粒⼦的),产⽣数量极多的电离空⽳⼀电⼦对,引起半导体器件的软错误,使逻辑器件和存储器产⽣单粒⼦翻转,CMOS器件产⽣单粒⼦闭锁,甚⾄出现单粒⼦永久损伤的现象。
集成度的提⾼、特征尺⼨降低、临界电荷和有效LED阈值下降等会使执单粒⼦扰动能⼒降低。
器件的抗单粒⼦翻转能⼒明显与版图设计、⼯艺条件等因素有关。
SEE 单粒⼦效应
SEL 单事件/粒⼦闭锁 Single Event Latch-up
SEU 单事件/粒⼦翻转 Single Event Upset。

目录一、辐射环境 (2)1.1 范艾伦辐射带 (2)1.1.1 内辐射带(Inner Belt) (3)1.1.2 外辐射带(Outer Belt) (3)1.2 宇宙线辐射环境 (3)1.2.1 银河宇宙线 (3)1.2.2 太阳宇宙线 (3)1.3 核爆辐射环境 (4)1.4 存在电离总剂量辐射的环境 (4)二、总剂量辐射损伤的产生机理 (4)三、电离总剂量辐射对器件的影响 (6)3.1 总剂量辐射对NMOS晶体管关态漏电流的影响 (6)3.2 总剂量辐射对VDMOS晶体管1/f噪声的影响 (7)3.3 总剂量辐射对SRAM静态功耗电流的影响 (8)3.4 总剂量辐射对SRAM功能的影响 (9)四、针对辐射损伤所采取的辐射加固方法 (9)4.1 环形栅结构 (10)4.2 H形栅结构 (13)4.3 P+保护环 (15)4.4 厚场氧旁附加薄场氧层 (16)电离总剂量辐射效应及加固方法解析起草人:丛忠超一、辐射环境辐射环境主要包括空间自然辐射环境和人造辐射环境两种。
其中,空间辐射环境又可以分为范.艾伦辐射带和宇宙射线两种,而人造辐射环境主要是指核武器爆炸和地面辐射模拟源两种。
下面针对上述辐射环境进行详细介绍。
1.1 范艾伦辐射带所谓地球辐射带就是指那些存在于地球周围的高能粒子集中的区域,一般存在于近层宇宙空间中,即距离地球100公里到几百公里的空间。
它是由美国科学家詹姆斯·范艾伦于1958年根据美国第一颗卫星的空间粒子探测得出结果推测发现的,因此被称为范·艾伦辐射带。
范.艾伦辐射带是由地磁场俘获高达几兆电子伏的电子以及高达几百兆电子伏的质子组成,其中只有很少百分比像O+这样的重粒子,其分布结构图如2.1所示。
由图可知,高能质子与高能电子主要分布在两个对称的集中区域,在赤道附近呈环状绕着地球,并向极地弯曲,这两个区域分别被称为内辐射带和外辐射带,简称内带与外带,其中距离地球较近的称为内带,距离地球较远的称为外带,它们共同组成了范艾伦辐射带,下面将分别介绍内带与外带。

Vol. 35, No. 5航 天 器 环 境 工 程第 35 卷第 5 期468SPACECRAFT ENVIRONMENT ENGINEERING2018 年 10 月 E-mail: htqhjgc@ Tel: (010)68116407, 68116408, 68116544浮栅器件和普通NMOS器件总剂量效应对比研究董 艺,沈鸣杰,刘 岐(上海复旦微电子集团股份有限公司,上海 200433)摘要:为深入了解应用NOR Flash工艺的多种器件的总剂量特性,特别是浮栅器件的特殊总剂量效应,开展了浮栅器件和多种NMOS器件总剂量效应的对比试验。
基于器件级测试芯片,进行了多种剂量的总剂量试验和高温退火试验,分析了不同器件在总剂量辐照下的不同特性,所关注的特性包括器件的漏电流变化和阈值电压变化。
通过试验发现浮栅器件受总剂量辐照后会产生弱编程效应且该效应无法通过退火恢复。
这一研究成果为抗辐射Flash产品的抗总剂量加固设计提供了依据。
关键词:Flash工艺;浮栅器件;NMOS器件;总剂量效应;漏电流;阈值电压中图分类号:TN406; V416.5文献标志码:A文章编号:1673-1379(2018)05-0468-05 DOI: 10.12126/see.2018.05.011Comparison of total ionizing dose effect between floating gate device andNMOS deviceDONG Yi, SHEN Mingjie, LIU Qi(Shanghai Fudan Microelectronics Group Co. Ltd., Shanghai 200433, China)Abstract: The effects of the total ionizing dose (TID) on the floating gate devices and the NMOS devices are compared based on the NOR Flash technology in order to further study the TID characteristic of the devices in the NOR Flash process, especially for the floating gate devices. Based on a device level test chip, the TID test with different dosages and annealing at a high temperature are conducted to acquire the radiation characteristics of different devices. The focus is on the leakage current change and the threshold voltage drift. The TID-induced soft program effect is determined, which cannot be recovered by annealing. This result provides a reference for the TID radiation hardening design for the Flash designers.Key words: Flash technique; floating gate device; NMOS device; total ionizing dose effect; leakage current; threshold voltage收稿日期:2018-06-01;修回日期:2018-09-13基金项目:国家重大科技专项工程引用格式:董艺, 沈鸣杰, 刘岐. 浮栅器件和普通NMOS器件总剂量效应对比研究[J]. 航天器环境工程, 2018, 35(5): 468-472 DONG Y, SHEN M J, LIU Q. Comparison of total ionizing dose effect between floating gate device and NMOS device[J]. Spacecraft Environment Engineering, 2018, 35(5): 468-4720 引言卫星集成电路在空间环境中会受到电离辐射的影响,产生总剂量效应[1]。

物理学报第52 卷第9 期2003 年9 月100023290Π2003Π52 (09) Π2235204 V ol . 52 ,No . 9 ,S eptemper ,2003 ν2003 Chin. Phys. S oc .ACTA PHY SICA SINIC A浮栅ROM 器件辐射效应机理分析贺朝会耿斌杨海亮陈晓华李国政王燕萍( 西北核技术研究所, 西安710613)(2002 年9 月18 日收到;2002 年12 月24 日收到修改稿)分析了浮栅R OM 器件的辐射效应机理,合理地解释了实验中观察到的现象. 指出辐射产生的电子空穴对在器件中形成的氧化物陷阱电荷和界面陷阱电荷是导致存储单元及其外围电路出现错误的原因.浮栅R OM 器件的中子、质子和60 C oγ辐射效应都是总剂量效应.关键词: F LASH ROM , EEPR OM , 中子, 质子, 60 C o γ, 总剂量效应PACC : 6180 , 7340Q11 引言21 辐射效应简介新型浮栅R OM 器件( 主要是F LASH R OM 和EEPR OM) 在单一的工作电压下, 就可以完成读出、擦除和写入功能,克服了原有只读存储器( R OM) 的不足;而且和静态随机存取存储器( SR AM) 相比,其存储的数据是非挥发性的,即使掉电,也不会丢失数据.因此,浮栅ROM 器件已开始应用于航天器的电子系统中. 开展浮栅R OM 器件的辐射效应研究具有重大的现实意义和应用价值.国外开展了浮栅R OM 器件的重离子单粒子效中子辐照实验是在兰州大学14MeV 强流中子发生器上进行的. 中子注量率为( 211 —612 )×108 cm - 2 s - 1 , 对应的电离剂量率在0126 —0178rad ( Si) Πs 之间. 质子辐照实验是在中国科学院高能物理研究所35MeV 质子直线加速器上进行的. 用散射束进行辐照实验,散射质子能量为3119MeV. 平均质子注量率为915 ×106 cm - 2 s - 1 ,对应的电离剂量率在214 —311rad ( Si) Πs 之间.γ辐照实验是在西北核技术研究所的小60 C o 源上进行,γ剂量率为01354rad ( S i) / s.实验用器件为29C256 , 28C256 和28C641 实验状态分为3 种: 不加电、静态加电和动态监测. 不加电就是器件管脚悬空,贴在辐照板上;静态加电就是把器件插入辐照板的插座上,供给5V 电压,但在辐照过程中,不读取数据,不对器件进行任何操作. 辐照前每个字节写入数据“55 H”,即“0”与“1”相互间隔. 对于不加电和静态加电的器件, 辐照后读取数据,与辐照前做比较. 动态监测就是辐照过程中循环读取器件中的数据, 与辐照前做比较, 记录出错单元,统计出错类型和数量.实验现象可归纳为以下几点11 —14 : 1) 器件出现功能错误或数据错误都有个注量或剂量阈值,低于阈值时不会出现相应的错误. 2) 动态监测和静态加电的器件都出现数据错误,且不能用编程器重新写入数据. 然而不加电的器件在更高注量的质子或中子或者更高剂量的γ辐照下未出现错误. 3) 器件刚应 1 —3、总剂量和剂量率效应2 —6 , 未见关于浮栅R OM 器件的质子和中子辐射效应方面的报道.国内开展了一些辐射效应研究7 —10 ,但关于浮栅R OM 器件, 只有我们开展了中子和质子辐射效应实验11 —14,观察到浮栅R OM 器件的14MeV 中子和3119MeV 质子辐照效应不是以往所认为的单粒子效应,而是一种总剂量效应. 随后开展了浮栅R OM 器件的60 C o γ验证实验15 及x 射线辐照实验16 . 60 C o γ辐射下,浮栅R OM 器件的出错规律与3119MeV 质子和14MeV 中子辐照下完全一致, 验证了我们的设想:浮栅R OM 器件的3119MeV 质子和14MeV 中子辐照效应不是单粒子效应,而是质子和中子产生的次级带电粒子的累积剂量造成的总剂量效应. 已有的浮栅R OM 辐射损伤机理不能完全解释实验中观察到的现象,本文试图从半导体器件物理的角度分开始出错时 ,错误数及错误地址都是不确定的. 错误 数在某一时刻错误多 , 而在下一时刻 , 错误反而少 了 ;某一单元在这一时刻出错 ,而在下一时刻却是正 确的 ,出现不确定错误. 4) 对于动态监测的器件 ,在 辐照过程中 ,中断测量一定时间后重新测量 ,器件的 错误数完全未按中断前的变化趋势发展 ,出现数量 级差异. 即使停止辐照 ,错误数仍在增加 ,甚至有的 错误成量级地增加. 5) 退火效应 :对于质子辐照下的 静态加 电 和 动 态 测 量 的 器 件 , 在 室 温 下 加 电 退 火11215h 后 ,仍然不能重新编程 : 在 100 ℃下加电退火 44h20min 后 ,29C256 全部可以编程 ; 28C256 全部可以写入数据“55 H ”,但全部不能写入数据“AAH ”.图 2 EEPRO M 28C256 存储单元外围电路示意图31 浮栅 ROM 的结构及存储原理41 辐射效应机理分析浮栅 R OM 存储单元的基本结构如图 1 所示5 , 3 ,5 辐射可以通过以下 4 种机理 改变浮栅 ROM 存储单元中的数据.1) 辐射在沟道氧化层和浮栅周围的氧化层内产生电子空穴对 . 经过快复合过程存留下来的空穴漂 移到浮栅 ,复合掉浮栅上的部分电子 ,降低了阈值电 压 . 浮栅上的负电荷在氧化层中产生的电场也促使 空穴向浮栅漂移 ,电子向体硅或控制栅漂移 .2) 辐射产生的空穴在沟道氧化层中形成陷阱电荷 ,减小了浮栅 MOSFET 的阈值电压.3) 浮栅上的电子从电离辐射中获得的能量超过 氧化层势垒时 ,发射到控制栅或硅衬底 ,减少了浮栅 上的电子.不同于 SR AM. 它有两个栅 : 一个控制栅和一个位于 沟道和控制栅之间的浮栅. 沟道和浮栅之间的氧化 层很薄 ,电子可以通过 F 2N 隧道效应或热电子注入 机理在浮栅和源区或沟道之间传输. 根据浮栅的带 电状态 ,存储单元就成为耗尽型或增强型的晶体管. 对于控制栅上的一定电压 ,晶体管就处于截止或导 通状态 ,对应于存储信息“0”或“1”. 一般情况下 ,浮 栅 R OM 写入信息前 ,浮栅上无电子 ,晶体管导通 ,表 示存“1”. 写入信息的过程就是使电子注入浮栅 ,晶 体管截止 ,表示存“0”. EE PR OM 存储单元外围有锁 存器 、译码器 、缓冲器 、时钟 、锁存控制和逻辑控制等 控制电路 (见图 2) ,实现电可擦除和电可编程 4 . 为 了减少 读 写 时 间 , FLASH ROM 中 还 有 命 令 状 态 器 (comm and state m achine) 和写状态器 (write state m a 2chine ) 等控制单元34) C ellere 通过研究浮栅存储器的重离子辐射效应指出 ,如果重离子径迹从浮栅到达硅衬底 ,会产 生一个导电通道 , 增大漏电 , 很快减少浮栅上的电 子 ;如果氧化层中的中性缺陷排列成行 ,产生导电通道 ,也会增大漏电 ,从而导致浮栅上的电荷流失. 同 时 ,作者认为前一种机理起主要作用 ,后一种机理起补充作用.60C oγ光子通过康普顿效应产生电子空穴对. 质子本身可以电离产生电子空穴对 ,但由于其电离 能力小 ,产生的电子空穴对少 ;然而质子与器件材料 中的硅原子发生反应产生次级重离子 ,一定程度地增加了其电离能力. 中子本身不带电 ,不能电离产生 电子空穴对 ;但它与质子一样可以与器件材料中的 硅原子发生反应产生次级重离子 ,从而电离出电子 空穴对. 但上述 4 种机理不能完全解释我们实验中观察到的现象 .图 1 浮栅 RO M 存储单元的基本结构示意图9 期贺朝会等:浮栅R OM 器件辐射效应机理分析2237根据第1 种机理,当浮栅上的电子减少到一定程度,阈值电压超过高低电平的噪声容限,就会出现错误,因此器件出现错误都有个注量或剂量阈值. 器件加电时,控制栅和浮栅之间,浮栅和沟道之间存在电场,降低了电子空穴对的复合率,更多的空穴漂移到浮栅,复合掉浮栅上更多的电子,导致器件更容易出错. 因此, 动态监测和静态加电的器件都出现错误,而不加电的器件未出现错误. 当浮栅上的电子减少到一定程度,晶体管处于截止和导通的临界状态, 其状态是不确定的. 应用该机理可以解释实验现象1 和3 以及2 的部分现象,但无法对实验现象4 和5以及不能重新写入数据给出合理的解释.根据第3 种机理,浮栅上电子的发射需要达到一定程度才能导致器件出错,因此器件出现错误存在注量或剂量阈值. 对于实验现象 3 也可以给出类似于前面的解释,但无法解释实验现象2 ,4 和5 .根据第4 种机理,如果重离子的径迹构成导电通道联接浮栅与硅衬底,应该很快减少浮栅上的电子,导致某位存储单元出错. 这种事件是一种概率事件,不应该存在注量或剂量阈值,且与加电状态关系不大.第2 种机理只提到氧化物陷阱电荷,实际上界面陷阱电荷也会导致阈值电压漂移.我们认为:1) 辐射在浮栅周围的绝缘层内电离产生电子空穴对. 电子空穴在电场的作用下漂移,电子漂移向体硅或控制栅. 空穴的迁移率小,一部分漂移到浮栅,减少了浮栅上的电子;一部分在氧化层中形成陷阱电荷;一部分在界面处形成界面陷阱电荷, 三方面的因素综合起来导致晶体管的阈值电压发生漂移. 当阈值电压漂移到一定程度,使原来截止的晶体管导通,存储单元的状态就发生变化,出现数据错误. 由于氧化物陷阱电荷和界面陷阱电荷的积累需要一定的剂量积累,才能导致阈值电压超过高低电平的噪声容限, 因此, 错误发生存在注量或剂量阈值. 随着注量或剂量的增加,阈值电压发生漂移的晶体管数目增加,错误数增加. 2) 辐射产生的电子空穴对在电场下复合率小,逃逸率大,容易形成氧化物陷阱电荷. 逃逸出的电子空穴发生漂移,其漂移有方向性,容易在界面处形成界面陷阱电荷; 无电场时,迁移率小,复合率大,不易形成氧化物陷阱电荷和界面陷阱电荷. 因此,器件在加电状态下出现错误,而在不加电状态下不出现错误. 3) 阈值电压漂移量不大时,晶体管处于截止和导通的临界状态,没有使存储单元由一种状态彻底变为相反状态. 因此,在存储单元状态彻底改变之前的一段时间内,其状态是不确定的. 所以,器件刚开始出错时,错误数及错误地址都是不确定的. 4) 高温退火使陷阱中的空穴获得激发而跳出陷阱与电子复合. 随着氧化物陷阱电荷和界面陷阱电荷的减少或消失,阈值电压逐渐恢复到辐照前的状态. 和29C256 相比,28C256 的功能不易通过高温退火得到恢复,这是由于28C256 的氧化层比29C256 厚,氧化物陷阱深的缘故. 5) 对于实验现象4 和不能重新编程写入数据的问题,我们认为是由控制部件出错导致的. 这是由于整个器件都处于辐射环境中,辐射在存储单元外围控制部件中也会产生总剂量效应,导致控制部件出错. 实验观察到出现不同错误的中子注量阈值不同. 对于29C256 , 中子注量大于91743 ×1012 cm - 2 时,不能编程重新写入数据,但存储的数据正确; 51832 ×1013 cm - 2 时,数据出错. 对于28C256 ,中子注量大于1013 cm - 2 时,不能编程重新写入数据, 但存储的数据正确; 515 ×1013 cm - 2 时, 数据出错. 对于28C64 , 中子注量大于1013 cm - 2 时,开始无法写入新数据;大于2 ×1013 cm - 2 时, 出现擦写故障. 说明中子辐照首先导致控制部件出错(先写入部件, 后擦除部件) , 其次是存储单元出错. 在随后更进一步的60 C o γ辐照实验中,监测了器件功耗电流的变化情况. 实验观察到,对于EEPROM 和F LASH R OM ,剂量积累到一定程度, 总的功耗电流开始逐渐增大;当电流增大到一定程度时,出现数据错误. Wrobel 研究表明 4 ,总剂量效应导致的阈值电压漂移会使功耗电流增大,降低外围电路的驱动能力,引起器件功能失效,出现控制部件错误,随后出现数据错误. 这也是一种解释,但终归是由总剂量效应引起的. 基于以上的分析, 我们认为浮栅R OM 器件的辐射效应是存储单元及其外围电路发生总剂量效应的综合体现.表1 比较了EEPR OM 和FLASH ROM 器件在中子、质子和60 C o γ辐射下出现数据错误时的累积剂量. 导致器件出错的累积剂量阈值60 C o γ最小; 其次是质子;再次是中子. 这是由于三种辐射源产生电子空穴对的方式不同: 60 C o γ光子通过康普顿效应直接产生电子空穴对; 质子直接电离产生的电子空穴对少,通过与硅原子发生反应产生次级重离子的反应截面小,绝大部分质子不发生反应而穿过器件(在典型的4μm 厚的硅片中,大约10 万个质子中只有一个质子与硅发生反应) ;中子不能电离产生电子空穴对 ,它与硅原子发生反应的截面也不大. 另外 ,γ 光 子电离产生的电子空穴对和重离子电离产生的电子空穴对的空间结构分布不同 :γ 光子电离产生的电 子空穴对稀疏 ,复合率小 ,逃逸率大 ; 重离子电离产 生的电子空穴对稠密 ,柱状分布 ,复合率大 ,逃逸率 小 . 因此 ,在三种辐射源辐照下 ,氧化物陷阱电荷和 界面陷阱电荷的形成速率由快到慢依次为γ、质子 和中子. 所以导致浮栅 R OM 器件出错的累积剂量阈 值60 C o γ最小 ;其次是质子 ;再次是中子.51 结 论应用总剂量效应机理合理地解释了实验中观察 到的现象 :错误发生存在注量或剂量阈值 ;器件在加 电状态下出现错误 ,而在不加电状态下不出现错误 ;器件刚开始出错时 ,错误数及错误地址都是不确定 的 ;高温退火效应和存储单元外围控制部件错误. 这些都是辐射产生的电子空穴对在器件中形成氧化物陷阱电荷和界面陷阱电荷的缘故 ,是存储单元及其 外围电路发生总剂量效应的综合体现. 因此 , 浮栅R OM 器件的中子 、质子和60C o γ 辐射效应都是总剂量效应. 导致浮栅 R OM 器件出错的累积剂量阈值.表 1 器件出现数据错误时的累积剂量累积剂量Π(104 rad ( S i) )器件型号中子质子 3γ3 28C256 71612 21790 11445Wr obel T F 1989 I E EE Tran s . Nuc . Sci . N S 236 2247 Snyder E S et al 1989 I E EE Trans . Nuc . Sci . N S 236 2131 V erkasalo R 1994 I E EE Trans . Nuc . Sci . N S 241 2600Wang J P et al 2000 Acta Phys . Sin . 49 1331 (in Chinese ) [ 王剑 屏等 2000 物理学报 49 1331 ]Zhang T Q et al 2001 Acta Phys . Sin . 50 2434 (in Chinese ) [ 张廷 庆等 2001 物理学报 50 2434 ] Wang X Q et al 2002 Acta Phys . Sin . 51 1094 (in Chinese ) [ 王晓 强等 2002 物理学报 51 1094 ] Lu T et al 2001 Chin . Phys . 10 145262 (in Chinese) [ 贺朝会Tech . 20 115 (in Chinese ) [ 贺朝会等 2000 核电子学与探测技术 20 115 ]He C H et al 2002 Chinese J o urnal o f Space S ci . 22 184 ( in Chi 2 nese ) [ 贺朝会等 2002 空间科学学报 22 184 ]He C H et al 2003 Acta Phys . Sin . 52 180 (in Chinese ) (in press ) [ 贺朝会等 2003 物理学报 52 180 (in press ) ]He C H et al 2002 Nucl . Elec . & Dec . Tech . 22 344 (in Chinese ) [ 贺朝会等 2002 核电子学与探测技术 22 344 ] G uo H X et al 2002 Acta Phys . Sin . 51 2315 (in Chinese ) [ 郭红霞等 2002 物理学报 51 2315 ]4 ]5 ]6 ]7 ] 13 ] 14 ]8 ]15 ]9 ] 16 ]10 ]Me c h a ni s m of ra d iatio n eff e c t s in flo a ting gat e ROMsHe C hao2Hui G eng B in Y ang H ai 2Liang C hen X iao2Hua Li G uo2Zheng Wang Y an2Ping( Northwest Institute of Nuclear Technology , Xi ’an 710613 , China ) ( Received 18 Se ptember 2002 ; revised manuscr ipt received 24 December 2002)AbstractMechanism of irradiati on effects is analyz ed for fl oating gate read only m em ories ( R OMs ) . Phenom ena in ex perim ents are reasonably ex plained. It is pr oposed that failures in devices result from ox ide trapped charge and interface tra pped charge gener 2 ated by radiati on in m em ory cells and peripheral circuitry. The neutr on , pr ot on and 60 C o γirradiati on effects in F L ASH R OM and EEPR OM are total dose effects.K ey w ord s : F LASH R OM , EE PR OM , neutron , pr ot on , 60 C o γ, t otal dose effect PACC : 6180 , 7340Q。

浮栅器件的单粒子翻转效应琚安安;郭红霞;丁李利;刘建成;张凤祁;张鸿;柳奕天;顾朝桥;刘晔;冯亚辉【期刊名称】《太赫兹科学与电子信息学报》【年(卷),期】2022(20)9【摘要】基于中国原子能科学研究院的HI-13加速器,利用不同线性能量传输(LET)值的重离子束流对4款来自不同厂家的90 nm特征尺寸NOR型Flash存储器进行了重离子单粒子效应试验研究,对这些器件的单粒子翻转(SEU)效应进行了评估。
试验中分别对这些器件进行了静态和动态测试,得到了它们在不同LET值下的SEU 截面。
结果表明高容量器件的SEU截面略大于低容量的器件;是否加偏置对器件的翻转截面几乎无影响;两款国产替代器件的SEU截面比国外商用器件高。
国产替代器件SEU效应的LET阈值在12.9 MeV·cm^(2)/mg附近,而国外商用器件SEU效应的LET阈值处于12.9~32.5 MeV·cm^(2)/mg之间。
此外,针对单粒子和总剂量效应对试验器件的协同作用也开展了试验研究,试验结果表明总剂量累积会增加Flash存储器的SEU效应敏感性,分析认为总剂量效应产生的电离作用导致了浮栅上结构中的电子丢失和晶体管阈值电压的漂移,在总剂量效应作用的基础上SEU更容易发生。
【总页数】8页(P877-883)【作者】琚安安;郭红霞;丁李利;刘建成;张凤祁;张鸿;柳奕天;顾朝桥;刘晔;冯亚辉【作者单位】湘潭大学材料科学与工程学院;上海精密计量测试研究所;西北核技术研究院;中国原子能科学研究院【正文语种】中文【中图分类】TN60【相关文献】1.功率MOS器件单粒子栅穿效应的PSPICE模拟2.平面型浮栅Flash单粒子效应研究进展3.14 nm bulk FinFET工艺的SRAM倒封装器件重离子单粒子翻转的角度效应4.功率MOS器件单粒子栅穿效应的等效电路模拟方法5.浮栅存储器的单粒子辐射效应研究进展因版权原因,仅展示原文概要,查看原文内容请购买。

NAND 型 Flash 存储器总剂量效应实验研究盛江坤;邱孟通;姚志斌;何宝平;黄绍艳;刘敏波;肖志刚;王祖军【摘要】Total ionizing dose (TID ) effect experiments on four kinds of devices of different feature sizes from Micron Technology Company were carried out .Experiment results indicate that the phenomena of TID effect under the static bias is similar to that under the dynamic bias , but is different from the unbiased one . The sensitive parameters of different feature sizes have the similar change trend ,but don’t vary with feature size monotonously because of the synthetic influence of other factors .%针对镁光公司的4种NAND型Flash存储器,开展了不同辐照偏置下的总剂量效应实验及不同工艺尺寸器件的静态加电辐照实验。
实验结果表明,器件在静态加电和动态辐照偏置下的总剂量效应相似,而与不加电辐照偏置下的总剂量效应不同。
不同工艺尺寸器件的敏感参数有相同的变化趋势,由于受其他因素的综合影响,各敏感参数并不随工艺尺寸单调变化。
【期刊名称】《原子能科学技术》【年(卷),期】2014(000)008【总页数】6页(P1502-1507)【关键词】NAND型Flash存储器;总剂量效应;辐照偏置;工艺尺寸【作者】盛江坤;邱孟通;姚志斌;何宝平;黄绍艳;刘敏波;肖志刚;王祖军【作者单位】西北核技术研究所强脉冲辐射环境模拟与效应国家重点实验室,陕西西安 710024;西北核技术研究所强脉冲辐射环境模拟与效应国家重点实验室,陕西西安 710024;西北核技术研究所强脉冲辐射环境模拟与效应国家重点实验室,陕西西安 710024;西北核技术研究所强脉冲辐射环境模拟与效应国家重点实验室,陕西西安 710024;西北核技术研究所强脉冲辐射环境模拟与效应国家重点实验室,陕西西安 710024;西北核技术研究所强脉冲辐射环境模拟与效应国家重点实验室,陕西西安 710024;西北核技术研究所强脉冲辐射环境模拟与效应国家重点实验室,陕西西安 710024;西北核技术研究所强脉冲辐射环境模拟与效应国家重点实验室,陕西西安 710024【正文语种】中文【中图分类】TN47NAND型Flash存储器是一种非易失性存储器,具有编程和擦除速度快、生产工艺简单、生产成本低、存储密度大、功耗小及重量轻等优点,在电子设备中常用作数据存储。