芯片封装形式与命名规则
- 格式:doc
- 大小:33.50 KB
- 文档页数:4

芯片命名规则MAXIM命名规则AXIM前缀是“MAX”。
DALLAS则是以“DS”开头。
MAX×××或MAX××××说明:1后缀CSA、CWA 其中C表示普通级,S表示表贴,W表示宽体表贴。
2 后缀CWI表示宽体表贴,EEWI宽体工业级表贴,后缀MJA或883为军级。
3 CPA、BCPI、BCPP、CPP、CCPP、CPE、CPD、ACPA后缀均为普通双列直插。
举例MAX202CPE、CPE普通ECPE普通带抗静电保护MAX202EEPE 工业级抗静电保护(-45℃-85℃)说明 E指抗静电保护MAXIM数字排列分类1字头模拟器 2字头滤波器 3字头多路开关4字头放大器 5字头数模转换器 6字头电压基准7字头电压转换 8字头复位器 9字头比较器三字母后缀:例如:MAX358CPDC = 温度范围P = 封装类型D = 管脚数温度范围:C = 0℃ 至70℃(商业级)I = -20℃ 至+85℃ (工业级)E = -40℃ 至+85℃ (扩展工业级)A = -40℃ 至+85℃ (航空级)M = -55℃ 至+125℃ (军品级)封装类型:A SSOP(缩小外型封装)B CERQUADC TO-220, TQFP(薄型四方扁平封装)D 陶瓷铜顶封装E 四分之一大的小外型封装F 陶瓷扁平封装H 模块封装, SBGA(超级球式栅格阵列, 5x5 TQFP)J CERDIP (陶瓷双列直插)K TO-3 塑料接脚栅格阵列L LCC (无引线芯片承载封装)M MQFP (公制四方扁平封装)N 窄体塑封双列直插P 塑封双列直插Q PLCC (塑料式引线芯片承载封装)R 窄体陶瓷双列直插封装(300mil)S 小外型封装T TO5,TO-99,TO-100U TSSOP,μMAX,SOTW 宽体小外型封装(300mil)X SC-70(3脚,5脚,6脚)Y 窄体铜顶封装Z TO-92,MQUAD/D 裸片/PR 增强型塑封/W 晶圆1、MAXIM 更多资料请参考/doc/041531190.html, MAXIM前缀是“MAX”。

BGA封装命名规则1. 引言BGA封装是电子元器件的一种封装形式,用于将电子元器件与电路板相连接,并提供保护和支持。
为了有效管理和识别不同类型的BGA封装,制定了一套BGA封装命名规则。
本文将详细介绍BGA封装命名规则的内容和要求。
2. BGA封装命名规则的目的BGA封装命名规则的主要目的是提供一个统一的命名标准,方便工程师和制造商在设计、生产和组装过程中准确识别和选择不同类型的BGA封装。
通过符合统一的命名规则,可以减少误解和错误,并提高工作效率和产品质量。
3. BGA封装命名规则的要求BGA封装命名规则需要满足以下要求:•唯一性:每种BGA封装都应有一个唯一的名称,以避免混淆和歧义。
•简洁性:命名应简洁明了,便于记忆和使用。
•规范性:命名规则应符合通用的命名规范,遵循一定的语法和规则。
•可拓展性:命名规则应具有一定的可拓展性,以适应新的封装类型的出现。
•易读性:命名应具有良好的可读性,避免使用过于复杂和晦涩的命名方式。
4. BGA封装命名规则的具体内容BGA封装命名规则的具体内容如下:4.1 前缀BGA封装的命名通常以一个前缀开始,用于表示封装的类型或特性。
常见的前缀包括:•FBGA:表示普通的BGA封装。
•LBGA:表示低温BGA封装,适用于高温敏感的元器件。
•CBGA:表示高温BGA封装,适用于高温环境下的元器件。
•PBGA:表示可塑性BGA封装,适用于需要更好的抗冲击性能的元器件。
•TBGA:表示薄型BGA封装,适用于对高度有限制的应用场景。
4.2 封装尺寸BGA封装的尺寸通常以数字表示,表示封装的外部尺寸或球阵列的尺寸。
常见的尺寸表示方式包括:•Xmm x Ymm:表示封装的外部尺寸,其中X表示封装的宽度,Y表示封装的长度。
•X x Y:表示球阵列的尺寸,其中X表示球阵列的行数,Y表示球阵列的列数。
4.3 球阵列间距BGA封装的球阵列间距通常以数字表示,表示球阵列之间的间距或间隔。
常见的间距表示方式包括:•Xmil:表示球阵列之间的间距,其中X表示间距的大小,单位为mil。

QFN封装命名1. 什么是QFN封装QFN(Quad Flat No-leads)封装是一种表面贴装技术,用于集成电路的封装和连接。
它采用无引脚的设计,通过焊接连接器或直接焊接在电路板上。
QFN封装通常由一个平面底部和四个侧面组成,底部有一些导电触点,用于与电路板上的焊盘进行连接。
2. QFN封装命名规则为了方便识别和标记不同类型的集成电路,QFN封装采用了一套命名规则。
这些命名规则通常由芯片制造商制定,并在产品规格书中详细说明。
以下是常见的QFN封装命名规则:•Package Type Identifier:标识QFN封装类型的字母和数字组合。
例如,“QFN32”表示具有32个引脚的QFN封装。
•Package Outline:描述QFN封装外形的数字代码。
每个数字代表一个特定的外形或尺寸。
例如,“5x5”表示外形为5mm x 5mm。
•Pitch:指引脚间距(Pitch)的数值表示。
通常以毫米为单位。
例如,“0.5mm”表示引脚间距为0.5毫米。
•Lead Count:指封装中引脚的数量。
例如,“QFN32”表示具有32个引脚。
•Lead Material:指封装中引脚的材料。
常见的材料包括铜、镍和金。
例如,“Cu/Ni/Au”表示引脚由铜、镍和金组成。
•Lead Finish:指封装中引脚的表面处理。
常见的处理方式包括无锡、热浸锡和热浸镀金。
例如,“Matte Sn”表示引脚表面为无锡处理。
3. QFN封装命名示例以下是几个常见的QFN封装命名示例:1.QFN32-5x5-0.5mm-Cu/Ni/Au-Matte Sn这个命名表示一个具有32个引脚的QFN封装,外形为5mm x 5mm,引脚间距为0.5毫米。
该封装使用铜、镍和金制成的引脚,并在表面进行了无锡处理。
2.QFN48-7x7-0.8mm-Cu/Ni/Au-Hot Tin这个命名表示一个具有48个引脚的QFN封装,外形为7mm x 7mm,引脚间距为0.8毫米。

封装形式说明图片1电子元器件,又叫电子芯片,半导体集成电路,广泛应用于各种电子电器设备上.封装形式:封装形式是指安装半导体集成电路芯片用的外壳.它不仅起着安装,固定,密封,保护芯片及增强电热性能等方面的作用,而且还通过芯片上的接点用导线连接到封装外壳的引脚上,这些引脚又通过印刷电路板上的导线与其他器件相连接.衡量一个芯片封装技术先进与否的重要指标是芯片面积与封装面积之比,这个比值越接近1越好.封装大致经过了如下发展进程:结构方面:TO->DIP->LCC->QFP->BGA ->CSP;材料方面:金属,陶瓷->陶瓷,塑料->塑料;引脚形状:长引线直插->短引线或无引线贴装->球状凸点;装配方式:通孔插装->表面组装->直接安装.英文简称/英文全称/中文解释/图片(1)DIPDouble In-line Package双列直插式封装.插装型封装之一,引脚从封装两侧引出,封装材料有塑料和陶瓷两种.DIP是最普及的插装型封装,应用范围包括标准逻辑IC,存贮器LSI,微机电路等.(2)PLCCPlastic Leaded Chip CarrierPLCC封装方式,外形呈正方形,32脚封装,四周都有管脚,外形尺寸比DIP封装小得多.PLCC封装适合用SMT表面安装技术在PCB上安装布线,具有外形尺寸小,可靠性高的优点.(3)PQFPPlastic Quad Flat PackagePQFP封装的芯片引脚之间距离很小,管脚很细,一般大规模或超大规模集成电路采用这种封装形式,其引脚数一般都在100以上.(4)SOPSmall Outline Package1968~1969年菲为浦公司就开发出小外形封装(SOP).以后逐渐派生出SOJ(J型引脚小外形封装),TSOP(薄小外形封装),VSOP(甚小外形封装),SSOP(缩小型SOP),TSSOP(薄的缩小型SOP)及SOT(小外形晶体管),SOIC(小外形集成电路)等.模拟滤波器光纤通信高速信号处理和转换无线/射频光线通讯,模拟显示支持电路高频模拟和混合信号ASIC 数字转换器,接口,电源管理,电池监控DC/DC电源电压基准MAXIM前缀是"MAX",DALLAS则是以"DS"开头。


TI芯片后辍名与封装对照详解TI芯片封装详解TI的芯片众多,芯片的后辍名常引起我们的兴趣,确有点难以理解。
下面将TI的后辍名中表示封装的信息与标准封装的对比贴出来,希望对大家有用。
TI的TLxxx系列产品:后缀CP普通级 IP工业级后缀带D是表贴后缀带MJB,MJG或带/883的为军品级TLC表示普通电压 TLV低功耗电压TMS320系列归属DSP器件, MSP430F微处理器原BB产品命名规则:前缀ADS模拟器件后缀U表贴 P是DIP封装带B表示工业级前缀INA,XTR,PGA等表示高精度运放后缀U表贴 P代表DIP PA表示高精度芯片封装对照D, DW -- 小型集成电路 (SOIC)DB, DL -- 紧缩小型封装 (SSOP)DBB, DGV -- 薄型超小外形封装 (TVSOP)DBQ -- 四分之一小型封装 (QSOP)DBV, DCK -- 小型晶体管封装 (SOT)DGG, PW -- 薄型紧缩小型封装 (TSSOP)FK -- 陶瓷无引线芯片载体 (LCCC)FN -- 塑料引线芯片载体 (PLCC)GB -- 陶瓷针型栅阵列 (CPGA)GKE, GKF -- MicroStar? BGA 低截面球栅阵列封装 (LFBGA)GQL, GQN -- MicroStar Junior BGA 超微细球栅阵列 (VFBGA) HFP, HS, HT, HV -- 陶瓷四方扁平封装 (CQFP)J, JT -- 陶瓷双列直插式封装 (CDIP)N, NP, NT -- 塑料双列直插式封装 (PDIP)NS, PS -- 小型封装 (SOP)PAG, PAH, PCA, PCB, PM, PN, PZ -- 超薄四方扁平封装 (TQFP) PH, PQ, RC -- 四方扁平封装 (QFP)W, WA, WD -- 陶瓷扁平封装 (CFP)卷带包装(芯片在出售时,包装是不一样的,常见包装有载带、盖带、卷带,一般包装越大,单片越便宜)DB 和 PW 封装类型中的所有新增器件或更换器件的名称包括为卷带产品指定的 R。

atmega芯片命名规则
ATmega芯片命名规则是指Atmel公司为其生产的一系列AVR微控制器芯片命名所采用的规则。
ATmega芯片是一种高性能、低功耗、可编程的微控制器芯片,广泛应用于工业控制、家电、医疗设备、汽车电子、电力电子等领域。
其命名规则主要包括以下几个方面:
1. 型号编号:ATmega芯片的型号编号一般由“AT”、“mega”和几个数字组成。
其中,“AT”代表Atmel公司,“mega”代表该芯片系列,数字则表示芯片的具体型号。
例如,ATmega328p的型号编号中,数字“328”表示芯片的存储容量和IO口数量,字母“p”表示该芯片采用了低功耗技术。
2. 功能特性:ATmega芯片的型号编号还可以反映其功能特性。
例如,ATmega32u4中的字母“u”表示该芯片具有USB接口,ATmega128a 中的字母“a”表示该芯片采用了高速器件技术。
3. 封装形式:ATmega芯片的型号编号还可以反映其封装形式。
例如,ATmega32m1中的字母“m”表示该芯片采用了QFN封装,ATmega2560的型号编号中没有字母表示它采用了DIP封装。
总之,ATmega芯片的命名规则可以提供芯片的型号、存储容量、IO口数量、功能特性和封装形式等信息,有助于用户选择适合自己应用的芯片。
- 1 -。

stm32芯片命名规则一、引言STM32芯片是STMicroelectronics(意法半导体)公司生产的一系列32位微控制器。
作为嵌入式系统开发中的核心芯片,STM32芯片命名规则对于开发者非常重要。
通过了解STM32芯片命名规则,开发者可以快速准确地辨识不同系列、不同型号的芯片,以便选择适合自己应用需求的产品。
本文将详细介绍STM32芯片命名规则的各个方面。
二、STM32芯片命名规则概述STM32芯片的命名规则由多个部分组成,每个部分都代表着不同的含义。
下面将分别介绍这些部分的含义和命名规则。
2.1 前缀STM32芯片的前缀由”STM32”组成,代表该芯片系列。
2.2 产品系列STM32芯片的产品系列是芯片的一级分类,它代表着芯片的主要特性和应用领域。
常见的产品系列包括STM32F、STM32L、STM32H等。
2.3 封装类型STM32芯片的封装类型代表了芯片的外形尺寸和引脚排列方式。
常见的封装类型有LQFP、BGA、TQFP等。
2.4 芯片型号芯片型号是STM32芯片命名规则中最重要的部分,它代表了芯片的具体型号和功能特性。
芯片型号通常由字母和数字组成,其中字母代表着芯片的系列和功能特性,数字代表着芯片的具体型号和性能等级。
例如,STM32F407是一个常见的芯片型号,其中的F代表着该芯片属于STM32F系列,407代表了该芯片的型号。
三、STM32芯片命名规则详解在了解了STM32芯片命名规则的概要之后,我们将更加详细地介绍各个部分的含义和规则。
3.1 前缀规则STM32芯片的前缀始终为”STM32”,不会有例外情况。
3.2 产品系列规则STM32芯片的产品系列采用字母进行表示,不同的字母代表着不同的特性和应用领域。
常见的产品系列及其代表的意义如下:•STM32F系列:高性能、多功能的通用型32位微控制器。
•STM32L系列:超低功耗型32位微控制器,适用于低功耗应用和长时间待机的应用。

sot封装命名规则SOT封装命名规则SOT(System-on-a-Chip Test)是一种用于集成电路测试的封装技术,它将测试模块集成到芯片封装中,可以在封装级别上对集成电路进行测试。
SOT封装命名规则是为了统一命名SOT封装中的测试模块,使其易于识别和管理。
本文将介绍SOT封装命名规则的几个重要方面。
一、命名规则的基本原则在制定SOT封装命名规则时,需要遵循以下几个基本原则:1. 清晰易懂:命名应简洁明了,能够准确表达测试模块的功能和作用。
2. 规范统一:命名规则应统一,以便于不同工程师之间的交流和协作。
3. 精炼简洁:命名应尽量简短,避免出现冗长的命名,提高命名的可读性和易理解性。
二、命名规则的要素在SOT封装的命名中,可以包含以下几个要素:1. 功能描述:对测试模块的功能进行简要描述,例如ADC (Analog-to-Digital Converter,模数转换器)。
2. 类型标识:标识测试模块的类型,例如DA(Digital Analyzer,数字分析仪)。
3. 版本号:标识测试模块的版本,以便于追踪和管理,例如V1.0。
4. 序号:标识同一类型的不同测试模块,以便于区分和管理,例如01、02等。
三、命名规则的示例根据上述要素,可以得到以下几个示例:1. ADC模块命名:ADC_DA_V1.0_01,表示版本为V1.0的ADC 模块,序号为01。
2. DA模块命名:DA_DA_V1.0_01,表示版本为V1.0的DA模块,序号为01。
3. GPIO模块命名:GPIO_DA_V1.0_01,表示版本为V1.0的GPIO 模块,序号为01。
四、命名规则的应用在实际应用中,SOT封装命名规则可以应用于以下几个方面:1. 设计和开发:在SOT封装的设计和开发过程中,可以根据命名规则对测试模块进行命名,以方便标识和管理。
2. 文档编写:在编写相关文档时,可以使用SOT封装命名规则对测试模块进行命名,以便于读者理解和查找相关信息。

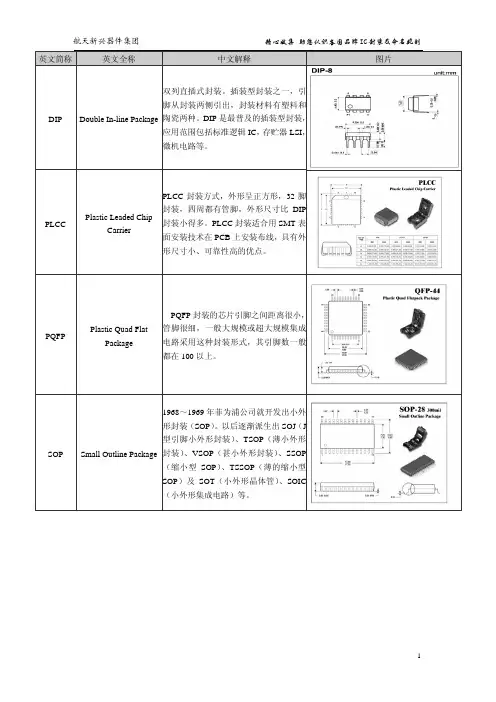
英文简称 英文全称 中文解释 图片DIPDouble In-line Package 双列直插式封装。
插装型封装之一,引脚从封装两侧引出,封装材料有塑料和陶瓷两种。
DIP 是最普及的插装型封装,应用范围包括标准逻辑IC ,存贮器LSI ,微机电路等。
PLCCPlastic Leaded ChipCarrierPLCC 封装方式,外形呈正方形,32脚封装,四周都有管脚,外形尺寸比DIP 封装小得多。
PLCC 封装适合用SMT 表面安装技术在PCB 上安装布线,具有外形尺寸小、可靠性高的优点。
PQFPPlastic Quad FlatPackagePQFP 封装的芯片引脚之间距离很小,管脚很细,一般大规模或超大规模集成电路采用这种封装形式,其引脚数一般都在100以上。
SOPSmall Outline Package 1968~1969年菲为浦公司就开发出小外形封装(SOP )。
以后逐渐派生出SOJ (J 型引脚小外形封装)、TSOP (薄小外形封装)、VSOP (甚小外形封装)、SSOP (缩小型SOP )、TSSOP (薄的缩小型SOP )及SOT (小外形晶体管)、SOIC (小外形集成电路)等。
以下就各种品牌具体说明 说明:1后缀CSA 、CWA 其中C 表示普通级,S 表示表贴,W 表示宽体表贴。
2 后缀CWI 表示宽体表贴,EEWI 宽体工业级表贴,后缀MJA 或883为军级。
3 CPA、BCPI、BCPP、CPP、CCPP、CPE、CPD、ACPA 后缀均为普通双列直插。
MAXIM 专有产品型号命名MAX XXX(X) X X X 1234561.前缀:MAXIM 公司产品代号 2.产品系列编号:100-199 模数转换器 600-699 电源产品200-299 接口驱动器/接受器 700-799 微处理器 外围显示驱动器 300-399 模拟开关 模拟多路调制器 800-899 微处理器 监视器 400-499 运放 900-999 比较器 500-599 数模转换器3.产品等级:由A、B、C、D 四类组成,A 档最高,依此B、C、D 档 4 .温度范围:C= 0℃ 至 70℃(商业级)I =-20℃ 至 +85℃(工业级) E =-40℃ 至 +85℃(扩展工业级) A = -40℃至+85℃(航空级) M =-55℃ 至 +125℃(军品级)5.封装形式:A SSOP(缩小外型封装)B CERQUADC TO-220, TQFP(薄型四方扁平封装)D 陶瓷铜顶封装E 四分之一大的小外型封装F 陶瓷扁平封装 H 模块封装, SBGA J CERDIP (陶瓷双列直插) K TO-3 塑料接脚栅格阵列 LLCC (无引线芯片承载封装) M MQFP (公制四方扁平封装) N 窄体塑封双列直插P 塑封双列直插Q PLCC (塑料式引线芯片承载封装) R 窄体陶瓷双列直插封装(300mil) S 小外型封装 T TO5,TO-99,TO-100 U TSSOP,μMAX,SOTW 宽体小外型封装(300mil) X SC-70(3脚,5脚,6脚) Y 窄体铜顶封装 Z TO-92MQUAD /D 裸片 /PR 增强型塑封 /W 晶圆6.管脚数量:A:8 B:10,64 C:12,192 D:14 J:32 K:5,68 L:40 M:7,48 N:18S:4,80 T:6,160 U:60 V:8(圆形)E:16 F:22,256 G:24 H:44I:28 O:42 P:20 Q:2,100 R:3,84W:10(圆形) X:36 Y:8(圆形) Z:10(圆形)注:对接口类产品,四个字母后缀的第一个字母E 表示则该器件具备抗静电功能。
issi芯片型号命名规则ISSI(Integrated Silicon Solution Inc.)是一家领先的半导体公司,专注于设计、开发和销售各种集成电路产品。
公司成立于1988年,总部位于美国加利福尼亚州米尔皮塔斯市。
ISSI芯片型号命名规则是一种规范性的体系,用于标识和区分不同型号的芯片产品。
这种规则旨在简化产品标识和分类,方便客户识别和选择合适的芯片。
在ISSI芯片型号中,通常包括一系列字母、数字和特殊字符,每个字符代表了特定的含义和属性。
下面是ISSI芯片型号命名规则的详细解释:1. 类别标识:该部分用于标识芯片所属的主要类别或系列。
常见的类别标识包括DRAM(动态随机存储器)、SRAM(静态随机存储器)、闪存(Flash)、控制器(Controller)等。
不同的类别可以通过不同的字母、数字或特殊字符进行标识。
2. 功能标识:该部分用于标识芯片的主要功能和特性。
常见的功能标识包括速度(Speed)、容量(Capacity)、接口(Interface)等。
速度通常用MHz或ns表示,容量通常用Mb或GB表示,接口通常用SPI、I2C、USB等表示。
3. 封装标识:该部分用于标识芯片的封装形式和尺寸。
常见的封装标识包括TSOP(Thin Small Outline Package)、BGA (Ball Grid Array)、QFN(Quad Flat No-leads)等。
不同的封装形式可以通过不同的字母、数字或特殊字符进行标识。
4. 温度等级标识:该部分用于标识芯片的温度等级和工作范围。
常见的温度等级标识包括商业级(Commercial)、工业级(Industrial)、汽车级(Automotive)等。
不同的温度等级可以通过不同的字母、数字或特殊字符进行标识。
5. 版本标识:该部分用于标识芯片的版本信息。
当芯片需要进行升级或改进时,可以通过版本标识进行区分。
版本标识通常用字母和数字组成,如A、B、C或V1、V2、V3等。
eeprom芯片的命名规则-回复EEPROM芯片的命名规则电可擦除可编程只读存储器(Electrically Erasable Programmable Read-Only Memory,简称EEPROM),作为一种存储数据的芯片,在电子设备的各种应用领域起着重要作用。
EEPROM芯片的命名规则是根据其性能和特征来命名的,下面将一步一步对其进行详细解析。
一、EEPROM的基本概念EEPROM,全称为Electrically Erasable Programmable Read-Only Memory,中文翻译为电可擦写可编程只读存储器。
与传统只读存储器相比,EEPROM具有可擦写特性,可以重复存储和擦除数据。
EEPROM通常被用于存储微控制器和其他电子设备中的重要数据,如参数配置、校准数据、用户设置等。
二、EEPROM芯片的命名规则在电子器件领域,芯片的命名规则一般采用一系列的规范和标准。
EEPROM芯片的命名规则主要按照以下几个方面进行命名:1. 容量(Capacity)EEPROM芯片的容量是决定其数据存储能力的重要指标,容量越大则存储的数据量越大。
常见的容量大小通常以位数(bit)或字节数(byte)表示,如1Kbit、4Kbit,或者以Mbit、Gbit为单位表示,如32Mbit、64Gbit 等。
2. 供电电压(Voltage)EEPROM芯片需要稳定的电压供应才能正常工作,供电电压是芯片需要的电压范围。
一般而言,常见的供电电压有3.3V、5V等,这也是设备设计中需要特别注意的一个参数。
3. 接口类型(Interface Type)EEPROM芯片的接口类型决定了它与其他设备之间的通信方式。
常见的接口类型有串行接口(如I2C、SPI)和并行接口(如8位或16位数据总线)。
不同的接口类型适用于不同场景的应用,可以根据具体需求进行选择。
4. 数据传输速率(Transfer Rate)数据传输速率是指EEPROM芯片进行读写操作时的速度,通常以MHz(兆赫)或MB/s(兆字节每秒)为单位。
s32k芯片命名规则
S32K芯片的命名规则一般包含以下信息:
1. S32K系列名称:该系列名称表示芯片所属的系列,例如S32K144等。
2. 数字部分:这部分表示芯片的型号和规格,包括芯片的位数、主频、封装等信息。
例如,数字部分为144,表示该芯片为32位MCU,并且主频为48MHz。
3. 后缀部分:该部分通常表示芯片的封装形式和温度范围。
例如,后缀为TQFP,表示该芯片采用TQFP封装;后缀为-40~105℃,表示该芯片的工作温度范围为-40℃~105℃。
综上所述,S32K芯片的命名规则可以帮助用户了解芯片的规格和特点,从而更好地选择和使用该芯片。
芯片封装形式芯片封装形式是指将芯片封装在一定形式的外壳内,以保护芯片的结构和功能,同时方便与外部电路连接和应用。
根据芯片封装的不同形式,可以分为多种封装形式。
1. DIP封装(Dual in-line package):DIP封装是最早的一种芯片封装形式,其特点是具有直插式引脚,引脚以两行排列,并且直插到插座或印刷电路板上,常用于早期的集成电路。
2. SOP封装(Small outline package):SOP封装是一种较为常见的封装方式,外形小巧,引脚以两行排列,并且是表面贴装形式,可以简化PCB组装工艺,常用于低功耗集成电路。
3. QFP封装(Quad flat package):QFP封装是一种常见的集成电路封装形式,采用四面平封装结构,有多种引脚数可选,外形较大,适用于高功耗集成电路。
4. BGA封装(Ball grid array):BGA封装是一种近年来较为流行的集成电路封装形式,主要特点是引脚以球形排列,焊接在封装底部,可以提供更好的散热性能,适用于高性能处理器和FPGA芯片。
5. CSP封装(Chip scale package):CSP封装是一种尺寸与芯片大小相当的封装形式,可以最大限度地减小芯片尺寸,提高集成度,通常用于需求小型化的应用,如移动设备等。
除了以上常见的封装形式外,还有一些特殊的封装形式,如:1. LGA封装(Land grid array):LGA封装与BGA封装类似,但是引脚是以直线排列,没有球形结构,适用于一些高频、高速的集成电路。
2. COB封装(Chip on board):COB封装是将芯片直接粘贴在印刷电路板上,并通过金线或金属线连接到电路板上,是一种尺寸最小的封装形式,适用于需要小型化的应用。
3. SIP封装(Single in-line package):SIP封装是一种只有一排引脚,长形封装形式,适用于功能较为简单的集成电路。
每种封装形式都有其独特的特点和适用范围,选择合适的封装形式可以提高芯片的性能和应用范围。
半导体分立器件封装命名规则解释说明以及概述1. 引言1.1 概述半导体分立器件封装是指对单个的半导体器件进行封装,以便在电路中使用。
而半导体分立器件封装命名规则则是用于标识和描述这些封装形式的一种规范。
随着电子行业的发展和技术的进步,半导体分立器件封装命名规则成为了确保产品质量、标准化生产和交流合作的重要工具。
1.2 文章结构本文将详细解释和说明半导体分立器件封装命名规则,旨在帮助读者更好地理解和掌握这一方面的知识。
文章首先会介绍什么是半导体分立器件封装命名规则,并阐述其目的和重要性。
接着,我们将列举常见的半导体分立器件封装命名规则示例,从实际案例中深入探讨这些规则的应用。
然后,本文还将概述国际标准与行业标准的区别,并提供国内外常用的半导体分立器件封装命名规则总览。
最后,我们将讨论这一领域的发展趋势和未来发展方向。
1.3 目的本文的目的是全面介绍半导体分立器件封装命名规则,解释其含义和重要性,并为读者提供一个清晰的概述。
通过深入研究和讨论,我们希望能够加深人们对半导体分立器件封装命名规则的理解,同时引起相关行业和领域内人士对这一问题的关注。
最后,我们也将提出进一步研究和应用推广建议,以促进半导体分立器件封装命名规则标准化、统一化发展。
2. 半导体分立器件封装命名规则解释说明2.1 什么是半导体分立器件封装命名规则半导体分立器件封装命名规则指的是定义半导体器件外部封装形式和结构的规则和标准。
由于不同类型的半导体器件在表面封装形式上有所差异,因此需要一套统一的命名规则来对这些器件进行分类和标识。
2.2 命名规则的目的和重要性半导体分立器件封装命名规则的主要目的在于方便工程师、制造商和用户理解各种类型的半导体器件,并选择适合自己需求的器件。
通过使用统一的命名规则,可以确保行业内人员能够准确地对不同型号和尺寸的器件进行描述、比较和选择。
此外,命名规则还有助于提高工作效率,降低误操作风险。
当有大量不同型号或者品牌的半导体器件需要被组装或替换时,使用统一的命名规则可以使得相关工作更加简便明了。
xilinx fpga封装命名规则摘要:I.引言- 介绍Xilinx FPGA- 简述封装命名规则的重要性II.Xilinx FPGA 封装命名规则- 概述Xilinx FPGA 的命名规则- 解释命名规则中的各个部分- 器件类型- 封装类型- 功能模块- 性能等级- 修订版本III.举例说明- 使用具体型号解释命名规则- 分析封装命名规则在实际应用中的作用IV.总结- 重申封装命名规则的重要性- 概括命名规则在Xilinx FPGA 中的作用正文:I.引言Xilinx FPGA 是一种广泛应用于电子行业的可编程逻辑器件,具有高度灵活性和可定制性。
然而,对于初学者而言,Xilinx FPGA 的封装命名规则可能显得有些复杂。
本文将介绍Xilinx FPGA 的封装命名规则,并探讨其重要性。
II.Xilinx FPGA 封装命名规则Xilinx FPGA 的封装命名规则主要包括以下几个部分:1.器件类型Xilinx FPGA 的器件类型通常以“XC”开头,例如XC3S、XC6S 等。
其中,“X”代表Xilinx 公司,“C”代表芯片类型,如“S”代表Spartan 系列,“V”代表Virtex 系列。
2.封装类型封装类型通常以“FFG”开头,例如FFG676、FFG768 等。
其中,“F”代表FBGA(倒装球栅阵列)封装,“G”代表芯片的引脚数。
3.功能模块功能模块包括逻辑单元(LE)、嵌入式存储器(EM)和输入/输出(I/O)等。
这些模块的命名通常以“L”和“M”开头,例如L16、M40 等。
4.性能等级性能等级通常以“-5”或“-7”表示,例如XC3S-500E、XC6S-750T 等。
其中,“5”代表性能等级为标准,“7”代表高性能。
5.修订版本修订版本通常以“C”或“D”表示,例如XC3S-500E-2C、XC6S-750T-2D 等。
其中,“C”代表修订版本1,“D”代表修订版本2。
III.举例说明以XC6S-750T-2D 为例,解释封装命名规则:- 器件类型:Xilinx Virtex-6 FPGA- 封装类型:FBGA,768 引脚- 功能模块:60,000-100,000 个逻辑单元,40 个嵌入式存储器模块- 性能等级:高性能,-7- 修订版本:修订版本2,-2D通过这个例子,我们可以看到封装命名规则在实际应用中的作用,它可以帮助工程师快速了解器件的基本信息,从而更好地进行设计和应用。
芯片封装之多少与命名规则一、DIP双列直插式封装DIP(DualIn-line Package)是指采用双列直插形式封装的集成电路芯片,绝大多数中小规模集成电路(IC)均采用这种封装形式,其引脚数一般不超过100个。
采用DIP封装的CPU芯片有两排引脚,需要插入到具有DIP结构的芯片插座上。
当然,也可以直接插在有相同焊孔数和几何排列的电路板上进行焊接。
DIP封装的芯片在从芯片插座上插拔时应特别小心,以免损坏引脚。
DIP封装具有以下特点:1.适合在PCB(印刷电路板)上穿孔焊接,操作方便。
2.芯片面积与封装面积之间的比值较大,故体积也较大。
Intel系列CPU中8088就采用这种封装形式,缓存(Cache)和早期的内存芯片也是这种封装形式。
二、QFP塑料方型扁平式封装和PFP塑料扁平组件式封装QFP(Plastic Quad Flat Package)封装的芯片引脚之间距离很小,管脚很细,一般大规模或超大型集成电路都采用这种封装形式,其引脚数一般在100个以上。
用这种形式封装的芯片必须采用SMD(表面安装设备技术)将芯片与主板焊接起来。
采用SMD安装的芯片不必在主板上打孔,一般在主板表面上有设计好的相应管脚的焊点。
将芯片各脚对准相应的焊点,即可实现与主板的焊接。
用这种方法焊上去的芯片,如果不用专用工具是很难拆卸下来的。
PFP(Plastic Flat Package)方式封装的芯片与QFP方式基本相同。
唯一的区别是QFP一般为正方形,而PFP既可以是正方形,也可以是长方形。
QFP/PFP封装具有以下特点:1.适用于SMD表面安装技术在PCB电路板上安装布线。
2.适合高频使用。
3.操作方便,可靠性高。
4.芯片面积与封装面积之间的比值较小。
Intel系列CPU中80286、80386和某些486主板采用这种封装形式。
三、PGA插针网格阵列封装PGA(Pin Grid Array Package)芯片封装形式在芯片的内外有多个方阵形的插针,每个方阵形插针沿芯片的四周间隔一定距离排列。
根据引脚数目的多少,可以围成2-5圈。
安装时,将芯片插入专门的PGA插座。
为使CPU能够更方便地安装和拆卸,从486芯片开始,出现一种名为ZIF 的CPU插座,专门用来满足PGA封装的CPU在安装和拆卸上的要求。
ZIF(Zero Insertion Force Socket)是指零插拔力的插座。
把这种插座上的扳手轻轻抬起,CPU就可很容易、轻松地插入插座中。
然后将扳手压回原处,利用插座本身的特殊结构生成的挤压力,将CPU的引脚与插座牢牢地接触,绝对不存在接触不良的问题。
而拆卸CPU芯片只需将插座的扳手轻轻抬起,则压力解除,CPU芯片即可轻松取出。
PGA封装具有以下特点:1.插拔操作更方便,可靠性高。
2.可适应更高的频率。
Intel系列CPU中,80486和Pentium、Pentium Pro均采用这种封装形式。
四、BGA球栅阵列封装随着集成电路技术的发展,对集成电路的封装要求更加严格。
这是因为封装技术关系到产品的功能性,当IC的频率超过100MHz时,传统封装方式可能会产生所谓的“CrossTalk”现象,而且当IC的管脚数大于208 Pin时,传统的封装方式有其困难度。
因此,除使用QFP封装方式外,现今大多数的高脚数芯片(如图形芯片与芯片组等)皆转而使用BGA(Ball Grid Array Package)封装技术。
BGA一出现便成为CPU、主板上南/北桥芯片等高密度、高性能、多引脚封装的最佳选择。
BGA封装技术又可详分为五大类:1.PBGA(Plasric BGA)基板:一般为2-4层有机材料构成的多层板。
Intel系列CPU中,Pentium II、III、IV处理器均采用这种封装形式。
2.CBGA(CeramicBGA)基板:即陶瓷基板,芯片与基板间的电气连接通常采用倒装芯片(FlipChip,简称FC)的安装方式。
Intel系列CPU中,Pentium I、II、Pentium Pro处理器均采用过这种封装形式。
3.FCBGA(FilpChipBGA)基板:硬质多层基板。
4.TBGA(TapeBGA)基板:基板为带状软质的1-2层PCB电路板。
5.CDPBGA(Carity Down PBGA)基板:指封装中央有方型低陷的芯片区(又称空腔区)。
BGA封装具有以下特点:1.I/O引脚数虽然增多,但引脚之间的距离远大于QFP封装方式,提高了成品率。
2.虽然BGA的功耗增加,但由于采用的是可控塌陷芯片法焊接,从而可以改善电热性能。
3.信号传输延迟小,适应频率大大提高。
4.组装可用共面焊接,可靠性大大提高。
BGA封装方式经过十多年的发展已经进入实用化阶段。
1987年,日本西铁城(Citizen)公司开始着手研制塑封球栅面阵列封装的芯片(即BGA)。
而后,摩托罗拉、康柏等公司也随即加入到开发BGA的行列。
1993年,摩托罗拉率先将BGA应用于移动电话。
同年,康柏公司也在工作站、PC电脑上加以应用。
直到五六年前,Intel公司在电脑CPU中(即奔腾II、奔腾III、奔腾IV等),以及芯片组(如i850)中开始使用BGA,这对BGA应用领域扩展发挥了推波助澜的作用。
目前,BGA已成为极其热门的IC封装技术,其全球市场规模在2000年为12亿块,预计2005年市场需求将比2000年有70%以上幅度的增长。
五、CSP芯片尺寸封装随着全球电子产品个性化、轻巧化的需求蔚为风潮,封装技术已进步到CSP(Chip Size Package)。
它减小了芯片封装外形的尺寸,做到裸芯片尺寸有多大,封装尺寸就有多大。
即封装后的IC尺寸边长不大于芯片的1.2倍,IC面积只比晶粒(Die)大不超过1.4倍。
CSP封装又可分为四类:1.Lead Frame Type(传统导线架形式),代表厂商有富士通、日立、Rohm、高士达(Goldstar)等等。
2.Rigid Interposer Type(硬质内插板型),代表厂商有摩托罗拉、索尼、东芝、松下等等。
3.Flexible Interposer Type(软质内插板型),其中最有名的是Tessera公司的microBGA,CTS的sim-BGA也采用相同的原理。
其他代表厂商包括通用电气(GE)和NEC。
4.Wafer Level Package(晶圆尺寸封装):有别于传统的单一芯片封装方式,WLCSP是将整片晶圆切割为一颗颗的单一芯片,它号称是封装技术的未来主流,已投入研发的厂商包括FCT、Aptos、卡西欧、EPIC、富士通、三菱电子等。
CSP封装具有以下特点:1.满足了芯片I/O引脚不断增加的需要。
2.芯片面积与封装面积之间的比值很小。
3.极大地缩短延迟时间。
CSP封装适用于脚数少的IC,如内存条和便携电子产品。
未来则将大量应用在信息家电(IA)、数字电视(DTV)、电子书(E-Book)、无线网络WLAN/GigabitEthemet、ADSL/手机芯片、蓝芽(Bluetooth)等新兴产品中。
六、MCM多芯片模块为解决单一芯片集成度低和功能不够完善的问题,把多个高集成度、高性能、高可靠性的芯片,在高密度多层互联基板上用SMD技术组成多种多样的电子模块系统,从而出现MCM(Multi Chip Model)多芯片模块系统。
MCM具有以下特点:1.封装延迟时间缩小,易于实现模块高速化。
2.缩小整机/模块的封装尺寸和重量。
3.系统可靠性大大提高。
总之,由于CPU和其他超大型集成电路在不断发展,集成电路的封装形式也不断作出相应的调整变化,而封装形式的进步又将反过来促进芯片技术向前发展。
TTL——Transistor-Transistor LogicHTTL——High-speed TTLLTTL——Low-power TTLSTTL——Schottky TTLLSTTL——Low-power Schottky TTLASTTL——Advanced Schottky TTLALSTTL——Advanced Low-power Schottky TTLFAST(F)——Fairchild Advanced schottky TTLCMOS——Complementary metal-oxide-semiconductorHC/HCT——High-speed CMOS Logic(HCT与TTL电平兼容)AC/ACT——Advanced CMOS Logic(ACT与TTL电平兼容)(亦称ACL)AHC/AHCT——Advanced High-speed CMOS Logic(AHCT与TTL电平兼容) FCT——FACT扩展系列,与TTL电平兼容FACT——Fairchild Advanced CMOS Technology,其电路含AC、ACT及FCT系列LV——Low-Voltage HCMOS TechnologyLVC——Low-voltage CMOS TechnologyLVT——Low-Voltage BiCMOS TechnologyALVC——Advanced Low-V oltage CMOS TechnologyABT——Advanced BiCMOS TechnologyBCT——BiCMOS Bus-Interface TechnologyCDC——Clock-Distribution Circuits这些芯片有LVC, LVT, ALVT, LCX, LVX, LPT and FCT3 Plus等3.3V的芯片可以直接与5V 芯片相连接CMOS的输出电平基本上就是0V和Vdd,LSTTL的0与1的threshold大约是1.3V,3V3CMOS输出的电平可以准确被5V LSTTL识别。
5VTTL的输出0低于0.4V,可以被CMOS识别。
至于TTL的高电平输出能力非常微弱(<1mA),CMOS电路的输入有嵌位二极管,防止可控硅闩锁,一般都有5~10mA的吸收能力,此时TTL的输出大约是3.3+0.7=4.0V,是1。