英飞凌的IGBT驱动芯片介绍
- 格式:pdf
- 大小:2.54 MB
- 文档页数:35




IGBT 1234567,看这一篇就够了话说公元2018年,IGBT江湖惊现第六代和第七代的掌门人,一时风头无两,各路吃瓜群众纷纷猜测二位英雄的出身来历。
不禁有好事者梳理了一下英家这些年,独领风骚的数代当家掌门人,分别是:呃,好像分不清这都谁是谁?呃,虽然这些IGBT“掌门人”表面看起来都一样,但都是闷骚型的。
只能脱了衣服,做个“芯”脏手术。
像这样,在芯片上,横着切一刀看看。
好像,有点不一样了。
故事,就从这儿说起吧。
史前时代-PTPT是最初代的IGBT,它使用重掺杂的P+衬底作为起始层,在此之上依次生长N+ buffer,N- base外延,最后在外延层表面形成元胞结构。
它因为截止时电场贯穿整个N-base区而得名。
它工艺复杂,成本高,而且需要载流子寿命控制,饱和压降呈负温度系数,不利于并联,虽然在上世纪80年代一度呼风唤雨,但在80年代后期逐渐被NPT取代,目前已归隐江湖,不问世事,英飞凌目前所有的IGBT 产品均不使用PT技术。
初代盟主——IGBT2特征:平面栅,非穿通结构(NPT)NPT-IGBT于1987年出山,很快在90年代成为江湖霸主。
NPT与PT不同在于,它使用低掺杂的N-衬底作为起始层,先在N-漂移区的正面做成MOS结构,然后用研磨减薄工艺从背面减薄到 IGBT 电压规格需要的厚度,再从背面用离子注入工艺形成P+ collector。
在截止时电场没有贯穿N-漂移区,因此称为“非穿通”型IGBT。
NPT不需要载流子寿命控制,但它的缺点在于,如果需要更高的电压阻断能力,势必需要电阻率更高且更厚的N-漂移层,这意味着饱和导通电压Vce(sat)也会随之上升,从而大幅增加器件的损耗与温升。
技能:低饱和压降,正温度系数,125℃工作结温,高鲁棒性因为N-漂移区厚度大大降低了,因此Vce(sat)相比PT大大减少。
正温度系数,利于并联。
名号:DLC,KF2C,S4…等等,好像混进了什么奇怪的东西!没写错!S4真的不是IGBT4,它是根正苗红的IGBT2,适用于高频开关应用,硬开关工作频率可达40kHz。


英飞凌IGBT 技术和产品概述及其应用领域IGBT芯片技术及其发展:功率半导体在整个电能供应链中扮演重要角色。
如何提高功率密度是功率器件发展的主题:芯片技术和功率密度:芯片技术的发展趋势——以600/650V 为例600V IGBT 新的里程碑——HighSpeed3:器件型号芯片技术Ic [A]@100°C 大小[mm2]SPW47N60C3 CoolmosTM C3 30 69.3 IKW30T60 TRENCHSTOPTM 30 15.2 IGW40N60H3 High Speed 3 40 19.3HighSpeed3 特性芯片面积只有CoolMOS的28%功率密度高芯片和模块成本低在高温在拖尾电流也很小关断特性接近于CoolMOS,Eoff是IGBT3的40%,是CoolMOS的120%平滑的开关波形,振荡很有限TRENCHSTOP™5 - 25°C Trade-off 曲线Vce(sat) 对Eoff:与英飞凌的Best-in-class Highspeed3 比, TRENCHSTOPTM5 : >60% 低的开关损耗10% 低的导通损耗TRENCHSTOP™5开关特性–接近MOSFET的开关特性,消除拖尾电流。
TRENCHSTOP™5 –应用目标,填补IGBT与MOSFET之间的中到高频开关应用650V TRENCHSTOP™5,产品家族。
F5:超高性能版本需要超低寄生电感设计开关频率:~120kHzH5:逆导型IGBT用于软开关,如准谐振感应加热R5:逆导型IGBT用于软开关,如准谐振感应加热L5:低饱和压降目标:Vcesat =1V @ Inom, 25°C600V/650V 芯片技术的发展:发展背景:•600V 主要应用220V 马达驱动,电源,以小功率为主。
•电动汽车,太阳能等新兴应用功率大,追求高效率,对芯片技术有新的要求IGBT2---IGBT3di/dt 降低25%.过电压减小25%更短的拖尾电流关断损耗在同一水平短路时间6us600V---650Vdi/dt 进一步降低关断损耗增加短路时间10us耐压增加50V电压余量增加180V芯片技术的发展趋势——IGBT4 回顾:芯片技术的发展趋势——IGBT4 回顾:IGBT4 P4 的软特性:2400A-模块的关断特性at Tvj=25°C , Ic= 0,5 Inom (Rg=0,3Ohm,没有有源嵌位) IGBT 3 E3 在测试条件下, 300V 直流电压下就开始振荡。
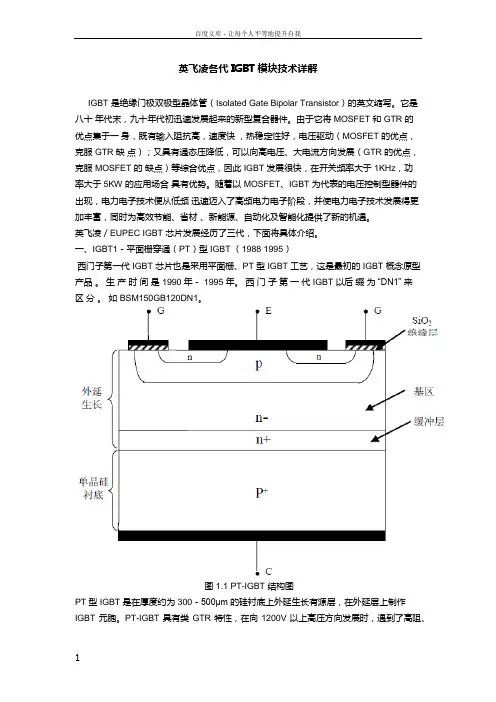
英飞凌各代IGBT模块技术详解IGBT 是绝缘门极双极型晶体管(Isolated Gate Bipolar Transistor)的英文缩写。
它是八十年代末,九十年代初迅速发展起来的新型复合器件。
由于它将 MOSFET 和 GTR 的优点集于一身,既有输入阻抗高,速度快,热稳定性好,电压驱动(MOSFET 的优点,克服 GTR 缺点);又具有通态压降低,可以向高电压、大电流方向发展(GTR 的优点,克服 MOSFET 的缺点)等综合优点,因此 IGBT 发展很快,在开关频率大于 1KHz,功率大于 5KW 的应用场合具有优势。
随着以 MOSFET、IGBT 为代表的电压控制型器件的出现,电力电子技术便从低频迅速迈入了高频电力电子阶段,并使电力电子技术发展得更加丰富,同时为高效节能、省材、新能源、自动化及智能化提供了新的机遇。
英飞凌/EUPEC IGBT 芯片发展经历了三代,下面将具体介绍。
一、IGBT1-平面栅穿通(PT)型 IGBT (1988 1995)西门子第一代 IGBT 芯片也是采用平面栅、PT 型 IGBT 工艺,这是最初的 IGBT 概念原型产品。
生产时间是 1990 年- 1995 年。
西门子第一代 IGBT 以后缀为“DN1” 来区分。
如 BSM150GB120DN1。
图 1.1 PT-IGBT 结构图PT 型 IGBT 是在厚度约为 300-500μm 的硅衬底上外延生长有源层,在外延层上制作IGBT 元胞。
PT-IGBT 具有类 GTR 特性,在向 1200V 以上高压方向发展时,遇到了高阻、厚外延难度大、成本高、可靠性较低的障碍。
因此,PT-IGBT 适合生产低压器件,600V 系列 IGBT 有优势。
二、IGBT2-第二代平面栅 NPT-IGBT西门子公司经过了潜心研究,于 1989 年在 IEEE 功率电子专家会议(PESC)上率先提出了 NPT-IGBT 概念。
由于随着 IGBT 耐压的提高,如电压VCE≥1200V,要求 IGBT 承受耐压的基区厚度dB>100μm,在硅衬底上外延生长高阻厚外延的做法,不仅成本高,而且外延层的掺杂浓度和外延层的均匀性都难以保证。
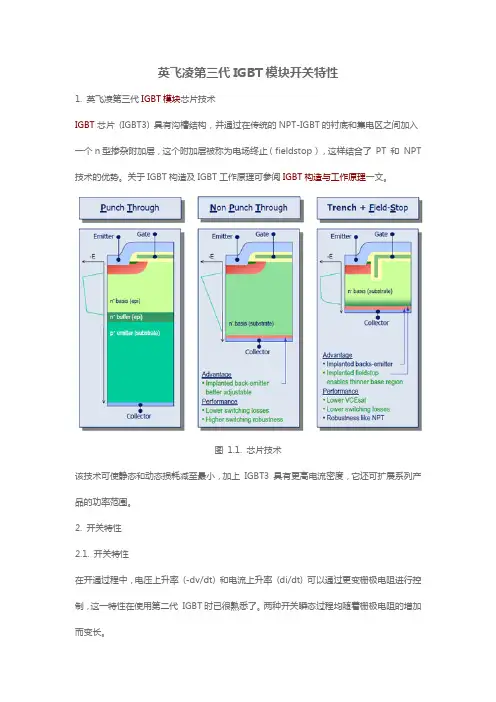
英飞凌第三代IGBT模块开关特性1. 英飞凌第三代IGBT模块芯片技术IGBT 芯片(IGBT3) 具有沟槽结构,并通过在传统的NPT-IGBT的衬底和集电区之间加入一个n型掺杂附加层,这个附加层被称为电场终止(fieldstop),这样结合了PT 和NPT 技术的优势。
关于IGBT构造及IGBT工作原理可参阅IGBT构造与工作原理一文。
图1.1. 芯片技术该技术可使静态和动态损耗减至最小,加上IGBT3 具有更高电流密度,它还可扩展系列产品的功率范围。
2. 开关特性2.1. 开关特性在开通过程中,电压上升率(-dv/dt) 和电流上升率(di/dt) 可以通过更变栅极电阻进行控制,这一特性在使用第二代IGBT时已很熟悉了。
两种开关瞬态过程均随着栅极电阻的增加而变长。
图2.1.1 标称栅极电阻下(数据手册中规定的最小栅极电阻)的开启过程VCE = 1200V (dv/dt=0.9kV/μs)IC = 1200A (di/dt=6.4kA/μs)VGE = ±15V (ICpeak = 2.4kA)Eon = 816mWs图2.1.2 低值栅极电阻下(比数据手册中规定的最小栅极电阻小)的开启过程(不推荐)VCE = 1200V (dv/dt=1.4kV/μs)IC = 1200A (di/dt=8.7kA/μs)VGE = ±15V (ICpeak = 2.7kA)Eon = 544mWs图2.1.3 大栅极电阻下(比数据手册中规定的最大栅极电阻)的开启过程VCE = 1200V (dv/dt=0.3kV/μs)IC = 1200A (di/dt=3kA/μs)VGE = ±15V (ICpeak = 1.81kA)Eon = 2558mWs2.2 关断特性图2.2.3 用标称栅极电阻的1700V IGBT3 的关断响应。
显示VGE、IC 和VCE。
关断过程从栅极电压的t1 点开始。
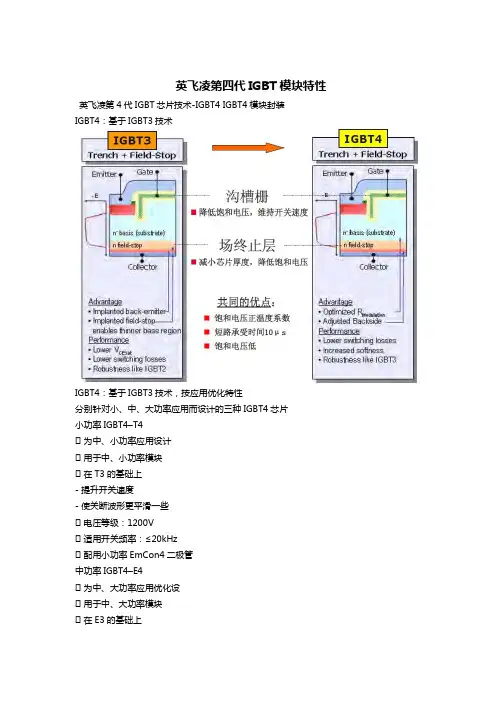
英飞凌第四代IGBT模块特性英飞凌第4代IGBT芯片技术-IGBT4 IGBT4模块封装IGBT4:基于IGBT3技术IGBT4:基于IGBT3技术,按应用优化特性分别针对小、中、大功率应用而设计的三种IGBT4芯片小功率IGBT4–T4为中、小功率应用设计用于中、小功率模块在T3的基础上- 提升开关速度- 使关断波形更平滑一些电压等级:1200V适用开关频率:≤20kHz配用小功率EmCon4二极管中功率IGBT4–E4为中、大功率应用优化设用于中、大功率模块在E3的基础上- 提升开关速度- 使关断波形更平滑一些电压等级:1200V,1700V适用开关频率:≤8kHz配用中功率EmCon4二极管大功率IGBT4–P4为大功率应用优化设计用于大功率模块在E3的基础上- 使关断过程“软”- 降低关断速度电压等级:1200V,1700V适用开关频率:≤3kHz配用大功率EmCon4二极管IGBT4(1200V):特征参数的调整:饱和电压T4-小功率IGBT4:开关能耗低于T3 (提高了开关速度)E4-中功率IGBT4:开关能耗低于E3 (提高了开关速度)P4-大功率IGBT4:开关能耗高于E3 (降低了关断速度,使关断“柔软”)关断过程对比:T4的波形比T3的平滑一些测试条件:Ls=200nH(极大),Ic=150A(Ic,nom=300A),Vdc=400V/450V/500V,Tj=25°CIGBT4(1200V):中功率E4关断过程对比:E4的波形比E3平滑一些测试条件:Ic=Ic,nom=450A,Vdc=800V/900V(仅供测试),Tj=25°CIGBT4(1200V):大功率P4关断过程对比:P4(及EmCon4)呈现明显的“软”特性IGBT4(1700V):大功率P4关断过程:对比IGBT3(E3),P4呈现明显的“软”特性关断过程:对比IGBT2(KF6C),P4呈现较“软”特性,且关断能耗较小IGBT4模块:Tvjop,max = 150°C!概念:在开关工作条件下,IGBT4模块的最高允许结温规格为 150°C,比IGBT3/IGBT2模块(1200V和1700V)的规格提高了25°C!出发点:适应芯片小型化(Rthjc,ΔTjc[=PLoss×Rthjc])实现:IGBT4模块内部焊线工艺的改进可靠性因素:焊线工艺决定了模块的可靠性指标之一-功率循环(PC)次数。
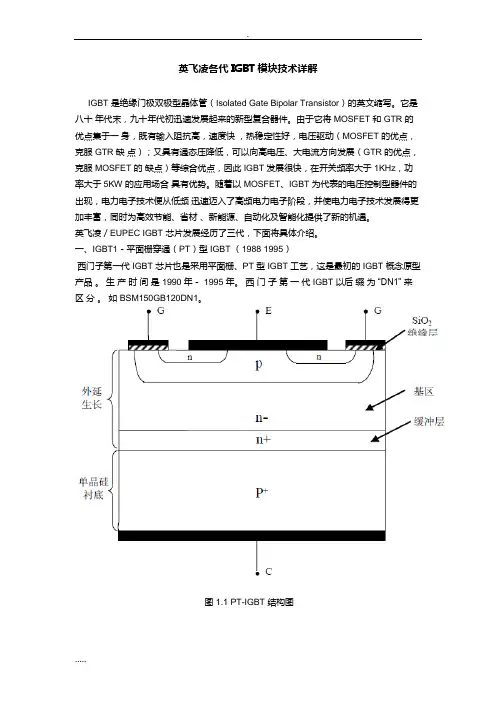
英飞凌各代IGBT模块技术详解IGBT 是绝缘门极双极型晶体管(Isolated Gate Bipolar Transistor)的英文缩写。
它是八十年代末,九十年代初迅速发展起来的新型复合器件。
由于它将 MOSFET 和 GTR 的优点集于一身,既有输入阻抗高,速度快,热稳定性好,电压驱动(MOSFET 的优点,克服 GTR 缺点);又具有通态压降低,可以向高电压、大电流方向发展(GTR 的优点,克服 MOSFET 的缺点)等综合优点,因此 IGBT 发展很快,在开关频率大于 1KHz,功率大于 5KW 的应用场合具有优势。
随着以 MOSFET、IGBT 为代表的电压控制型器件的出现,电力电子技术便从低频迅速迈入了高频电力电子阶段,并使电力电子技术发展得更加丰富,同时为高效节能、省材、新能源、自动化及智能化提供了新的机遇。
英飞凌/EUPEC IGBT 芯片发展经历了三代,下面将具体介绍。
一、IGBT1-平面栅穿通(PT)型 IGBT (1988 1995)西门子第一代 IGBT 芯片也是采用平面栅、PT 型 IGBT 工艺,这是最初的 IGBT 概念原型产品。
生产时间是 1990 年- 1995 年。
西门子第一代 IGBT 以后缀为“DN1” 来区分。
如 BSM150GB120DN1。
图 1.1 PT-IGBT 结构图PT 型 IGBT 是在厚度约为 300-500μm 的硅衬底上外延生长有源层,在外延层上制作IGBT 元胞。
PT-IGBT 具有类 GTR 特性,在向 1200V 以上高压方向发展时,遇到了高阻、厚外延难度大、成本高、可靠性较低的障碍。
因此,PT-IGBT 适合生产低压器件,600V 系列 IGBT 有优势。
二、IGBT2-第二代平面栅 NPT-IGBT西门子公司经过了潜心研究,于 1989 年在 IEEE 功率电子专家会议(PESC)上率先提出了 NPT-IGBT 概念。
由于随着 IGBT 耐压的提高,如电压VCE≥1200V,要求 IGBT 承受耐压的基区厚度dB>100μm,在硅衬底上外延生长高阻厚外延的做法,不仅成本高,而且外延层的掺杂浓度和外延层的均匀性都难以保证。
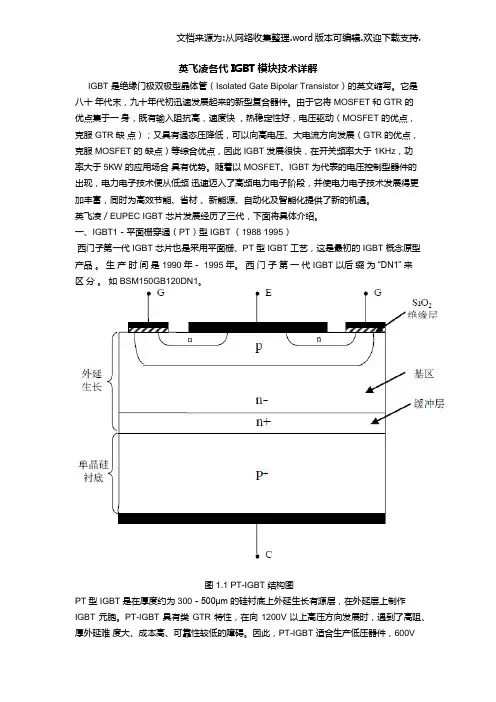
英飞凌各代IGBT模块技术详解IGBT 是绝缘门极双极型晶体管(Isolated Gate Bipolar Transistor)的英文缩写。
它是八十年代末,九十年代初迅速发展起来的新型复合器件。
由于它将 MOSFET 和 GTR 的优点集于一身,既有输入阻抗高,速度快,热稳定性好,电压驱动(MOSFET 的优点,克服 GTR 缺点);又具有通态压降低,可以向高电压、大电流方向发展(GTR 的优点,克服 MOSFET 的缺点)等综合优点,因此 IGBT 发展很快,在开关频率大于 1KHz,功率大于 5KW 的应用场合具有优势。
随着以 MOSFET、IGBT 为代表的电压控制型器件的出现,电力电子技术便从低频迅速迈入了高频电力电子阶段,并使电力电子技术发展得更加丰富,同时为高效节能、省材、新能源、自动化及智能化提供了新的机遇。
英飞凌/EUPEC IGBT 芯片发展经历了三代,下面将具体介绍。
一、IGBT1-平面栅穿通(PT)型 IGBT (1988 1995)西门子第一代 IGBT 芯片也是采用平面栅、PT 型 IGBT 工艺,这是最初的 IGBT 概念原型产品。
生产时间是 1990 年- 1995 年。
西门子第一代 IGBT 以后缀为“DN1” 来区分。
如 BSM150GB120DN1。
图 1.1 PT-IGBT 结构图PT 型 IGBT 是在厚度约为 300-500μm 的硅衬底上外延生长有源层,在外延层上制作IGBT 元胞。
PT-IGBT 具有类 GTR 特性,在向 1200V 以上高压方向发展时,遇到了高阻、厚外延难度大、成本高、可靠性较低的障碍。
因此,PT-IGBT 适合生产低压器件,600V系列 IGBT 有优势。
二、IGBT2-第二代平面栅 NPT-IGBT西门子公司经过了潜心研究,于 1989 年在 IEEE 功率电子专家会议(PESC)上率先提出了 NPT-IGBT 概念。
由于随着 IGBT 耐压的提高,如电压VCE≥1200V,要求 IGBT 承受耐压的基区厚度dB>100μm,在硅衬底上外延生长高阻厚外延的做法,不仅成本高,而且外延层的掺杂浓度和外延层的均匀性都难以保证。
英飞凌3.3kV的IGBT模块作为一款成熟的产品,芯片技术已经从第二代发展到了第三代。
不少传统的传动行业客户会使用3.3kV等级的模块,轨道交通牵引行业更是大量使用3.3kV等级的模块。
高压变频行业客户也正逐步采用3.3kV系列模块进行技术更新,以替代传统1.2kV,1.7kV级联模式的复杂系统。
因此,对3.3kV等级的IGBT模块驱动电路进行研究十分有意义。
目前,市场上专业驱动器生产厂商有相关配套驱动器产品提供给客户选择,但是做为一款广泛应用的模块产品,很有必要做更深入的细节分析,希望能够帮助客户更安全合理的使用3.3kV系列模块产品。
英飞凌作为全球最大的功率半导体厂商,总部位于德国慕尼黑,可以提供从发电、输电到用电整个链条所需的功率半导体和功率模块。
英飞凌科技(中国)有限公司是2003年7月在上海成立的,除了负责中国区的市场和销售外,还拥有应用研发中心。
其中有关IGBT模块的支持则是亚太区的应用技术中心。
多年来,在半导体解决方案和客户服务上持续在业内居于领先。
对于3.3kV的驱动,无论是电路本身还是并联使用时的均流问题,英飞凌都有合适的解决方案。
所有相关测试都是在英飞凌上海的实验室完成。
本文主要从安全隔离、门极电路、有缘钳位和短路保护这几个方面来简单介绍下设计时要注意的事项。
这里借助一款使用英飞凌驱动芯片1ED020I12的3.3kV驱动设计来作分析,图1和图2分别为驱动板和适配板的实物图。
另外,英飞凌还能够提供3.3kV并联方案的测试板。
图1 3.3kV驱动板图2 3.3kV有源适配板1. 驱动的安全隔离在设计高压IGBT驱动电路时,首先要考虑的就是安全隔离的问题。
不同电压等级的IGBT模块有不同的隔离要求,包括驱动信号与主电路的隔离以及初级供电电源与主电路的隔离。
驱动信号与主电路的隔离可以用光纤来实现。
用光纤隔离不仅绝缘好,使用方便,而且抗干扰能力也强。
使用光纤连接信号时要注意光纤收发器的工作温度,常见的塑料光纤,工作温度最高不超过85℃,可靠的工作环境温度一般是0℃~70℃。
英飞凌各代IGBT 模块技术详解IGBT 是绝缘门极双极型晶体管(Isolated Gate Bipolar Transistor )的英文缩写。
它是八十年代末,九十年代初迅速发展起来的新型复合器件。
由于它将MOSFET 和GTR 的优点集于一身,既有输入阻抗高,速度快,热稳定性好,电压驱动(MOSFET 的优点,克服GTR 缺点);又具有通态压降低,可以向高电压、大电流方向发展(GTR 的优点,克服MOSFET 的缺点)等综合优点,因此IGBT 发展很快,在开关频率大于1KHz ,功率大于5KW 的应用场合具有优势。
随着以MOSFET 、IGBT 为代表的电压控制型器件的出现,电力电子技术便从低频迅速迈入了高频电力电子阶段,并使电力电子技术发展得更加丰富,同时为高效节能、省材、新能源、自动化及智能化提供了新的机遇。
英飞凌/EUPEC IGBT 芯片发展经历了三代,下面将具体介绍。
一、IGBT1 -平面栅穿通(PT)型IGBT (1988 1995 )西门子第一代IGBT 芯片也是采用平面栅、PT 型IGBT 工艺,这是最初的IGBT 概念原型产品。
生产时间是1990 年-1995 年。
西门子第一代IGBT 以后缀为“DN1来”区分。
如BSM150GB120DN1 。
图1.1 PT-IGBT 结构图PT 型 IGBT 是在厚度约为300 -500μm 的硅衬底上外延生长有源层,在外延层上制作IGBT 元胞。
PT-IGBT 具有类G TR 特性,在向1200V 以上高压方向发展时,遇到了高阻、度大、成本高、可靠性较低的障碍。
因此,PT-IGBT 适合生产低压器件,600V厚外延难系列 IGBT 有优势。
二、IGBT2 -第二代平面栅N PT-IGBT(PESC )上率先提出议西门子公司经过了潜心研究,于1989 年在 IEEE 功率电子专家会了NPT -IGBT 概念。
由于随着IGBT 耐压的提高,如电压VCE≥1200V,要求 IGBT 承受耐压的基区厚度dB>100 μm,在硅衬底上外延生长高阻厚外延的做法,不仅成本高,而且。
IGBT4 Modules optimized for EV/HEV Drive ApplicationsSep. 2010 Power SeminarCompact design/High power densityOverload coefficient is around: 2 – 2.5 lasting 1mins – 3mins Already thermal stable for IGBT module Recommend to do stable thermal calculate based on peak power. Load profile simulation is even better Max. liquid temperature is up to 75 degree or even higher Much harsh than industry application Better cooling Higher max. Tj Chip losses reduction Trench fieldstop technologyCopyright © Infineon Technologies 2010. All rights reserved.All 600/650V chip and 1200V E4, P4 chip reach 150 degree max. operating temperature1200V level chipsTwo kinds chips are recommended to be used IGBT4 - High Power P4 chip¬ A little bit higher switching losses ¬ Much softer switching performance lower EMC problemIGBT4 - Medium Power E4 chip¬ Lower switching losses for high frequency2800 1400 2400 12002000100016008001200600800IC_HE4 IC_HP4 UDC_HE4 UDC_HP44004002000 0 -400 0,5 1 1,5 2 2,5 3 3,5 40-200Copyright © Infineon Technologies 2010. All rights reserved. t [µs]UDC [V]IC [A]600V level chipsTwo kinds of chip E3(600V)¬ Lower switching losses for high frequencyE4(650V)¬ A little bit higher switching losses ¬ Much softer switching performance ¬ 50V more voltage marginVCEmax=559V VCEmax=428VNewE3 chipE4 chipCopyright © margin increase reserved. Turn off peak voltage Infineon Technologies 2010. All rights(559-428)+50 = 181VIGBT voltage classes choosing576V battery voltage system 1200V IGBT312V/336V battery voltage system Maximum peak DC voltage is around 420V Big challenge to minimize bus stray inductance 600V or 1200V ?V g∆Vdi/dt∆V=Ls*di/dtModule internal stray inductanceCopyright © Infineon Technologies 2010. All rights reserved.650V chip Vs. 1200V chip @ lossesTypical 100kW powerDC link voltage 650V E4 Vcesat Eon Eoff 1.7V 4mJ 35mJ 1200V E4 2.1V 61mJ 73mJ Output current Output frequency Modulation Frequency Modulation factor Power Factor V Amps V kHz 336 300 400 16 0.8 0.8600A,650V E4 chip (W)600A,1200V E4 chip (W) 158 270 47 111 58635% lower losses, means 1.2%IGBT static losses127 169 42 46 384efficiency improvement IGBT dynamic lossesDiode static losses Diode dynamic lossesCopyright © Infineon Technologies 2010. All rights reserved.Total lossesReliability - VibrationVibration test required system structure design¬ Fixing block ¬ Soft copper bus bar ¬ Fastness of capacitorCopyright © Infineon Technologies 2010. All rights reserved.EconoDUAL™3 & PrimePACK™Acceleration [g] 15 swept sine Frequency [Hz] f = 47-2000 Hz with 1Oct./min Endurance time 8 ms f = 47Hz …2kHz Test duration [h] each direction t = 8h each direction50 shock 15 random6 times each direction t = 8h each directionMichael Sleven IFAG IMM INP HPPage 9Lifetime challenge10 – 15 years life time is required Up to 60kh operation time neededCopyright © Infineon Technologies 2010. All rights reserved.Bond wire connections (PC)Power cycling test defines bond wire reliabilityTest criteria: active heating, active cooling End-of-test criteria: Vcesat +5% from initial valueBond-wire heel cracksCopyright © Infineon Technologies 2010. All rights reserved.Bond-wire lift-offPower cycling for IGBT4Comparing to old generation chip, IGBT4 have around 4 times improvement with same max. junction temperature.Solder connection between DCB and baseplate (TC)Thermal cycling test definessoldering reliabilityTest criteria: active heating, activecoolingEnd-of-test criteria: Rthjc +20%from initial valueCoefficient of thermal expansion (CTE)[ppm/K]Thermal cycling of normal modulePrimePACK, EconoDual3 provide the best cost efficiencyPersist to use module with baseplate in EV/HEVPersist to use module with baseplate in EV/HEVPersist to use module with baseplate in EV/HEVHow to qualify lifetime of IGBT moduleWhat’s needed: Basic system parametersDC link voltageOutput voltageOutput currentHow to qualify lifetime of IGBT moduleCalculate the losses and further more get temperature ripple.losses Temperature rippleThermal model of systemHow to qualify lifetime of IGBT moduleCompare PC/TC curve with estimated number off temperature rippleInverter in EV/HEVCompact designHigh reliabilityLong life time requirementHigh power densitySuitable switching behaviorStrong mechanical structureEnough Thermal capabilityHigh reliabilityProduct portfolio (keeping update)。